Nanocrystal-Embedded-Insulator (NEI) ferro-elektrische FET's voor apparaten met negatieve capaciteit en toepassingen met niet-vluchtig geheugen
Abstract
We rapporteren een nieuwe nanokristal-embedded-isolator (NEI) ferro-elektrische veldeffecttransistor (FeFET) met een zeer dunne unified-ferro-elektrische/diëlektrische (FE/DE) isolerende laag, die veelbelovend is voor laagspanningslogica en niet-vluchtig geheugen ( NVM) toepassingen. De ferro-elektrische aard van de NEI-lagen bestaande uit orthorhombische ZrO2 nanokristallen ingebed in amorf Al2 O3 wordt bewezen door polarisatiespanningsmetingen, piëzoresponskrachtmicroscopie en elektrische metingen. De temperatuurafhankelijke prestatie en het uithoudingsvermogen van een NEI negatieve capaciteit FET (NCFET) worden onderzocht. Een FeFET met 3,6 nm dikke FE/DE bereikt een geheugenvenster groter dan 1 V, wat een pad vrijmaakt voor ultieme schaling van de FE-dikte om driedimensionale FeFET's met een zeer kleine vinsteek mogelijk te maken.
Achtergrond
Veldeffecttransistoren met een ferro-elektrische gate-isolatorlaag (FeFET's) hebben veel belangstelling gewekt voor een verscheidenheid aan toepassingen met geïntegreerde schakelingen. Vanwege zijn inherente negatieve capaciteitseigenschappen (NC), kan een FeFET een steiler schakelgedrag bereiken dan een conventionele MOSFET, waardoor een lagere spanning mogelijk is [1]. Verschillende kanaalstructuren [2,3,4] en materialen [5,6,7] hebben sub-60 mV/decade subthreshold swing (SS) verkregen. Ook hysterese in de stroom-spanning (I -V ) karakteristiek vanwege restpolarisatie (P r ) kan worden gebruikt voor toepassingen met niet-vluchtig geheugen (NVM) [8]. De materiaalontwikkeling voor FeFET's heeft zich recentelijk gericht op polykristallijn-gedoteerde HfO2 vanwege de betere dikteschaalbaarheid [9] en CMOS-procescompatibiliteit [2]. Er bestaat echter nog steeds een fundamentele limiet voor HfO2 dikteschaling om ongewenste poortlekstroom te voorkomen; dit beperkt op zijn beurt de FinFET [2]. Geïnspireerd door het nanokristal MOS- en geheugenapparaatconcept [10, 11], wordt in dit werk een isolerende diëlektrische (DE) laag met ingebedde ferro-elektrische (FE) nanokristallen geïntroduceerd. Het resulterende nieuwe apparaatontwerp geïllustreerd in Fig. 1 wordt de "Nanocrystal-Embedded-Insulator" (NEI) FeFET genoemd. Het belangrijkste voordeel van dit ontwerp is een dunnere unified-FE/DE-laag die voldoet aan de lage-gate-lekkage-eis.
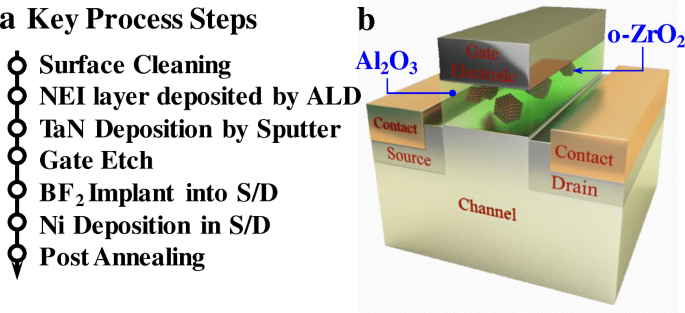
een Belangrijkste processtappen voor de fabricage van de NEI ferro-elektrische veldeffecttransistoren. b 3D-schema van de gefabriceerde NEI FeFET
In dit werk worden NEI FeFET's gerapporteerd. Fysische eigenschappen en ferro-elektriciteit van de NEI-lagen met verschillende fysieke diktes worden gekarakteriseerd. De elektrische prestaties van NEI FeFET's worden onderzocht voor laagspanningslogica en NVM-toepassingen.
Methoden
De belangrijkste processtappen voor de fabricage van NEI FeFET's worden getoond in figuur 1a. Vier-inch n-type Ge (001) wafels met een soortelijke weerstand van 0,088-0,14 Ω cm werden gebruikt als uitgangssubstraten. Na pregate-reiniging met verdunde HF, werden Ge(001)-wafels geladen in een atomaire laagafzettingskamer (ALD) voor de afzetting van de NEI-laag bestaande uit ZrO2 nanokristallen ingebed in amorf Al2 O3 Matrix. In dit werk werden NEI-lagen met de verschillende diktes gebruikt. TaN-metalen poort werd afgezet op de NEI FeFET's met behulp van het reactieve sputteren. Na het poortpatroon en het etsen, BF2 + ionen werden geïmplanteerd in de source/drain-regio's met een energie van 20 keV en een dosis van 1 × 15 cm −2 . Dertig nanometer nikkel (Ni) werd afgezet in source/drain-gebieden met behulp van het lift-off-proces. Ten slotte werd de fabricage van het apparaat voltooid met snelle thermische annealing (RTA). Regel metaaloxide-halfgeleider veldeffecttransistoren (MOSFET's) met een puur diëlektrische Al2 O3 poort isolerende laag werden ook vervaardigd.
Figuur 1b toont het 3D-schema van de gefabriceerde NEI FeFET, die bestaat uit FE-nanokristallen ingebed in een amorfe DE-poortisolatielaag. Hoewel het volume FE-materiaal klein is, is het voldoende voor NCFET- en NVM-toepassingen. Het isolerende DE-materiaal is de sleutel tot het bereiken van een lage poortlekkage en een lage bedrijfsspanning; het moet zowel een grote bandgap-energie als een hoge diëlektrische permittiviteit hebben (κ ). Het moet ook zorgen voor een sterk dwingend veld (E c ) van de ingebedde FE-nanokristallen.
Het transversale transmissie-elektronenmicroscoop (XTEM) -beeld in figuur 2a toont de source / drain-, kanaal- en gate-randgebieden van een gefabriceerde FeFET. Figuren 2b en c geven aan dat de dikten van de NEI-lagen die in dit werk zijn bestudeerd, respectievelijk 3,6 en 2,1 nm zijn. Merk op dat een grenslaag van GeOx bestaat tussen de NEI-laag en Ge, hoewel het niet kan worden gezien.
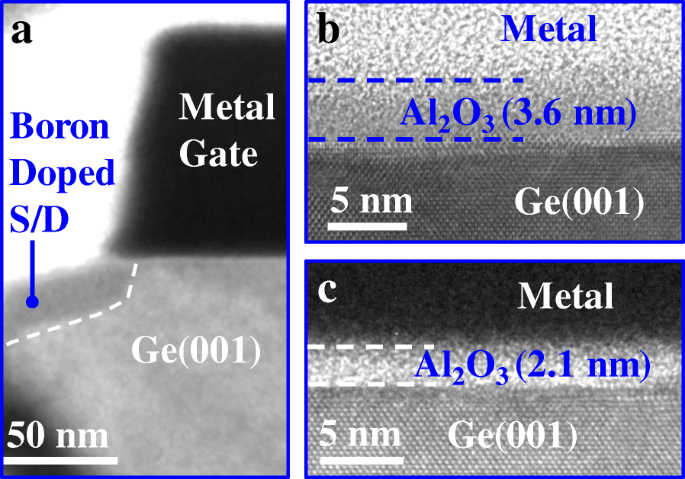
een XTEM-afbeelding met poort-, kanaal- en source/drain-regio's van NEI-FeFET. b en c XTEM-afbeeldingen van gate-stack van FeFET's met respectievelijk 3,6- en 2,1-nm dikke NEI-lagen
Hoge resolutie TEM (HRTEM) afbeeldingen in Fig. 3 demonstreren de ZrO2 nanokristallen ingebed in amorf Al2 O3 op Ge(001) in de NEI-monsters met diktes van 3,6 en 6 nm. In ons vorige werk hebben we aangetoond dat het atomaire percentage van Zr in de NEI-laag minder dan 0,5% is [12]. Gebaseerd op de diffractiepatronen, is de interplanaire afstand d binnen de nanokristallen wordt berekend op 0,173 nm, wat overeenkomt met (111)-georiënteerd orthorhombisch ZrO2 fase [13].
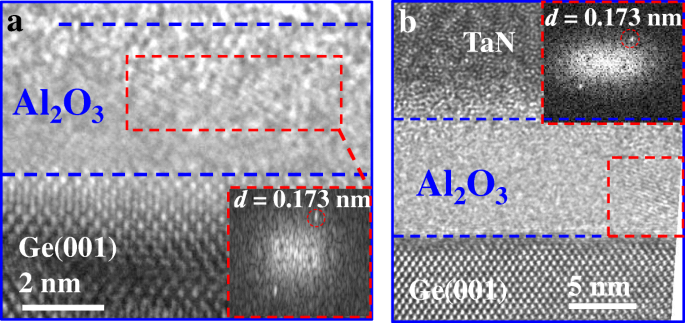
HRTEM-beelden met nanokristallen ingebed in amorf Al2 O3 voor de monsters met een dikte van a 3,6 nm en b 6 nm. Inzetstukken laten zien dat de interplanaire afstand d in het nanokristal is 0,173 nm, wat overeenkomt met o-ZrO2 (111) fase
Polarisatie vs. spanning (P -V ) en piëzoresponskrachtmicroscopie (PFM) metingen werden uitgevoerd op de NEI-monsters met de verschillende diktes. Om de ferro-elektriciteit van de NEI-laag te karakteriseren, P -V krommen van TaN/NEI (3,6 nm)/Ge, TaN/NEI (6 nm)/Si0,7 Ge0.3 , en TaN/NEI (10 nm)/TaN-condensatoren worden respectievelijk getoond in Fig. 4a, b en c. De NEI-laag vertoont een lagere P dan de gerapporteerde waarden van HfZrO2 (HZO) [14], wat te wijten is aan het feit dat de volumeverhouding van ZrO2 nanokristal in Al2 O3 matrix is vrij laag. Het is te zien dat de resterende polarisatie P r van de NEI-film neemt toe met toenemende filmdikte. P-V krommen in Fig. 4c geven aan dat de ferro-elektriciteit van de NEI-laag degenereert terwijl de gloeitemperatuur stijgt van 450 tot 550 ° C. Opgemerkt wordt dat de reden voor de niet-gesloten P-V lussen is omdat er inderdaad een lekkage is. Er werd gemeld dat de resulterende offset bij nul elektrisch veld afneemt naarmate het bereik van de spanningszwaai kleiner wordt [3, 15, 16]. De amplitude (bovenste) en fase (onderste) beelden van 3,6 nm, 6 nm en 10 nm NEI werden gemeten, zoals weergegeven in respectievelijk Fig. 5a, b en c. Zoals getoond in Fig. 6, vertonen patronen die de tegenovergestelde polariteit aangeven die op het oppervlak van NEI op TaN zijn geschreven, een duidelijker contrast met de toenemende filmdikte.
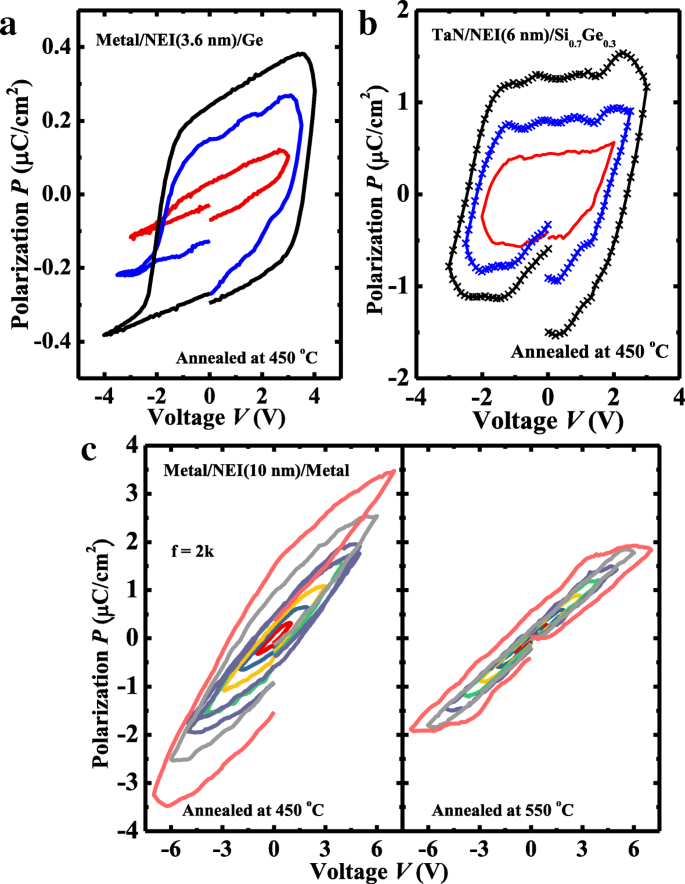
een –c Gemeten P -V krommen van TaN/NEI (3,6 nm)/Ge, TaN/NEI (6 nm)/Si0,7 Ge0.3 , en respectievelijk TaN/NEI (10 nm)/TaN
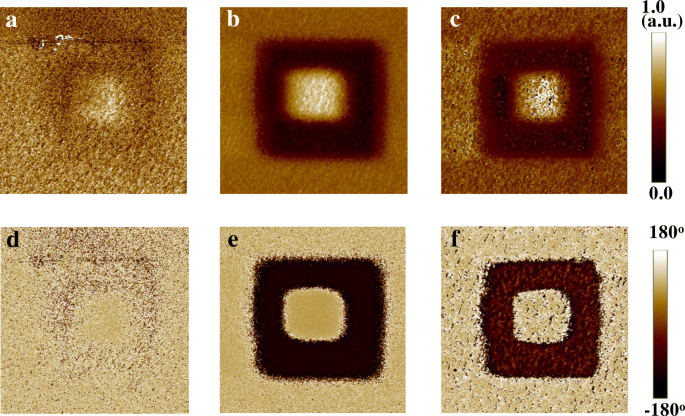
een –c Amplitude (bovenste) en fase (onderste) beelden van PFM-meting voor respectievelijk 3,6, 6 en 10 nm NEI op TaN
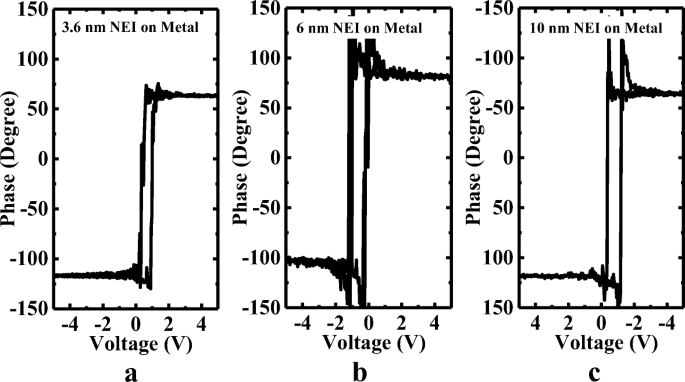
een –c Faseveranderingskenmerken van respectievelijk 3,6, 6 en 10 nm NEI op TaN. Er is waargenomen dat tegengestelde polariteit kan worden geschreven op het oppervlak van de NEI-laag
Resultaten en discussie
NEI NCFET
Afbeelding 7a toont gemeten I DS -V GS curven van de NEI NCFET's met een NEI-dikte van 3,6 nm gegloeid bij 450 ° C en 500 ° C. De NCFET's vertonen weinig hysterese, wat wijst op de goede afstemming tussen de ferro-elektrische capaciteit en de MOS-capaciteit in de transistoren. De NCFET's tonen het NC-effect dat met de klok mee wordt geïnduceerd I-V lussen, wat in contrast staat met de tegen de klok in lussen door ladingsopsluiting/detrapping [17]. De poortlekkage I G als een functie van V GS van hetzelfde paar apparaten toont aan dat de vorming van nanokristallen in Al2 O3 verhoogt de poortlekkage niet. Figuur 7b laat zien dat de NCFET's de steile SS-punten van minder dan 60 mV/decennium bereiken voor de voorwaartse en achterwaartse zwaaibewegingen. De SS-fluctuaties in de NEI NCFET, ook waargenomen in NC FinFET's [2, 18], kunnen te wijten zijn aan de polarisatieomschakeling door de verschillende ferro-elektrische nanokristallen of domeinen. De gemeten I DS -V DS krommen voor hetzelfde paar apparaten in Fig. 7c laten zien dat bij ∣V GS − V TH ∣ = ∣ V DS ∣ = 1.0 V, de NCFET met RTA bij 500 °C bereikt 29% groter I DS in vergelijking met de bij 450 °C gegloeide transistor. Dit wordt toegeschreven aan het feit dat de mobiliteit van de drager in kanaal- en contactweerstandskarakteristieken kan worden verbeterd met de toenemende gloeitemperatuur [19]. Het typische kenmerk dat wordt veroorzaakt door de ferro-elektrische laag, negatieve differentiële weerstand (NDR), wordt waargenomen in de I DS -V DS curven voor de NCFET's gegloeid bij de verschillende temperaturen.
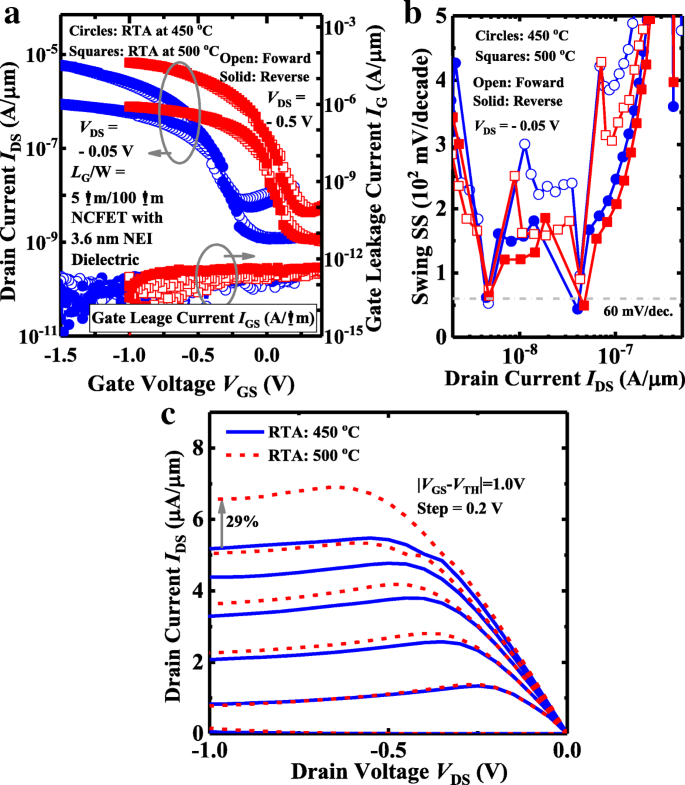
een Gemeten I DS -V GS en ik G -V GS curven van NCFET's met 3,6-nm NEI gegloeid bij 450 ° C en 500 ° C. b NEI NCFET's heeft de sub-60 mV/decade punten voor een V DS waarde van − 0,05 V. c Ik DS -V DS curven voor de NEI NCFET's die de voor de hand liggende NDR-verschijnselen tonen. NC-transistor gegloeid bij 500 °C bereikt een I . van 29% DS verbetering ten opzichte van het apparaat met RTA bij 450 °C bij een voedingsspanning van 1,0 V
Afbeelding 8a toont gemeten I DS -V GS curven van een NEI NCFET en een controle MOSFET met dezelfde isolatordikte van 2,1 nm. Apparaten hebben een L G van 6 urn. De NCFET vertoont de hysteresevrije eigenschappen. De inzet toont het punt SS vs. I DS curven voor de apparaten, wat aantoont dat verbeterde SS wordt bereikt in de NCFET in vergelijking met het besturingsapparaat, tot aan de drempelspanning. Afbeelding 8b toont de I DS -V DS curven van de NEI NCFET en de controle MOSFET. NCFET vertoont het NDR-fenomeen voor de lage V GS . Het NDR-effect komt overeen met de verbeterde drain-geïnduceerde barrière-verlagende (DIBL) kenmerken in NCFET in vergelijking met de controle-MOSFET, zoals weergegeven in figuur 8a. Bij ∣V GS − V TH ∣ = ∣ V DS ∣ = 1.0 V, een 16% I DS verbetering wordt verkregen in NCFET in vergelijking met het besturingsapparaat. NCFET met 2,1 nm NEI heeft de minder significante NDR vergeleken met de transistor met 3,6 nm NEI, wat consistent is met de conclusie in [20].
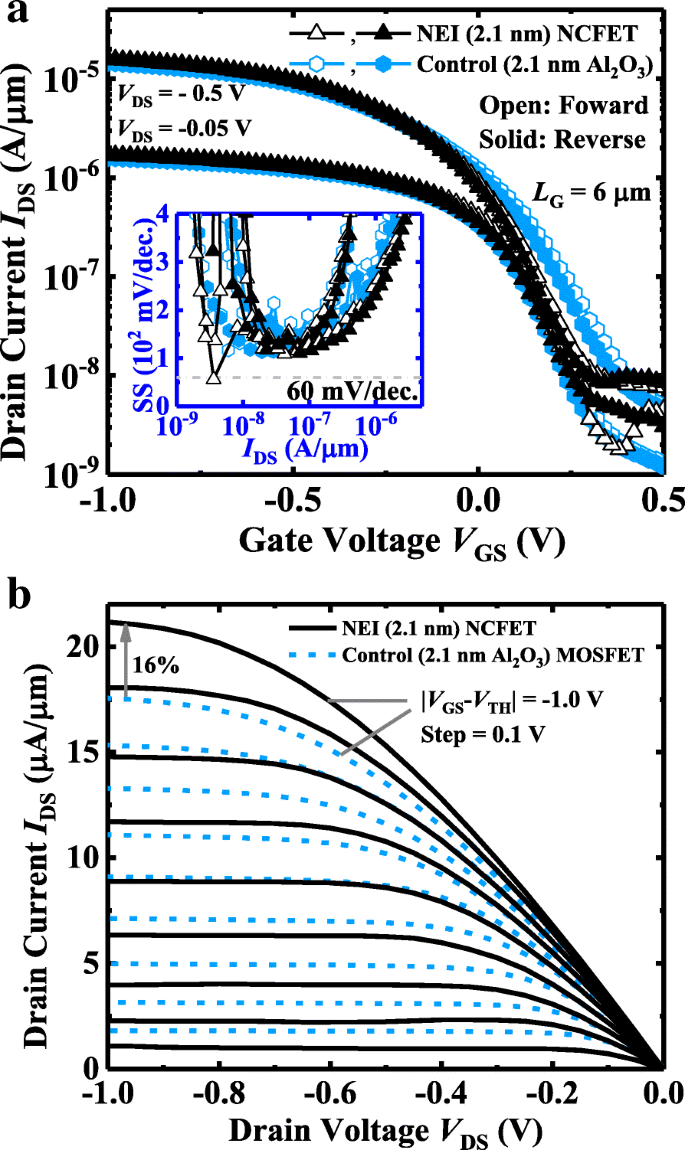
een Ik DS -V GS curven van een NEI NCFET en controle MOSFET met pure Al2 O3 diëlektrisch. Beide apparaten hebben de 2.1-nm gate-isolator. De inzet laat zien dat de NCFET een steilere SS heeft dan het regelapparaat tot aan de drempelspanning. b Gemeten I DS -V DS curven voor NCFET en besturings-MOSFET. NDR wordt waargenomen voor NCFET bij zeer lage V GS . Bij ∣V GS − V TH ∣ = ∣ V DS ∣ = 1,0 V, NCFET behaalt een I . van 16% DS verbetering vergeleken met het controleapparaat
De temperatuurafhankelijkheid van de NCFET met 3,6 nm dikke NEI wordt hierin onderzocht. Afbeelding 9a toont I DS -V GS curven gemeten bij 10 °C en 30 °C. Inzet geeft aan dat de SS-prestaties van de transistor niet verslechteren bij de verhoogde temperaturen. Naarmate de temperatuur stijgt, wordt de I -V curve verschuift naar meer negatieve V GS vanwege het dominante effect van ferro-elektriciteit, wat tegengesteld is aan de trend voor een conventionele MOSFET. Figuur 9b geeft een samenvatting van de verschuivingen in hysteresisspanning en voorwaartse schakeldrempelspanning met temperatuur. Doorsturen V GS verschuift naar meer negatieve waarden naarmate de temperatuur stijgt, wat te wijten kan zijn aan verhoogde E c van de NEI.
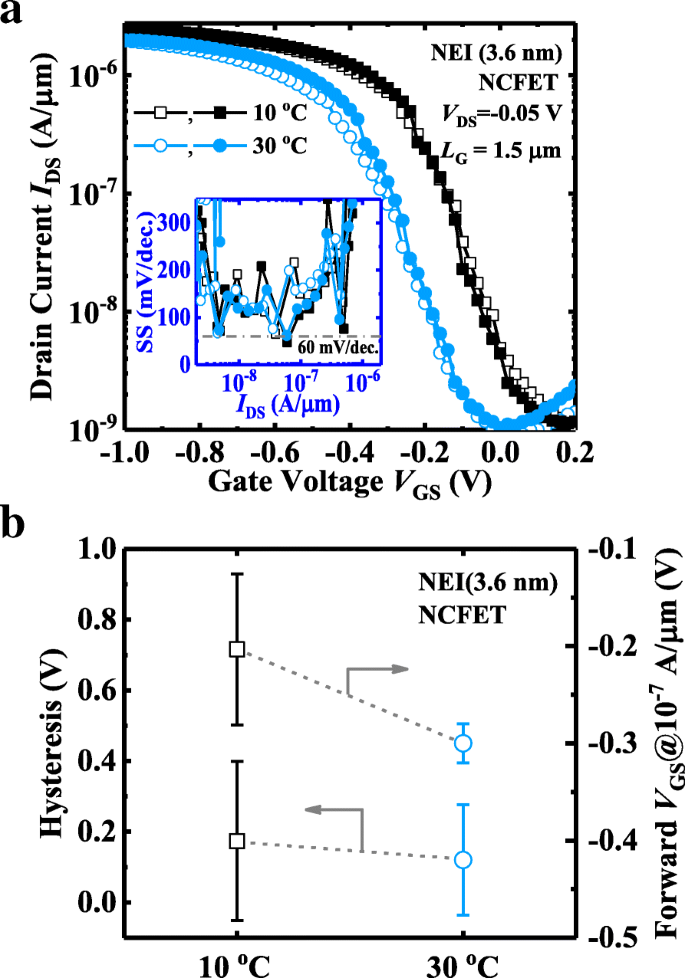
een Ik DS -V GS van een NEI (3,6 nm) NCFET gemeten bij 10 °C en 30 °C. De curven laten, zoals verwacht, een verschuiving zien naar meer negatieve spanning met toenemende temperatuur. Inzet toont steile punt SS. b Statistische grafieken van hysterese (links) en voorwaartse V GS @ 10 −7 A/μm (rechts) voor NCFET's met 3,6-nm NEI-laag. Doorsturen V GS verschuift in de negatieve richting met toenemende temperatuur
NEI FeFET voor toepassing met niet-vluchtig geheugen
Door het bereik van V . te vergroten GS vegen, kan de hysteresisspanning van een NEI FeFET worden verhoogd om een groot en stabiel geheugenvenster (MW) te bereiken voor lees- en schrijfbewerkingen. Zoals getoond in Fig. 10, toont een FeFET met 3,6-nm NEI aan dat de MW toeneemt van 0,2 tot 1,14 V als V GS veegbereik varieert van (0,1 V, − 0,1 V) tot (1 V, − 2 V). Het uithoudingsvermogen van de DC-zwaai van een andere FeFET-geheugeninrichting wordt getoond in figuur 11a, en figuur 11b illustreert de hysteresekarakteristieken als een functie van het aantal DC-zwaaicycli. Stabiele I-V hysteresevenster van ~ 0,65 V wordt gezien.
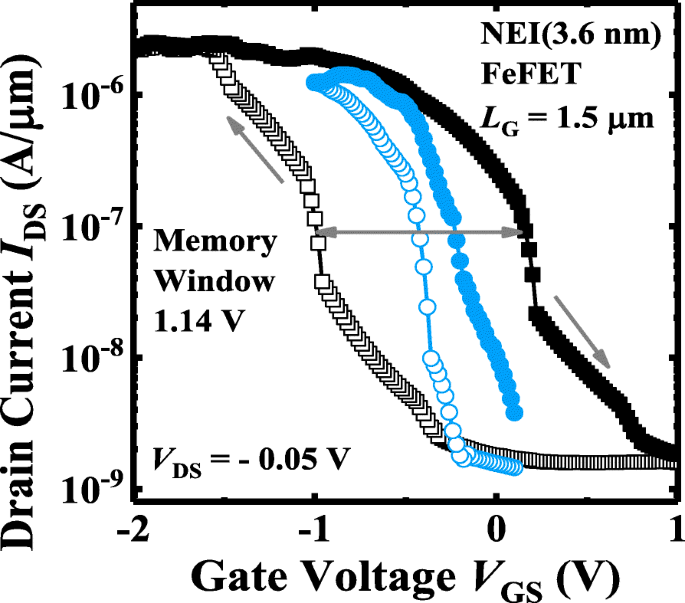
Voor een grote V GS DC-zwaaibereik, een MW van 1,14 V wordt waargenomen voor de NEI (3,6 nm) FeFET
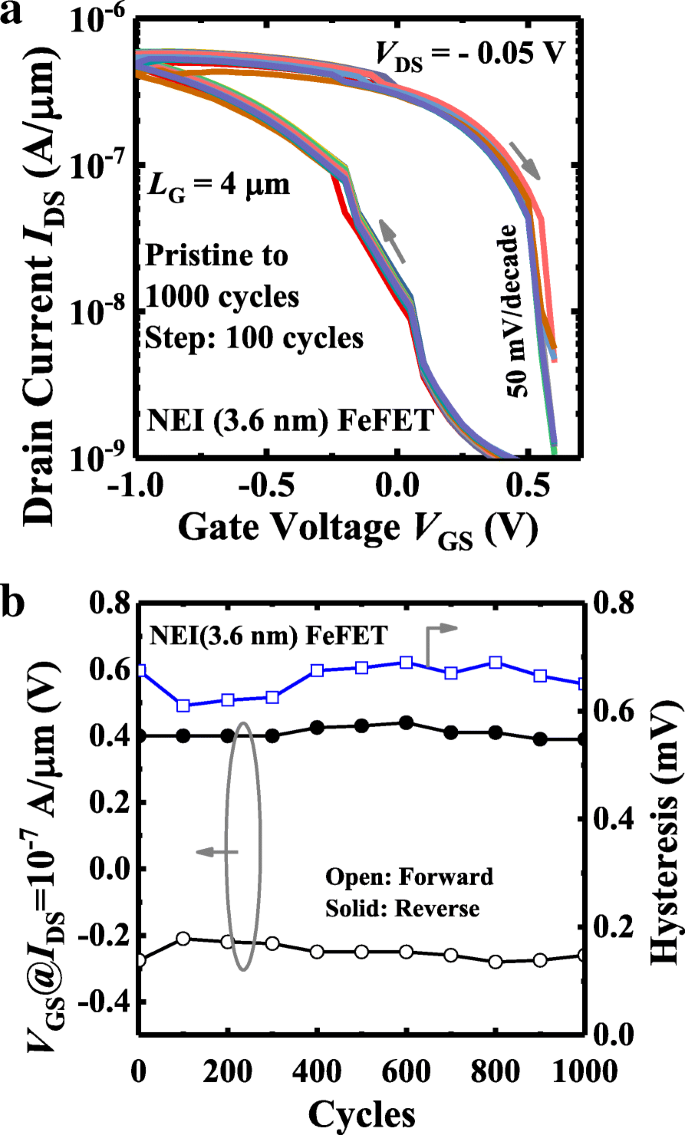
een Gemeten I DS -V GS curven voor NEI (3,6 nm) FeFET, door 1000 DC-veegcycli. b DC sweeping duurzaamheidsmetingen tonen aan dat de NEI FeFET een stabiel MW heeft gedurende 1000 cycli
Figuur 12 vergelijkt het NEI FeFET-geheugenapparaat met gerapporteerde FeFET's, met betrekking tot MW- en FE-laagdikte [8, 21-24]. Opgemerkt moet worden dat het NEI FeFET-apparaat in dit werk een aanzienlijke (>-1 V) MW bereikt met de dunste gerapporteerde FE-dikte van 3,6 nm. We speculeren dat het gemakkelijker is om de stabiele FE-fase in NEI te bereiken met een kleinere dikte, in vergelijking met de gedoteerde HfO2 [28,29,30].
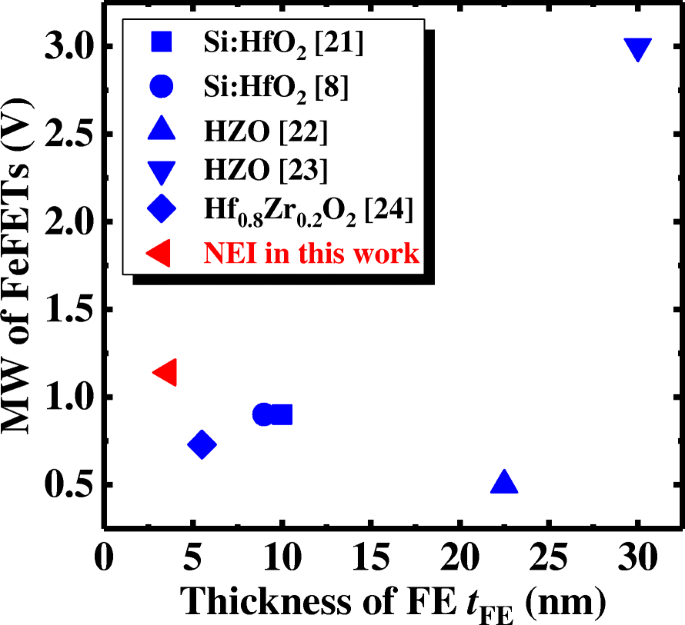
Benchmarking van NEI FeFET-geheugenapparaat tegen gerapporteerde FeFET's, met betrekking tot MW en t FE . Dunste FE wordt bereikt door NEI FeFET-geheugenapparaat
Tot slot, de voordelen van de NEI FeFET geleverd door ZrO2 nanokristallen ingebed in amorfe poortisolator worden besproken. Figuur 13 vergelijkt de NEI-laag met gerapporteerde gedoteerde HfO2 films [2, 3, 21, 25–27], met betrekking tot E c en P r . NEI kan een veel lagere P . behalen r vergeleken met gedoteerde HfO2 voor soortgelijke E c . Onze experimenten hebben aangetoond dat een P r onder 1 μC/cm 2 kan de vereiste MW in de FeFET's leveren. Overmatige polarisatie kan leiden tot grotere depolarisatie, wat resulteert in slechtere retentiekenmerken, wat werd gerapporteerd in [25]. Bovendien kunnen de FE- en DE-eigenschappen van de NEI-laag afzonderlijk worden aangepast:P r wordt versterkt/verkleind door het volume van FE-nanokristallen te vergroten/verlagen, en κ wordt verhoogd door andere elementen in de amorfe matrix op te nemen (bijv.. , LaAlO3 ), om de FeFET-prestaties te optimaliseren.

Benchmarking van NEI-lagen tegen gerapporteerde gedoteerde HfO2 films, met betrekking tot E c en P r . NEI behaalt veel lagere P r vergeleken met gedoteerde HfO2 met behoud van vergelijkbare E c. [2, 3, 21, 25,26,27]
Conclusies
Nieuwe FeFET's met ZrO2 nanokristallen ingebed in een amorf Al2 O3 poort isolerende laag worden gerapporteerd. Fysische analyses geven aan dat minder dan 0,5% Zr in Al2 O3 produceert voldoende ferro-elektriciteit voor NCFET- en NVM-toepassingen. Stabiel NC-effect wordt waargenomen bij verschillende meettemperaturen. Stabiele FeFET-geheugenwerking met een recorddunne (3,6-nm totale dikte) poortisolator wordt gedemonstreerd. Stabiel MW wordt bereikt over 1000 DC-duurzaamheidscycli. Het voorgestelde NEI FeFET-ontwerp biedt een mogelijkheid om de dikte van de FE/DE-poortisolatielaag te verkleinen om compatibel te zijn met FinFET's met zeer kleine vinafstanden.
Afkortingen
- Al2 O3 :
-
Aluminiumoxide
- ALD:
-
Atoomlaagafzetting
- BF2 + :
-
Boorfluoride-ion
- DC:
-
Gelijkstroom
- Ec:
-
Dwingend veld
- FeFET:
-
Ferro-elektrische veldeffecttransistor
- Ge:
-
Germanium
- GeOx :
-
Germaniumoxide
- HF:
-
Fluorwaterstofzuur
- HRTEM:
-
Transmissie-elektronenmicroscoop met hoge resolutie
- Ik DS :
-
Afvoerstroom
- MOSFET's:
-
Metaaloxide-halfgeleider veldeffecttransistoren
- MW:
-
Geheugenvenster
- NC:
-
Negatieve capaciteit
- NDR:
-
Negatieve differentiële weerstand
- NEI:
-
Nanokristal-embedded-isolator
- Ni:
-
Nikkel
- Pr:
-
Resterende polarisatie
- RTA:
-
Snel thermisch gloeien
- SS:
-
Subdrempelzwaai
- TaN:
-
Tantaalnitride
- V GS :
-
Poortspanning
- V TH :
-
Drempelspanning
- ZrO2 :
-
Zirkoniumdioxide
Nanomaterialen
- Sensoren en processors komen samen voor industriële toepassingen
- Multifunctionele gouden nanodeeltjes voor verbeterde diagnostische en therapeutische toepassingen:een overzicht
- Vooruitgang en uitdagingen van fluorescerende nanomaterialen voor synthese en biomedische toepassingen
- Geavanceerde atoomlaagdepositietechnologieën voor micro-LED's en VCSEL's
- Grafeen- en polymeercomposieten voor toepassingen met supercondensatoren:een recensie
- Evaluatie van grafeen/WO3 en grafeen/CeO x-structuren als elektroden voor supercondensatortoepassingen
- Dubbele functies van V/SiOx/AlOy/p++Si-apparaat als selector en geheugen
- Effecten van etsvariaties op Ge/Si-kanaalvorming en apparaatprestaties
- Drives voor industriële koeling en industriële koelingstoepassingen
- Draaibanken voor boor- en draaitoepassingen
- Speciale metalen voor toepassingen in medische hulpmiddelen



