Dubbele functies van V/SiOx/AlOy/p++Si-apparaat als selector en geheugen
Abstract
Deze letter presenteert dubbele functies, waaronder selector en geheugenomschakeling in een V/SiOx /AlOy /p ++ Si-resistief geheugenapparaat door simpelweg de nalevingsstroomlimiet (CCL) te regelen. Unidirectionele drempelomschakeling wordt waargenomen na een positieve vorming met een lage CCL van 1 A. De verschuivingen naar de V-elektrodezijde van de zuurstof vormen de VOx laag, waar de drempelomschakeling kan worden verklaard door het fenomeen metaal-isolatie-overgang. Voor hogere CCL (30 μA) toegepast op het apparaat, wordt een bipolaire geheugenomschakeling verkregen, die wordt toegeschreven aan vorming en breuk van het geleidende filament in SiOy laag. 1,5 nm dik AlOy laag met hoge thermische geleidbaarheid speelt een belangrijke rol bij het verlagen van de uit-stroom voor geheugen- en drempelomschakeling. Door de temperatuurafhankelijkheid wordt een hoge-energiebarrière (0,463 eV) in de LRS bevestigd, die niet-lineariteit kan veroorzaken in een toestand met lage weerstand. Hoe kleiner de CCL, hoe hoger de niet-lineariteit, wat zorgt voor een grotere array-afmeting in de cross-point-array. Het naast elkaar bestaan van geheugen- en drempelomschakeling in overeenstemming met de CCL biedt de flexibiliteit om het apparaat te bedienen voor het beoogde gebruik.
Achtergrond
Resistief willekeurig toegankelijk geheugen (RRAM) is een van de veelbelovende kandidaten voor de niet-vluchtige geheugentechnologie van de volgende generatie vanwege de hoge schakelsnelheid [1, 2], het lage stroomverbruik [3,4,5,6,7 ,8], multilevel-mogelijkheid [9,10,11,12,13,14,15], hoge schaalbaarheid [16,17,18,19,20] en 3D-stapelbaarheid [21,22,23,24,25 ]. Deze eigenschappen zijn met name geschikt voor Storage Class Memory (SCM) dat de prestatiekloof tussen dynamisch willekeurig toegankelijk geheugen (DRAM) als hoofdgeheugen en solid-state-drive (SSD) als opslaggeheugen kan opvullen. Hoewel het RRAM-apparaat de afgelopen jaren veel vooruitgang heeft geboekt [1,2,3,4,5,6,7,8,9,10,11,12,13,14,15,16,17,18,19 ,20,21,22,23,24,25], blijft er echter een groot nadeel:sluipstroom door naburige cellen vindt plaats in een cross-point-array met hoge dichtheid [26]. Het geheugenapparaat met de selectorcomponent moet niet-lineaire stroom-spanning (I-V) karakteristieken bieden om dit probleem op te lossen [26,27,28,29,30,31,32,33,34,35]. Tot nu toe waren verschillende apparaten met niet-lineaire concepten zoals complementaire resistieve schakeling (CRS) [26], tunnelbarrière [27,28,29,30,31,32,33], op Ag gebaseerde drempelschakeling [34], diodetype selector [35, 36], ovonische drempelomschakeling (OTS) [37, 38] en metaal-isolator-overgang (MIT) [39,40,41,42,43] zijn gerapporteerd. VOx aangezien een van de typische MIT-materialen op grote schaal kan worden gebruikt in potentiële toepassingen als optische en elektrische schakelcomponenten [40,41,42]. SiO2 wordt veel gebruikt als passiveringslaag in de halfgeleiderindustrie. Bovendien is Si-rijk SiOx (x < 2) kan worden gebruikt als een weerstandsveranderingslaag in RRAM [44,45,46,47,48,49,50,51,52,53,54,54,55]. SiOx kan de voorkeur hebben boven veel andere materialen in termen van compatibiliteit met CMOS-processen en lage kosten. SiOx Van gebaseerde RRAM-apparaten is gemeld dat ze fungeren als een bemiddelaar van de rol van geleidende bruggen door simpelweg gebruik te maken van elektroden zoals Cu en Ag met een hoge diffusiviteit [44,45,46,47]. In een ander geval wordt geheugenwisseling veroorzaakt door het valentieveranderingseffect binnen de SiOx laag, wat kan worden verklaard door het genereren van zuurstofvacatures of een protonenuitwisselingsmodel [48.49.50.51.52.53.54.55]. Bij de unipolaire schakeling waarbij een ingestelde handeling voorafgaat aan een reset, is deze gevoelig voor de omgevingsatmosfeer. De schakelprestaties in de lucht zijn aanzienlijk verslechterd [48.49.50.51.52.53]. Aan de andere kant vertoont filamentschakeling zonder achterwaartse scaneffecten typische unipolaire en bipolaire schakelingen in verschillende SiOx -gebaseerde RRAM-apparaten [52,53,54].
Hier presenteren we het naast elkaar bestaan van drempelomschakeling en geheugenomschakeling in V/SiOx /AlOy /p ++ Si-apparaat afhankelijk van conformiteitsstroomlimiet (CCL). Het apparaat met siliconen bodemelektrode (BE) heeft verschillende voordelen ten opzichte van de conventionele metalen elektrode. Het RRAM-apparaat met geheugen- of drempelomschakeling is direct verbonden met de bron- of afvoerzijde in een transistor, wat een potentiële toepassing is voor ingebed geheugen en steile hellingsapparaten. Door de serieweerstand van Si BE kan de doorschietstroom worden verminderd. Bovendien kan nano-tip van silicium BE door nat etsen en de aanpassing van de dopingconcentratie in het siliciumoppervlak de schakelprestaties verbeteren. De AlOy laag, een grote bandafstand met een geïsoleerde eigenschap, helpt de bedrijfsstroom te verlagen tijdens drempel- en geheugenschakeling. De SiOx laag fungeert als geheugenschakellaag bij een hoge CCL, terwijl het dient om zuurstof te leveren aan VTE bij lage CCL, wat zorgt voor drempelschakeling.
Methoden
V/SiOx /AlOy /p ++ Si-apparaat werd als volgt gefabriceerd:Ten eerste, BF2 ionen werden geïmplanteerd met een versnellingsenergie van 40 keV en een dosis van 5 × 10 15 cm −2 in een Si-substraat tot zwaar gedoteerd Si BE. De roosterschade werd genezen door het gloeiproces bij 1050 ° C gedurende 10 minuten. Zwaar gedoteerd Si BE had een bladweerstand van 30,4 /□. Vervolgens een 1,5 nm dik AlOy laag werd afgezet door een atomaire laagafzetting (ALD) systeem met behulp van H2 O en Al (CH3 )3 en een 5,5 nm dikke SiOx laag onderging plasma-versterkte chemische dampafzetting (PECVD) door 5% SiH4 te laten reageren /N2 (160 sccm), N2 O (1300 sccm) en N2 (240 sccm) bij 300 °C. Vervolgens werd een 50 nm dikke vanadium (V) topelektrode (TE) met een diameter van 100 m afgezet door DC sputteren van een V-doelwit met Ar-gas (30 sccm). Ten slotte werd een 50 nm dik Al als beschermende laag afgezet door DC-sputteren om verdere oxidatie van VTE te voorkomen. Alle elektrische eigenschappen werden gekarakteriseerd via de DC-spanningszwaai- en pulsmodi met behulp van respectievelijk een Keithley 4200-SCS halfgeleiderparameteranalysator (SPA) en een 4225-PMU ultrasnelle stroom-spanning (I-V) module bij kamertemperatuur. Voor de werking van het apparaat was de TiN BE geaard en werd de Ni TE-bias gecontroleerd.
Resultaten en discussie
Figuur 1a toont de schematische structuur van V/SiOx /AlOy /p ++ Si-apparaat. Drie amorfe V, SiOx , en AlOy lagen en een enkelkristallijne Si-laag worden waargenomen door een transmissie-elektronenmicroscopie (TEM) dwarsdoorsnede-afbeelding zoals weergegeven in figuur 1b. De diktes van de SiOx en AlOy lagen zijn respectievelijk 5,5 en 1,5 nm. Om de compositieverhouding van twee diëlektrische films te bevestigen, werd XPS-analyse uitgevoerd (aanvullend bestand 1). De x waarde van SiOx en de y waarde van AlOy zijn respectievelijk 0,88 en 1,33. Onze SiOx film met PECVD vergeleken met SiO2 afgezet met droge oxidatie wordt afgezet bij een veel lagere temperatuur en heeft veel meer defecten, waardoor ze geschikt zijn voor resistief schakelen bij relatief lagere spanningen. Afbeelding 2a toont typische drempelomschakeling van V/SiOx /AlOy /p ++ Si-apparaat. De initiële schakeling met een positief vormingsproces vereist een hogere spanning dan de daaropvolgende drempelomschakeling, aangezien de diëlektrische lagen aanvankelijk kleinere defecten hebben. Er wordt een CCL van 1 μA op het apparaat toegepast om de vorming van overmatige geleidende filamenten in de SiOx te voorkomen laag. De lekstroom is erg laag (100 pA bij 1 V) vergeleken met eerder gerapporteerde drempelomschakeling van VOx . Dit voordeel wordt toegeschreven aan de Al2 O3 met hogere permittiviteit en thermische geleidbaarheid in vergelijking met de SiO2 . Off-state heeft de isolerende eigenschap omdat de filamenten gemakkelijk kunnen scheuren en er geen resterende filamenten zijn. Een mogelijk mechanisme voor drempelomschakeling is de oxidatie van de VTE uit de zuurstof geleverd door de SiOx laag tijdens het positieve vormingsproces zoals getoond in Fig. 2b. De elektrische eigenschap van VOx tussen VTE en SiOx laag kan veranderen van isolerende staat naar metalen staat, wat een plotselinge verandering in weerstand veroorzaakt. Een lage CCL van 1 μA is niet voldoende om efficiënt geleidende filamenten in de SiOx te veroorzaken film. Daarom is SiOx met isolerende eigenschappen kan een andere oorzaak zijn om de uitstroom te verminderen. Voor een negatief vormingsproces van V/SiOx /AlOy /p ++ Si-apparaat, wordt er geen drempelomschakeling waargenomen (zie Aanvullend bestand 1). Wanneer de negatieve bias wordt toegepast op de VTE, beweegt de beweging van het oxide naar de Si BE, zodat de VTE niet langer kan deelnemen aan de drempelomschakeling als VOx . Inzet van Fig. 2a toont de drempelspanning (Vth ) en houd spanning vast (Vhoud ) tijdens de 100 cycli. De Vde waarbij de stroom sterk toeneemt met een bijna oneindige helling tussen 1,08 en 1,82 V, en Vhold op welk punt de stroomterugkeer naar een toestand met hoge weerstand tussen 0,12 en 0,54 V ligt. Afbeelding 2c toont de I-V-karakteristieken in de aan-stroom bij verschillende temperaturen. Bij 25 ° C en 55 ° C vertonen ze bijna dezelfde drempelomschakeling, maar de IV-curve bij een hogere temperatuur van 85 ° C verliest de eigenschap van de drempelomschakeling. Het is algemeen bekend dat VOx verliest zijn MIT bij hoge temperaturen. Dit resultaat is dus nog een bewijs dat VOx is de belangrijkste oorzaak van de drempelomschakeling. Afbeelding 2d toont de transiënte kenmerken voor drempelomschakeling. De puls met de amplitude van 1 V bewaakt de leesstroom voor en na de schrijfpuls met een breedte van 1 μs. De hoge stroom werd gecontroleerd terwijl de puls met hoge amplitude op het apparaat werd toegepast, en vervolgens de V/SiOx /AlOy /p ++ Si-apparaat schakelde de stroom uit onmiddellijk nadat de schrijfpuls was verwijderd. De hierboven geanalyseerde selector-eigenschappen kunnen worden gebruikt in combinatie met de werking van geheugenelementen lager dan 1 μA [55, 56].
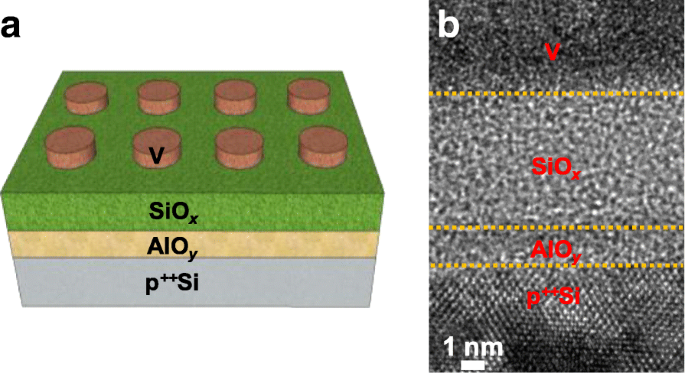
Apparaatconfiguratie van V/SiOx /AlOy /p ++ Si. een Schematische tekening en b TEM-afbeelding

Unidirectionele drempelomschakeling van V/SiOx /AlOy /p ++ Si wanneer een positieve vorming met CCL van 1 A wordt toegepast. een Typische IV-curven. b Schematische tekening van het vormingsproces. c IV-kenmerken door temperatuurafhankelijkheid. d Voorbijgaande kenmerken
Afbeelding 3a toont de bipolaire resistieve schakeling van V/SiOx /AlOy /p ++ Si-apparaat na positieve vorming met CCL van 100 μA. Vervolgens wordt het resetproces met een snelle toename van de weerstand uitgevoerd door de negatieve spanning te vegen en wordt het apparaat overgeschakeld naar een hoge-weerstandsstatus (HRS). Het instelproces met een snelle afname van de weerstand vindt dan plaats bij een positieve voorspanning, waardoor het apparaat terugkeert naar een toestand met lage weerstand (LRS). Om de eigenschappen van de geleidende gloeidraad te begrijpen, observeren we de genormaliseerde geleidbaarheid en de temperatuurafhankelijkheid. De geleiding in de LRS is een belangrijke richtlijn om indirect de eigenschappen van de geleidende gloeidraad te informeren. Afbeelding 3b toont de genormaliseerde geleiding (GN ) die wordt gedefinieerd als de dynamische geleiding (Gd ) delen door statische geleiding (G0 ) voor I–V-curven van V/SiOx /AlOy /p ++ Si-apparaat in de LRS met verschillende temperaturen. Ongeacht de temperatuur, de GN waarde convergeert naar 1 wanneer de spanning nul is. Hierdoor kunnen we het bekende geleidingsmechanisme uitsluiten, zoals Schottky-emissie, Fowler-Nordheim-tunneling en de wet van het kind (I~V 2 ) in ruimtelading-beperkte stroom (SCLC). Metaalohmse geleiding kan ook worden uitgesloten gezien de temperatuurafhankelijkheid, zoals weergegeven in figuur 3c. De afname van de weerstand bij toenemende temperatuur suggereert dat het geleidende filament een halfgeleidende eigenschap heeft. We kunnen dus de penetratie van V in de SiOx . uitsluiten laag voor het geleidende hoofdfilament van V/SiOx /AlOy /p ++ Si-apparaat in LRS. Daarom is de bipolaire geheugenwerking van de V/SiOx /AlOy /p ++ Si-apparaat wordt gedomineerd door intrinsiek schakelen van SiOx . Er wordt ook bevestigd dat de positieve en negatieve stromen niet zo veel verschillen, wat suggereert dat het in plaats van een interface-type zoals Schottky-emissie wordt gedomineerd door bulkgeleiding. Rekening houdend met de bovengenoemde genormaliseerde geleiding, zijn er twee mogelijke bulkdominante geleidingsmechanismen. De eerste is hoppinggeleiding volgens de formule:
$$ J={qnav}_o{e}^{-q{\o}_T/ kT}{e}^{qaV/2 dkT} $$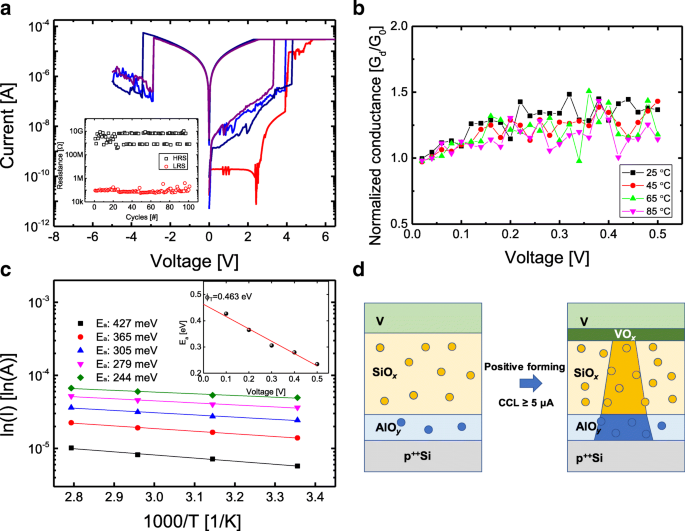
Geheugenwisseling van V/SiOx /AlOy /p ++ Si wanneer een positieve vorming met CCL van 30 A wordt toegepast. een Typische IV-curven. b Genormaliseerde geleiding. c In (I) versus 1000/T. d Schematische tekening van het vormproces
waar q , n , een , ø T , v o , en d zijn respectievelijk de elektrische lading, de concentratie van de ruimtelading, het gemiddelde van de sprongafstand, de hoogte van de elektronenbarrière voor het springen, de intrinsieke trillingsfrequentie en de dikte van de diëlektrische film. De ø T berekend uit de helling van een lineaire grafiek van ln (I) versus 1000/T is 0,463 eV zoals weergegeven in figuur 3c. Een waarde berekend op basis van de relatie tussen Ea en V is 5,17 nm, wat aangeeft dat de geleidende gloeidraad is gevormd in de SiOx is niet sterk en ligt dicht bij de HRS-toestand. Het andere geleidingsmechanisme, de Poole-Frenkel (PF)-emissie, werd behandeld in aanvullend bestand 1. Op basis van de bovenstaande resultaten, het geleidende filamentmodel in de geheugenbewerking van V/SiOx /AlOy /p ++ Si-apparaat is afgebeeld in figuur 3d. Bij het positieve vormingsproces verliep het oxidatieproces aan de VTE-zijde, maar vanwege de hoge CCL kan een geleidend filament worden gevormd in de SiOx en AlOy door de beweging van de zuurstofvacatures. Tijdens het resetproces induceert het elektrische veld tegenover de vorming en zetting zuurstof en recombinatie met de zuurstofvacature, wat resulteert in de breuk van de geleidende gloeidraad. Opgemerkt wordt dat de selector- en geheugenbewerkingen in dezelfde cel worden waargenomen. Geheugenbewerking is mogelijk nadat de drempelbewerking heeft plaatsgevonden en vervolgens is de schakelaar volledig uitgeschakeld. De omgekeerde richting is echter niet mogelijk omdat de reset-omschakeling van de geheugenbewerking niet volledig is uitgeschakeld.
Afbeelding 4a toont genormaliseerde I–V-curven in de LRS van V/SiOx /AlOy /p ++ Si-apparaat bij laagspanningsregime (0~1 V) voor verschillende CCL-omstandigheden (5 A, 30 μA en 1 mA). Hier wordt de genormaliseerde I-V-curve gedefinieerd als de stroom bij elke spanning gedeeld door de stroom bij 1 V. Aangezien de niveaus van de LRS-stroom, afhankelijk van de CCL, variëren, stellen we de stroomwaarde in op 1 V om gemakkelijk de niet-lineariteit. Er kan worden waargenomen dat naarmate de CCL afneemt, de stroom wordt onderdrukt bij een lager spanningsregime. Om een meer kwantitatieve relatie af te leiden, wordt niet-lineariteit gedefinieerd als de verhouding van de stroom bij VREAD tot dat op de helft van VLEES . Afbeelding 4b toont de leesstroom bij 1 V en niet-lineariteit als functie van CCL voor V/SiOx /AlOy /p ++ Si-apparaat. De afname in leesstroom als gevolg van CCL-reductie suggereert dat de geleidende gloeidraad fijner wordt en dat vervolgens de niet-lineariteit toeneemt. De intrinsieke siliciumoxidefilm vertoont zelfs in een enkele laag een hoge niet-lineariteit. De intrinsieke niet-lineaire eigenschap is te wijten aan de bulkaard van het siliciumoxide in plaats van aan het grensvlak van het silicium. Hoe kleiner de CCL, hoe minder degradatie wordt gegenereerd in de SiOx , zodat de verlaging van het trapenergieniveau in de LRS in vergelijking met die in de HRS kan worden geminimaliseerd. Daarom kan de hogere energiebarrière de niet-lineariteit in de LRS-toestand maximaliseren wanneer een lagere CCL op het apparaat wordt toegepast. Evenzo is de geleiding beschreven door de PF-emissie in de TaOx /TiOy stapel zorgt voor een hoge niet-lineariteit [57]. Een andere mogelijkheid is dat omdat de diëlektrische constante van het oxide kleiner is, er meer passages naar de oxidefilm worden gemaakt vanwege de concentratie van het veld. Dit kan leiden tot een verlaging van het valenergieniveau van de oxidelaag, die naar verwachting zal dienen als een tunnelbarrière voor Al2 O3 . Om de leesmarge (∆V) te verkrijgen in n × n kruispuntarray gebruiken we het vereenvoudigde equivalente circuit zoals weergegeven in figuur 4c. In het ergste geval worden de aangrenzende cellen ingesteld op de LRS en de belastingsweerstand (RL ) aan de LRS-weerstand. De ∆V werd berekend uit het verschil tussen VOUT bij LRS en VOUT bij HRS. Afbeelding 4d toont de ∆V als functie van het aantal woordregels (n ) voor V/SiOx /AlOy /p ++ Si-apparaat. Hoe kleiner de CCL, hoe hoger de AV omdat de niet-lineariteit toeneemt. Wanneer 10% leesmarge is beveiligd, kan de array worden uitgebreid tot ongeveer meer dan 10 × 10 voor CCL van 5 μA en tot 5 × 5 voor CCL van 1 mA. De arraygrootte om de sluipstroom te weerstaan is niet voldoende, maar het zal helpen de arraygrootte uit te breiden wanneer het apparaat met selectorfunctie is aangesloten in een V/SiOx /AlOy /p ++ Si-apparaat. Vergeleken met 0,5 V uitlezing in alle CCL's, heeft deze een hogere niet-lineariteit bij uitlezing bij 1 V. Hoewel lage VREAD leidt tot een laag statisch vermogen bij het lezen, wordt de waarde van niet-lineariteit kleiner, wat te wijten is aan het feit dat het elektrische veld minder is op de SiOx /AlOy laag in kleinere VLEES .

Niet-lineaire kenmerken van V/SiOx /AlOy /p ++ Si voor geheugenwisseling. een IV-curven met verschillende CCL's. b Lees huidige en niet-lineariteit als functies van CCL. c Equivalente circuits van kruispuntarray. d Leesmarge als functie van woordregelnummer voor verschillende CCL's en leesspanning
Conclusies
In dit werk is een V/SiOx /AlOy /p ++ Si-apparaat met zowel een selector als een geheugenfunctie door eenvoudig CCL te besturen, wordt onderzocht. Wanneer een CCL van 1 A of minder wordt toegepast, wordt unidirectionele drempelomschakeling waargenomen voor selectortoepassing. Positieve vorming oxideert de V-elektrode en het MIT-fenomeen van VOx drempeloverschakeling kan veroorzaken. De AlOy laag kan een hoge selectiviteit van 10 4 . bereiken door de uitstroom te verlagen. Aan de andere kant, wanneer een CCL van 5 μA of meer wordt toegepast, wordt geheugenwisseling waargenomen omdat er effectieve geleidende filamenten worden gevormd op de SiOx laag. Hoe lager de CCL, hoe groter de niet-lineariteit, wat helpt om de grootte van de cross-point-array te vergroten.
Afkortingen
- ALD:
-
Atoomlaagafzetting
- BE:
-
Onderste elektrode
- CCL:
-
Conformiteitsstroomlimiet
- CRS:
-
Complementaire resistieve schakeling
- DRAM:
-
Dynamisch willekeurig toegankelijk geheugen
- HRS:
-
Staat met hoge weerstand
- I–V:
-
Stroom–spanning
- LRS:
-
Staat met lage weerstand
- MIT:
-
Metaal-isolator-overgang
- OTS:
-
Ovonische drempelomschakeling
- PECVD:
-
Plasma-versterkte chemische dampafzetting
- P-F:
-
Poole-Frenkel
- RRAM:
-
Resistief willekeurig toegankelijk geheugen
- SCLC:
-
Ruimte-lading-beperkte stroom
- SCM:
-
Opslagklasse geheugen
- SPA:
-
Halfgeleiderparameteranalysator
- SSD:
-
Solid State-schijf
- TE:
-
Bovenste elektrode
- TEM:
-
Transmissie-elektronenmicroscopie
- V:
-
Vanadium
Nanomaterialen
- termen en concepten voor digitaal geheugen
- Wat is een besturingssysteem en zijn componenten
- C++ Geheugenbeheer:nieuw en verwijderen
- Partitiegeheugen – introductie en basisservices
- Processors pakken de convergentie van IoT en AI aan
- Dubbele niet-lineariteitsregeling van modus- en dispersie-eigenschappen in grafeen-diëlektrische plasmonische golfgeleider
- Een collectief onderzoek naar modellering en simulatie van resistief willekeurig toegankelijk geheugen
- Alkalimetaal-geadsorbeerde g-GaN-monolaag:ultralage werkfuncties en optische eigenschappen
- IoT-productie:definitie, functies en voorbeelden
- Slotter machine onderdelen en hun functies
- Soorten differentieel en hun functies



