Hoogwaardige a-InGaZnO dunnefilmtransistoren met extreem laag thermisch budget door gebruik te maken van een waterstofrijk Al2O3-diëlektricum
Abstract
Elektrische kenmerken van amorfe In-Ga-Zn-O (a-IGZO) dunne-filmtransistoren (TFT's) worden vergeleken met behulp van O2 plasma-versterkte atomaire laagafzetting Al2 O3 diëlektrica bij verschillende temperaturen. Krachtige a-IGZO TFT's worden met succes gedemonstreerd met een Al2 O3 diëlektricum afgezet bij kamertemperatuur, met een hoge veldeffectmobiliteit van 19,5 cm 2 V − 1 s − 1 , een kleine schommeling onder de drempel van 160 mV/dec, een lage drempelspanning van 0,1 V, een grote aan/uit stroomverhouding van 4,5 × 10 8 en superieure negatieve en positieve gate-biasstabiliteiten. Dit wordt toegeschreven aan het waterstofrijke Al2 O3 diëlektricum afgezet bij kamertemperatuur in vergelijking met hogere depositietemperaturen, waardoor de grensvlaktoestanden van a-IGZO/Al2 efficiënt worden gepassiveerd O3 en de zuurstofvacatures en verbetering van de geleidbaarheid van het a-IGZO-kanaal door extra elektronen te genereren vanwege verbeterde waterstofdoping tijdens sputteren van IGZO. Zo'n extreem laag thermisch budget voor high-performance a-IGZO TFT's is zeer aantrekkelijk voor flexibele elektronische toepassingen.
Achtergrond
Amorfe, op In-Ga-Zn-O (a-IGZO) gebaseerde dunne-filmtransistoren (TFT's) hebben de afgelopen tien jaar veel aandacht getrokken vanwege hun hoge mobiliteit, goede uniformiteit, hoge transparantie van zichtbaar licht en lage procestemperatuur [1, 2,3]. Deze verdiensten maken het een veelbelovende kandidaat voor de toepassing van elektronica van de volgende generatie, zoals een transparant display, flexibele apparaten of draagbare elektronica. In het bijzonder voor de toepassingen van flexibele elektronica worden TFT's in het algemeen gefabriceerd op laag thermisch stabiele polymeersubstraten. Het is dus noodzakelijk om het thermische budget van a-IGZO TFT-fabricage te verminderen. Voor dit doel hebben veel onderzoekers zich gericht op a-IGZO TFT's met op kamertemperatuur gefabriceerde poortisolatoren, zoals sputteren [4,5,6], oplossingsproces [7,8,9], e-beam verdamping [10], en anodisatie [11]. Deze diëlektrische films hebben echter vaak last van een hoge dichtheid van vallen en sterke diëlektrische/a-IGZO-grensvlakverstrooiing, wat resulteert in een beperkte mobiliteit van het veldeffect, een grote subthreshold-zwaai en een kleine aan/uit-stroomverhouding [4,5,6 ,7,8,9,10,11].
Aan de andere kant is atomic layer deposition (ALD) een veelbelovende techniek, die kan zorgen voor films van hoge kwaliteit, nauwkeurige controle van de filmdikte, goede uniformiteit over een groot gebied en lage procestemperatuur [12,13,14]. Zheng et al. [15] meldde dat de a-IGZO TFT met ALD SiO2 diëlektricum vertoonde uitstekende elektrische prestaties zonder de noodzaak van nagloeien. Voor de ALD van SiO2 . is echter een hoge substraattemperatuur van 250 °C vereist films [15], wat hoger is dan de glasovergangstemperaturen van de meeste flexibele kunststofsubstraten. Interessant is dat wordt gemeld dat ALD van Al2 O3 films kunnen zelfs bij kamertemperatuur (RT) worden gerealiseerd [16, 17]; ondertussen, de Al2 O3 film afgezet bij kamertemperatuur bevat een grote hoeveelheid waterstof (H) onzuiverheden [17]. Voor zover ons bekend, is het bovengenoemde H-rijke Al2 O3 film is nooit gebruikt als poortisolator in a-IGZO TFT. Daarom is het wenselijk om de a-IGZO TFT te verkennen met een RT ALD Al2 O3 poortisolator.
In deze brief werd een hoogwaardige a-IGZO TFT met succes vervaardigd met een op kamertemperatuur gedeponeerd Al2 O3 poort diëlektricum. Door de kenmerken van de a-IGZO TFT's te vergelijken met verschillende Al2 O3 poortisolatoren afgezet bij verschillende temperaturen, werd het onderliggende mechanisme aangepakt.
Methoden
Sterk gedoteerde p-type siliciumwafels (<-0,0015 Ω cm) werden gereinigd door standaard RCA-processen en dienden als poortelektroden. Veertig nanometer Al2 O3 films werden gedeponeerd in een commercieel ALD-systeem (Picsun Ltd.) met behulp van trimethylaluminium (TMA) en O2 plasma als voorloper en reactant, respectievelijk. Eén groeicyclus bestond uit 0,1 s TMA-puls, 10 s N2 zuiveren, 8 s O2 plasmapuls en 10 s N2 zuiveren. De TMA werd op 18°C gehouden voor een stabiele dampdruk en dosis, en de O2 gasstroomsnelheid werd vastgesteld op 150 sccm met een plasmageneratorvermogen van 2500 W. Vervolgens werden 40 nm a-IGZO-films afgezet door RF-sputteren met behulp van een IGZO-keramisch doelwit met een atomaire verhouding van In:Ga:Zn:O = 1 :1:1:4. Tijdens sputteren, werkdruk en Ar en O2 gasstroomsnelheden werden vastgesteld op respectievelijk 0,88 Pa en 48 en 2 sccm. Het actieve gebied werd gevormd door fotolithografie en nat etsen. Daarna werden source/drain-elektroden van 30-nm Ti/70-nm Au-dubbellagen geprepareerd door elektronenbundelverdamping en een lift-off-methode. Op deze apparaten werden geen verdere gloeiprocessen toegepast.
De elektrische eigenschappen van a-IGZO TFT's werden gekarakteriseerd met behulp van een halfgeleiderapparaatanalysator (Agilent Tech B1500A) in een donkere doos bij kamertemperatuur. De stabiliteit van het apparaat werd gemeten onder respectievelijk positieve en negatieve gate-biasspanningen. De diepteprofielen van elementen en chemische samenstelling werden gemeten met respectievelijk secundaire ionenmassaspectrometrie (SIMS) en röntgenfoto-elektronspectroscopie (XPS).
Resultaten en discussie
Figuur 1a vergelijkt de diëlektrische constanten van de Al2 O3 films afgezet bij verschillende temperaturen als functie van de frequentie (d.w.z. van 10 Hz tot 10 5 Hz). Naarmate de depositietemperatuur stijgt van 100 tot 150 °C, vertoont de film een geleidelijke afname van de diëlektrische constante. Een vergelijkbare trend werd ook gerapporteerd in eerdere literatuur voor de depositietemperatuur die veranderde van RT naar 150 °C [18, 19]. Dit komt omdat de RT Al2 O3 film bevat de hoogste concentratie waterstof (H) in de vorm van OH-groepen. De corresponderende diëlektrische constante wordt dus verbeterd door een rotatie van meer OH-groepen in een elektrisch veld [20]. In termen van de meetfrequentie van 10 Hz, de geëxtraheerde diëlektrische constanten voor de RT, 100 °C en 150 °C Al2 O3 films zijn gelijk aan respectievelijk 8,6, 7,9 en 7,4, die worden gebruikt voor de extractie van de veldeffectmobiliteit (μ FE ) en grensvlakdichtheid (D het ) van het gefabriceerde TFT-apparaat. Afbeelding 1b toont de lekstroomkenmerken van verschillende Al2 O3 films. Het blijkt dat de RT Al2 O3 film vertoont een kleine lekstroomdichtheid van 2,38 × 10 − 8 A/cm 2 bij 2 MV/cm en een elektrisch doorslagveld van 5,3 MV/cm. Bovendien neemt het elektrische doorslagveld geleidelijk toe met toenemende depositietemperatuur van 100 tot 150 °C.
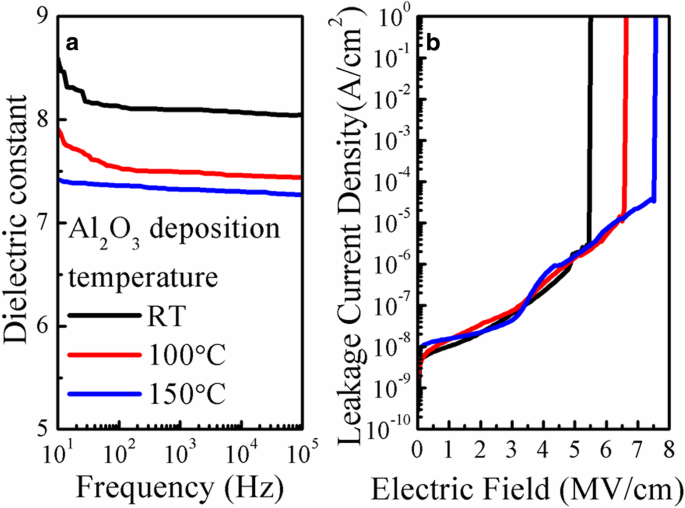
Elektrische eigenschappen van Al2 O3 films afgezet bij verschillende temperaturen. een Diëlektrische constante versus frequentie. b Lekstroomdichtheid versus elektrisch veld
Afbeelding 2 toont de typische overdrachtscurves van de a-IGZO TFT's met verschillende Al2 O3 poort isolatoren. De RT Al2 O3 TFT vertoont de beste prestaties, zoals hoge μ FE van 19,5 cm 2 V − 1 s − 1 , een kleine subthreshold swing (SS) van 160 mV/dec, een kleine drempelspanning (V T ) van 0,1 V en een grote aan/uit stroomverhouding (I aan/uit ) van 4,5 × 10 8 . De a-IGZO TFT's met Al2 O3 gate-isolatoren die bij zowel 100 als 150 °C zijn gedeponeerd, vertonen een veel slechtere prestatie, d.w.z. verminderde aan-stromen (10 − 7 en 3 × 10 − 9 A) en gedegradeerde SS. De D het op de interface van Al2 O3 /a-IGZO kan worden berekend op basis van de volgende vergelijking [21]:
$$ {D}_{\mathrm{it}}=\left(\frac{\mathrm{SS}\times \lg e}{kT/q}-1\right)\frac{C_{ox}}{ q^2} $$ (1)waar e , k , T , en q vertegenwoordigen respectievelijk het Euler-getal, de Boltzmann-constante, de absolute temperatuur en de eenheidselektronenlading. C os is de gate diëlektrische capaciteit per oppervlakte-eenheid. Voor de RT Al2 O3 TFT, de D het is gelijk aan 1,1 × 10 12 eV − 1 cm − 2 , wat meer dan een of twee keer lager is dan die voor de TFT's met de Al2 O3 poortisolatoren gedeponeerd bij 100 en 150 °C.

Transfercurves van de a-IGZO TFT's met ALD Al2 O3 poortisolatoren afgezet bij verschillende temperaturen samen met de geëxtraheerde apparaatparameters
De gate-biasstabiliteiten van de apparaten werden verder gemeten door negatieve en positieve spanningen aan te leggen. Afbeelding 3 toont de V T verschuiving als een functie van bias-stresstijd voor verschillende TFT's. In termen van negatieve gate bias stress (NGBS), is de RT Al2 O3 TFT vertoont een verwaarloosbare V T verschuiving van − 0.04 V na 40 min te zijn gestrest bij − 10 V. Echter, hogere temperatuur Al2 O3 poortisolatoren genereren grotere V T verschuift speciaal voor 150°C. Zo'n hoge NGBS-stabiliteit voor RT Al2 O3 moet worden toegeschreven aan een lage concentratie van zuurstofvacatures (V O ) in het a-IGZO-kanaal [22]. Met betrekking tot positieve gate bias stress (PGBS), de RT Al2 O3 TFT toont een V T verschuiving van 1,47 V, wat veel kleiner is dan die (8,8 V en 12,1 V) voor de 100 en 150 °C Al2 O3 TFT's. Bovendien werd de invloed van opslagtijd op de prestaties van het apparaat onderzocht, zoals weergegeven in Fig. 4. Hoewel er geen passiveringslaag is bedekt op het achterste kanaal, behoudt het apparaat nog steeds uitstekende prestaties nadat het in een kast is bewaard (20% RV) gedurende 60 dagen bij 30 °C; ondertussen zijn er geen significante variaties in μ FE en SS worden waargenomen. Dit geeft de RT Al2 . aan O3 TFT's zonder passiveringslaag hebben een goede opslagtijdafhankelijke stabiliteit in de huidige omgeving.

V T verschuiving als functie van de spanningstijd van de bias onder NGBS = − 10 V en PGBS = 10 V voor de TFT's met Al2 O3 isolatoren afgezet bij verschillende temperaturen

Tijdsafhankelijke stabiliteit van RT Al2 O3 TFT na bewaring in een kast (20% RV) bij 30 °C. een Overdracht bochten. b Mobiliteit en swing onder de drempel
Tabel 1 vergelijkt de prestaties van onze RT Al2 O3 TFT met andere rapporten. Het is gebleken dat ons apparaat een nul-nabij V . vertoont T , kleinere SS en grotere I aan/uit bij vergelijkbare mobiliteit [4, 23]. Hoewel het gebruik van een Ta2 O5 poortisolator kan een hogere mobiliteit van 61,5 cm verkrijgen 2 V − 1 s − 1 , zowel SS als I aan/uit opmerkelijk achteruitgaan [10]. Kortom, onze RT Al2 O3 TFT heeft een superieure uitgebreide prestatie in vergelijking met de 100 en 150 °C Al2 O3 TFT's. Aangezien alle verwerkingsstappen identiek zijn, behalve de depositiestap van Al2 O3 , zouden dergelijke significante verschillen in elektrische prestaties afkomstig moeten zijn van de Al2 O3 poortisolatoren.
Om het onderliggende mechanisme te begrijpen, zijn de diepteprofielen van de elementen in de a-IGZO/Al2 O3 gestapelde films werden geanalyseerd door SMIS. Figuur 5a toont de afhankelijkheid van de H-concentratie van de diepte in de stapels van IGZO/Al2 O3 , waarbij de Al2 O3 films werden respectievelijk bij kamertemperatuur en 150°C gedeponeerd. Ter vergelijking werd ook een IGZO-film die op een kaal Si-substraat was afgezet, geanalyseerd. De IGZO-film afgezet op kale Si bevat een H-concentratie van ~ 3 × 10 21 cm − 3 , die afkomstig is van het restgas in het sputtersysteem en H2 . heeft geabsorbeerd /H2 O-moleculen op het Si-oppervlak. Beide IGZO-films gedeponeerd op de Al2 O3 films bevatten hogere H-concentraties dan die op het kale Si-substraat. Dit geeft aan dat de verhoogde H-concentraties afkomstig moeten zijn van het vrijkomen van H-onzuiverheden in het onderliggende Al2 O3 films tijdens het sputteren van IGZO. Bovendien wordt waargenomen dat de H-concentratie in de IGZO-film bovenop de RT Al2 O3 film is hoger dan die op de 150 ° C in het grensvlak-nabije gebied, wat een efficiëntere passivering van grensvlaktoestanden kan bieden. Dit verbetert dus de SS- en PGBS-stabiliteit van de RT Al2 O3 TFT door het verminderen van interfacial carrier trapping. Bovendien zijn de O 1s XPS-spectra van de a-IGZO-films nabij het grensvlak van IGZO/Al2 O3 werden geanalyseerd, zoals weergegeven in figuur 5b. De gemonteerde pieken bevinden zich op 530,2 ± 0.1 eV, 530,9 ± 0.1 eV en 531,6 ± 0.1 eV, wat overeenkomt met O 2− ionen gebonden met metaal (O1), V O (O2) en OH-groepen (O3), respectievelijk [13, 24]. Het percentage O2 is 26,3% in de a-IGZO-laag bovenop het kale Si; het neemt echter af tot 12,3% en 6,8% voor de 150 °C en RT Al2 O3 onderliggende films, respectievelijk. Dit geeft aan dat meer V O in het IGZO-kanaal kan effectief worden gepassiveerd door extra H-onzuiverheden afkomstig van het onderliggende Al2 O3 films, speciaal voor de RT Al2 O3 film met een hogere H-concentratie. Het is gemeld dat wanneer V O en H beide aanwezig zijn in de a-IGZO-film, kunnen ze combineren om een stabiele toestand te vormen waarin H wordt opgesloten bij V O (V O H), en de resulterende V O H is een ondiepe donor [25,26,27]. Dus verbeterde H-doping in het IGZO-kanaal bovenop de RT Al2 O3 verbetert de kanaalgeleiding door extra elektronen te leveren. Verder is de kleine V T shift onder de NGBS voor de RT Al2 O3 TFT kan ook worden toegeschreven aan de effectieve H-passivering van V O [28]. Zoals gerapporteerd in de literatuur, komt de instabiliteit van TFT onder NGBS voort uit ionisatie van neutrale V O (V O → V O 2+ +2e − ) [17, 29]. Bovendien is het O3-percentage van de a-IGZO-film op de RT Al2 O3 is 6,9%, wat hoger is dan die op de 150 °C Al2 O3 (5,3%) en het kale Si (4,6%) respectievelijk. De OH-groep kan afkomstig zijn van de reactie O 2− + H → OH − + e − tijdens depositie van IGZO-films [30]. Dus de verbeterde H-doping in het IGZO-kanaal bovenop de RT Al2 O3 film genereert meer OH-groepen en draagt ook bij aan het verbeteren van de kanaalgeleiding.

een SIMS-profielen van waterstofconcentratie in Al2 O3 gedeponeerd bij kamertemperatuur en 150°C. b Hoge resolutie O1s XPS-spectra van het IGZO-kanaal gedeponeerd op RT Al2 O3 , 150 °C Al2 O3 , en blote Si
Conclusies
Een hoogwaardige a-IGZO TFT werd met succes gefabriceerd onder het extreem lage thermische budget van RT met behulp van een H-rijke Al2 O3 poortdiëlektricum voorbereid door O2 plasma-versterkte ALD. Dit wordt toegeschreven aan het feit dat de Al2 O3 diëlektricum afgezet bij kamertemperatuur bevat meer waterstof onzuiverheden dan die afgezet bij hogere temperaturen. Dus de vrijgekomen H-onzuiverheden tijdens het sputteren van IGZO genereerden meer elektronen en passeerden efficiënt de grensvlaktoestanden van a-IGZO/Al2 O3 en de V O in het a-IGZO-kanaal.
Afkortingen
- a-IGZO:
-
Amorf In-Ga-Zn-O
- ALD:
-
Atoomlaagafzetting
- D het :
-
Dichtheid grensvlak
- H:
-
Waterstof
- Ik aan/uit :
-
Aan/uit stroomverhouding
- NGBS:
-
Negatieve gate bias spanning
- PGBS:
-
Positieve gate bias spanning
- RT:
-
Kamertemperatuur
- SIMS:
-
Secundaire ionenmassaspectrometrie
- SS:
-
Subdrempelzwaai
- TFT:
-
Dunne-filmtransistor
- V O :
-
Zuurstoftekort
- V O H:
-
Waterstof gevangen bij zuurstoftekort
- V T :
-
Drempelspanning
- XPS:
-
Röntgenfoto-elektronenspectroscopie
- μ FE :
-
Mobiliteit met veldeffect
Nanomaterialen
- 3D-printarmaturen met hoogwaardige materialen
- Epoxyhars gebruiken met artwork
- Volledige Terahertz-polarisatiecontrole met verbrede bandbreedte via diëlektrische metasurfaces
- Multi-Layer SnSe Nanoflake Field-Effect Transistors met Au Ohmic-contacten met lage weerstand
- Geweldige verbetering van de thermische geleidbaarheid van siliconencomposiet met ultralange koperen nanodraden
- Vervaardiging van besteld nanopatroon met behulp van ABC Triblock-copolymeer met zout in tolueen
- UV-uitgeharde inkjet-geprinte zilveren poortelektrode met lage elektrische weerstand
- RGO en driedimensionale grafeennetwerken hebben TIM's samen gemodificeerd met hoge prestaties
- Atomic-Layer-Deposition van indiumoxide nanofilms voor dunnefilmtransistors
- Verbetering van de prestaties van a-IGZO TFT-apparaten met behulp van een schoon interfaceproces via Etch-Stopper nanolagen
- Voorbereiding en karakterisering van in oplossing verwerkte nanokristallijne p-type CuAlO2 dunne-filmtransistoren



