De optische eigenschappen van GaAsSb-capped InAs Quantum Dots wijzigen door middel van InAlAs-tussenlagen
Abstract
In dit werk onderzoeken we de optische eigenschappen van InAs-kwantumdots (QD's) afgedekt met composiet In0.15 Al0,85 As/GaAs0,85 Sb0,15 rekverminderende lagen (SRL's) door middel van hoge resolutie röntgendiffractie (HRXRD) en fotoluminescentie (PL) spectroscopie bij 77 K. Thin In0,15 Al0,85 Als lagen met dikte t = 20 Å, 40 Å en 60 Å werden ingevoegd tussen de QD's en een 60-Å-dikke GaAs0,85 Sb0,15 laag. De type II-emissies waargenomen voor GaAs0,85 Sb0,15 -capped InAs QD's werden onderdrukt door het invoegen van de In0.15 Al0,85 Als tussenlaag. Bovendien was de emissiegolflengte blauwverschoven voor t = 20 Å en roodverschuiving voor t ≥ 40 Å als gevolg van respectievelijk het verhoogde opsluitingspotentieel en de verhoogde belasting. De scheiding van energie in grondtoestand en aangeslagen toestand wordt verhoogd tot 106 meV voor t = 60 Å vergeleken met 64 meV voor de QD's met alleen GaAsSb SRL. Bovendien kan het gebruik van de In0.15 Al0,85 Omdat lagen de QD-spectrale lijnbreedte aanzienlijk verkleinen van 52 tot 35 meV voor de monsters met 40 en 60 Å dikke In0,15 Al0,85 Als tussenlagen.
Achtergrond
In de afgelopen decennia hebben zelfgeorganiseerde kwantumstippen (QD's), gesynthetiseerd met behulp van de Stranski-Krastanov-techniek, veel aandacht getrokken. Hun optische en elektronische eigenschappen zijn intensief onderzocht vanwege hun potentiële toepassingen in opto-elektronische apparaten [1]. Het veel onderzochte InAs/GaAs QD-systeem is gebruikt in een reeks opto-elektronische apparaten als actief materiaal. Tijdens de groei van deze nanostructuren treedt tijdens het afdekproces een significante verandering in de grootte en de vorm van de QD's op. Dit proces is vrij complex en omvat vermenging, segregatie of door spanning versterkte diffusie [2]. Het gebruik van een pure GaAs-afdeklaag beperkt de QD-emissie tot minder dan 1300 nm. Om dit probleem te verminderen, zijn spanningsverminderende lagen gemaakt van (Ga, In) (As, Sb, N) gebruikt [2,3,4,5,6,7]. In het bijzonder heeft het ternaire GaAsSb bijzondere aandacht gekregen omdat de resulterende banduitlijning kan worden aangepast om van type I of type II te zijn door het Sb-gehalte [8, 9] te veranderen en door zijn vermogen om de emissiegolflengte buiten de C-band uit te breiden. [10]. Het verschil in energie tussen de fundamentele en de aangeslagen toestand is echter beperkt tot 60-75 meV wanneer GaAsSb wordt gebruikt als een spanningsverminderende laag (SRL) [11]. Deze energiescheiding verhindert niet dat dragers thermisch uit de QD's ontsnappen. Voor toepassingen die een lange levensduur van de drager vereisen, zal het inbrengen van een dunne barrière tussen de InAs QD's en GaAsSb gunstig zijn, omdat het de dragerscheiding tussen de QD's en de GaAsSb-kwantumbron (QW) zal vergroten. Als voorbeeld zijn GaAs-tussenlagen gebruikt, wat heeft geleid tot een verhoging van de energie-efficiëntie van zonnecellen met een factor 23% [12]. Het gebruik van InAlAs-lagen kan van belang zijn voor het ontwerpen van het type stralingsrecombinatie. Voor type II-transitie zal de insertie van InAlAs de levensduur van de drager [13] en de energiescheiding tussen de fundamentele en eerste aangeslagen toestanden [14,15,16] verlengen. Bovendien wordt verwacht dat het inbrengen van een InAlAs-laag tussen InAs QD's en GaAsSb de segregatie van InAs zal verminderen en de vermenging van InAs- en GaAs-atomen tussen de InAs QD's en de GaAsSb SRL zal onderdrukken en de QD-stam verder zal verminderen [17]. InAlAs/InGaAs samengestelde SRL's zijn gebruikt om InAs QD's af te dekken, wat resulteert in emissie op lange golflengte en een gunstige energiescheiding tussen de fundamentele en aangeslagen toestand tot wel 104 meV [16, 18].
In dit artikel rapporteren we het eerste onderzoek naar het effect van het gebruik van een In0.15 Al0,85 Als tussenlaag op de optische eigenschappen van InAs/GaAs0,85 Sb0,15 QD's door middel van fotoluminescentie (PL) spectroscopie. Met name de variatie van de emissiegolflengte, het type optische emissie, de spectrale lijnbreedte en de energiescheiding tussen de fundamentele en eerste aangeslagen toestand werden in detail bestudeerd.
Methoden
De monsters die in de huidige studie werden onderzocht, werden gekweekt op epi-ready quarter 2'p-type GaAs (001) -substraten in een Veeco Gen20A Molecular Beam Epitaxy-systeem. Krakers met klep werden gebruikt om As2 . te genereren en Sb2 dimeren. Na de groei van een GaAs-bufferlaag bij 590 ° C, werd de substraattemperatuur vervolgens verlaagd tot ~ -485 ° C om een nominaal 2,5-ML dikke InAs QD's te laten groeien. Na een korte pauze onder As2 flux, een samengestelde In0,15 Al0,85 As/GaAsSb SRL werd onmiddellijk afgezet, gevolgd door de groei van een GaAs van 5 nm dik bij dezelfde temperatuur, waarna de groeitemperatuur werd verhoogd tot 570 ° C om een GaAs-barrièrelaag van 38 nm te laten groeien. De dikte van GaAsSb was vastgesteld op 60 Å, terwijl de dikte van In0,15 Al0,85 Zoals varieerde van 20 tot 60 Å. De 60-Å-dikke GaAsSb SRL werd gerealiseerd met behulp van een As2 /Sb2 fluxverhouding geeft een Sb-gehalte van 15% zoals bepaald door röntgendiffractiemetingen op een referentiemonster. Voor alle lagen werd een vaste Ga-groeisnelheid van 0,5 ML/s gebruikt. Er zijn vier monsters, aangeduid als A, B, C en D, gekweekt waarvoor de In0.15 Al0,85 Als dikte t was ingesteld op respectievelijk 0 Å, 20 Å, 40 Å en 60 Å. Op basis van de procedure van Krijn [19] en met behulp van de parameters in [20] is de relatieve positie van de geleidings- en valentiebanden geschat en een schematische weergave van de gegroeide structuren met het bijbehorende banddiagram is weergegeven in Fig. 1.
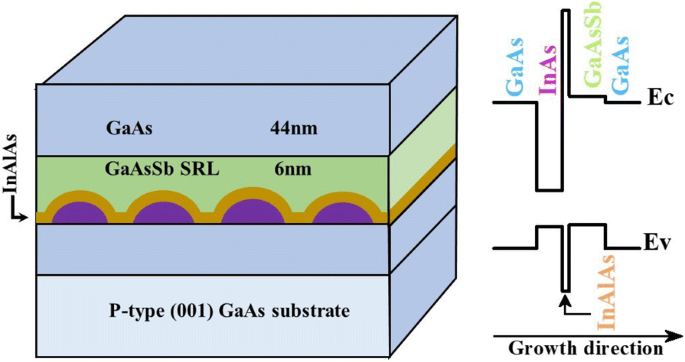
Schema van de gegroeide structuren en het bijbehorende energiebanddiagram van InAs QD's met een samengestelde In0.15 Al0,85 Als /GaAs0,85 Sb0,15 . De In0.15 Al0,85 Als dikte t = 0 Å, 20 Å, 40 Å en 60 Å voor respectievelijk monsters A, B, C en D
De kristalkwaliteit van de monsters werd gekenmerkt door röntgendiffractie met hoge resolutie (HRXRD) met behulp van een Panalytical röntgendiffractometer. De optische eigenschappen van de gekweekte monsters werden beoordeeld door middel van PL-spectroscopie bij 77 K met behulp van een PL-module aangesloten op een Vertex 80 Fourier Transform Infrared-instrument (Bruker Optics GmbH) en met behulp van een thermo-elektrisch gekoelde high-gain InGaAs-detector [21]. De monsters werden geëxciteerd met een CW 532 nm solid-state laserbron.
Resultaten en discussie
De kristalkwaliteit van de gegroeide monsters werd gekarakteriseerd door HRXRD met behulp van rocking curve-scans door het diffractiepatroon van 004 atomaire vlakken op te nemen. Figuur 2a toont de verkregen diffractiepatronen voor monsters A, B, C en D die overeenkomen met een InAlAs-dikte van respectievelijk 0, 20, 40 en 60 Å. Duidelijke satellietpieken als gevolg van de InAs/InAlAs/GaAsSb worden waargenomen en tonen de goede kristalkwaliteit van de gekweekte monsters. De gesimuleerde röntgenschommelcurven zijn opgenomen in figuur 2a naast de experimentele gegevens. Het verkregen gemiddelde Sb-gehalte in het referentiemonster A is 13% en de dikte van GaAsSb is 66 Å. Deze waarden werden gebruikt in monsters B, C en D om het In-gehalte en de dikte van de InAlAs-tussenlaag te vinden. De simulatie toonde aan dat het gemiddelde In-gehalte 13,5% is en dat de dikte van de InAlAs-tussenlaag 22 Å, 44 Å en 65 Å is in respectievelijk monsters B, C en D, die dicht bij de nominale diktes liggen.

een Hoge resolutie ω /2θ scant voor monsters A, B, C en D. b PL-spectrum van monster A verkregen bij 77 K en 100 mW excitatie. c Vermogensafhankelijke PL van monster A bij 77 K. d De corresponderende energiepiek voor de eerste twee optische overgangen versus Pex 1/3 bij 77 K
De optische eigenschappen van het referentiemonster A werden eerst onderzocht bij 77 K met behulp van de vermogensafhankelijke PL-techniek. Figuur 2b toont het PL-spectrum voor een excitatievermogen van 100 mW. Het PL-spectrum kan worden aangepast door drie Gauss-pieken gecentreerd op 1004 meV, 1068 meV en 1113 meV, die kunnen worden geïdentificeerd als de fundamentele en opgewonden optische overgangen. De volledige breedte bij half maximum (FWHM) van de fundamentele en eerste aangeslagen toestanden zijn respectievelijk 52 en 58 meV. Om de oorsprong van de waargenomen eerste twee optische overgangen te begrijpen, werd het excitatievermogen gevarieerd van 1 tot 100 mW en werden de overeenkomstige PL-spectra verkregen zoals weergegeven in figuur 2c. Voor elk excitatievermogen werd de energie van de eerste twee pieken geëxtraheerd met behulp van multi-Gauss-functieaanpassing en uitgezet als een functie van de derdemachtswortel van het excitatievermogen zoals weergegeven in figuur 2d. De energie van de fundamentele overgang neemt af met het verminderen van het excitatievermogen in overeenstemming met een type II-overgang, wat aangeeft dat de emissie het resultaat is van de recombinatie van elektronen die zich in de fundamentele elektronentoestand in de QD bevinden (E0QD ) en gaten in de GaAsSb QW (H0QW ). Voor banduitlijning van InAs/GaAsSb type II induceert de lokalisatie van elektronen en gaten in respectievelijk de QD's en GaAsSb SRL een bandbuigend effect als gevolg van het elektrische veld, dat zich voornamelijk in de groeirichting bevindt [22]. De overgangsenergie van type II zal naar verwachting evenredig toenemen met de derde wortel van het excitatievermogen, zoals aangetoond door Jin et al. [22]. Evenzo neemt de energie van de eerste aangeslagen toestandsovergang af met het verminderen van het excitatievermogen, en deze overgang is hoogstwaarschijnlijk het resultaat van de recombinatie van elektronen in de eerste elektron-aangeslagen toestand in de QD (E1QD ) en gaten in de GaAsSb QW (H0QW ) omdat de toestandsdichtheid in de GaAsSb QW veel groter is dan de toestandsdichtheid in de QD's. De eerste twee optische overgangen zijn geïllustreerd in figuur 3a. We merken ook op dat de energiescheiding tussen de fundamentele en de eerste aangeslagen toestand ΔE bijna constant blijft op 64 meV met afnemend excitatievermogen, en dit is een bewijs dat het elektrische veld dat resulteert uit de ladingsopbouw loodrecht staat op de groeirichting [22], dat wil zeggen, de gaten in de GaAsSb zijn gelokaliseerd boven de QD's. In monster A wordt een type II-emissie verwacht omdat het Sb-gehalte in de GaAsSb, dat 13% is, dicht bij de samenstelling ligt waar een overgang van type I naar type II optreedt [23, 24]. Voor het beschouwde Sb-gehalte zou een kleine valentieband-offset tussen de QD's en de GaAsSb QW moeten bestaan die de lokalisatie van gaten in de GaAsSb QW en vervolgens type II-emissies bevordert [25, 26].
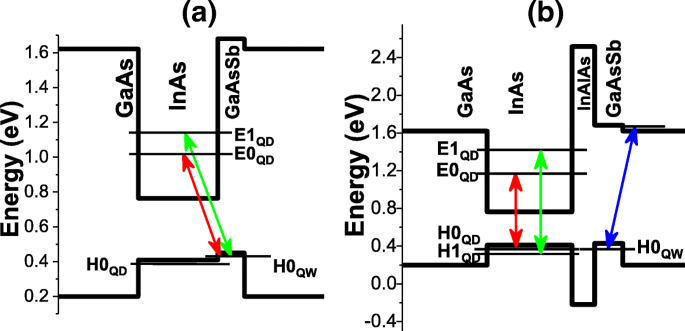
Bandprofielen van voorbeeld A (a ) en monsters B, C en D (b ) met hun corresponderende recombinatiekanalen
Afbeelding 4a toont de PL-emissie die overeenkomt met de monsters met verschillende In0,15 Al0,85 Als dikte met excitatievermogen variërend van 1 tot 100 mW. Er kunnen drie hoofdpieken worden geïdentificeerd voor alle monsters met een In0,15 Al0,85 Als tussenlaag. We merken een wijziging op van de energiepiekposities van de verschillende stralingskanalen ten opzichte van het referentiemonster A. Bij een excitatievermogen van 100 mW werden de energie van de fundamentele overgang, FWHM, en de energiescheiding ΔE geëxtraheerd en vergeleken met monster A. De geëxtraheerde waarden worden weergegeven in Afb. 4b.

een Vermogensafhankelijke PL van de InAs/In0.15 Al0,85 As/GaAsSb QD's bij 77 K. b De corresponderende piekenergie, FWHM en ΔE versus InAlAs-dikte en c de variatie van de piekenergie van optische overgangskanalen als functie van de derdemachtswortel van het excitatievermogen voor monsters B, C en D
De overgang van de grondtoestand van monster A vindt plaats bij 1004 meV met een FWHM van 52 meV en een energiescheiding ΔE van 64 meV. 20 Å van In0,15 . invoegen Al0,85 As (monster B) induceert een blauwverschuiving van de overgang van de grondtoestand met 52 meV. De blauwverschuiving komt overeen met wat is waargenomen wanneer een samengestelde InAlAs/InGaAs werd gebruikt voor QD's die bij bijna dezelfde groeitemperatuur werden gekweekt [27]. De blauwverschuiving van de overgangsenergie in de grondtoestand van de InAs QD's in monster B is het gevolg van het verhoogde opsluitingspotentieel [15]. Naarmate de barrière voor elektronen en gaten wordt vergroot, zou de scheiding van elektronen en gaten op energieniveau moeten toenemen, wat leidt tot de waargenomen emissieblauwverschuiving. Het is algemeen bekend dat het afdekken van InAs met GaAs resulteert in een vermindering van de QD-hoogte als gevolg van In-segregatie en In-Ga-vermenging [28]. De introductie van Sb in de GaAs-afdeklaag vermindert de QD-decompositie door remming van de door spanning aangedreven In-Ga-vermenging [29]. Het inbrengen van de InAlAs-tussenlaag zal naar verwachting de In-segregatie en In-Ga-vermenging als gevolg van de inactiviteit van Al-adatoms verder onderdrukken. In feite, Jun et al. [17] hebben door middel van STEM aangetoond dat het gebruik van een InAlAs/InGaAs-combinatielaag als afdeklaag In-segregatie en vermenging van In-Ga langs de groeirichting tijdens het afdekproces van de InAs QD's sterk onderdrukt, wat leidt tot de verhoogde hoogte van de nanostructuren en een hogere In-concentratie in InAs QD's na capping. Gezien de lage groeitemperatuur van de QD's, d.w.z. 485 °C, wordt verwacht dat de indiumsegregatie en de vermenging van de interface tussen de QD's en de InAlAs-tussenlaag onbeduidend zijn als gevolg van de inactiviteit van Al-adatomen.
De FWHM en ΔE worden verlaagd en verhoogd tot respectievelijk 39 meV en 92 meV. De dikte van In0,15 . verder vergroten Al0,85 Wat betreft 40 Å en 60 Å (respectievelijk monsters C en D) veroorzaakt een roodverschuiving van de emissiegolflengte. Deze roodverschuiving wordt waarschijnlijk veroorzaakt door de wijziging van de spanning in InAs QD's, aangezien de totale dikte van de samengestelde InAlAs/GaAsSb SRL toeneemt met toenemende InAlAs-dikte [30]. Dit kan de structurele afmetingen van de QD's veranderen en daarmee de energieniveaus van elektronen en gaten wijzigen. Het lijkt erop dat voor monsters C en D (respectievelijk 40 Å en 60 Å), het spanningseffect het opsluitingspotentieel-effect domineert. De laagste FWHM van 35 meV en de hoogste energiescheiding ΔE van 35 meV en 106 meV werden respectievelijk verkregen voor monster D. De grote ΔE wordt veroorzaakt door het gebruik van een dikkere InAlAs-laag en mogelijk een verhoogde QD-hoogte [31, 32]. De energiescheiding is vergelijkbaar met die verkregen wanneer een samengestelde InAlAs/InGaAs SRL wordt gebruikt (104 meV) [16, 33]. De verlaging van de FWHM kan worden begrepen in termen van een verlaging van de vermenging tussen In0.15 Al0,85 As en QD's en dus een behoud van de QD-distributie. De geëxtraheerde parameters zijn samengevat in Tabel 1.
De PL-intensiteit van monsters B en C was verhoogd in vergelijking met monster A; er werd echter een sterke vermindering van de PL-intensiteit waargenomen voor monster D, d.w.z. een vermindering met een factor 5 vergeleken met monster C. De verminderde PL-intensiteit is het gevolg van de vermindering van dragerinjectie van de GaAsSb-laag naar de QD's. Tijdens de belichting worden in feite talloze dragers gefotogenereerd en het inbrengen van de In0.15 Al0,85 Omdat tussenlaag een barrière vormt voor dragers en hun injectie in de QD's kan beperken. Dragers kunnen via een tunnelproces naar de QD's worden overgebracht en de PL-intensiteit is hoger voor de monsters met dunner In0,15 Al0,85 Als barrières [34]. Monster D vertoonde de laagste PL-intensiteit als tunneling door de 60 Å In0.15 Al0,85 Zoals sterk wordt verminderd, en dit wordt bewezen door de verhoogde PL-emissie van de GaAsSb QW zoals weergegeven in figuur 4a. De vermindering van het tunnelproces maakt de stralingsrecombinatie van elektronen en gaten in de GaAsSb QW gunstig en verbetert deze.
De belangrijkste waarneming van de vermogensafhankelijke PL bij 77 K voor monsters B, C en D getoond in Fig. 4a zijn de vaste energieposities van de eerste twee pieken met toenemend excitatievermogen in tegenstelling tot wat werd waargenomen in monster A. Dit is een kenmerk van een type I-emissie waarbij zowel elektronen als gaten binnen de QD's zijn gelokaliseerd. De eerste twee emissiepieken zijn het gevolg van de recombinatie van elektronen en gaten in de fundamentele en eerste aangeslagen toestanden in de QD's (E0QD -H0QD en E1QD -H1QD ). Wij zijn van mening dat de derde piek afkomstig is van een type II-emissie die het gevolg is van de recombinatie van elektronen in GaAs en gaten gelokaliseerd in GaAsSb QW. Inderdaad, de energie die overeenkomt met deze overgang neemt toe met toenemend excitatievermogen, zoals weergegeven in figuur 4a en figuur 4c, kenmerkend voor een type II-overgang. Bovendien zien we dat de intensiteit toeneemt met toenemende In0.15 Al0,85 Als laagdikte. Dit is in overeenstemming met de vermindering van de PL-intensiteit van de fundamentele overgang als een dikkere In0.15 Al0,85 Omdat laag de tunneling van dragers van GaAsSb naar de QD's vermindert en de type II-emissie bevordert die wordt verkregen door de recombinatie van elektronen en gaten in respectievelijk GaAs en GaAsSb. Een schema van de recombinatiekanalen voor monsters B, C en D is weergegeven in figuur 3b. De onderdrukking van de type II-emissie kan als volgt worden begrepen. Het invoegen van een 20-Å In0.15 Al0,85 Naarmate de laag de dragerscheiding tussen de QD's en GaAsSb QW vergroot, en als resultaat, neemt de overlap van de elektron- en gatgolffunctie af. Bovendien is het feit dat het Sb-gehalte in het GaAsSb-gehalte dicht bij de type I-type II-crossover ligt, de In0.15 Al0,85 Als tussenlaag zal het beperkte niveau in de QW worden gebracht (H0QW ) onder het eerste gekwantiseerde niveau in de QD's (H0QD ) zoals weergegeven in Fig. 3b en daarom kunnen gaten die in de QW zijn gevangen, door de InAlAs-laag tunnelen, waardoor de type II-emissie minder waarschijnlijk wordt. Voor een dikkere In0,15 Al0,85 Als tussenlaag (40 Å en 60 Å) wordt de tunneling verder verminderd, maar de overlap van de elektronen- en gatgolffunctie wordt aanzienlijk verminderd, wat de recombinatie van elektronen in GaAs met gaten in GaAsSb bevordert [13]. De optische overgang van InAs/GaAsSb QD's kan worden aangepast aan het type toepassing dat een korte of lange levensduur vereist. In onze studie hebben we een Sb-gehalte van 13% in GaAsSb overwogen, wat dicht bij de overgang van type I naar type II ligt. Het inbrengen van een InAlAs-tussenlaag onderdrukte de type II-emissie en verhoogde de energiescheiding tussen de fundamentele en eerste aangeslagen toestand, wat wenselijk is voor toepassingen die een korte levensduur van de drager vereisen. De huidige studie kan ook op maat worden gemaakt voor toepassingen die een lange levensduur van de drager vereisen. In feite wordt verwacht dat de combinatie van het gebruik van een hoger Sb-gehalte in de GaAsSb-laag en de insertie van een InAlAs-tussenlaag de type II-emissie voor dunne InAlAs-tussenlagen zal behouden, terwijl de levensduur van de drager aanzienlijk wordt verlengd. Tegelijkertijd zal de grotere energiescheiding tussen de fundamentele en de eerste aangeslagen toestand de thermische ontsnapping van de drager verminderen.
Conclusie
InAs QD's afgetopt met samengestelde In0.15 Al0,85 As/GaAs0,85 Sb0,15 SRL's met variërende In0,15 Al0,85 Naarmate diktes werden gekweekt en gekarakteriseerd. Uit onze analyse blijkt dat het invoegen van een In0.15 Al0,85 As laag onderdrukt de waargenomen type II emissie verkregen uit InAs/GaAs0,85 Sb0,15 QD's. Bovendien is de emissiegolflengte blauwverschoven voor t = 20 Å en roodverschuiving voor t ≥ 40 Å als gevolg van respectievelijk het verhoogde opsluitingspotentieel en de verhoogde belasting. Een grote energiescheiding ΔE van 106 meV werd verkregen voor het monster met een 60-Å-dikke In0,15 Al0,85 Als tussenlaag. Daarnaast is de introductie van de In0.15 Al0,85 Als tussenlaag vermindert de FWHM aanzienlijk van 52 meV tot een minimum van 35 meV.
Afkortingen
- FWHM:
-
Volledige breedte op halve maximum
- HRXRD:
-
Röntgendiffractie met hoge resolutie
- PL:
-
Fotoluminescentie
- QD's:
-
Kwantumstippen
- QW:
-
Kwantumbron
- SRL's:
-
Spanningverminderende lagen
Nanomaterialen
- De atoomherschikking van op GaN gebaseerde meerdere kwantumbronnen in H2/NH3 gemengd gas voor het verbeteren van structurele en optische eigenschappen
- N,N-dimethylformamide die de fluorescentie van MXene Quantum Dots reguleert voor de gevoelige bepaling van Fe3+
- Het detecteren van ruimtelijk gelokaliseerde excitatie in zelfgeorganiseerde InAs/InGaAs Quantum Dot Superroosters:een manier om de fotovoltaïsche efficiëntie te verbeteren
- Effecten van dubbellaagse dikte op de morfologische, optische en elektrische eigenschappen van Al2O3/ZnO-nanolaminaten
- Groene synthese van InP/ZnS Core/Shell Quantum Dots voor toepassing in licht-emitterende diodes zonder zware metalen
- Synthese van in water oplosbare antimoonsulfide Quantum Dots en hun foto-elektrische eigenschappen
- Eenstaps sonochemische synthese en fotokatalytische eigenschappen van grafeen/Ag3PO4 Quantum Dots Composites in één stap
- Eliminatie van bimodale grootte in InAs/GaAs Quantum Dots voor de voorbereiding van 1,3-μm Quantum Dot Lasers
- Interband fotogeleiding van metamorfe InAs/InGaAs Quantum Dots in het venster van 1,3–1,55 µm
- Materiële en optische eigenschappen van fluorescerende koolstof Quantum Dots vervaardigd uit citroensap via hydrothermische reactie
- Optische eigenschappen van met Al-gedoteerde ZnO-films in het infraroodgebied en hun absorptietoepassingen



