Verbetering van de prestaties van a-IGZO TFT-apparaten met behulp van een schoon interfaceproces via Etch-Stopper nanolagen
Abstract
Om de technologische en economische obstakels van op amorf indium-gallium-zink-oxide (a-IGZO) gebaseerde display-backplane voor industriële productie te overwinnen, is een clean etch-stopper (CL-ES)-proces ontwikkeld om op a-IGZO gebaseerde dunne filmtransistor (TFT) met verbeterde uniformiteit en reproduceerbaarheid op 8.5e generatie glassubstraten (2200 mm × 2500 mm). Vergeleken met a-IGZO-gebaseerde TFT met back-channel-etched (BCE) structuur, een nieuw gevormde ES-nanolaag (~ 100 nm) en gelijktijdig etsen van a-IGZO-nanolaag (30 nm) en source-drain elektrodelaag wordt eerst geïntroduceerd in een op IGZO gebaseerd TFT-apparaat met CL-ES-structuur om de uniformiteit en stabiliteit van het apparaat voor weergave op groot gebied te verbeteren. De verzadigingselektronenmobiliteit van 8,05 cm 2 /V s en de V de uniformiteit van 0,72 V worden gerealiseerd op het a-IGZO-gebaseerde TFT-apparaat met CL-ES-structuur. In de negatieve bias temperatuur verlichtingsspanning en positieve bias thermische stress betrouwbaarheidstests onder een ± 30 V bias voor 3600 s, de gemeten V de verschuiving van CL-ES-gestructureerd apparaat nam significant af tot -0,51 en +-1,94 V, wat veel lager is dan die van BCE-gestructureerd apparaat (-3,88 V, + -5,58 V). De elektrische prestaties van het op a-IGZO gebaseerde TFT-apparaat met CL-ES-structuur impliceren dat de economische overdracht van een op silicium gebaseerd TFT-proces naar het op metaaloxide halfgeleider gebaseerde proces voor LCD-fabricage zeer haalbaar is.
Achtergrond
Thin film transistor (TFT) backplane met hogere resolutie en grotere paneelafmetingen is zeer gewenst in de flat plane display-industrie. Halfgeleidermateriaal met een hoge elektronenmobiliteit is cruciaal om de prestaties van de TFT-backplane te verbeteren. In het bijzonder wordt een op metaaloxide halfgeleider gebaseerde TFT-backplane beschouwd als een veelbelovende kandidaat om de beperking van op silicium gebaseerde TFT-backplane te overwinnen in termen van mechanische flexibiliteit en elektronenmobiliteit [1,2,3,4]. Hoewel een op metaaloxide halfgeleider gebaseerde TFT-backplane veelbelovende eigenschappen vertoont, is de procesmethode met een goedkoop proces voor zowel grootschalige depositie voor industriële toepassing nog steeds nodig [5].
Amorf indium-gallium-zink-oxide (a-IGZO) is een uitstekende metaaloxide-halfgeleider met een hoge verzadigingselektronenmobiliteit (~ 5–10 cm 2 /V s) en een lage uit-stroom (< 10 pA) [6,7,8,9,10]. De gebruikelijke industriële productiemethode voor een op a-Si:H gebaseerde TFT-backplane is het vijf-masker-back-channel-etched (BCE) proces. A-IGZO nanofilm heeft echter een zeer lage chemische resistentie tegen de typische etsmiddelen die momenteel in het BCE-proces worden gebruikt. Vooral a-IGZO-nanofilms zouden binnen enkele seconden volledig worden geëtst wanneer ze worden blootgesteld aan Al-etsmiddel bestaande uit fosforzuur, salpeterzuur en azijnzuur [11,12,13]. Deze oncontroleerbaar snelle etsing belemmert de acceptatie van het BCE-proces voor een op IGZO gebaseerde TFT-backplane. Om a-IGZO in BCE-gestructureerde backplane te gebruiken, is Cu-bedradingstechnologie ontwikkeld, zoals het etsmiddel dat wordt gebruikt in het Cu-bedradingsproces, dat is gebaseerd op H2 O2 , is veel milder voor a-IGZO-nanofilm dan degene die worden gebruikt in Al-bedrading [11, 13]. Helaas wordt a-IGZO-nanofilm nog steeds beschadigd tijdens het Cu-bedradingsproces, zelfs wanneer een milder etsmiddel wordt gebruikt. Zelfs mildere etsmiddelen veroorzaken schade aan het oppervlak van een IGZO-nanofilm die het achterkanaal van TFT-apparaten vormt. Deze schade veroorzaakt een ineenstorting van de stoichiometrische moleculaire samenstellingsverhouding nabij het oppervlak van a-IGZO-nanofilm, wat leidt tot een verslechtering van de uniformiteit in weergave op groot gebied en de betrouwbaarheid van TFT-apparaten. Tot op heden is een conventioneel zes-masker-ets-stop (CV-ES) proces ontwikkeld om een op IGZO gebaseerde TFT-backplane met een ets-stop-laag (ESL) structuur [14, 15] te fabriceren. Dit ES-proces met zes maskers kan echter leiden tot een negatieve economische haalbaarheid. Bovendien zou dit toegenomen aantal dunne-filmlagen het overlapgebied tussen de lagen vergroten en resulteren in een verhoogde parasitaire capaciteit en verminderde openingsverhouding [16,17,18]. Hoewel recentelijk is gerapporteerd over een vijf-masker ES-proces dat TFT-backplane produceert met behulp van halftoon- en lift-off-technologie, is dit proces niet toegankelijk voor de productie van een op IGZO gebaseerde TFT-backplane, omdat hun actieve laagoppervlak nog steeds wordt blootgesteld aan proceschemicaliën zoals stripper en fotoresist in de laatste stap, die aanzienlijke verontreiniging van a-IGZO kunnen veroorzaken, waardoor de apparaatkwaliteit en het productierendement afnemen [19,20,21]. Daarom blijft de industriële productiemethode voor een op IGZO gebaseerde TFT-backplane met hoge uniformiteit en stabiliteit een uitdaging.
In dit artikel stellen we een schoon vijfmasker ES-proces (CL-ES) voor via de introductie van ESL voor de fabricage van een op IGZO gebaseerde TFT-backplane. Dit nieuw ontwikkelde CL-ES-proces is zeer compatibel met het bestaande proces voor BCE-apparaten. Dit CL-ES-proces is ontworpen om dezelfde maskers te hebben als dat van het BCE-proces, wat zorgt voor een verwaarloosbaar productiviteitsverlies van de bestaande AM-LCD TFT-backplane FAB. a-IGZO-gebaseerde backplane geproduceerd met behulp van CL-ES-proces deponeert gate-isolator, IGZO-nanolaag en ES-nanolaag achtereenvolgens en vormt vervolgens een nieuw ESL-masker door middel van de dry-etch-methode. Dit zou de verontreiniging van a-IGZO-nanolaag en hun interface door etsmiddel, stripper en oplosmiddel kunnen voorkomen. Dit nieuw gevormde nanomasker helpt de uniformiteit en stabiliteit van het TFT-apparaat te verbeteren. Vergeleken met een conventioneel BCE-gestructureerd apparaat, vertoont een op IGZO gebaseerd apparaat met CL-ES-structuur verbeterde elektrische prestaties, namelijk een hogere verzadigingselektronenmobiliteit, een hoge openingsverhouding en een laag stroomverbruik.
Methoden/experimenteel
Vervaardiging van een op IGZO gebaseerde TFT-backplane
De a-IGZO-gebaseerde TFT-backplane met ES-structuur vervaardigd via het CL-ES-proces was als volgt (Fig. 1).
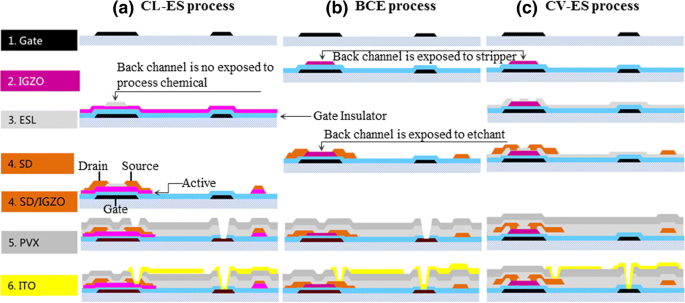
(Online kleur) Schema's van a CL-ES, b BCE, en c CV-ES-processen
Ten eerste werd een dubbele laag (Mo/Cu:30 nm/250 nm) gebruikt voor de poortelektrode, omdat deze een redelijk lage soortelijke weerstand heeft. Vervolgens werd gate-isolator, siliciumnitride (SiNx) / siliciumoxide (SiOx) (300 nm/100 nm), afgezet door middel van plasma-enhanced chemische dampafzetting (PECVD) -methode. Deze SiNx-film is ontworpen om oxidatie van Cu-metallisering en diffusie van Cu-ionen in de poortisolator te voorkomen. Vervolgens werd een dunne SiOx-film afgezet. De afzettingsomstandigheden van PECVD SiOx-film waren 17 kW RF-vermogen, 1000 mTorr-druk, 1:55 SiH4 /N2 O-gasverhouding en een temperatuur van 350 ° C. Vervolgens werd a-IGZO nanofilm afgezet tot 30 nm met behulp van dc roterende magnetron sputter. Het doelwit had een diameter van 171 mm terwijl de compositie In2 . was O3 :Ga2 O3 :ZnO = 1:1:1 mol%. De sputterparameters voor de a-IGZO nanofilm waren systeembasisdruk van 5~ 9 × 10 −7 Torr, rf-sputtervermogen van 10 kW, sputterdruk van 5 mTorr Ar/O2 gasmengsel (85% Ar-15% O2 ). De depositietemperatuur is bij kamertemperatuur. Geproduceerde a-IGZO-film wordt gedurende 1 uur gegloeid bij 330 °C in een omgeving met schone, droge lucht.
Ten tweede werd etch-stopper (ES) nanolaag (SiOx) afgezet met behulp van de PECVD-methode. ES-nanolaag wordt gelijktijdig afgezet om contaminatie in a-IGZO-laag te voorkomen. Net als in het BCE-proces is er geen beschermende laag voor a-IGZO-nanofilm vóór het S/D-elektrodepatroonproces, oppervlakteverontreiniging en schade aan a-IGZO-nanofilm door S/D-etsmiddel bij het vormen van een TFT-kanaal is onvermijdelijk. ES-nanolaag in CL-ES-proces kan het TFT-kanaal effectief beschermen tegen externe verontreiniging en schade. De ES-nanolaag werd afgezet tot een dikte van 100 nm. De afzettingsomstandigheden van SiOx-dunne film waren 17 kW RF-vermogen, 1000 mTorr-druk, 1:66 SiH4 /N2 O-gasverhouding en 240 ° C temperatuur. Het geproduceerde ES-nanomasker werd geëtst door droog etsen en patroonvorming. Tijdens het etsproces, CF4 en O2 gas werd geleverd met een snelheid van 2000 sccm/800 sccm.
Ten derde werd Mo/Cu/Mo ook gebruikt voor de S/D-elektrode. Om de S/D-elektrode van a-IGZO TFT te selecteren, werd aangenomen dat het verschil in werkfunctie tussen metaal en a-IGZO een Ohms contact vormt en de materialen met een lage soortelijke weerstand. Zoals beschreven in het ets-stopproces, worden de a-IGZO-nanofilms, die niet worden beschermd door de ets-stoplaag, tijdens het patroonvorming van het ES-nanomasker al geleid door te worden gebombardeerd met CF4 plasma. Daarom wordt op natuurlijke wijze Ohms contact gevormd met Mo/Cu/Mo [22]. De S/D-lagen werden afgezet in een dikte van 30 nm/300 nm/30 nm met dezelfde sputtercondities als de poortelektrode. Bovendien werden multi-dunne filmlagen van Mo/Cu/Mo en a-IGZO batchgewijs geëtst met behulp van "H2 O2 gebaseerd Cu-etsmiddel met een fluoride-additief” om de S/D-elektrode te voltooien. De 30 nm Mo toegevoegd bovenop Cu werd gevormd om oxidatie van het Cu-oppervlak door passiveringsfilm (SiOx) in het volgende proces te voorkomen en om plasmaschade aan het Cu-oppervlak te voorkomen tijdens droog etsen voor de vorming van passiveringsgaten.
Ten vierde werd passiveringsfilm, verdeeld in twee soorten dunne film, afgezet met behulp van de PECVD-methode. De eerste passivering werd gemaakt van SiOx dunne film. De dunne film was 250 nm dik. De tweede passivering bestond uit SiNx dunne film. De dikte van de dunne film was 200 nm.
Ten vijfde, als de pixelelektrode, werd indiumtinoxide (ITO) -film, die het meest wordt gebruikt in de beeldschermindustrie, gebruikt. De ITO-film was 40 nm dik en voor de afzetting werd dc-sputtering gebruikt. Vervolgens werd het laatste gloeien uitgevoerd in een omgeving met schone, droge lucht bij 230 ° C gedurende 1 uur met behulp van een heteluchtoven. De elektrische kenmerken van gefabriceerde a-IGZO TFT's werden gemeten met behulp van Keysight 4082A Parametrisch testsysteem. Dit proces levert hetzelfde aantal maskers op (TN-productstandaard:vijf maskers) als het BCE-proces, dat veel wordt gebruikt in massaproductie.
Ter vergelijking:een op IGZO gebaseerde TFT-backplane met BCE-structuur werd gefabriceerd via het BCE-proces.
Karakterisering
De IV-meting van TFT werd uitgevoerd bij kamertemperatuur met behulp van een halfgeleiderkarakteristiekanalysator. De analyseconditie om de stabiliteit van de TFT onder negatieve gate-bias-temperatuurverlichtingsstress (NBTIS) te evalueren, was als volgt. V gs en V ds werden respectievelijk gefixeerd op -30 en 15 V, en de temperatuur van het substraat werd op 60 ° C gehouden. De luminantie voor NBITS was ingesteld op 5000 cd/m 2 . De duur van de stress voor evaluatie duurde 3600 s [23]. Positieve gate bias thermische spanning (PBTS) werd getest bij een V gs van 30 V en een V ds van 15 V en de substraattemperatuur werd ingesteld op 60 ° C. De duur van de stress voor evaluatie duurde 3600 s [24].
Resultaten en discussie
a-IGZO-gebaseerde TFT vervaardigd via het CL-ES-proces toont hetzelfde maskernummer als dat van het BCE-proces (Fig. 1). Vergeleken met a-IGZO-gebaseerde TFT met BCE-structuur, heeft a-IGZO-gebaseerde TFT met CL-ES-structuur twee voordelen:(1) a-IGZO-gebaseerde backplane geproduceerd met gebruikmaking van CL-ES process deposits gate-isolator, a-IGZO nano -laag en ES-nanolaag achtereenvolgens, vormt vervolgens een ESL-nanomasker door middel van de droog-etsmethode. Dit nieuw gevormde ESL-nanomasker met 100 nm kan de blootstelling van a-IGZO-nanofilm aan etsmiddel, stripper of fotoresist voorkomen. Daarom wordt de verontreiniging op grensvlakken tussen de lagen effectief voorkomen [25]. (2) Tegelijkertijd wordt a-IGZO nanofilm niet beschermd door een ES-laag, maar gebombardeerd door CF4 plasma tijdens de ESL-nanomaskervorming, wordt dus een geleider. Dit vormt natuurlijk het Ohmse contact tussen de S/D-elektrode van het volgende proces en een IGZO-halfgeleider. Voor een ander deel kan een gelijktijdig etsen van S/D en a-IGZO nanolaag één overlay-toeslag van ESL-(a-IGZO+S/D metallisatie) laag zijn, wat de twee overlayprocesfouten van de a- IGZO-ESL en ES-S/D metallisatielaag in het conventionele ESL-proces (Fig. 2). Het overlay-nummer van de a-IGZO-, ES- en S/D-laag is verminderd, wat resulteerde in de afname van de grootte van het TFT-apparaat dat de parasitaire capaciteit verlaagde. De vlakke structuur van het resultaat is vergelijkbaar met de BCE-structuur (Fig. 3a, b).
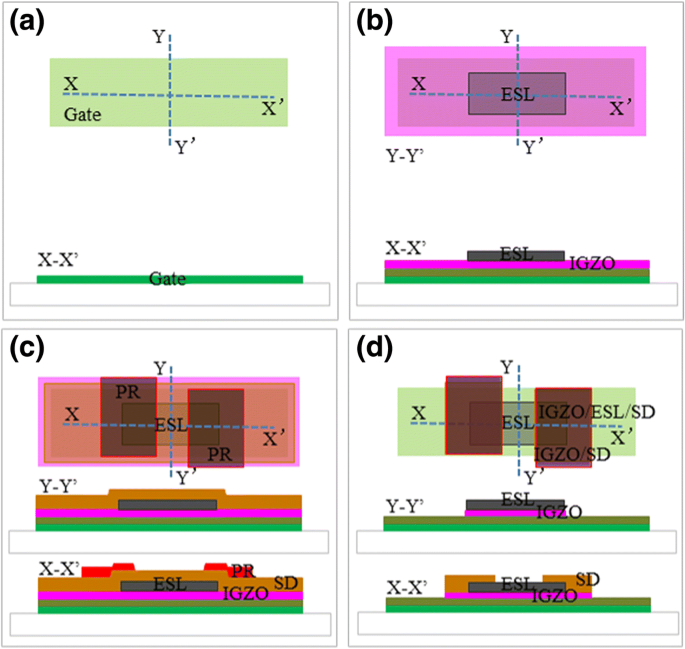
(Kleur online) Schema's van gelijktijdige vormingsmethode voor TFT-kanaal en S/D-elektrode in CL-ES-proces. een De eerste stap die poortelektrode vormt. b De tweede stap die een etsstoplaag vormt. c De derde stap die het S/D-fotopatroon vormt. d De vierde stap die S/D-elektrode en actief patroon vormt
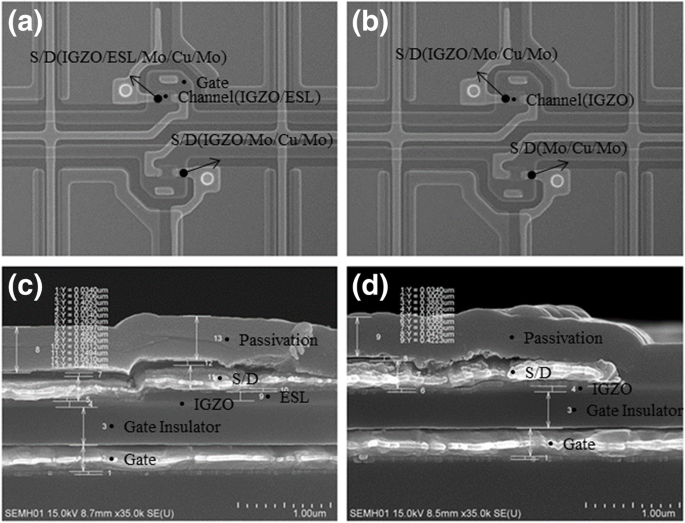
(Online kleur) SEM-afbeeldingen van a-IGZO TFT (a , b bovenaanzicht; c , d zijaanzicht) met CL-ES-structuur (a , c ) en BCE-structuur (b , d )
Figuur 3 toont de SEM-afbeeldingen van a-IGZO-gebaseerde TFT's met CL-ES-structuur (Fig. 3a, c) en BCE-structuur (Fig. 3b, d). Vanuit het bovenaanzicht is het moeilijk om de verschillen tussen de CL-ES-structuur en de BCE-structuur te identificeren (Fig. 3a, b). Vanuit het zijaanzicht is een ES-nanolaag te vinden tussen de a-IGZO-nanolaag en de S / D-elektrodelaag in de CL-ES-structuur (figuur 3c). Ondertussen is een passiveringslaag te vinden op de bovenkant van een a-IGZO-nanolaag in BCE-structuur (figuur 3d). In het gepresenteerde CL-ES-proces wordt een a-IGZO-nanolaag met een dikte van 30 nm afgezet. Bovendien is de schade tijdens nat etsen verwaarloosbaar. Voor het BCE-proces wordt een 70 nm a-IGZO-nanolaag afgezet, omdat een a-IGZO-laag compensatie nodig heeft voor etsverlies. Het verschil tussen de diktes van a-IGZO-nanolagen in CL-ES- en BCE-structuren kan worden waargenomen in de SEM-afbeeldingen (Fig. 3c, d).
De IV-kenmerken van een op IGZO gebaseerde TFT met CL-ES-structuur en BCE-structuur worden vergeleken (Fig. 4). De verzadigingselektronenmobiliteit, drempelspanning, subdrempelspanningszwaai (SS) -waarde en meer karakteristieke waarden zijn samengevat in tabel 1. Merk op dat de waarden samengevat in tabel 1 het gemiddelde aantal zijn afgeleid van het midden en de rand van een 8,5 generatie glassubstraat . De op a-IGZO gebaseerde TFT met CL-ES-structuur realiseert V de van − 0,8 V, SS-waarde van 0,18 V/dec en verzadigingselektronenmobiliteit van 8,05 cm 2 /Vs. In de op a-IGZO gebaseerde TFT met BCE-structuur zijn de overeenkomstige resultaten V de van + 0,5 V, SS-waarde van 0,77 V/dec en verzadigingselektronenmobiliteit van 6,03 cm 2 /Vs. Vergeleken met de BCE-structuur vertoont de CL-ES-structuur verbeterde apparaatprestaties. De stroomkarakteristiek van het op a-IGZO gebaseerde TFT-apparaat met CL-ES-structuur is echter lager dan dat van het BCE-gestructureerde apparaat. Dit komt door het feit dat TFT-kanaalstructuren verschillen in CL-ES- en BCE-structuren. Over het algemeen is de BCE-gestructureerde TFT-kanaallengte de afstand tussen S/D-metaalelektroden, en de gemeten kanaallengte in deze studie is 5 um [21]. In de CL-ES-structuur zijn elektroden in contact met de a-IGZO-nanofilm die aan de zijkant van het ESL-nanomasker is uitgerekt. Daarom wordt de kanaallengte bepaald door de afstand tussen de a-IGZO's gedefinieerd aan de zijkanten van de etsstop, maar niet bepaald door de afstand tussen de elektroden. De kanaallengte van het huidige apparaat met CL-ES-structuur wordt gemeten als 10 um.

(Kleur online) Vergelijking van I-V-karakteristiek van a-IGZO TFT's met CL-ES- en BCE-structuur in het midden (a ) en rand (b ) van 8.5 generatie glassubstraat
Zoals weergegeven in tabel 1 zijn de gemeten waarden van I aan /Ik uit verhouding (~ 10 6 , zie tabel 1) zijn ongeveer 10 keer kleiner dan de normale waarde (> 10 7 ) van op a-IGZO gebaseerde TFT's. De meetapparatuur die hier gebruikt wordt is namelijk bedoeld voor de 8.5 generatie massaproductie. Voor deze metingen zijn lange kabels nodig, omdat de industriële apparatuur groot is. De lange kabels resulteerden in een verhoogde meetruis. Bij de volgende betrouwbaarheidstests wordt gebruik gemaakt van kleinere meetapparatuur en worden de individuele TFT-apparaten gebruikt als monster voor de meting. Op deze manier wordt de gemeten I aan /Ik uit verhoudingen zijn allemaal bovenste 10 7 (zie hieronder).
Het CL-ES-proces is zorgvuldig ontworpen om te voorkomen dat een IGZO-kanaallaag wordt blootgesteld aan etsmiddel, fotoresist of stripper. Tijdens het proces dat CL-ES-proces, poortisolator, a-IGZO nanolaag en ES nanolaag produceert, komt elke tussenlaaginterface in contact met alleen DI-water voor reinigingsdoeleinden. Daarom is de chemische verontreiniging verwaarloosbaar in de isolatorlaag en de a-IGZO-nanolaag [25, 26]. Het BCE-proces stelt echter niet alleen de kanaallaag bloot aan de chemicaliën, maar omvat ook Cu-iondiffusiecontaminatie, aangezien het a-IGZO-kanaal direct wordt blootgesteld aan Cu-metaal. Dit wordt ook vermeden bij apparaten met CL-ES-structuur. Het kanaalgebied van de a-IGZO-nanofilm wordt goed beschermd door ESL-nanomasker. De lage chemische verontreiniging in het CL-ES-proces kan leiden tot een lage carrier-trapdichtheid op het grensvlak tussen a-IGZO-nanolaag en isolatorlaag, wat resulteert in een uitstekende SS-waarde. Deze lage chemische contaminatie van a-IGZO-gebaseerd TFT-apparaat via CL-ES-proces helpt ook de uniformiteit en reproduceerbaarheid van a-IGZO TFT te verbeteren, die zeer belangrijk zijn in industriële productie [27, 28].
Afbeelding 5 toont de gemeten IV-karakteristiek van TFT's met CL-ES-structuur en BCE-structuur afgeleid van 42 meetpunten op een 8,5 generatie substraat. a-IGZO-gebaseerde TFT met CL-ES-structuur heeft een V de bereik van 0,72 V, terwijl dat van een BCE-gestructureerd apparaat 2,14 V is (tabel 1). Met andere woorden, de uniformiteit van de apparaatprestaties wordt aanzienlijk verbeterd door de CL-ES-structuur.
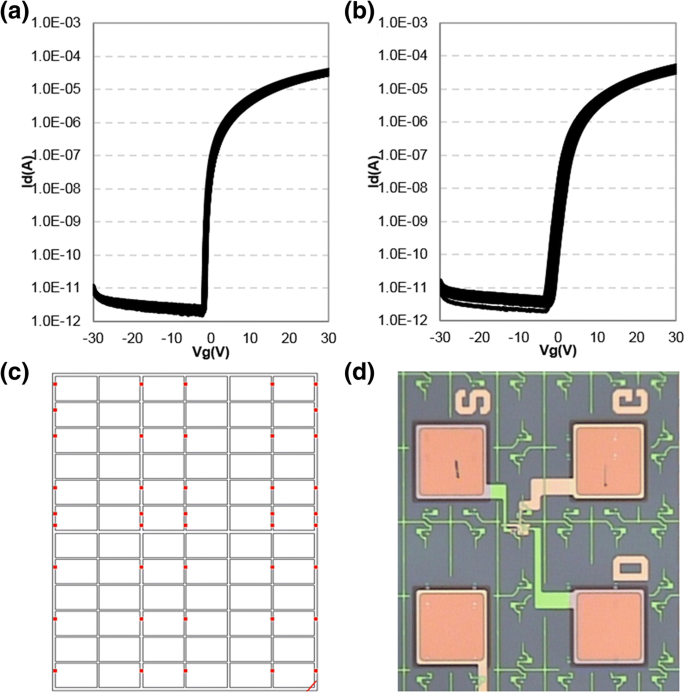
(Online kleuren) a CL-ES-structuur. b De TFT's IV-overdrachtskarakteristiek van de BCE-structuur. c 42 meetpunten. d de foto van TFT. Allemaal gemeten op een substraat van 8,5 generatie
Afbeelding 6a, b tonen de I-V-karakteristieke verschuiving van respectievelijk CL-ES-gestructureerd apparaat en BCE-gestructureerd apparaat verkregen in NBTIS-tests. De NBTIS-testresultaten zijn samengevat in Tabel 2. Onder de stressconditie beschreven in Tabel 2, de V de verschuiving van CL-ES-gestructureerd apparaat en BCE-gestructureerd apparaat zijn respectievelijk − 0,51 en − 3,88 V. Bovendien zijn de huidige shift, off-current shift en SS-waardevariantie van het CL-ES-gestructureerde apparaat allemaal lager dan die van het BCE-gestructureerde apparaat (tabel 2); dit komt omdat een op IGZO gebaseerd apparaat met CL-ES-structuur de besmetting van a-IGZO effectief kan voorkomen en een lagere dragervaldichtheid van een IGZO TFT-kanaal. Vooral als we kijken naar het resultaat van de eerste 1000 s van stress, wordt er geen verandering in de SS-waarde waargenomen in een CL-ES-gestructureerd apparaat. Dit fenomeen is vergelijkbaar met de toename van 0,16 V/dec in SS-waarde van een BCE-gestructureerd apparaat, omdat het laat zien dat defecte locaties, die dragervallen kunnen vormen op het oppervlak van een IGZO-nanofilm die het CL-ES TFT-achterkanaal vormt, worden niet extra gecreëerd door elektrische en verlichtingsstress. Deze resultaten bewijzen volledig dat een CL-ES-gestructureerd apparaat veel stabieler is dan een BCE-gestructureerd apparaat. Afbeelding 6c, d toont de IV-curveverschuiving van CL-ES- en BCE-gestructureerde TFT's verkregen uit PBTS-tests. De gedetailleerde PBTS-testresultaten zijn samengevat in tabel 3. Zowel CL-ES-gestructureerde TFT als BCE-gestructureerde TFT zijn afgenomen in ionenstroom tijdens PBTS-evaluatie. Dit wordt veroorzaakt door de verschuiving in V de naar de positieve richting. Tijdens PBTS-evaluatie, resterende ionenstroomverhouding [(laatste ion/initiële ion) × 100] van de CL-ES-gestructureerde TFT met relatief kleinere V de positieve verschuiving (+-1,94 V) ligt op het niveau van 88,2%. In vergelijking met de BCE-gestructureerde TFT's resterende ionenstroomverhouding van 41,3%, is CL-ES-gestructureerde TFT aanzienlijk superieur. Dit toont het belangrijke capaciteitsverschil tijdens het ontwerpen van een gate drive on array (GOA) circuit. Anders dan NBTIS, vertoont de SS-waarde van CL-ES-gestructureerde TFT geen significante variatie ((∆SS 0,06 V/dec), of liever afname (∆SS − 0,86) zoals bij BCE-gestructureerde TFT. Dit is misschien te wijten aan de dragers, accumuleren in de binnenruimte en interface tussen gate-isolator en a-IGZO nanofilm door positieve gate-bias, waardoor de carrier-trap-plaats in een vroeg stadium wordt gevuld, waardoor het carrier-trap-fenomeen afneemt. Bovendien treedt het fenomeen van de drempelspanningsverschuiving op door dragerlading gevangen in de buurt van de interface tussen poortisolator en a-IGZO nanofilm Een kleine drempelspanningsverschuiving van CL-ES-gestructureerde TFT geeft aan dat de interface en de binnenruimte van a-IGZO opmerkelijk schoon zijn. suggereert dat de structuur en het proces van de CL-ES leiden tot een betere betrouwbaarheid van het apparaat.

(kleur online) I-V overdrachtskarakteristiek drift van CL-ES (a , c ) en BCE (b , d ) TFT verkregen van NBITS (a , b ) en PBTS-testen (c , d )
Conclusies
Kortom, een nieuw ontwikkeld CL-ES-proces is met succes ontwikkeld om een op IGZO gebaseerde TFT-backplane te fabriceren met vijf maskers voor geavanceerde weergave. Het CL-ES-proces heeft de voordelen van een etsstop-laagstructuur, terwijl het aantal maskers en soortgelijke apparaatgebieden gelijk blijft aan een BCE-proces, dat het probleem van een groter aantal maskers en bezet gebied in conventionele etsstop-TFT-apparaten overwint . Een nieuw gevormd ESL-nanomasker en een gelijktijdig etsen van een IGZO-nanolaag en S/D-elektrodenanolaag zorgen voor een hoge uniformiteit en stabiliteit van het apparaat voor weergave op grote oppervlakken. Met betrekking tot elektrische prestaties zijn de reproduceerbaarheid en betrouwbaarheid van de apparaatprestaties van een op IGZO gebaseerde TFT met CL-ES-structuur veel beter dan die van een BCE-gestructureerd apparaat. Het op a-IGZO gebaseerde TFT-apparaat heeft een V de verdeling over 42 meetpunten TFT's op het 8.5 generatie glassubstraat van 0,72 V, verzadiging elektronenmobiliteit van 8,05 cm 2 /V s en SS-waarde van 0,18 V/dec. Volgens de resultaten van de betrouwbaarheidsevaluatie verkregen van NBTIS en PBTS, V de varianties voor en na stress van op CL-ES a-IGZO gebaseerde TFT's zijn respectievelijk -0,51 en 1,94 V na 3600 s stress. De SS-waardevarianties zijn 0,33 en 0,06 V/dec. Daarom zal de gepresenteerde CL-ES-techniek, door de technologische en economische obstakels te overwinnen, de weg vrijmaken voor de volgende generatie producten met hoge resolutie en grote panelen.
Afkortingen
- a-IGZO:
-
Amorf indium-gallium-zink-oxide
- AM-LCD:
-
Actieve matrix liquid crystal display
- BCE:
-
Terug kanaal etch
- ESL:
-
Ets-stoplaag
- GOA:
-
Gate-drive op array
- NBTIS:
-
Negatieve bias temperatuur verlichting stress
- PBTS:
-
Positieve bias temperatuurstress
- SiNx:
-
Siliciumnitride
- SiOx:
-
Siliciumoxide
- SS:
-
Subdrempelzwaai
- TFT:
-
Dunne-filmtransistor
- TN LCD:
-
Twisted nematic liquid crystal display
Nanomaterialen
- Waterloze technologieën gebruiken in het verfproces
- Hardware opstartkeuzeschakelaar met Pico
- Algemene effectiviteit van apparatuur gebruiken
- Strategieën om activaprestaties te beheren
- Activaprestatiebeheer gebruiken om de activawaarde te maximaliseren
- Dip-coating procestechniek en prestatie-optimalisatie voor drie-staten elektrochrome apparaten
- Nanogestructureerde Silica/Gold-Cellulose-Bonded Amino-POSS Hybrid Composite via Sol-Gel Process en zijn eigenschappen
- Vervaardiging van op nanoschaal gebaseerde 3D-periodieke structuren door middel van een sjabloonproces met behulp van van oplossing afgeleid ZnO
- Aanzienlijke verbetering van MgZnO metaal-halfgeleider-metaal fotodetectoren via koppeling met Pt nanodeeltjes oppervlakteplasmonen
- Een 3D-printer gebruiken om uw fabricageproces te verbeteren - Video
- Voordelen van het gebruik van VIA in pads



