Morfologie, structuur en optische eigenschappen van halfgeleiderfilms met GeSiSn-nano-eilanden en gespannen lagen
Abstract
De afhankelijkheid van de tweedimensionale naar driedimensionale groei (2D-3D) kritische overgangsdikte van de samenstelling voor GeSiSn-films met een vast Ge-gehalte en Sn-gehalte van 0 tot 16% bij een groeitemperatuur van 150 °С zijn verkregen . De fasediagrammen van de bovenbouwverandering tijdens de epitaxiale groei van Sn op Si en op Ge(100) zijn gebouwd. Met behulp van de fasediagramgegevens wordt het mogelijk om de Sn-dekking op het Si-oppervlak te identificeren en de Sn-segregatie op de bovenbouw te regelen die wordt waargenomen op het reflectiepatroon met hoge energie-elektronendiffractie (RHEED). De meerlaagse structuren met de pseudomorfe GeSiSn-lagen en de eilandarray met een dichtheid tot 1,8 × 10 12 cm −2 zijn gegroeid met inachtneming van de Sn-segregatie-onderdrukking door de afname van de GeSiSn- en Si-groeitemperatuur. De dubbeldomein (10 × 1) bovenbouw gerelateerd aan de aanwezigheid van Sn op het oppervlak werd voor het eerst waargenomen in de meerlaagse periodieke structuren tijdens Si-groei op de GeSiSn-laag. De periodieke GeSiSn / Si-structuren toonden de fotoluminescentie in het bereik van 0,6-0,85 eV, wat overeenkomt met het golflengtebereik van 1,45-2 μm. De berekening van het bandendiagram voor de structuur met de pseudomorfe Ge0.315 Si0,65 Sn0,035 lagen maakt het mogelijk aan te nemen dat fotoluminescentiepieken overeenkomen met de interbandovergangen tussen de X vallei in Si of de Δ4 -vallei in GeSiSn en de subband van zware gaten in de GeSiSn-laag.
Achtergrond
De effectieve lichtgevende apparaten werden niet gepresenteerd omdat Si de halfgeleider is met de indirecte bandgap, hoewel de siliciumfotonica-apparaten, zoals golfgeleiders [1], fotodetectoren [2] en modulatoren [3] met succes zijn gemaakt.
De Sn-toevoeging in de matrix van de vaste oplossing van Ge, Si of GeSi is een van de benaderingen voor het verkrijgen van de directe bandgap-halfgeleider die is gebaseerd op de IV-groepmaterialen. De opname van Sn in het Ge-rooster verkleint het verschil tussen de minima van Г en L valleien, en GeSn kan een direct bandgap-materiaal worden. Zoals werd aangetoond, ontstaat de directheid voor het GeSn-kubusrooster bij het Sn-gehalte van ongeveer 9% [4, 5]. Deze waarde kan lager zijn dan 6% in aanwezigheid van de trekrek, terwijl voor films met een compressieve rek de overgang kan worden verwacht voor het Sn-gehalte van meer dan 11% [6]. De vermindering van de bandgap als gevolg van de opname van Sn maakt het mogelijk om de golflengte te vergroten van het nabije tot middelste infraroodbereik, wat wenselijk is op het gebied van optische onderlinge verbindingen, in nieuwe generatie glasvezelcommunicatiesystemen, sensoren, signaalverwerking, energieconversie en optische opslagapparaten [7]. Daarom is de interesse voor de klasse van Ge-Si-Sn-materialen de afgelopen jaren aanzienlijk toegenomen.
Grote inspanningen worden gebundeld om de epitaxiale GeSn-films van instrumentale kwaliteit te verkrijgen [8, 9]. Een van de ernstige problemen is de vorming van Sn-insluitingen (precipitaten) tijdens de groei van de GeSn-laag [10, 11]. Naast precipitatie wordt Sn-segregatie waargenomen in het proces van GeSn, GeSiSn-laaggroei en GeSn-filmoxidatie [11, 12]. Niet-evenwichtsgroeitechnieken, zoals de moleculaire bundelepitaxie (MBE) en chemische dampafzetting (CVD), dienen betrouwbare methoden voor het onderdrukken van precipitatie en segregatie. Om het effect van Sn-precipitatie en -segregatie te verminderen, kan de groeitemperatuurdaling [13] of de deformatie-insluiting, of de toevoeging van het derde element, bijvoorbeeld Si, dat de lokale spanning rond de Sn-atomen vermindert, worden uitgevoerd.
De gegevens over morfologie en oppervlaktestructuur of over de vormingsmechanismen van monokristallijne GeSiSn-films worden praktisch niet gevonden in de literatuur, ondanks een grote belofte van de materialen op basis van groep IV-verbindingen. Deze gegevens zijn nodig voor het creëren van nanoheterostructuren met gespannen en ontspannen GeSiSn-lagen. In dit artikel worden de gegevens met betrekking tot het creëren van meerlaagse structuren, superroosters, niet alleen met pseudomorfe GeSiSn-lagen maar ook met GeSiSn-nano-eilanden, eerst gedemonstreerd, en ze bevatten geen dislocaties en maken het mogelijk de bandbreedte van het materiaal in een breed bereik te variëren. en bestrijken het infrarode golflengtebereik dat voorheen niet beschikbaar was voor GeSi.
Het doel van dit artikel is om de elastisch gestresste pseudomorfe GeSiSn-filmgroei, driedimensionale nano-eilandvorming te bestuderen en om de meerlagige periodieke structuren te verkrijgen die pseudomorfe GeSiSn-lagen en nano-eilanden bevatten.
In onze eerdere artikelen [14,15,16] werden de kinetische diagrammen van de morfologische GeSiSn-filmtoestand geconstrueerd voor verschillende roosterparametermismatches tussen GeSiSn en Si in het Sn-gehalte van 0 tot 8% met behulp van de reflectieve hoogenergetische elektronendiffractie ( RHEED). Dit artikel bevat nieuwe kritische tweedimensionale naar driedimensionale groei (2D-3D) overgangsdikte-afhankelijkheden van de GeSiSn-filmsamenstelling met een vast Ge-gehalte in het Sn-gehalte van 0 tot 16%. De fasediagrammen van de bovenbouwverandering tijdens de groei van Sn op Si en Ge(100) werden verkregen. Ondanks het feit dat in [17,18,19], Sn oppervlaktereconstructies op Si werden bestudeerd bij de verschillende blikken deksels, toonden onze gegevens nieuwe superstructuren aan. Bovendien is het fasediagram van de bovenbouwverandering tijdens de Sn-groei op Ge(100) nergens eerder gepresenteerd. De optische eigenschappen van meerlagige periodieke structuren, waaronder pseudomorfe GeSiSn-lagen, werden eerst bestudeerd met de fotoluminescentiemethode voor monsters met verschillende Sn-gehalten. De banddiagramberekening van GeSiSn/Si-heterostructuren werd uitgevoerd met behulp van de model-solid theory-benadering [20].
Experimenteel
Alle monsters met pseudomorfe GeSiSn-lagen en met GeSiSn-nano-eilanden werden gekweekt onder ultrahoge vacuümomstandigheden 10 −7 –10 −8 Pa op moleculaire bundel epitaxie (MBE) apparatuur "Katun C." De epitaxiale groeikamer heeft de elektronenstraalverdamper voor Si en de Knudsen-effusiecellen voor Ge en Sn. De groeisnelheid van de GeSiSn-laag werd gevarieerd van 0,015 tot 0,05 nm/s. De epitaxiale groei werd uitgevoerd op Si(100)-substraten in het temperatuurbereik van 150-450 ° C met een Sn-gehalte van 0 tot 20%. Niet alleen enkele GeSiSn-lagen, maar ook meerlagige periodieke structuren, die GeSiSn/Si-heterojuncties bevatten, werden verkregen. Eerst werd de GeSiSn-laag afgezet, die vervolgens werd bedekt door een Si-laag van 10 nm bij een groeitemperatuur van 400-500 ° . De belangrijkste techniek om de veranderingen in morfologie en oppervlaktestructuur te beheersen en de groeimechanismen te onderzoeken, was reflectie van hoogenergetische elektronendiffractie (RHEED). Het RHEED-patroon werd tijdens de groei vastgelegd op een videocamera. Vervolgens werd een profiel gekozen, samen met een van de kristallografische richtingen, en werden de intensiteitsveranderingen van dit profiel in ruimte-tijdcoördinaten gemaakt. De RHEED ruimte-tijd intensiteitsverdelingsanalyse stelde ons in staat om de mechanismen van tweedimensionale groei, veranderingen in de bovenbouw en driedimensionale eilandvorming te bestuderen. Het moment van de overgang van de tweedimensionale naar de driedimensionale groei (2D-3D-overgang) werd bepaald uit de tijdsafhankelijkheid van de RHEED-patroonintensiteit samen met een van de staven in de richting waarin de volumereflex verschijnt. De afhankelijkheid van kritische 2D-3D-overgangsdikte van het GeSiSn-gehalte met een vast Ge-gehalte werd gecreëerd op basis van de methode van 2D-3D-overgangsbepaling. Op basis van deze afhankelijkheden werd de GeSiSn-pseudomorfische laagdikte ingesteld in meerlaagse structuren en werden lagen met een GeSiSn-nano-eilandarray gecreëerd. De morfologie en oppervlaktestructuur werden geanalyseerd door scanning tunneling microscopie (STM) op ultrahoogvacuümapparatuur Omicron-Riber. De optische eigenschappen van het monster werden bestudeerd door fotoluminescentie (PL) spectroscopie met behulp van een ACTON 2300i monochromator en een gekoelde OMA-V-detector op basis van de InGaAs-fotodiode-array met een gevoeligheidsband van 1,1 tot 2,2 m. Om fotoluminescentie op te wekken, werd de Nd:YAG-laserstraling (532 nm) gebruikt.
Resultaten en discussie
De dunne GeSiSn-filmgroei bij een temperatuur van 150 °С in het Sn-gehalte van 0 tot 16% werd bestudeerd. De spanningsaccumulatie vindt plaats tijdens de GeSiSn-laagafzetting veroorzaakt door de mismatch tussen de GeSiSn- en Si-roosterparameter. De overgang van 2D-3D overgang wordt waargenomen bij een bepaalde dikte. De procedure voor het bepalen van de 2D-3D-overgang op het voorbeeld van de Ge0.6 Si0,28 Sn0,12 groei wordt weergegeven in Fig. 1. Er zijn de initiële RHEED-patronen van het Si-oppervlak vóór de Ge0.6 Si0,28 Sn0,12 filmafzetting (Fig. 1a), het uiteindelijke RHEED-patroon (Fig. 1c) gevormd door de Ge0.6 Si0,28 Sn0,12 eilandarray en de bevochtigingslaag, evenals de ruimte-tijd-intensiteitsverdeling van het verticale profiel aangegeven door de pijl in Fig. 1a en de afhankelijkheid van de horizontale profielintensiteit (horizontaal profiel aangegeven op de ruimte-tijd-intensiteitsverdeling in Fig. 1b) op de Ge0.6 Si0,28 Sn0,12 filmdikte (Fig. 1b). Het 2D-3D-overgangsmoment werd bepaald door de raaklijn aan de intensiteitsgrafiek op de dikte (figuur 1b) in het gebied van een scherpe intensiteitstoename uit te zetten. Een dergelijke benadering is algemeen aanvaard [21].
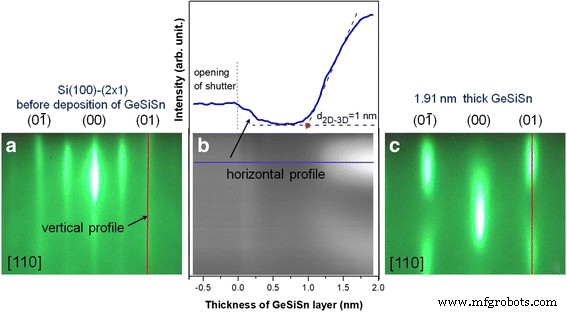
2D-3D-overgangsmomentbepaling tijdens de GeSiSn-filmgroei:a RHEED-patroon van het Si(100)-(2 × 1) oppervlak vóór de Ge0.6 Si0,28 Sn0,12 groei wordt getoond, b de ruimte-tijd intensiteitsverdeling van het verticale profiel in de grijsschaal en de intensiteitsafhankelijkheid van het horizontale profiel op het afgezette Ge0.6 Si0,28 Sn0,12 film dikte. De profielen worden aangegeven door de pijlen in (a ) en (b ), en c het uiteindelijke RHEED-patroon na de 1,91 nm dikke Ge0,6 Si0,28 Sn0,12 afzetting
De afhankelijkheid van de kritische 2D-3D-overgangsdikte van de compositie voor GeSiSn-films met een vast Ge-gehalte en een Sn-gehalte van 0 tot 16% zijn gebouwd (Fig. 2) met behulp van de hierboven beschreven 2D-3D-overgangstechniek. Eerder werden de kinetische diagrammen voor de morfologische toestand van GeSiSn-films in het temperatuurbereik van 150-450 ° C, bij een ander roostermismatch tussen GeSiSn en Si, gepubliceerd [14]. Op basis van kinetische diagramanalyse werd de optimale temperatuur van 150 °С bepaald, waarbij de kritische 2D-3D-overgangsdikte zijn maximale waarde bereikt en de Sn-segregatie wordt onderdrukt. De GeSiSn-filmdiktewaarde onder de curve die overeenkomt met de kritische 2D-3D-overgangsdikte op de temperatuur en samenstelling bepaalt het gebied van het bestaan van pseudomorfe films. De afname van de kritische 2D-3D-overgangsdikte, met de toename bij het Sn-gehalte van 0 tot 16% wordt waargenomen op de curven (Fig. 2). Dergelijk gedrag wordt verklaard door het spanningseffect. De toename van het Sn-gehalte van 0 naar 16%, bijvoorbeeld de Ge0.6 Si0,28 Sn0,12 groei, resulteert in de opkomst van de roosterparameter mismatch tussen Ge0.6 Si0,28 Sn0,12 en Si van respectievelijk 2,5 tot 5,6%, en de tijd en bijgevolg de overgangsdikte naar driedimensionale nano-eilanden te verminderen. De aard van het kenmerk dat op de curve verschijnt met het 30% Ge-gehalte en wordt waargenomen bij het Sn-gehalte van 3 tot 10% tot het einde is volledig niet duidelijk. Als we de grootte van de kritische 2D-3D-overgangsdikte kennen, is het mogelijk om de pseudomorfe GeSiSn-films te verkrijgen en deze te gebruiken in de meerlagige periodieke structuren met de GeSiSn/Si-heterojunctie. In onze experimenten is de nauwkeurigheid van het bepalen van de kritische 2D-3D-overgangsdikte 0,06 nm en wordt deze voornamelijk bepaald door de onnauwkeurigheid van het handhaven van de Si-stroomsnelheid vanwege de instabiliteit van de bronwerking.
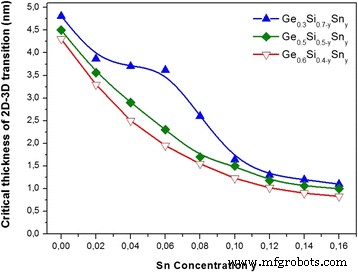
De kritische 2D-3D-overgangsdikte hangt af van de GeSiSn-filmsamenstelling bij verschillende vaste waarden van het Ge-gehalte, het Sn-gehalte van 0 tot 16% en bij de groeitemperatuur van 150°С
De keuze van de pseudomorfe laagdikte op basis van de eerder verkregen kinetische diagrammen [16] en de afhankelijkheid van de kritische 2D-3D-overgangsdikte van de compositie (Fig. 2) maakt het mogelijk om niet alleen afzonderlijke GeSiSn-lagen te laten groeien, maar ook om deze lagen te gebruiken in meerlagige periodieke structuren. In de periodieke GeSiSn/Si-structuur, waar de GeSiSn-laag wordt bedekt door de Si-laag, ontstaat het probleem vanwege de Sn-segregatie op het Si-oppervlak. De Sn-segregatie leidt tot de oppervlaktereconstructie en het verschijnen van de hele reeks superstructuren, afhankelijk van de Sn-oppervlakteconcentratie. Het onderzoek van de oppervlaktereconstructie tijdens de Sn-groei op Si(100) en Ge(100) was nodig om te begrijpen welke Sn-coating overeenkomt met de bovenbouw die is waargenomen in de RHEED-foto. De fasediagrammen van de verandering van de bovenbouw werden gebouwd in het temperatuurbereik van 100-750 ° . Een soortgelijk diagram voor de Sn-groei op Si(100) werd voor het eerst gepresenteerd in [17]. Ueda et al. afgezet Sn bij kamertemperatuur gevolgd door uitgloeien. Ze observeerden de bovenbouw pas na het uitgloeien van de film. In onze experimenten werd Sn afgezet bij een temperatuur van 100 ° C en werd het verkregen op het gereconstrueerde Si(100–(2 × 1) oppervlak. De temperatuurstijging tot 750 °С resulteerde in de vorming van de bovenbouwreeks op de oppervlak (Fig. 3). Het positie-effect van geadsorbeerde Sn-atomen op het Si(100)-oppervlak op de Sn-Si-bindingsenergie werd bestudeerd door de foto-elektronenspectroscopie in [18]. De afname van de Sn-Si-bindingsenergie werd waargenomen met de Toename van de Sn-dekking. Daardoor kunnen alle reconstructies, die optreden tijdens de Sn-groei op Si(100), worden verklaard door een afname van de energie van het oppervlaktesysteem. De overgang naar de driedimensionale groei wordt geassocieerd met de accumulatie van spanningen als gevolg van de roosterparameter mismatch tussen Sn en Si van 19% Het uiterlijk van de polykristallijne film werd waargenomen in [17] bij de 3,2 ML (monolaag) Sn dikke film. De vorming van polykristallijne film wordt veroorzaakt door een lage afzettingstemperatuur van de Sn-film. Dezelfde redenering is gerelateerd aan de Sn groei op het Ge(100)-oppervlak. Op dit moment zijn bijdragen over de Sn-superstructuren op Ge(100) niet in de literatuur vermeld.

Fasediagrammen van de verandering van de bovenbouw tijdens de groei:a Sn op Si(100) en b Sn op Ge(100)
De bovenbouw aangegeven in de diagrammen verschijnen zowel met de temperatuurstijging als -daling. Deze fasediagrammen helpen bij het bepalen van de Sn-concentratie op het oppervlak bij de Si-groei over de GeSiSn-laag. De superstructuren die tijdens de periodieke structuurgroei op het Si-oppervlak verschijnen, kunnen worden waargenomen bij de temperaturen die verschillen van de temperaturen weergegeven in de fasediagrammen. De Si-laag wordt afgezet op het GeSiSn-oppervlak bij temperaturen van 400-500 °С; de bovenstructuren die kenmerkend zijn voor het hele temperatuurbereik dat in Fig. 3 wordt weergegeven, kunnen echter verschijnen. Het creëren van de structuur met GeSiSn / Si-heterojuncties vereist het voorkomen van de vorming van de twee-domein (5 × 1) bovenbouw, die wordt geassocieerd met de Sn-segregatie en de obstructie in de meerlaagse periodieke structuurvorming met de pseudomorfe lagen (Fig. 4a ). De eenvoudigste manier om Sn-segregatie bij de Si-groei over de GeSiSn-laag te onderdrukken, is de Si-groei in twee fasen. De eerste fase omvat de 1-2 nm dikke Si-laagafzetting bij kamertemperatuur. De verdere Si-groei gaat door bij een temperatuur van 400-500 ° . Deze temperatuur wordt bepaald door het Sn-gehalte in de GeSiSn-laag. De belangrijkste bovenbouwreeksen die optreden tijdens de Si-groei op de GeSiSn-laag in meerlagige periodieke structuren bestaan uit (2 × 1) + (2 × N), c(8 × 4), (4 × 1), (6 × 1) , en (5 × 1). Bovendien wordt de bovenbouw met twee domeinen (10 × 1) waargenomen op het Si-oppervlak (figuur 4b). Deze bovenbouw kwam niet voor in de experimenten bij de Sn-groei op Si en Ge, maar er kan worden gezegd dat deze overeenkomt met de minimale Sn-coating aangezien deze verdwijnt tijdens een korte gloeiing bij een temperatuur van 400-500 °С en de (2 × 1) bovenbouw verschijnt, wat kenmerkend is voor het Si-oppervlak.

Superstructuren waargenomen bij de Si-groei op de GeSiSn-laag in de meerlaagse periodieke structuur in de azimutale [110] richting:a (5 × 1) en b (10 × 1)
Er werden periodieke structuren verkregen, die pseudomorfe lagen of een GeSiSn-nano-eilandarray bevatten. Met behulp van de kinetische diagrammen van de morfologische toestand van de GeSiSn-film werd een GeSiSn-eilandarray in de meerlaagse periodieke structuur onderzocht. De STM-foto's van Ge0.75 Si0,2 Sn0,05 oppervlak met de nano-eilandarray in de eerste (Fig. 5a) en in de vijfde periode (Fig. 5b) met een scangrootte van 400 nm × 400 nm worden gepresenteerd. De eilandreeks werd verkregen bij een groeitemperatuur van 250 °С. De histogrammen van de verdeling van eilandnummers in grootte worden ook getoond in Fig. 5. De eilanden met een dichtheid van 5,18 × 10 11 cm −2 en gemiddelde grootte 8,95 nm worden weergegeven in Fig. 5c. De gedeponeerde Ge0,75 Si0,2 Sn0,05 filmdikte was 1,78 nm. De gemiddelde eilandgrootte in de vijfde periode is ongeveer 4 nm en de eilanddichtheid bereikt 1,8 × 10 12 sm −2 bij een effectieve dikte van Ge0,75 Si0,2 Sn0,05 film 1,89 nm, en volgt uit het histogram in Fig. 5d. Een toename van de dichtheid met een factor 3,5 en een afname van de eilandgrootte met een factor 2 kan verband houden met de toenemende Sn-fractie op het Si-oppervlak met een toename van het periodegetal. Deze verklaring wordt bevestigd door de verandering in superstructuren, waargenomen door het RHEED-patroon tijdens de Si-filmgroei over de GeSiSn-laag, van (2 × 1) en (2 × N) naar de c(8 × 4) oppervlaktestructuur. De vorming van c(8 × 4) bovenbouw vindt plaats tijdens het proces van Sn-groei op Si, uitgaande van de deklaagdikte van 0,4 monolaag (ML) bij groeitemperatuur 400 °С. Met de dalende groeitemperatuur tot 100 °С kunnen we de eilanddichtheid verhogen, maar de oppervlaktekwaliteit is slechter. Een stijging van de groeitemperatuur tot meer dan 250 °С verbetert de Sn-segregatie. Het optimale groeitemperatuurbereik van GeSiSn-lagen met de eilandarray is dus 150-250 °С, waarbij spiegelende reflectie-oscillaties worden waargenomen bij de GeSiSn-bevochtigende laaggroei, wat overeenkomt met het 2D-groeimechanisme.

STM-afbeeldingen van de Ge0,75 Si0,2 Sn0,05 oppervlak met een scangrootte van 400 nm × 400 nm:a de Ge0,75 Si0,2 Sn0,05 oppervlakte in de eerste periode, b de Ge0,75 Si0,2 Sn0,05 oppervlakte in de vijfde periode; de distributiehistogrammen voor het aantal eilanden op de grootte van de basis voor de Ge0,75 Si0,2 Sn0,05 film:c in de eerste periode (de Ge0,75 Si0,2 Sn0,05 filmdikte is gelijk aan 1,78 nm) en d in de vijfde periode (de Ge0,75 Si0,2 Sn0,05 filmdikte is gelijk aan 1,89 nm)
De kristallijne perfectie van een meerlaagse structuur werd bestudeerd met transmissie-elektronenmicroscopie (TEM). De TEM-afbeeldingen voor een meerlagige structuur met de Ge0.5 Si0,45 Sn0,05 /Si heterojunctie en een periode van 25 nm worden getoond in Fig. 6. Uit de TEM-gegevens kan worden geconcludeerd dat onze monsters geen dislocaties met schroefdraad bevatten en kristallijn perfect zijn met scherpe interfaces. De pseudomorfe GeSiSn-filmtoestand in een meerlagige periodieke structuur, het kristalrooster en stammen worden besproken in [14] op basis van de met behulp van TEM verkregen data-analyse. De samenstelling van de GeSiSn-film werd bepaald door Si-, Ge- en Sn-stromen in te stellen. De groeisnelheden van Si, Ge en Sn werden gemeten met een kwartsdiktemeter. De samenstelling van de GeSiSn-film werd geïdentificeerd door röntgendiffractometrie. De analyse toonde het samenvallen van zowel de ingestelde als gemeten composities.
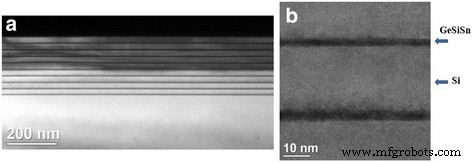
een TEM-afbeelding van de meerlaagse structuur inclusief de Ge0.5 Si0,45 Sn0,05 heteroovergang met de 25-nm periode. b TEM-beeld met hoge resolutie van dezelfde structuur
De optische eigenschappen van meerlagige periodieke structuren met GeSiSn-lagen werden onderzocht door fotoluminescentie voor structuren met verschillende Sn-gehalten. De structuren vertoonden hun fotoluminescentie in het bereik van 0,6-0,8 eV, wat overeenkomt met het golflengtebereik van 1,45-2 m (figuur 7). De fotoluminescentiespectra met de intensiteitsmaxima bij 0,78, 0,69 en 0,65 eV werden verkregen. Ze komen overeen met de golflengten van 1,59, 1,8 en 1,9 m en worden waargenomen bij respectievelijk 3,5, 4,5 en 6% Sn. De toename van het Sn-gehalte in de GeSiSn-laag leidt tot zowel de energieafname van optische overgangen als de toename van de fotoluminescentie-intensiteit. De intensiteitstoename kan worden veroorzaakt door de dieptetoename van de kwantumput voor een hoger Sn-gehalte in de GeSiSn-vaste oplossingslaag. Om verder te gaan in het golflengtebereik van meer dan 2 μm, is een toename van het Sn-gehalte in GeSiSn-lagen vereist. Om de optische overgangen te bepalen die zijn waargenomen in de luminescentiespectra, was het noodzakelijk om het banddiagram van de GeSiSn/Si-heterostructuur te berekenen.

De fotoluminescentiespectra van meerlagige periodieke structuren met het Sn-gehalte van 3,5, 4,5 en 6% in de pseudomorfe GeSiSn-lagen
Het GeSiSn/Si-heterostructuurbanddiagram werd berekend met behulp van de model-solid-theorie [20]. Binnen dit model moeten beide halfgeleiders die de heterojunctie vormen, op de enkele "energie" -schaal worden gezet om de bandpositie in de heterojunctie te bepalen. De valentiebandgap-waarde voor Ge/Si-heterostructuren in de heterojunctie is bekend [22] en is gelijk aan 0,54 eV; bovendien ligt de Ge-valentieband hoger op de energie dan de Si-valentieband. De bandgap tussen Ge en Sn is bekend uit het model gepresenteerd in [23] en is 0,69 eV [24]. Dus de bandgap-waarde op de heterointerface voor de Si/Si 1-x-y Ge x Sn y heterostructuur kan worden geschreven als:
$$ {E}_{v, av}=0,54x+1,23j $$Aangezien de halfgeleidervalentieband wordt gevormd door de subbanden van zware en lichte gaten, en ook door de subband die wordt afgesplitst door de spin-baaninteractie; vervolgens de positie van de valentieband (E v,av ) gemiddeld in de drie subbanden wordt gebruikt om de bandgap en constructie van het heterostructuurbanddiagram te bepalen. Om de subbandpositie voor zware en lichte gaten te bepalen, evenals de subband die wordt afgesplitst door de spin-baaninteractie, worden de volgende uitdrukkingen gebruikt:
$$ {\displaystyle \begin{array}{l}{E}_{\mathrm{HH}\left(\mathrm{LH}\right)}={E}_{v, av}+{\Delta} _0/3\\ {}{E}_{\mathrm{SO}}={E}_{v, av}-2/3{\Delta}_0\end{array}}, $$waarbij de HH-, LH- en SO-indexen de subbanden voor zware en lichte gaten aangeven, evenals de spin-gesplitste subband. De Δ0 waarde geeft de spin-baan splitsingsenergie in de halfgeleider aan. Na het bepalen van de subbandpositie van de valentieband in de heterojunctie, worden de posities van de overeenkomstige geleidingsbanddalen bepaald met behulp van de uitdrukking:
$$ {E}^n={E}_{\mathrm{Ge}}^n\left(1-xy\right)+{E}_{\mathrm{Si}}^nx+{E}_{\ mathrm{Sn}}^ny-{b}_{\mathrm{Si}\mathrm{Ge}}^nx\left(1-xy\right)-{b}_{\mathrm{Sn}\mathrm{Ge }}^ny\left(1-xy\right)-{b}_{\mathrm{Si}\mathrm{Sn}}^n xy, $$waar indexen n = Γ , L , en X geef de bijbehorende dalen aan \( {b}_{\mathrm{SiGe}}^n \), \( {b}_{\mathrm{SnGe}}^n \), en \( {b}_{\mathrm {SiSn}}^n \)––“buiging” parameters, rekening houdend met de afwijking van de lineaire wet voor de bandbreedte, \( {E}_{\mathrm{Ge}}^n \),\( { E}_{\mathrm{Si}}^n \), en \( {E}_{\mathrm{Sn}}^n \)––Ge, Si en Sn bandhiaten in de corresponderende vallei. Vrijwel alle parameters zijn overgenomen uit [24]. De buigingsparameters voor valleien L en Г zijn afkomstig uit [25].
Na het bepalen van de positie van alle interessebanden in de heterojunctie, hebben we rekening gehouden met hun verplaatsing onder invloed van vervormingen. De invloed van vervormingen op de bandgap werd in rekening gebracht door middel van vervormingspotentiaalconstanten [26]. Omdat de tweedimensionale lagen pseudomorf waren, werd in ons geval de standaardbenadering gebruikt om vervormingen te bepalen die bijvoorbeeld wordt beschreven in [26]:spanningen in een kwantumputvlak kunnen worden bepaald uit ε xx(yy) = ε ǀǀ = (een GeSiSn − een Si )/een Si , waar a ––de roosterconstante van het corresponderende materiaal. In de richting, die loodrecht staat op het vlak van de kwantumput, rekwaarde ε zz = −2(С 12 /С 11 )ε xx kan worden bepaald via de C 12 en C 11 elastische modules van de kristallijne verbinding. De roosterconstante van de vaste oplossing werd bepaald uit de kwadratische relatie:
$$ {a}_{\mathrm{Ge}\mathrm{SiSn}}={a}_{\mathrm{Ge}}\left(1-xy\right)+{a}_{\mathrm{Si} }x+{a}_{\mathrm{Sn}}y+{b}_{\mathrm{Si}\mathrm{Ge}}^{\hbox{'}}x\left(1-x\right)+{ b}_{\mathrm{Sn}\mathrm{Ge}}^{\hbox{'}}y\left(1-y\right), $$waar a Ge , een Si , een Sn ––Ge, Si en Sn roosterparameters [24], \( {b}_{\mathrm{SiGe}}^{\hbox{'}} \)= − 0.026 Å, \( {b}_{\ mathrm{SnGe}}^{\hbox{'}} \) = 0.166 Å––«buiging» parameters, rekening houdend met de afwijking van de wet van Vegard.
Op basis van de banddiagramberekeningen komen de PL-pieken overeen met de interbandovergangen tussen de X-vallei van Si of de Δ4 -vallei van GeSiSn en de band van het zware gat in de GeSiSn-laag (Fig. 8).
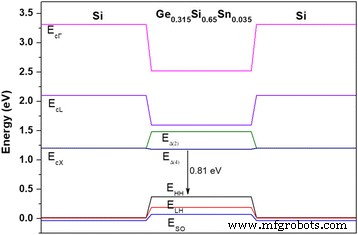
De Si/Ge0.315 Si0,65 Sn0,035 /Si heterocompositie banddiagram
Conclusies
De kritische 2D-3D overgangsdikte-afhankelijkheden van de samenstelling van GeSiSn-lagen met een vast Ge- en Sn-gehalte, variërend van 0 tot 16% bij een groeitemperatuur van 150 °С, werden bepaald. De bovenbouw fasediagrammen voor de epitaxiale groei van Sn op Si(100) en Ge(100) werden gemaakt. De meerlagige periodieke structuren met pseudomorfe lagen en met een GeSiSn-eilandarray met een dichtheid tot 1,8 × 10 12 sm −2 waren verkregen. Voor het eerst werd in de meerlaagse periodieke structuur tijdens de Si-groei op de GeSiSn-laag een (10 × 1) twee-domein bovenbouw waargenomen, die bij een lichte uitgloeiing transformeert in een (2 × 1) bovenbouw. De periodieke structuren van GeSiSn/Si vertoonden hun fotoluminescentie in het bereik van 0,6-0,8 eV, wat overeenkomt met het golflengtebereik van 1,45-2 μm. Gebaseerd op de banddiagramberekeningen voor de structuur met pseudomorf Ge0.315 Si0,65 Sn0,035 lagen, komen de PL-pieken overeen met de interbandovergangen tussen de X-vallei van Si of de Δ4 -vallei van GeSiSn en de heavy-hole band in de GeSiSn-laag. Verdere vooruitgang in het langegolfgebied vereist een onderzoek naar de optische eigenschappen van de structuren met een hoog Sn-gehalte.
Afkortingen
- CVD:
-
Chemische dampafzetting
- MBE:
-
Moleculaire bundelepitaxie
- ML:
-
Monolaag
- PL:
-
Fotoluminescentie
- RHEED:
-
Reflectie hoge energie elektronendiffractie
- STM:
-
Scanning tunneling microscopie
- TEM:
-
Transmissie-elektronenmicroscopie
Nanomaterialen
- Halfgeleider nanodeeltjes
- Structuur en elektronische eigenschappen van met overgangsmetaal gedoteerde kaoliniet nanoklei
- Modulatie van elektronische en optische anisotropie-eigenschappen van ML-GaS door verticaal elektrisch veld
- Eenvoudige synthese en optische eigenschappen van kleine selenium nanokristallen en nanostaafjes
- Optische en elektrische kenmerken van silicium nanodraden bereid door stroomloos etsen
- Invloed van water op de structuur en diëlektrische eigenschappen van microkristallijne en nano-cellulose
- Effecten van dubbellaagse dikte op de morfologische, optische en elektrische eigenschappen van Al2O3/ZnO-nanolaminaten
- De oppervlaktemorfologieën en eigenschappen van ZnO-films afstemmen door het ontwerp van grensvlakken
- Optische en elektronische eigenschappen van door femtoseconde laser-geïnduceerde zwavel-hyperdoped silicium N+/P fotodiodes
- Voorbereiding en optische eigenschappen van GeBi-films met behulp van de moleculaire straal-epitaxiemethode
- Frequentiemodulatie en absorptieverbetering van THz-microbolometer met microbrugstructuur door spiraalvormige antennes



