Atomic-Layer-Deposition van indiumoxide nanofilms voor dunnefilmtransistors
Abstract
Atomic-layer-deposition (ALD) van In2 O3 nanofilms is onderzocht met behulp van cyclopentadienyl indium (InCp) en waterstofperoxide (H2 O2 ) als voorlopers. De In2 O3 films kunnen bij voorkeur worden afgezet bij relatief lage temperaturen van 160-200 ° C, met een stabiele groeisnelheid van 1,4-1,5 /cyclus. De oppervlakteruwheid van de afgezette film neemt geleidelijk toe met de depositietemperatuur, wat wordt toegeschreven aan de verbeterde kristallisatie van de film bij een hogere depositietemperatuur. Naarmate de depositietemperatuur stijgt van 150 tot 200 °C, wordt de optische band gap (Eg ) van de afgezette film stijgt van 3,42 naar 3,75 eV. Bovendien verschuift met de toename van de depositietemperatuur de atomaire verhouding van In tot O in de film zoals gedeponeerd geleidelijk naar die in de stoichiometrische In2 O3 , en het koolstofgehalte neemt ook gradueel af. Voor een depositietemperatuur van 200 °C vertoont de afgezette film een In:O-verhouding van 1:1,36 en geen koolstofopname. Verdere, krachtige In2 O3 dunnefilmtransistors met een Al2 O3 gate-diëlektricum werden bereikt door gedurende een geschikte tijd in lucht bij 300 °C te gloeien, wat een veldeffectmobiliteit van 7,8 cm aantoont 2 /V⋅s, een schommeling onder de drempel van 0,32 V/dec en een stroomverhouding aan/uit van 10 7 . Dit werd toegeschreven aan passivering van zuurstofvacatures in het apparaatkanaal.
Achtergrond
Indiumoxide (In2 O3 ) is een transparante metaaloxidehalfgeleider, die een brede bandafstand van ~3,7 eV bij kamertemperatuur vertoont, een hoge transparantie voor zichtbaar licht en een uitstekende chemische stabiliteit [1, 2]. Daarom, In2 O3 is onderzocht voor verschillende toepassingen, zoals fotovoltaïsche apparaten, elektrochemische sensoren en platte beeldschermen [3,4,5]. Tot dusver zijn er verschillende depositietechnieken ontwikkeld om In2 . voor te bereiden O3 dunne films, waaronder sputteren [6, 7], sol-gel [8, 9] en chemische dampafzetting (CVD) [10, 11]. De technieken van sputteren en sol-gel hebben echter gewoonlijk te lijden van een slechte uniformiteit over een groot gebied en een onnauwkeurige elementaire samenstelling; de CVD-techniek vereist doorgaans relatief hoge depositietemperaturen van> 300 °C. Deze nadelen maken het een uitdaging om een uniforme In2 . te bereiken O3 film met nauwkeurige controle van dikte en samenstelling bij een lage depositietemperatuur.
In de afgelopen jaren is atomic-layer-deposition (ALD) naar voren gekomen als een veelbelovende benadering die uitstekende stapdekking, controleerbaarheid van de dikte op atomaire schaal, goede uniformiteit en een relatief lage depositietemperatuur kan opleveren. Dienovereenkomstig is de groei van In2 O3 dunne films is onderzocht door middel van ALD met verschillende voorlopers, waaronder InCl3 -H2 O [12], InCl3 -H2 O2 [13], InCp-O3 [14], InCp-O2 -H2 O [15], en In (CH3 )3 -H2 O [16]. In termen van de voorlopers van InCl3 -H2 O en InCl3 -H2 O2 , de depositietemperaturen voor In2 O3 films moeten worden verhoogd tot ~ -300-500 ° C [13]; ondertussen, de InCl3 container moet worden verwarmd tot 285 ° C om voldoende InCl3 . te verkrijgen damp [15]. Bovendien kan het bijproduct van bijtend HCl de ALD-apparatuur beschadigen en het afgezette In2 etsen. O3 film [17], en de groeisnelheid van In2 O3 is zo laag als 0,25-0,40 /cyclus. Hoewel andere voorlopers zoals TMIn-H2 O en TMIn-H2 O2 zijn geadopteerd voor ALD In2 O3 films, zijn de depositietemperaturen nog steeds hoog (d.w.z. 200–450 °C) ondanks relatief hoge groeisnelheden (1,3–2 /cyclus) [18].
In dit werk, InCp en H2 O2 werden voorgesteld als de voorlopers van ALD In2 O3 dunne films, dus de In2 O3 dunne films werden met succes afgezet bij lagere temperaturen en vertoonden een bevredigende groeisnelheid. Daarnaast werden de fysische en chemische eigenschappen van de afgezette films gekarakteriseerd. Verder is de In2 O3 dunnefilmtransistors (TFT's) met ALD Al2 O3 gate-diëlektrica zijn vervaardigd, die goede elektrische prestaties aantonen, zoals een veldeffectmobiliteit van 7,8 cm 2 V −1 s −1 , en een aan/uit stroomverhouding van 10 7 enz.
Experimenteel
Si (100)-wafels werden gereinigd met behulp van het standaard Radio Corporation of America-proces, dat als de initiële substraten diende. In2 O3 dunne films werden afgezet op de vooraf gereinigde Si (100)-substraten met behulp van de ALD-apparatuur (Wuxi MNT Micro Nanotech Co., LTD, China) bij relatief lage temperaturen van 150-210 ° C, waarbij de temperaturen van InCp (Fornano Electronic Technology Co., LTD, China, onzuiverheid:99,999%) en H2 O2 Voorlopers van (30% waterige oplossing) werden respectievelijk op 130 en 50°C gehouden. Stikstofgas werd gebruikt als spoelgas. Om de functie van de ALD In2 . te demonstreren O3 dunne film, de In2 O3 -gebaseerde kanaal-TFT's werden gefabriceerd als de volgende processen. Ten eerste een 38-nm Al2 O3 gate diëlektrische film werd gekweekt op een vooraf gereinigd p-type Si (100) substraat (<-0,0015 Ω·cm) bij 200 ° C door ALD met behulp van trimethylaluminium en H2 O, en een dergelijk siliciumsubstraat met een lage soortelijke weerstand diende als de achterpoort. Vervolgens een 20-nm In2 O3 kanaallaag is gegroeid op de Al2 O3 film bij 160 °C. Bron/afvoer-contacten van Ti/Au (30 nm/70 nm) stapels werden op hun beurt gevormd door optische lithografie, elektronenbundelverdamping en een lift-off proces. Ten slotte werden de gefabriceerde apparaten gedurende verschillende tijden bij 300 ° C in lucht gegloeid.
De kristalliniteit, oppervlaktemorfologie, elementaire samenstelling, absorptiecoëfficiënt en dikte van de In2 O3 films werden gekarakteriseerd door röntgendiffractie (XRD) (Bruker D8 Discover), atoomkrachtmicroscopie (AFM) (Bruker Icon), röntgenfoto-elektronspectroscopie (XPS) (Kratos Axis Ultra DLD), ultraviolet-zichtbare spectroscopie (UV- VIS) en ellipsometer (Sopra GES-SE, Frankrijk), respectievelijk. De elektrische metingen van de apparaten werden uitgevoerd met behulp van een halfgeleiderparameteranalysator (B1500A, Agilent Technologies, Japan) met Cascade-sondestation in omgevingslucht bij kamertemperatuur.
Resultaten en discussie
Figuur 1a toont de groeisnelheid van de In2 O3 film als functie van de substraattemperatuur. Er is gevonden dat een stabiele groeisnelheid van ~-1,46 Å/cyclus wordt bereikt in het bereik van 160 ~ -200 °C, wat een snelle groeisnelheid en een goed gedefinieerd temperatuurvenster voor ALD In2 onthult. O3 films. Wanneer de substraattemperatuur werd verlaagd tot 150 °C of verhoogd tot 210 °C, werd de resulterende groeisnelheid groter [19, 20]. Het eerste wordt toegeschreven aan de condensatie van InCp op het substraat, terwijl het laatste het gevolg is van de thermische ontleding van InCp bij een hogere temperatuur. Verder de evolutie van de gedeponeerde In2 O3 filmdikte werd geëvalueerd als een functie van ALD-cycli, zoals getoond in figuur 1b. Het is duidelijk dat de In2 O3 filmdikte neemt lineair toe met het aantal depositiecycli, wat wijst op een vrij uniforme groei.

een Groeisnelheid van ALD In2 O3 film op het Si-substraat als functie van de substraattemperatuur, en b afhankelijkheid van de In2 O3 filmdikte op het aantal ALD-cycli bij 160 °C
Om de evolutie van de In2 . te observeren O3 filmtextuur met depositietemperatuur, de XRD-patronen van de In2 O3 films die bij verschillende temperaturen zijn afgezet, worden weergegeven in Fig. 2. Wanneer de depositietemperatuur niet hoger is dan 160 ° C, kan geen diffractiepiek worden waargenomen. Dit geeft aan dat de gedeponeerde In2 O3 films bij lagere temperaturen zijn amorf. Wanneer de depositietemperatuur stijgt tot 170 °C, beginnen enkele diffractiepieken te verschijnen. Verder, terwijl de depositietemperatuur geleidelijk toeneemt tot 210 °C, nemen de diffractiepiekintensiteiten dramatisch toe, typisch getoond door de pieken bij 2θ =-30,3° en 35,4°. Dit geeft aan dat de kristalliniteit en korrelgrootte van de in de toestand afgezette In2 O3 film worden geleidelijk verbeterd met het verhogen van de depositietemperatuur. Figuur 3 toont de oppervlaktemorfologieën van de vertegenwoordiger In2 O3 films afgezet bij verschillende temperaturen. Het is gebleken dat het filmoppervlak ruwer en ruwer wordt naarmate de depositietemperatuur toeneemt, d.w.z. de resulterende RMS-ruwheid neemt toe van 0,36 tot 1,15 nm bij verhoging van de depositietemperatuur van 160 tot 210 °C. Dit zou gerelateerd moeten zijn aan de kristalliniteit van de In2 O3 film. In termen van de depositietemperatuur van 160 °C, de gedeponeerde In2 O3 film is amorf en vertoont een zeer glad oppervlak. Wanneer de afzettingstemperatuur 180 °C bereikt, wordt de afgezette film polykristallijn. Dit betekent dat de resulterende film veel kristallijne korrels bevat, en de korrelgroottes worden groter en groter naarmate de depositietemperatuur toeneemt, zoals blijkt uit Fig. 2. Dit komt goed overeen met onze waarneming dat de grootte van heuvels op het filmoppervlak geleidelijk toenemen met het verhogen van de depositietemperatuur, wat resulteert in een verhoogde RMS-waarde.
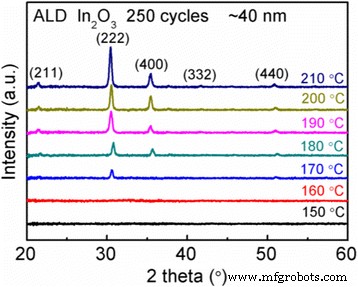
Röntgendiffractiepatronen van de In2 O3 films afgezet bij verschillende temperaturen gedurende 250 cycli

De AFM-beelden van de In2 O3 films afgezet bij verschillende temperaturen:a 160 °C, b 180 °C, c 200 °C en d 210 °C. De afzettingscycli waren vastgesteld op 250 voor elke film
Afbeelding 4 toont hoge resolutie C 1 s, In 3d en O1s XPS-spectra van de In2 O3 films afgezet bij verschillende temperaturen. Met betrekking tot de C 1 s XPS-spectra getoond in Fig. 4a, vertoont de film die is afgezet bij 160 ° C een piek bij 289,8 eV, wat zou moeten overeenkomen met C-O [21]. Wanneer de depositietemperatuur wordt verhoogd tot 180 °C, wordt de piek veel zwakker. Verder, in termen van 200 °C depositietemperatuur, verdwijnt de C 1 s-piek. Er wordt dus aangegeven dat hoe hoger de depositietemperatuur, hoe minder de onzuiverheid van C in het afgezette In2 O3 film. Afbeelding 4b toont de In 3d XPS-spectra van de In2 O3 films, die duidelijk één-doublet Gauss-pieken laten zien bij 444,7 en 452,3 eV, die worden geassocieerd met In 3d5/2 en In 3d5/2 kernniveaus voor In2 O3 [22, 23]. De XPS-spectra van O 1 zijn weergegeven in figuur 4c. Het blijkt dat het O 1 s-spectrum voor elk monster goed kan worden gescheiden in drie pieken, die zich respectievelijk op 529,8, 531,0 en 532,0 eV bevinden. Deze pieken komen overeen met O 2− ionen gebonden met respectievelijk metaal (O1), zuurstofvacatures (O2) en –OH/CO (O3) [24, 25]. Naarmate de depositietemperatuur stijgt van 160 naar 200 °C, stijgt het relatieve percentage O1 van 76 naar 92%; en het relatieve percentage O2 neemt geleidelijk af van 16 naar 4%. Bovendien laat ook het relatieve percentage O3 een dalende trend zien. Deze resultaten geven aan dat een hogere depositietemperatuur gunstig is om de concentratie van zuurstofvacatures in de afgezette film evenals hydroxylgroepen en C−O-bindingen te verminderen. Verder zijn de elementaire composities van de In2 O3 films die bij verschillende temperaturen zijn afgezet, worden weergegeven in tabel 1. Interessant is dat de atoomverhouding van In/O in de afgezette film gradueel afneemt met toenemende depositietemperatuur. Maar zelfs voor de pure In2 O3 film afgezet bij 200 °C, is de atoomverhouding (1:1,36) van In/O nog steeds groter dan die (1:1,5) van de stoichiometrische In2 O3 . Hieruit blijkt dat de ALD In2 O3 film is over het algemeen rijk aan zuurstoftekorten.

Hoge resolutie a C 1s, b In 3D en c O 1 s XPS-spectra van de In2 O3 films afgezet bij respectievelijk 160, 180 en 200 °C. Om onvoorziene oppervlakteverontreinigingen te verwijderen, werden alle monsters gedurende 6 minuten geëtst met in-situ Ar-ionenbombardement voordat het signaal werd verzameld
Afbeelding 5a toont de variatie van (αhν) 2 als functie van fotonenergie voor de as-afgezette In2 O3 films bij verschillende depositietemperaturen. De optische band gap (Eg ) van de In2 O3 film kan worden bepaald door de relatie van Tauc:αhν = A(hν-Eg ) n [26], waar α is de absorptiecoëfficiënt, A is een constante, h is de Plank-constante, ν is de frequentie, en de exponent n karakteriseert de aard van de bandovergang. Hier, n = 1/2, wat aangeeft dat In2 O3 is een halfgeleider met een direct toegestane overgang. E g wordt geëxtraheerd door het rechte lijngedeelte te extrapoleren naar de energiebias bij α = 0. De geëxtraheerde E g voor de In2 O3 film wordt getoond in Fig. 5b. Het is te zien dat E g stijgt van 3,42 naar 3,75 eV met een verhoging van de depositietemperatuur van 150 naar 200 °C. De verhoogde E g bij hogere depositietemperaturen zou het gevolg kunnen zijn van de vermindering van zuurstofvacatures en C-onzuiverheid in de afgezette film. In feite rapporteerden andere onderzoekers ook dat wanneer er veel zuurstofvacatures waren in ZnO, de onzuiverheden meer gedelokaliseerd werden en overlapten met de rand van de valentieband, wat leidde tot vernauwing van de bandgap [27]. Bovendien zou de geleidelijk verhoogde kristalliniteit als functie van de depositietemperatuur de optische bandafstand van de In2 kunnen beïnvloeden. O3 film. Dit kan als volgt worden uitgelegd. Naarmate de depositietemperatuur stijgt, neemt de korrelgrootte van de afgezette In2 O3 film neemt toe, getoond in Fig. 2. Dit leidt dus tot een afname van de dichtheid van korrelgrenzen in de film. Aangezien elektronen gemakkelijk in de korrelgrenzen worden gevangen, zou het aantal vrije elektronen in de In2 moeten toenemen. O3 film met minder korrelgrenzen [28, 29]. Daarom resulteert een dergelijke verhoogde elektronenconcentratie in een grotere optische bandafstand vanwege de Burstein-Moss-verschuiving [30].

een Plotten van (αhν) 2 vs fotonenenergie voor de In2 O3 films afgezet bij verschillende temperaturen; b afhankelijkheid van de geëxtraheerde band gap (Eg ) van In2 O3 op depositietemperatuur
Om de functie van de ALD In2 . te demonstreren O3 film die fungeert als het kanaal van TFT, de In2 O3 -kanaalgebaseerde TFT's met op een atoomlaag gedeponeerde Al2 O3 poortdiëlektrica werden vervaardigd. Afbeelding 6a toont de overdrachtskenmerken van In2 O3 TFT's. Gebleken is dat de als gefabriceerde inrichting niet de schakelkarakteristieken vertoont die typisch zijn voor veldeffecttransistoren, maar een geleiderachtige tussen source en drain. Dit moet worden toegeschreven aan het bestaan van veel zuurstofvacatures in de In2 O3 kanaal omdat zuurstofvacatures vrije elektronen kunnen leveren. Daarom, omwille van het verminderen van de concentratie van zuurstofvacatures in de In2 O3 kanaal, werd nagloeien in lucht uitgevoerd bij 300 ° C. Het is duidelijk dat de In2 O3 TFT vertoont een typisch schakelgedrag na 2 uur gloeien. Dit geeft aan dat het nagloeien in lucht de prestaties van het apparaat aanzienlijk kan verbeteren. Verder, naarmate de uitgloeitijd geleidelijk toeneemt tot 10 uur, wordt de drempelspanning (Vth ) van de TFT verschuift in de richting van positieve bias, en de sub-threshold swing (SS) verbetert beetje bij beetje. Wanneer de gloeitijd echter toeneemt tot 11 uur, beginnen de prestaties van het apparaat te degenereren. Opgemerkt wordt dat waterstof tijdens het fabricageproces in de film kan worden opgenomen, als een elektronenval door het vormen van –OH-bindingen in het kanaal of op het grensvlak tussen het kanaal en het diëlektricum [31]. Deze elektronenvallen leiden wellicht tot de degradatie van SS. Na uitgloeien in lucht werden de OH-bindingen verminderd door O2 in te bouwen moleculen [32]. Dit zou kunnen leiden tot een afname van de valdichtheid, waardoor de SS van het apparaat wordt verbeterd. In termen van 10 uur gloeien in lucht, is de In2 O3 TFT vertoont een veldeffectmobiliteit (μEF ) van 7,8 cm 2 V −1 s −1 , een Vde van −3,7 V, een SS van 0,32 V/dec en een aan/uit stroomverhouding (Iaan /Iuit ) van 10 7 . De overeenkomstige uitgangskarakteristieken worden ook weergegeven in figuur 6b, die duidelijk afknijp- en stroomverzadigingsgedrag onder verschillende positieve poortspanningen demonstreert. Verder geven de outputcurves ook een n . aan -type verbeteringsmodus. Ter vergelijking vat tabel 2 de kenmerken van de gerapporteerde ALD samen In2 O3 films en TFT's van verschillende onderzoeksgroepen [33,34,35,36,37]. Het is aangetoond dat onze In2 O3 film vertoont een superieure groeisnelheid bij een relatief lage temperatuur, en het gefabriceerde apparaat vertoont ook een kleine SS. De algemene prestaties van het apparaat zijn echter niet zo perfect, wat kan worden verbeterd via enkele proces- en apparaatstructuuroptimalisaties.
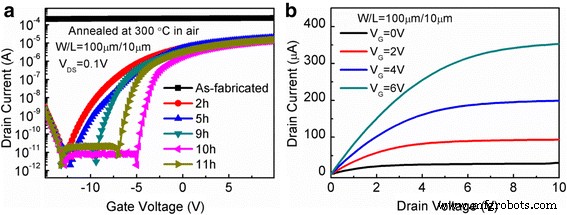
een Overdrachtskenmerken van de In2 O3 TFT's gegloeid bij 300 ° C in lucht gedurende verschillende tijd; b Uitgangskenmerken van de In2 O3 TFT gegloeid bij 300 °C in lucht gedurende 10 uur
De invloed van nagloeien in lucht op de samenstelling van de In2 . goed begrijpen O3 kanaal, de In2 O3 films werden gedurende verschillende tijden bij 300 ° C gegloeid en vervolgens geanalyseerd met behulp van XPS. Tabel 3 geeft een overzicht van de elementaire percentages van verschillende gegloeide films. Naarmate de gloeitijd toeneemt van 2 tot 11 uur, neemt de atoomverhouding van In:O af van 1:1,22 tot 1:1,48, en nadert geleidelijk die (1:1,5) van de stoichiometrische In2 O3 . Dit bevestigt verder dat een toenemende gloeitijd in lucht de dichtheid van zuurstofvacatures in de In2 effectief verminderde. O3 film. Daarom is de verbetering van de prestaties van de In2 O3 TFT moet voornamelijk worden toegeschreven aan de passivering van zuurstofvacatures die zich in het bulkkanaal en/of de interface tussen het kanaal en het diëlektricum zouden kunnen bevinden [25]. De overmatige gloeiing verslechterde echter de prestaties van het apparaat, zoals bleek uit 11 uur gloeien. Dit kan worden toegeschreven aan de verandering van kristallisatie van de In2 O3 kanaallaag en mogelijke oxidatie van Ti-elektroden tijdens overbodige nagloeiing in lucht. Er is dus een geschikte gloeitijd nodig om goede prestaties van de In2 . te bereiken O3 TFT.
Conclusies
De snelle ALD-groei van de In2 O3 films is bereikt bij relatief lage temperaturen (160-200 °C) met de InCp en H2 O2 voorlopers, met een uniforme groeisnelheid van 1,46 Å/cyclus. Naarmate de afzettingstemperatuur toenam, werd de kristallisatie van de afgezette film geleidelijk verbeterd. Ondertussen werden zowel zuurstofvacatures als koolstofonzuiverheden in de afgezette films ook aanzienlijk verminderd. Dit leidde dus tot een toename van de E g van In2 O3 . Verder, met de ALD In2 O3 kanaallaag, de TFT's met een ALD Al2 O3 diëlektricum werden vervaardigd. Naarmate de nagloeitijd in lucht werd verlengd, werden de elektrische prestaties van de In2 O3 TFT was duidelijk verbeterd tot 10 uur gloeien. Dit komt voornamelijk door de passivering van zuurstofvacatures in het bulkkanaal en/of de interface tussen het kanaal en het diëlektricum na uitgloeien in lucht. In termen van 10 uur gloeien, vertoonde het apparaat goede prestaties, zoals een veldeffectmobiliteit van 7,8 cm 2 /V⋅s, een schommeling onder de drempel van 0,32 V/dec en een stroomverhouding aan/uit van 10 7 . In termen van de depositietemperatuur van 200 °C vertoont de afgezette film een In:O-verhouding van 1:1,36 zonder detecteerbare koolstof, waardoor het bestaan van zuurstofvacatures in de als afgezette film wordt onthuld.
Nanomaterialen
- Air spacers voor 10nm chips
- Geavanceerde atoomlaagdepositietechnologieën voor micro-LED's en VCSEL's
- Hoogreflecterende dunnefilmoptimalisatie voor micro-LED's met volledige hoek
- Effect van verschillende bindmiddelen op de elektrochemische prestaties van metaaloxide-anode voor lithium-ionbatterijen
- Mesoporeuze nikkeloxide (NiO) nanopetals voor ultragevoelige glucosewaarneming
- Een nanokristallijne Fe2O3-filmanode bereid door gepulseerde laserafzetting voor lithium-ionbatterijen
- Polarisatie-ongevoelige oppervlakteplasmonpolarisatie Elektro-absorptiemodulator op basis van Epsilon-Near-Zero Indium Tin Oxide
- Ontwikkeling van elektrospun chitosan-polyethyleenoxide/fibrinogeen biocomposiet voor potentiële wondgenezingstoepassingen
- De anionische oppervlakteactieve stof/ionische vloeistoffen geïntercaleerd gereduceerd grafeenoxide voor krachtige supercondensatoren
- Effectieve lichtabsorptie met behulp van de dubbelzijdige piramideroosters voor dunne-film silicium zonnecel
- Dunne-film, hoogfrequente antenne-array voor draadloze communicatie



