Fermi-niveau-afstemming van ZnO-films door middel van supercyclische atoomlaagafzetting
Abstract
Een nieuw supercycled atomic layer deposition (ALD)-proces dat een thermisch ALD-proces combineert met in situ O2 plasmabehandeling wordt in dit werk gepresenteerd om dunne ZnO-films af te zetten met sterk afstembare elektrische eigenschappen. Beide O2 plasmatijd en het aantal thermische ALD-cycli in een supercyclus kunnen worden aangepast om fijnafstemming van filmweerstand en dragerconcentratie tot zes ordes van grootte te bereiken zonder extrinsieke doping. Aangenomen wordt dat de concentratie van waterstofdefecten een belangrijke rol speelt bij het aanpassen van de elektrische eigenschappen van ZnO-films. Resultaten van de Kelvin-sondekrachtmicroscopie tonen duidelijk de verschuiving van het Fermi-niveau in verschillende ZnO-films en zijn goed geassocieerd met de verandering van de dragerconcentratie. Deze betrouwbare en robuuste techniek die hier wordt beschreven, wijst duidelijk op de mogelijkheid om deze methode te gebruiken om ZnO-films met gecontroleerde eigenschappen in verschillende toepassingen te produceren.
Achtergrond
Ooit gedefinieerd als het toekomstige materiaal , heeft zinkoxide (ZnO) al meer dan een halve eeuw de aandacht van de wetenschappelijke gemeenschap getrokken vanwege zijn superieure optische en elektrische eigenschappen [1]. Onlangs heeft de snelle groei van de transparante geleidende oxide-industrie de toepassing ervan als transparante elektroden in platte beeldschermen, aanraakschermen, coatings met lage emissiviteit, dunne-filmzonnecellen, enz. verder nieuw leven ingeblazen. [2, 3]. Bovendien heeft ZnO talloze toepassingen gevonden in elektronische apparaten, waaronder lichtgevende diodes, fotodetectoren en stroomapparaten [4, 5]. Deze verschillende soorten toepassingen vereisen dat ZnO-films verschillende elektrische parameters hebben, en sommige toepassingen vereisen zelfs meerlaagse ZnO-films met verschillende elektrische eigenschappen [6]. Zo zijn er talloze pogingen gedaan om transparant resistief willekeurig toegankelijk geheugen (TRRAM) te ontwikkelen voor de realisatie van volledig geïntegreerde transparante elektronica [7, 8]. Als een van de meest veelbelovende kandidaten gebruikt op ZnO gebaseerde TRRAM een zeer resistieve ZnO-film als de actieve schakellaag, terwijl hooggeleidende ZnO-films idealiter worden geëist om als transparante elektroden te fungeren [8,9,10]. Het vermogen om de elektrische eigenschappen zoals soortelijke weerstand en dragerconcentratie van de ZnO-films te regelen, is daarom een belangrijke vereiste. Doping wordt meestal gebruikt wanneer de eigenschapsaanpassing nodig is en er een verscheidenheid aan doteermiddelen is toegepast om de eigenschappen van de ZnO-film te veranderen [11,12,13]. Doping is echter altijd complex en kan leiden tot de vorming van de secundaire fase [14]. Modulatie van de elektrische eigenschappen van ongedoteerd ZnO door een enkel depositieproces kan daarom voordelig zijn.
Atomic Layer Deposition (ALD) is een populaire techniek geworden om ZnO van hoge kwaliteit te vormen met een uitstekende controle van de filmdikte tot op nanometerschaal en uniformiteit over een groot substraat [15, 16]. De groeitemperatuur van ZnO is meestal lager dan 200 ° C, waardoor het compatibel is met een reeks substraten, waaronder glas en kunststoffen. De ALD ZnO wordt normaal gesproken gekweekt door diethylzink (DEZ) als Zn-precursor en waterdamp (thermisch) of zuurstofplasma (plasma-versterkt) als zuurstofprecursor te gebruiken. De dominante manier om de eigenschappen van ongedoteerde ZnO-film in het thermische ALD-proces af te stemmen, is door de groeitemperatuur te veranderen [17, 18]. Hoewel dit de afzetting van sterk geleidende films mogelijk maakt, zijn hoogwaardige ZnO-films moeilijk te verkrijgen met een lage dragerconcentratie. De plasma-versterkte ALD wordt bij voorkeur gebruikt wanneer ZnO met een lage dragerconcentratie vereist is [19, 20]. We hebben onlangs de mogelijkheid gerapporteerd om ZnO af te stemmen met behulp van een enkel plasma-versterkt ALD-proces waarmee de soortelijke weerstand en dragerconcentratie tot drie orden kunnen worden afgestemd met behulp van verschillende O2 plasmatijden [21]. De plasma-versterkte ALD kan echter een niet-zelfbeperkende groei ondergaan als een korte O2 plasmatijd wordt toegepast om de benodigde dragerconcentratie te bereiken, wat kan resulteren in een slechte uniformiteit over een groot substraat. Een afstembaar ALD-proces binnen het zelfbeperkende venster zou daarom gewenst zijn.
Afgezien van het vermogen om de elektrische eigenschappen van ZnO af te stemmen, blijft het bepalen van deze eigenschappen ook een uitdaging. Hall-effectmeting is de meest populaire techniek voor het meten van de elektrische eigenschappen van dunne ZnO-films. Het kan echter vatbaar zijn voor verkeerde interpretaties en heeft moeite met het ondubbelzinnig detecteren van de werkelijke oorzaak van doping [1]. Kelvin probe force microscopie (KPFM) is een niet-destructieve oppervlaktetechniek die op grote schaal is gebruikt om structurele, dynamische en elektrische eigenschappen van halfgeleidermaterialen en apparaten op nanoschaal te karakteriseren [22, 23]. Door het contactpotentiaalverschil direct te meten (V CPD ), d.w.z. het verschil tussen de werkfuncties van de punt en het monster, kan het inzicht geven in de materiële doteringstypes, dragerconcentraties en soortelijke weerstand, aangezien deze de positie van het Fermi-niveau binnen de bandgap beïnvloeden. Werken die de ZnO-eigenschappen correleren met KPFM-resultaten worden echter zelden gerapporteerd, en voor zover wij weten, zijn er geen gebaseerd op ALD-gegroeide ZnO-films [24,25,26].
In dit werk stellen we een nieuw supercycled ALD-proces voor voor het afstemmen van elektrische eigenschappen in ongedoteerd ZnO. Het thermische ALD-proces combineren met een in situ O2 plasmabehandeling maakt dit proces een brede maar verfijnde afstemming van de ZnO-filmweerstand en dragerconcentratie mogelijk. Wat nog belangrijker is, is dat de Fermi-niveauverschuivingen in de ZnO-films direct kunnen worden gemeten door KPFM en worden gebruikt om de elektrische eigenschappen van ZnO te karakteriseren.
Methoden
Alle dunne ZnO-films werden bereid in een OIPT FlexAl ALD-systeem met behulp van een diethylzink-precursor (DEZ). Elke supercyclus van het ALD-proces bestaat uit m cycli van thermische ALD-processen (DEZ en H2 O) en één O2 plasmastap zoals aangetoond in Fig. 1a. Binnen het thermische ALD-proces werd aanvankelijk DEZ-damp in de kamer gebracht en vervolgens gespoeld door een argonstroom, en H2 O-damp werd vervolgens geïntroduceerd en vervolgens met argon gespoeld. Na m cycli van thermische ALD-processen, een O2 plasmastap werd toegevoegd als een in situ plasmabehandelingsstap. De O2 plasmastap werd ingesteld met een O2 stroom van 60 sccm, RF-vermogen van 300 W en druk van 15 mTorr. Beide thermische ALD-nummers (m ) en O2 plasmatijd (t 3 ) werden gebruikt voor ZnO-filmeigenschapscontrole. De specifieke details voor één groei-supercyclus in het ALD-proces worden gegeven in Aanvullend bestand 1:Tabel S1. Alle ZnO-films werden afgezet op de SiO2 -gecoate Si-substraten (1 cm × 1 cm) bij een vaste temperatuur van 190 ° C, en alle filmdiktes werden geprojecteerd op 40 nm.

een Illustratie van de ene groei-supercyclus van het voorgestelde supercyclische ALD-proces. b ZnO-groeisnelheid als functie van de O2 plasmatijd voor supercyclische ALD met vaste thermische cyclus (m =1) en plasma-versterkte ALD-processen; de gestippelde curven zijn gidsen van het oog. c ZnO-groeisnelheid en lineaire aanpassing als functie van de thermische procescyclus m met vaste O2 plasmatijden (t 3 = 1 en 8 s)
De dikte en optische constanten van de afgezette ZnO-films werden gemeten met ellipsometrie (VASE, J.A. Woollam Co. M-2000) en uitgerust met een Tauc-Lorentz (TL) -model. De elektrische eigenschappen werden gemeten door middel van Hall-metingen (Nanometrics HL5500PC) bij kamertemperatuur onder een magnetisch veld van 0,5 T. Er werd extra op gelet dat er vóór elke afzonderlijke meting lineair contact werd verkregen tussen elke koperen sonde en het monster. Röntgendiffractie (XRD) patronen werden verzameld in begrazingsincidentie (θ 1 = 1°) met behulp van een Rigaku Smartlab-diffractometer met een 9 kW Cu-K α bron. Röntgenfoto-elektronspectroscopie (XPS)-gegevens werden verkregen met behulp van een Thermo Scientific Theta-sondesysteem met Al-K α straling (fotonenergie =1486,6 eV). Waar nodig werd oppervlakteverontreiniging geëlimineerd door het gebruik van een ionensputterpistool. De Zn 2p , O 1s , en C 1s spectra werden verzameld. Alle gegevens werden verwezen naar de C 1s piek, waaraan een bindingsenergie van 284,6 eV werd toegewezen. KPFM-metingen werden uitgevoerd op Nanonics CV2000 door een Nanosensor ATEC Pt-Ir-gecoate tip met een resonantiefrequentie van 65 kHz. Om de invloed van oppervlakteverontreinigingen te verminderen, werden de metingen uitgevoerd net nadat de monsters uit de vacuümkamer waren gehaald.
Resultaten en discussie
Het voorgestelde supercyclische ALD-proces wordt geïllustreerd in figuur 1a met één supercyclus bestaande uit m cycli van thermische ALD-processen (DEZ en H2 O) en één O2 plasmastap (O2 plasma). Meer details vindt u in het gedeelte "Methoden". Figuur 1b vergelijkt de ZnO-groeipercentages in ons supercyclische ALD-proces wanneer m = 1 en het conventionele plasma-versterkte ALD-proces als functie van O2 plasma tijd. De groeisnelheid in het plasma-versterkte ALD-proces (rood) blijkt gevoelig te zijn voor de O2 plasma als het stijgt van ca. 1,4 tot 1,7 /cyclus waarbij de plasmatijd verandert van 2 naar 4 s. Het is dan verzadigd op het niveau van ca. 1,7 Å/cyclus bij langere plasmatijden. De onverzadigde groeisnelheid bij kortere O2 plasmatijd wordt toegeschreven aan het zuurstoftekort in het proces. Hoewel dit soms de voorkeur heeft om ZnO-films met een hoge geleidbaarheid te verkrijgen, is het niet zelfbeperkend en kan het resulteren in een slechte uniformiteit over het hele substraat. Daarentegen bleek de groeisnelheid stabiel te zijn op ca. 1,69 Å/supercyclus in het supercyclische ALD-proces (zwart) en ligt dicht bij dat van het thermische ALD-proces (t 3 = 0 s) ongeacht de toegepaste plasmatijd. Bovendien, toename van de thermische cyclus m in één supercyclus met vaste plasmatijd leidt tot een lineaire toename van de groeisnelheid zoals weergegeven in figuur 1c. De aangepaste helling wordt berekend op 1,67 voor beide groeisels met verschillende O2 plasmatijden, die ook dicht bij de groeisnelheid van het thermische ALD-proces ligt. Dit suggereert dat de groei van ZnO in onze supercyclische ALD wordt gedomineerd door het thermische ALD-proces en de daaropvolgende O2 plasmastap dient als louter een behandeling.
Alle ZnO-films gekweekt door het supercycled ALD-proces (m = 1) kristalliseren in de hexagonale wurtzietstructuur en illustreren een vergelijkbare verdeling van piekintensiteiten ongeacht de O2 plasmatijd, zoals weergegeven in Fig. 2a. Vergeleken met de theoretische intensiteitsverhouding van 0,44 tussen piek (0 0 2) en (1 0 1) (berekend uit JCPDS-34-1451 voor een willekeurige oriëntatie van de kristallieten), vertonen deze films een sterke voorkeursoriëntatie langs de c -as met de (0 0 2) en (1 0 1) piekintensiteitsverhouding tussen 2 en 5, wat een goede kristallijne kwaliteit van de films suggereert. Een lichte toename van de (0 0 2) tot (1 0 1) piekverhouding wordt waargenomen met toenemende O2 plasmatijd (weergegeven in het aanvullende bestand 1:Afbeelding S1). Dit suggereert een hogere mate van voorkeursoriëntatie bij blootstelling aan langer plasma. Soortgelijk gedrag werd ook gemeld [27, 28]. Het is echter de moeite waard erop te wijzen dat de verandering van de intensiteitsverhouding in ons werk nogal triviaal is in vergelijking met andere. Dit suggereert verder de stabiliteit van ons supercycled ALD-proces voor het produceren van hoogwaardige ZnO-films. De gemiddelde korrelgroottes werden ook geschat op basis van de Scherrer-formule [29] en bleken ca. 11 nm, wat suggereert dat de ZnO-korrelgrootte nauwelijks werd beïnvloed door de O2 plasma tijd. Soortgelijke patronen worden ook waargenomen op ZnO-films die zijn gegroeid uit verschillende thermische ALD-cycli (m ) met een vaste O2 plasmatijd (1 s) zoals weergegeven in Afb. 2b.
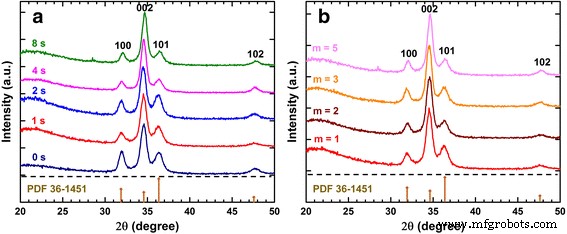
XRD-patronen van ZnO-films die zijn gegroeid door het supercyclische ALD-proces met behulp van a verschillende O2 plasmatijden met vaste thermische cyclus (m = 1) en b verschillende thermische cycli met vaste O2 plasmatijd (t 3 = 1 s)
Naast de kristalliniteit werden ook de optische eigenschappen van de supercyclische ALD-gegroeide ZnO-films bestudeerd met behulp van spectroscopische ellipsometrie (SE). Optische constanten (n en k ) kan worden geëxtraheerd uit de ellipsometrieresultaten door een Tauc-Lorentz-model dat vaak wordt gebruikt bij het plaatsen van ZnO-films [28, 30, 31]. Net als bij de analoge kristalliniteit, zijn de optische eigenschappen van ZnO-films die zijn afgezet met verschillende O2 plasmatijden en thermische cycli blijven ook ongewijzigd, zoals weergegeven in Aanvullend bestand 1:Afbeelding S2. Dit komt overeen met de gerapporteerde werken dat een verandering van kristalliniteit altijd gepaard gaat met een verandering van optische eigenschappen [28, 32]. De morfologische eigenschappen van de ZnO-films worden gekenmerkt door AFM. Alle films bleken even glad te zijn met een gemiddelde ruwheid tussen ca. 0,3 en 0,8 nm (Extra bestand 1:Afbeelding S3).
De elektrische eigenschappen van de ZnO-films die zijn gegroeid door het supercyclische ALD-proces, worden onderzocht door een Hall-effectsysteem. Alle films bleken n . te zijn -type halfgeleidend, en de soortelijke weerstand neemt toe van ca. 10 −3 tot 10 3 Ω cm met toenemende O2 plasmatijd en vaste thermische cyclus (m =1) zoals weergegeven in Fig. 3a. Dit gaat gepaard met de verlaging van de dragerconcentratie van ca. 10 21 tot 10 15 cm −3 als de O2 plasmatijd neemt toe van 0 tot 8 s (Fig. 3b). Integendeel, de elektronenmobiliteit van alle ZnO-films blijkt vrij consistent te zijn (ca. 3,0 ± 1,0 cm 2 /V s) en worden niet beïnvloed door de plasmaduur. Het gedetailleerde geleidingsmechanisme zal verder worden besproken in de onderstaande sectie. Vergeleken met het plasma-versterkte ALD-proces dat we eerder rapporteerden [21], is de omvang van de weerstandsafstemming verder verbeterd in het supercycled ALD-proces tot meer dan vijf orden. Bovendien biedt dit voorgestelde ALD-proces een meer verfijnde controle over deze elektrische eigenschappen door de thermische cyclus te variëren (m ) in één supercyclus tijdens het repareren van de O2 plasmatijd (t 3 ). Dit is vooral handig in het geval van t 3 =1 s waarbij afstemming niet mogelijk is door de plasmatijd verder te verminderen vanwege de beperking van de ALD-apparatuur. De open punten in Fig. 3a, b vertegenwoordigen de weerstanden en dragerconcentraties van ZnO-films die zijn gegroeid door verschillende thermische cycli (m = 2, 3, 5) wanneer t 3 = 1 s (foutbalken staan tussen de stippen). Er kan worden waargenomen dat meer thermische cycli resulteren in minder resistieve films met hogere dragerconcentraties. Dit levert een extra van drie weerstanden op binnen het bereik van 10 −3 tot 10 1 Ω cm.
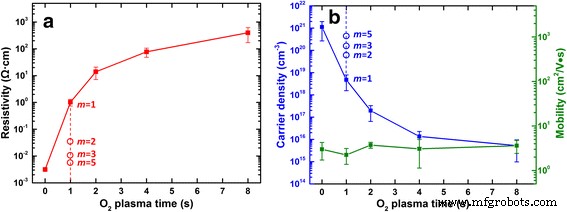
een Elektrische weerstand van ZnO-films gegroeid uit verschillende O2 plasmatijden met vaste thermische cyclus m (vaste stippen) en verschillende thermische cycli met vaste O2 plasmatijd (open punten) door het supercycled ALD-proces. b Dragerconcentratie (blauw) van ZnO-films gegroeid uit verschillende O2 plasmatijden met vaste thermische cyclus (vaste punten) en verschillende thermische cycli met vaste O2 plasmatijd (open stippen). Mobiliteit (groen) van ZnO-films gegroeid uit verschillende O2 plasmatijden met een vaste thermische cyclus
KPFM-metingen werden uitgevoerd om inzicht te krijgen in de Fermi-niveauposities van de ZnO-films met veranderende resistiviteit. Het meet het contactpotentiaalverschil V CPD tussen een geleidende tip en het monster dat wordt gedefinieerd als:
$$ {V}_{\mathrm{CPD}}=\frac{\phi_{\mathrm{tip}}-{\phi}_{\mathrm{voorbeeld}}}{q} $$ (1)waar q is de elektronische lading, terwijl ϕ tip en ϕ voorbeeld zijn respectievelijk de werkfunctie van de tip en het monster. Wanneer twee verschillende materialen in elektrisch contact worden gebracht, zullen de Fermi-niveaus op één lijn komen te staan door de elektronenstroom, wat dientengevolge een contactpotentiaalverschil tussen de punt en het monster induceert, zoals weergegeven in aanvullend bestand 1:Afbeelding S4. Gedetailleerd werkingsprincipe van KPFM wordt gepresenteerd in Aanvullend bestand 1. De contactpotentiaalverschillen van de ZnO-films die zijn gegroeid door het supercyclische ALD-proces van verschillende O2 plasmatijden met vaste thermische cyclus (m = 1) worden weergegeven in Afb. 4. Terwijl elke V CPD het beeld lijkt uniform en relatief glad te zijn, aanzienlijke verschillen in de gemiddelde V CPD waarden kunnen worden waargenomen (getoond in Fig. 4f). De tip-werkfunctie ϕ tip blijft constant voor alle metingen; het substantiële verschil in V CPD is daarom het gevolg van de Fermi-niveauverschuiving binnen verschillende ZnO-films. Een totale verschuiving van ca. 0,32 eV wordt verkregen tussen ZnO-film gekweekt met 0 en 8 s O2 plasmatijd die significant is in vergelijking met de ZnO-bandgap (ca. 3,22 eV op basis van de SE-resultaten in dit werk zoals weergegeven in aanvullend bestand 1:figuur S2c). Voor ZnO-films die zijn gegroeid uit verschillende thermische cycli (m = 2, 3, 5) op vaste O2 plasmatijd (t 3 = 1 s), verschillende V CPD waarden werden ook gedetecteerd zoals weergegeven in figuur 4f. De tweedimensionale KPFM-afbeeldingen van deze films zijn te vinden in Aanvullend bestand 1:Afbeelding S5. Dit houdt in dat de verandering in de elektron-gat-balans door de films heen optreedt, wat een aanzienlijke invloed zou kunnen hebben op de ZnO-dragerconcentratie.
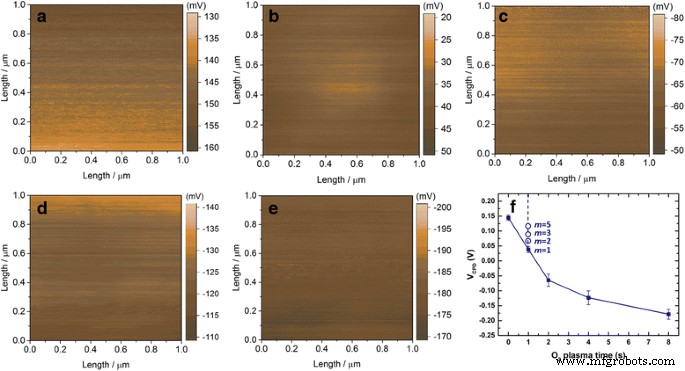
een –e Tweedimensionaal contactpotentiaalverschil V CPD afbeeldingen van de oppervlaktepotentiaalmetingen van de supercyclische ALD-gegroeide ZnO-films met O2 plasmatijd (t 3 ) variërend van 0 tot 8 s en vaste thermische cyclus (m = 1). v Gemiddeld V CPD waarden met variërende O2 plasmatijden (vaste punten) en thermische cycli (open punten)
Om de relatie tussen het Fermi-niveau en de dragerconcentratie te onderzoeken, gebruiken we het elektronische energiemodel voorgesteld door Maragliano et al. om het contactpotentiaalverschil te correleren V CPD met de dopingconcentratie in het materiaal [26]. Uitgaande van de effectieve donorconcentratie n D aanzienlijk hoger is dan de intrinsieke dragerconcentratie, kan het worden geschreven als:
$$ {n}_{\mathrm{D}}\circa {N}_{\mathrm{C}}\exp \left(\frac{q{V}_{\mathrm{C}\mathrm{PD} }-{\phi}_{\mathrm{tip}}+\chi }{K_BT}\right) $$ (2)waar N C is de effectieve toestandsdichtheid, χ is de elektronenaffiniteit van de halfgeleider, K B is de Boltzmann-constante, en T is de temperatuur. Hoewel de waarden van de effectieve toestandsdichtheid N C , de tip-werkfunctie ϕ tip , en de elektronenaffiniteit χ moeilijk te verkrijgen zijn, kunnen de relatieve dragerconcentratieverschillen van verschillende ZnO-films worden berekend, aangezien deze waarden in alle metingen hetzelfde zijn. Vandaar dat de dragerconcentratieverhouding tussen de films gegroeid met 0 s O2 plasmatijd tot een bepaalde ZnO-film kan worden uitgedrukt als:
$$ \frac{n_0}{n_x}=\exp \left(\frac{V_{\mathrm{CPD}0}-{V}_{\mathrm{CPD}x}}{K_BT/q}\right) $$ (3)waarin n 0 en n x zijn de dragerconcentratie van de ZnO-film gegroeid met 0 en x s van O2 respectievelijk plasmatijd en V CPD0 en V CPDx zijn de bijbehorende contactpotentiaalverschillen. De berekende dragerconcentratieverhoudingen zijn uitgezet in Fig. 5 als functie van O2 plasma tijd. De concentratieverhouding wordt zo berekend dat deze toeneemt met een langere O2 plasmatijd (rood). Belangrijker is dat de stijgende trend goed overeenkomt met de waarden die zijn verkregen uit de meetresultaten van het Hall-effect (zwart). Een vergelijkbare trend werd ook waargenomen voor ZnO-films die zijn gegroeid uit verschillende thermische cycli (m = 2, 3, 5) op vaste O2 plasmatijd (t 3 = 1 s). Dit suggereert duidelijk dat de verschuiving van het Fermi-niveau van de ZnO-film direct verband houdt met het concentratieniveau van de drager.
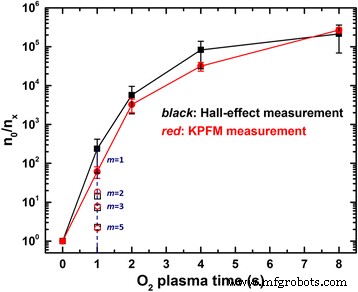
Hall-effect en KPFM-meetresultaten van dragerconcentratieverhoudingen tussen ZnO-films gegroeid met variërende O2 plasmatijden (vaste punten) en thermische cycli (open punten)
Röntgenfoto-elektronspectroscopie (XPS) metingen werden uitgevoerd om licht te werpen op het geleidingsmechanisme door de binding en chemische toestanden van de supercyclische ALD-gegroeide ZnO-films te bestuderen. De chemische toestanden van O 1s worden getoond in Fig. 6 waar twee pieken kunnen worden geïdentificeerd na Gauss-fittingen. De onderste energiepiek (A) bevindt zich op ca. 530.3 eV wordt voorgesteld als de O 2− ionen in de wurtzietstructuur van hexagonaal Zn 2+ ionen [33,34,35]. De toewijzingen van de hogere bindingsenergiecomponent bij ca. 532.2 (B) zijn controversieel geweest over literatuur [33,34,35,36,37,38]. Er wordt echter algemeen gerapporteerd dat het geassocieerd is met de hydroxylgroep (d.w.z. Zn-OH) [33, 37,38,39] in ZnO-film. We schrijven daarom voorlopig de OB piek waargenomen in Fig. 6 tot de Zn−OH-bindingen. Aan de andere kant, de zuurstof vacature-geassocieerde piek gepositioneerd op ca. 531.2 eV [35] wordt in dit werk niet waargenomen. ZnO-film gegroeid door het thermische ALD-proces (t 3 = 0 s) kenmerkt een dominante OB piek in het XPS-spectrum (figuur 6a). Dit impliceert het bestaan van een grote hoeveelheid waterstofgerelateerde onzuiverheden in deze film. Dit hoge niveau van defecten dient als een zelfdopingmechanisme en leidt tot een hoge dragerconcentratie. De extra O2 plasmastap (t 3 ) vermindert de onzuiverheden, en de OB piekintensiteit neemt af met langere O2 plasmatijd (Fig. 6f). Een vergelijkbare trend werd ook waargenomen voor ZnO-films die zijn gegroeid uit verschillende thermische cycli waarin meer thermische cycli leiden tot de toename van OB piekintensiteit zoals weergegeven in Afb. 6f en Aanvullend bestand 1:Afbeelding S6.

een –e XPS-spectra en hun Gauss-fittingen van de O 1s regio van de supercyclische ALD-gegroeide ZnO-films met O2 plasmatijd (t 3 ) variërend van 0 tot 8 s en vaste thermische cyclus (m = 1). v Aandeel van de waterstofgerelateerde OB piek in ZnO-films gegroeid met variërende O2 plasmatijden (vaste punten) en thermische cycli (open punten)
De oorsprong van de intrinsieke n -type geleidbaarheid in ZnO-films is nog steeds controversieel. Hoewel conventionele wijsheid deze geleidbaarheid heeft toegeschreven aan een aangeboren defect (d.w.z. zuurstofvacatures en Zn-interstitials) [18, 40,41,42,43,44], is het op de proef gesteld door recente eerste-principeberekeningen [45]. Het is ook onwaarschijnlijk dat zuurstoftekorten bijdragen aan een dergelijk hoog concentratieniveau, aangezien talrijke onderzoeken suggereren dat ze eerder diepe dan ondiepe donoren zijn en hoge vormingsenergieën hebben in n -type ZnO (en zijn daarom in tegenstelling tot vorm) [41,42,43,44]. Daarnaast zijn de zuurstofvacature-gerelateerde O 1s piek wordt ook niet waargenomen in onze XPS-gegevens getoond in Fig. 6. Hoewel Zn-interstitials ondiepe donoren zijn, is gesuggereerd dat ze hoge vormingsenergieën hebben en snellere diffusors zijn en daarom is het onwaarschijnlijk dat ze stabiel zijn [41]. De XPS-spectra van de Zn 2p 3/2 staat van de supercycled ALD-gegroeide ZnO-films met verschillende O2 plasmatijden worden getoond in Fig. 7. Alle spectra worden gekenmerkt door een vergelijkbare piek gepositioneerd op ca. 1021,5 eV die kan worden toegeschreven aan de Zn 2+ binding in ZnO [6, 34, 46]. De interstitiële Zn-component met een iets hogere bindingsenergie [6, 47] wordt echter niet in alle spectra waargenomen. Dit suggereert dat de invloed van Zn-interstitial op de geleidbaarheid van de ZnO-film ook in dit werk kan worden uitgesloten.

een –e XPS-spectra en hun Gauss-fittingen van de Zn 2p 3/2 regio van de supercyclische ALD-gegroeide ZnO-films met O2 plasmatijd (t 3 ) variërend van 0 tot 8 s en vaste thermische cyclus (m =1)
Onlangs is voorgesteld waterstofgerelateerde onzuiverheden/defecten een rol te spelen in de n -type geleidbaarheid in ZnO [33, 48]. Het bewijs van het bestaan van waterstofbruggen in ZnO is aangetoond door Janotti et al. [48], en er is gesuggereerd dat die bindingen in hoge concentraties kunnen worden opgenomen en zich gedragen als ondiepe donoren [49,50,51]. Inderdaad, waterstof is aanwezig in ons supercyclische ALD-proces als zowel voorloper als H2 O bevatten waterstof en een Zn−OH-binding wordt geproduceerd in elke halve cyclus in de thermische ALD-stap. Dit wordt ook ondersteund door de waarneming van hydroxylgroep-gerelateerde O 1s piek in de XPS-spectra (weergegeven in Fig. 6). De weerstand van de ZnO-film en de dichtheid van de drager zijn uitgezet tegen het aandeel van deze piek in figuur 8. Een hoog aandeel van deze waterstofverontreinigingen leidt tot hoge dragerconcentraties, wat leidt tot lage soortelijke weerstanden. De daaropvolgende O2 plasmastap binnen elke supercyclus vermindert de dragerconcentratie door de waterstofbruggen effectief te verwijderen. Dit gaat gepaard met een verlaging van de dragerconcentratie en een toename van de soortelijke weerstand. Hetzelfde gedrag werd ook gerapporteerd bij zowel ALD- als CVD-processen [33, 52].
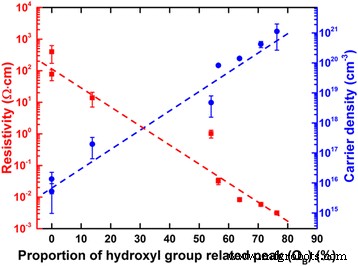
Elektrische weerstand en dragerconcentratie als functie van de hydroxylgroep-gerelateerde OB piekverhouding (stippellijnen zijn hulplijnen voor het oog)
Conclusies
Depositie van ongedoteerde ZnO-films met sterk afstembare elektrische eigenschappen werd hier gerapporteerd met behulp van een supercyclisch ALD-proces dat een thermisch ALD-proces combineert met in situ O2 plasmabehandeling. Meer dan vijf ordes van grootte aanpassing over de filmweerstand en dragerconcentratie werden bereikt door de O2 af te stemmen plasma tijden. Een fijnere afstemming van de eigenschappen kan ook worden gerealiseerd door het aantal thermische ALD-cycli in een supercyclus te variëren. Aangenomen wordt dat de afstemming van deze elektrische eigenschappen verband houdt met de verandering van de waterstofdefectconcentratie in de film. Dit veroorzaakt direct de verschuiving van Fermi-niveaus binnen de ZnO-films, zoals onthuld door de Kelvin-probe-krachtmicroscopie. Door een eenvoudig elektronisch energiemodel te gebruiken, laten de dragerconcentraties die zijn berekend op basis van de Fermi-niveauverschuivingen, een goede overeenkomst zien met de meetresultaten van het Hall-effect. Deze betrouwbare en robuuste techniek die hier wordt vermeld, wijst duidelijk op de mogelijkheid om deze methode te gebruiken om ZnO-films met gecontroleerde eigenschappen in verschillende toepassingen te produceren.
Afkortingen
- ALD:
-
Atoomlaagafzetting
- DEZ:
-
Diethylzink
- KPFM:
-
Kelvin-sondekrachtmicroscopie
- XPS:
-
Röntgenfoto-elektronenspectroscopie
- XRD:
-
Röntgendiffractie
Nanomaterialen
- Geavanceerde atoomlaagdepositietechnologieën voor micro-LED's en VCSEL's
- Bipolaire resistieve schakelkenmerken van HfO2/TiO2/HfO2 drielaagse structuur RRAM-apparaten op Pt- en TiN-gecoate substraten vervaardigd door atomaire laagafzetting
- Kenmerken van grensvlak-, elektrische en banduitlijning van HfO2 / Ge-stapels met in situ gevormde SiO2-tussenlaag door plasma-versterkte atomaire laagafzetting
- De antibacteriële polyamide 6-ZnO hiërarchische nanovezels vervaardigd door afzetting van atoomlagen en hydrothermische groei
- Fotokatalytische eigenschappen van Co3O4-gecoate TiO2-poeders bereid door plasma-versterkte afzetting van atoomlagen
- Depositie in twee stappen van met Al-gedoteerde ZnO op p-GaN om ohmse contacten te vormen
- De oppervlaktemorfologieën en eigenschappen van ZnO-films afstemmen door het ontwerp van grensvlakken
- Optische eigenschappen van met Al-gedoteerde ZnO-films in het infraroodgebied en hun absorptietoepassingen
- Effect van verschillende CH3NH3PbI3-morfologieën op fotovoltaïsche eigenschappen van perovskiet-zonnecellen
- Preparatie- en antibiofilmeigenschappen van zinkoxide/poreuze anodische aluminiumoxide composietfilms
- Afhankelijkheid van dikte van grensvlak- en elektrische eigenschappen in atoomlaag afgezet AlN op c-vlak GaN



