Groot lateraal fotovoltaïsch effect in MoS2/GaAs heterojunctie
Abstract
Molybdeendisulfide (MoS2 ) films op nanoschaal worden afgezet op GaAs-substraten via magnetronsputtertechniek en MoS2 /GaAs heterojuncties worden gefabriceerd. Het laterale fotovoltaïsche effect (LPE) van de gefabriceerde MoS2 /GaAs heterojuncties wordt onderzocht. De resultaten laten zien dat een grote LPE kan worden verkregen in de MoS2 /n -GaAs heterojunctie. De LPE vertoont een lineaire afhankelijkheid van de positie van de laserverlichting en de aanzienlijk hoge gevoeligheid van 416,4 mV mm − 1 . Deze gevoeligheid is veel groter dan de waarden in andere gerapporteerde MoS2 gebaseerde apparaten. Ter vergelijking:de LPE in de MoS2 /p -GaAs heterojunctie is veel zwakker. De mechanismen voor de LPE worden onthuld door de energiebanduitlijning van de MoS2 te construeren /GaAs heterojuncties. De uitstekende LPE-eigenschappen maken MoS2 films gecombineerd met GaAs-halfgeleiders die veelbelovende kandidaten zijn voor de toepassing van hoogwaardige positiegevoelige detectoren.
Achtergrond
Vanwege zijn uitstekende eigenschappen is molybdeendisulfide (MoS2 ) wordt onderzocht als een typisch soort tweedimensionale materialen om micro-elektronische apparaten en opto-elektronische apparaten van de volgende generatie te ontwikkelen [1,2,3,4,5]. In tegenstelling tot grafeen, MoS2 heeft een duidelijke band gap en de band gap neemt af met toenemende laagnummers [6]. De aanwezigheid van de duidelijke band gap maakt de fabricage van de MoS2 . mogelijk transistors met een aan/uit-verhouding van meer dan 10 8 en de fotodetectoren met een hoge responsiviteit [7, 8]. Onlangs, MoS2 gecombineerd met andere halfgeleiders heeft veel belangstelling gewekt, zoals GaAs, Si en GaN [9,10,11,12,13]. Deze ontworpen heterostructuren leveren een haalbare technische route voor MoS2 -gebaseerde materialen om praktisch toepasbare opto-elektronische apparaten te ontwikkelen. Van al deze bulkhalfgeleiders heeft GaAs een geschikte directe bandafstand van ~-1,42 eV en een hoge elektronenmobiliteit (~ 8000 cm 2 V −1 s −1 ). Lin et al. gefabriceerde MoS2 /GaAs-zonnecellen met een energieconversie-efficiëntie van meer dan 9,03% [9]. Verder, Xu et al. meldde een MoS2 /GaAs zelfrijdende fotodetector met de extreem hoge detectiviteit van 3,5 × 10 13 Jones [10]. In eerdere rapporten hebben de onderzoeken naar MoS2 /GaAs heterostructuren zijn voornamelijk gericht op de toepassing op het gebied van zonnecellen en fotodetectoren. Echter, de MoS2 /GaAs als positiegevoelige detector (PSD) op basis van het laterale fotovoltaïsche effect (LPE) is zelden gemeld. Anders dan het gewone longitudinale fotovoltaïsche effect, is de LPE afkomstig van de laterale diffusie en recombinatie van de door fotonen gegenereerde dragers in de inversielaag op het grensvlak [14,15,16,17,18]. Bij het LPE-effect kan een laterale fotospanning (LPV) worden verkregen en deze verandert lineair met de positie van de laservlek op het actieve gebied van het apparaatoppervlak. Deze kenmerken maken LPE zeer nuttig bij het ontwikkelen van krachtige PSD's en zijn uitgebreid bestudeerd op het gebied van robotica, biomedische toepassingen, procesbesturing, positie-informatiesystemen, enzovoort.
In dit werk, MoS2 dunne films met verschillende diktes worden afgezet op het oppervlak van n -/p -GaAs-substraten via magnetron sputtertechniek. Een grote LPE wordt waargenomen in de gefabriceerde MoS2 /n -GaAs heterojunctie, en de gevoeligheid bereikte 416,4 mV mm −1 . Onze resultaten tonen verder aan dat de LPE een duidelijke afhankelijkheid vertoont van de dragertypes van de GaAs-substraten en de dikte van de MoS2 films. Door de constructie van de uitlijning van de energieband bij de interface, worden de mechanismen voor de LPE in de apparaten voorgesteld.
Methoden
MoS2 dunne films werden afgezet op (100)-georiënteerde GaAs-substraten met behulp van de DC-magnetronsputtertechniek. De MoS2 poeders (zuiverheid, ~ -99%) werden koud geperst tot een schijf onder een druk van 20,0 MPa. De als gefabriceerde schijf (Φ60,0 mm x 4,5 mm) werd tijdens het sputteren als doelwit gebruikt. De n- /p -GaAs-substraten werden respectievelijk in onze experimenten gebruikt. Vóór de afzetting werden de substraten achtereenvolgens ultrasoon gereinigd met alcohol, aceton en gedeïoniseerd water. Vervolgens MoS2 dunne films met verschillende diktes (d MoS2 =~ -10, 30, 50, 90 nm) werden respectievelijk gekweekt op de GaAs-substraten bij een temperatuur van 400 ° C. Tijdens de depositie werden de werkdruk en het vermogen op respectievelijk 1,0 Pa en 10,0 W gehouden. Als referentie, MoS2 dunne films werden ook afgezet op intrinsieke GaAs (i -GaAs) substraten onder dezelfde voorwaarde. Ten slotte werden ongeveer 300 m In-pads met een diameter van 0,5 mm als elektroden op de MoS2 gedrukt film.
De MoS2 films werden gekarakteriseerd met behulp van Raman-spectroscopie (HORIBA, HR800) met een excitatiegolflengte van 488 nm. Het oppervlak van het monster werd gescand door een atomic force microscope (AFM). Röntgenfoto-emissiespectroscopie (XPS) werd uitgevoerd door een Kratos Axis ULTRA-spectrometer met een monochromatische Al Ka-röntgenbron. De afzettingssnelheid werd verkregen door de dikte van de cross-sectionele scanning elektronenmicroscoop (SEM) (aanvullend bestand 1:figuur S1) en de afzettingstijd, vervolgens werd elke filmdikte bepaald door de afzettingssnelheid en elke afzettingstijd. De transmissiespectra werden gemeten door Shimadzu UV-3150 spectrofotometer. Ultraviolette foto-elektronspectroscopie (UPS) werd uitgevoerd met behulp van een ongefilterde He-I (21,22 eV) gasontladingslamp. LPV's werden gemeten met een Keithley 2000 voltmeter en een driedimensionaal elektrisch gemotoriseerd platform met een laser met een golflengte van 650 nm als verlichtingsbron. De stroom-spanning (I -V ) curven werden gemeten met een Keithley 2400 SourceMeter.
Resultaten en discussie
Figuur 1 toont het Raman-spectrum van de MoS2 film op het GaAs-substraat. Naast de piek van het GaAs-substraat bij ~ 287.1 cm −1 , twee karakteristieke MoS2 Raman-pieken zijn te zien, de A1g modus bij ∼ 406.7 cm −1 en E 1 2g modus bij ∼ 378,9 cm −1 . De twee rechter inzetstukken tonen de illustratie van de atomaire vibratie in MoS2 . De A1g modus komt overeen met de S-atomen die in tegenfase oscilleren in de richting buiten het vlak, en de E 1 2g modus komt overeen met de S- en Mo-atomen die in tegenfase evenwijdig aan het kristalvlak oscilleren. Zoals weergegeven in de afbeelding, komt de Raman-piek overeen met de A1g modus is bij voorkeur opgewonden voor de film. Volgens onze metingen is de intensiteitsverhouding van A1g /E 1 2g ligt rond de 2.1. Deze Raman-kenmerken zijn vergelijkbaar met andere gerapporteerde resultaten over MoS2 dunne films [19]. De linker inzet toont een AFM-topografische afbeelding van de 40-nm MoS2 film gegroeid op het GaAs-substraat. Uit de figuur kunnen we zien dat het oppervlak van de film is samengesteld uit dichte kegelachtige korrels. Volgens de metingen is de wortel-mean-square (RMS) ruwheid van de film ongeveer 1,7 nm en de gemiddelde grootte van korrels is ongeveer 76,3 nm in diameter. Deze korrels op het oppervlak kunnen de oppervlaktereflectie naar het externe licht verminderen en de lichtabsorptie van het gefabriceerde apparaat verbeteren.

Raman-spectrum van de MoS2 film op GaAs. De rechter twee inzetstukken tonen de schematische illustraties van de oscillerende modus van E 1 2g en A1g , respectievelijk. Atoomkleurcode:licht blauwgroen, Mo; geel, S. De linker inzet toont het oppervlaktemorfologiebeeld van de als gegroeide MoS2 films
Afbeelding 2 toont de XPS-spectra van de MoS2 film. Zoals getoond in Fig. 2a, zijn de pieken bij 229,3 en 232,5 eV gerelateerd aan de Mo 3d5/2 en Mo 3d3/2 orbitalen, respectievelijk. Zoals getoond in Fig. 2b, S 2p3/2 en S 2p1/2 orbitalen van tweewaardige sulfide-ionen (S 2− ) worden waargenomen bij respectievelijk 162,2 en 163,3 eV. De resultaten komen goed overeen met de gerapporteerde waarden voor de MoS2 kristal [17, 18].

XPS-spectra van de MoS2 film voor a Mo en b S-elementen, respectievelijk
Figuur 3a toont de longitudinale I -V curve van de gefabriceerde MoS2 /n -GaAs heterojuncties. Twee In-elektroden met een diameter van ongeveer 0,5 mm werden op het oppervlak van de MoS2 . gedrukt film en de achterkant van de GaAs, respectievelijk. De inzet toont de schematische schakeling voor de longitudinale metingen. De voorwaartse spanning wordt gedefinieerd als een positieve voorspanning die wordt aangelegd op de bovenste In-elektrode. Zoals te zien is in de afbeelding, is de gefabriceerde MoS2 /n -GaAs heterojunctie vertoont duidelijk corrigerend gedrag. De rectificatieverhouding (I + /Ik − ) gemeten bij ±-1,0 V is ongeveer 520. In onze experimenten waren zowel In/MoS2 en In/GaAs behoren tot ohmse contacten en hun I -V curven zijn bijna lineair. Dus de rectificerende I -V kenmerk in de heterojunctie is voornamelijk afkomstig van de MoS2 /GaAs-contactpersoon. Figuur 3b toont de transversale I -V curve van de gefabriceerde MoS2 /n -GaAs heterojuncties. Twee In-elektroden met een diameter van ongeveer 0,5 mm werden op het oppervlak van de MoS2 . gedrukt film. De bovenste inzet toont de schematische schakeling voor de dwarsmetingen. Uit de afbeelding, de I -V curve toont een enigszins niet-lineaire toename van de stromen met toenemende spanningen. Dit geeft aan dat een inversielaag op de MoS2 /n -GaAs-interface wordt gevormd [18]. De onderste inzet toont de I -V curven van de enkele MoS2 films op het intrinsieke GaAs-substraat. Uit de figuur, een bijna lineaire I -V curve kan worden gezien, wat verder de ohmse aard van de In/MoS2 . aangeeft contact. Bij de spanning van + 0,5 V, de stroom van de enkele MoS2 is ongeveer 3,1 × 10 −2 μA, veel kleiner dan de waarde in de MoS2 /n -GaAs, ongeveer 2,3 A. Dus, vergeleken met de MoS2 film, de inversielaag bij de MoS2 /n -GaAs-interface levert een pad met een veel lagere soortelijke weerstand voor dragertransport tijdens de transversale metingen van de MoS2 /n -GaAs heterojunctie.

een Longitudinaal I -V curve van de gefabriceerde MoS2 /n -GaAs heterojuncties. De inzet toont de schematische schakeling voor de longitudinale metingen. b Dwars I -V krommen van de gefabriceerde MoS2 /n -GaAs heterojuncties. De bovenste inzet toont de schematische schakeling voor de dwarsmetingen. De onderste inzet toont de I -V curven van de MoS2 films op het intrinsieke GaAs-substraat
Figuur 4a toont het schematische circuit voor het meten van de LPE van de gefabriceerde MoS2 /GaAs heterojunctie. Twee In-elektroden met een diameter van 0,5 mm worden op het oppervlak van de MoS2 . gedrukt film om de metingen van de LPE uit te voeren. De afstand (2L ) tussen de elektroden is ~ 1,0 mm. Tijdens onze metingen werden elektroden A en B respectievelijk verbonden met de positieve en negatieve sondes van een Keithley 2000 voltmeter. Figuur 4b toont de LPE-curves van de MoS2 /n -GaAs en MoS2 /p -GaAs heterojuncties, respectievelijk. De dikte van de MoS2 films is ~ 30,0 nm. Wanneer het oppervlak van de MoS2 film wordt gedeeltelijk verlicht door een laserspot met een diameter van ongeveer 0,1 mm, een grote LPE kan worden waargenomen in de MoS2 /n -GaAs heterojunctie. Zoals te zien is in de afbeelding, vertoont de LPE een ongeveer lineaire afhankelijkheid van de positie van de laservlek wanneer de laservlek beweegt tussen elektroden A en B op de MoS2 oppervlakte. Uit de figuur kunnen we zien dat de LPV afhangt van de positie van de laserspot. Dit kan worden gefit met de diffusietheorie [16],
$$ \mathrm{LPV}={K}_0\Big[\exp \left(-\frac{\left|Lx\right|}{d}\right)-\exp \left(-\frac{\left |L+x\rechts|}{d}\rechts) $$waar K 0 , 2L , d , en x vertegenwoordigen respectievelijk een evenredigheidscoëfficiënt, de afstand tussen twee elektroden, de dragerdiffusielengte en de laserspotpositie. De goed passende resultaten in de figuur suggereren duidelijk dat de LPE in de MoS2 /n -GaAs heterojunctie ontstaat door de laterale diffuse stroming en recombinatie van de aangeslagen dragers weg van de laserpositie. Zoals te zien is in de figuur, is de LPV-waarde nul wanneer de lichtvlek zich in het midden tussen twee elektroden bevindt, wat kan worden toegeschreven aan de diffusiesymmetrie van de dragers. Wanneer de lichtpositie dicht bij de A-elektrode is, is de LPV positief en vice versa. Dit geeft aan dat de LPE in de MoS2 /n -GaAs heterojunctie wordt veroorzaakt door de foto-geëxciteerde dragers van het gattype. De maximale LPV wordt verkregen wanneer de laserverlichting het dichtst bij de elektroden is. Volgens onze metingen is de maximale laterale fotospanning (LPVmax ) is ongeveer 208,2 mV in het lineaire gebied van de MoS2 /n -GaAs heterojunctie. Ter vergelijking:de LPV van de MoS2 /p -GaAs heterojunctie is veel kleiner en de LPVmax is slechts 7,3 mV, zoals weergegeven in de afbeelding. Uit de figuur kunnen we zien dat de LPE van de MoS2 /p -GaAs heterojunctie wordt bepaald door de elektronen-type foto-geëxciteerde dragers. Bovendien, niet-lineaire LPE-kenmerken van de MoS2 /p -GaAs heterojunctie is te zien aan de figuur wanneer de laservlek tussen de A- en B-elektroden beweegt.
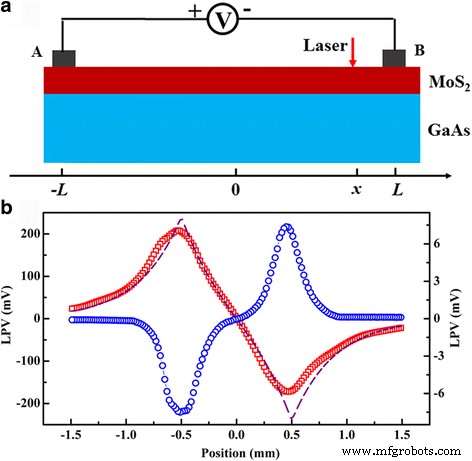
een Schematische schakeling voor het meten van de LPE. b LPE-curven van de MoS2 /n -GaAs en MoS2 /p -GaAs heterojuncties, respectievelijk
Afbeelding 5 toont de LPE-gevoeligheid van de MoS2 /n -GaAs heterojunctie als functie van het laservermogen en de dikte (d MoS2 ) van de MoS2 film. De gevoeligheid wordt gedefinieerd door S =LPVmax /L . Het is duidelijk dat de S neemt aanvankelijk drastisch toe met toenemend laservermogen, maar verzadigt dan langzaam wanneer het vermogen verder toeneemt. Deze verzadiging kan worden veroorzaakt door de snel toenemende recombinatiesnelheid van de foto-geëxciteerde gaten met toenemende laserintensiteit in het verlichte gebied [20]. Zoals te zien is in de afbeelding, kan een duidelijke LPE en een hoge gevoeligheid worden verkregen, zelfs onder de zwakke laserverlichting van 100,0 μW. Uit de figuur blijkt een significante afhankelijkheid van de gevoeligheid van de dikte van de MoS2 films te zien zijn. Wanneer d MoS2 =~ 10.0 nm, S =165,4 mV mm −1 onder de laserverlichting van 100,0 μW. Met toenemende filmdikte, S neemt geleidelijk toe. Wanneer d MoS2 =30,0 nm, S bereikt 416,4 mV mm −1 . Deze gevoeligheid is veel groter dan de gerapporteerde MoS2 /Si-apparaten [17, 18]. Na d MoS2> 30,0 nm, S neemt af met verder toenemende MoS2 dikte. Wanneer d MoS2 =90,0 nm, S = 283,3 mV mm −1 . Om de grootste LPE en gevoeligheid te verkrijgen, is er dus een optimale dikte van de MoS2 film in de gefabriceerde MoS2 /n -GaAs, ongeveer 30,0 nm.

Afhankelijkheid van positieve en negatieve gevoeligheden van de gefabriceerde MoS2 /n -GaAs heterojunctie op laservermogens, respectievelijk
Afbeelding 6a toont de UPS-spectra van de MoS2 film op het Si-substraat. De werkfunctie (W ) van de film kan worden berekend uit het verschil tussen de grens van de hoogste bindingsenergie en de fotonenergie van de opwindende straling. Uit de afbeelding, W =5,24 eV kan worden verkregen. De afstand (∆E ) tussen de valentieband (E V ) en het Fermi-niveau (E F ) van MoS2 film kan worden geëxtraheerd uit de beginenergie, zoals weergegeven in de inzet. De ∆E voor de MoS2 film is ongeveer 0,51 eV. Gebruik van de gegevens uit het transmissiespectrum van de MoS2 film op kwartssubstraat, (αhν ) 2 is uitgezet als functie van de fotonenergie hν , waarbij h is de constante van Planck en ν is de fotonfrequentie. De α is de absorptiecoëfficiënt, berekend door αd =ln(1/T ) [21], waarbij d en T zijn respectievelijk de dikte en de transmissie van de film. De band gap (E g ) van de film kan worden bepaald vanaf het snijpunt van de lijn op de hν as, E g =1,54 eV, zoals weergegeven in Fig. 6b. Op basis van deze energiebandparameters wordt de p -type gedrag van de MoS2 film kan worden bepaald, wat verder kan worden bewezen door Hall-metingen. De Hall-resultaten laten zien dat de concentratie van de drager van het gattype en de mobiliteit ongeveer 3,8 × 10 15 zijn cm −3 en 11,2 cm 2 V −1 s −1 , respectievelijk.

een UPS-spectra van de MoS2 film op GaAs, die het Fermi-niveau van de films en de afstand tussen het Fermi-niveau en de bovenrand van de geleidingsband laat zien. b (αhν ) 2 ~hν curve van het UV-spectrum van de MoS2 film op kwartssubstraat onder dezelfde depositieconditie
Om de mechanismen van de LPE in de MoS2 . te verduidelijken /GaAs-heterojuncties, de energiebanddiagrammen op de interface zijn geconstrueerd op basis van de resultaten in Fig. 6. Hier, E g =1,42 eV en E F =4,17 eV voor n -GaAs wordt in aanmerking genomen om de bandstructuur te construeren [22]. Wanneer de MoS2 film wordt afgezet op het GaAs-substraat, de elektronen stromen van de GaAs naar de MoS2 film op de interface vanwege de hogere E F van de GaAs. Het vloeiende proces stopt wanneer de Fermi-niveaus gelijk zijn en de MoS2 /GaAs p -n verbinding wordt gefabriceerd, zoals weergegeven in Fig. 7a. Bijgevolg is een ingebouwd veld (E twee ) wordt gevormd op de interface van de MoS2 /GaAs heterojunctie. E twee =[E F (n -GaAs) − E F (MoS2 )]/e =1,07 V en het wijst van de GaAs naar de MoS2 film. Dus de asymmetrische longitudinale I -V curve wordt getoond in Fig. 3a. Vanwege het bestaan van een sterke E twee , worden grote hoeveelheden dragers van het gattype verzameld nabij het grensvlak en wordt een inversielaag gevormd in de n -GaAs-substraat nabij het grensvlak, zoals weergegeven in Fig. 7b. Vergelijkbaar met het tweedimensionale gatengas (2DHG) [23], zou de inversielaag het kenmerk van hoge geleiding kunnen vertonen vanwege de hoge plaatconcentratie van de gaten (p+ ). Uit Fig. 3b kunnen we zien dat de geleiding van de inversielaag veel groter is dan de MoS2 film. Dus de geleiding tussen twee elektroden aan dezelfde kant van de MoS2 film wordt gedomineerd door de inversielaag in plaats van de MoS2 film. Wanneer de junctie gedeeltelijk wordt verlicht door de laser, wordt het licht geabsorbeerd en de elektron-gat-paren in de MoS2 film en GaAs kunnen respectievelijk worden geïnduceerd, zoals getoond in Fig. 7c. Het kan echter worden verwacht dat het grootste deel van de laser wordt geabsorbeerd door de GaAs-substraten vanwege de veel grotere dikte en kleinere bandafstand. Onder de laserbelichting kunnen de elektron-gatparen alleen worden geëxciteerd in het verlichte gebied en ruimtelijk gescheiden door de E twee . Door de oriëntatie van de E twee wijzend van GaAs naar MoS2 , stromen de foto-geëxciteerde gaten naar het grensvlak en gaan ze de inversielaag in de GaAs binnen, zoals weergegeven in figuur 7c. De foto-exciteerde gaten in de inversielaag diffunderen zijdelings weg van de verlichte plek naar de twee elektroden. De concentratie van de geëxciteerde gaten die door de twee elektroden worden verzameld, is verschillend voor verschillende afstanden tot de verlichte plek. Er wordt dus een grote LPV gevormd tussen de elektroden en de LPE wordt waargenomen in de heterojunctie. Dit is in overeenstemming met de gefitte resultaten van Fig. 3b, en de LPE in de MoS2/n -GaAs heterojuncties zijn voornamelijk afkomstig van de dragerdiffusie. Wanneer de MoS2 film wordt afgezet op de p -GaAs-substraat, a p -p heterojunctie wordt gevormd, zoals weergegeven in figuur 7d. E F (p -GaAs) =5,32 eV wordt gebruikt in het banddiagram [22]. De E twee van de p -p heterojunctie kan worden berekend, 0,08 V, en de richting wijst van de film naar het substraat. Vanwege de E twee , elektronen-type dragers worden geaccumuleerd nabij het grensvlak van de heterojunctie en de inversielaag wordt gevormd. Zo wordt het LPE dat wordt geïnduceerd door de diffusie van de foto-geëxciteerde elektronen verkregen in de MoS2 /GaAs p -p heterojunctie, zoals weergegeven in Fig. 4. De concentratie van de geaccumuleerde drager in de inversielaag kan echter lager zijn vanwege de zwakke V twee van slechts 0,08 V in de p -p heterojunctie vergeleken met de p -MoS2 /n -GaAs-knooppunt. Dit vergroot de moeilijkheden van het transport van de foto-aangeslagen elektronen in de inversielaag. Serieus, de Schottky-barrières kunnen worden gevormd tussen de n -type inversielaag en de p -MoS2 film, zoals getoond in Fig. 7e. Deze kenmerken van de p -MoS2 /p -GaAs-junctie onderdrukken de verzameling van de foto-geëxciteerde elektronen bij de elektroden. Als gevolg hiervan kon de LPE grotendeels worden verminderd. Zoals getoond in Fig. 4b, is de LPVmax voor de p -p junctie is slechts 7,3 mV terwijl deze 208,2 mV bereikt in de p -n kruising.

een Uitlijning van de energieband van de MoS2 /n -GaAs heterojunctie, en b de bijbehorende afbeelding van het elektrisch contact op de interface. c Mechanisme van de LPE in de MoS2 /n -GaAs heterojunctie. d Uitlijning van de energieband van de MoS2 /p -GaAs heterojunctie, en e de bijbehorende afbeelding van het elektrisch contact op de interface
Het gebeurt meestal in de gerapporteerde heterojunctie-type PSD's dat de LPE kan worden afgesteld door de dikte van de afdeklagen te veranderen [20]. Dit kan goed worden begrepen door rekening te houden met de recombinatie van de foto-geëxciteerde dragers in de film en de evolutie van het ingebouwde veld. In de MoS2 /GaAs p -n knooppunt kan de recombinatie van door fotonen gegenereerde dragers worden verbeterd dankzij het lange transportpad in de dikke MoS2 film voordat ze door de elektroden worden opgevangen. Dit vermindert de LPE van de heterojuncties. Omgekeerd kan een dunnere film de recombinatie sterk verminderen, wat de toename van de LPE veroorzaakt. Wanneer de MoS2 dikte kleiner is dan de kritische waarde, de E twee op het grensvlak neemt af met verder afnemende MoS2 dikte [24]. Dit kan de scheiding van door fotonen gegenereerde elektron-gatparen verminderen en de LPE neemt af. Zo is er een optimale dikte van de MoS2 film voor het verkrijgen van de hoogste LPE, ongeveer 30 nm.
Conclusies
Samengevat, MoS2 dunne films werden via magnetron-sputtertechniek op het oppervlak van het GaAs-substraat afgezet. Een grote LPE werd verkregen in de gefabriceerde MoS2 /n -GaAs heterojunctie en de afhankelijkheid van de LPV van de positie van de laserverlichting vertoonden een goede lineariteit. Door de vorming van het sterke ingebouwde veld aan de interface is de MoS2 /n -GaAs heterojunctie vertoonde een hoge gevoeligheid van 416,4 mV mm −1 , terwijl de waarde slechts 7,3 mV mm −1 . was voor de MoS2 /p -GaAs. Onze resultaten toonden verder aan dat de LPE een duidelijke afhankelijkheid vertoonde van de dikte van de MoS2 films en ongeveer 30,0 nm was de optimale dikte van de MoS2 film om de hoogste LPE in de gefabriceerde MoS2 . te verkrijgen /n -GaAs heterojuncties. De mechanismen naar de LPE in de MoS2 /GaAs-apparaten werden opgehelderd op basis van de uitlijning van de energieband op de interface.
Afkortingen
- ∆E :
-
Afstand tussen E V en E F
- d MoS2 :
-
Dikte van de MoS2 film
- E twee :
-
Ingebouwd veld
- E C :
-
Geleidingsbandniveau
- E F :
-
Fermi energieniveau
- E g :
-
Energieband kloof
- E V :
-
Valentiebandniveau
- Ik -V :
-
Stroom-spanning
- LPE:
-
Lateraal fotovoltaïsch effect
- LPV:
-
Laterale fotospanning
- LPVmax :
-
Maximale laterale fotospanning
- MoS2 :
-
Molybdeendisulfide
- PSD:
-
Positiegevoelige detector
- UPS:
-
Ultraviolette foto-elektronenspectroscopie
- W :
-
Werkfunctie
Nanomaterialen
- Fotovoltaïsche kenmerken van GaSe/MoSe2 heterojunctie-apparaten
- MoS2 met gecontroleerde dikte voor elektrokatalytische waterstofevolutie
- Temperatuurafhankelijke kristallisatie van MoS2-nanovlokken op grafeen-nanobladen voor elektrokatalyse
- Weinig gelaagde MoS2/acetyleenzwarte composiet als een efficiënt anodemateriaal voor lithium-ionbatterijen
- Bias-afhankelijke fotoresponsiviteit van meerlaagse MoS2-fototransistoren
- Zeer verbeterde H2-detectieprestaties van MoS2/SiO2/Si-heterojuncties met weinig lagen door oppervlaktedecoratie van Pd-nanodeeltjes
- Effect van verschillende CH3NH3PbI3-morfologieën op fotovoltaïsche eigenschappen van perovskiet-zonnecellen
- Optimalisatie van GaAs Nanowire Pin Junction Array-zonnecellen met behulp van AlGaAs/GaAs Heterojunctions
- Verbeterde fotovoltaïsche eigenschappen in Sb2S3 vlakke heterojunctie zonnecel met een snelle selenyleringsbenadering
- Dragertransporteigenschappen van MoS2 asymmetrische gassensor onder ladingoverdracht-gebaseerde barrièremodulatie
- Waarneming van extrinsiek foto-geïnduceerd inverse spin-hall-effect in een GaAs/AlGaAs tweedimensionaal elektronengas



