Bipolaire resistieve schakelkenmerken van HfO2/TiO2/HfO2 drielaagse structuur RRAM-apparaten op Pt- en TiN-gecoate substraten vervaardigd door atomaire laagafzetting
Abstract
De HfO2 /TiO2 /HfO2 drielaagse-structuur resistieve random access memory (RRAM) apparaten zijn vervaardigd op Pt- en TiN-gecoate Si-substraten met Pt-topelektroden door atomaire laagafzetting (ALD). Het effect van de onderste elektroden van Pt en TiN op de resistieve schakeleigenschappen van drielaagse structuureenheden is onderzocht. Beide Pt/HfO2 /TiO2 /HfO2 /Pt en Pt/HfO2 /TiO2 /HfO2 /TiN vertonen typisch bipolair resistief schakelgedrag. De dominante geleidingsmechanismen in lage en hoge weerstandstoestanden (LRS en HRS) van beide geheugencellen zijn respectievelijk Ohms gedrag en ruimtelading-beperkte stroom. Het is gebleken dat de onderste elektroden van Pt en TiN een grote invloed hebben op de polariteitsvoorkeur voor elektroformering, de verhouding van hoge en lage weerstand en dispersie van de bedrijfsspanningen van geheugencellen met drielagige structuur. Vergeleken met het gebruik van symmetrische Pt boven-/onderelektroden, vertonen de RRAM-cellen die asymmetrische Pt boven-/TiN-onderelektroden gebruiken een kleinere negatieve vormingsspanning van −3,7 V, een relatief smalle verdeling van de set/reset-spanningen en een lagere verhouding van hoge en lage weerstanden van 10 2 . De elektrode-afhankelijke elektroformeringspolariteit kan worden geïnterpreteerd door rekening te houden met de chemische activiteit van de elektroden met zuurstof, de gerelateerde reacties aan de anode en de niet-uniforme verdeling van de zuurstofvacatureconcentratie in de drielaagse structuur van HfO2 /TiO2 /HfO2 op Pt- en TiN-gecoat Si. Bovendien, voor Pt/HfO2 /TiO2 /HfO2 /TiN-apparaten, speelt de TiN-elektrode als zuurstofreservoir een belangrijke rol bij het verminderen van de vormingsspanning en het verbeteren van de uniformiteit van resistieve schakelparameters.
Achtergrond
Resistive Random Access Memory (RRAM) heeft veel aandacht getrokken vanwege het potentieel voor de vervanging van flash-geheugen in niet-vluchtige geheugens van de volgende generatie [1,2,3]. Het fenomeen van resistief schakelen (RS) is op grote schaal ontdekt in overgangsmetaaloxiden, vaste elektrolyten en organische polymeren [4,5,6,7]. RRAM-apparaten op basis van overgangsmetaaloxiden zijn uitgebreid onderzocht vanwege de eenvoudige samenstelling en compatibele verwerking met conventionele complementaire metaaloxide-halfgeleider (CMOS) fabricage [8,9,10]. Het filamentmodel van zuurstofvacaturemigratie wordt gebruikt om het schakelgedrag op te helderen [1, 11]. Er wordt een uniform microscopisch principe voorgesteld om zowel unipolaire als bipolaire schakelkarakteristieken van op overgangsmetaaloxide gebaseerde RRAM te kwantificeren, die gecorreleerd zijn met de verdeling van gelokaliseerde zuurstofvacatures in de oxideschakellaag [12, 13].
Geheugencellen die overgangsmetaaloxiden gebruiken, lijden echter aan niet-uniformiteit van resistieve schakelparameters, zoals onstabiele weerstandswaarden van lage en hoge weerstandstoestanden (LRS en HRS), verspreide set- en resetspanningen, die de commerciële toepassingen belemmeren. Onlangs is aangetoond dat de op oxide gebaseerde RRAM-apparaten met drie lagenstructuur de spreiding van resistieve schakelparameters verbeteren. De cellen met een structuur van Al2 O3 /HfO2 /Al2 O3 vertoonde een fantastische uniformiteit van set- en reset-spanningen en een uitstekend uithoudingsvermogen bij het schakelen tussen de LRS en HRS [14]. De koppeling of breuk van de geleidende filamenten trad gemakkelijker op in twee grensvlaklagen tussen Al2 O3 /IL/HfO2 /IL/Al2 O3 . Ondertussen is de eenheid van drielaagse structuur van TaOx /TiO2 /TaOx vertoonde goede prestaties in één selector-één weerstandsarrays, wat werd toegeschreven aan het feit dat de energieband van de TiO2 film was aan de boven- en onderkant symmetrisch gebogen TaO x /TiO2 grensvlakken en gewijzigd als een kuifoxidebarrière vanwege diffusie van enkele Ta-atomen in TiO2 film [15].
Bovendien kan het RS-gedrag van een bepaald oxide-opslagmedium aanzienlijk worden beïnvloed door de elektrodematerialen [1, 16, 17]. De bestaande modellen gebaseerd op de vrije energie van grensvlakoxidevorming en de metaalbewerkingsfuncties zijn echter onvoldoende om de resultaten volledig te verklaren. Ondertussen ontbreekt het momenteel ook nogal aan het van de elektroden afhankelijke RS-fenomeen van het RRAM met drielagige structuur.
Atomic Layer Deposition (ALD) is een nieuw type dunnefilmdepositietechnologie gebaseerd op sequentiële zelfbeperkende en complementaire oppervlaktechemisorptiereacties met behulp van precursordamp met eenvoudige en nauwkeurige diktecontrole, uniformiteit van het grote oppervlak en uitstekende driedimensionale conformiteit, vooral voor afzetting van nano-gelamineerde structuur [18, 19].
In dit werk, de HfO2 /TiO2 /HfO2 RRAM-apparaten met drie lagenstructuur zijn voorbereid op Si/SiO2 /Ti/Pt- en Si/TiN-substraten met Pt-topelektroden van ALD. De impact van de onderste elektroden van Pt en TiN op het RS-gedrag van HfO2 /TiO2 /HfO2 apparaten is zorgvuldig onderzocht. De bijbehorende verklaring is voorgesteld.
Methoden
In dit experiment hebben we twee verschillende bodemelektroden gebruikt, waaronder commerciële Si/SiO2 /Ti/Pt en zelfgemaakte Si/SiO2 /Blik. Geleidend TiN werd afgezet door plasma-enhanced atomic layer deposition (PEALD) in ons laboratorium.
ALD werd uitgevoerd in een commerciële Picosun SUNALE TM R-200 geavanceerde reactor (Picosun, Finland). P type Si (100) wafels met een soortelijke weerstand van 1 ~ 10 Ω cm werden gebruikt als uitgangssubstraten. Na de conventionele RCA-reiniging van de Si-wafels zonder natief oxide te verwijderen, werd 30 nm dik TiN afgezet op Si als de onderste elektrode bij 400 ° C door PEALD, met behulp van TiCl4 kamertemperatuur en NH3 plasmagas als respectievelijk de Ti- en N-precursors. Vloeibare NH3 werd geselecteerd als NH3 plasmabron bij kamertemperatuur. Het plasmavermogen en NH3 gasstroomsnelheid waren respectievelijk 2500 W en 150 sccm.
Vervolgens 5 nm HfO2 /10 nm TiO2 /5 nm HfO2 stapelstructuren werden op hun beurt afgezet op Pt- en TiN-gecoate Si-substraten bij 250 ° C door thermische ALD met behulp van Hf[N(C2 H5 )CH3 ]4 (TEMAH), TiCl4 , en H2 O als respectievelijk de Hf-, Ti- en O-precursoren, waarbij één oxidecyclus uit 0,1s bestond metaalbroninjectie, 4s N2 zuiveren, 0.1s H2 O injectie, en 4s N2 zuiveren. TEMAH werd verdampt bij 150°C. Pure N2 (99,999%) werd gebruikt als draaggas en spoelgas. Vervolgens werden 100 nm dikke Pt-topelektroden DC gesputterd door een schaduwmasker met een diameter van 150 μm met behulp van het Q150T-systeem.
De groei per cyclus (GPC) van pure HfO2 of TiO2 op Si werd bepaald met een spectroscopische ellipsometer (GES-5, Sopra). De topografie en oppervlakteruwheid van de films en bodemelektroden werden geanalyseerd met atomaire krachtmicroscopie (AFM, Cypher, Asylum Research). De RMS-ruwheidswaarden werden geregistreerd van 1 μm × 1 μm-gebieden. De samenstelling en chemische toestand van de stapelstructuren werden onderzocht met röntgenfoto-elektronspectroscopie (XPS, Thermo Fisher K-Alpha) met een monochromatische Al Kα bron (hν = 1486.6 eV) voor excitatie van foto-elektronen. Het laadeffect werd gekalibreerd door de C 1s . in te stellen foto-emissie bij 284,6 eV. Het XPS-diepteprofiel van HfO2 /TiO2 /HfO2 op Pt- en TiN-gecoat Si werd verkregen door Ar-ionenetsen. De elektrische eigenschappen van de HfO2 /TiO2 /HfO2 RRAM-apparaten met drie lagenstructuur werden gemeten door Keithely 4200 halfgeleiderkarakteriseringssysteem op een sondestation (CasCade Summit 12000 B-M). Er werd een stroomconformiteit van 10 mA opgelegd om de gefabriceerde apparaateenheden te beschermen tegen schade door hoge stroomsterkte tijdens ingestelde processen. De voorspanning werd toegepast op de Pt-bovenelektrode met de geaarde onderelektroden van Pt of TiN.
Resultaten en discussie
Het schema van het RRAM-apparaat van HfO2 /TiO2 /HfO2 drielaagse structuur door ALD wordt geïllustreerd in Fig. 1. De oppervlaktemorfologie en ruwheid van de bodemelektroden en drielaagse structuur van HfO2 /TiO2 /HfO2 op Pt- en TiN-gecoat Si zijn onderzocht. De Pt-bodemelektrode heeft een kleinere RMS-waarde van 0,39 nm dan van PEALD afgeleid TiN van 0,87 nm. Vandaar dat de steekproef van HfO2 /TiO2 /HfO2 op met Pt gecoat Si vertoont ook een relatief gladder oppervlak met RMS van 0,68 nm dan dat op TiN-gecoat Si met 1,3 nm.
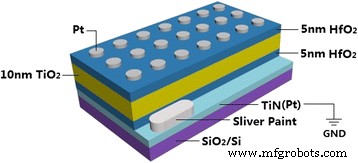
Het schema van het RRAM-apparaat van HfO2 /TiO2 /HfO2 drielaagse structuur door ALD
De DC I-V-curven van Pt/HfO2 /TiO2 /HfO2 /Pt en Pt/HfO2 /TiO2 /HfO2 /TiN-apparaten die het initiële elektroformeringsproces bevatten, zijn uitgezet in respectievelijk Fig. 2a, b, wat wijst op een typische bipolaire resistieve schakelkarakteristiek. Voor bijna alle monsters is een grotere vormingsspanning nodig om geleidende filamenten te vormen vóór de schakeltest. Bij het toepassen van een positieve voorspanning op de Pt-topelektrode, zal de Pt/HfO2 /TiO2 /HfO2 /Pt apparaateenheid toont een vormingsspanning van +7 V in Fig. 2a. Bij voortzetting van de spanningszwaai wordt een resetspanning van -0,8 V gemeten voor eenheidscel van LRS naar HRS en een ingestelde spanning van 2,0 V van HRS naar LRS. De corresponderende verhouding van hoge en lage weerstanden is ongeveer 10 5 . Het elektroformerings- en rustproces kan ook worden voltooid door een negatieve spanning van respectievelijk -11 V en een positieve van +4 V aan te leggen, die veel groter zijn dan de positieve vormings- en negatieve resetspanningen. Bovendien schakelt de apparaatcel slechts enkele cycli van LRS naar HRS na het negatieve vormingsproces en kan vervolgens niet worden gereset naar HRS vanwege de onomkeerbare storing (hier niet weergegeven). In Fig. 2b, vergeleken met die met symmetrische Pt-boven- en onderelektroden, tonen de drielaagse structuur RRAM-apparaten met asymmetrische TiN-bodemelektrode en Pt-bovenelektrode een tegengestelde lagere vormingsspanning van ongeveer -3,7 V, ingestelde spanning van -1,5 V , resetspanning van +1,5 V en relatief kleinere verhouding van hoge en lage weerstanden van 10 2 . Bij het opleggen van de positieve elektroformeringsspanning kan het RS-fenomeen niet worden waargenomen in de Pt/HfO2 /TiO2 /HfO2 /TiN-cel en het apparaat wordt permanent afgebroken bij +14 V zonder de volgende efficiënte reset van LRS naar HRS bij negatieve spanning (hier niet weergegeven).
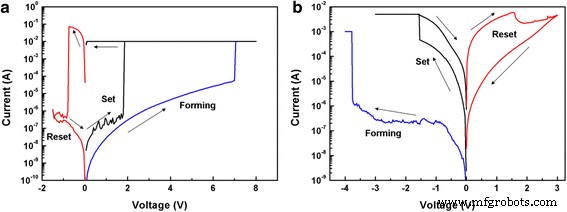
De typische bipolaire resistieve schakelkarakteristieken van de RRAM-apparaten. een Pt/HfO2 /TiO2 /HfO2 /Pt. b Pt/HfO2 /TiO2 /HfO2 /TiN
De RRAM-apparaten met drielagige structuur met symmetrische Pt-boven-/onderelektroden en asymmetrische TiN-onderelektrode/Pt-bovenelektroden vertonen zulke verschillende voorkeur voor elektroformeringspolariteit. De onderste elektrode van chemisch inert Pt of relatief actief TiN lijkt een sleutelrol te spelen. De gerelateerde reden voor elektrode-afhankelijke elektroformeringspolariteit zal later worden besproken na overweging van de XPS-diepteprofielen van drielaagse structuren van HfO2 /TiO2 /HfO2 op Pt- en TiN-gecoat Si.
Voor toepassingen met geheugen met hoge dichtheid is uniformiteit van RS-parameters erg belangrijk. Afbeelding 3a, b geeft de statistische resultaten weer van de distributie van de ingestelde en resetspanningen gemeten vanaf een enkele apparaateenheid van de Pt/HfO2 /TiO2 /HfO2 /Pt en Pt/HfO2 /TiO2 /HfO2 /TiN voor respectievelijk 200 keer testen. Afbeelding 3c, d registreert de I–V-curves van 10 willekeurig geselecteerde apparaateenheden van de Pt/HfO2 /TiO2 /HfO2 /Pt en Pt/HfO2 /TiO2 /HfO2 /TiN, respectievelijk. De RRAM-apparaateenheden met drielagige structuur met symmetrische Pt-elektroden aan de boven- en onderkant vertonen een brede verdeling voor ingestelde spanning van 1,2 tot 2,8 V en resetspanning van -0,5 tot -1 V (Fig. 3a) en dispersieve I-V-curven (Fig. 3c). Terwijl de apparaateenheden met asymmetrische TiN-onder- en Pt-bovenelektroden een beter RS-gedrag vertonen, zoals een relatief geconcentreerde verdeling van de ingestelde spanning van -0,8 tot -1,8 V en een resetspanning van 1,3 tot 1,8 V, en stabiele reproduceerbaarheid in IV-curven (Fig. 3b, d). Tegelijkertijd gedragen verschillende apparaateenheden op TiN-gecoat Si zich ook verbeterde monodispersie in RS-parameters, wat gunstig is voor praktische RRAM-toepassingen.

De statistische resultaten van de distributie van de ingestelde en resetspanningen gemeten vanaf een enkele apparaateenheid voor 200 keer testen. een Pt/HfO2 /TiO2 /HfO2 /Pt. b Pt/HfO2 /TiO2 /HfO2 /Blik. De IV-curven van 10 willekeurig geselecteerde apparaateenheden. c Pt/HfO2 /TiO2 /HfO2 /Pt. d Pt/HfO2 /TiO2 /HfO2 /TiN
De duurzaamheids- en retentie-eigenschappen van de apparaateenheden van Pt/HfO2 /TiO2 /HfO2 /Pt en Pt/HfO2 /TiO2 /HfO2 /TiN zijn onderzocht, zoals te zien is in respectievelijk Fig. 4a-d. In Pt/HfO2 /TiO2 /HfO2 /Pt, de sweep-spanning werd toegepast van 0 tot 3 V voor set en 0 tot -1,5 V voor reset. In Pt/HfO2 /TiO2 /HfO2 /TiN, de sweep-spanning werd toegepast van 0 tot -2 V voor set en 0 tot 2 V voor reset. De AAN- en UIT-weerstandswaarden werden afgelezen met 0,2 V bij kamertemperatuur. De retentietesten zijn gemeten bij kamertemperatuur met een leesspanning van 0,2 V. Na 200 programmeer-/wiscycli Pt/HfO2 /TiO2 /HfO2 /Pt-apparaateenheden vertonen een relatief stabiele weerstandsverhouding van UIT/AAN-toestanden boven 10 5 (Fig. 4a); echter, het uithoudingsvermogen van Pt/HfO2 /TiO2 /HfO2 /TiN-geheugencellen lijken niet zo goed te zijn als die van Pt/HfO2 /TiO2 /HfO2 /Pt (Fig. 4b). De AAN- en UIT-statussen in apparaten met Pt-TiN-elektroden zijn niet erg stabiel met een kleinere weerstandsverhouding van UIT/AAN-statussen van ongeveer 10 2 tijdens de schakelcyclustest, vooral significante HRS-fluctuatie dan die van LRS. Op basis van het fysieke model in Ref. [12], het uithoudingsvermogen zal worden verbeterd door de vormingsenergie van zuurstofvacature en interface O 2− te verhogen hoeveelheid. We speculeren één plausibele verklaring. In ons vorige werk [14], uitstekende bipolaire resistieve schakeleigenschappen van ALD-afgeleide Al2 O3 /HfO2 /Al2 O3 drielaagse structuren met asymmetrische TiN-onder- en Pt-bovenelektroden zijn aangetoond, waaronder een beter schakeluithoudingsvermogen tot 10 3 cycli met stabiele AAN/UIT-weerstandsverhouding. Hierin hebben we HfO2 . aangenomen /TiO2 /HfO2 configureren in plaats van Al2 O3 /HfO2 /Al2 O3 . De metaalionen in HfO2 en TiO2 hebben dezelfde identieke chemische valentie van +4, wat leidt tot minder defecten in de interface geladen, zoals zuurstofvacatures tussen twee grensvlaklagen (IL's) van drielaagse HfO2 /TiO2 /HfO2 . Terwijl de metaalionen in Al2 O3 en HfO2 hebben een verschillende chemische valentie van Al 3+ en Hf 4+ , waardoor meer interface-geladen defecten van zuurstofvacatures tussen twee IL's van Al2 . ontstaan O3 /HfO2 /Al2 O3 . Hieruit kan worden afgeleid dat de interface O 2− bedrag door twee IL's toe te voegen tussen Al2 O3 /HfO2 /Al2 O3 moet hoger zijn dan tussen HfO2 /TiO2 /HfO2 . Bovendien is de vormingsenergie van zuurstofvacature in opslaglaag van Al2 O3 /HfO2 /Al2 O3 is ook hoger dan die van HfO2 /TiO2 /HfO2 (formatie-energie van zuurstoftekort 7,08 eV (Al2 O3 ), 6,53 eV (HfO2 ), en 4,35 eV (TiO2 ) [20, 21]). Na overweging van deze factoren, de geheugencel van Pt/HfO2 /TiO2 /HfO2 /TiN vertoont degeneratie van het uithoudingsvermogen, vergeleken met Pt/Al2 O3 /HfO2 /Al2 O3 /TiN.

De duurzaamheids- en retentiekenmerken van de apparaateenheden. een , c Pt/HfO2 /TiO2 /HfO2 /Pt. b , d Pt/HfO2 /TiO2 /HfO2 /TiN.
Voor Pt/HfO2 /TiO2 /HfO2 /Pt en Pt/HfO2 /TiO2 /HfO2 /TiN, het weerstandsniveau van de AAN- en UIT-statussen heeft geen duidelijke veranderingen na een cumulatieve wachttijd van 10 4 s bij kamertemperatuur in Fig. 4c-d, wat wijst op een betere retentie-eigenschap van beide geheugencellen gedurende 10 jaar op basis van de extrapolatiemethode.
Pt/HfO2 /TiO2 /HfO2 /TiN-apparaten hebben een veel lagere weerstandsverhouding van UIT/AAN-toestanden dan Pt/HfO2 /TiO2 /HfO2 /Pt, wat kan worden toegeschreven aan het verschil van de onderste elektroden in werkfunctie en geleidbaarheid. De werkfunctie van Pt- en TiN-bodemelektroden is respectievelijk 5,65 en 4,5 eV; vandaar de interface-barrière tussen TiN en onderliggende HfO2 is relatief lager in de Pt/HfO2 /TiO2 /HfO2 /TiN-apparaat. Tijdens een resetproces is de benodigde energie voor het elektron om de barrière te passeren ook kleiner. Dus Pt/HfO2 /TiO2 /HfO2 /TiN vertoont een lagere weerstandswaarde in de UIT-toestand dan Pt/HfO2 /TiO2 /HfO2 /Pt dienovereenkomstig. Tijdens een vast proces verandert het RRAM-apparaat van HRS in LRS vanwege de vorming van de geleidende kanalen. De Pt-bodemelektrode heeft een hogere geleidbaarheid dan de TiN-bodemelektrode; dienovereenkomstig, de weerstandswaarde in AAN-status voor Pt/HfO2 /TiO2 /HfO2 /TiN is hoger dan die voor Pt/HfO2 /TiO2 /HfO2 /Pt. Als resultaat, Pt/HfO2 /TiO2 /HfO2 /TiN-apparaten vertonen een kleinere weerstandsverhouding van UIT/AAN-statussen van 10 2 . De weerstandsverhouding van 10 2 heeft al voldaan aan de vereisten van RRAM-toepassingen.
Om het geleidende mechanisme tijdens resistief schakelen te verduidelijken, worden de typische IV-curven opnieuw geplot op dubbellogaritmische schaal. Afbeelding 5a, b toont de lineaire aanpassing van de I–V-curven voor de spanningsvegende gebieden van Pt/HfO2 /TiO2 /HfO2 /Pt en Pt/HfO2 /TiO2 /HfO2 /TiN-apparaten. Beide geheugencellen gedragen zich vergelijkbaar geleidend mechanisme. Wanneer het apparaat wordt overgeschakeld naar de LRS, zijn de curven van log (I)-log (V) lineair met een helling dicht bij 1 (0,94 in Fig. 5a, 0,98 in Fig. 5b), wat aangeeft dat de I-V bij de LRS wordt gedomineerd door de wet van Ohm. Het filamentmodel van zuurstofvacaturemigratie kan worden gebruikt om het schakelgedrag te verklaren. Voor de HRS, in het laagspanningsgebied (absolute waarde <0,11 V), wordt de I-V gedomineerd door de wet van Ohm met de lineaire relatie tussen stroom en spanning (helling 1.05 in Fig. 5a, 1.09 in Fig. 5b). Bij een hoger spanningsgebied (6,8 V > absolute waarde> 0,11 V in Fig. 5a, 1,85 V > absolute waarde> 0,11 V in Fig. 5b), is de helling van de log (I)-log (V) lijnen ongeveer 2 en de stroom is afhankelijk van het geschatte kwadraat van de aangelegde spanning (I/V 2 ). Bij kritische spanning (absolute waarde 6,8 V in Afb. 5a, 1,85 V in Afb. 5b), verschijnt plotseling een steile stroomstijging met een zeer grote helling. Dit resultaat bestaat uit drie regio's in HRS, die in principe gehoorzamen aan de typische trap-gecontroleerde space-charge-limited conduction (SCLC) injectie [11].
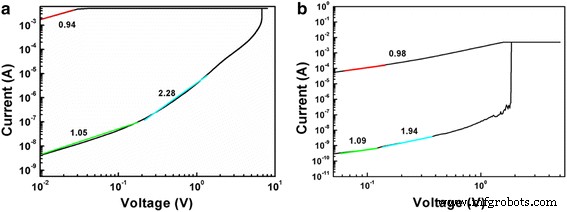
De typische I–V-curves uitgezet op dubbellogaritmische schaal van a Pt/HfO2 /TiO2 /HfO2 /Pt en b Pt/HfO2 /TiO2 /HfO2 /TiN
Om het onderliggende resistieve schakelmechanisme van HfO2 . beter te begrijpen /TiO2 /HfO2 op Pt-gecoat en TiN-gecoat Si hebben we de XPS-smalle scans en diepteanalyses uitgevoerd op drielaagse structuren met symmetrische en asymmetrische onder-/bovenelektroden. XPS-spectra werden uitgerust met Gauss-Lorentziaanse (G-L) functies na slimme achtergrondaftrekking.
Afbeelding 6a–d illustreert de narrow-scan XPS-spectra van Hf 4f , Ti 2p , en O 1s pieken in HfO2 en TiO2 lagen op TiN-gecoat Si. De Hf 4f en Ti 2p-spectra van HfO2 en TiO2 lagen kunnen worden gedeconvolueerd in twee groepspieken. Hoe sterker Hf 4f 5/2 en Hf 4f 7/2 pieken bij 18,4 en 16,7 eV met een spin-orbit-splitsing van 1,7 eV worden toegewezen aan Hf-O-binding (Hf 4+ ) van HfO2 (Fig. 6a). De zwakkere spin-orbit-doubletpieken bij een lagere bindingsenergie van 17,6 en 14,8 eV zijn mogelijk het gevolg van de lage chemische valentietoestand van Hf n + –O (n < 4), wat wijst op de aanwezigheid van zuurstofvacatures in HfO2 laag. De berekende procentuele concentratie van Hf n + (n < 4) is ongeveer 3,7% in Hf-ionen. In Fig. 6b komt een sterker doublet overeen met Ti 2p 3/2 en 2p 1/2 kenmerken bij 458,8 en 464,5 eV, behorend tot de Ti–O-binding (Ti 4+ ) van TiO2 . Een zwakker doublet lokaliseert op 456,1 en 462,0 eV, toewijzend aan de Ti 3+ –O binding. De berekende procentuele concentratie van Ti 3+ is ongeveer 21% in Ti-ionen. Dit impliceert het bestaan van zuurstofvacatures in TiO2 laag.
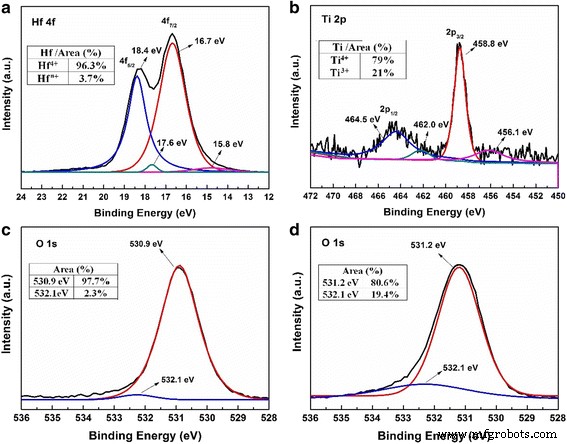
Narrow-scan XPS-spectra van drielaagse structuur van HfO2 /TiO2 /HfO2 op TiN-gecoat Si. een Hf 4f, b Ti 2p pieken van HfO2 /TiO2 /HfO2. O 1s pieken van c HfO2 en d TiO2 lagen
De O 1s spectra van HfO2 en TiO2 lagen kunnen ook worden gedeconvolueerd in twee pieken, zoals te zien is in figuur 6c, d. De relatief lagere bindingsenergieën van de O 1s piek bij ~530,9 en 531,2 eV worden toegewezen aan Ti-O- en Hf-O-binding in TiO2 en HfO2 lagen die respectievelijk behoren tot roosterzuurstof zonder zuurstofvacatures. Terwijl de iets hogere energie van 532,1 eV in de O 1s spectra van Fig. 6c, d worden toegeschreven aan de zuurstofatomen nabij zuurstofvacatures in HfO2 en TiO2 lagen op basis van de literatuurrapporten [22,23,24,25]. De relatieve zuurstofleegstandconcentratie in de oxidelaag kan ruwweg worden beoordeeld door de oppervlakteverhouding van elke piek te berekenen [22, 23]. De berekende procentuele concentratie zuurstoftekort in HfO2 en TiO2 lagen is respectievelijk ongeveer 2,3 en 19,4%, in overeenstemming met de resultaten van Hf n + en Ti 3+ .
Afbeelding 7a, b toont de XPS-diepteprofielen van HfO2 /TiO2 /HfO2 monsters op Pt- en TiN-gecoat Si door respectievelijk Ar-ionenetsen. De drielaagse structuur van HfO2 /TiO2 /HfO2 op Pt- en TiN-gecoat Si kan gemakkelijk worden herkend, hoewel de significante grensvlakdiffusie tussen HfO2 /TiO2 en HfO2 /TiN is waargenomen. Gewoonlijk domineert het filamentmodel van migratie van zuurstofvacatures het RS-gedrag in RRAM-apparaten op basis van overgangsmetaaloxiden [11]. Het simpelweg verhogen van het gehalte aan zuurstofvacatures is echter niet volledig effectief. Hoe de distributie van zuurstofvacature-filamenten effectief kan worden gecontroleerd, is een belangrijk punt om uiteindelijk de RS-uniformiteit te verbeteren [20]. Veel werk heeft aangetoond dat een niet-uniforme verdeling van zuurstofvacatures gewoonlijk gunstig is voor het RS-gedrag, waaronder het verlagen van de vormingsspanning, het verbeteren van de schakelstabiliteit en het uithoudingsvermogen [1, 14, 20, 26,27,28,29]. Een aanvankelijk niet-uniforme verdeling van zuurstofvacatures in een opslagoxidelaag wordt vaak verkregen door het gebruik van een chemisch actieve elektrode met een relatief hoge zuurstofaffiniteit (bijv. Ta, Ti, Al of TiN) of door het opzettelijk introduceren van een zuurstofvacaturerijke grensvlaklaag door interface-engineering [1, 17, 30].
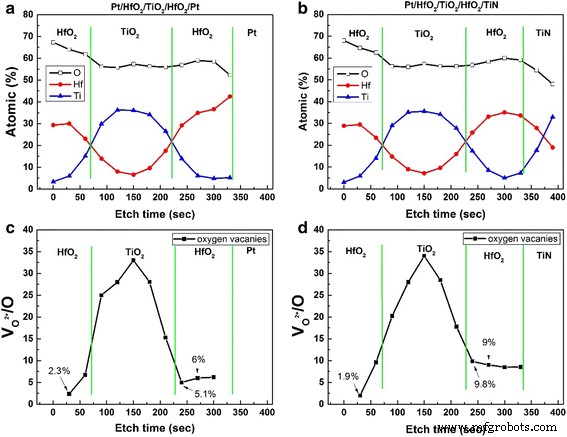
XPS-diepteprofielen van HfO2 /TiO2 /HfO2 op Pt- en TiN-gecoat Si door Ar-ionenetsen. een HfO2 /TiO2 /HfO2 op Pt-gecoat Si. b HfO2 /TiO2 /HfO2 op TiN-gecoat Si. De diepteverdeling van de zuurstofvacatureconcentratie (V O 2+ /O) bepaald uit XPS-spectra voor HfO2 /TiO2 /HfO2 op Pt- en TiN-gecoat Si. c HfO2 /TiO2 /HfO2 op Pt-gecoat Si. d HfO2 /TiO2 /HfO2 op TiN-gecoat Si
Afbeelding 7c, d geeft de distributiecurves van de zuurstofvacatureconcentratie van HfO2 weer /TiO2 /HfO2 op Pt- en TiN-gecoat Si op basis van respectievelijk de bovengenoemde diepte XPS-profielen. De zuurstofvacatureconcentratie werd geëvalueerd met behulp van de hierboven genoemde methode. Het kan worden gevonden dat de hoogste zuurstofvacatureconcentratie (~34%) voorkomt in TiO2 tussenlaag. Een ander opmerkelijk kenmerk is dat de onderliggende HfO2 laag nabij Pt- of TiN-bodemelektroden heeft een hogere zuurstofvacatureconcentratie dan bovenste HfO2 laag (~2%). Bovendien is de zuurstofvacatureconcentratie (~9%) van de onderliggende HfO2 laag op TiN-gecoat Si is duidelijk hoger dan die (~6%) op Pt-gecoat Si.
Afbeelding 8 toont de schematische diagrammen van elektroformeren en resetten van Pt/HfO2 /TiO2 /HfO2 /Pt bij positieve en negatieve voorspanningen. Voor chemisch inerte Pt-boven- en onderelektroden zijn de polariteitsafhankelijke elektroformeringsverschijnselen gerelateerd aan de O2 gas dat vrijkomt uit de oxidelaag bij de anode als een product van elektroreductie. Zoals bekend, worden tijdens het elektroformeringsproces zuurstofvacatures gecreëerd door een hoog elektrisch veld en migreren deze naar de kathode, waarbij gelokaliseerde geleidende filamenten in de oxidelaag worden gevormd, d.w.z. O O →V O 2+ + O 2− , V O 2+ + 2e − →V O [12] (Fig. 8b, e). Tegelijkertijd O 2− ionen drijven naar de anode, geven hun lading vrij en evolueren O2 gas, d.w.z. O 2− →1/2O 2 + 2e − (Fig. 8b, e), die mogelijk fysieke vervorming van de cel en zelfs de vorming van scheuren of gaten veroorzaken [31]. Bij het toepassen van positieve vormingsspanning op de Pt-topelektrode, postuleren we de O2 gas dat vrijkomt boven de bovenste HfO2 film ontsnapt gemakkelijk aan de rand van de bovenste elektrode of door kleine nanoporiën in de Pt-topelektrode (figuur 8b), wat een zwakke fysieke vervorming veroorzaakt. Ondertussen, gezien de relatief hogere zuurstofvacatureconcentratie in onderliggende HfO2 (~6%) dichtbij Pt-bodemelektrode dan de bovenste HfO2 laag (~ 2,3%) (Fig. 7c), vormt zich gemakkelijk de geleidende gloeidraad, wat leidt tot een kleinere positieve vormingsspanning van +7 V. Met een sperspanning van -0,8 V leidt de omgekeerde reactie tot de filamentbreuken en het apparaat is schakel eenvoudig terug naar de HRS-status (Fig. 8d).

Schematische diagrammen van elektroforming en reset van de drielaagse structuur van HfO2 /TiO2 /HfO2 met symmetrische Pt boven- en onderelektroden. een –d Electroforming bij positieve spanning en reset bij negatieve spanning. e –g Electroforming bij negatieve spanning en reset bij positieve spanning
Omgekeerd, met een negatieve vormingsspanning op de bovenste elektrode, vormt zich zuurstofgas onder de onderliggende HfO2 laag en boven Pt de onderste elektrode (Fig. 8e). De O2 loslaten wordt moeilijker, wat de vorming van geleidende filamenten zal belemmeren. Bovendien, omdat de zuurstofvacatureconcentratie van de bovenste HfO2 laag (~2,3%) is lager dan die van de onderliggende HfO2 (~ 6%) (Fig. 7c), is de hogere negatieve vormingsspanning van -11 V nodig om filamenten te vormen. Wanneer meer O2 accumuleert tot een bepaalde druk onder onderliggende HfO2 , het barst mogelijk uit het mechanisch zwakste deel van de dunne films, wat leidt tot het gat in oxidefilms of scheiding tussen oxidefilms en de onderste elektrode veroorzaakt door het kraken van bellen. Hoewel het apparaat kan worden gereset naar HRS bij toegepaste +4 V-bias (Fig. 8g), wordt de geheugencel na verschillende schakelcycli verslechterd. In onze monsters werd na het vormingsproces een deel van de bovenste elektrode afgeblazen. Een vergelijkbaar voorkeursscenario voor elektroformering van polariteit is ook waargenomen in Pt/TiO2−x /Pt bipolaire RRAM-cellen met verschillende fysieke vervormingen van de juncties [31, 32].
Pt/HfO2 /TiO2 /HfO2 /TiN-apparaten vertonen een heel andere polariteit voor elektroforming dan Pt/HfO2 /TiO2 /HfO2 /Pt. De LRS veroorzaakt door elektroforming kan worden waargenomen bij zowel negatieve als positieve voorspanning; de effectieve reset van LRS naar HRS kan echter alleen worden bereikt bij een positieve voorspanning in Pt/HfO2 /TiO2 /HfO2 /TiN-apparaat. Een vergelijkbare voorkeur voor elektroformering met asymmetrische Pt- en TiN-elektroden is waargenomen in sommige literatuur met verschillende opslagoxidelagen zoals HfO2 [33, 34], TiO2 [35], ZrO x /HfO y dubbellaag [22], en Al2 O3 /HfO2 /Al2 O3 drielaags [14]. De bijbehorende verklaringen lopen echter uiteen of ontbreken.
Na overweging van de chemische activiteit van de TiN-elektrode met zuurstof [1, 30, 36] en de niet-verdeling van de zuurstofvacatureconcentratie in de drielaagse structuur van HfO2 /TiO2 /HfO2 gebaseerd op de XPS-diepteprofielen (Fig. 7), een mogelijk mechanisme voor de polariteitsvoorkeur voor elektroforming van Pt/HfO2 /TiO2 /HfO2 /TiN-cellen worden voorgesteld. Afbeelding 9 toont de schematische diagrammen van elektroformeren en resetten van Pt/HfO2 /TiO2 /HfO2 /TiN bij negatieve en positieve voorspanningen. De TiN-bodemelektrode speelt een sleutelrol in de elektroformeringspolariteit. Kwak et al. meldde dat de relatief actieve TiN-elektrode gemakkelijk zuurstofionen uit oxidefilms zou absorberen om TiO x te vormen N1−x (TiON) grenslaag [36]. De ernstige zuurstofdiffusie van onderliggende HfO2 laag in de TiN-bodemelektrode is in ons monster bevestigd door het XPS-diepteprofiel (figuur 7b). Voor Pt/HfO2 /TiO2 /HfO2 /TiN-apparaat, de TiN-elektrode met hoge zuurstofaffiniteit [34, 36] produceert veel zuurstofvacatures in de onderliggende HfO2 laag in de buurt van de TiN-bodemelektrode. De concentratie van zuurstofvacatures van ~9% van de onderliggende HfO2 laag is veel hoger dan die van ~6% in de Pt/HfO2 /TiO2 /HfO2 /Pt-apparaat.
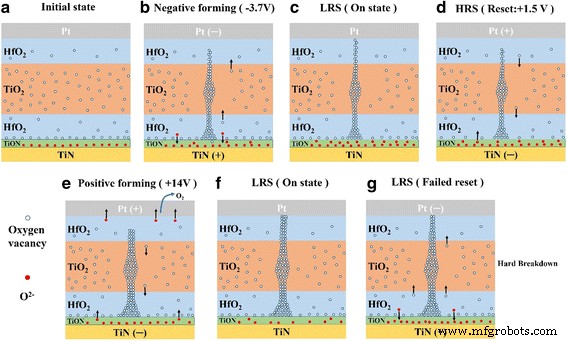
Schematische diagrammen van elektroforming en reset van de drielaagse structuur van HfO2 /TiO2 /HfO2 met asymmetrische Pt-bovenelektrode en TiN-onderelektrode. een –d Electroforming bij negatieve spanning en reset bij positieve spanning. e –g Electroforming bij positieve spanning en reset bij negatieve spanning
Voor chemisch inerte Pt-bovenelektrode en relatief actieve TiN-onderelektrode, bij het toepassen van negatieve vormingsspanning, O 2− ionen drijven naar de TiN-anode en worden geabsorbeerd om TiO x . te vormen N1−x laag (Fig. 9b), d.w.z. TiN + x O 2− →TiO x N 1−x + x 2e , de O2 . vermijden vrijkomen en mogelijke schade aan cellen. De TiN-elektrode kan fungeren als een reservoir voor zuurstofionen die onder een aangelegde spanning afdrijven [1, 36]. Tegelijkertijd door de hogere zuurstofleegstand in de onderliggende HfO2 laag (~9%) en tussenliggende TiO2 laag (~10–34%) dan de bovenste HfO2 laag (~1.9%), de migratie van de rijke zuurstofvacatures van de onderliggende HfO2 laag door TiO2 laag naar de bovenste HfO2 laag, die direct geleidende zuurstofvacature-filamenten produceert met een kleinere vormingsspanning van -3,7 V (figuur 9b). Bij het uitvoeren van een omgekeerd resetproces bij +1,5 V, levert de onderste elektrode van de TiN-laag die fungeert als zuurstofreservoir zuurstofionen om te reageren met zuurstoftekort, d.w.z. O 2− + V O 2+ →O O (roosterzuurstof), wat gunstig is voor de resetbewerking van LRS naar HRS met breuk van geleidende gloeidraad (figuur 9d). Bovenal draagt het zuurstofreservoireffect van de TiN-bodemelektrode bij aan de vermindering van de vormingsspanning en aan een betere set/reset-spanningsvariatie [1, 29, 36].
Aan de andere kant, bij het opleggen van de positieve vormingsspanning op de bovenste elektrode Pt, migreren de zuurstofvacatures van de bovenste HfO2 in de onderliggende HfO2 op TiN, hopen zich op in de buurt en ontwikkelen zich tot filamenten. Door de lagere zuurstofconcentratie in de bovenste HfO2 (~1,9%) dan de onderliggende HfO2 laag (~9%) en tussenliggende TiO2 laag (~10–34%), dit leidt tot een verdere toename van de zuurstofvacatureconcentratie in het onderliggende HfO2 en tussenliggende TiO2 laag. Tegelijkertijd, als gevolg van een lichte aanwezigheid van zuurstof in PEALD-afgeleide TiN-films (ongeveer 10%), drijven sommige zuurstofionen in TiN naar het onderliggende HfO2 laag om isolerende roosterzuurstof te vormen met nabijgelegen zuurstoftekort, waardoor de groei van geleidende filamenten wordt voorkomen (Fig. 9e). Ten slotte, wanneer de voorspanning +14 V bereikt, worden de grovere geleidende filamenten in oxiden gevormd. Wanneer echter een negatieve spanning op het apparaat wordt toegepast, is het geleidende filament in de drielaagse structuur te groot om te worden verbroken (Fig. 9g). Daarom kan het apparaat niet overschakelen naar HRS door een negatieve spanning aan te leggen, wat aangeeft dat er een onomkeerbare harde storing optreedt in Pt/HfO2 /TiO2 /HfO2 /TiN-apparaat.
Ten slotte, vanwege het feit dat de ingevoegde TiO2 laag slaat meer zuurstofvacatures op dan HfO2 laag, is de verdeling van zuurstofvacatures in de drielaagse structuur niet uniform, vooral in de twee grensvlaklagen tussen HfO2 /IL/TiO2 /IL/HfO2 , die de groeipositie, -richting en overlapping van geleidende filamenten kunnen beïnvloeden. De koppeling of breuk van de geleidende filamenten komt overeen met respectievelijk het instelproces van HRS naar LRS of het resetproces van LRS naar HRS, wat gemakkelijker gebeurt in twee grensvlaklagen. Verder de vorm en positie van de geleidende filamenten in HfO2 en TiO2 lagen veranderen minder in de set- en resetprocessen.
Conclusies
Samengevat, RRAM-apparaten gebaseerd op drielaagse structuur van Pt/HfO2 /TiO2 /HfO2 /Pt en Pt/HfO2 /TiO2 /HfO2 /TiN zijn opgesteld door ALD. Beide geheugencellen vertonen typische bipolaire resistieve schakelkarakteristieken en ohmse en SCLC dominante geleidingsmechanismen in respectievelijk LRS en HRS. Het blijkt dat de onderste elektroden van Pt en TiN grote invloed hebben op de voorkeur voor elektroformeringspolariteit, de verhouding van hoge en lage weerstanden en dispersie van de bedrijfsspanning van geheugencellen met drielaagse structuur. Vergeleken met symmetrische Pt boven-/onderelektroden, vertonen de RRAM-cellen met asymmetrische Pt boven-/TiN-onderelektroden een kleinere negatieve vormingsspanning van −3,7 V, een relatief smalle verdeling van de set/reset-bedrijfsspanningen en een lagere verhouding van hoge en lage weerstanden van 10 2 . De elektrode-afhankelijke elektroformeringspolariteit kan worden verklaard door rekening te houden met de chemische activiteit van elektroden met zuurstof, de gerelateerde reacties aan de anode en de niet-uniforme verdeling van de zuurstofvacatureconcentratie in de drielaagse structuur van HfO2 /TiO2 /HfO2 op Pt- en TiN-gecoat Si. Verder speelt de TiN-elektrode als zuurstofreservoir een belangrijke rol bij het vormen van spanningsvermindering en een betere spreiding van RS-parameters voor Pt/HfO2 /TiO2 /HfO2 /TiN-apparaten. Gezien het modulatie-effect van elektrode- en drielaagse structuur op resistieve schakelprestaties, biedt dit werk een nieuwe route voor apparaatontwerp voor toekomstige RRAM-toepassingen.
Nanomaterialen
- Geavanceerde atoomlaagdepositietechnologieën voor micro-LED's en VCSEL's
- Retentiemodel van TaO/HfO x en TaO/AlO x RRAM met zelfherstellende schakelkenmerken
- Kenmerken van grensvlak-, elektrische en banduitlijning van HfO2 / Ge-stapels met in situ gevormde SiO2-tussenlaag door plasma-versterkte atomaire laagafzetting
- De antibacteriële polyamide 6-ZnO hiërarchische nanovezels vervaardigd door afzetting van atoomlagen en hydrothermische groei
- Een RRAM-geïntegreerde 4T SRAM met zelfremmende resistieve schakelbelasting door puur CMOS logisch proces
- Effect van gouden nanodeeltjesdistributie in TiO2 op de optische en elektrische kenmerken van kleurstofgevoelige zonnecellen
- Fotokatalytische eigenschappen van Co3O4-gecoate TiO2-poeders bereid door plasma-versterkte afzetting van atoomlagen
- Fermi-niveau-afstemming van ZnO-films door middel van supercyclische atoomlaagafzetting
- Een collectief onderzoek naar modellering en simulatie van resistief willekeurig toegankelijk geheugen
- Afhankelijkheid van dikte van grensvlak- en elektrische eigenschappen in atoomlaag afgezet AlN op c-vlak GaN
- Atomaire laagafzetting bij lage temperatuur van SiO2 met behulp van koolstofdioxide



