Beoordeling van recente vooruitgang op verticale GaN-gebaseerde PN-diodes
Abstract
Als representatief halfgeleidermateriaal met brede bandgap heeft galliumnitride (GaN) steeds meer aandacht getrokken vanwege zijn superieure materiaaleigenschappen (bijvoorbeeld hoge elektronenmobiliteit, hoge elektronenverzadigingssnelheid en kritisch elektrisch veld). Verticale GaN-apparaten zijn onderzocht, worden beschouwd als een van de meest veelbelovende kandidaten voor toepassing in vermogenselektronica en worden gekenmerkt door het vermogen voor hoge spanning, hoge stroom en hoge doorslagspanning. Van deze apparaten is de verticale GaN-gebaseerde PN-junctiediode (PND) aanzienlijk onderzocht en vertoont deze een grote prestatievooruitgang op basis van de hoge epitaxiekwaliteit en het ontwerp van de apparaatstructuur. De epitaxiekwaliteit van het apparaat vereist echter verdere verbetering. Wat de elektrische prestaties van het apparaat betreft, is het verdringingseffect van het elektrische veld aan de rand van het apparaat een urgent probleem, wat resulteert in voortijdige uitval en de afgifte van superioriteit van het GaN-materiaal beperkt, maar momenteel wordt verlicht door randafsluiting. Deze recensie benadrukt de vooruitgang in materiële epitaxiale groei en edge-terminaltechnieken, gevolgd door de verkenning van de huidige GaN-ontwikkelingen en potentiële voordelen ten opzichte van siliciumkoolstof (SiC) voor materialen en apparaten, de verschillen tussen GaN Schottky-barrièrediodes (SBD's) en PND's als betreft mechanismen en kenmerken, en de voordelen van verticale apparaten ten opzichte van hun laterale tegenhangers. Vervolgens biedt de beoordeling een vooruitblik en onthult de ontwerptrend van verticale GaN PND die wordt gebruikt voor een voedingssysteem, inclusief met een inchoate verticale GaN PND.
Inleiding
Het wereldwijde energieverbruik stijgt veel sneller dan in de afgelopen decennia door de snelle groei van industrie en economie. Daarom zijn geavanceerde energiebesparende technologieën vereist om de problemen van een toenemend energieverbruik te verlichten.
Op silicium gebaseerde apparaten zijn momenteel het dominante type onder stroomapparaten [1]. Van deze vermogenscomponenten spelen de bipolaire transistor- (IGBT's)-structuren met geïsoleerde poort een belangrijke rol en vertonen ze een groeiende trend in de richting van de vervanging van de bipolaire junctietransistor (BJT) en metaaloxidehalfgeleider-veldeffecttransistor (MOSFET) sinds de uitvinding van de IGBT's in 1982 [2]. Momenteel zijn IGBT's essentiële elementen van vermogenselektronische velden voor conversie en transmissie [3]. Op silicium gebaseerde stroomapparaten hebben tot op heden echter hun fundamentele materiële limieten bereikt en worden op grote schaal gebruikt in elektrische energietoepassingen.
Gezien zijn uitstekende eigenschappen is GaN een van de halfgeleidermaterialen met een brede bandgap (inclusief SiC, GaN, Ga2 O3 en diamant) in staat om vermogensapparaten te fabriceren met een lage capaciteit en weerstand voor een gespecificeerde doorslagspanning met betrekking tot de Si-gebaseerde apparaten. Er worden dus op GaN gebaseerde apparaten met een laag energieverbruik, hoge vermogensdichtheden en een hoge conversie-efficiëntie voor vermogenselektronische systemen verwacht.
Zoals weergegeven in tabel 1, heeft GaN een veel hogere Baliga's figure of merit (BFOM) dan SiC (dat op de markt is gebracht), een kenmerk dat wordt toegeschreven aan de hogere elektronenverzadigingssnelheid en het hogere kritische elektrische veld. SiC heeft echter een betere thermische geleidbaarheid. Bovendien bezit GaN een hogere dragermobiliteit µ en een hogere thermische geleidbaarheid, en beide bereikten p - en n -type doping vergeleken met Ga2 O3 . Ondertussen moet voor de ultieme halfgeleider met brede bandgap, diamant, aanzienlijke vooruitgang worden geboekt om het praktische stadium te bereiken. Tot op heden zijn op GaN gebaseerde apparaten, zoals apparaten met drie aansluitingen (heterostructure-veldeffecttransistoren (HFET's) en MOSFET's) en apparaten met twee aansluitingen (SBD's en PND's) belangrijke onderzoeksonderwerpen geworden, en er is grote vooruitgang geboekt in hun toepassingen in stroomrectificatie en stroomconversie.
GaN versus SiC
Vanwege de inherente materiaaleigenschappen heeft GaN iets superieure voordelen ten opzichte van SiC, waaronder een grotere energiebandgap, een hoger kritisch elektrisch veld, een hogere elektronenverzadigingssnelheid en een 3-4x betere BFOM voor vermogensapparaten [6]. Dus, gezien de uitstekende eigenschappen, zouden op GaN gebaseerde apparaten beter moeten presteren dan op SiC gebaseerde tegenhangers. In de praktijk zijn verticale op GaN gebaseerde apparaten essentieel voor een hoge vermogensdichtheid en een hoge werkfrequentie (Fig. 1) vanwege hun uitstekende materiaaleigenschappen.
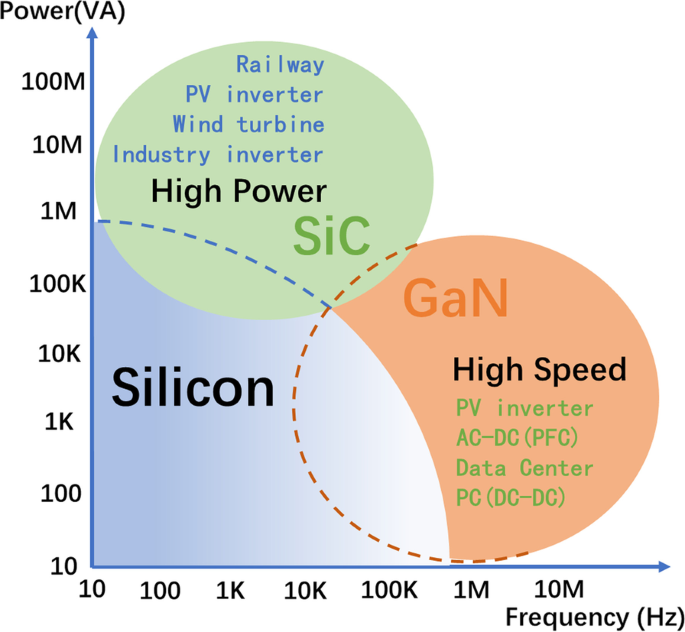
Potentiële toepassingen van GaN- en SiC-vermogensschakeltransistors [7]
Als de meest volwassen halfgeleiders met een brede opening hebben SiC-apparaten de afgelopen tien jaar opmerkelijke vooruitgang geboekt en laten ze veelbelovende prestaties zien in termen van hoge spanning, lage specifieke aan-weerstand en hoge schakelsnelheid [8]. Gezien de diepgaande onderzoeksbasis sinds 1980 en beschikbaar groter SiC-substraat met weinig defect (< 10 4 cm −2 ), waren SiC SBD's en junction field-effect transistors (JFET's) de eerste gecommercialiseerde SiC-gebaseerde apparaten sinds 2001. Andere SiC-gebaseerde stroomapparaten, waaronder MOSFET's en BJT's, werden met succes ontwikkeld op het gebied van hoogspannings- en stroomtoepassingen en hebben indrukwekkende resultaten opgeleverd. prestatie [9].
In vergelijking met SiC ontwikkelden GaN-apparaten zich zeer langzaam. Hun onbevredigende materiaalkwaliteit verhindert de realisatie van enkele van hun theoretisch superieure eigenschappen. Gezien het ontbreken van het GaN-substraat, zijn de meeste onderzoeken naar GaN-apparaten in dit stadium voornamelijk gebaseerd op de laterale structuur (bijv. AlGaN/GaN-heterostructuur). Met zijn hogere elektronenmobiliteit van 2000 cm 2 /V s (tweedimensionaal elektronengas (2DEG) in AlGaN/GaN), 1000 cm 2 /V s (bulk GaN) en hogere verzadigingssnelheid van 2,5 × 10 7 cm/s ten opzichte van die van SiC-tegenhangers, hebben AlGaN/GaN-apparaten de voorkeur voor hoogfrequente toepassingen en hebben ze een laag vermogen watt met betrekking tot SiC-apparaten [10]. Bij hoogfrequente velden bereiken AlGaN/GaN SBD's uitstekende elektrische transportprestaties en zijn ze meer geschikt voor microgolf- en millimetergolftoepassingen op wattniveau [11, 12]. De AlGaN/GaN SBD is een representatief apparaat voor GaN SBD's. De hoge mobiliteit van 2DEG betekent dat AlGaN/GaN SBD's enorme prestatievoordelen vertonen bij hoogfrequente toepassingen ten opzichte van verticale SBD's en ook een lage inschakelspanning behouden. Onlangs vormden AlGaN/GaN SBD's de basis voor een 5,8-GHz gelijkrichterschakeling met een ingangsvermogen van 6,4 W en een inschakelspanning van 0,38 V met een doorslagspanning (BV ) van 3000 V [13, 14]. De maximale afsnijfrequentie ligt dicht bij 1 THz bij 0 V met een anode-naar-kathode-afstand van 70 nm [15].
Voor op GaN gebaseerde stroomapparaten is het GaN-substraat (bulk GaN) ideaal voor epitaxiegroei, waarbij homo-epitaxy-technologie zou kunnen worden gebruikt om de mismatch te elimineren. De lage dislocatiedichtheid van bulk-GaN is essentieel voor het epitaxiale substraat omdat de hoge dislocatiedichtheid prestatiekenmerken zoals BV kan beïnvloeden , omgekeerde lekstroom, productievolume en betrouwbaarheid [16]. De ontwikkelingen van verticale op GaN gebaseerde apparaten zijn de afgelopen jaren gedreven door de vooruitgang van het GaN-substraat. Gezien de relatief onvolwassen technologie voor de verticale triode, is de verticale GaN-diode in dit beginstadium echter een populair onderzoeksonderwerp geworden. Vergeleken met AlGaN/GaN SBD's hebben verticale GaN SBD's vergelijkbare voordelen bij frequentievelden, zoals een hoge schakelsnelheid met een lage hersteltijd in omgekeerde richting en een laag geleidingsverlies; niettemin heeft de laatste een grote stroomdichtheid en een kleiner lekpad dan de eerste [17, 18].
Er zijn enkele problemen gerezen voor het GaN-substraat. Ten eerste zijn er momenteel GaN-substraten beschikbaar met dislocatiedichtheden van 10 4 –10 6 cm −2 , maar deze dislocatiedichtheden zijn nog steeds veel hoger dan die van Si- en SiC-substraten [19]. Ten tweede, met betrekking tot de 4-6 inch wafergrootte en redelijke kosten (10 euro/cm 2 ) van SiC, het formaat van 2-3 inch en relatief hoge kosten (100 euro/cm 2 ) van het GaN-substraat remmen de commercialisering en productiviteit van GaN op grote schaal [20]. Afgezien van het vergroten van het aantal leveranciers, is de hetero-epitaxie op buitenlandse substraten (Si, saffier of SiC) een alternatieve manier om de kosten van GaN-substraat te verlagen, maar de uitdaging van relatief hoge mismatch en defecten moet worden aangepakt.
Naast de bovengenoemde problemen in bulkmaterialen, is de uitdaging voor de GaN-diode het bereiken van een hoge kwaliteit van de p - soort materiaal. Met betrekking tot de relatief geavanceerde technieken voor het vormen van p -type SiC door Al-ionenimplantatie, onvolwassen p -type ionenimplantatietechnologie en de lage acceptoractivering voor p -type GaN zijn vitale belemmeringen, die de ontwikkeling van de structuur en fabricage van op GaN gebaseerde apparaten beperken. Daarom worden verschillende soorten randafsluitingsstructuren voorgesteld om de prestaties van de GaN-diode te verbeteren en vormen een belangrijk onderdeel van deze beoordeling.
Verticale GaN-gebaseerde apparaten op het FS-substraat
Tot 10 jaar geleden werden de meeste GaN-diodes, inclusief SBD's en PND's, gefabriceerd op vreemde substraten die laterale of quasi-verticale apparaatstructuren vormden vanwege de onbeschikbaarheid van een bulk-GaN-substraat. Laterale of quasi-verticale diodes vertonen uitstekende elektrische eigenschappen, maar ze hebben nog steeds inherente nadelen van de apparaatstructuur [21]. Ten eerste zijn de mismatch en defecten onvermijdelijk. Voor GaN-apparaten op vreemde substraten is dan een buffer essentieel tussen de GaN-driftlaag en het vreemde substraat. De spanningsrelaxatie van de bufferlaag zou dus een wafelbuiging veroorzaken, wat de dikte van de GaN-epitaxielagen [22] zal verminderen. Bovendien heeft de grote thermische grensweerstand (GaN met substraat) een serieuze invloed op de apparaatprestaties voor de GaN-apparaten die werken met een hoge vermogensdichtheid [23].
Volgens de ontwikkeling van epitaxietechnieken heeft het vrijstaande GaN-substraat (FS-GaN) met een lage dislocatiedichtheid, aangenomen voor verticale GaN-apparaten, grote vooruitgang geboekt. De materiaalkwaliteit van homo-epitaxiaal GaN op het FS-GaN-substraat heeft een duidelijke verbetering en toont het potentieel voor stroomtoepassingen. Verticale GaN-apparaten kunnen de nadelen van laterale GaN-tegenhangers verminderen. Ten eerste kunnen dikkere GaN-epitaxiale lagen worden gekweekt zonder enige buffer, en hogere BV (die die van laterale GaN-apparaten overschrijden) kunnen worden verkregen en bepaald door de dikte van de driftlaag. Ondertussen bevindt een maximaal elektrisch veld zich aan de binnenkant van apparaten en is het ver van het apparaatoppervlak (waardoor het effect van elektronenvangst, dat over het algemeen optreedt bij laterale apparaten) wordt geëlimineerd. Gezien de hoge kwaliteit van het FS-GaN-substraat, worden sinds 2011 verticale GaN-apparaten bestudeerd [24]. Sindsdien zijn verticale GaN PND's met hoge BV en lage on-state weerstand zijn gefabriceerd en leveren opmerkelijke prestaties.
PND versus SBD
Voor praktische toepassingen zijn diodes essentiële componenten voor stroomconversie en inversie [25]. Met de verschillende materiaaleigenschappen van GaN, vertonen op GaN gebaseerde diodes (SBD's en PND's) opmerkelijke prestaties, die naar verwachting zullen voldoen aan de vereisten van stroomtoepassingen. Zoals te zien is in afbeelding, hebben de PND's het grootste bereik onder GaN-apparaten met verschillende structuren en zijn ze bestand tegen spanningen van 600 tot 5000 V, een functie die bredere toepassingsscenario's aangeeft.
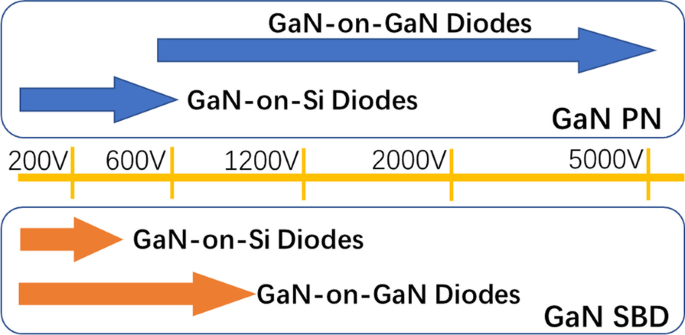
Overzicht van de apparaattypen, rapporten en spanningsklassen van de belangrijkste verticale GaN-stroomapparaten die de afgelopen jaren zijn gerapporteerd [26]
Vergeleken met PND's, die geen probleem hebben met de opslag van minderheidsdragers en een lagere SBD-barrièrehoogte hebben, hebben GaN SBD's een lage voorwaartse inschakelspanning (V aan ) en snel omgekeerd herstel, en deze kenmerken geven aan dat de voordelen van SBD worden onthuld in een laag geleidings-/schakelverlies, hoogfrequente werking, maar een lagere BV waarde dan die van PND; merk bovendien op dat een hoge inschakelspanning kan leiden tot een hoog geleidingsverlies en de efficiëntie van circuits en systemen kan verminderen [27, 28].
Op de velden met hoog vermogen hebben quasi-verticale of verticale SBD's uitstekende voordelen ten opzichte van AlGaN/GaN SBD's [29]. Bovendien wordt een lage inschakelspanning (< 0,5 V) bereikt door de barrièrehoogte aan te passen met een metaal met een lage werkfunctie. Een lage barrièrehoogte kan echter gemakkelijk leiden tot de hoge omgekeerde lekstroom en de BV . verlagen . Dientengevolge worden verschillende randafsluitingsstructuren voorgesteld om de prestatie te verbeteren. Door de hulp van verschillende edge-termination-technologieën [27, 28, 30, 31], de hoge stroomdichtheid bij KA/cm 2 cijfer met BV s boven 1 kV wordt bevestigd. Ondertussen vertonen verticale SBD's ook grote mogelijkheden voor hoge frequenties, zoals 177-183 GHz en een maximum van 902 GHz afsnijfrequentie bij 0 V, een functie die wordt verwacht voor stroombronnen in terahertz-draadloze communicatiesystemen [12, 32].
Met betrekking tot n -type GaN, de p GaN van het type dat gegroeid is door metaalorganische chemische dampafzetting (MOCVD) en moleculaire bundelepitaxie (MBE) werd geïntroduceerd door Mg als acceptor te gebruiken [33]. Vergeleken met GaN SBD's hebben GaN PND's veel voordelen, zoals een lage specifieke weerstand (R aan A ) en voldoende stabiliteit van het apparaat en het vermogen om piekstromen te voorkomen. Ondanks de hoge inschakelspanning (> 3 V) en relatief lage schakelsnelheid, een ultralage lekstroom vanwege de hogere barrièrehoogte en hoge BV is verkregen. Merk op dat een hoge BV van 0,6 tot 5 kV is de beste prestatie voor op GaN gebaseerde PND's. Op GaN gebaseerde PND's hebben dus een groot potentieel als belangrijke bouwstenen van de volgende generatie energiesystemen voor toepassingen met hoog vermogen, die een hoog rendement en een laag energieverlies vereisen [34]. Net als bij verticale GaN SBD's, zijn de randafsluitingen voor GaN PND's ook gefabriceerd om de drukte van elektrische velden rond de anode te verminderen, een functie die later in dit artikel in detail zal worden beschreven.
In stroomapparaten kan de PN-overgang ook worden behandeld als een nieuwe verbindingsstructuur. Voor het gebruik van een hoge BV met tegelijkertijd een lage omgekeerde lekstroom van PND's, hoge schakelprestaties en lage inschakelspanning van SBD's, genereren nieuwe apparaatstructuren, waaronder de junctiebarrière Schottky (JBS) en samengevoegde PN Schottky (MPS) een combinatie van SBD en PND door de vorming van p -type rastergebieden in het Schottky-contactgebied. JBS- of MPS-apparaten hebben de kenmerken van voorwaartse geleiding van SBD's en omgekeerde blokkering van PND's en zullen naar verwachting betere schakelprestaties en hogere sperspanning hebben dan respectievelijk conventionele PND's en SBD's [35].
Naast hun krachtige toepassing worden GaN PND's ook gebruikt voor opto-elektronische apparaten zoals light-emitting diodes (LED's), fotodetectoren en voor vlamdetectie vanwege de lage donkerstromen van een paar pA in op GaN gebaseerde PN-junctie-fotodiodes [36 , 37].
Doel van deze recensie
Op basis van de superieure materiaaleigenschappen van GaN zijn op GaN gebaseerde apparaten op grote schaal onderzocht en gebruikt in vermogenselektronica-toepassingen als een van de heetste halfgeleidermaterialen. Van de op GaN gebaseerde apparaten is de verticale op GaN gebaseerde PND aanzienlijk onderzocht en vertoont deze een uitstekende BFOM. De edge-terminaltechnieken zijn ook essentieel om de drukte van het elektrische veld rond het anodekussen te verminderen.
In deze review worden de vorderingen in materiële epitaxiegroei en edge-terminaltechnieken als de belangrijkste accenten gevolgd door de huidige GaN-ontwikkelingen te illustreren, de verschillen tussen GaN SBD's en PND's in termen van mechanismen en kenmerken, en de voordelen van verticale apparaten ten opzichte van laterale apparaten. . Deze beoordeling biedt een vooruitblik en onthult de ontwerptrend van verticale GaN PND's die worden gebruikt voor een voedingssysteem, inclusief inchoate verticale GaN PND's. De ontwikkeling van epitaxiale groei die overeenkomt met een andere laag in verticale GaN PND's wordt geïntroduceerd in Sect. 2. De edge-terminaltechnologieën worden onderzocht in Sect. 3. In sectie. 4, worden de verticale GaN PND's op Si-substraat gedemonstreerd als een alternatieve methode. Ten slotte worden de conclusies en vooruitzichten voor de toekomstige ontwikkeling van verticale GaN PND's gegeven.
Materiële epitaxiegroei
GaN-substraat van verticale PND's
Als een mainstream epitaxiaal proces worden verticale epitaxiale lagen van apparaten momenteel voornamelijk gekweekt door MOCVD op geleidende GaN-substraten die zijn vervaardigd door hydride dampfase-epitaxie (HVPE). In deze structuur heeft de kwaliteit van het substraat direct invloed op de volgende epitaxiale structuur. Veel faalmechanismen in het apparaat zijn afkomstig van de epitaxiekwaliteit van het substraat [38]. Er moet een geleidend GaN-substraat van hoge kwaliteit worden verkregen om de voorwaartse en achterwaartse I . verder te verbeteren –V prestaties, vooral de omgekeerde lekstroom en BV vermogen.
Substraat gekweekt door HVPE wordt beschouwd als de meest geschikte methode voor massaproductie vanwege de relatief lage kosten en reproduceerbaarheid. In het vroege stadium betekende de onrijpe groeitechnologie echter dat GaN-substraat gekweekt door HVPE een hoge achtergronddragerconcentratie had (> 10 19 cm −3 ) en onbevredigende kristalkwaliteit. Daarom is de HVPE niet aangenomen om de apparaatstructuur te laten groeien [39]. Door de snelle ontwikkeling van epitaxiegroeitechnologie worden hoogwaardige bulk-GaN-materialen door HVPE geleidelijk mogelijk [40, 41]. Afgezien van het substraat, kan de gedeeltelijk epitaxiale laag in het apparaat nu worden gekweekt door HVPE en kan dit resulteren in een hogere stroomuniformiteit en de eliminatie van de macrostap op het GaN-oppervlak door HVPE en het MOCVD-epitaxiale proces te combineren met koolstofvrije technologie vergeleken met apparaten die zijn gegroeid uitsluitend door MOCVD [42].
Momenteel een commercieel GaN-substraat met een minimale dislocatiedichtheid van minder dan 10 4 cm −2 is beschikbaar. De GaN verticale PND's op GaN-substraat met lage defectdichtheid werden verwerkt. Het buigen van de wafel blijft echter een probleem. Als veelbelovende oplossing kan de ammonothermische methode een GaN-substraat bereiken met een betere epitaxiekwaliteit. Met de hogedrukautoclaven en superkritische ammoniak kan de draaddislocatie aanzienlijk worden verminderd tot 10 4 –10 5 cm −2 [43]. Met behulp van de ammonothermische methode, een lage weerstand van 0,001 cm 2 in het GaN-substraat met sterk gedoteerde n -type (1 × 10 19 –1 × 10 20 cm −3 ) werd gemeld evenals de BV van 3 kV [44]. Het nadeel van de ammonothermische methode is echter de lage groeisnelheid van ongeveer 80-90 μm/dag, een eigenschap die nadelig is voor de praktische productie. Het verbeteren van de groeisnelheid en het handhaven van een hoge materiaalkwaliteit zijn ook winstgevende richtingen voor vervolgonderzoek.
Naast het commerciële GaN-substraat werden ook enkele substraten onderzocht op onderscheidende prestaties, waaronder het niet-Ga-vlak (c -vlakke) ondergronden. Over het algemeen is een Ga-polaire (d.w.z. c -vlak) substraat wordt gebruikt voor een GaN verticaal apparaat. Vervolgens vertonen de volgende epitaxiale lagen een drastisch polarisatie-effect. Echter, in de tegenovergestelde richting van de Ga-polaire tegenhangers, de homoepitaxiale lagen langs de N -polaire richting vertoont unieke apparaateigenschappen vanwege de hogere ontledingstemperatuur en polariteitsafhankelijke eigenschap [45, 46]. Met de N -polair eenkristal FS-GaN-substraat, een elektrisch veld van 2,2 MV/cm zonder randafsluitingen werd bereikt, evenals een BV van 2,4 kV met N2 O oppervlakteplasmabehandeling en veldplaat (FP) [46, 47]. Als een ander speciaal GaN-substraat, de m -vlak trekt ook veel aandacht gezien zijn niet-polaire eigenschap waarvoor de Ga:N 1:1 was in de m -vlak met betrekking tot alleen Ga in de c -polair en alleen N in de N -polaire substraten. Met dit niet-polaire GaN-substraat werden de kenmerken van PND's gerapporteerd met het kritische elektrische veld van 2,0 MV/cm en een hoge aan/uit-verhouding zonder FP of randafsluiting [48].
N-GaN epitaxiale technieken
Voorafgaand aan het bestaan van geleidende GaN-substraten van hoge kwaliteit, werden GaN PND's voornamelijk gefabriceerd op vreemde substraten, waaronder Si, SiC en saffier. Daarom was de structuur van apparaten altijd beperkt tot laterale. Een methode gebaseerd op de laterale structuur werd voorgesteld om de epitaxiale kwaliteit te verbeteren. Gezien de lage threading dislocatie (TD) op het venstergebied bij laterale apparaten, kan de GaN-epitaxiale laag die lateraal over het masker is gegroeid, een veel lagere TD-dichtheid bereiken. Zo werd laterale epitaxiale overgroei uitgevoerd om de GaN-epitaxiale laag op een saffiersubstraat voor laterale PND's te laten groeien. De omgekeerde lekstroom werd onderdrukt met drie ordes van grootte [49].
Met de ontwikkeling van epitaxiale technologie, hoogwaardige eenkristal GaN-substraten met lage dislocatiedichtheden van 3 × 10 –6 cm −2 beschikbaar kwamen en GaN PND's werden gefabriceerd op GaN-substraten. Gecombineerd met bovenste epitaxiale lagen door MOCVD gegroeid, vertonen de apparaten een lage lekstroom en een hoge BV van 600 V tot 4 kV overeenkomend met een driftdikte van 6 tot 40 m [16, 50]. Met betrekking tot het apparaat op het saffiersubstraat, omgekeerde lekstroom en BV aanzienlijk verbeterd [51].
Met het natieve GaN-substraat komt er meestal geen speciale bufferlaag voor in de PND-epitaxiale structuur zoals die op een vreemd substraat. Het effect van de bufferlaag in de PND op het GaN-substraat werd als referentie onderzocht. Het bestaan van een bufferlaag betekent dat de driftlaag een lagere defectdichtheid heeft. Ondertussen een hogere BV kan worden verkregen met een dunnere driftlaag maar een dikkere bufferlaag. De omgekeerde lekstroom van het apparaat werd ook verbeterd. Deze apparaatparameters vertonen een sterke relatie met de dikte van de bufferlaag, wat een klein effect heeft op de voorwaartse kenmerken van het apparaat [52].
De bovenste epitaxiale lagen worden afgezet door de MOCVD, metaal-organische dampfase-epitaxie (MOVPE) en MBE, zoals besproken in dit gedeelte. De epitaxiale structuur van PND's omvat een sterk gedoteerde n + -GaN-laag en een driftlaag van n − -GaN tussen het substraat en p -GaN (afb. 3). De sterk gedoteerde n + -GaN-laag fungeert in sommige rapporten als een overgangslaag op het geleidende GaN-substraat.
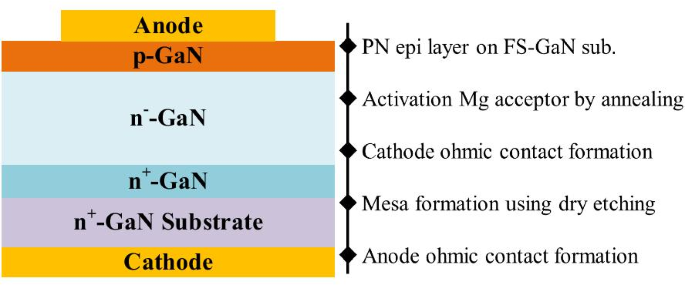
Schematische structuur en fabricageproces van GaN verticale PND
Over het algemeen is de BV bepaalt de toepassingsscenario's van apparaten. Bijvoorbeeld, de hogere BV voor een SiC-apparaat in vergelijking met dat met GaN, kan het SiC-apparaat worden gebruikt in krachtige en hoogspanningstoepassingen zoals elektrische voertuigen en bullet-treinen (Fig. 1). Evenzo worden PN-diodes meestal toegepast in hogere spanningen met betrekking tot de Schottky-diode en HEMT's. In PND's is de BV wordt voornamelijk uitgevoerd door de driftlaag (licht gedoteerde n − -GaN-laag) met de verbreding van het uitputtingsgebied (zoals weergegeven in vergelijking 1 met aangelegde spanning V waarvoor V is positief/negatief voor de voorwaartse/achterwaartse voorspanning wanneer het apparaat onder omgekeerde voorspanning staat. Bovendien vindt de uitsplitsing plaats met een verdere toename van de omgekeerde bias.
$${W_{\text{D}}} =\sqrt {\frac{{2{\varepsilon_{\text{s}}}\left( {{V_{{\text{bi}}}} - V } \right)}}{q}\frac{{{N_{\text{A}}} + {N_{\text{D}}}}}}{{{N_{\text{A}}}{N_ {\text{D}}}}}}$$ (1)waar S , q , V twee , N D , en N A zijn respectievelijk het gebied van de kruising, elektronische lading, ingebouwde potentiaal, donorconcentratie en acceptorconcentratie [53].
Volgens de uitputtingsbreedte kunnen de apparaten worden onderverdeeld in niet-doorboorde [W D> W Dm (W Dm :maximale depletion-layer width)] en punch-through (W D < W Dm ). Gezien de problemen met de epitaxiestructuur en -rand, vallen de meeste verticale GaN-apparaten onder het punch-through-type, d.w.z. hun uitputtingsgebieden breiden zich uit tot buiten de gehele n − -GaN-laag en bereik de n + -GaN-substraat vóór afbraak.
Bovendien, zoals beschreven in Vgl. (2), de BV kan worden verbeterd door de dikte te vergroten en de n . te verkleinen -type doteringsconcentratie van de driftlaag.
$${\text{BV}} ={E_{\text{C}}}t - \frac{{q{N_{\text{D}}}{t^2}}}{{2{\varepsilon_0 }{\varepsilon_{\text{r}}}}}$$ (2)waar E C , q , t , N D , en ε r zijn het kritische elektrische veld, elektronenlading, n − -GaN laagdikte, netto dragerconcentratie van de n − -GaN-laag en halfgeleider permittiviteit, respectievelijk [54]. Gelukkig leert de ervaring dat een driftlaag met een dikkere dikte en lagere doping slechts bijdraagt aan een lichte toename van de weerstand in voorwaartse geleiding.
Vergeleken met het verbeteren van de BV door de dikte van de driftlaag te vergroten, de n . te verlagen -type dopingconcentratie in de n − -GaN-laag is momenteel moeilijk, vanwege de hoge achtergrondconcentraties, waaronder die van Si, O enzovoort. Voor verdere verlaging van de dopingconcentratie in de n − -GaN laag, de onbedoelde dopingconcentratie wordt onderzocht. Veel onderzoeksgroepen introduceerden een nominale i-GaN van ongeveer 10 15 –10 16 cm − 3 contact opnemen met p -GaN om de p . te vormen –ik –n structuur om de BV van diodes [55] te verbeteren.
De voorwaarde voor deze maatregelen is zeker een hoge epitaxiale kwaliteit van de driftlaag, omdat de TD's de lekkage buiten de toestand kunnen vergroten en de BV kunnen degraderen. eigenschappen [56].
Om de epitaxiale kwaliteit van de driftlaag in GaN verticale PND's verder te verbeteren, werd groei door MBE op het GaN-substraat onderzocht. Een lekstroom van minder dan 3 nA/cm 2 en elektrisch veld van 3,1 MV / cm werden verkregen door de zeer lage dislocatiedichtheid. De bijna ideale doorslagprestaties geven aan dat de MBE een effectieve methode is om epitaxiale lagen in GaN verticale PND's te laten groeien [56]. Echter, vergelijkbaar met ammonothermische groei, is de epitaxiale snelheid een ander nadeel.
P-GaN-epitaxie
P-GaN, een belangrijke component in GaN verticale PND's, werd gerapporteerd in 1989 sinds het verschijnen van GaN door HVPE in 1969 [57, 58]. Het werd voor het eerst gebruikt om blauwe LED te verkrijgen. Dan, de p -GaN werd geleidelijk toegepast op het gebied van elektrische apparaten, zoals normaal-uit-apparaten en PND's. In verticale GaN PND's is de p -GaN vormt licht (ongeveer 10 19 cm −3 ) en zwaar (≥ 10 20 cm −3 ) dopingconcentratie, die overeenkomt met het vormen van een PN-overgangslaag met de driftlaag en het faciliteren van ohmse contacten als de anode-elektrode.
Over het algemeen is de epitaxiale groei van een p -GaN wordt gefabriceerd door MOCVD bij een temperatuur van ongeveer 1000 °C en gebruikt de Mg 2+ als acceptant. Dan de volwassen p -GaN-laag moet worden geactiveerd bij hoge temperaturen van 700-800 °C in N2 omgevingstemperatuur of 400 °C in O2 omgevingstemperatuur, waardoor een relatief hoge gatenconcentratie mogelijk wordt [59,60,61]. De hoge ionisatie-energie van 150-200 meV van de Mg-H-binding betekent echter een p -GaN-activeringspercentage van slechts 1-3%. Een lage activeringssnelheid is ook gerelateerd aan de temperatuur. De Mg-doteermiddelen kunnen opnieuw worden gepassiveerd bij hoge temperaturen van -600 °C in NH3 of waterstofomgeving [62]. Om de gatenconcentratie te verbeteren, is alleen het verhogen van de dopingconcentratie niet haalbaar omdat een hogere dopingconcentratie in de p -GaN zou kunnen leiden tot een verslechtering van de kristallijne kwaliteit van de laag en de gatendichtheid verminderen door een zelfcompenserend effect [63]. Momenteel kan een piek van de gatendichtheid gewoonlijk worden bereikt bij een acceptorconcentratie van ongeveer 3 × 10 19 cm −3 [64]. Hoewel het enkele problemen zijn voor p -GaN, gerelateerde onderzoeksrapporten zijn niet veel. Het kan aan twee redenen worden toegeschreven. Een daarvan is de beperking van de intrinsieke eigenschappen van materiaal en epitaxiale apparatuur. Een andere is dat de huidige p -GaN kan ook vergelijkbare apparaatprestaties verkrijgen.
De optimalisatie van de groeiconditie en het nieuwe epitaxiale proces worden echter nog steeds onderzocht. In 2017 bijvoorbeeld, de niet-geactiveerde regrown p -GaN door MBE werd voorgesteld en heeft een voordeel ten opzichte van MOCVD. Met de omgeving met lage waterstofgroei kan een BV van 1,1 kV en een idealiteitsfactor van 2,5 werden bereikt door de gefabriceerde verticale GaN PND's [65]. Nog een interessante p -GaN-fabricagemethode is Mg-ionenimplantatie met een ultra-hogedruk-gloeiproces (UHPA). De resultaten laten zien dat een hoge activeringsratio van 70% en een mobiliteit van 24,1 cm 2 V −1 s −1 werden bereikt met annealing na implantatie bij een temperatuur van 1573–1753 K in N2 druk van 1 GPa. Dit resultaat is vergelijkbaar met dat van epitaxiegroei door MOCVD [66].
Concluderend, voor substraat is nu het commerciële GaN-substraat met laag defect beschikbaar. Ondertussen ontwikkelt de epitaxiale technologie zich nog steeds, een situatie die de prestaties van het apparaat sterk beïnvloedt. In vergelijking met MOCVD kan de MBE een uitstekende epitaxiale kwaliteit bereiken, wat resulteert in geweldige apparaatprestaties zonder randafsluitingen. De trage groei en hoge kosten maken de MBE echter ongeschikt voor grootschalige productiviteit. De epitaxiegroei door MOCVD is in de praktijk nog steeds de belangrijkste productieve methode. Het verbeteren van de kwaliteit van door MOCVD gekweekte epitaxiale lagen is dus een urgente kwestie, die veel tijd zou vergen. Daarom worden in dit stadium een geavanceerd ontwerp of maatregelen voor de apparaatstructuur voorgesteld voor geweldige prestaties.
Edge-beëindigingstechnieken
Voor een verticale GaN PND's, BV is een belangrijke parameter. Almost all investigations on vertical GaN PNDs are centered on improving the withstanding voltage at reverse (i.e., BV ). However, due to the electric field crowding at the edge of PN junction, the depletion layer edge, or the electrode edge, premature breakdown often occurs. Therefore, to reduce the electric field crowding of the device, advanced device structure designs (i.e., edge termination techniques) are developed. Varied edge termination techniques have now been adopted to relax the electric field crowding at the edge of GaN PNDs for a higher BV . These techniques include mainly the field plate (FP), ion implantation and plasma treatment, and mesa etching in varied angle or steps and guard rings (GRs) [49, 67,68,69]. These features are discussed in this section.
Metal Field Plates
The FP has been widely utilized in GaN-based devices for transferring the peak electric field far from the edge of the gate, anode, or junction. This method has an identical feature to relax the intensity of the electric field at the PN edge under reverse bias. Moreover, the low leakage current and high breakdown voltage under reverse voltage can be achieved by using FP termination, which has a relatively simple fabricating process as well.
The merits of the FP structure include a simple fabrication process and compatibility with the device process. Simultaneously, the dielectric layer of FP is also the passivation layer of the device. As the earliest and most widely used edge termination for vertical GaN PNDs, the non-extended FP termination was initially used, as shown in Fig. 4a. For fabricating the FP structure, mesa structures were processed by inductively coupled plasma (ICP) dry etching. Then, to suppress the parasitic leakage currents from plasma damage, a passivation dielectric film was deposited all over the anode electrode and the entire mesa structure [70].
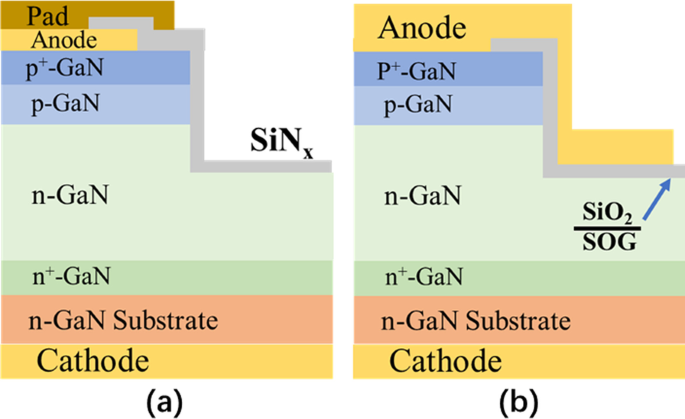
PNDs’ structures with a FP and extended passivation dielectric layer and b extended FP metal and passivation dielectric layer [70, 71]
To furtherly relax the electric field crowding at the periphery of the PN junction edge, the extended metal of the FP was utilized to cover the entire mesa to reduce the reverse leakage current and raise the BV [71]. This optimized FP structure is now widely employed in vertical GaN PNDs fabrications. As shown in Fig. 4b, the BV was raised over 3 kV with an extended FP structure. Meanwhile, the reverse leakage current was also suppressed to a quite low level at revere voltage of 3 kV.
As an essential component of the FP structure, the passivation layer has a considerable impact on the device characteristics. Thus, an appropriated passivation layer is essential. A passivation layer owned high-k permittivity is proposed by simulation, and uniform reverse current flow can be also obtained [50]. According to this theory, vertical GaN PNDs with FP termination using Ga2 O3 (the dielectric permittivity of 10) as passivation film were reported. The BV had a large improvement from 200 to 550 V, thereby revealing that a high-k permittivity film such as Ga2 O3 is promising as a passivation film of FP termination in vertical GaN PNDs for raising device characteristics [72]. However, some demerits arise for FP termination. The main issue is the defect during the dielectric layer deposition and interface between the dielectric and GaN, which result in carrier trapping. These would lead to the instability of device performance during long-term use. Therefore, the optimized deposition process of the dielectric layer must be investigated.
Mesa Termination
Mesa etching is an indispensable step to isolate adjacent devices in the fabrication of planar GaN-based devices. Given the simple process, this structure is popular for vertical GaN PND processes. Aside from a uniform electric field at the edge of PN junction, a high BV with nondestructive and avalanche characteristics can be achieved in PNDs. For instance, a simple but deep mesa structure can obtain great performance. As shown in Fig. 5a, with more than 10 µm depth of mesa structure in vertical PNDs, nondestructive BV and avalanche characteristics were confirmed [73].
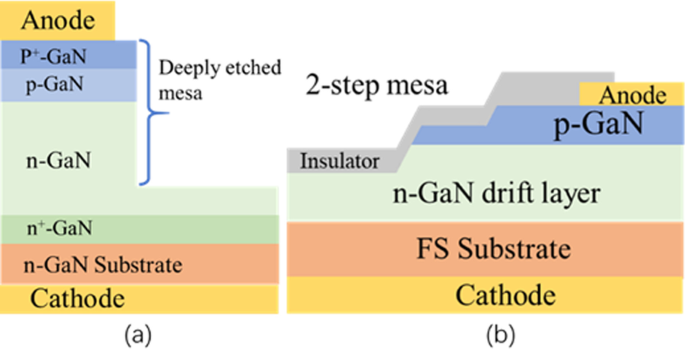
een PNDs with deeply etched mesa structure; b PNDs with two-step mesa [73, 74]
The novel mesa structures are investigated as shown in Fig. 5b. A multi-mesa (two-mesa) structure was adopted in vertical PNDs. With respect to the common single mesa structure, the two-mesa structure can shift the peak electric field from the edge of the PN junction to underneath the thinned p -GaN in the upper mesa because of the total depletion of holes in the thinned p -GaN layer. A high BV of 4.7–4.8 kV with nondestructive feature was successfully achieved by the two-mesa structure. Avalanche capability was obtained without lowering the forward I –V characteristics [74]. On the other hand, the two-mesa structure has the identical function for quasi-vertical PINDs [75]. The BV was enhanced from 665 to 835 V with the low leakage current simultaneously.
Besides the common perpendicular mesa structure, a mesa structure with negative bevel was recently proposed to mitigate the electric field crowding at edge of the PN junction. With the negative bevel mesa, the electric field at the edge has a decreasing trend when the bevel angle θ is lowered from 90˚. The peak electric field would be transferred into device inner. In [76], experimental investigation showed that beveled mesa structure (Fig. 6a) could induce a higher BV over 3 kV and a low leakage current with respect to BV of 3 kV in PNDs with steep mesa when using the same FP structure. Further investigation was performed by simulation using technology computer-aided design (TCAD). In vertical GaN PNDs with beveled mesa (Fig. 6b), the maximum electric field was determined by the acceptor concentration N A in p -GaN, donor concentration N D in n − -GaN drift layer, and θ of the beveled mesa. By theoretical analysis and simulation, the smaller θ could lead to higher E pp (parallel-plane breakdown field). At the same time, a lightly doped p -GaN is beneficial for achieving high BV for a fixed θ of the beveled mesa. Taking θ = 10° as an example, the experimental results support these findings. A parallel-plane breakdown field of 2.86 MV/cm was achieved, and this outcome is consistent with the simulation [77].
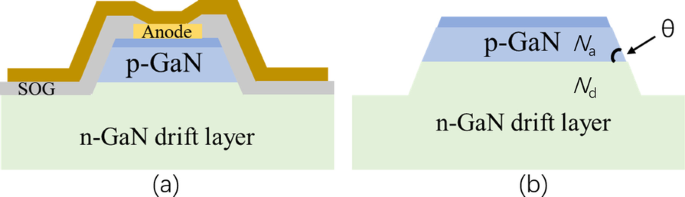
Schematic cross of PND structure with a bevel mesa and FP structure, b PND epitaxial structure is simulated by treating N A , N D en θ as variable [76, 77]
Similar with FP termination, the dry etching and/or insulator (or passivation film) is required in process of edge termination. Thus, the damage from dry etching must be considered and can cause a high reverse leakage current, even the premature breakdown. At the same time, it is a high demand to etched equipment for etched precision, and the etched depth is difficult to control. Meanwhile, the existence of damage generates a more complicated interface state between the insulator and the etched semiconductor, a situation that would affect device reliability. Consequently, reducing or alleviating damage is an inevitable issue. Now, some recipes (e.g., tetramethylammonium hydroxide (TMAH) and post-annealing that have the features of removing the damage by wet etching and repairing dry etching damage, respectively) have been adopted to treat etched surface to improve performance.
Ion Treatment
Ion implantation was employed to alleviate the electric field concentration near the edge. As a relatively simple termination structure, an implantation-based technique was investigated in GaN devices, which includes the compensating species (e.g., O, H, and Zn) or inert species (e.g., Ar, N, He, and Kr) to create deep-level traps in the termination regions [78,79,80,81,82]. Recently, for moderating the occurring of premature breakdown in vertical GaN PNDs, the ion implanted termination (e.g., N, F, Mg, and H) is also utilized. However, the mechanisms of these ion implanted terminations are different.
With respect to vertical GaN SBDs [83], N implantation in vertical GaN PNDs reveals a different mechanism, which entails creating the donor-like defects (N vacancy and N interstitial) to compensate for the p -type dopants. After processing by N implantation as shown in Fig. 7a and b, the conductivity of p -GaN can be reduced or eliminated (insulating) by N implantation [53]. To further improve the BV , a non-fully compensated layer was proposed, that is, a fully compensated layer coupled with a partially compensated counterpart in p -GaN. Thus, a higher BV was expected, and the mechanism was analyzed by simulation [84]. The experimental results show that N implantation with partially compensated p + -GaN could induce a BV of 1.68 kV without compromising the forward characteristics [85].
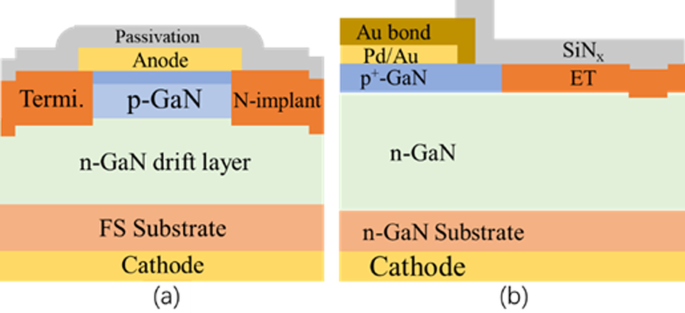
een Cross-sectional plot of the PNDs with N implantation termination, and b N implantation termination with fully and partially compensated [53, 84]
The hydrogen-plasma (H-plasma) edge termination can also reduce p -GaN conductivity, but with another mechanism. H-plasma treatment is an effective passivation method to transform the conductive p -GaN into a highly resistive one because of the strong bond of Mg-H in p -GaN. In contrast to N implantation, the H-plasma treatment is more appropriate for use in vertical GaN PNDs because of the low damage, low temperature, and simple operation involved. As shown in Fig. 8a, the PNDs exhibited an electric field of 3.0 MV/cm with just the H-plasma treatment. Simultaneously, the devices showed comparable forward I –V characteristics and a lower reverse leakage current [86].
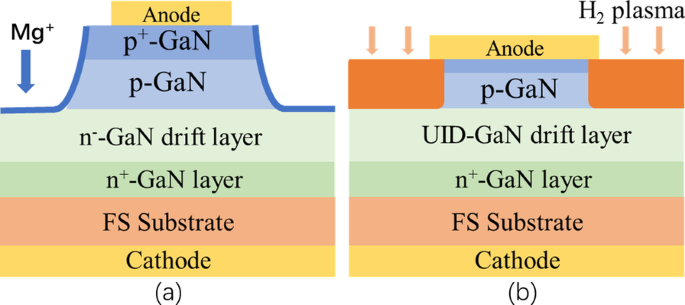
een Schematic view of PND structure by Mg ion treatment; b PNDs with H2 plasma treatment [86, 88]
At the same time, fluorine (F) ion also has the capability of modulating the peak electric field due to the negative fixed charges when the device is under a reverse bias. Nevertheless, if the F implanted edge termination is carried out in vertical GaN PINDs, strict design and structural optimization are needed [87].
In addition to the N, H, and F ion implantation as edge terminations, Mg ion implantation is also an alternative method to convert the surface/interface state, which originates from the damage of ICP dry etching. A novel Mg ion implantation coupled with moat mesa was recently adopted to compensate for the donor-like damage for GaN vertical PNDs (Fig. 8b). Then, a BV of 1.5 kV was achieved with a specific on-state R aan of 0.7 mΩ cm 2 [88].
Ion implantation termination is an effective method for a high BV in vertical GaN PNDs. The ion implantation process is also relatively simple. However, crystal damage occurs during high-energy ion implantation. Moreover, post-annealing at high temperature is required in some of the ion implantation terminations for alleviating the crystal damage. The rectangle-shaped ion implantation profile is pursued, so the implantation depth must be controlled exactly. Finally, although the ion implantation process is simple, the equipment needed is costly due to usage of high energy ion.
Guard Rings
The use of floating guard rings (GR) as edge termination to improve BV is an effective method for vertical GaN PNDs, for which the reverse voltage has a voltage drop over the GR to relax the electric field crowding. At the same time, the GR fabrication process does not require a specialized step, which is synchronous with anode metal deposition. For a higher BV , a GR in the FP structure was fabricated in the PNDs (Fig. 9a), in which polyimide was set between the GR and anode portion as resistive device for a further voltage drop. Due to the resistance portion, an incremental 0.2–0.4 kV of BV to a maximum of 5.0 kV was obtained. Compared with normal PNDs without a GR structure, the device with a resistive GR exhibited a similar forward I –V characteristics with R aan of 1.25 mΩ cm 2 , but a lower reverse leakage current with BFOM of 20 GW/cm 2 [69].
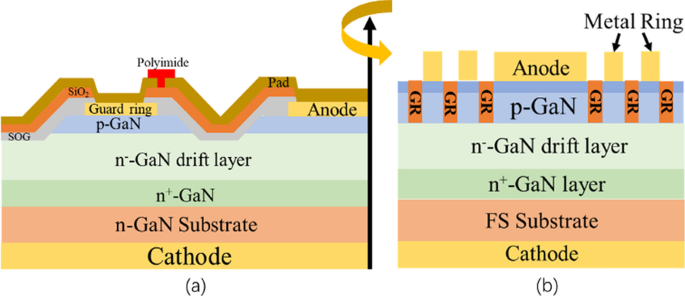
een Vertical GaN PNDs structure with floating GR termination; b PNDs structure with H-implanted GRs [69, 90]
Besides the floating GR, the H-plasma-based GR structure was also applied to form the edge termination. In addition to low damage, the low diffusivity of H-plasma could result in relatively ideal profile in GaN [89]. Owing to passivation effect of the H-plasma on p -GaN, the conductive p -GaN becomes highly resistive, and the GR structure was subsequently formed by the highly resistive p -GaN ring (Fig. 9b). The narrow GR width of 1–2 µm and decreasing spacing were used to improve the BV. GR structures with varied rings were measured. The PNDs with varied rings have similar forward characteristics with around 0.65 mΩ cm 2 and an ideality factor of 1.65 compared with those without GR. More GRs could further relax the electric field at the device edge. Thus, the devices exhibited a higher BV by increasing the number of rings after measurement. Consequently, the PNDs showed a BV of 1.7 kV with the highest electric field of 3.43 MV/cm 10 GRs [90].
The disadvantage of GR is its low area utilization rate, and the GR structure generally requires a large area, which is even bigger than anode. Then, the amount of GR raises the design difficulty such as the width and spacing of the GR. At present, two and more kinds of edge termination are adopted in single vertical GaN PNDs for a higher BV . These edge terminations typically include the FP, bevel mesa, and guard rings due to the relatively simple fabrications. On the other hand, these edge terminations are not meant to introduce the foreign element into the GaN crystal with respect to ion treatment, a feature that is beneficial for device performance. However, the quality of epitaxial layers still occupies a considerable proportion.
Vertical GaN PNDs on Si Substrate
To date, although vertical GaN-on-GaN devices exhibit excellent performance, the high cost and small diameter of GaN substrates still impede their large-scale market applications. Consider to the merit of a large scale and low cost of Si substrate, GaN-on-Si devices have attracted considerable many attentions at this stage.
For the quasi-vertical PND on Si substrate, high-quality buffer is essential. In [91], as shown in Fig. 10a, optimizing the AlN nucleation layer and the succeeding growth process, a GaN drift layer with a low threading dislocation density of 2.95 × 10 8 cm −2 and high electron mobility of 720 cm 2 /Vs is verkregen. With the FP structure, the device has a BV of 820 V with R aan of 0.33 mΩ cm 2 .
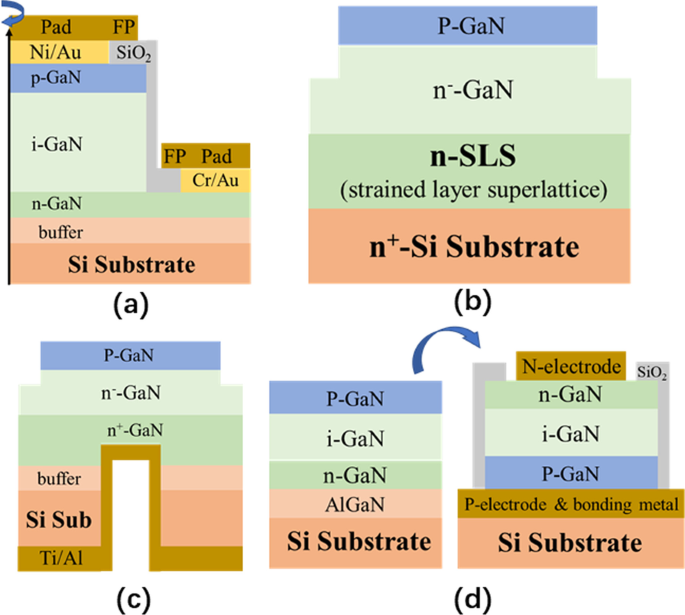
een Quasi-vertical PINDs with FP; b fully vertical PNDs by using the thin AlN and SLS superlattice structure on conductive Si substrate; c PNDs with trenched ohmic contact on back; d PNDs fabricated by layer transfer technology [91,92,93,94]
In addition to the challenge of materials mismatch, the conductive buffer layer and Si substrate are fundamental for fully vertical PNDs on Si substrate. In Fig. 10b, a n + -type Si substrate was first utilized as the cathode of vertical PNDs. Subsequently, the Si-doped thin AlN layer and GaN/AlN strained superlattice layer were employed to facilitate device performance [92]. Vertical PNDs on Si substrate are proposed with FP, and a BV of 288 V is confirmed with a drift layer of 1.5 µm. Moreover, a higher BV of 720 V in PNDs on Si with 5.7 µm drift layer is reported in Fig. 10c [93]. Unlike the conductive Si substrate method, the cathode ohmic on back approach was made by a trench, which reaches the n + -GaN layer through the selective removal of regular Si substrate and buffer layer.
Besides the conductive Si substrate and trenched ohmic contact on back, substrate removal technology is an alternative method to produce vertical GaN PNDs on Si substrates. In Fig. 10d, a layer transfer technology is used to process vertical PINDs on Si substrate. After Si substrate removal, transfer, n -electrode, and sidewall passivation, the devices exhibit a low R aan of 3.3 mΩ cm 2 and BV of 350 V [94]. The high BFOM value of 37.0 MV/cm 2 in PINDs demonstrates that substrate removal technology is an effective way for GaN-based PIND fabrication on Si substrates. Relative to other technologies, however, the more complicated fabrication process and higher production cost are issues that must be addressed during the substrate removal part.
As an alternative technical route, PNDs on Si substrates are fabricated with quasi-vertical or vertical device structures. To mitigate the substantial material mismatch between the Si substrate and GaN epitaxial stacks, a more effective epitaxial technology must be investigated. For a higher BV , thicker drift layer is also essential for a higher BV . This fact presents another key issue to investigate because the drift layer thickness on Si substrate is approximately 5 µm.
Future Challenges and Conclusion
Vertical PNDs are essential to simultaneously obtain high current (> 100 A) with high voltages (> 600 V), which can meet the requirements of several applications including electric vehicles and recycled energy processing. Despite the great progress achieved, applications of vertical GaN PNDs remain several barriers such as cost and technical limitations.
For FS-GaN substrate, high epitaxial quality with low threading dislocation has been achieved by a common MOCVD. The small size and high cost of the FS-GaN substrate confine the applications of the vertical GaN PNDs within a narrow range, and the small size also raises the price of GaN. The commercial GaN substrate is only 2-inch and is much smaller than 4–6 inch SiC and 8–12 inch Si substrates. The primary challenge for vertical GaN PNDs is achieving high epitaxial quality, especially the high quality of the p -GaN layer with a high hole concentration. Recently, novel PNDs are proposed through replacing p -GaN with NiOx synthesized by thermal oxidation or sputtering; great performance is also demonstrated as replacement of p -GaN in vertical PND and guard ring in GaN SBD [95,96,97,98].
Vertical GaN PNDs, as one of the most promising power devices, are reviewed and summarized in this study. The recent progresses on vertical GaN PNDs, including comparison of different materials (SiC vs. GaN) and different device structures (SBD versus PND), material epitaxy growth and edge termination techniques (FP, MESA, ion implanted and GR edge terminations), are discussed. De waarden van R aan versus BV by varied technologies are plotted in Fig. 11. Aside from the epitaxial technologies, edge termination technologies play a key role for vertical GaN PNDs to achieve high device performance at this stage. Despite its great progress in terms of device performance, the advantages of vertical GaN PNDs remain under-exploited. The characteristics of vertical GaN PNDs could be promoted by optimizing the device structure and epitaxial quality in succeeding studies. Then, commercialized vertical GaN PNDs will soon be available in the future with mature edge termination and epitaxial techniques.
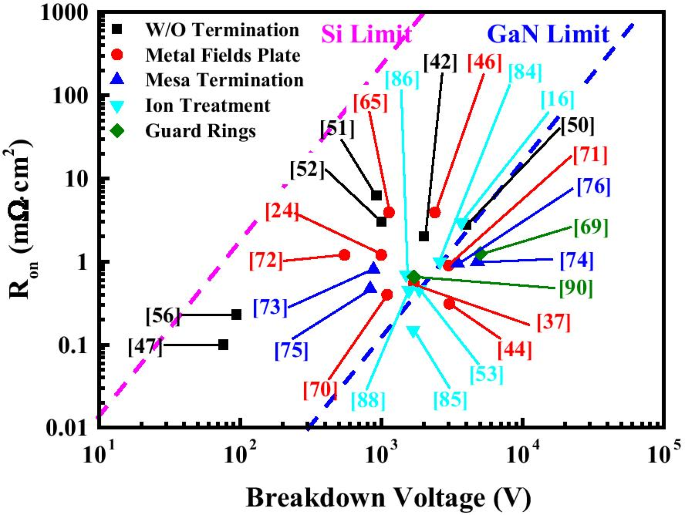
Benchmarking of the R aan versus BV of quasi- or full-vertical GaN PNDs
Beschikbaarheid van gegevens en materialen
The datasets used or analyzed during the current study are available from the corresponding author on reasonable request.
Afkortingen
- GaN:
-
gallium nitride
- SiC:
-
silicon carbon
- PND:
-
PN junction diode
- PIND:
-
P-i-N junction diode
- SBD:
-
Schottky-barrièrediode
- IGBT:
-
insulated gate bipolar transistors
- BJT:
-
bipolar junction transistor
- MOSFET:
-
metal oxide semiconductor field effect transistor
- BFOM:
-
Baliga’s figure of merit
- HFET:
-
heterostructure field-effect transistor
- JFET:
-
junction field-effect transistor
- 2DEG:
-
two-dimensional electron gas
- BV:
-
breakdown voltage
- FS:
-
free-standing
- MOCVD:
-
metalorganic chemical vapor deposition
- MBE:
-
molecular beam epitaxy
- JBS:
-
junction barrier Schottky
- MPS:
-
merged PN Schottky
- LED:
-
light-emitting diode
- HVPE:
-
hydride vapor phase epitaxy
- FP:
-
field plate
- TD:
-
threading dislocation
- MOVPE:
-
metalorganic vapor phase epitaxy
- HEMT:
-
high electron mobility transistor
- UHPA:
-
ultra-high-pressure annealing
- GR:
-
guard ring
- ICP:
-
inductively coupled plasma
- TCAD:
-
technology computer-aided design
- TMAH:
-
tetramethylammonium hydroxide
Nanomaterialen
- Stroombronnen
- Bulldozer
- De volgende generatie apparaten bieden verbeterde PoE-mogelijkheden voor IoT-apparaten
- Apparaten versterken PoE-kracht via bestaande switches en kabels
- Nanogenerator
- IoT-beveiliging:wat we kunnen leren van recente bedreigingen
- Ingenieurs ontwikkelen ultra-laag vermogen wifi-radio's
- Hoe draadloze energie de productie transformeert
- Draadloos meerdere draagbare apparaten van stroom voorzien met één enkele bron
- Zonnetechnologie gebruiken om slimme apparaten binnenshuis van stroom te voorzien
- Systeem haalt energie uit radiogolven om draagbare apparaten van stroom te voorzien



