Ge N-Channel MOSFET's met ZrO2-diëlektricum voor verbeterde mobiliteit
Abstract
Hoge mobiliteit GenMOSFET's met ZrO2 gate-diëlektricum worden gedemonstreerd en vergeleken met transistors met verschillende grensvlakeigenschappen van ozon (O3 ) behandeling, O3 nabehandeling en zonder O3 behandeling. Het blijkt dat met O3 behandeling, de Ge nMOSFET's met ZrO2 diëlektricum met een EOT van 0,83 nm verkrijgen een maximale effectieve elektronenmobiliteit (μ eff ) van 682 cm 2 /Vs, wat hoger is dan die van de universele Si-mobiliteit bij de gemiddelde inversieladingsdichtheid (Q inv ). Aan de andere kant, de O3 nabehandeling met Al2 O3 grensvlaklaag kan drastisch verbeterde-μ eff , het behalen van ongeveer 50% μ eff verbetering in vergelijking met de universele mobiliteit van Si bij gemiddelde Q inv van 5 × 10 12 cm −2 . Deze resultaten geven het potentiële gebruik van ZrO2 . aan diëlektricum in hoogwaardige Ge nMOSFET's.
Achtergrond
GERMANIUM (Ge) heeft voordelen getoond van een grotere mobiliteit van de drager en een lagere verwerkingstemperatuur in vergelijking met Si-apparaten. Deze maken Ge een alternatief voor toepassingen van ultrageschaalde CMOS-logica-apparaten en dunne-filmtransistors (TFT's) als toplaag in driedimensionale geïntegreerde schakelingen [1,2,3]. In de afgelopen jaren zijn grote inspanningen geleverd op het gebied van oppervlaktepassivering, poortdiëlektricum en kanaaltechniek voor Ge p-kanaal metaaloxidehalfgeleider veldeffecttransistoren (MOSFET's), die hebben bijgedragen aan een aanzienlijke verbetering van de elektrische prestaties voor de p-kanaal apparaten.
Maar voor Gen-channel MOSFET's, lage effectieve draaggolfmobiliteit (μ eff ) veroorzaakt door een slechte grenslaag van de gate-stack, beperkt de prestaties van de apparaten sterk. Verschillende technieken voor oppervlaktepassivering, waaronder Si-passivering [1], plasma-postoxidatie [4] en InAlP-passivering [5] en verschillende hoge-κ diëlektrica, waaronder HfO2 , ZrO2 [6,7,8], Y2 O3 [9], en La2 O3 [10] zijn onderzocht in Ge nMOSFET's om het elektron te stimuleren μ eff . Er werd aangetoond dat ZrO2 diëlektricum geïntegreerd met Ge-kanaal kan een robuuste interface bieden dankzij een GeO2 grensvlaklaag kan reageren en vermengen met de ZrO2 laag [7]. Een behoorlijk gat μ eff is gerapporteerd in Ge p-kanaaltransistoren [6,7,8], terwijl er nog veel ruimte is voor verbetering in elektron μ eff voor hun tegenhangers.
In dit werk, Ge nMOSFET's met ZrO2 gate diëlektricum zijn vervaardigd om verbeterde μ . te bereiken eff over Si in het gehele bereik van inversieladingsdichtheid (Q inv ). Ge-transistors behalen een verbetering van 50% in elektron μ eff vergeleken met de universele mobiliteit van Si bij een gemiddelde Q inv van 5,0 × 10 12 cm −2 .
Experimenteel
De belangrijkste processtappen voor het fabriceren van Ge nMOSFET's op 4-inch p-Ge(001)-wafels met een soortelijke weerstand van 0,136-0,182 Ω cm worden getoond in figuur 1a. De source/drain (S/D)-regio's werden geïmplanteerd met fosforionen in een dosis van 1 × 10 15 cm −2 en een energie van 30 keV gevolgd door doteringsactiveringsgloeien bij 600 ° C. Na de pre-gate reiniging werden Ge-wafels geladen in een atomaire laag depositiekamer voor de vorming van de gate diëlektrische laag (lagen):Al2 O3 /O3 oxidatie/ZrO2 , ZrO2 , of O3 oxidatie/ZrO2 voor respectievelijk wafels A, B of C. Voor wafer A, 0,9 nm Al2 O3 werd gebruikt om het kanaaloppervlak te beschermen tijdens O3 oxidatie. O3 oxidatie werd uitgevoerd bij 300 ° C gedurende 15 minuten voor zowel wafels A als C. Voor alle wafels, de dikte van ZrO2 was ~ 3,3 nm. Vervolgens werd TiN (100 nm) poortmetaal afgezet via fysiek reactief sputteren, en lithografiepatronen en reactief ionenetsen werden gebruikt om de poortelektrode te vormen. Daarna werd een 25 nm dikke Ni-laag afgezet in S/D-gebieden. Ten slotte werd de post-metallisatie-uitgloeiing (PMA) bij 350 ° C gedurende 30 s uitgevoerd om het Ni-germanide te vormen en de interfacekwaliteit te verbeteren. Schematische en microscoopbeelden van de gefabriceerde transistor worden respectievelijk getoond in Fig. 1b, c.
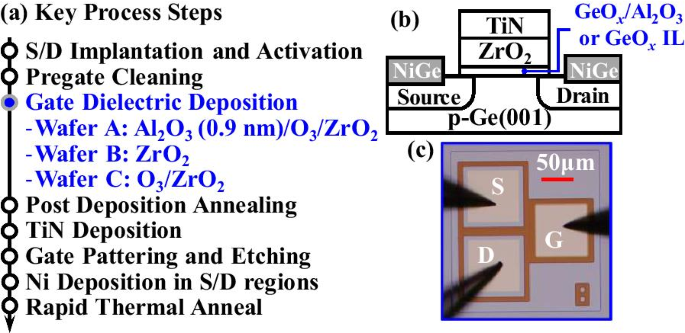
een Belangrijkste processtappen voor het fabriceren van Ge nMOSFET's. b Schema in dwarsdoorsnede en c microscoopbeeld van de gefabriceerde apparaten
Figuur 2a, b toont de hoge resolutie transmissie-elektronenmicroscoop (HRTEM) afbeeldingen van de poortstapels op respectievelijk wafels A en B. De uniforme dikte van de Al2 O3 /GeOx grenslaag (IL) voor wafer A is ~-1,2 nm, wat de 0,2–0,3 nm GeOx aangeeft . Voor het apparaat op wafer B, een ultradunne GeOx IL werd experimenteel aangetoond [7].
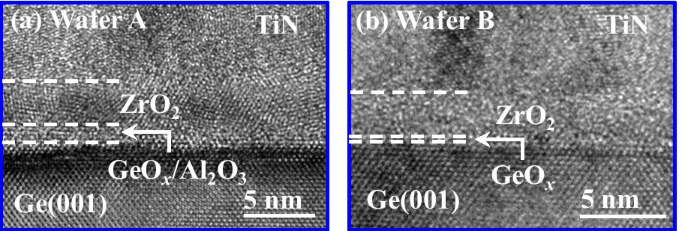
HRTEM-afbeeldingen van a TiN//ZrO2 /Al2 O3 /GeOx /Ge, b TiN/ZrO2 /GeOx /Ge-stacks voor de apparaten op respectievelijk wafers A en B
Resultaten en discussie
De gemeten capaciteit (C ) en de lekstroom (J ) kenmerken voor Ge MOS-condensatoren op wafers A, B en C worden gemeten en weergegeven in respectievelijk Fig. 3a, b. De equivalente oxidedikte (EOT) van de apparaten op de wafels A, B en C wordt geëxtraheerd op respectievelijk 1,79, 0,59 en 0,83 nm. Uitgaande van de GeOx IL biedt een extra EOT van ~ 0,25 nm voor wafers A en C door wafers B en C te vergelijken, de 3,3 nm ZrO2 draagt bij aan een EOT van ~ 0,6 nm met een κ-waarde van ~ 21,8, wat consistent is met de eerder gerapporteerde waarde van amorf ZrO2 [11].Deze afgeleide resultaten bevestigen ook dat de dikte in GeOx IL op wafer B is verwaarloosbaar.

een Gemeten C als functie van spanning V kenmerken voor Ge pMOS-condensatoren op wafers A, B en C. b J versus V curven voor de apparaten. c Benchmarking van J (uitgepakt op V FB ±-1 V) van de Ge MOS-condensatoren in dit werk tegen gegevens die zijn verkregen voor vergelijkbare bias-condities uit de literatuur
De GeOx /Al2 O3 IL voor wafer A en GeOx IL voor wafer C produceert de EOT van respectievelijk ~ -1.2 en ~ -0.25 nm. De EOT van de apparaten kan verder worden verminderd door de IL-dikte te verminderen of de interfacekwaliteit te verbeteren en de permittiviteit van ZrO2 te verbeteren met enige oppervlaktepassivering, bijv. NH3 /H2 plasmabehandeling [6]. Afbeelding 3c vergelijkt J versus EOT-kenmerken voor de Ge nMOSFET's in dit werk tegen waarden voor andere gerapporteerde Ge-apparaten [5, 12,13,14,15,16,17]. Er wordt ook waargenomen dat de resultaten consistent zijn met de gerapporteerde Ge MOS met ultradunne EOT die dezelfde trends volgt, wat aangeeft dat het verschil in lekstroom getoond in Fig. 3b voornamelijk te wijten moet zijn aan het verschil van EOT.
Afbeelding 4a toont gemeten afvoerstroom (I D ) en bronstroom (I S ) versus poortspanning (V G ) krommen van Ge nMOSFET's van wafers A, B en C. Alle transistors hebben een poortlengte L G van 4 μm en een poortbreedte W van 100 μm. De punt subthreshold swing (SS), gedefinieerd als dV G /d(logIk D ), als functie van I D curven voor de transistors in figuur 4a worden berekend en weergegeven in figuur 4b. Er wordt verduidelijkt dat de transistor op wafer A de gedegradeerde I . vertoont D lekvloer en SS vergeleken met de apparaten op wafers B en C. Behalve dat de toename van EOT in apparaten op wafer A de toename van SS zou veroorzaken, moeten deze fenomenen deels worden toegeschreven aan het feit dat het apparaat met de Al 2 O3 ingevoegde laag heeft een hogere dichtheid van interface-traps (D het ) binnen de bandgap van het Ge-kanaal in vergelijking met de wafers B en C.
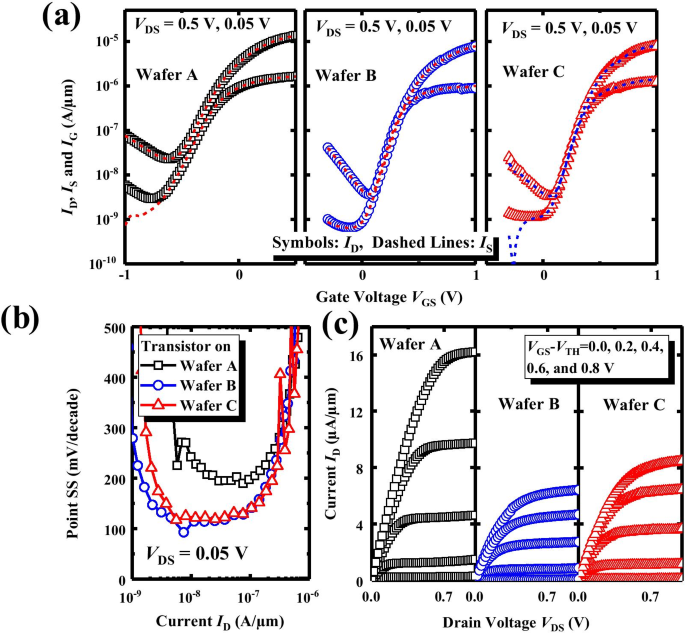
een Gemeten I D en ik S versus V GS krommen van Ge nMOSFET's op wafers A, B en C. b Punt SS als functie van I D voor de transistoren. c Ik D –V D kenmerken tonen aan dat de Ge nMOSFET op wafer A een hogere aandrijfstroom heeft in vergelijking met de apparaten op wafers B en C
Afbeelding 4c toont de gemeten uitgangskarakteristieken, d.w.z. I D –V D curven voor verschillende waarden van gate-overdrive |V G –V TH | van de apparaten die aantonen dat de Ge-transistor op wafer A een aanzienlijk verbeterde aandrijfstroom bereikt in vergelijking met de apparaten op wafers B en C. Hier, V TH is gedefinieerd als V GS corresponderend met een I D van 10 −7 A/μm. Gezien de identieke voorwaarden voor S/D-vorming, is de versterkte I DS voor transistors op wafer A geeft de hogere μ . aan eff [18,19,20,21]. De Al2 O3 laag heeft niet geleid tot de degradatie van D het optreden in de buurt van de geleidingsband van het Ge-kanaal.
Afbeelding 5a toont de totale weerstand R tot als een functie van L G voor de Ge nMOSFET's met ZrO2 diëlektricum met een L G variërend van 2 tot 10 µm. De waarden van R tot worden geëxtraheerd met een gate-overdrive van 0,6 V en een V D van 0,05 V. De S/D-weerstand R SD van de transistors wordt geëxtraheerd om ~ 13,5 kΩ μm te zijn, gebruikmakend van de gepaste lijnen die elkaar kruisen op de y -as. De vergelijkbare R SD is consistent met het identieke proces van PMA- en S/D-vorming. De kanaalweerstand R CH waarden van de apparaten worden verkregen door de helling van de aangebrachte lijnen, d.w.z. ΔR tot /ΔL G , die kan worden gebruikt voor het berekenen van de μ eff kenmerken van Gen nMOSFET's. Om de interfacekwaliteit te evalueren, worden interface-trapdichtheden (D het ) werden geëxtraheerd met de volgende vergelijking volgens de methode van Hill [17]:
$$D_{{{\text{it}}}} =\frac{{2G_{{{\text{m}}\max }} /\omega }}{{qA\left[ {\left( {\ frac{{G_{{{\text{mmax}}}} }}{{\omega C_{{{\text{ox}}}} }}} \right) + \left( {1 - C_{{\ text{m}}} /C_{{{\text{ox}}}} } \right)^{2} } \right]}}$$waar q is de elektronische lading, A is de oppervlakte van de condensator, G m,max is de maximale waarde van de gemeten geleiding, met de bijbehorende capaciteit C m , ω is de hoekfrequentie, en C os is poortoxidecapaciteit. De D het waarden worden berekend als 3,7, 3,2 en 2,3 × 10 12 eV −1 cm −2 voor de apparaten op respectievelijk wafers A, B en C.
Het is bekend dat de berekende waarden overeenkomen met de midgap D het . Het apparaat met Al2 O3 IL op wafer A heeft een hogere midgap D het vergeleken met de apparaten op wafels B en C. Dit komt overeen met de resultaten in Fig. 3a en 4a, en de hogere midgap D het geeft aanleiding tot een grotere dispersie van de uitputtingscapaciteit in wafer A, wat een hogere lekstroom van I veroorzaakt DS in vergelijking met de andere twee wafels. Merk op dat de wafer A de lagere D . moet hebben het nabij de geleidingsbandgap vanwege de hogere μ eff over wafels B en C.
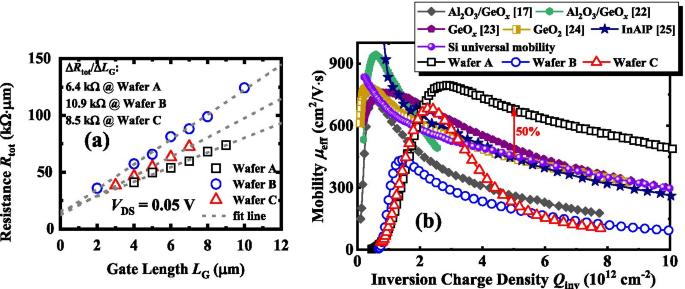
een R tot versus L G krommen voor Ge nMOSFET's op wafers A, B en C. De gepaste lijn die elkaar kruist op de y-as en de helling van lineaire aanpassingslijnen worden gebruikt om de R te extraheren SD en R CH , respectievelijk. b μ eff voor de Ge nMOSFET's in dit werk versus eerder gepubliceerde resultaten voor ongespannen Ge-transistors. De apparaten op wafer A tonen de verbeterde μ eff dan de universele Si-mobiliteit in het hele bereik van Q inv
Het is algemeen bekend dat μ eff is de bottleneck voor hoge aandrijfstroom en transconductantie in Gen nMOSFET's. Hier, μ eff kan worden berekend door \(\mu_{{{\text{eff}}}} =1/[WQ_{{{\text{inv}}}} (\Delta R_{{{\text{tot}}}} /\Delta L_{{\text{G}}} )]\), waarbij ΔR tot /ΔL G is de helling van de R tot versus L G zoals weergegeven in Fig. 5a. V inv kan worden verkregen door de gemeten C . te integreren inv –V G bochten. In Fig. 5b vergelijken we de μ eff versus Q inv van de Ge nMOSFET's op wafers A, B en C met die eerder gerapporteerd in [18, 22,23,24,25]. De geëxtraheerde piek μ eff waarden van de transistors op wafers A en C zijn 795 en 682 cm 2 /V s, en die van Ge nMOSFET's op wafer B is 433 cm 2 /Vs. Ge nMOSFET's met Al2 O3 IL bereikt een significant verbeterde μ eff in vergelijking met de transistors op wafer B of C, de apparaten in [18, 22,23,24,25] in een hoog veld en Si universele mobiliteit in de hele Q inv bereik. Op een Q inv van 5 × 10 12 cm −2 , een 50% μ eff verbetering wordt bereikt in apparaten op wafer A in vergelijking met de Si universele mobiliteit. Dit toont aan dat door het kanaaloppervlak te beschermen om vermenging van ZrO2 . te voorkomen en GeOx met behulp van Al2 O3 , wordt een hoogwaardige interface tussen gate-isolator en Ge gerealiseerd om de mobiliteitskenmerken te verbeteren, wat ook is gerapporteerd in de eerdere studies van Ge MOSFET's met ultradunne EOT [26]. μ eff in transistors op wafer C is hoger dan de Si-universeel bij een Q inv van 2,5 × 10 12 cm −2 , hoewel het snel vervalt met de toename van Q inv bereik. Dit geeft aan dat de gebruikte O3 oxidatie voor ZrO2 depositie zou de grensvlakkwaliteit tot op zekere hoogte verbeteren; het leidt echter niet tot voldoende vlak kanaaloppervlak om de verstrooiing van de oppervlakteruwheid van de drager bij hoge Q effectief te onderdrukken inv door de vermenging van ZrO2 en GeOx , omdat is gemeld dat het genereren van zuurstofvacatures tijdens het mengen de ruwheid op korte termijn (SRO) zou vergroten [27]. De O3 . optimaliseren oxidatieproces of reductie van de Al2 O3 IL-dikte kan ervoor zorgen dat de Ge-transistor een lagere EOT bereikt terwijl een hogere μ . wordt behouden eff op de hoge Q inv .
Conclusies
De effecten van de diëlektrische structuur en morfologie van de poort op de elektrische kenmerken van Ge nMOSFET worden onderzocht. Een Al2 O3 /ZrO2 gate-diëlektricum zorgt voor aanzienlijk verbeterde μ eff in vergelijking met de Si universele mobiliteit. μ eff kan worden verbeterd door een Al2 . in te voegen O3 laag tussen de ZrO2 en Ge-kanaal, wat echter onvermijdelijk leidt tot een grotere EOT. Al2 O3 -gratis GenMOSFET's met O3 oxidatie van het Ge-oppervlak voorafgaand aan ZrO2 afzetting bereikt een piek μ eff van 682 cm 2 /V s die hoger is dan die van Si bij de vergelijkbare Q inv .
Beschikbaarheid van gegevens en materialen
De datasets die de conclusies van dit artikel ondersteunen, zijn in het artikel opgenomen.
Afkortingen
- Ge:
-
Germanium
- ZrO2 :
-
Zirkoniumdioxide
- Al2 O3 :
-
Aluminiumoxide
- O3 :
-
Ozon
- Si:
-
Silicium
- PMA:
-
Post-metal gloeien
- PDA:
-
Uitgloeien na depositie
- IL:
-
Tussenlaag
- TiN:
-
Titaannitride
- MOSFET's:
-
Metaal-oxide-halfgeleider veldeffecttransistoren
- ALD:
-
Atoomlaagafzetting
- HF:
-
Fluorwaterstofzuur
- µ eff :
-
Effectieve vervoerdermobiliteit
- PPO:
-
Plasma post-oxidatie
- SS:
-
Subdrempelzwaai
- CET:
-
Capaciteit-equivalente dikte
- EOT:
-
Equivalente oxidedikte
- Qinv:
-
Inversie ladingsdichtheid
- HRTEM:
-
Transmissie-elektronenmicroscoop met hoge resolutie
- Ni:
-
Nikkel
- GeOx :
-
Germaniumoxide
- Ik DS :
-
Afvoerstroom
- V GS :
-
Poortspanning
- V TH :
-
Drempelspanning
Nanomaterialen
- Duurzaamheid bereiken met kleurstoffen en pigmenten
- KUHMUTE herontwerpt mobiliteit met SLS 3D Printing
- Volledige Terahertz-polarisatiecontrole met verbrede bandbreedte via diëlektrische metasurfaces
- Compliance-vrij ZrO2/ZrO2 − x /ZrO2 resistief geheugen met controleerbaar interfaciaal multistate schakelgedrag
- Geleidingsmechanisme en verbeterd uithoudingsvermogen in HfO2-gebaseerd RRAM met nitridatiebehandeling
- Diëlektrische verbetering van door atoomlaag afgezette Al2O3/ZrO2/Al2O3 MIM-condensatoren door middel van microgolfgloeien
- Ge pMOSFET's met hoge mobiliteit met amorfe Si-passivering:impact van oppervlakteoriëntatie
- Hoogwaardige a-InGaZnO dunnefilmtransistoren met extreem laag thermisch budget door gebruik te maken van een waterstofrijk Al2O3-diëlektricum
- 6 manieren waarop we Protocase Designer hebben verbeterd met release 4.6
- Een fenomenale afwerking bereiken met metallisatie
- Verbeterde slijtvastheid met koperen wolfraamelektroden



