Karakterisering en fabricage van de CFM-JTE voor 4H-SiC Power Device met zeer efficiënte bescherming en verhoogd JTE-dosistolerantievenster
Abstract
Een 13,5 kV 4H-SiC PiN-gelijkrichter met een aanzienlijk actief gebied van 0,1 cm 2 is in dit papier verzonnen. Charge-field-modulated junction termination extension (CFM-JTE) is voorgesteld om te voldoen aan de eis van ultrahoge sperspanning, die het JTE-dosistolerantievenster vergroot, waardoor het ongeveer 2,8 keer zo groot is als dat van de conventionele JTE met twee zones. Bovendien kan de CFM-JTE worden geïmplementeerd via het conventionele JTE-proces met twee zones. De gemeten voorwaartse stroom is maximaal 100 A @ V F = 5,2 V bij afwezigheid van technologie voor het verbeteren van de levensduur van de carrier. De CFM-JTE-structuur bereikt 96% van de theoretische doorslagspanning van de parallelle vlakovergang met een relatief klein aansluitoppervlak van 400 μm, wat bijdraagt aan het behalen van de verdienste van de Baliga van 58,8 GW/cm 2 .
Inleiding
Siliciumcarbide is een nieuwe optie geworden voor het verbeteren van vermogenstoepassingen vanwege de kenmerken van hogere spanning die werkt op dunnere actieve lagen, grotere vermogensdichtheid, hogere frequentieschakeling, betere warmteafvoer, kleinere systeemgrootte en lagere systeemkosten [1, 2]. In de afgelopen jaren zijn commerciële SiC-gelijkrichters en MOSFET's beoordeeld op 1,2-1,7 kV. In representatieve toepassingsgebieden zoals smart grids, elektrische voertuigen, pulsvoedingen en ultrahoogspanningssolid-state voedingen, is er echter een toenemende vraag naar blokkeervermogen van meer dan 10 kV en doorlaatstroomvermogen van meer dan 1000 A cm −2 .
Tot nu toe waren de belangrijkste uitdagingen voor 10 kV en hoger SiC-vermogenselektronische apparaten gericht op de prestaties van de junction-termination-technologie, vereenvoudiging van fabricageprocessen, hoge kwaliteit van dikke epitaxiale laag en vermindering van oppervlaktedefecten. Voor SiC-apparaten met ultrahoog voltage is de lengte van de terminalstructuur meestal 6-8 keer die van de epitaxiale dikte [3], wat de benuttingsgraad van de wafer enorm vermindert en dus de fabricagekosten verhoogt. 4H-SiC PiN-gelijkrichters zijn de meest geschikte kandidaten geworden voor ultrahoogspanningstoepassingen als gevolg van het geleidingsmodulatie-effect. Voor de structuur van de veldbegrenzende ring (FLR) kan een nauwkeurig optimalisatieontwerp worden verkregen door analytische berekening [4], terwijl de huidige fotolithografie de nauwkeurige ruimte en breedte van de ringen niet kan bereiken. De nieuwe veldbeperkende ringterminal voor 10 kV SiC-apparaten is toegepast om een hoge efficiëntie van omgekeerde bescherming te hebben [5, 6], maar het terminalgebied is groter dan 700 μm, wat resulteert in extra verbruik van de SiC-wafer. Junction Termination Extension (JTE) is een andere veelgebruikte hoogrenderende terminalbeveiligingsstructuur, maar de efficiëntie ervan is extreem gevoelig voor de dosis JTE. Voor ultrahoge spanningsniveaus worden MZ-JTE's en CD-JTE's [7] gebruikt om het elektrische veld kritisch te moduleren en vereisen strikte ionenimplantatievoorwaarden en -tijden, die op hun beurt de fabricagecomplexiteit en -kosten verhogen. Om het geleidingsvermogen te verbeteren, is onderzoek gedaan naar kenmerken van barrièrehoogte tussen verschillende metalen en SiC [8, 9]. Gewoonlijk wordt een 50-100 nm dikke Ti/Al-film gevormd voor respectievelijk het ohmse anodecontact en Ni-film voor het ohmse kathodecontact. Bovendien zal de schaal van het actieve gebied van de 4H-SiC-gelijkrichter een grote invloed hebben op de voorwaartse stroomkarakteristieken. Er is gevonden dat in de 4H-SiC N-type epitaxiale laag, de Z 1/2 midden (E C -0,65 eV), het acceptorniveau van de koolstofmonovacature, heeft vooral invloed op de levensduur van de drager [10]. Implantatie van aluminiumionen zal leiden tot een grote concentratie van enorme diepe niveaus waarbij de Z . betrokken is 1/2 centrum in de mesa-periferie en het junction-termination-gebied [11], wat resulteert in een afname van de levensduur van de carrier. Daarom zijn 4H-SiC-gelijkrichters met een groot actief gebied (> 9 mm 2 ) zijn vereist bij het ontwerp en de fabricage, aangezien de impact van de verminderde levensduur van de drager in het mesa-perifere gebied en het eindgebied relatief verwaarloosbaar is.
In dit artikel wordt de 4H-SiC CFM-JTE PiN-gelijkrichter gefabriceerd op een 100 μm epitaxiale laag van 5 × 10 14 cm −3 en bereikt een aanzienlijke blokkeringscapaciteit van 13,5 kV in de uit-stand en voorwaartse stroom van 100A @ V F = 5,2 V in de aan-status. De differentiële aan-weerstand van de CFM-JTE PiN-gelijkrichter wordt gemeten van 3,1 mΩ cm 2 op kamertemperatuur. De CFM-JTE verkrijgt 96% van de theoretische doorslagspanning door het concept en de analyse van ladingsveldmodulatie, wat het tolerantievenster van de implantatiedosis gunstig vergroot en leidt tot een acceptabele beëindigingslengte van 400 μm.
Methoden
Apparaatstructuuranalyse
Het ontwerp, de optimalisatie en de analyse worden uitgevoerd door Silvaco-TCAD. Figuur 1 toont het schema van de 4H-SiC PiN-structuur met beëindiging, met inbegrip van:(a) charge-field-gemoduleerd (CFM-JTE), (b) out-ring-assisted JTE (ORA-JTE) en (c) twee-zone JTE (TZ-JTE). In de blokkerende toestand is de ionisatiesnelheid van de elektron-gatbotsing nauw verwant aan de elektrische veldsterkte. Een concept van lading elektrisch veld modulatie E q (r ) wordt voorgesteld om het modulatiemechanisme van de CFM-JTE te onthullen via de vectorsuperpositiemethode van het elektrische terminalveld veroorzaakt door het elektrische ladingsveld E q (r ) in afb. 1a. De CFM-JTE bestaat uit het JTE1-gebied, het JTE2-gebied en drie groepen ringen. De meerdere ringen verdelen de terminal op equivalente wijze in vijf gedoteerde zones:R1 -R2 , R2 -R3 , R3 -R4 , R4 -R5 en R5 -R6 , waarbij effectieve kosten van Q 1 , V 2 , V 3 , V 4 en Q 5 respectievelijk worden geïntroduceerd. Gebaseerd op de decompositie en superpositie van elektrische veldvectoren bij x en y coördinaten, het totale elektrische veld in R ik punt veroorzaakt door het aangelegde potentiaalveld E p (r ) en het elektrische veld van de lading E Qi (r ) gegenereerd door elke Q ik kan analytisch worden uitgedrukt in de x en y richtingen, zoals gegeven in Vgl. respectievelijk (1) en (2).
$$E_{Ri, x} =E_{px} + \mathop \sum \limits_{j =1}^{i - 1} E_{Qjx} - \mathop \sum \limits_{j =i}^{5 } E_{Qjx}$$ (1) $$E_{Ri,y} =E_{py} + \mathop \sum \limits_{j =1}^{i - 1} E_{Qjy} + \mathop \sum \limits_{j =i}^{5} E_{Qjy}$$ (2)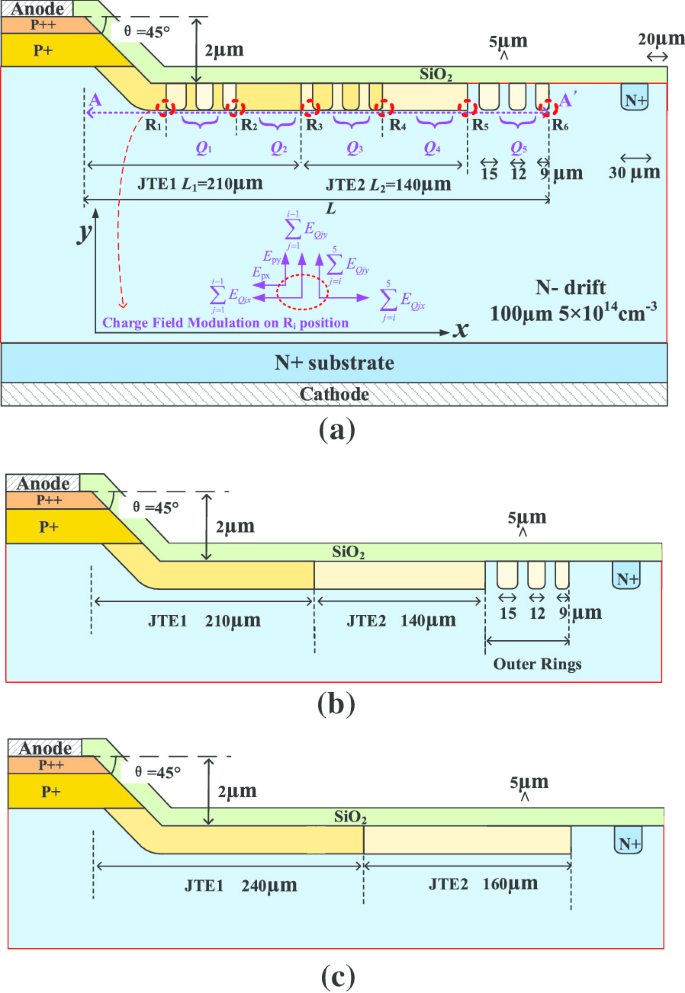
Schematische doorsnede van 4H-SiC PiN-gelijkrichter met a CFM-JTE, b ORA-JTE, c conventionele TZ-JTE
In de uit-stand trekt het laaggedoteerde uitputtingsgebied voortijdig samen en stopt het in het eindgebied vanwege het krommingseffect in de PiN-hoofdovergang. Dus het toegepaste potentiaalveld E p (r ) is volledig geconcentreerd aan de periferie van de hoofdknooppunten. Het bestaan van Q ik bevordert de uitputting langs de CFM-JTE naar de buitenste epitaxiale laag. De sterkte van het elektrische veld van de lading E Qi wordt geassocieerd met de hoeveelheid Q ik . De afname van Q ik langs de buitenste rand van de terminal bereikt effectief de elektrische veldmodulatie in het terminalgebied. Bijgevolg overwint CFM-JTE, door het mechanisme en het effect van ladings-elektrische veldmodulatie, het tekort aan lage diffusiecoëfficiënt van SiC om het gevarieerde laterale doping (VLD) -effect te vormen, wat een zeer effectieve, robuuste en volwassen junction-terminalbeschermingstechnologie is voor Si-apparaten [12, 13]. De ringbreedte (w r ) van elke groep wordt verminderd tot respectievelijk 15 urn, 12 urn en 9 urn. De ruimte van elke ring is gelijk aan dezelfde waarde van 5 μm. De lengte en dosis van het JTE1-gebied en het JTE2-gebied hebben beide een vaste verhouding van 3:2. De gedetailleerde parameters van de voorgestelde gelijkrichter worden gegeven in Tabel 1.
Simulatie en optimalisatie
Om de afwijkingen veroorzaakt door de gevoeligheid van de apparaatstructuur en dopingconcentraties te verminderen, wordt de verwerkingsconfiguratie Athena toegepast. De doteringsconcentraties van de CFM-JTE worden gevormd door meerdere stappen van simulatie van aluminiumimplantatieprocessen. De totale dopingdiepte bereikt bijna 1 μm.
Afbeelding 2 toont de blokkerende capaciteiten en de toleranties voor de implantatiedosis van CFM-JTE, ORA-JTE en conventionele TZ-JTE. De vier beëindigingsstructuren delen een vaste lengtewaarde van L = 400 μm om hun efficiëntie te vergelijken. Zowel de lengte als de dosis van JTE1 en JTE2 zijn vastgesteld op de verhouding van 3:2. De simulatie wordt uitgevoerd op de 2D-structuur en het beoordelingscriterium voor doorslag is dat de omgekeerde lekstroom 1 × 10 –9 bereikt A. De zwarte ononderbroken lijn vertegenwoordigt de theoretische BV die wordt berekend als 14,1 kV volgens [10, 14], en de grijze stippellijn geeft 12 kV aan. De ontwerpmarge van 20% wordt toegepast in het doel voor 10 kV, rekening houdend met de procestolerantie en simulatieafwijking. In de conventionele TZ-JTE is de doorslagspanning vrij gevoelig voor de implantatiedosis en bereikt deze alleen meer dan 12 kV wanneer de dosis varieert tussen 0,98 en 1,14 × 10 13 cm −2 . De gevoeligheid van ORA-JTE voor JTE-injectieconcentratie is verminderd en er is een breder tolerantievenster van 0,97-1,28 × 10 13 cm −2 wordt verkregen om de doelspanning boven 12 kV te houden. De CFM-JTE heeft de grootste tolerantie van het implantatiedosisvenster in een bereik van 0,86-1,30 × 10 13 cm −2 , wat ongeveer 2,8 keer die van de conventionele TZ-JTE en 1,4 keer die van ORA-JTE is. De CFM-JTE toont dus een betere robuustheid voor procesvariaties.
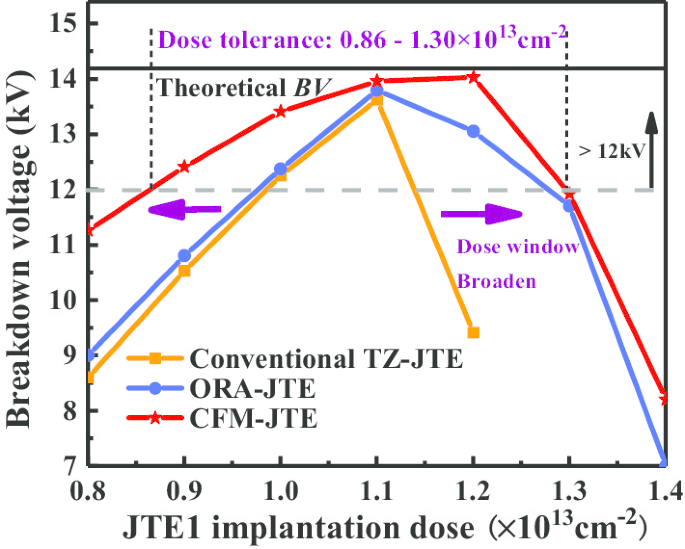
Vergelijking van de doorslagcapaciteiten met het JTE-dosisvenster voor de 4H-SiC PiN-gelijkrichter met CFM-JTE, ORA-JTE en conventionele TZ-JTE
Figuur 3 toont de vergelijking van de oppervlakte-elektrische veldverdeling en intensiteit van CFM-JTE, ORA-JTE en TZ-JTE in de blokkerende toestand. Het elektrische piekveld is voornamelijk geconcentreerd in de hoofdjunctie en de periferie van de terminal. CFM-JTE vlakt beschikbaar de elektrische veldverdeling af en bevordert de elektrische veldsterkte langs de terminal, wat uiteindelijk de blokkeercapaciteit efficiënt verbetert.
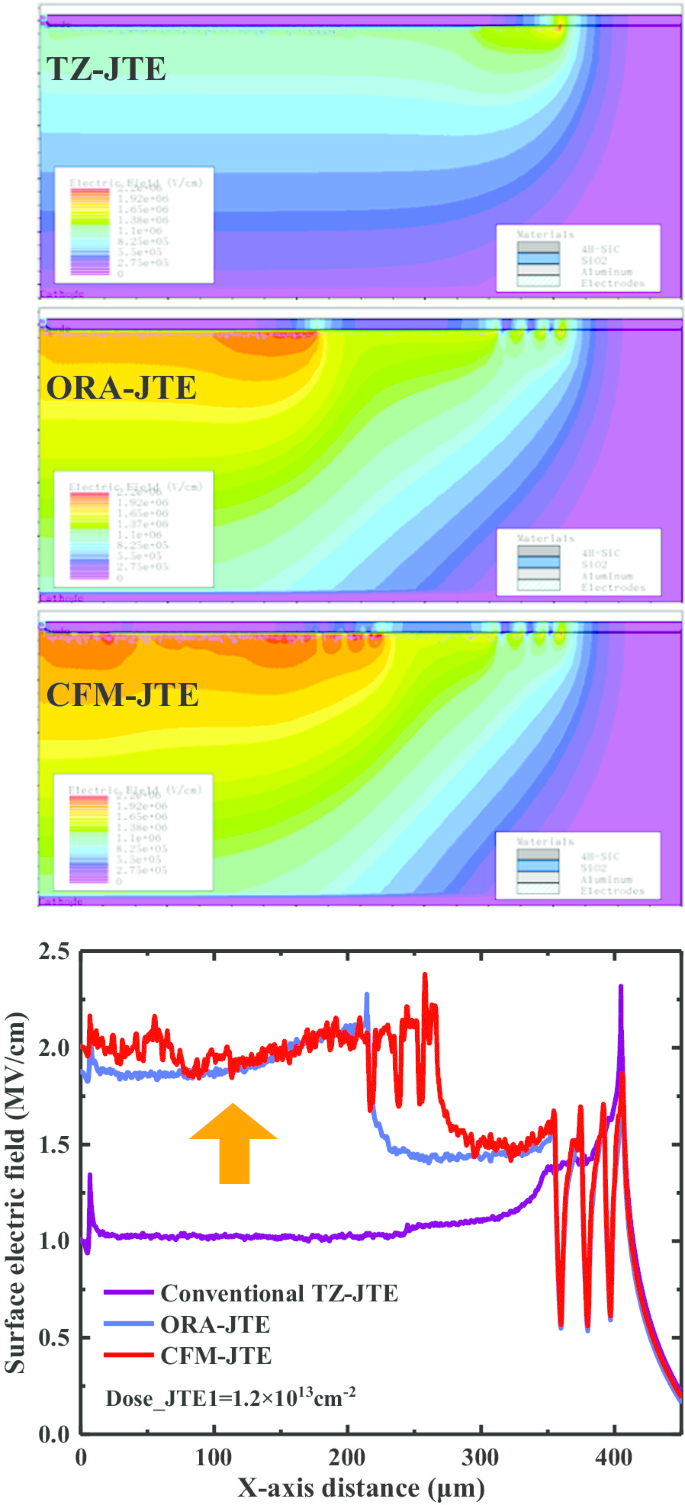
Omgekeerde elektrische veldverdeling en intensiteit aan het oppervlak in CFM-JTE, ORA-JTE en conventionele TZ-JTE
Om het mechanisme van CFM-JTE modulerende lading elektrisch veld te begrijpen, zijn de verdelingen van het elektrische doorslagveld over de AA'-cutline in figuur 1a met verschillende implantatiedoses van JTE1 uitgezet in figuur 4. Het bestaan van Q ik , vooral de sterk gedoteerde Q 1 zone naast het hoofdknooppunt, vermindert de concentratie van elektrische veldlijnen in de mesa-etshoek enorm. De Q 5 zone is ingesteld om de drukte van het elektrische veld op R5 . te verlichten punt in Fig. 1a. De resultaten tonen aan dat de uniformiteit van de elektrische veldverdeling effectief kan worden verbeterd door de modulatie van het elektrische veld van de lading E Qi (r ) in de terminal. Zo kunnen de mogelijkheden van de blokkeerspanning en de betrouwbaarheid van het apparaat worden verbeterd.

Elektrische oppervlakteveldverdelingen in storing overeenkomend met verschillende implantatiedoses van JTE1
De grootte van het terminalgebied heeft rechtstreeks invloed op de efficiëntie van het chipgebruik. In de blokkerende toestand is het aangelegde potentiaalveld geclusterd rond de periferie van de hoofdjunctie. Het JTE1-gebied nabij het hoofdknooppunt moet meer ladingen introduceren om het modulatie-effect van het ladingsveld te versterken (E q ). Dus, L 1 moet langer worden ingesteld dan L 2 . Wanneer de verhouding van L 1 naar L 2 is vastgesteld op 3:2, de blokkeercapaciteiten van verschillende lengtes L op de terminal worden vergeleken in Fig. 5 geanalyseerd.

Blokkeercapaciteiten met verschillende aansluitlengtes
De overeenkomstige elektrische veldverdelingen worden weergegeven in Fig. 6. Het grootschalige gebied van CFM-JTE is bevorderlijk voor het vergroten van de vereiste lading Q ik en volledig spelen van het modulatie-effect van E Qi (r ), om een groter implantatiedosistolerantievenster (TW) te verkrijgen. Wanneer de CFM-JTE lengte L is ingesteld op 300 μm, 350 μm, 400 μm en 450 μm, neemt het TW-bereik sequentieel toe, wat overeenkomt met 3 × 10 12 cm −2 , 3,2 × 10 12 cm −2 , 4,4 × 10 12 cm −2 en 4,7 × 10 12 cm −2 binnen bereik op voorwaarde dat de BV hoger is dan 12 kV. Het is geschikter om een eindlengte L . te selecteren van 400 μm in dit werk op basis van de afweging van terminalgrootte, JTE-dosistolerantievenster, terminal elektrisch veldmodulatie en doorslagspanningsvermogen.
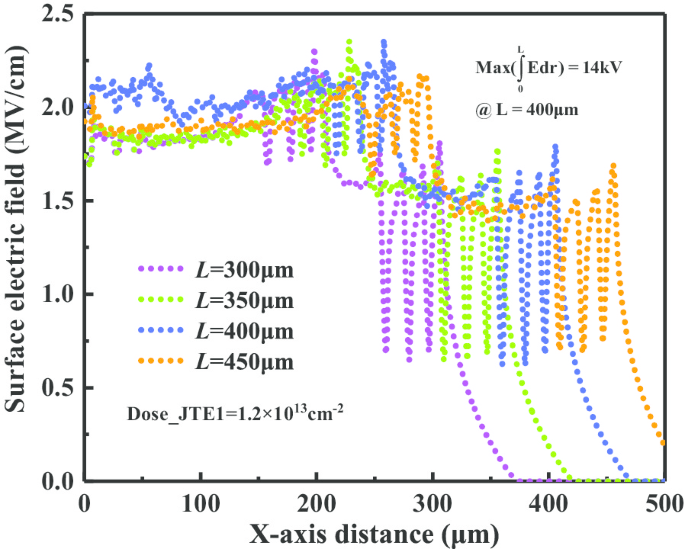
Elektrische oppervlakteveldverdelingen in doorslag die overeenkomen met verschillende terminallengtes
Bij de feitelijke fabricage van de 4H-SiC PiN-gelijkrichter moet rekening worden gehouden met het bestaan van oppervlaktetoestanden. Deze oppervlaktetoestanden zijn afgeleid van gaten die zijn opgesloten in diepe grensvlakken, vaste oxideladingen van P-SiC (inclusief P ++ laag en P-JTE-gebied)/SiO2 interface en het implementatieproces [15,16,17,18]. Voor de CFM-JTE-afsluiting, de elektrische veldmodulatie op de interface S 1 en S 2 door interface positieve ladingen (Q het ), effectieve kosten (Q j ) en toegepaste potentiaal in de richting van de verticaal wordt geanalyseerd in Fig. 7.
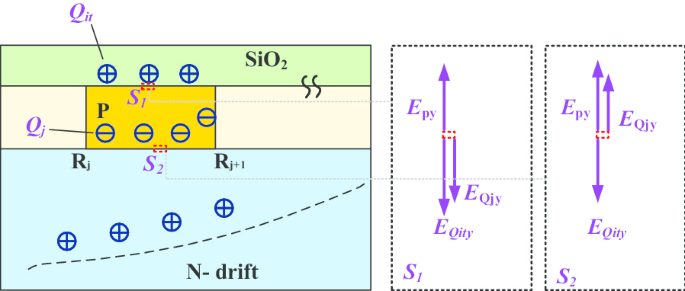
Elektrisch veldmodulatie bij S 1 en S 2 door interface positieve ladingen (Q het ), effectieve kosten (Q j ) en toegepast potentieel
Positieve interfacekosten (Q het ) een tegengesteld ladingsveld genereren (E Aantal ) vergeleken met het toegepaste potentiaalveld (E py ), waardoor de elektrische veldsterkte in de richting van de verticale interface wordt verminderd. Afbeelding 8 toont de elektrische veldverdelingen in SiO2 /SiC-interface S 1 onder omstandigheden van verschillende Q het .

Elektrische veldverdelingen in SiO2 /SiC-interface met verschillende Q het
In termen van de analyse van de ladingsveldmodulatie op interface S 2 , E Aantal is tegengesteld aan de vectorrichting van E py en E Qjy . Het bestaan van Q het helpt het elektrische veld in S . te verminderen 2. Gezien het bestaan van de interfacelading (Q het ), een grotere ionisatie-effectieve lading Q j is vereist om de elektrische veldintensiteit die wordt gegenereerd door de Q . tegen te gaan het . Bijgevolg, wanneer de hoeveelheid Q het toeneemt, moet de optimale implantatiedosisconcentratie van JTE tegelijkertijd worden verhoogd om hetzelfde blokkerende vermogen te behouden. Zoals weergegeven in Afb. 9 is de algemene BV–Dose curve verschuift in de richting van stijgen met de toename in Q het .

Vergelijking van invloeden met de blokkeercapaciteit door interfaceladingen in 4H-SiC PiN-gelijkrichter
Resultaten en discussie
De voorgestelde CFM-JTE 4H-SiC PiN-gelijkrichter is vervaardigd in een 4-inch N-type wafer met 4° off-axis (0001). De wafel wordt door middel van epitaxie gegroeid met vier lagen (N + , N − , P + , P ++ ) overeenkomend met de concentratie van 1 × 10 18 cm −3 , 5 × 10 14 cm −3 , 1 × 10 18 cm −3 en 5 × 10 19 cm −3 . De belangrijkste processtroom van de CFM-JTE-fabricage wordt weergegeven in Afb. 10. De P ++ laag wordt gegroeid door middel van epitaxie om uniforme en zeer dotering te verkrijgen om de ohmse contactkwaliteit tussen SiC en anodemetaal te bevorderen. De mesa-etsstructuur wordt gevormd in de ICP-RIE-faciliteit via het mesa-etsmasker. Het etsgas bestaat voornamelijk uit SF6 en zuurstof. Meerdere Al-ionenimplantaties worden geïmplementeerd met een maximale energie van 500 keV om de CFM-JTE-structuur te vormen. Een tweestaps Al-ionenimplantatie wordt toegepast om de vijf afnemende gedoteerde zones te vormen. JTE1 en R2 -R3 zones worden gevormd door het eerste implantatiemasker. JTE2, R1 -R2 , R3 -R4 , R4 -R5 en R5 -R6 regio's worden gelijktijdig geconfigureerd door de Al-ionenimplantatie door het tweede implantatiemasker. Zoals iedereen weet, is de ionenactiveringssnelheid in siliciumcarbide niet hoog na implantatie van hoogenergetische ionen, wat gepaard gaat met ernstige roosterschade. Om de bovengenoemde ongewenste situatie te verbeteren, worden de implantaties van aluminiumionen uitgevoerd bij een temperatuur van 500 °C via een oxidemasker. Uitgloeien na implantatie is uitgevoerd in argonomgeving bij een temperatuur van 1800 ° C gedurende 10 minuten met een koolstofkap om de schade veroorzaakt door hoogenergetische ionenimplantatie verder te herstellen en de nauwkeurigheid van de dopingconcentratie te verbeteren door de effectieve ionenconcentratie te verhogen activeringssnelheid. P-type SiC ohms contact wordt gevormd met behulp van Al/Ti. Het RTA-proces wordt consequent uitgevoerd en gedurende twee minuten geïnspecteerd in een stikstofomgeving met inert gas bij een temperatuur van 1000 °C. Hoogwaardige passiveringslagen (SiO2 laag, Si3 N4 film en dikke polyimidelaag) worden afgezet om oppervlaktelekkage te voorkomen en vonken in de lucht te voorkomen [5]. De CFM-JTE PiN-gelijkrichter beslaat een actief gebied van maximaal 0,1 cm 2 . Het fabricageproces is consistent met de conventionele JTE 4H-SiC PiN-gelijkrichter met twee zones, zonder extra maskers of processtappen, wat uiterst bevorderlijk is om de fabricagecomplexiteit en -kosten te verminderen.
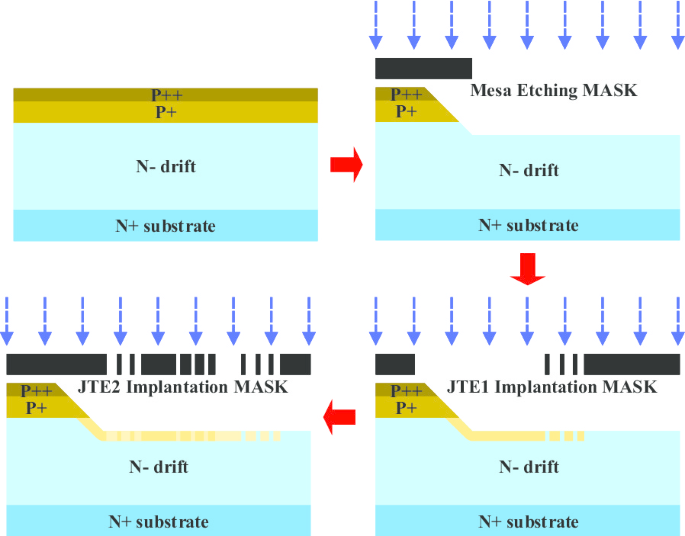
Procesflow van de CFM-JTE
De voorwaartse kenmerken van de vervaardigde CFM-JTE PiN-gelijkrichter zijn getest op de wafer met behulp van het CS-3200 Curve Tracer-instrument. De gefabriceerde CFM-JTE PiN-gelijkrichter vertoont een grote capaciteit van voorwaartse stroomgeleiding zonder technologie voor het verbeteren van de levensduur van de drager. De voorwaartse stroom wordt gemeten tot 100 A, wat overeenkomt met een voorwaartse spanning van 5,2 V, zoals weergegeven in Afb. 11. De differentiële aan-weerstand van de voorgestelde gelijkrichter wordt gemeten als 3,1 mΩ cm 2 bij kamertemperatuur, overeenkomend met de voorwaartse spanning van 3,6 V. De voorwaartse geleidingskarakteristieken bij verschillende temperaturen worden ook geïllustreerd in de inzet van Fig. 11. De I–V curve toont eigenaardigheid van de negatieve temperatuurcoëfficiënt. Dit komt omdat naarmate de temperatuur stijgt, de mobiliteit van het materiaal afneemt, terwijl de smallere bandafstand van het SiC-materiaal het zelfgebouwde potentieel van de P-N-overgang vermindert, en de levensduur van de drager van het driftgebied verlengt met de toename in temperatuur, waardoor de stroomdichtheid toeneemt. De gemeten inschakelspanning is gedefinieerd bij een voorwaartse stroomdichtheid van 10 A·cm −2 . Deze daalt geleidelijk van 3,14 naar 3,04 V wanneer de omgevingstemperatuur stijgt van 25 tot 150 °C. De maximale verschuiving van de voorwaartse inschakelspanning is vastgelopen in een bereik van 3%, wat overeenkomt met een waarde van 0,1 V, wat een veel betere temperatuurstabiliteit vertoont dan Si PiN.
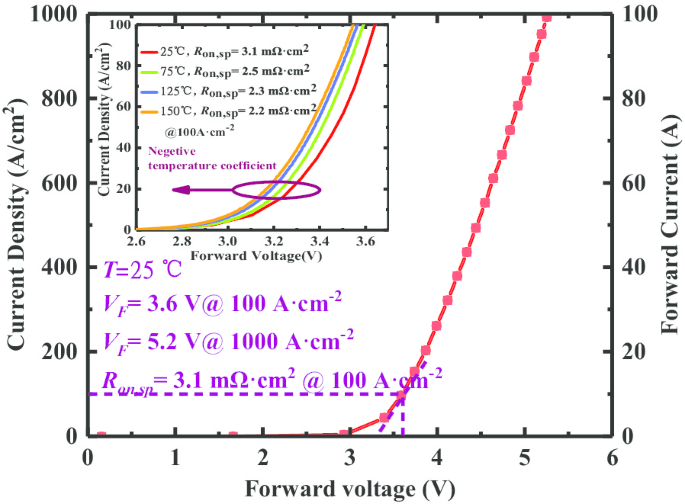
Doorsturen I–V curve van de CFM-JTE PiN-gelijkrichter en kenmerken bij verschillende temperatuuromgevingen in de inzet
De 4H-SiC PiN-gelijkrichters met CFM-JTE, ORA-JTE en conventionele TZ-JTE zijn gefabriceerd op de 4-inch wafer en hun terminalbeschermingseffecten worden getoond in Fig. 12. Omgekeerde doorslagspanningsmetingen worden uitgevoerd en ondergedompeld in Fluorinert-olie om vonken in de lucht te voorkomen. In experimentele metingen met een JTE1-dosis van 1,2 × 10 13 cm −2 , verkrijgen de PiN-gelijkrichters met ORA-JTE en de conventionele TZ-JTE de blokkeercapaciteiten van respectievelijk 12,5 kV en 9,6 kV, met dezelfde aansluitlengte van 400 μm.
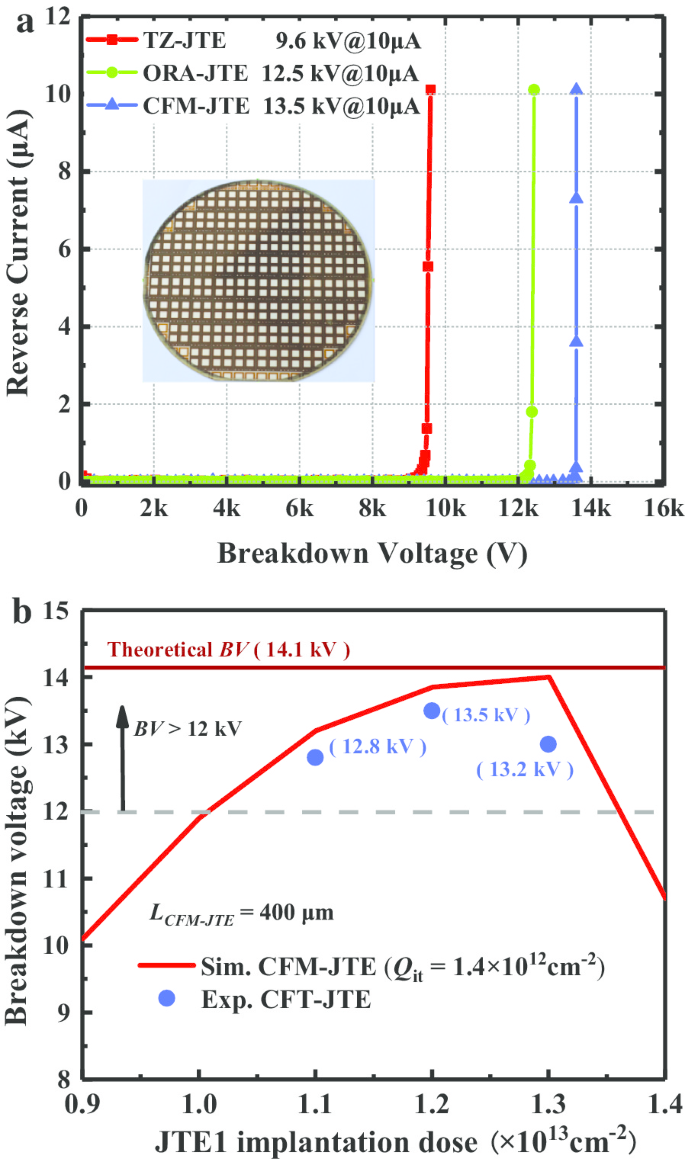
Doorslagkenmerken van de gefabriceerde 4H-SiC PiN-gelijkrichter. een Gemeten BV van de CFM-JTE, ORA-JTE en TZ-JTE. b Gemeten BV van de CFM-JTE met verschillende implantatiedosis. Vaste markeringen zijn de experimentele waarden
Meerdere batches van CFM-JTE PiN-gelijkrichters konden herhaaldelijk de doorslagspanning van 13,5 kV verkrijgen bij een lekstroom van 10 μA. De experimentele blokkeerspanning bereikt tot 96% van de theoretische doorslagwaarde, wat aangeeft dat de CFM-JTE een hogere efficiëntie van de klembeveiliging heeft. Een weerstandsspanning van meer dan 130 V/μm is bereikt in de 100 μm driftlaag van de 4H-SiC PiN-gelijkrichter. Het verdienste van de Baliga (BFOM = BV 2 /R op,sp ) bereikt 58,8 GW/cm 2 op kamertemperatuur. De CFM-JTE PiN's met verschillende JTE1-implantatiedoses zijn vervaardigd. De experimentele en gesimuleerde waarden van de doorslagspanning zijn weergegeven in figuur 12b. De experimentele waarden zijn in overeenstemming met de trend van simulatie en bevestigen dat de CFM-JTE-structuur het JTE-dosistolerantievenster effectief kan uitbreiden. Tabel 2 vergelijkt de kenmerken van de recentelijk gerapporteerde 4H-SiC-gelijkrichters met ultrahoog voltage. De CFM-JTE 4H-SiC-gelijkrichter die in dit werk is gefabriceerd, vertoont uitstekende prestaties op het gebied van ultrahoogspanningsblokkeringscapaciteit, ultrahoge voorwaartse stroomgeleidingscapaciteit en hoge afsluitefficiëntie.
Conclusies
In dit werk is de 4H-SiC CFM-JTE PiN-gelijkrichter met succes ontworpen en gefabriceerd. De experimentele doorslagspanning van de CFM-JTE PiN is 13,5 kV, wat overeenkomt met 96% van de theoretische blokkeringswaarde. De CFM-JTE vertoont een sterk verbeterde efficiëntie van de terminalbeveiliging in vergelijking met de ORA-JTE (BV = 12,5 kV, met een beschermingsefficiëntie tot 88%) en de conventionele TZ-JTE (BV = 9,6 kV, met een beschermingsefficiëntie tot 68% ). De CFM-JTE PiN-gelijkrichter verwerft een grote voorwaartse stroom van 100 A @ V F =5,2 V zonder gebruik te maken van technologie voor levenslange verbetering van de carrier en vertoont stabiele forward I–V eigenschappen bij verschillende temperaturen. De verdienste van de Baliga voor de CFM-JTE PiN-gelijkrichter bereikt 58,8 GW/cm 2 op kamertemperatuur. De tolerantie van het implantatiedosisvenster voor CFM-JTE wordt vergroot op basis van de ladingselektrische veldmodulatie, die ongeveer 2,8 keer die van de conventionele TZ-JTE en 1,4 keer die van ORA-JTE is, wat een veel betere robuustheid tegen procesvariatie laat zien. Bovendien is het fabricageproces voor CFM-JTE consistent met het conventionele TZ JTE-proces zonder het aantal uitzonderlijk complexe processen of maskers te vergroten, wat aantoont dat de CFM-JTE optimaal is voor toepassingen met ultrahoog vermogen met bevredigende terminalefficiëntie en procestolerantie.
Beschikbaarheid van gegevens en materialen
Alle gegevens zijn onbeperkt beschikbaar.
Afkortingen
- SiC:
-
Siliciumcarbide
- JTE:
-
Verlenging knooppuntbeëindiging
- CFM:
-
Laadveld gemoduleerd
- TZ-JTE:
-
Uitbreiding junctionbeëindiging met twee zones
- FLR:
-
Veldbegrenzingsring
- MZ-JTE:
-
Uitbreiding knooppuntbeëindiging met meerdere zones
- CD-JTE:
-
Verlenging van de beëindiging van de gedoteerde kruising
- Ti:
-
Titanium
- Al:
-
Aluminium
- E c :
-
Energiegeleidingsband
- V F :
-
Voorwaartse spanning
- ORA-JTE:
-
Uitbreiding knooppuntbeëindiging buiten de ring
- E q :
-
Elektrisch veld opladen
- E p :
-
Toegepast potentieel veld
- Q ik :
-
Effectieve lading
- VLD:
-
Gevarieerde laterale doping
- w r :
-
Ringbreedte
- 2D:
-
Tweedimensionaal
- BV:
-
Doorslagspanning
- TW:
-
Tolerantievenster
- Q het :
-
Interface opladen
- Q j :
-
Ionisatie effectieve lading
- RTA:
-
Snel thermisch gloeien
- R op,sp :
-
Specifieke aan-weerstand
- BFOM:
-
Baliga's verdienste
Nanomaterialen
- Overwegingen voor circuitbescherming, controle en detectie voor Smart Home Security-toepassingen
- Vervaardiging en karakterisering van nieuwe composiet Tio2 koolstof nanovezel anodische katalysatorondersteuning voor directe methanolbrandstofcel via elektrospinmethode
- Vervaardiging, karakterisering en biologische activiteit van avermectine nano-afgiftesystemen met verschillende deeltjesgroottes
- Vervaardiging, karakterisering en cytotoxiciteit van sferisch gevormde geconjugeerde van goudkokkelschil afgeleide calciumcarbonaat nanodeeltjes voor biomedische toepassingen
- De fabricage en zeer efficiënte elektromagnetische golfabsorptieprestaties van CoFe/C Core-Shell gestructureerde nanocomposieten
- Vervaardiging en karakterisering van ZnO-nanoclips door het door polyol gemedieerde proces
- Synthese en karakterisering van hiërarchische ZSM-5-zeolieten met uitstekende mesoporositeit en uitstekende katalytische eigenschappen
- Eenstaps-maskergebaseerde diffractielithografie voor de fabricage van hangende 3D-structuren
- Multifunctioneel apparaat met schakelbare functies voor absorptie en polarisatieconversie op Terahertz-bereik
- Nieuw apparaat moduleert zichtbaar licht met de kleinste voetafdruk en het laagste stroomverbruik
- De gas- en vlamveiligheidsaanpak voor de energieopwekkingsindustrie



