Lichtvangst geïnduceerde hoge kortsluitstroomdichtheid in III-nitride nanostaafjes/Si (111) heterojunctie zonnecellen
Abstract
Een effectief fotovoltaïsch rendement van 1,27% in stroomconversie, exclusief het metalen contactoppervlak van het rooster en onder 1 zon, AM 1.5G-omstandigheden, is verkregen voor de p-GaN/i-InGaN/n-GaN-diodearrays die epitaxiaal zijn gegroeid op (111)-Si. De kortsluitstroomdichtheid is 14,96 mA/cm 2 en de nullastspanning is 0,28 V. Verbeterde lichtvangst verkregen via meerdere reflecties binnen de spannings- en defectvrije III-nitride nanostaafarraystructuren en de kortegolflengteresponsen versterkt door de brede bandgap III-nitride-bestanddelen worden verondersteld bij te dragen aan de waargenomen verbeteringen in apparaatprestaties.
Inleiding
De ontwikkeling van groene energie is steeds belangrijker geworden en de industrieën voor lichtemitterende diodes (LED's) en zonnecellen hebben zich in een snel tempo ontwikkeld als gevolg van een steeds groter wordende energiecrisis. In de afgelopen decennia zijn III-nitride-halfgeleiders met succes toegepast op LED-apparaten [1,2,3], wat aanzienlijke commerciële voordelen heeft opgeleverd. Momenteel proberen veel wetenschappers het onderzoekspotentieel van III-nitriden te benutten voor fotovoltaïsche toepassingen [4, 5]. Groepen III-V-nitridematerialen hebben veel voordelen voor fotovoltaïsche systemen, zoals een directe bandgap met een grote absorptiecoëfficiënt [4, 6], een breed bandgapbereik dat het grootste deel van het zonnespectrum bestrijkt via bandengineering [4, 6, 7], hoge dragermobiliteit [7] en superieure stralingsweerstand [8]. Op basis van deze uitstekende eigenschappen worden verschillende ontwerpen van apparaatstructuren gesimuleerd, zoals InGaN/Si-tandemcellen [9,10,11,12,13,14], hete dragerzonnecellen [15], op Schottky gebaseerde zonnecellen [16, 17,18], enkele [19,20,21,22,23,24] en meerdere [25, 26] junctie zonnecellen, evenals polarisatie-effecten op de prestaties van zonnecellen [9, 23, 27]. De simulaties hebben voorspeld dat InGaN/Si heterostructurele tandemcellen een efficiëntie kunnen hebben van wel 21-36% [10, 11, 13] op basis van verschillende simulatiemodellen. De vermogensconversie-efficiëntie (PCE) van InGaN homostructurele tandemzonnecel met vier verschillende In-samenstellingen wordt voorgesteld op 51% onder 1-zonstraling en 58% onder 250-zon geconcentreerde toestand [26]. De problemen van onzuiverheden en niet-stralingsrecombinatie worden echter steeds belangrijker onder lage-temperatuur InGaN dunne-filmgroeiomstandigheden [28,29,30]. De significante stapelfouten en dislocatiedichtheden als gevolg van roostermismatch leiden tot de afname van de dragerdiffusielengte en de beperking van zonnecel-PCE [31,32,33,34]. Daarom blijven er tal van uitdagingen over voor de realisatie van de potentiële mogelijkheden van hoogrenderende III-nitride fotovoltaïsche apparaten.
In het afgelopen decennium zijn veel relevante onderzoeksonderwerpen zoals hoog-in InGaN-kristalgroeimethoden op vrijstaand GaN-substraat [34], p-type InGaN-doping [35], kwantumputontwerpen [36,37,38,39,40], elektrode ontwerpen [41,42,43,44], concentrator fotovoltaïsche cellen [37, 41, 45], tussenliggende band zonnecellen [46] en reflectie-gereduceerde structuren [47,48,49] zijn bestudeerd. Bovendien werden de niet-polaire zonnecellen op nitridebasis onderzocht op het polarisatie-effect [50, 51]. Dahal et al. demonstreerde een werking van meer dan 30% InGaN-zonnecellen met meerdere kwantumputten bij langere golflengten (> 420 nm) [38] en illustreerde een efficiëntie van 3,03% bij verhoogde verlichtingsintensiteit tot 30 zonnen [37]. Mori et al. onderzocht op concentrator nitride gebaseerde zonnecellen [45] en richtte zich op de hoogste PCE van 4% bij een hoge lichtintensiteit tot 300 zonnen [41]. Hoewel verschillende onderzoeksgroepen verschillende structurele of optische ontwerpen hebben geleverd en de groeitechnieken hebben verbeterd, is de PCE van III-nitride-zonnecellen niet veel vooruitgegaan. Aan de andere kant, Reichertz et al. toonde aan dat tandemzonnecellen haalbaar zijn door epitaxiaal groeien van pn-junctie GaN op pn-junctie Si-substraat [14]. Hun resultaten gaven aan dat het Si-substraat bijdroeg aan de efficiëntie met een lange golflengte, terwijl nitride de efficiëntie met de korte golflengte bijdroeg. Siliciumsubstraten bieden niet alleen een goedkope oplossing, maar ook PCE-verbetering en een goede thermische geleidbaarheid [52].
Gewoonlijk worden voor zonnecelgroei continue filmlagen op elkaar gekweekt en dit resulteert in een hoge dislocatiedichtheid. Wanneer III-nitriden echter in nanostructuren worden gekweekt, is het bodemgebied dat in contact staat met het substraat klein, waardoor dislocaties in de schroefdraad worden verminderd en spanning ook minimaal kan zijn. Tessarek et al. rapporteerde dat de dislocaties van GaN-nanostaafjes verdwenen naarmate de diameter daalt tot 200 nm [53]. Daarom zou het, als alternatief voor filmgroei op siliciumsubstraten, een voorkeurskeuze zijn om III-nitride nanorod-zonnecellen te laten groeien om de kosten te verlagen, de kristalkwaliteit te verbeteren en de celefficiëntie te verbeteren. Ook heeft nanostaaf/nanodraad een grote capaciteit voor fotovoltaïsche toepassingen omdat de foto-gegenereerde elektronen effectiever kunnen worden verzameld voordat ze opnieuw worden gecombineerd met gaten dankzij een direct pad naar de elektroden en nanostaafstructuren kunnen het vangen van licht verbeteren om de fotonabsorptie te verbeteren [54, 55]. Verschillende groepen hebben de fotodetectoren [56, 57], nanolasers [58, 59], nano-LED's [60, 61] en foto-elektrochemische watersplitsingstoepassingen [62] op basis van III-nitride nanostaafjes [55] gedemonstreerd. Desalniettemin is het nadeel van zonnecellen met nanostaafjes dat foto-gegenereerde elektron-gat-paren recombineren op overvloedige centra voor het vangen van dragers als gevolg van oppervlaktedefecten. Bovendien zijn de fabricageprocessen van nanorod-zonnecellen ingewikkelder dan die van dunne-filmapparaten. Het overwinnen van deze hierboven genoemde problemen heeft echter geleid tot een bijna drievoudige toename van PCE, zoals aangetoond door Wallentin et al. waarbij de InP nanorod-array een PCE van 13,8% heeft door optimalisatie van de nanorod-diameter en de lengte van het bovenste n-segment [54, 63]. Krogstrup et al. gaf aan dat hoge kortsluitstroomdichtheid (Jsc ) werd verkregen in de GaAs-nanodraadstructuren met een enkele kern als gevolg van meer dan één orde van grootte lichtabsorptie versterkt door lichtconcentratie [64]. Wiener et al. [65], Cansizoglu et al. [66], en Nguyen et al. [31] demonstreerde verschillende soorten nitride nanorod-array zonnecellen op GaN-template en Si-substraat. De vergelijking van recent fotovoltaïsch onderzoek met nanorod / nanodraad staat vermeld in aanvullende informatie:tabel S1. De foto-elektrische conversiebijdragen van verschillende InGaN nanorod-ensemble-fotovoltaïsche apparaten op goedkope Si (111)-substraten zijn tot nu toe echter niet systematisch besproken.
In deze studie werden Mg:GaN/InGaN/Si:GaN III-nitride nanostaafensembles met 8% en 11% indiumconcentratie gekweekt op n-gedoteerde Si (111) substraten door plasma-ondersteunde moleculaire bundelepitaxie (PA-MBE, Veeco EPI930). De structurele eigenschappen en het indiumgehalte werden geschat door röntgendiffractie met hoge resolutie (HR-XRD, Bede D1) metingen. De fijne structuur van nanostaafjes werd geanalyseerd door transmissie-elektronenmicroscopie met hoge resolutie (HR-TEM, FEI E.O Tecnai F20 G2). De stroomdichtheid versus spanning (J-V) eigenschappen van nitride zonnecellen werden besproken onder 1 zon, AM 1.5G verlichting (Newport 94023A). Externe kwantumefficiëntie (EQE, Enli Technology Co., Ltd., QE-R3018) werd gemeten om de spectrale respons te bestuderen. De uitlijning en simulaties van het banddiagram werden ook onderzocht om het transport van elektronen en gaten te verklaren.
Experimentele methode
Groeitechniek
De groei van Si:GaN en Mg:GaN/InGaN/Si:GaN nanostaafjes is gebaseerd op de plasma-assisted moleculaire bundel epitaxie (PA-MBE) techniek. Alle monsters werden gekweekt met een Veeco GEN930 PA-MBE-systeem uitgerust met een 6N stikstofplasmabron (Veeco, UNI-Bulb). Het n-type Si (111) substraat met een soortelijke weerstand van 0,001-0,005 cm werd gereinigd met aceton, isopropanol en gedeïoniseerd water in een ultrasoon bad gedurende 5 min bij elke stap om resterende organische verontreiniging te verwijderen en vervolgens geëtst in een 48–51% HF:H2 O =1:5 oplossing gedurende 5 min om het natieve oxide te verwijderen. Na het chemische reinigings-/etsproces werd het Si-substraat drooggeblazen met stikstofgas. Het Si-substraat werd in de bufferkamer gebracht en vervolgens door een magnetisch gekoppelde overdrachtsarm naar de groeikamer overgebracht. Voorafgaand aan de groei van nanostaafjes werd het substraat 30 min thermisch gereinigd bij 900 ° C om achtergebleven natuurlijk oxide te verwijderen voor het verkrijgen van een schoon en geordend 7 x 7 gereconstrueerd Si-oppervlak. De geactiveerde stikstofatomen werden gegenereerd door een plasmakanon en de flux en zuiverheid ervan werden geregeld via een massastroomregelaar met hoge resolutie (HORIBA STEC, SEC-7320 M) en een stikstofzuiveringsinstallatie (Entegris, CE35KFI4R). De Ga-, In-, Si- en Mg-bronnen met een hoge zuiverheid (6N of hoger) werden geleverd door effusiecellen met een vaste bron. Het groep III metaal en N2 plasmabundel equivalente druk (BEP) werden gemeten met een bundelfluxmeter. Door de III / V-fluxverhoudingen tot N-rijke toestand te regelen, kunnen nanostaafjes worden verkregen. Eerst werden zelf-geassembleerde Si:GaN-nanostaafjes gedurende 82 min bij 760 ° C gekweekt. Desorptie van InN is van cruciaal belang bij verhoogde temperaturen omdat indium van het monsteroppervlak zal verdampen. Om indium in de nanostaafjes vast te houden, werd de metaal-gemoduleerde epitaxie (MME) techniek gebruikt [67, 68]. MME omvat het periodiek openen en sluiten van de metalen luiken om de metaalfluxen te moduleren, terwijl de N2 sluiter wordt open gehouden. Voor het afstemmen van de In-concentratie troffen twee verschillende cyclustijden van In- en Ga-atomen afwisselend 20 s/30 s (monster B) en 30 s/30 s (monster C) met 50 perioden bij 550 °C. Ten slotte werd de Mg:GaN-laag gekweekt bij 600 ° C. De monsters zijn gekweekt onder 9,25 × 10 −6 torr actieve stikstof BEP met plasmavermogen 450 W, 2,42 × 10 −8 torr In BEP, en 1,93 × 10 −8 torr Ga BEP. Bovendien werden de enkellaagse Si:GaN-nanostaafjes (monster A) ook bereid als een gecontroleerde groep onder dezelfde omstandigheden.
Apparaatfabricage
Na de groei van nanostaafjes omvatte het fabricageproces van het apparaat de volgende stappen. (1) Het apparaatgebied van 350 × 350 μm 2 mesa werd gedefinieerd door te etsen tot het n-type Si met tetrafluormethaan (CF4 ) gebaseerd op de reactieve-ionen-etstechniek (Advanced System Technology, Cirie-200) met fotoresist (Microchemicals GmbH, AZ1400) als masker. (2) Een ultrasoon bad met gedeïoniseerd water werd gebruikt om losse nanostaafjes uit het apparaat te verwijderen, behalve die van het mesagebied. (3) Dompel het monster onder in (NH4 )2 S bij 60 ° C gedurende 1 min om het nitride-oppervlak te passiveren voor natuurlijke oxideonderdrukking en niet-stralingsrecombinatiereductie [69,70,71,72,73]. (4) Een dunne film van 100 nm indiumtinoxide (ITO) werd bovenop de nanostaafjes afgezet om te dienen als het Mg:GaN ohmse transparante contact door sputteren (Advanced System Technology, Psur-100HB) vergezeld van fotolithografie (M&R Nano Technology , AG350-6B) en opstijgtechnieken. (5) Meerlagige Ti/Al/Ti/Au (20 nm/300 nm/20 nm/50 nm) metalen roostercontacten op de ITO-film en op de n-type Si-substraten werden vervaardigd door e-beam-verdamping (Advanced System Technology , Peva-600E) met behulp van fotolithografie en lift-off-technieken. (6) Alle metalen roostercontacten werden gegloeid door een snel thermisch gloeisysteem (Advanced System Technology, FA04) gedurende 30 s in stikstof bij 800 °C om ohmse contacten te verkrijgen.
TEM-monstervoorbereiding
Om de kristalstructuur verder te bestuderen, werden individuele nanostaafjes van monsters B en C geëxtraheerd door sonicatie in ethanol. Na 30 min ultrasoonapparaat werden een paar druppels van de ethanoloplossing aangebracht op een koperen rooster (Ted Pella) en de ethanol werd verdampt bij kamertemperatuur. Voorafgaand aan de metingen werd het monster gebakken op 150°C om vrije organische oplosmiddelen te verwijderen.
Resultaten en discussie
Morfologische en structurele eigenschappen
De bovenaanzichten en dwarsdoorsneden van scanning-elektronenmicroscopie (SEM) -afbeeldingen worden getoond in Fig. 1a-f en illustreren de morfologie van de als gegroeide nanostaafjes. Van links naar rechts, Fig. 1 a-c vertegenwoordigt de variatie in de oppervlaktemorfologie van Si:GaN (monster A) en Mg:GaN/InGaN/Si:GaN met gevarieerde In/Ga-atomen die een cyclustijd van 20 s/30 beïnvloeden s (monster B) en 30 s/30 s (monster C) tijdens respectievelijk de 50-cyclus InGaN-groei. De diameters van Si:GaN en Mg:GaN/InGaN/Si:GaN nanostaafjes zijn respectievelijk 30-100 nm en 80-150 nm, terwijl de oppervlaktedichtheden ~ 7 × 10 9 zijn cm −2 . De dwarsdoorsnede-afbeeldingen van de nanostaafjes worden getoond in Fig. 1d-f en geven aan dat de lengte van nanostaafjes ongeveer 700 nm is voor monsters A tot C. De schematische structuur van de Mg:GaN / InGaN / Si:GaN-monsters wordt getoond in afb. 1g.
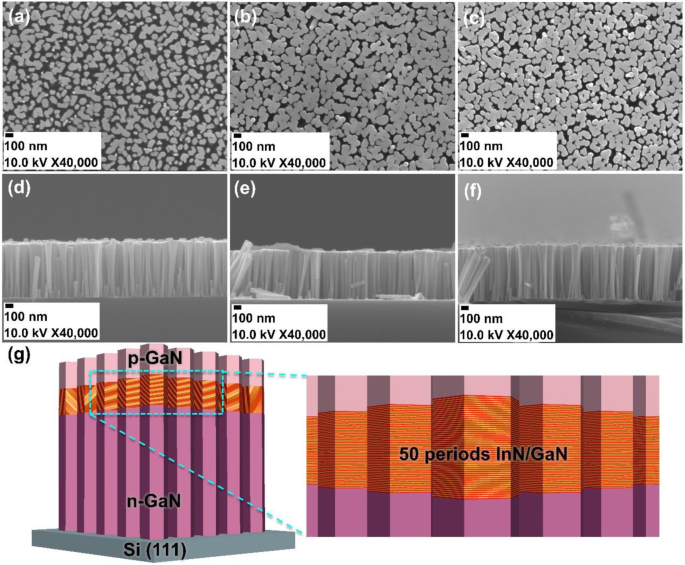
De SEM-topweergaven van a n-GaN (monster A), p-GaN/InGaN/n-GaN met de In- en Ga-atomen getroffen cyclustijden van b 20 s/30 s (voorbeeld B) en c 30 s/30 s (voorbeeld C). De SEM-doorsnedeweergaven van d voorbeeld A, e voorbeeld B, en f monster C. g Een schematisch diagram van p-GaN/InGaN/n-GaN nanostaafstructuur
Figuur 2a registreerde de x-ray theta-2theta-diffractiemeting gericht op verschillende broninvallende cyclustijdmonsters. De sterkste piek op 28,44° is afkomstig van het Si-substraat. Een scherpe heldere piek bij 34,56° komt overeen met de GaN (0002) diffractie en duidt op een goede remming van fasemenging van de InGaN-laag. Een piek aan de onderste 2-theta-zijde van de GaN (0002)-piek bij 34,22° voor monster B en bij 34,13° voor monster C is InGaN (0002). De c roosterconstanten van InN en GaN zijn respectievelijk 5.760 Å en 5.185 Å [74]. Volgens de wet van Bragg is de c roosterconstanten van InGaN (0002) worden berekend als 5,23 Å voor monster B en 5,25 Å voor monster C. Importeren van de c roosterconstante van InGaN (0002) volgens de wet van Vegard, kan de In-concentratie worden geschat op 8% voor monster B en 11% voor monster C zonder rekening te houden met spanning. Figuur 2b toont het TEM-beeld met lage vergroting van monster C en schematisch diagram van de structuur ervan. Het gebied 1 en gebied 2 zijn respectievelijk n-GaN- en InGaN-gebieden. Het selectieve gebied elektronendiffractie (SAED) patroon genomen in het gebied 1 toont aan dat de richting van de [0001] evenwijdig is aan de lange as van de nanostaaf en een gemeenschappelijke groeirichting van nitride nanostaafjes. Bovendien wordt er geen dislocatie in het kristal gevonden. In figuur 2 c en d leveren de TEM-beelden met atomaire resolutie de c roosterconstanten van GaN en InGaN als respectievelijk 5,19 Å en 5,25 Å, hetzelfde als de resultaten berekend door de wet van Bragg via XRD theta-2theta-scan. Bovendien is de c roosterconstante van InGaN voor monster B is 5,23 via TEM-afbeeldingen met atomaire resolutie die worden weergegeven in de aanvullende informatie:figuur S1. Bovendien zijn high-angle ringvormige donkerveld (HAADF) afbeeldingen en energiedispersieve röntgenspectroscopie (EDS) lijnscan, die de indiumverdeling aangeeft, opgenomen in aanvullende informatie:figuur S2.
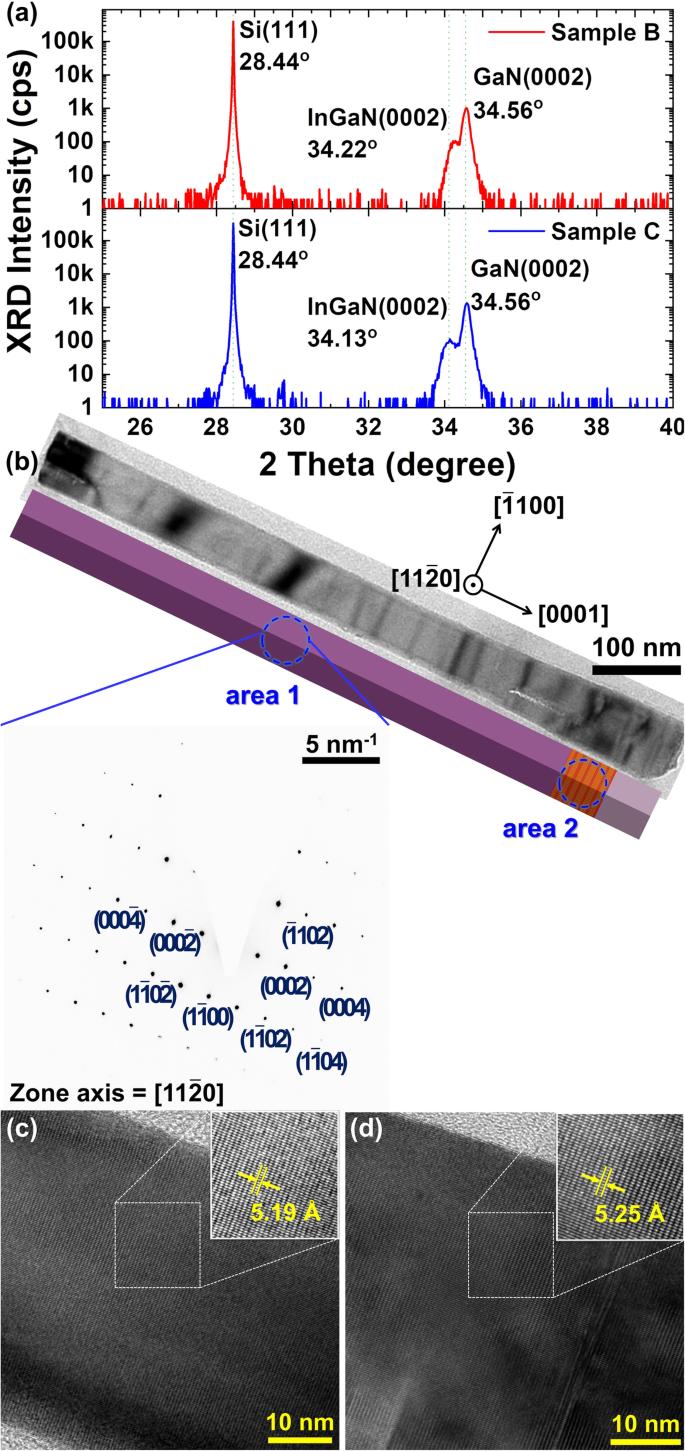
een HR-XRD-spectra voor de theta-2theta-scans. Het indiumgehalte van het InGaN-materiaal werd geschat op 8% voor monster B (rode curve) en 11% voor monster C (blauwe curve) met behulp van de wet van Vegard. b Het dislocatievrije nitride nanostaafje TEM-beeld en SAED-patroon van het n-GaN-gebied. Het schematische diagram van de enkele nanostaaf onder de afbeelding gehoorzaamt aan de structurele relatieve schaal. De TEM-beelden met atomaire resolutie van c n-GaN in gebied 1 en d InGaN in gebied 2 tonen dislocatie vrij en hun c roosterconstanten
Analyse van elektrische en optische kenmerken
De stroomdichtheid versus spanningsmetingen werden uitgevoerd door een Keithley 2400 bronmeter. Figuur 3a toont het schematische diagram van de nanorod-assemblage van de zonnecel. Het totale apparaatoppervlak is 0,12 mm 2 en het effectieve gebied onder de verlichting exclusief het contactmetaal is 0,0924 mm 2 . Om door fotonen gegenereerde elektronen te verzamelen, wordt een 100 nm transparante geleidende ITO-film afgezet op de bovenkant van de p-GaN om de nanostaafjes en de Ti/Al/Ti/Au (20 nm/300 nm/20 nm/50 nm te verbinden) ) vingerelektrode. Foto-elektrische karakteristieke analyses van het apparaat werden ook uitgevoerd met een zonnesimulator onder 1 zon, AM 1.5G-conditie zoals weergegeven in Fig. 3b-d. De serieweerstand R s waarden bepaald uit Fig. 3b-d zijn 83 Ω, 250 Ω en 2.5 kΩ en de shuntweerstand R sh waarden zijn respectievelijk 413 kΩ, 550 kΩ en 2 MΩ voor monsters A, B en C. De fotostroomdichtheid bij nulspanning, Jsc , van In0,08 Ga0,92 N-apparaat (voorbeeld B) en In0.11 Ga0,89 N apparaat (monster C) is 7,77 mA/cm 2 en 14,96 mA/cm 2 respectievelijk. De verbetering van de fotostroom ten opzichte van de toenemende In-concentratie werd aangetoond via Jsc vergelijking. Verder hebben Krogstrup et al. illustreerde dat de lichtconcentrerende eigenschap in nanorod-zonnecellen de lichtabsorptie kan verbeteren en een hoge fotostroom kan leveren [64]. De nullastspanning (Voc ) en vulfactor (FF) van monster C zijn respectievelijk 0,28 V en 30%. Verschillende groepen demonstreerden ook nanostaafjes met lagere Voc [72, 75, 76]. Om de werkelijke fotovoltaïsche prestaties in een werkelijk verlicht gebied te verduidelijken, PCE, PCEeff , stelt een efficiëntie vast op basis van het effectieve gebied dat het rasterelektrodegebied uitsluit, terwijl het totale gebied PCE, PCEtot , houdt rekening met het hele apparaatgebied. Het is opmerkelijk dat de PCEtot en PCEeff waarden zijn 0,98% en 1,27%, wat wijst op een hogere PCE van nitride nanostaaf-zonnecel ooit gerapporteerd. De belangrijkste bijdrage komt van de hoge Jsc , hoewel de Voc is lager dan andere III-nitride nanostaafjes zonnecellen [65, 77]. Er zijn twee mogelijke redenen voor een lage Voc , inclusief het quasi-Fermi-niveau beperkt op de pn Si-junctie dat Si-bandgap 1,12 eV is op basis van het banddiagram en een beperkt stroompad kan worden gecreëerd als gevolg van het vastzetten van het Fermi-niveau op het oppervlak [66]. Tabel 1 vat Jsc . samen , Voc , FF en PCE vergelijking van drie samples.
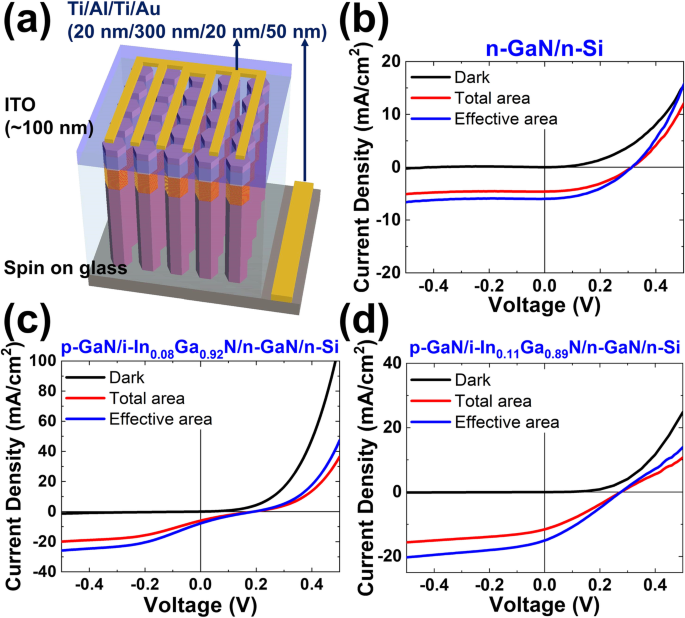
een De nanorod monteren zonnecel schematisch diagram. De stroomdichtheid-spanningscurven van b n-GaN/n-Si, c p-GaN/In0,08 Ga0,92 N/n-GaN/n-Si, en d p-GaN/In0,11 Ga0,89 N/n-GaN/n-Si nanostaafjes assembleren zonnecellen gemeten onder 1 zon, AM 1.5G zonnesimulator
Om de fysieke en elektrische eigenschappen te begrijpen, worden de banddiagrammen berekend met behulp van een 1D-DDCC (One Dimensional Poisson, Drift-Diffusion en Schrodinger Solver) programma [78]. De gebruikte elektronenaffiniteiten van ITO, Si en GaN zijn respectievelijk 4,40 eV, 4,05 eV en 4,1 eV. Figuur 4 a en b tonen het ITO / n-GaN / n-Si-banddiagram zonder spanningsbias en J-V-curve onder respectievelijk donker. Het illustreert dat de ITO/n-GaN/n-Si-structuur geen corrigerend effect heeft en een lineair J-V-profiel vertoont. De potentiële barrière van de hetero-interface kan worden genegeerd voor vervoerders om te transporteren, omdat de geleidingsband-offset tussen Si en GaN naar verwachting een kleine waarde van 50 meV zal zijn. Deze weerstandachtige lineaire J-V-curve is in tegenspraak met de experimentele resultaten.

een ITO/n-GaN/n-Si-banddiagram, b ITO/n-GaN/n-Si J-V-curve, c ITO/n-GaN/p-Si/n-Si banddiagram, en d J-V-curven van ITO/n-GaN/p-Si/n-Si gesimuleerd door 1D-DDCC-programma
Een mogelijke verklaring voor de resultaten van de J-V-curve is dat Ga-diffusie een p-Si induceert op het GaN/Si-interface en een pn-overgang creëert. Reichertz et al. [14] en Neplokh et al. [76] hebben de Al-diffusie in het siliciumsubstraat geverifieerd tijdens de groei van nitridelagen. Boor, Al en Ga zijn IIIB-groepselementen die een doteringsmiddel kunnen zijn voor de vorming van p-Si-lagen. De Ga-diffusiesnelheid is echter 8 nm/dag bij 700 °C [79]. Figuur 4c toont een banddiagram met een zeer dunne (1 nm) p-Si-laag tussen n-GaN en n-Si-interface. Er wordt een klein ingebouwd elektrisch veld gecreëerd in de p-n Si-junctie die de elektronen naar het n-Si-substraat en gaten naar de ITO-contactlaag kan sturen. De dikteafhankelijke J-V-curven laten zien dat de diode-inschakelspanning afneemt wanneer de dikte van p-Si-lagen dunner wordt in figuur 4d. De ultradunne p-Si zal een beperking zijn voor quasi-Fermi-niveauscheiding en de Voc verminderen van zonneprestaties. De gesimuleerde elektrische eigenschap met de p-Si-laag inbegrepen ligt dichter bij dit onderzoeksresultaat. Daarom kan het banddiagram van de Mg:GaN/InGaN/Si:GaN/p-Si/n-Si-structuur worden gebouwd als een model zoals in Fig. 5. Verlichting van AM 1.5G-licht vanaf de bovenkant leidt tot de absorptie van fotonen met een energie hoger dan de InGaN-bandgap. Wanneer licht door de staven en de tussenruimte tussen de staven op het Si straalt, kunnen de fotonen met een energie groter dan de Si bandgap ook worden geabsorbeerd door het pn Si-substraat en wordt fotostroom geproduceerd. Tegelijkertijd worden de elektron-gat-paren die in de nitridegebieden worden gegenereerd door het licht met korte golflengte gescheiden door een ingebouwd elektrisch veld van de p-i-n-overgang. Uiteindelijk konden foto-gegenereerde dragers worden verzameld via het bovenste indiumtinoxide (ITO) contact met Mg:GaN en het onderste Si-n-contact. Op basis van dit structuurmodel en rekening houdend met de Schottky-barrière geïntroduceerd door ITO-contact, wordt de J-V-curvesimulatie getoond in figuur 5b. De gesimuleerde J-V-curve geeft aan dat de S-vorm wordt veroorzaakt door het niet-ohmse gedrag van het p-contact. Dat is een mogelijke reden om te verklaren dat de S-vorm bestond voor Mg:GaN/u-InGaN/Si:GaN (monsters B en C) in Fig. 3 c en d. Daarom zijn de stroomdichtheden bij negatieve bias (Jnegative bias (− 0,5 V) ) waar de S-vorm is afgeplat, staan vermeld in Tabel S2. Jnegatieve vooringenomenheid kan een controlepunt zijn voor verdere optimalisatie en een gerichte waarde.
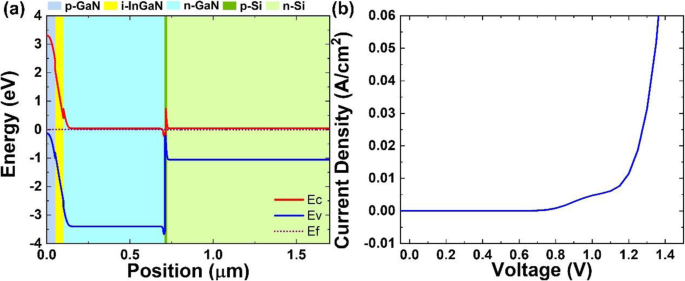
een De p-i-n nitride nanostaaf op p-n Si zonnecelbanddiagram gesimuleerd door 1D-DDCC-programma. b J-V-curvesimulatie van p-i-n nitride nanostaaf op p-n Si-zonnecel
De EQE-meetresultaten zonder lichtafwijking (extra ongemoduleerd licht) worden getoond in Fig. 6a, waarin de EQE's van Si:GaN/n:Si (monster A), Mg:GaN/u-In0,08 Ga0,92 N/Si:GaN (monster B) en Mg:GaN/u-In0,11 Ga0,89 N/Si:GaN (monster C). Monster C heeft een hogere In-concentratie die verantwoordelijk kan zijn voor de hogere waarden bij korte golflengte vanwege de absorptie in de InGaN-laag. De maximale EQE's in monsters A, B en C zijn respectievelijk 32%, 55% en 63%. Vergeleken met de reflectiespectra van Si-wafer, monsters A, B en C getoond in Fig. 6b, zijn de oscillaties van EQE's en reflectiespectra te wijten aan de interferentie van verschillende lagen. De kale Si-wafer heeft de hoogste reflectie vanwege het vlakke oppervlak. Monsters A, B en C hebben een lagere reflectie omdat nanostaafstructuren een lichtvangend effect hebben. Monster C blijkt de hoogste EQE te hebben bij lange golflengte en de laagste reflectie vanwege het hoogste lichtvangeffect. Dit resultaat kan de hogere fotostroom die wordt gegenereerd in monster C verklaren. De fotoluminescentiespectra (PL) bij kamertemperatuur (RT, 300 K) van monster B en monster C worden getoond in Fig. 6c. De hoogste piek bij de 3,40 eV is GaN near band edge (NBE) emissie. De pieken bij 3,09 eV en 3,03 eV zijn te wijten aan In0,08 Ga0,92 N en In0.11 Ga0,89 N NBE-emissie. De resultaten zijn vergelijkbaar met de waarden uit de berekening van de buigvergelijking van 3,1 eV en 3,0 eV bij RT [4]. Het toont ook dezelfde sterke Fabry-Perot-oscillaties (gemarkeerd door sterrenbeelden) als de EQE's en de reflectiespectra, die de vloeiende interfaces tussen elke laag/oppervlak vertegenwoordigen.

een Externe kwantumefficiëntiespectra van drie nitride-nanostaafjes / Si-monsters. b De reflectiespectra van kale Si-wafels en drie nitride-nanostaafjes / Si-monsters. c De fotoluminescentiespectra bij kamertemperatuur van twee InGaN-monsters
Conclusie
Hoge kwaliteit Mg:GaN/InGaN/Si:GaN en Si:GaN nanostaafjes gekweekt op n-Si door plasma-geassisteerde moleculaire bundelepitaxie zijn met succes aangetoond. Fotovoltaïsche metingen vertonen een PCEeff van 1,27% en een PCEtot van 0,98% onder 1 zon, AM 1,5G-verlichting voor Mg:GaN/u-In0,11 Ga0,89 N/Si:GaN dat een hogere In-concentratie heeft en een hoger lichtvangend effect dat een hoge fotostroom induceert. Hoewel Si:GaN-nanostaafjes op n-Si-apparaten mogelijk geen prominent ingebouwd veld voor pn-overgangen hebben, helpt het ontwerp van een goede heterojunctiestructuur om de fotodragers naar de bovenste en onderste contacten te drijven en de celprestaties te verbeteren.
Beschikbaarheid van gegevens en materialen
De auteurs verklaren dat het materiaal en de gegevens beschikbaar zijn voor de lezers, en alle conclusies die in dit manuscript worden getrokken, zijn gebaseerd op de gegevens die allemaal in dit artikel worden gepresenteerd en getoond.
Afkortingen
- LED:
-
Lichtgevende diode
- PCE:
-
Energieconversie-efficiëntie
- Jsc :
-
Kortsluitstroomdichtheid
- PA-MBE:
-
Plasma-geassisteerde moleculaire bundelepitaxie
- HR-XRD:
-
Röntgendiffractie met hoge resolutie
- HR-TEM:
-
Transmissie-elektronenmicroscopie met hoge resolutie
- EQE:
-
Externe kwantumefficiëntie
- BEP:
-
Straal equivalente druk
- MME:
-
Door metaal gemoduleerde epitaxie
- ITO:
-
Indiumtinoxide
- Voc :
-
Nullastspanning
- RT:
-
Kamertemperatuur
- PL:
-
Fotoluminescentie
- NB:
-
Nabij bandrand
Nanomaterialen
- Zonnecel
- Nanobomen voor kleurstofgevoelige zonnecellen
- Hoogrendement grafeen zonnecellen
- Nano-heterojuncties voor zonnecellen
- Fotovoltaïsche kenmerken van GaSe/MoSe2 heterojunctie-apparaten
- Plasmon-versterkte lichtabsorptie in (p-i-n) Junction GaAs nanodraad-zonnecellen:een FDTD-simulatiemethodestudie
- Een kort voortgangsrapport over hoogrenderende perovskiet-zonnecellen
- Zeer geleidende PEDOT:PSS transparante gattransportlaag met oplosmiddelbehandeling voor hoogwaardige silicium/organische hybride zonnecellen
- Elektrodepositie van SnO2 op FTO en de toepassing ervan in planaire heterojunctie perovskiet-zonnecellen als een elektronentransportlaag
- Synthese van ZnO-nanokristallen en toepassing in omgekeerde polymeerzonnecellen
- Wolfraam



