Theoretisch en experimenteel onderzoek naar AlGaN/GaN Schottky-barrièrediode op Si-substraat met dubbele heterojunctie
Abstract
Een AlGaN/GaN Schottky barrièrediode (SBD) met dubbele heterojunctie wordt theoretisch en experimenteel onderzocht op de GaN/AlGaN/GaN/Si-sub. Het tweedimensionale gatengas (2DHG) en elektronengas (2DEG) worden gevormd op respectievelijk het GaN-top/AlGaN- en AlGaN/GaN-interface. In de off-state zijn de 2DEH en 2DHG gedeeltelijk uitgeput en verdwijnen dan volledig. Er blijven de vaste positieve en negatieve polarisatieladingen, die de polarisatiejunctie vormen. Daarom wordt een vlak elektrisch veld in het driftgebied en een hoge doorslagspanning (BV) verkregen. Bovendien is de anode verzonken om de inschakelspanning te verminderen (V AAN ). Het schadearme ICP-etsproces resulteert in verbeterde Schottky-contacten en een lage lekstroom en een lage V AAN is verkregen. De gefabriceerde SBD vertoont een BV van 1109 V met anode-naar-kathode afstand (L AC ) van 11 m. De gefabriceerde SBD's bereiken een lage V AAN van 0,68 V met goede uniformiteit, een hoge aan/uit stroomverhouding ∼ 10 10 bij kamertemperatuur een lage specifieke aan-weerstand (R AAN,SP ) van 1,17 mΩ cm 2 , en een hoge Baliga's figure-of-merit (FOM) van 1051 MW/cm 2 .
Inleiding
Op AlGaN/GaN-heterostructuur gebaseerde laterale diode is een aantrekkelijk apparaat vanwege de hoge elektronenmobiliteit van het tweedimensionale elektronengas (2DEG), de hoge elektronenverzadigingssnelheid en het hoge elektrische doorslagveld [1,2,3]. Er zijn uitgebreide inspanningen geleverd om een lage inschakelspanning (V AAN ), een lage sperlekstroom en een hoge doorslagspanning (BV) voor de GaN-diodes die worden gebruikt in converters en inverters voor voedingen en vermogensfactorcorrecties [4,5,6,7,8,9,10,11,12] . Er zijn verschillende benaderingen voorgesteld om de niet-uniforme verdeling van het elektrische veld op te lossen. Een daarvan is de veldplaattechnologie (FP) [5, 13]. Een volledig verzonken anode SBD met een dubbele veldplaat bereikt een hoge doorslagspanning van 1,9 kV met 25 m L AC [5]. Het kan ook de inschakelspanning aanzienlijk verlagen terwijl een hoge doorslagspanning behouden blijft. Bovendien is het conventionele REduced SURface Field (RESURF)-concept dat gewoonlijk wordt gebruikt in siliciumtechnologie, aangetoond in GaN HEMT [14]. Bovendien wordt de polarisatieovergang (PJ) bestaande uit het tweedimensionale gatgas (2DHG) boven de 2DEG voorgesteld om de relatie tussen specifieke aan-weerstand (R AAN,SP ) en BV [15,16,17,18]. Op GaN gebaseerde apparaten op basis van het PJ-concept zijn aangetoond op saffier- en SiC-substraat, terwijl de hoge kosten en kleine diameters van de GaN op SiC-substraten indruisen tegen de massale commerciële toepassing. GaN-op-Si met een grote diameter wordt gezien als een veelbelovende keuze vanwege de lage kosten [19,20,21,22]. Daarom zijn de prestaties van de PJ-diode op siliciumsubstraten het bestuderen waard.
In dit werk hebben we een GaN/AlGaN/GaN-op-Si Schottky-barrièrediode met dubbele heterojunctie (DJ) voorgesteld en experimenteel gedemonstreerd. Het polarisatie-junctie-effect wordt bevestigd door simulaties en experimenten. Het vlakke elektrische veld (E-veld) tussen de anode- en kathode-elektroden wordt bereikt. Het ICP-proces voor het etsen van Schottky-geul is geoptimaliseerd om een lage omgekeerde lekstroom en een lage V te verkrijgen AAN met uitstekende etsuniformiteit. Het ohmse contactproces is ook geoptimaliseerd om een lage contactweerstand (voor 2DEG) te bereiken op basis van de aangepaste epitaxiale laag (met 45 nm GaN-top). Daarom wordt een doorslagspanning van 1109 V bereikt voor de SBD's met 11 μm L AC en Baliga's figure-of-merit (FOM) is 1051 MW/cm 2 . De temperatuurafhankelijkheid en dynamische R AAN,SP prestaties worden ook onderzocht.
Methode en experiment
De epitaxiale laag werd gegroeid door metaal-organische chemische dampafzetting op 6-in p-type silicium, bestaande uit 3,5 μm GaN-bufferlaag, 150-nm GaN-kanaallaag, 1-nm AlN-tussenlaag, 45-nm Al 0,25 Ga0,75 N barrièrelaag en 45 nm GaN-toplaag van onder naar boven. De GaN-toplaag omvat een p-GaN-laag van 35 nm en een ongedoteerde GaN-laag van 10 nm. Voor een gegeven AlGaN-dikte van 45 nm neemt de 2DHG-dichtheid toe met de toename van de GaN-topdikte [22]. De dikke GaN-toplaag is van vitaal belang voor de 2DHG met hoge dichtheid, terwijl deze de laagohmige contactweerstand (voor 2DEG) tegengaat. De schematische weergaven van de voorgestelde Schottky-barrièrediode met dubbele heterojunctie (DJ SBD) worden getoond in figuur 1a. De SBD-fabricage begon met de mesa-isolatie door Cl2 /BCl3 etsen op basis van inductief gekoppeld plasma (ICP) tot een diepte van 300 nm. Vervolgens werden de ohmse geul en de Schottky-anodegeul gevormd met het ICP-etsproces met weinig schade. De diepte van de ohmse geul en de Schottky-anodegeul was respectievelijk 50 nm en 90 nm, wat werd bevestigd met behulp van atomaire krachtmicroscopie (AFM). Tetramethylammoniumhydroxide (TMAH)-oplossing bij 85 °C gedurende 15 min werd geïntroduceerd om de resten na het etsen te verwijderen en om de zijwand van de sleuf te modificeren na het beëindigen van het etsproces [23]. Vervolgens, het gloeien bij 400 °C gedurende 10 min in N2 ambient werd uitgevoerd. De ohmse kathode werd vervolgens gevormd door e-beam verdampte Ti/Al/Ni/Au (20/140/55/45 nm), gegloeid bij 870 °C gedurende 35 s in N2 omgevingstemperatuur, met een contactweerstand (R C ) van 0,49 Ω·mm. Ten slotte werden anodemetaal en de onderlinge verbindingen afgezet door Ni/Au om de fabricagestroom te voltooien. De apparaten hadden verschillende L AC van 7 tot 11 urn. Figuur 1b toont het TEM-beeld van de dwarsdoorsnede met hoge resolutie van de anode na ICP en metaalafzetting, en de laagstructuur werd duidelijk waargenomen.
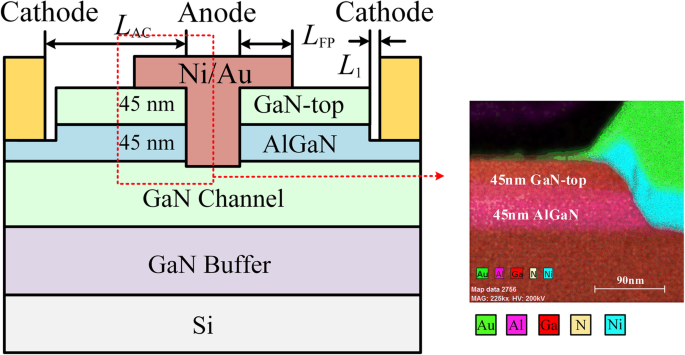
een Dwarsdoorsnede van de voorgestelde dubbele heterojunctie AlGaN/GaN SBD en het belangrijkste fabricageproces. L AC is de lengte van anode tot kathode. L FP en L 1 zijn respectievelijk 1 m en 2 m. b HR-TEM-beeld van de anode na ICP en metaalafzetting
De 2DEG wordt geïnduceerd door de positieve polarisatieladingen langs de AlGaN/GaN-interface. De bovenste GaN/AlGaN-interface heeft negatieve polarisatieladingen en genereert daarom 2DHG aan de bovenste interface [15]. De opening tussen het driftgebied en de kathode (L 1 ) wordt gebruikt om het gatstroompad te verkleinen zoals weergegeven in Fig. 2. We hebben alleen de invloed van L onderzocht 1 van 2 tot 3 m op de voorwaartse en achterwaartse blokkeringskenmerken vanwege de limiet van het oorspronkelijke lay-outontwerp. De V AAN en R AAN,SP laat geen verandering zien omdat L 1 heeft geen invloed op het Schottky-contact en het elektronenstroompad. Bovendien neemt de BV licht af met de toename van L 1 vanwege het verkorte driftgebied. Het bedieningsmechanisme van de DJ SBD's onder voorwaartse bias is bijna hetzelfde als de conventionele SBD's, wat betekent dat 2DHG het elektronenstroompad van de kathode naar de anode nauwelijks beïnvloedt. Met de toenemende sperspanning zijn de 2DEG en 2DHG volledig uitgeput. Er blijven vaste positieve en negatieve polarisatieladingen over, die de polarisatiejunctie vormen. Als resultaat wordt een vlakke E-veldverdeling tussen de kathode en anode verkregen (Fig. 3).
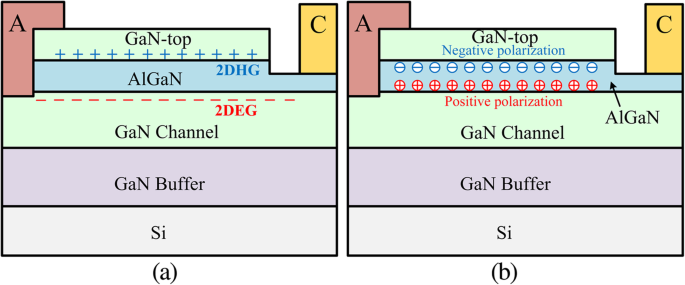
Analyse van het werkingsmechanisme van DJ SBD's a zero-bias en b omgekeerde vooringenomenheid

Elektrisch velddistributie langs de AlGaN / GaN-kanaal hetero-interface door TCAD-simulatie. De Al-fractie wordt gedefinieerd als 0,25. De netto acceptordichtheid (diep niveau) in de bufferlaag is ingesteld op 1,5 × 10 16 cm −3 en het energieniveau is 0,45 eV onder het minimum van de geleidingsband. De acceptordichtheid van de AlGaN/GaN-interface is ingesteld op 6 × 10 12 cm −3 en het energieniveau is 0,23 eV onder het minimum van de geleidingsband
Zoals getoond in figuur 3, werden de doorslagkarakteristiek en het polarisatie-junctiemechanisme bevestigd door 2-D Sentaurus TCAD van Synopsys. We hadden rekening gehouden met verschillende belangrijke fysieke fenomenen in simulatie, waaronder bandgap-vernauwing, polarisatie, elektron/gat-mobiliteit, impactionisatie en SRH-recombinatie.
Hall-effectmeting werd toegepast om de 2DHG- of 2DEG-dichtheids- en mobiliteitswaarden [22] te bepalen. De metingen zijn uitgevoerd volgens de Van der Pauw methode bij kamertemperatuur. Om 2DHG te meten volgens Ref. [17], Hall-meetmonsters werden vervaardigd met Ni/Au ohmse contacten. De dichtheid en mobiliteit van de 2DHG waren 9 × 10 12 cm −2 en 15 cm 2 /V s, respectievelijk. De 2DEG werd gemeten door de monsters met verzonken GaN-top en gedeeltelijk AlGaN vervaardigd met Ti/Al/Ni/Au ohmse contacten (voor 2DEG). De dichtheid en mobiliteit van de 2DEG waren 8,5 × 10 12 cm −2 en 970 cm 2 /V s, respectievelijk. Uit de Hall-metingen bleek dat de mobiliteit van de gaten nog steeds veel lager was dan de mobiliteit van de bulk over 100 cm 2 /Vs. De degradatie van mobiliteit werd toegeschreven aan de diffusie van Mg van het p-GaN naar het ongedoteerde GaN tijdens de MOCVD-groei.
Resultaten en discussie
De gemeten I-V voorwaartse kenmerken van de SBD's met verschillende L AC zijn uitgezet in Fig. 4a en b. De inschakelspanning (V AAN ) is 0,68 V met een kleine variatie van 0,02 V. De idealiteitsfactor en de barrièrehoogte van de SBD's worden berekend als respectievelijk 1,44 ± 0,15 en 0,76 ± 0,04 eV. Figuur 4a laat zien dat de hoge voorwaartse stroomdichtheid van 183 mA/mm en 144 mA/mm (@ voorwaartse voorspanning van 2,5 V) en de aan-weerstand van 0,642 en 1,17 mΩ cm 2 worden behaald bij L AC =respectievelijk 7 en 11 m. Daarnaast een uitstekende aan/uit stroomverhouding ∼ 10 10 wordt verkregen zoals getoond in figuur 4b. De helling onder de drempel (SS) is 63,0 mV/dec, wat dicht bij de ideale SS ligt (59,6 mV/dec).
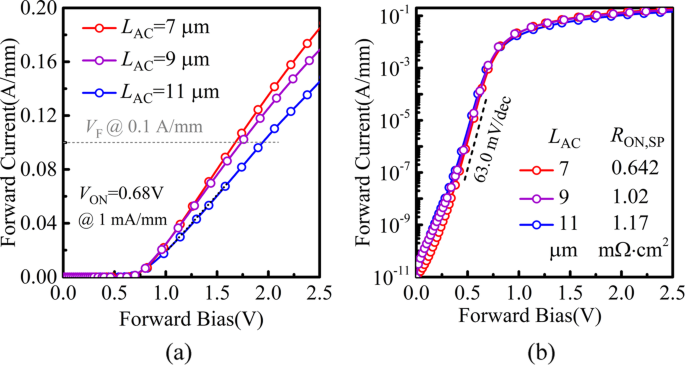
Gemeten voorwaartse bias I-V kenmerken van DJ SBD's in a lineair en b semi-log schaal met verschillende L AC
Figuur 5a toont de gemeten omgekeerde blokkering I-V kenmerken van de SBD's met verschillende L AC bij 300 K. De doorslagspanning van de apparaten met verschillende L AC is respectievelijk 803 V, 940 V en 1109 V bij een lekstroom van 1 mA/mm. De dichtheden van 2DEG en 2DHG worden verondersteld hetzelfde te zijn tijdens de simulatie. De experimentele resultaten laten echter zien dat de dichtheden van 2DHG (9 × 10 12 cm −2 ) zijn iets hoger dan die van 2DEG (8.5 × 10 12 cm −2 ). Het verschil tussen de vaste positieve en negatieve polarisatieladingen tijdens de uit-toestand beïnvloedt de ladingsbalans en verslechtert dus de doorslagspanning. De invloed van de L AC op de BV en de R AAN,SP wordt getoond in Fig. 5b. Een bijna lineaire relatie tussen BV en L AC wordt verkregen, wat het relatieve vlakke laterale E-veld in het driftgebied impliceert. Door het polarisatie-junctie-effect vertoont het apparaat een hoge Baliga's figure-of-merit (FOM =BV 2 /R AAN,SP ) van 1051 MW/cm 2 (@ L AC =11 μm).
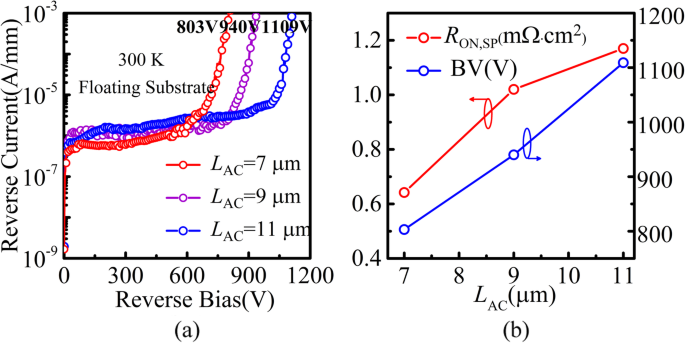
een Gemeten omgekeerde blokkering I-V kenmerken van DJ SBD's met verschillende L AC (b ) R AAN,SP en BV als de functies van L AC
Het etsproces is essentieel voor de hoogwaardige Schottky-interface en het ohmse contact. Figuur 6a toont de oppervlaktemorfologie van de verzonken sleuf na het ICP-etsen (@ 5 °C) en de TMAH-oplossing. De etssnelheid is ongeveer 4,9 nm/min en het uiteindelijke geselecteerde recept is met een Cl2 van 4 sccm, een ICP-vermogen van 50 W en een RF-vermogen van 15 W. De RMS-ruwheid is 0,244 nm met een scangebied van 2 × 2 μm 2 .
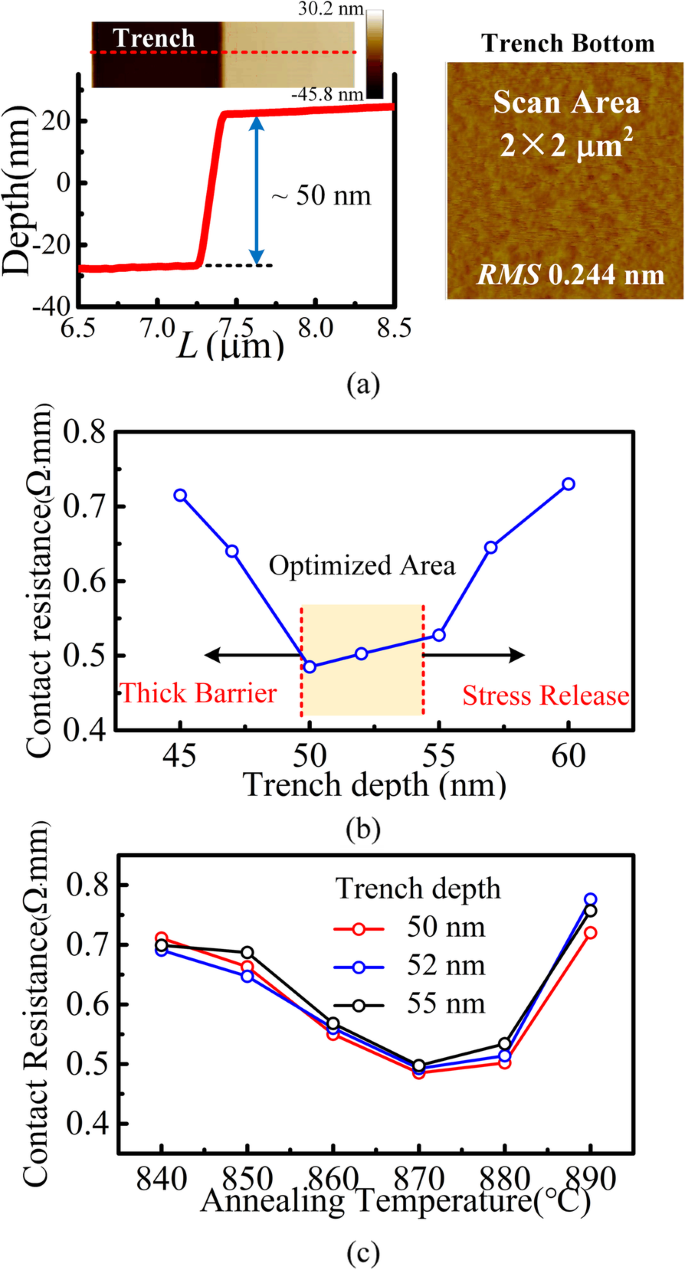
een AFM-morfologie van de greppel na ICP-etsen. b Invloed van etsdiepte op ohmse contactweerstand door TLM-test. c Contactweerstand als functie van de gloeitemperatuur met de sleufdiepte van 50 tot 55 nm. De gloeitijd was 35 s
Omdat de op maat gemaakte epitaxiale laag een 45 nm GaN-toplaag en een 45 nm AlGaN-laag omvat, is het ohmse contactproces (voor 2DEG) anders dan de conventionele SBD's. Zonder zowel GaN-top- als AlGaN-barrièrelagen te verzonken, is een lage contactweerstand moeilijk te bereiken door te gloeien vanwege de potentiaalbarrière tussen het ohmse metaal en de 2DEG. Als de barrière echter te ver is verzonken, leidt de spanningsafgifte tot een verlaging van de 2DEG-concentratie. De extra processen worden toegepast om de ohmse contactweerstand te verminderen. De oppervlakken van de monsters worden behandeld met de HCl-oplossing om de oorspronkelijke oxidelaag te verwijderen vóór afzetting. Bovendien wordt de plasma-oppervlaktebehandeling toegepast (ICP-vermogen 50 W BCl3 10 sccm 3 min) om oppervlaktedonortoestanden te introduceren [24]. Figuur 6b toont de afhankelijkheid van de contactweerstand van de sleufdiepte. De geoptimaliseerde diepte wordt verkregen van 50 tot 55 nm. De snelle thermische uitgloeiing (RTA) bij hoge temperatuur voor het Ti / Al / Ni / Au-contact wordt onderzocht in figuur 6c. De gloeitemperatuur is van 840 tot 890 °C, en de 870 °C resulteert in de laagste contactweerstand. Gloeien bij hoge temperatuur, d.w.z. 870 °C, is bevorderlijk voor de vorming van TiN op het Ti/nitride-grensvlak. Een hogere temperatuur (bijv. 890 °C) verhoogt echter de interdiffusie van Au en Al, wat nadelig is voor de vorming van goede ohmse contacten.
Figuur 7a–c tonen de statistische plots van de statische kenmerken, waaronder V AAN , V F , en BV. De gegevens worden geëxtraheerd uit 72 SBD's met L AC van 7, 9 en 11 μm vervaardigd in 3 afzonderlijke procesruns. De apparaten vertonen stabiele voorwaartse inschakelkarakteristieken en de V AAN is onafhankelijk met L AC , omdat V AAN wordt voornamelijk bepaald door het Schottky-contact. Het schadearme ICP-etsproces, de nauwkeurig gecontroleerde sleufdiepte en de hoogwaardige Schottky-interface dragen bij aan de uitstekende uniformiteit van de V AAN en V F . Bovendien, met de toename van L AC (van 7 tot 11 m), is er een monotone toename (∼ 100 V/μm) in de BV waargenomen in voorgestelde structuren. Afbeelding 7d toont de histogramstatistieken van de V AAN voor 72 apparaten, en de gemiddelde waarde is 0,68 V met een kleine standaardafleiding van 0,02 V.

Statistische plots van a inschakelspanning, b doorlaatspanning en c doorslagspanning geëxtraheerd uit 72 SBD's met L AC van 7, 9 en 11 m vervaardigd in 3 afzonderlijke procesruns. d Distributie van V AAN voor 72 apparaten
De temperatuurafhankelijkheid van de achterwaartse en voorwaartse kenmerken wordt beoordeeld in Fig. 8. Zoals getoond in Fig. 8a, resulteert een verhoging van de omgevingstemperatuur van 300 tot 475 K in een verhoging van de R AAN,SP met een factor 1,94.
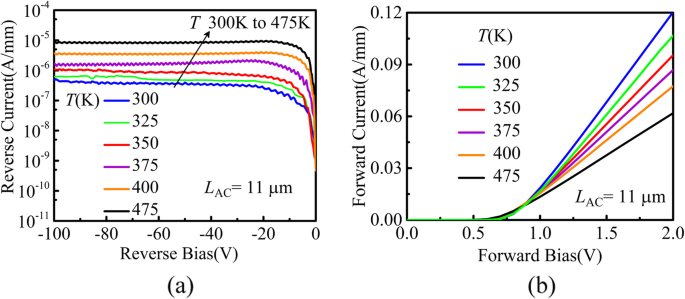
een Omgekeerde lekstroom en b voorwaartse kenmerken voor de DJ SBD's bij verschillende temperaturen
De dynamische kenmerken van de DJ SBD's worden gemeten door Agilent B1505A power device analyzer. De rustpunten van de anodepuls zijn ingesteld op -10 V, − 20 V, − 30 V, − 40 V, − 70 V en − 100 V, met een anodepulsbreedte en -periode van 0,5 ms/500 ms. Afbeelding 9b toont de dynamische R AAN,SP als functie van de spanningsspanning. De dynamische R AAN,SP zelfs bij 100 V is de reservespanning slechts 1,18 keer die zonder omgekeerde spanning, wat vergelijkbaar is met Ref. [8]. De beperkte toename van de dynamische R AAN,SP draagt bij aan de vermindering van de interfacestatus. De degradatie van dynamische R AAN,SP heeft verder werk nodig.
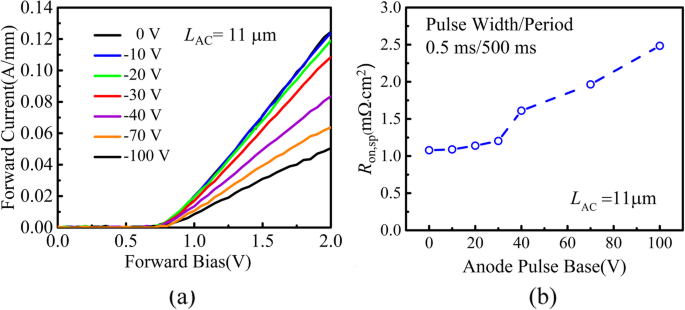
een I-V kenmerken onder pulsmeting. b Geëxtraheerd R AAN,SP versus anodepulsbasis met pulsbreedte/periode =0,5 ms/500 ms
Afbeelding 10 geeft de benchmarkgrafiek weer van BV versus R AAN,SP voor GaN-vermogensdiode op Si/SiC/saffiersubstraten [8, 10, 22, 25,26,27,28,29,30,31]. Het voorgestelde apparaat met L AC van 11 m toont een BV van 1109 V met een overeenkomstige R AAN,SP van 1,17 mΩ cm 2 , wat leidt tot een hoge Baliga's FOM van 1051 MW/cm 2 . Deze waarde is het beste resultaat van de laterale GaN-vermogensdiode op Si-substraat.
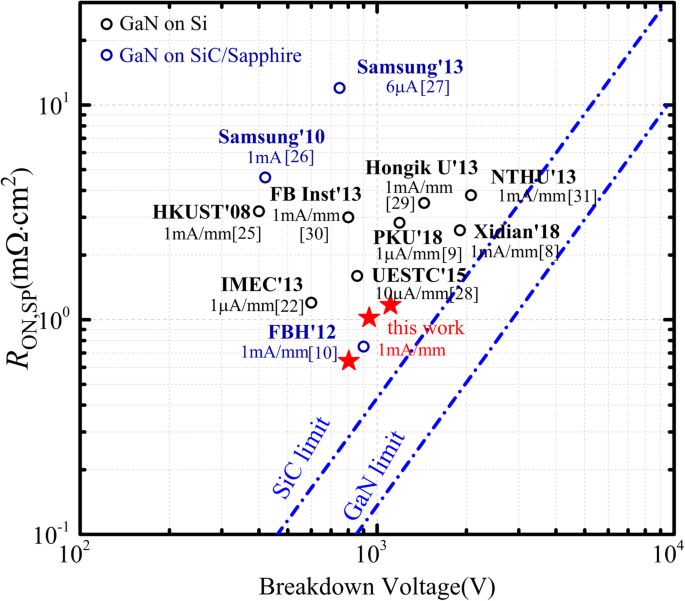
Benchmarkplot van BV versus R AAN,SP van GaN-vermogensdiode op SiC/saffier/Si-substraten. De omgekeerde lekkage die wordt gebruikt om de storing te definiëren, wordt ook gegeven
Conclusie
Een dubbele heterojunctie GaN/AlGaN/GaN-op-Si SBD met een hoog cijfer van verdienste wordt gefabriceerd. Het ICP-etsproces met weinig schade resulteert in de geoptimaliseerde ohmse en Schottky-contacten voor het voorgestelde apparaat. Daarom een lage V AAN van 0,68 V met goede uniformiteit en een lage R AAN,SP van 1,17 mΩ cm 2 worden verkregen in het apparaat met L AC van 11 urn. Een hoge Baliga's FOM van 1051 MW/cm 2 wordt bereikt door het polarisatie-junctie-effect. De hoge prestaties samen met de goedkope GaN-on-Si-technologie bieden een groot potentieel voor toekomstige stroomtoepassingen.
Beschikbaarheid van gegevens en materialen
Alle gegevens die tijdens dit onderzoek zijn gegenereerd of geanalyseerd, zijn opgenomen in dit artikel.
Afkortingen
- SBD:
-
Schottky-barrièrediode
- 2DEG/2DHG:
-
Tweedimensionaal elektron/gatgas
- MOCVD:
-
Metaal-organische chemische dampafzetting
- ICP:
-
Inductief gekoppeld plasma
- TEM:
-
Transmissie-elektronenmicroscoop
- AFM:
-
Atoomkrachtmicroscoop
- BV:
-
Doorslagspanning
- R AAN,SP :
-
Specifieke aan-weerstand
- V AAN :
-
Inschakelspanning
- FOM:
-
Cijfer van verdienste
Nanomaterialen
- Impact van oppervlaktetoestanden en aluminiummolfractie op oppervlaktepotentiaal en 2DEG in AlGaN/GaN HEMT's
- Experimenteel onderzoek naar stabiliteit en natuurlijke convectie van TiO2-water nanovloeistof in behuizingen met verschillende rotatiehoeken
- Onderzoek naar oppervlaktepolarisatie van Al2O3-capped GaN/AlGaN/GaN heterostructuur door middel van hoek-opgeloste röntgenfoto-elektronspectroscopie
- RGO en driedimensionale grafeennetwerken hebben TIM's samen gemodificeerd met hoge prestaties
- Experimenteel onderzoek naar de stromings- en warmteoverdrachtskenmerken van TiO2-water-nanovloeistoffen in een spiraalvormig gecanneleerde buis
- Grafeen/polyaniline-aerogel met superelasticiteit en hoge capaciteit als zeer compressietolerante supercondensatorelektrode
- Experimentele studie van 5-fluorouracil ingekapselde ethosomen gecombineerd met CO2 fractionele laser om hypertrofisch litteken te behandelen
- Een overzicht van de Ultrawide Bandgap Ga2O3-halfgeleider-gebaseerde Schottky-barrièrediode voor toepassingen in vermogenselektronica
- Experimentele en theoretische studies van Mo/Au Schottky Contact op mechanisch geëxfolieerde β-Ga2O3 dunne film
- Herstelprestaties van met gedoteerde verticale GaN Schottky-barrièrediodes
- Voordelen en nadelen van hoge en lage spiraalhoeken



