Verkleinde c-Si en c-SiGe Wagon-Wheels voor de visualisatie van de anisotropie en selectiviteit van natchemische etsen
Abstract
Nat etsen biedt een voordeel als een zachte, schadeloze methode om opofferingsmateriaal te verwijderen met een precisie van bijna nanometer, wat cruciaal is geworden voor de fabricage van structuren op nanoschaal. Om dergelijke natte etsoplossingen te ontwikkelen, is screening van etseigenschappen zoals selectiviteit en (an)isotropie essentieel geworden. Aangezien deze etsmiddelen doorgaans lage etssnelheden hebben, zijn gevoelige teststructuren vereist om hun etsgedrag te evalueren. Daarom werden verkleinde monokristallijne Si (c-Si) en SiGe (c-SiGe) wagenwielen gefabriceerd. Ten eerste de gevoeligheid van de c-Si wagenwielen voor het detecteren van anisotroop gedrag van kristallijn silicium in de alkalische etsmiddelen TMAH en NH4 OH werd aangetoond. Onderscheidende wagenwielpatronen, kenmerkend voor elk materiaal / etsmiddelpaar, werden waargenomen door top-down scanning elektronenmicroscopie (SEM) na anisotroop nat etsen. Vergelijkbare trends in kristallografische vlakafhankelijke etssnelheden werden verkregen voor zowel Si(100)- als Si(110)-substraten. Ten tweede, het etsen van zowel c-Si als c-Si75 Ge25 wagenwielen in een typisch selectief etsmiddel, perazijnzuur (PAA), werd geëvalueerd. c-Si75 Ge25 etsen in PAA resulteerde in isotroop etsen. Selectiviteitswaarden werden berekend op basis van twee methoden:de eerste door meting van het zijwandverlies van de spaken van het wagenwiel, de tweede, indirecte methode, door meting van de spaakterugtreklengtes. Beide methoden geven vergelijkbare waarden, maar de laatste methode kan pas worden gebruikt na een bepaalde kritische etstijd, waarna de spaakpunten zijn geëvolueerd naar een scherpe punt.
Inleiding
Traditioneel werd de geleidelijke toename van de dichtheid van transistors op de halfgeleiderapparaten met geïntegreerde schakelingen bereikt door de knooppuntgrootte te verkleinen. Dit is technologisch en economisch niet meer houdbaar. Daarom worden nieuwe veldeffecttransistors (FET)-architecturen zoals Fin-FET en gate-all-round GAA-FET geïntroduceerd [1,2,3]. De laatste biedt een voordeel ten opzichte van de eerste omdat de poort het kanaal nauwkeuriger kan afstemmen [4]. Sommige processen die worden gebruikt voor de fabricage van deze complexe 3D-functies die worden gebruikt in de meeste geavanceerde FET-transistors en geheugencellen, vereisen extreem selectieve en isotrope etsmiddelen [5, 6].
Voor de fabricage van GAA-architecturen die een of meer verticaal gestapelde horizontale kristallijne nanodraden omvatten, is een zeer selectieve en isotrope etsing van de opofferingskristallijne epitaxiale lagen nodig. Voor het vrijgeven van Si-nanodraden bijvoorbeeld, een Six Ge1-x etsmiddel dat de Si-nanodraden intact laat, is vereist.
Daarom is screening en begrip van etseigenschappen van vitaal belang geworden. Screening van etsmiddelen op dekenfilms geeft geen betrouwbare informatie over de (an)isotropie van het materiaal/etsmiddelpaar. Het visualiseren van anisotropie is uiterst belangrijk omdat het etsen van kristallijne opofferingslagen kan worden vertraagd of zelfs gestopt door de vorming van langzaam etsende of zogenaamde 'blokkerende' vlakken in de laterale greppels. Anisotropie is ook uitgebreid bestudeerd voor de fabricage van micro-elektromechanische structuren (MEMS) [7, 8] en voor de oppervlaktetexturisering van Si in zonnetoepassingen [9,10,11].
Er zijn in principe twee experimentele methoden gebruikt, die beide etssnelheden opleveren als een functie van de kristallografische richtingen van Si. In de eerste wordt een bol of halve bol van silicium met een diameter van enkele millimeters geëtst; anisotropie leidt tot facetvorming die, eenmaal gekwantificeerd, de etssnelheden van de verschillende kristalvlakken oplevert [12,13,14]. Bij de tweede en meest wijdverbreide methode worden siliciumspaken of sleuven op een radiale manier op een wafel aangebracht, waardoor de zogenaamde wagenwielvorm ontstaat [15, 16]. De kracht van de laatste methode ligt in het feit dat veel kristallografische vlakken kunnen worden onderzocht in een enkel nat etsexperiment en in het amplificatie-effect ervan. Tijdens anisotroop nat etsen zal de punt van de spaken zich terugtrekken met een snelheid die evenredig is met de etssnelheid van de zijwand van de wagenwielspaak, waarbij de laatste de van belang zijnde etssnelheid is. Door de geometrie van de spaak is de terugtreksnelheid van de spaakpunt aanzienlijk hoger dan de werkelijke etssnelheid van de zijwanden. Deze relatief grote intreklengte is dus gemakkelijker te visualiseren en te kwantificeren dan de kleine zijwandverdunning van de spaken. De versterkingsfactor hangt af van de geometrische opstelling van de spaken in een wagenwiel. Wagenwielen met meer spaken, en dus kleinere hoeken, hebben grotere versterkingsfactoren. De wagenwielen die in de literatuur [15,16,17,18] worden beschreven, hebben een diameter van cm en zijn typisch geschikt voor 180 spaken met een hoekbreedte en afstand van 1°, wat resulteert in versterkingsfactoren van 115. Voor de meeste toepassingen zijn hoge etssnelheden gewenst; daarom hebben de meeste auteurs het anisotroop etsen van silicium bestudeerd in relatief hete (~-60-80 °C) en relatief geconcentreerde (~-12-25 gew.%) alkalische TMAH- en KOH-oplossingen. Er is echter weinig bekend over anisotroop etsen in alkalische oplossingen met een lage concentratie en nog minder bij lage temperatuur. Bovendien is meestal alleen nanometer-verwijdering van halfgeleidermateriaal vereist tijdens het fabricageproces van structuren op nanoschaal in de meeste geavanceerde complementaire metaaloxidehalfgeleidertoepassingen (CMOS). Daarom zijn veel lagere natte etssnelheden, in het bereik van enkele nanometers/min, vereist voor de meeste natte etsprocessen die worden gebruikt bij zeer grootschalige integratie (VLSI). Daarom stellen we de miniaturisering van de vorige generatie wagenwielen voor.
In dit werk werden niet alleen verkleinde c-Si maar ook c-SiGe wagenwielen gefabriceerd. Als zodanig kunnen zowel de isotrope als de selectiviteitsvereisten van etsmiddelen gelijktijdig worden geëvalueerd met een hoge mate van nauwkeurigheid. Aangezien de belangrijkste troef van de wagenwieltechniek nog steeds de bepaling van de anisotropiegraad van materiaal/etsmiddelparen is, zullen we onze resultaten eerst benchmarken met die verkregen op cm-formaat wagenwielen in eerdere studies. Vervolgens zullen we het nut van deze techniek illustreren voor de ontwikkeling van selectieve en isotrope etsmiddelen, specifiek voor het selectief etsen van c-Si75 Ge25 met betrekking tot c-Si.
Experimenteel/methoden
Wagon-Wheel Design
De afmetingen van de wagenwielen zijn gekozen met het idee om nanometer . te observeren -range zijwandverlies resulterend in sub -micron intrek lengtes. De afmetingen van de wagenwielen zijn gebaseerd op een evenwicht tussen de volgende drie grenzen:
- 1.
De fotolithografische techniek stelt een beperking in op de minimale kritische dimensie (CD), de wagenwiel (binnenste) spaakbreedte.
- 2.
De beeldvormingstechniek die een maximaal praktisch gezichtsveld (FoV) definieert, en dus een maximale wagenwieldiameter.
- 3.
Het maximale aantal spaken dat kan worden gerangschikt in het cirkelvormige wagenwielpatroon, of dienovereenkomstig, de minimale spaakwighoek, die de maximale versterkingsfactor definieert.
Daarom werd de binnenspaakbreedte ingesteld op 90 nm (CD), de wagenwieldiameter op 3,8 m (FoV) en 32 spaken werden in een cirkelvormig patroon gerangschikt. Dit wagenwielontwerp resulteert in spaakhoeken van 5,6° en een versterkingsfactor van ongeveer 20. Hiervoor is een speciaal masker ontworpen (Fig. 1a). De afmetingen worden vergeleken met die van eerder vervaardigde wagenwielen door Wind et al. (zie tabel 1). De wagenwielen zijn in verticale en horizontale richting uitgelijnd met een steek van 3,9 m, waardoor er een ruimte van 100 nm overblijft tussen twee wagenwielen (Fig. 1b). De fabricage van deze wagenwielen zal in de volgende sectie worden beschreven.
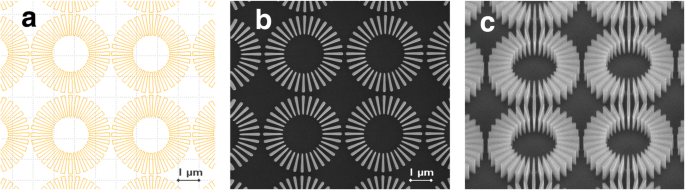
Wagenwielen zoals ontworpen op masker (a ) en na het nanofabricageproces:bovenaanzicht SEM (b ), gekantelde weergave SEM (c )
Wagon-Wheel Fabrication
Wafelwielen van kristallijn silicium (c-Si) werden vervaardigd op standaard p-type (B-gedoteerd, 1-100 Ohm cm) 300 mm Si (100) en Si (110) wafels. Het patroonvormingsproces bestond uit de afzetting van een hardmaskerstapel bestaande uit (van boven naar beneden) 30 nm siliciumnitride, 160 nm amorfe koolstof (APF), 20 nm siliciumnitride en 30 nm amorf Si. Een 193-nm immersielithografie werd gebruikt om het patroon in de fotoresist over te brengen. Nadat de fotoresist was ontwikkeld, werd het wagenwielpatroon geëtst met behulp van een plasma-ets met een fotoresist en APF-strip. De onderste laag van de hardmaskerstapel, zijnde de SiN-laag, werd verwijderd met heet fosforzuur (6 min. 85 gew.% H3 PO4 bij 160 °C) of fluorwaterstofzuur (5 min 10 gew.% HF). Figuur 1c toont een gekanteld SEM-aanzicht van de gefabriceerde wagenwielen.
Kristallijn silicium-germanium wagenwielen (c-Si75 Ge25 ) werden ook vervaardigd op standaard p-type (B-gedoteerde, 1-100 Ohm cm) 300 mm Si (100) of Si (110) wafels. Vóór het patroon werd een laag van ongeveer 600 nm ongedoteerd Si75 Ge25 epitaxiaal afgezet. Hierna werden dezelfde patroonvormingsstappen gevolgd als voor de Si-wagenwielen, resulterend in c-Si75 Ge25 wagenwielspaken.
(An)Isotrope natte etsexperimenten
Voorafgaand aan de (an)isotrope natte etstests, een SPM-reiniging (5 min H2 SO4 :H2 O2 3:1 bij 60°C), gericht op de verwijdering van organische resten, werd uitgevoerd en daarna werd de oxidelaag verwijderd tijdens een onderdompeling van 2 minuten in een waterige 1 gew.% HF-oplossing. Onmiddellijk na de SPM- en HF-reinigingsprocessen wordt de anisotropie van het etsmiddel bepaald door het testpatroon bij kamertemperatuur (RT) in een niet-geroerd monster van het etsmiddel te plaatsen. TMAH en NH4 OH-etsoplossingen werden bereid door verdunning van 25 gew.% TMAH of 29 gew.% NH4 OH. De perazijnzuur (PAA)-oplossingen werden bereid door 9,5 delen H2 . te mengen O2 (30 gew.%), 11 delen azijnzuur (98 gew.%) en 0,1 delen HF (49 gew.%). Van deze etsoplossing is bekend dat deze selectief Six . etst Ge1-x legeringen over zuiver Si [19, 20]. PAA, dat fungeert als de oxiderende stof voor SiGe-etsen, wordt gevormd door reactie van het azijnzuur met het peroxide met HF als katalysator. Er is echter een bepaalde tijd nodig om evenwicht te bereiken; daarom werden de oplossingen 1 week gerijpt. De anisotropie en selectiviteit van het etsmiddel werd bepaald door de testpatronen bij kamertemperatuur in een niet-geroerd monster van het etsmiddel te plaatsen. Direct na het etsen werden de monsters 30 s in gedeïoniseerd water gespoeld en vervolgens met stikstofgas gedroogd.
Resultaten en discussie
Anisotrope etsing van c-Si(100) en c-Si(110) wagenwielen in TMAH
Wanneer siliciumwagenwielen vervaardigd op een Si(100)-wafel worden geëtst in lage concentratie TMAH (5 gew.%) bij kamertemperatuur, kunnen de volgende waarnemingen worden gedaan (Fig. 2):ten eerste de karakteristieke viervoudige symmetrie van een Si (100) wafel wordt onthuld door het anisotrope etsen van het wagenwiel. Ten tweede kan de oriëntatie-afhankelijke etssnelheid van verschillende kristallografische vlakken visueel worden afgeleid:de relatief snelle etsspaken van de wagenwielen worden gedefinieerd door {110} en vicinale {110} zijwandvlakken, terwijl de langzamere etsspaken worden gedefinieerd door de {100} en vicinale {100} zijwandvlakken. Naast deze hoofdwaarneming dat de volgorde van de etssnelheid van Si in lage concentratie en RT TMAH volgt R (110)> R (100) , konden andere anisotrope effecten worden waargenomen:bijvoorbeeld de vier spaken die overeenkomen met de vier {110}-vlakken zijn niet de snelst etsende spaken, dat zijn, om precies te zijn, telkens de twee naastgelegen spaken van deze {110}-vlakken. Dienovereenkomstig wordt de etssnelheid rond {110} gesplitst in twee equivalente maxima, en de {110}-vlakken zijn lokale minima. Dit komt overeen met soortgelijke waarnemingen van [21,22,23] waarbij de lagere etssnelheid van de {110}-vlakken wordt toegeschreven aan een blokkerend effect door de TMA + ionen.

een TD SEM van een Si(100) wagenwiel geëtst in lage concentratie TMAH (5 gew.%) bij RT en ingezoomd (b ) laat de ontwikkeling zien van de sneller etsende {110} vlakken/facetten, zoals aangegeven door de stippellijnen
Een ander resultaat van het anisotrope etsen is de bijzondere vorm van de buitenste spaakuiteinden van de vier {100} spaken. Het is bekend dat de snelste etsvlakken zullen worden onthuld voor convexe oppervlakken. Aanvankelijk zijn de spaakuiteinden convexe oppervlakken, bijgevolg worden na een bepaalde etstijd de snellere ets {110}-vlakken onthuld, die facetten vormen aan de buitenste spaakuiteinden. Dit is het duidelijkst voor de spaken langs de <100> richtingen (inzoomen b van Fig. 2).
Voor een concave oppervlak, maar de langzaamste etsvlakken worden onthuld. Tijdens het etsen van de wagenwielspaken wordt ook het Si(100)-substraat rondom de spaken geëtst. Deze basis-substraat overgang is een concaaf oppervlak; daarom moeten de langzaamste etsvlakken, namelijk de {111} vlakken, worden onthuld. Deze {111} vlakken lijken uitgelijnd met de <110> richtingen voor Si(100) substraten. In Fig. 3b is zelfs te zien dat de {111}-vlakken werden onthuld na etsen in TMAH, waardoor een basis werd gevormd met schuine {111}-vlakken voor alle spaken in de <110> richtingen.
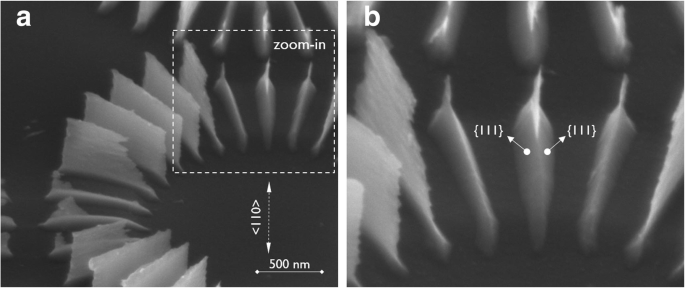
een Gekanteld SEM-beeld van een Si(100) wagenwiel geëtst in lage concentratie TMAH (5 gew.%) bij RT en ingezoomd (b ) met de schuine {111} vlakken
Net als de Si(100) wagenwielen, werden Si(110) wagenwielen geëtst in lage concentratie TMAH (5 gew.%) bij kamertemperatuur. In plaats van de viervoudige symmetrie van een Si(100)-wafer, wordt de tweevoudige symmetrie van de Si(110) onthuld. De kristallografische oriëntaties van enkele van de {100}, {110}, {111} en {211} vlakken zijn toegewezen in figuur 4a. Een van de voordelen van het gebruik van Si(110)-substraten voor de evaluatie van anisotropie is de aanwezigheid van verticale {111}-vlakken, die worden weergegeven door de zijwanden van de {111}-spaken van de wagenwielen. Zoals te zien is in figuur 4, zijn dit de langzaamste etsvlakken. De snelste etsvlakken lijken de {110} en de {211} vlakken te zijn. Tussenliggende etssnelheden worden gevonden voor de {100} vlakken. Vandaar, R (110) ~ R (211)> R (100)> R (111) , in lijn met de resultaten verkregen op Si(100).
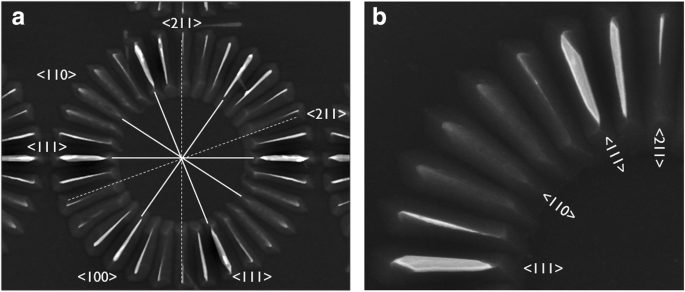
een TD-SEM van een Si(110) wagenwiel geëtst in lage concentratie TMAH (5 gew.%) bij RT en ingezoomd (b ) met de facetformatie op de <111> georiënteerde spaken. De belangrijkste kristallografische richtingen (of equivalente vlakken) worden weergegeven door ononderbroken lijnen, de hogere indexvlakken door stippellijnen
In figuur 4b is te zien dat de uiteinden van de langzaamst etsende {111}-spaken evolueren van een ronde vorm naar een pijlachtige vorm, waardoor een asymmetrisch parallellogram wordt gevormd. De onderliggende oorzaak voor de vorming van deze facetten is het sneller etsen van de {110} en de {211} vlakken.
TMAH- en TMAH/IPA-mengsels zijn goed bestudeerde en veelgebruikte etsmiddelen voor de fabricage van MEMS-structuren waarvoor hoge etssnelheden en afstemming van anisotropie vereist zijn. Dienovereenkomstig is het meeste onderzoek naar Si-etsen in TMAH gedaan bij hogere temperaturen en concentraties. Typische concentraties variëren van 10 tot 25 gew.% TMAH en bij temperaturen van 60 tot 90 °C [12,13,14, 23]. Een paar onderzoeksgroepen voerden etsproeven uit bij lage concentraties rond de 5 gew.%, zoals in ons werk, maar ze gebruikten nog steeds hoge temperaturen 60-90 °C [24,25,26]. De R (110) /R (100) verhouding ligt meestal rond de 2 voor hoge concentraties en hoge temperaturen en lijkt toe te nemen met afname TMAH temperatuur (Aanvullend bestand 1:S1). Aangezien deze studie zich richt op etstoepassingen op nanoschaal, worden geen hoge etssnelheden nagestreefd. Daarom werden lage (RT) temperaturen gekozen om een acceptabel tijdvenster te hebben voor het observeren van etsverschijnselen en om het volledig oplossen van structuren te voorkomen. Dezelfde volgorde van snelheden, R (110)> R (100) , wordt waargenomen in deze studie, uitgevoerd bij RT en 5 gew.% TMAH, maar de berekende waarden van de R (110) /R (100) verhouding liggen ruim boven de 2 (zie ook referentie [27]). Dit bevestigt dus de trend dat deze anisotrope verhouding toeneemt met afnemende TMAH-temperatuur. Een gedetailleerde mechanistische verklaring van deze waarneming, inclusief kinetische en atomistische aspecten, valt buiten het bestek van dit werk. Op basis van bovenstaande vergelijkingen voor het etsen van silicium in TMAH kan echter worden geconcludeerd dat de verkleinde wagenwielen de vereiste gevoeligheid bieden om het anisotrope gedrag van etsmiddelen te detecteren en te vergelijken.
Anisotrope etsing van c-Si(100) en c-Si(110) wagenwielen in NH4 OH
Zowel Si(100) wagenwielen als Si(110) wagenwielen werden geëtst in lage concentratie (0,4 gew.%) ammoniumhydroxide (NH4 OH) bij RT. In de eerste (Fig. 5, links) wordt de viervoudige symmetrie van een Si(100)-wafel onthuld. Het is duidelijk dat de spaken in de richtingen <210> en <310>, die theoretisch 18,4° en 26,6° zijn ten opzichte van de richtingen <110>, het best worden weergegeven door de derde spaak (gerekend vanaf de bovenste 'noordelijke' spaak) ) met zijwanden op 19,7° en 25,3°, zijn de snelst etsende spaken. De spaken {110} etsen langzamer dan de spaken {100} en aan de uiteinden van deze spaken ontwikkelen zich facetten. Deze facetten zijn waarschijnlijk de snel etsende {210} en {310} vlakken en kunnen bijdragen aan een algehele snellere schijnbare etssnelheid van de {110} spaken, vooral bij langere etstijden. Dus de waargenomen etssnelheid volgt R (310) ~ R (210)> R (100) ~ R (110) .

TD SEM afbeelding van een Si(100) (links) en een Si(110) wagenwiel (rechts) geëtst in lage concentratie NH4OH (0,4 gew.%) bij kamertemperatuur. Specifieke kristallografische richtingen worden weergegeven door [ ], een familie van equivalente richtingen door <>. De belangrijkste kristallografische richtingen (of equivalente vlakken) worden weergegeven door ononderbroken lijnen, de hogere indexvlakken door stippellijnen
Voor de Si(110) wagenwielen (Fig. 5, rechts), wordt de tweevoudige symmetrie rond het (100) en (110) vlak onthuld door anisotroop etsen in NH4 OH. De spaken langs de <111> richtingen, met {111} zijwanden, verschijnen als de langzaamst etsende spaken of vlakken. De snelste etsspaken worden gedefinieerd door de hoge index {211} en {311} vlakken. De {110} en {100} hebben tussenliggende etssnelheden. De Si(110)-resultaten komen dus overeen met de Si(100)-resultaten in NH4 OH. Ook bij de Si(110) wagenwielen is facettering van de spaken merkbaar, vooral aan de uiteinden van de {111} en {100} spaken. De facetten zijn waarschijnlijk de ontwikkeling van de sneller etsende {211} en {311} vlakken.
In de literatuur is beperkte informatie beschikbaar over de anisotropie van de etssnelheid van NH4 OH. Waterige oplossingen van NH4 OH zijn ook gebruikt als anisotrope etsmiddelen [28], met vergelijkbare eigenschappen als andere OH - die Si-etsmiddelen bevatten. Het voordeel is dat het geen metalen bevat (zoals K + , Na + , Cs + , ...). Daarom NH4 OH is een IC-compatibel etsmiddel dat het onderzoeken waard is. Schnakenberg et al. toonde aan dat de R (111) /R (100) etssnelheidsverhouding voor een etspatroon van het type wagenwiel geëtst in 3,7 gew.% NH4 OH bij 75 °C is ongeveer 0,04 en de R (110) /R (100) etssnelheidsverhouding 0,3 [28]. Het latere resultaat komt goed overeen met onze geschatte etssnelheidsverhouding van 0,5 voor R (110) /R (100) .
Uit onze resultaten blijkt duidelijk dat het etsen van Si in NH4 OH geeft ongelijke wagon-wheel etspatronen in vergelijking met TMAH. Hoewel er een klein verschil is in de [OH − ] voor beide etsoplossingen (~ 0.12 M vs. ~ 0.55 M), zowel het etsen in TMAH als in NH4 OH werden uitgevoerd bij dezelfde temperatuur (RT). Het enige overgebleven verschil is het tegenkation:het grotere (CH3 )4 N + vergeleken met de kleinere NH4 + kation. Er is op gewezen dat kationen in de etsoplossing aan het oppervlak kunnen hechten, waardoor verschillende Si-oppervlakten met eindstandige hydroxylgroepen die bij de verschillende etsvlakken horen, selectief worden geblokkeerd [29, 30]. Wanneer de etssnelheden van verschillende vlakken verschillend worden beïnvloed, zal de anisotropie veranderen.
Selectief etsen van Si75 Ge25 Naar Si
In deze sectie zullen we het potentieel van de verkleinde wagenwielen voor de evaluatie van de etssnelheid en selectiviteit van etsmiddelen demonstreren en bespreken. De Si/Si75 Ge25 paar werd geselecteerd als een modelsysteem omdat het representatief is voor de vorming van GAA-structuren waarbij het offer c-Si75 Ge25 tussenlagen moeten isotroop en selectief worden geëtst in de richting van de c-Si-nanodraden. Het etsen wordt uitgevoerd in een selectief etsmiddel bereid door een mengsel van HF, H2 O2 , en CH3 COH. Het is bekend dat dit mengsel perazijnzuur (CH3 CO3 H) vanwege de door zuur gekatalyseerde reactie tussen het peroxide en het azijnzuur [31, 32]. Na een bepaalde verouderingstijd worden de evenwichtsconcentraties bereikt. Het zo gevormde PAA is een effectieve en selectieve oxidator van Si75 Ge25 . Na de selectieve oxidatie van SiGe zullen de SiGe-oxiden worden opgelost door HF in een tweede, diffusiebeperkte reactie.
c-Si75 Ge25 wagenwielmonsters werden gedurende toenemende tijden in de PAA-oplossing gedompeld (t 0 + 30 s, + 60 s, ...+ 180 s) en het etsen van de wagenwielspaken werd gevolgd door daaropvolgende top-down SEM-metingen. De breedte van de spaken kan betrouwbaar worden gemeten met onze conventionele SEM als ze niet kleiner zijn dan 10 nm. De resultaten worden getoond in de tijdreeks in Fig. 6. Aanvankelijk worden de wagenwielspaken dunner door het etsen van hun zijwanden. Alle Si75 Ge25 spaken worden gelijkmatig verdund, wat aantoont dat de ets isotroop is. Na ongeveer 90 s beginnen de spaakpunten terug te trekken, wat suggereert dat het versterkingseffect begint. We zien dat dit versterkingseffect zich pas manifesteert nadat de spaaktips zijn geëvolueerd naar een scherpe punt. Bij t 0 , de punten van de spaken zijn nog afgerond. Door de geleidelijk convergerende zijwanden tijdens de eerste etsfase van de spaken (t <90 s), verandert de afgeronde punt in een louter scherpe punt en beginnen de spaken terug te trekken (zie ook Aanvullend bestand 1:S2). Deze bevinding wordt duidelijk geïllustreerd voor de vorm van de wagenwielspaak op t =180 s:ongeveer de helft van de spaak is geëtst vanwege het terugtrekken van de punt (∆l is ongeveer 450 nm). Er is echter nog wat SiGe over, althans aan het breedste uiteinde van de spaken, aangezien de zijwanden aan beide zijden slechts met een hoeveelheid ∆w~∆l/20 =22,5 nm zijn ingetrokken. Bijgevolg, na een kritieke tijd (t kritiek ), kan de terugtreklengte (∆l) worden gebruikt om indirect de etssnelheid van de Si75 te berekenen Ge25 spaken. Echter, voordat deze t kritiek , kan de etssnelheid alleen worden berekend door directe meting van zijwandverlies (∆w) dat moeilijk te meten is. Een vergelijking van de etssnelheden van Si en SiGe in PAA verkregen door directe meting van het zijwandverlies en indirecte meting van de spaakterugtrekking wordt getoond in Tabel 2. De etssnelheden werden verkregen door de helling van de afnemende zijwandbreedten versus de tijd en de helling van de toenemende lengte van de spaakretracties versus de tijd. De laatste helling werd berekend met behulp van de gegevenspunten na t kritiek zoals weergegeven in Fig. 7. De breedtes van de zijwanden lijken lineair af te nemen, althans tot de waarnemingslimiet van onze conventionele SEM, die daalt tot ongeveer 10 nm. Tot aan deze kenmerkgroottes hebben we geen opvallende veranderingen in de etssnelheid waargenomen tijdens het geleidelijk dunner worden van de spaken (Fig. 7 en 9).

Ets tijdreeksen van Si75Ge25(100) wagenwielen in PAA-oplossing
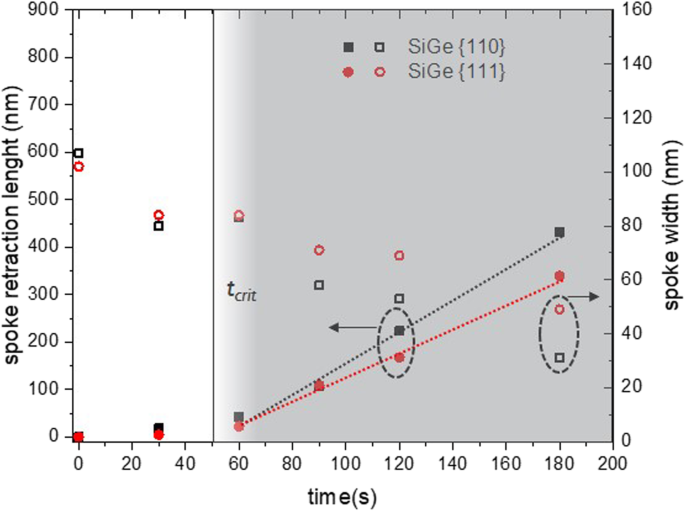
Etsen van Si75Ge25-spaken:de spaakbreedte neemt geleidelijk af, maar pas na een bepaalde tcrit. beginnen de spaakpunten in te trekken en kunnen de gemeten intreklengtes Si75Ge25 lineair worden gemonteerd vb. etstijd (grijs gearceerd gebied)
Naast het verkrijgen van etssnelheden voor het SiGe-etsmiddel, hebben we het isotrope gedrag van het etsmiddel geverifieerd. Het is duidelijk dat alle verschillend georiënteerde spaken met dezelfde etssnelheid etsen, d.w.z. isotroop. Dit wijst dus in de richting van een proces waarvan de reactiesnelheid wordt geregeld door de oxide-oplossnelheid en niet door de Si75 Ge25 oxidatie snelheid. Oxide-oplossing is diffusiebeperkt, met lage activeringsenergieën en is niet vatbaar voor anisotroop gedrag.
Resultaten verkregen op c-Si75 Ge25 (100) wagenwielen werden gevalideerd met c-Si75 Ge25 (110) wagenwielen. Zoals uitgelegd voor de silicium wagenwielen, is een voordeel van het gebruik van (110) substraten de extra aanwezigheid van verticale {111} vlakken, weergegeven door de zijwanden van de {111} spaken van de wagenwielen. Dit zijn meestal de langzaamste etsvlakken/spaken; dus een zorgvuldige observatie van die spaken is noodzakelijk voor een volledig beeld van de anisotropie van de Si75 Ge25 -PAA etspaar. De resultaten (zie aanvullend bestand 1:S3.1) zijn in lijn met de etsresultaten verkregen met de Si75 Ge25 (100) wagenwielen (Fig. 6). Het etsen verliep geleidelijk, eerst door dunner te worden, gevolgd door het terugtrekken van de spaaktip. Bij de langste etstijd (t) kan een lichte ongelijkmatigheid in de terugtreklengtes van de verschillend georiënteerde spaken worden waargenomen =180 s). Omdat er echter geen duidelijke trend is, d.w.z. een specifieke hoekafhankelijkheid van ∆l, werd dit niet toegeschreven aan anisotropie. We schrijven dit alleen toe aan een grotere variatie (inter- en intra-spoke) van de spaakbreedtes na fabricage. Het is inderdaad al te zien op de referentiefoto (t 0 ) dat de zijwanden niet perfect recht zijn. Deze ruwheid van de zijwand is waarschijnlijk te wijten aan relaxatiedefecten van het epitaxiaal afgezette Si75 Ge25 laag op een (110) substraat. Samengevat, zowel de c-Si75 Ge25 (100) en (110) wagenwielen zijn isotroop geëtst in de PAA-oplossing, wat een voordeel is voor de snelle en volledige verwijdering van c-Si75 Ge25 , gebruikt als opofferingsmateriaal, omdat het geen blokkerende vlakken zal vormen.
Nat etsen in PAA werd herhaald voor c-Si wagenwielen. Het doel van deze tests is om de selectiviteit van de etsoplossing naar silicium te verifiëren. De monsters werden gedurende toenemende tijden in een identieke PAA-oplossing gedompeld (t 0 + 15 min, + 30 min, ...+ 90 min). Let op:de etstijden zijn in minuten en niet in seconden zoals bij de Si75 Ge25 Wagenwielen. Deze langere etstijden zijn bedoeld om Si-etsen waar te nemen, zelfs als het doel van dit etsmiddel is om het silicium te behouden.
Hoewel de etstijden verschillend waren, een vergelijkbare waarneming als voor de Si75 Ge25 wagon-wheels spaken werden gemaakt:aanvankelijk worden de siliconen spaken geleidelijk dunner vanwege hun relatief langzame zijwandetsing, en na een tijdje, t kritiek In dit geval beginnen de spaken na ongeveer 45 minuten relatief snel terug te trekken vanwege het versterkingseffect (Fig. 8 en 9). In alle gevallen lijkt de ets isotroop. De tijdreeksen verkregen met c-Si(100) wagenwielen (zie Aanvullend bestand 1:S3.2) komen overeen met de tijdreeksen verkregen met de c-Si(110) wagenwielen (Fig. 8).

Ets tijdreeksen van Si(110) wagenwielen in PAA-oplossing. Let op de iets langzamere etssnelheid van de <111> spaken in vergelijking met de andere richtingen, het meest waarneembaar in de afbeelding t 0 + 90 min, en aangegeven door de stippellijnen
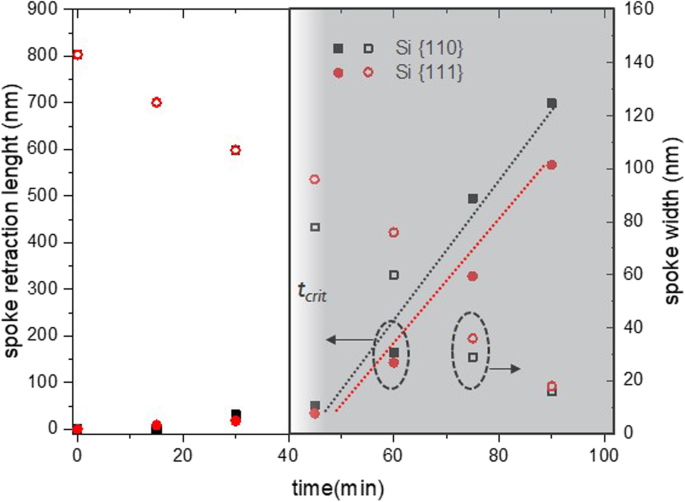
Etching of Si spokes:the spoke width decreases gradually, but only after a certain tcrit., the spoke tips start to retract, and the measured retraction lengths can be fitted linearly a.f.o. etching time (gray-shaded area)
Calculated etch rates are shown in Table 2. Both measurement methods give comparable etching rates with only a 7% and 4% difference in the etch rate values of the {111} and {110} planes, respectively. The values of the Si etching rate are all < 1 nm/min. Holländer et al. measured Si(100) etch rates of ~ 10 nm/min with HF:H2 O2 :CH3 COOH 1:2:3 with a HF concentration of 1.6 wt.% and Wieser et al. measured etch rates of ~ 3 and 5 nm/min for undoped Si(111) and Si(100), respectively with BHF:H2 O2 :CH3 COOH 1:2:3 solutions with a HF concentration of 1 wt.% [33, 34]. Our values compare well with those reported values, considering that the HF concentration in our tests are lower ([HF] =0.25 wt.%). Our results also suggest a slightly lower etching rate of the {111} planes, measured on Si(110) substrates, compared to the {110} planes, measured on Si(100) substrates. These quantitative results point toward a very low etching anisotropy of Si in PAA which is hardly observable by the top-down SEM images. For the sake of clarity, the {111} planes of the wagon-wheel at t 0 + 90 min in Fig. 8 are indicated and it can be noticed that the {111} spokes are slightly broader and longer than the surrounding spokes. This demonstrates again that these scaled-down wagon-wheels are sensitive to detect very faint differences in the crystallographic plane-dependent etch rates (‘anisotropy’) of etchants.
The selectivity ratios of the Si75 Ge25 /Si pair in PAA were extracted from the etching rates in Table 2. The selectivity ratios of Si75 Ge25 (111)/Si(111) range between 11.0 and 12.6 while the Si75 Ge25 (110)/Si(110) ratios are slightly higher, between 14.2 and 16.8. These values are slightly lower than the reported values from Holländer et al. who claim selectivities around ~ 20 [33]. This can be attributed to the higher SiGe etch rates (11–17 nm/min) due to the dynamic process conditions (wafer rotation) in contrast to our static process conditions (no stirring) in which case the SiGe etch rates were ranging between 7.8 and 12.3 nm/min. Interestingly, this confirms the observed isotropic etching of SiGe in PAA:since the reaction rate is kinetically controlled (by stirring or rotation), the rate determining step (RDS) is most probably the diffusion controlled SiGe-oxide dissolution by HF.
Conclusies
Scaled-down wagon-wheels with a diameter of 4 μm and 32 spokes exposing the different crystallographic planes were fabricated on 300-mm-diameter wafers. The structures were patterned on Si(100), Si(110), Si75 Ge25 (100), and Si75 Ge25 (110) substrates allowing the observation of the etching of the three main crystallographic orientations of c-Si and c-Si75 Ge25 ({111}, {110}, and {100}) as well as higher index planes. The structures proved to be valuable for the evaluation of the isotropic or anisotropic behavior of etchants by simple inspection by TD SEM. Various alkaline as well as acidic etchants were evaluated by image analysis of their characteristic wagon-wheel etching pattern. Trends in etching ratios were in good agreement with previous works. In TMAH, the plane-dependent etching rate of silicon follows the order:R (110) ~ R (211)> R (100)> R (111) . In NH4 OH, on the other hand, the etching rate follows the order:R (310) ~ R (210)> R (100) ~ R (110)> R (111) . Besides the relative etching rates of the main crystallographic planes, other anisotropic features, like facets, were observed, indicating that the structures are very sensitive to changes in the anisotropic properties of the etchant.
In addition to their capacity for the revelation of the (an)isotropy of etchants, these wagon-wheel structures also demonstrate their benefit for the assessment of the selectivity of etchants. For this purpose, the system PAA/Si/Si75 Ge25 was assessed in terms of Si75 Ge25 etching, selective toward Si. Selectivity values were obtained by two methods:the first by measurement of the sidewall loss of the spokes; the second, indirect method, through measurement of the spoke retraction lengths. It was shown that the latter method could only be used after a certain critical etching time, after which the spoke tips have evolved toward a seemingly sharp tip.
In conclusion, scaled-down wagon-wheels can be used as lab-scale vehicles for the swift evaluation of anisotropy and selectivity of material/etchant pairs. The structures also have the potential to be used as high-throughput short loop test structures for the screening of etchants on 300 mm wafer wet processing tools. In addition, due to their small size, these wagon-wheels could be used for future in-situ etching studies, using liquid cell environmental electron transmission microscopy ETEM.
Beschikbaarheid van gegevens en materialen
Alle gegevens zijn onbeperkt beschikbaar.
Afkortingen
- AA:
-
acetic acid
- BHF:
-
buffered hydrofluoric acid
- CD:
-
critical Dimension
- CMOS:
-
complementary metal oxide semiconductor
- c-Si:
-
single-crystalline silicon
- c-SiGe:
-
single-crystalline silicon-germanium
- ETEM:
-
environmental electron transmission microscopy
- FinFET:
-
fin field effect transistor
- FoV:
-
field of view
- GAA:
-
gate all around
- HF:
-
hydrofluoric acid
- MEMS:
-
microelectromechanical systems
- PAA:
-
peracetic acid
- R (xyz) :
-
etch rate of a (xyz) plane
- RDS:
-
rate determining step
- SEM:
-
scanning electron microscopy
- TMAH:
-
tetramethyl ammonium hydroxide
- VLSI:
-
very large-scale integration
Nanomaterialen
- Doe mee voor een bijeenkomst van geesten en machines
- Industrie 4.0 en het IoT:markttrends voor de komende jaren
- Digitale transformatie in productie – De versnellers en roadmap voor fabrikanten
- De perfecte formule om operaties en onderhoud op elkaar af te stemmen
- Hygiënisch ontwerp voor de voedings- en verwerkingsindustrie
- Internet of Things en de rol van 5G in verbonden voertuigen
- De vijf belangrijkste problemen en uitdagingen voor 5G
- Industrieel IoT en de bouwstenen voor Industrie 4.0
- De voordelen en uitdagingen voor hybride productie begrijpen
- Kenmerken van de meest effectieve API's voor 3D-visualisatie in productie
- Punch and Die-onderhoud:de formule voor succes en productiviteit



