Dominante invloed van verstrooiing van de ruwheid van de interface op de prestaties van GaN Terahertz Quantum Cascade Lasers
Abstract
Het effect van interface-ruwheid van kwantumputten, niet-opzettelijke doping en legeringsstoornis op de prestaties van op GaN gebaseerde terahertz-kwantumcascadelasers (QCL) is onderzocht door het formalisme van niet-evenwichtsfuncties van Green. Er werd vastgesteld dat de invloed van de legeringsstoornis op de optische winst verwaarloosbaar is en dat niet-opzettelijke doping onder een redelijke concentratie van 10 17 moet blijven. cm −3 om verstrooiing van elektronenonzuiverheden en absorptie van vrije dragers te voorkomen. Wat nog belangrijker is, is dat interface-ruwheidsverstrooiing de dominante factor is bij degradatie van optische versterking. Daarom is de nauwkeurige controle tijdens de fabricage van cruciaal belang. Eindelijk een winst van 60 cm −1 kan worden verkregen bij 300 K, wat de mogelijkheid aantoont om GaN Terahertz QCL op kamertemperatuur te fabriceren.
Inleiding
De spectrale regio van Terahertz (THz) is een onderwerp van intensief onderzoek vanwege de potentiële toepassingen in kwaliteits- en veiligheidscontrole, medische diagnose en telecommunicatie. De ontwikkeling ervan werd echter belemmerd door het gebrek aan beschikbare compacte apparaten. Quantum cascade laser (QCL) is een veelbelovende kandidaat voor het ontwikkelen van krachtige THz solid-state bronnen [1, 2]. Tot nu toe is de beste THz QCL gebaseerd op GaAs, waarvan de maximale bedrijfstemperatuur ongeveer 200 K is vanwege de lage LO-phonon-energie (36 meV) van GaAs [3, 4]. Met behulp van een magnetisch veld kan deze temperatuur worden verhoogd tot 225 K. Deze methode is echter niet geschikt voor wijdverbreide toepassingen [5, 6]. Wanneer de temperatuur stijgt, kunnen elektronen in de toestand op het hogere niveau voldoende thermische energie verwerven voor het activeren van niet-stralingsrelaxaties via LO-fonon-emissie naar de toestand van het lagere niveau, waardoor de populatie-inversie wordt vernietigd. In vergelijking met GaAs heeft GaN een veel hogere LO-phonon-energie (92 meV) en biedt het dus de mogelijkheid om THz QCL te produceren bij kamertemperatuur [7,8,9]. Bovendien kunnen op GaAs gebaseerde QCL's niet worden gebruikt in het frequentiebereik van 4,6-12 THz vanwege hun Reststrahlen-band, het spectrale gebied waar het materiaal volledig ondoorzichtig is vanwege de absorptie door optische fononen. De grotere energie van optische fononen in GaN opent perspectieven voor THz-kwantumcascade-apparaten, die in een veel breder spectraal bereik tussen 1 en 15 THz kunnen werken.
De eerste stapstudie in GaN THz QCL's was het afstemmen van de intersubband (ISB) -overgang naar het ver-infrarooddomein. ISB-absorptie bij THz-frequenties is waargenomen in polaire [10, 11] en niet-polaire op nitride gebaseerde kwantumbronnen (QW's) [12,13,14,15,16,17]. THz werkende ISB GaN-gebaseerde detectoren werden gedemonstreerd bij respectievelijk 13 THz [18] en 10 THz [19]. Er is tot nu toe geen elektroluminescentiedemonstratie in dit bereik bereikt, behalve een controversieel rapport van de Hirayama-groep over de spontane elektroluminescentie van een QCL-structuur [20, 21]. Er zijn verschillende theoretische studies gepubliceerd [7, 9, 22,23,24,25,26], waaronder enkele die beperkende factoren van GaN THz QCL-prestaties onderzoeken, zoals verbreding van het versterkingsspectrum als gevolg van zeer sterke interacties tussen elektronen en LO-fononen in GaN [23].
In dit artikel stellen we voor om deze onderzoeken te voltooien door andere factoren te analyseren die de optische winst van THz GaN QCL kunnen beschadigen, zoals interface-ruwheid van kwantumbronnen, niet-opzettelijke doping en legeringsstoornis. Er werd vastgesteld dat de invloed van de legeringsstoornis op de optische winst verwaarloosbaar is, en niet-opzettelijke doping moet onder een redelijke concentratie van 10 17 blijven. cm −3 om verstrooiing van elektronenonzuiverheden en absorptie van vrije dragers te voorkomen [27]. Ten slotte ontdekten we dat verstrooiing van de interface-ruwheid de dominante factor is bij degradatie van optische versterking. En een winst van 60 cm −1 kan worden verkregen bij 300 K, wat ruim boven het theoretische verlies van een dubbele metalen golfgeleider ligt, wat de mogelijkheid aantoont om GaN THz QCL op kamertemperatuur te fabriceren.
Methoden
Het is bekend dat de fabricage van GaN THz QCL-apparaten dikke actieve regio's met lage dislocatiedichtheden moet laten groeien. Deze taak is een uitdaging vanwege de roostermismatch tussen GaN en AlGaN [28]. Andere ongewenste factoren afkomstig van epitaxie kunnen ook optreden:interfaceruwheid (IFR) afhankelijk van de groeiconditie, n-type niet-opzettelijke doping (nid) afkomstig van onzuiverheden (meestal zuurstof) opname tijdens groei en legeringsstoornis (AD) afkomstig van Ga-oppervlak segregatie en Al adatom lage mobiliteit. Om te onderzoeken hoe deze verschijnselen de THz GaN QCL-prestaties beïnvloeden, gebruiken we het formalisme van niet-evenwichtsfuncties van Green (NEGF). Berekeningen worden uitgevoerd met Nextnano QCL-software [29,30,31]. Dit model omvat relaxatie veroorzaakt door ruwheid van het grensvlak, geïoniseerde onzuiverheden, legeringsstoornis, LO fonon, akoestische fonon of elektron-elektron interactie. We gebruikten een drie-quantum-well QCL met een resonant-phonon-ontvolkingsschema, aangezien dat THz QCL-ontwerp de hoogste bedrijfstemperatuur tot nu toe biedt [3, 32]. Figuur 1a toont de ontworpen actieve regiostructuur. De laagvolgorde voor één AlGaN-kwantumstructuur/AlGaN-kwantumstructuur is 1.6 /6.2/1.6 /3.4/1.0 /3,4 nm, waarbij de cursieven de dikte van de barrières weergeven. Figuur 1b toont het geleidingsbanddiagram van de ontworpen QCL-structuur met een bias van − 84,5 kV/cm. Van de vorige periode aan de rechterkant, worden elektronen geïnjecteerd door resonantietunneling in de bovenste lasertoestand, gelabeld met 1. Vervolgens ondergaan ze een stralingsovergang naar de lagere lasertoestand 2. Deze lagere lasertoestand wordt ontvolkt door tunneling naar toestand 3. Ten slotte ontspannen elektronen door naar toestand 4 door LO-fonon-emissie. Het proces wordt voor elke periode herhaald.
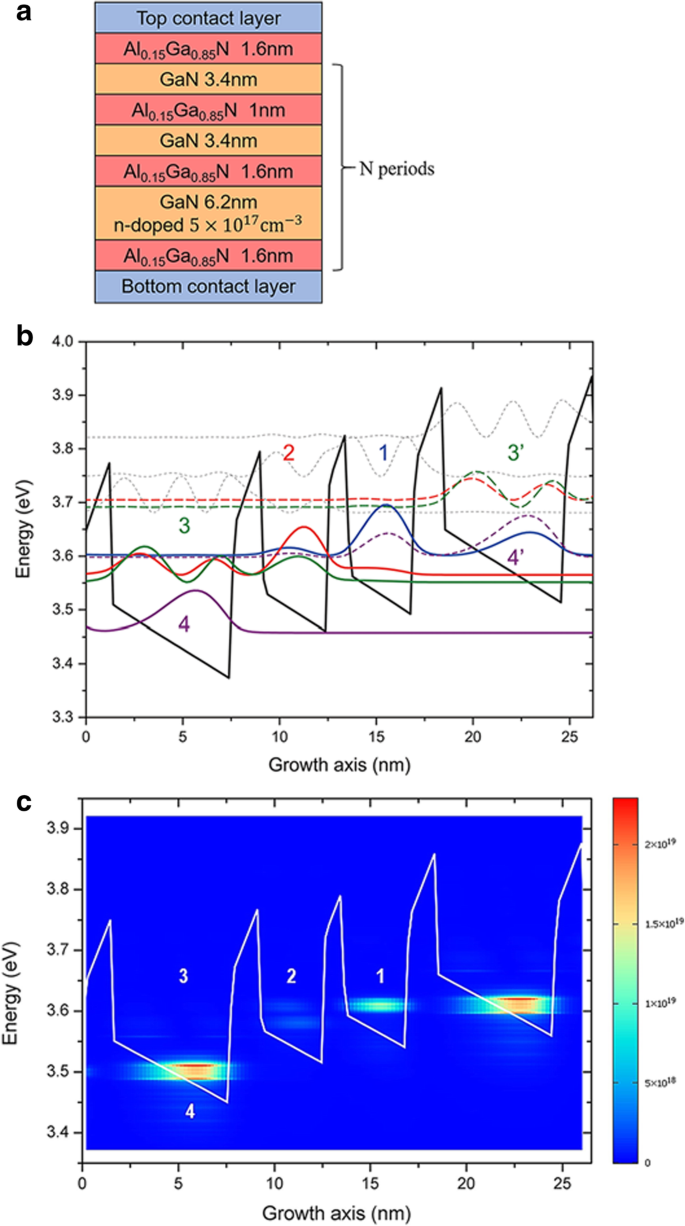
Ontworpen actieve regiostructuur, geleidingsbandprofiel, vierkante envelopfuncties en dragerdichtheden. een De laagvolgorde voor één periode is 1.6 /6.2/1.6 /3.4/1.0 /3,4nm. Barrières zijn cursief weergegeven. De 6,2 nm dikke put is n-gedoteerd met n = 5 × 10 17 cm −3 . b Geleidingsbandprofiel en gekwadrateerde envelopfuncties van de GaN/Al0,15 Ga0,85 N QCL overwogen in deze studie. Er wordt een elektrisch veld van − 84,5 kV/cm aangelegd. c Dragerdichtheden en geleidingsband van de QCL berekend in het NEGF-model. Het aangelegde elektrische veld is − 84,5 kV/cm. De temperatuur is ingesteld op 10 K.
Bij de berekening gebruiken we de parameters die gewoonlijk worden gevonden in GaN/AlGaN-gegroeide structuur met plasma-assisted moleculaire bundelepitaxie (PAMBE):een interfaceruwheid van 0.25 nm [33] met een correlatielengte van 1 nm en een niet-opzettelijk n- doping met een dragerconcentratie van 10 17 cm −3 . Legeringswanordeverstrooiing is ook opgenomen in de simulatie.
Resultaten en discussie
Figuur 1c toont de berekende dragerdichtheden van deze structuur bij de operationele bias van − 84,5 kV/cm. We hebben de anti-kruising waargenomen tussen de vorige periode en de bovenste lasertoestand 1. We zien ook dat de onderste laserende toestand 2 wordt ontvolkt door resonerende fononen in toestand 3 en 4. Om de invloed van IFR te analyseren en te vergelijken, nid, en AD, hebben we onze GaN THz QCL optische versterking en huidige kenmerken berekend voor verschillende configuraties:de referentieconfiguratie waarbij rekening wordt gehouden met IFR, nid en AD, een configuratie zonder IFR, een andere zonder nid en een laatste zonder AD. Figuur 2 toont de maximale optische versterking versus frequentie (a) en stroomdichtheden versus aangelegd elektrisch veld (b) voor elke configuratie berekend bij een temperatuur van 10 K. De referentiestructuur toont een piekversterking van 142 cm −1 bij 8,7 THz, frequentie onbereikbaar voor arsenidenmateriaal. Laten we eens kijken hoe n.i.d onze QCL-prestaties beïnvloedt. Zonder n.i.d is de piekversterking 127 cm −1 op 8.46 THz. De winstdaling is te wijten aan die dragerconcentratie die afneemt in de bovenste lasertoestand na het wegnemen van elektronen afkomstig van n.i.d. In de referentieconfiguratie is de elektronenconcentratie van de bovenste en onderste lasertoestand inderdaad ∆N = N 1 – N 2 = 5.43 ×10 12 cm −2 , terwijl het zonder n.i.d ∆N . wordt = N 1 – N 2 = 5.06 ×10 12 cm −2 . Toegepast elektrisch veld verschuift van -84,5 naar 81,6 kV/cm. Huidige drempel daalt en verschuift van 25,11 kA/cm 2 bij − 84,49 kV/cm tot 17,11 kA/cm 2 bij − 93,24 kV/cm. De daling van de stroomdichtheid kan worden toegeschreven aan de vermindering van de verstrooiing van elektronen-onzuiverheden, waardoor het elektronentransport in de berekening toeneemt zonder n.i.d. Een andere hint van deze hypothese is de piek bij − 64 kV/cm die we zien in het geval zonder n.i.d stroomdichtheden. Dit is een inter-periode resonantietunnel tussen 4' en 3 (hier niet getoond). Dit fenomeen wordt verborgen door de verstrooiing van elektronen-onzuiverheden in de huidige kenmerken, rekening houdend met n.i.d. De stroomdrempel en de toegepaste elektrische veldverschuiving worden toegeschreven aan een verkeerde uitlijning van de geleidingsband tussen de configuratie met of zonder n.i.d. Interessant is dat, hoewel de versterkingspiek groter is in het n.i.d-geval, we een verbreding van het versterkingsspectrum waarnemen, de signatuur van geladen onzuiverheden beïnvloedt [31] Niet-opzettelijke doping zou op een redelijke concentratie van 10 17 moeten blijven cm −3 om verstrooiing van elektronenonzuiverheden en absorptie van vrije dragers te voorkomen. In de configuratie zonder AD-verstrooiing is de piekversterking 147 cm −1 op 8,7 THz. We zien dat de piekversterking dezelfde frequentie heeft met of zonder AD-verstrooiing. Optische winst krijgt slechts een marginale toename van 3% wanneer AD-verstrooiing niet in de berekening wordt meegenomen. De huidige kenmerken zijn ook bijna identiek. Aangezien ons ontwerp gebruik maakt van een laag aluminiumgehalte van 15% en vrij dunne barrières (1-1,5 nm), is de invloed van AD-verstrooiing in deze QCL verwaarloosbaar.

Gesimuleerde maximale optische versterking versus frequentie en stroom-elektrisch veldsimulaties voor verschillende verstrooiingsproces. een Gesimuleerde optische versterking versus frequentie rekening houdend met verschillende verstrooiingsproces. b Stroom-elektrisch veldsimulaties van de GaN THz QCL rekening houdend met verschillende verstrooiingsparameters. De temperatuur is ingesteld op 10 K
Integendeel, de invloed van IFR-verstrooiing op de prestaties van het apparaat is belangrijk. Zonder IFR-verstrooiing zien we een piekversterking van 191 cm −1 op 8,7 THz. Stroomdichtheidsdrempel is 24,08 kA/cm 2 . Deze toename van de versterking van 34% en de daling van de stroomdichtheidsdrempel weerspiegelt het feit dat veel elektronen door IFR-verstrooiing worden getransporteerd. Hoe meer IFR-verstrooiing, hoe minder stralingsverstrooiing er is voor laseren. Bij het vergelijken van de referentieconfiguratie elektronenpopulatie van de bovenste en onderste lasertoestand ∆N = N 1 – N 2 = 6,6 ×10 12 – 1,27 ×10 12 = 5.43 ×10 12 cm −2 naar degene zonder IFR ∆N = N 1 – N 2 = 7.4 ×10 12 – 1.17 ×10 12 = 6.23 ×10 12 cm −2 , kan men zien dat de elektronenpopulatie in de hogere staat hoger is. Dit komt door de levensduur van de bovenste lasertoestand die toeneemt door de afwezigheid van IFR-verstrooiing. In vergelijking met het geval zonder nid, zien we in de huidige dichtheden van het apparaat zonder IFR-verstrooiing een piek bij -67 kV/cm, signatuur van de inter-periode resonantietunnel tussen 4' en 3. Dit fenomeen is beter zichtbaar in het geval zonder rekening te houden met het IFR-verstrooiingsproces. Dit is een bewijs van zijn overwicht op resonante tunneling. Met die waarnemingen benadrukken we het overwicht van IFR-verstrooiingsinvloed in de prestaties van THz GaN QCL.
Na het opmerken van het belang van IFR-verstrooiing in THz-prestaties. We hebben verder onderzoek gedaan door de IFR-grootte te variëren. We hebben aan onze studie het geval van IFR = 0.5 nm en 0.75 nm toegevoegd. De correlatielengte wordt op 1 nm gehouden. In figuur 3 toonden we de maximale versterking versus frequentie (a) en stroomdichtheden versus aangelegde elektrische veldkenmerken (b). Ten eerste hebben we waargenomen dat voor IFR = 0.5 nm de maximale optische versterking afneemt tot 47,9 cm −1 en zelfs dramatisch daalt tot − 8,8 cm −1 optische winst verliezen voor IFR = 0.75 nm. De versterkingsverbreding als functie van de IFR-lengte is ook duidelijk. Zoals we kunnen zien aan de IV-karakteristieken, neemt de rol van de IFR in de elektronenverstrooiing toe naarmate de IFR-grootte toeneemt, de stroomdichtheden toenemen en het resonantietunnel- en stralingsverstrooiingsproces in de apparaten afnemen. Dit effect wordt duidelijk wanneer de referentieconfiguratie van IFR = 0,25 nm wordt vergeleken met het extreme geval van IFR = 0,75 nm, waarbij de elektronenpopulatie van de bovenste en onderste lasertoestand daalt van ∆N = 5.43 ×10 12 cm −2 naar ∆N = N 1 – N 2 = 3.71 ×10 12 cm −2 .
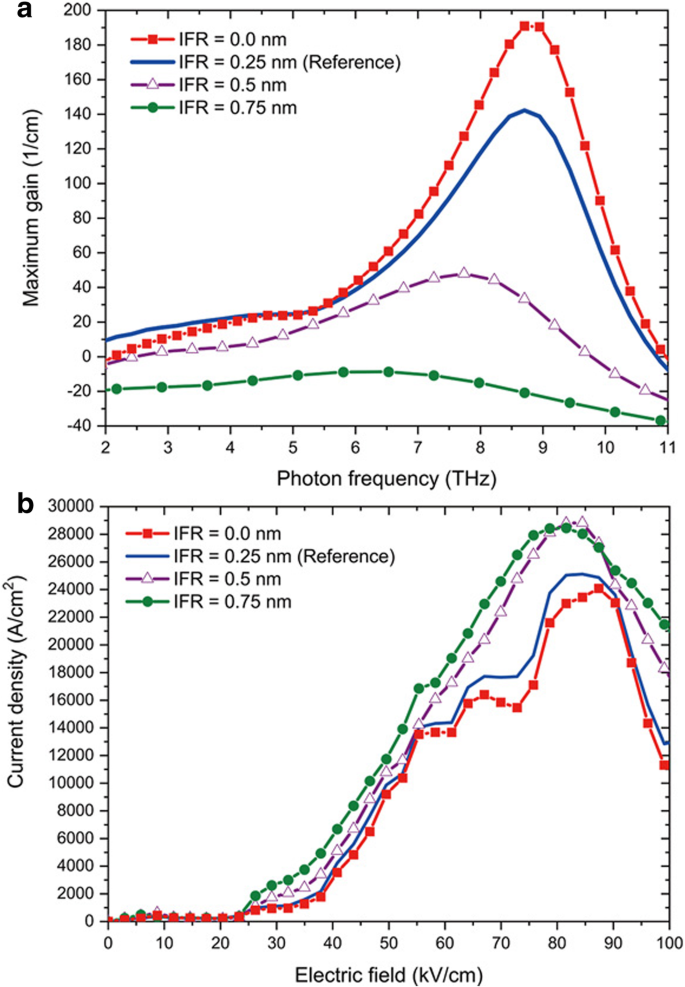
Gesimuleerde maximale optische versterking versus frequentie en stroom-elektrisch veldsimulaties voor verschillende IFR. een Gesimuleerde maximale optische versterking versus frequentie voor verschillende IFR. b Stroom-elektrisch veldsimulaties van de GaN THz QCL rekening houdend met verschillende IFR. De temperatuur is ingesteld op 10 K
Dit laatste neemt af tot het punt dat we geen lasering meer in de apparaten zien. Zoals al is aangegeven in eerdere studies met behulp van op GaAs gebaseerde THz QCL [25, 34,35,36], benadrukken we het belang van het overwegen van de IFR-grootte tijdens epitaxie en om deze kleiner te houden dan 0,5 nm voor de fabricage van GaN THz QCL om te kunnen om positieve optische versterking te bieden.
Een voordeel voor GaN THz QCL is het potentieel om bij een hogere temperatuur te werken dan op GaAs gebaseerde THz QCL. In dit deel hebben we de prestaties van ons apparaat geanalyseerd als een functie van de bedrijfstemperatuur. We bleven onze referentieapparaten gebruiken met IFR = 0,25 nm, n.i.d en AD in de berekening. Figuur 4 toont de maximale optische winst voor verschillende roostertemperaturen. De versterkingswaarde is stabiel van 10 tot 150 K rond de 142 cm −1 , het begint af te nemen tussen 150 en 250 K, om te dalen tot 61 cm −1 bij 300 ° K. Inderdaad, naarmate de temperatuur stijgt, neemt de populatie-inversie af als gevolg van thermische opvulling en veroorzaakt toename van de LO-fononverstrooiing versterking van de versterking. Deze optische versterkingswaarde van 61 cm −1 is nog steeds hoger dan het verlies van een GaN THz QCL dubbele metalen golfgeleider (30 cm −1 ), waaruit blijkt dat dit GaN THz QCL-ontwerp bij kamertemperatuur zou moeten kunnen werken. We vermelden ook dat naast de mogelijkheid om bij kamertemperatuur te werken, op GaN gebaseerde THz QCL nog een ander voordeel heeft:vanwege hun hogere dopingconcentratie, lagere brekingsindex en dunnere periodelengte, hebben ze het potentieel om een veel hogere optische versterking te bieden dan in hun GaAs-tegenhanger. Ons ontwerp biedt een redelijk hoge optische versterkingswaarde van 142 cm −1 bij 10 K, wat een goed voorbeeld is.
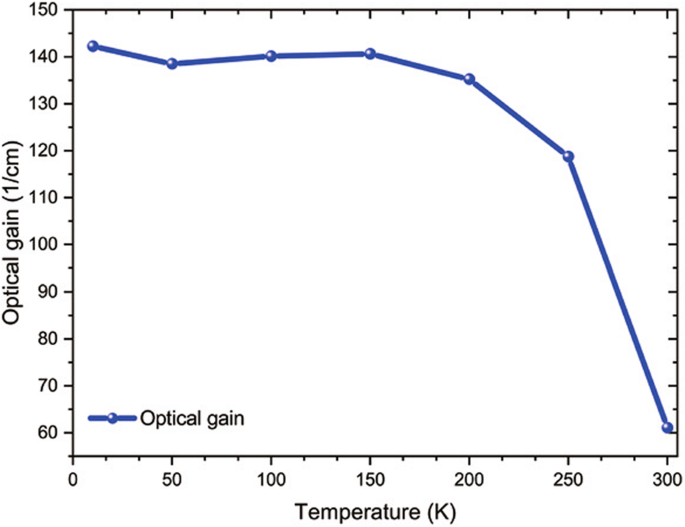
Kenmerken van de berekende maximale versterking versus roostertemperatuur
Conclusies
Concluderend rapporteren we een GaN THz QCLs-ontwerp dat werkt op 8,7 THz. De simulatie toont een optische winst van 142 cm −1 bij 10 K en 60 cm −1 op kamertemperatuur. Onder ongewenste verschijnselen die voortkomen uit epitaxie, hebben we de invloed van interface-ruwheid, niet-opzettelijke doping en legeringsstoornis op de prestaties van GaN THz QCL-versterking berekend. De invloed van de legeringsstoornis is verwaarloosbaar:optische versterking daalt slechts van 147 tot 142 cm −1 bij het toevoegen van legeringsstoornisverstrooiing in de simulatie. Bij het ontwerp moet rekening worden gehouden met niet-opzettelijke doping om verkeerde uitlijning van de geleidingsband te voorkomen. We hebben in onze studie een toegepaste elektrische veldverschuiving waargenomen van -84,5 tot -81,6 kV/cm geïnduceerd door n.i.d. Ten slotte zagen we een grote ongelijkheid in optische versterking voor verschillende interface-ruwheidswaarden:191, 142, 47,9 en − 8,8 cm −1 voor interfaceruwheid gelijk aan respectievelijk 0, 0,25, 0,5 en 0,75 nm. Dat is de reden waarom we de dominante invloed van interface-ruwheidsverstrooiing op de degradatie van optische versterking identificeren. Dit werk biedt routes voor prestatie-optimalisatie van uiteindelijk toekomstige GaN THz QCL-fabricage.
Beschikbaarheid van gegevens en materialen
De datasets die zijn gegenereerd tijdens en/of geanalyseerd tijdens het huidige onderzoek zijn op redelijk verzoek verkrijgbaar bij de corresponderende auteur.
Afkortingen
- AD:
-
Legeringsstoornis
- IFR:
-
Ruwheid interface
- ISB:
-
Intersubband
- n.i.d:
-
Niet-opzettelijke doping
- NEGF:
-
Niet-evenwichtsfuncties van Groen
- QCL:
-
Kwantumcascadelaser
Nanomaterialen
- Invloed van molybdeen op de prestaties van roestvrij staal
- Inleiding tot de Terahertz Band
- De prestaties van glasvezel
- Invloed van water op de structuur en diëlektrische eigenschappen van microkristallijne en nano-cellulose
- Laag energieverbruik Substraat-emitterende DFB Quantum Cascade Lasers
- Optimale siliciumdoteringslagen van kwantumbarrières in de groeireeks die een zacht opsluitingspotentieel vormen van acht-periode In0.2Ga0.8N/GaN Quantum Wells of Blue LED's
- Fotovoltaïsche prestaties van een Nanowire/Quantum Dot Hybrid Nanostructure Array Zonnecel
- Interband fotogeleiding van metamorfe InAs/InGaAs Quantum Dots in het venster van 1,3–1,55 µm
- Het groeimechanisme van GaN epitaxiale lagen op mechanisch geëxfolieerd grafiet begrijpen
- Tapered Quantum Cascade Laser Arrays geïntegreerd met Talbot Cavities
- Invloed van het substraat op de LSP-koppelingsgolflengte en sterkte



