Eenstaps-maskergebaseerde diffractielithografie voor de fabricage van hangende 3D-structuren
Abstract
We stellen een nieuwe eenstaps belichtingsmethode voor voor het vervaardigen van driedimensionale (3D) hangende structuren, gebruikmakend van de diffractie van maskerpatronen met een kleine lijnbreedte. Er wordt een optisch model van het belichtingsproces gebouwd en de 3D-lichtintensiteitsverdeling in de fotoresist wordt berekend op basis van Fresnel-Kirchhoff-diffractieformulering. Er zijn verschillende 3D-opgehangen fotoresiststructuren bereikt, zoals balken, mazen, woordpatronen en meerlaagse structuren. Na de pyrolyse van SU-8-structuren worden verder hangende en vrijstaande 3D-koolstofstructuren verkregen, die een groot potentieel vertonen bij de toepassing van transparante elektrode, semitransparante zonnecellen en energieopslagapparaten.
Inleiding
3D koolstof micro-elektromechanische systeem (C-MEMS) structuren hebben steeds meer aandacht getrokken vanwege hun uitstekende chemische stabiliteit, elektrochemische activiteit en biocompatibiliteit [1,2,3,4,5]. Gesuspendeerde koolstofstructuren zijn de typische 3D C-MEMS-structuren die vrij zijn van intermoleculaire eigenschappen [2], die aanzienlijke voordelen bieden in sensoren [6, 7], micro-elektroden [8, 9] en toepassingen voor energieopslag [9]. Verschillende C-MEMS-microstructuren zijn bereikt door pyrolyse van polymeer, waarbij SU-8 de meest gebruikte voorloper is voor pyrolytische koolstofstructuren [10, 11]. Met betrekking tot de lage lichtabsorptie is het gemakkelijk om microstructuren met een hoge aspectverhouding te fabriceren met SU-8 [12]. Het is echter nog steeds een grote uitdaging om gesuspendeerde polymeertemplate te verkrijgen.
Er zijn verschillende benaderingen ontwikkeld om zwevende microstructuren te fabriceren, zoals E-beam writer [13,14,15], X-ray [10, 16] en twee-fotonenlithografie [17,18,19]. Twee-fotonenlithografie is een haalbare manier om complexe hangende structuren, zoals hangende holle microbuisjes, met grote nauwkeurigheid maar met lage efficiëntie te bereiken [17]. Rekening houdend met de efficiëntie en de kosten, zou UV-lithografie een betere keuze kunnen zijn voor het vervaardigen van fotoresist-precursoren. Een meerstaps lithografieproces met gecontroleerde blootstellingsdosis voor het vervaardigen van hangende structuren is aangetoond [3, 6, 7, 20]. Lim et al. [21] vervaardigde gesuspendeerde nanodraden en nanomeshes met behulp van een tweestaps UV-lithografieproces en verkregen glasachtige koolstofnanostructuren via een pyrolyseproces. Sommige eenstaps lithografiemethoden zijn ook voorgesteld. Nee et al. [22] bereikte zwevende microstructuren door een enkel belichtingsproces, waarbij een optische diffusorfilm op de Cr-maskers werd aangebracht. De diffusorfilm had een aanzienlijke invloed op het belichtingsproces, wat leidde tot de vervorming van fotoresistpatronen. Lang et al. [2] heeft met succes 3D-hangende structuren gefabriceerd door de belichtingsdosis en de luchtspleet tussen de fotoresist en het fotomasker te regelen tijdens het belichtingsproces in de nabijheid, terwijl de belichtingsmodus in de nabijheid de fabricageresolutie beperkte. Grijsschaalfotolithografie is ook toegepast bij het vervaardigen van hangende structuren met grijsschaalmaskers of maskerloze lithografiesystemen [11, 23]. Aangezien SU-8 bijna transparant is wanneer de lichtgolflengte hoger is dan 350 nm [12], is het erg moeilijk om de nauwkeurigheid van de dikte van de zwevende laag te controleren door de belichtingsdosis aan te passen [8, 10]. Hemanth et al. [10] optimaliseerde de UV-golflengte in het belichtingsproces volgens de eigenschappen van SU-8. Ze kozen de UV-golflengte van 405 nm voor de microstructuren met een hoge verhouding en 313 nm voor de zwevende laag. De combinatie van blootstelling aan verschillende UV-lichtgolflengten verhoogt echter de kosten en moeilijkheden van het hele fabricageproces.
In deze studie demonstreren we een nieuw eenstaps maskergebaseerd diffractielithografieproces dat compatibel is met de meeste soorten fotoresist om 3D-opgehangen structuren te fabriceren. Een 3D-lichtintensiteitsverdeling wordt gesimuleerd in de fotoresist volgens de diffractietheorie van Kirchhoff en verder geverifieerd door experimenten. De dikte van de hangende constructies wordt bepaald door de breedte van de patronen en de hangende balken worden verbreed door meerdere lijnpatronen naast elkaar te stapelen met de juiste tussenruimte. Complexe 3D-ophangingsstructuren, zoals balken met gradiëntdikte en volledig opgehangen mazen met woordpatronen, kunnen worden bereikt door het lithografieproces in één stap. Ten slotte zijn ook de zwevende koolstofbalken, mazen en vrijstaande koolstofmatten verkregen via een pyrolyseproces.
Methoden en experimenten
Optisch model van diffractielithografie
Tijdens het UV-lithografieproces zal het diffractieverschijnsel heel duidelijk zijn wanneer de patroongrootte te klein is. Hier gebruiken we de diffractie van smalle patronen met verschillende golflengtebreedtes om hangende balken te fabriceren. Om de ruimtelijke lichtintensiteitsverdeling in de fotoresist te analyseren, bouwen we een optisch model (Fig. 1) voor diffractielithografie op basis van Fresnel-diffractie. De luchtspleet tussen de fotoresist en het fotomasker kan worden verwaarloosd omdat de belichting wordt uitgevoerd in een modus met hard contact. Het masker wordt verlicht met een vlakke golf met een typische golflengte van 365 nm, en de fotoresist wordt behandeld als een transparant materiaal met een brekingsindex van 1.659 (de brekingsindex van SU-8 bij 365 nm, gemeten met een ellipsometer). P 0 is een punt op het masker met een coördinaat van (x 0 , j 0 , 0), en P 1 is een willekeurig punt in de fotoresist met een coördinaat van (x 1 , j 1 , z 1 ).
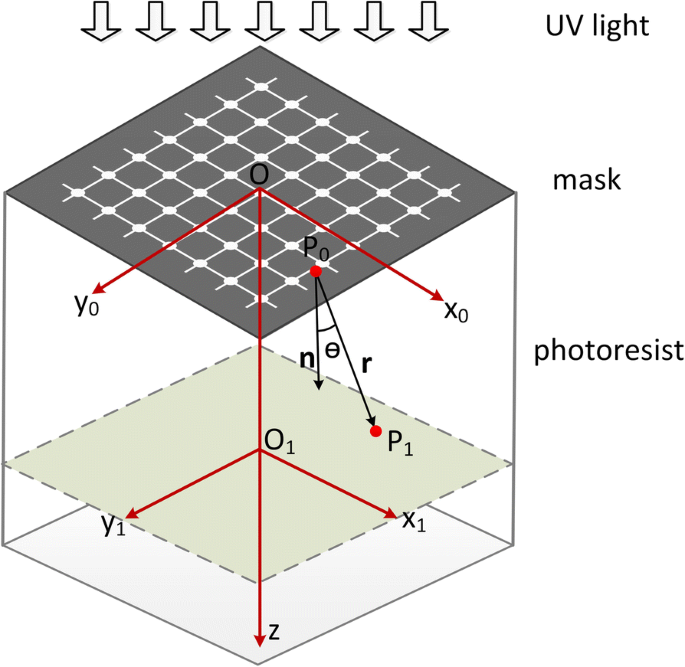
Het optische model van de diffractielithografie
Volgens de Fresnel-Kirchhoff-diffractieformulering [24] is de amplitude op punt P 1 in de fotoresist is
$$ E\left({P}_1\right)=\frac{1}{2 j\lambda}\underset{\sum }{\iint }E\left({P}_0\right)\frac{\ exp (jkr)}{r}\left(1+\cos \theta \right) ds $$ (1)waar k = 2π /λ , λ vertegenwoordigt de golflengte van UV-licht in de fotoresist, E (P 0 ) is de lichtgolfamplitude op punt P 0 , θ is de hoek tussen P 0 P 1 en de z as, r is de afstand tussen P 1 en P 0 , en Σ vertegenwoordigt het integrale domein van het maskerpatroon. Volgens de geometrische relatie in Fig. 1 kunnen we
$$ r=\sqrt{{\left({x}_1-{x}_0\right)}^2+{\left({y}_1-{y}_0\right)}^2+{z_1} ^2} $$ (2) $$ \cos \theta ={z}_1/r $$ (3)E (P 0 ) is een constante in het model. De berekeningsformule wordt dus:
$$ E\left({P}_1\right)=\frac{E\left({P}_0\right)}{2 j\lambda}\underset{\sum }{\iint}\frac{\exp \Big( jk\sqrt{{\left({x}_1-{x}_0\right)}^2+{\left({y}_1-{y}_0\right)}^2+{z_1} ^2\Big)}}{\sqrt{{\left({x}_1-{x}_0\right)}^2+{\left({y}_1-{y}_0\right)}^2 +{z_1}^2}}\left(1+\frac{z_1}{\sqrt{{\left({x}_1-{x}_0\right)}^2+{\left({y}_1 -{y}_0\right)}^2+{z_1}^2}}\right){dx}_0{dy}_0 $$ (4)Vervolgens worden de integralen berekend met behulp van Matlab-software en kan de lichtintensiteitsverdeling in de fotoresist worden uitgedrukt als:
$$ I\left(x,y,z\right)={\left|E\left({P}_1\right)\right|}^2 $$ (5)waar (x , j , z ) is gelijk aan de coördinaat van P 1 .
Om de absorptie van de fotoresist verder te onderzoeken, hebben we de berekeningen van de lichtintensiteit aangepast bij het beschouwen van de absorptiecoëfficiënt. Wanneer een lichtstraal door de fotoresist van P . gaat 0 naar P 1 , kan de lichtintensiteit worden berekend met de volgende formule [25].
$$ \frac{I_{\alpha }}{I_0}=\exp \left(-\alpha r\right) $$ (6)waar ik 0 is de initiële lichtintensiteit op punt P 0 , ik α is de lichtintensiteit op punt P 1 , α is de absorptiecoëfficiënt van de fotoresist, en r is de afstand tussen P 0 en P 1 . We definiëren ik α = 0 als de lichtintensiteit op punt P 1 wanneer α = 0 μm −1 . Het is gemakkelijk te achterhalen dat I α = 0 = Ik 0 volgens formule (6). De relaties tussen E (P α = 0 ) (de amplitude die overeenkomt met I α = 0 ) en E (P α ) (de amplitude die overeenkomt met I α ) kan worden uitgedrukt door:
$$ \frac{E\left({P}_{\alpha}\right)}{E\left({P}_{\alpha =0}\right)}=\exp \left(-\alpha r /2\rechts) $$ (7)Dus, bij het beschouwen van de absorptie van de fotoresist in de diffractielithografie, is de amplitude op punt P 1 (gedefinieerd als E (P 1α )) kan worden berekend door:
$$ E\left({P}_{1\alpha}\right)=\frac{1}{2 j\lambda}\underset{\sum }{\iint}\exp \left(-\alpha r/ 2\right)E\left({P}_0\right)\frac{\exp (jkr)}{r}\left(1+\cos \theta \right) ds $$ (8)En de lichtintensiteit kan worden verkregen met formules (2), (3), (5) en (8).
Experimentele details
Maskers met lijnpatronen werden gebruikt om hangende structuren te vervaardigen, terwijl cirkels of vierkanten werden ontworpen voor het vervaardigen van pilaren om de hangende laag te ondersteunen. Bij de experimenten werden twee soorten dikke negatieve fotoresist gebruikt, waaronder SU-8 2100 (Microchem Co., Ltd.) met een dikte van ~ 50 m en NR26-25000P (Futurrex Co., Ltd.) met een dikte van ~ 30 m. Het belichtingsproces werd uitgevoerd met een MJB4-maskeruitlijner, waarbij de golflengte van het verhelderende UV-licht 365 nm was. De zwevende structuren kunnen worden verkregen nadat de monsters een bepaalde tijd in de ontwikkelaar zijn ondergedompeld. Hier werd propyleenglycolmethyletheracetaat (PGMEA, Aladdin Co., Ltd.) gebruikt als ontwikkelaar voor de SU-8 2100-monsters en werd RD6-ontwikkelaar (Futurrex Co., Ltd.) gekozen voor de NR26-25000P-monsters. Ten slotte werd een pyrolyseproces [16, 26, 27] met een harde bakstap en een carbonisatiebakstap uitgevoerd in een kwartsoven (MTI GAL 1400X) om 3D-koolstofmicrostructuren te verkrijgen. Het hele proces wordt geïllustreerd in Fig. 2a, en de temperatuurvariaties tijdens het pyrolyseproces worden geïllustreerd in Fig. 2b. De monsters werden 30 min hard gebakken bij 300°C en vervolgens 60 min gepyrolyseerd bij 900°C. Tijdens het pyrolyseproces werden de monsters bewaard in de H2 (5%)/Ar(95%) atmosfeer met een verwarmingssnelheid van 10 °C/min. De verkregen microstructuren werden gekarakteriseerd door een scanning elektronenmicroscoop (SEM, Helios NanoLab G3, FEI).
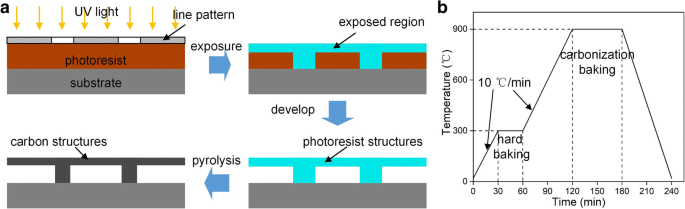
een Het proces voor het fabriceren van 3D-constructies met koolstofophanging. b De temperatuurcurve van de pyrolyse
Resultaten en discussies
Lichtintensiteitsverdeling
Afbeelding 3a toont de dwarsdoorsnede van de 3D-lichtintensiteitsverdeling onder een lijnvormig masker met de lijnbreedte d =1 m, 1,5 m, 2 m, 2,5 m, 3 m, 3,5 m en 4 m, respectievelijk. Hier wordt de relatieve intensiteit aangenomen en wordt de intensiteit van het invallende licht gedefinieerd als 1. Het licht aan de onderkant van de fotoresist zal geleidelijk verstrooien als gevolg van het lichtdiffractie-effect. Zodra de lichtintensiteit een drempelwaarde bereikt, krijgt de fotoresist genoeg energie om de reactie los te laten en vast te worden; anders wordt het verwijderd tijdens het ontwikkelingsproces. De dikte van het gebied boven de drempel (0,75 in deze studie) wordt gedefinieerd als de belichtingsdiepte, die erg gevoelig is voor de patroonbreedte. De belichtingsdiepte is 5,3 m onder d = 1 μm en 18,2 μm onder d = 2 μm. Het zal verder toenemen tot 33,5 m onder d = 3 μm en 47,5 μm onder d = 4 μm. Als de lijnbreedte smaller is dan 1 m, zal de belichtingsdiepte te klein zijn voor de fabricage, omdat de luchtspleet tussen het masker en de fotoresist veroorzaakt door de oneffenheden van de dikke fotoresist de belichting zal doen mislukken. Afbeelding 3b, c toont de maskerpatronen voor het vervaardigen van hangende constructies en de bijbehorende lichtintensiteitsverdeling bij z = 5, 10, 15 en 20 m, waarbij de lijnbreedte is ingesteld op 2 m. De belichtingsdiepte van de lijn- en maaspatronen ligt tussen 15 en 20 m, terwijl die van de grote vierkanten en cirkels groot genoeg is om pilaren te vormen tijdens lithografie. Zo kunnen hangende balken en mazen worden gefabriceerd, ondersteund door de pilaren. Omdat het moeilijk is om hangende constructies te maken wanneer de lijnbreedte groter is dan 5 μm, worden lijnpatronen naast elkaar gestapeld om brede hangende balken of mazen te maken, zoals weergegeven in Fig. 3d.
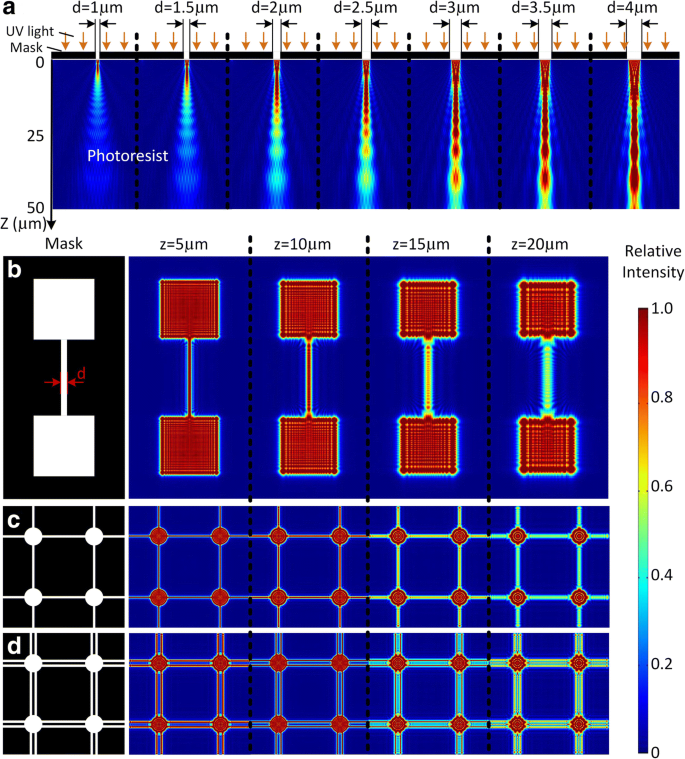
De maskerpatronen en simulatie resulteren in de fotoresist. een De lichtintensiteitsverdelingen onder het fotomasker onder d = 1 μm, 1,5 μm, 2 μm, 2,5 μm, 3 μm, 3,5 μm en 4 μm, waarbij d is de breedte van het lijnpatroon. Het maskerpatroon voor b opgehangen balken, c meshes, en d mazen met gestapelde lijnpatronen en de bijbehorende lichtintensiteitsverdelingen onder z = 5 μm, 10 μm, 15 μm en 20 μm in de fotoresist. Hier, z is de afstand tussen het doorsnedevlak en het fotomasker
Opgeschorte fotoresiststructuren
Er werden experimenten uitgevoerd om hangende constructies te fabriceren. We hebben de minimale belichtingstijd getest om fotoresistpilaren te verkrijgen en deze gedefinieerd als de belichtingsdrempel. Vervolgens werd vier of drie keer de drempelwaarde aangenomen als de blootstellingsdosis en werd de drempel van de relatieve lichtintensiteit geëvalueerd op 0,75, in overeenstemming met de simulatie. Afbeelding 4 toont de hangende fotoresiststralen onder verschillende d waarde. Het blijkt dat de dikte van de zwevende laag h is positief gerelateerd aan d . Voor NR26-25000P fotoresist, h is 10,9 m onder d = 2 μm (Fig. 4a) en neemt toe tot 25,5 μm onder d = 4 μm (Fig. 4e). Als d 5 μm bereikt, is de belichtingsdiepte groot genoeg om het substraat te bereiken en worden er geen hangende structuren verkregen (Fig. 4f). Figuur 4g-k toont de hangende structuren van SU-8. De functie van h vs. d voor zowel experimenten als simulaties wordt geïllustreerd in Fig. 4l, waar de rechte lijnen worden aangepast met de kleinste kwadratenmethode. De lineaire correlatiecoëfficiënt R van de paslijnen zijn R 2 =0,963, 0,988 en 0,858 voor simulaties zonder respectievelijk de absorptie, NR26-25000P en SU-8 te tellen. Het is te zien dat de resultaten van de SU-8-experimenten zeer dicht bij de simulatieresultaten liggen. Daarentegen is de zwevende laag van NR26-25000P veel dunner dan die van de simulatie zonder absorptie. Dit kan voornamelijk worden toegeschreven aan de transparante eigenschap van SU-8 en het hoge absorptievermogen van NR26-25000P. Dit is ook de reden waarom grijze belichting kan worden gebruikt om hangende structuren te maken voor sommige fotoresist, maar niet geschikt voor SU-8.
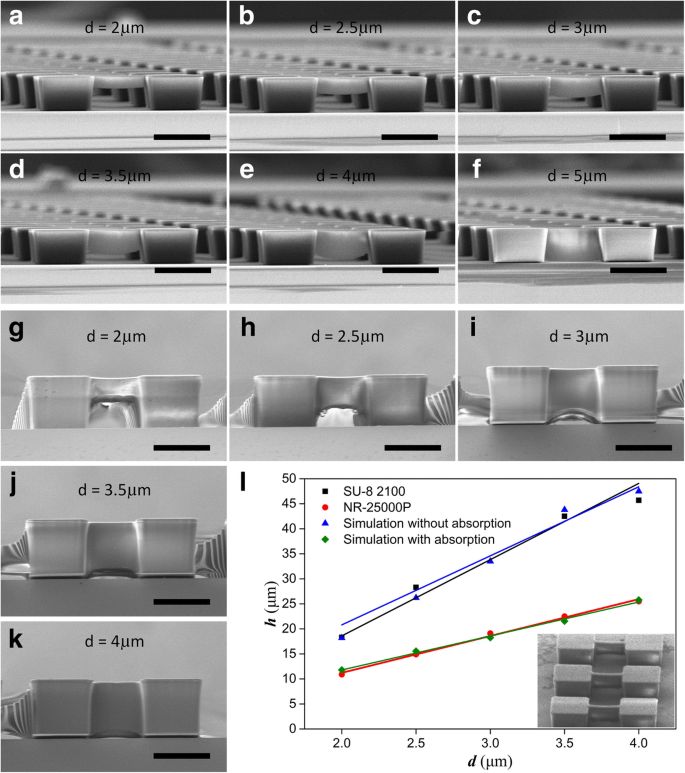
De hangende fotoresiststralen waren het resultaat van eenstaps diffractielithografie met verschillende lijnbreedtes d met behulp van het maskerpatroon in Fig. 3b. NR26-25000P fotolakstralen onder a d = 2 μm, b 2,5 μm, c 3 μm, d 3,5 μm, e 4 μm, en f 5 μm; SU-8 2100 fotoresiststralen onder g d = 2 μm, h 2,5 μm, ik 3 μm, j 3,5 μm en k 4 μm; ik de functies van belichtingsdikte vs. lijnbreedte in simulatie zonder absorptie, NR26-25000P en SU-8 2100 en simulaties met absorptiecoëfficiënt α = 0.0374 μm −1 , waarbij de inzet het gekantelde aanzicht van SU-8-hangbalken toont. De dikte van de bundels neemt toe met de lijnbreedte van het maskerpatroon. De schaalbalken zijn 50 μm
Vervolgens introduceren we de absorptiecoëfficiënt α in optisch model en voer de berekeningen uit met formule (8). De resultaten onder α = 0.0374 μm −1 (de absorptiecoëfficiënt van NR21-25000P bij 365 nm, getest met een UV-zichtbare spectrofotometer, UV 2600, Shimadzu Co., Ltd.) worden getoond in Fig. 4l, waar de gepaste lijn met R 2 = 0.986 komt goed overeen met de experimentele resultaten van NR26-25000P. Onze methode is dus beschikbaar voor bijna alle soorten dikke negatieve fotoresist om hangende structuren te fabriceren met eenstapsbelichting, waarbij de belichtingsdiepte door simulaties kan worden geleid.
Afbeelding 5a–c toont de verschillende patronen van kruisverbindingen en de bijbehorende simulatieresultaten bij z = 15 μm. Drie lijnen worden naast elkaar gestapeld om een brede hangende balk te fabriceren, waarbij de lijnbreedte en intervalbreedte beide 2 μm zijn. Het kruisverbindingspatroon met een cirkel van 20 m wordt gebruikt om een pilaar te fabriceren om de hangende balken te ondersteunen (Fig. 5a). Holle kruisverbindingspatronen zijn ontworpen om hangende mazen te fabriceren, zoals getoond in Fig. 5b, c. De verkregen NR26-25000P fotoresistverbindingen worden getoond in Fig. 5d-f, waar de oppervlaktestructuren op de dwarsverbindingen samen met de balken duidelijk kunnen worden waargenomen, in goede overeenstemming met de simulaties (Fig. 5a-c). Hangende mazen met de drie soorten dwarsverbindingen worden getoond in Fig. 5g-i, en de ondersteunende pilaren worden ook verkregen zoals verwacht (Fig. 5g). Figuur 5h illustreert de dunne pilaren onder de dwarsverbindingen, vanwege de dichte patronen met een hoge verhouding. Het kruisverbindingspatroon in Fig. 5c heeft een lagere duty-ratio, waar de lichtintensiteit zwak is, wat resulteert in een volledig opgehangen gaas (Fig. 5f). Zo kan de verhouding van de kruisverbindingspatronen worden verminderd om volledig opgehangen constructies te fabriceren, terwijl de ondersteunende pilaren gemakkelijk kunnen worden gevormd met een solide verbinding. Ondertussen kan de breedte van de straal ook worden geregeld door het aantal gestapelde lijnpatronen aan te passen.
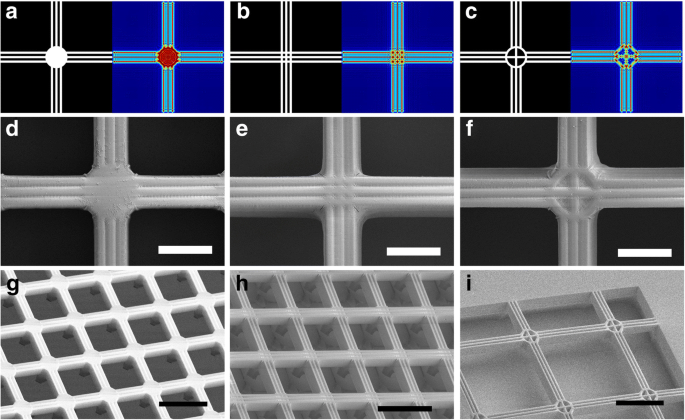
Verschillende kruisverbindingspatronen met NR26-25000P. een –c Drie kruisverbindingspatronen op het masker en de bijbehorende simulatieresultaten bij z = 15 μm, waarbij de lijnbreedte 2 μm is met een tussenruimte van 2 μm en z is de afstand tussen het doorsnedevlak en het fotomasker. d –f De texturen op de verkregen fotoresist-dwarsverbinding en de brede balken, waar de schaalbalken 20 m zijn. g De opgehangen mazen met steunpilaren. u De hangende mazen met dunne steunpilaren, waar de pilaren het resultaat zijn van de dichte dwarsverbindingspatronen met een hoge verhouding. ik De volledig opgehangen mesh-patronen. De schaalbalken in g –ik zijn 100 μm
Sommige complexe 3D-microstructuren zijn ook gefabriceerd via een enkele belichtingsmethode (afb. 6a-c, e, f) of een tweestaps-belichtingsmethode (afb. 6d). Hangende balken met gradiëntdikte worden getoond in figuur 6a, waar de breedte van de lijnpatronen varieert van 2 tot 4 m en 4 tot 6 m in de twee gebieden. De dikte van de hangende laag neemt toe met de toename van de lijnbreedte, in lijn met de resultaten weergegeven in Fig. 4. Hangende concentrische ringen en hangende woordpatronen kunnen ook gemakkelijk worden gemaakt (Fig. 6b, c). Door de twee belichtingsprocessen te combineren, zijn twee hangende lagen geïntegreerd met NR26-25000P, zoals weergegeven in Fig. 6d. Nadat de eerste belichting is voltooid, wordt de tweede laag vervolgens door spincoating op de eerste laag aangebracht en belicht. De gestapelde mazen worden bereikt na de twee belichtingsprocessen gevolgd door een ontwikkelproces. Aangezien de tweede blootstelling schade aan de eerste laag kan veroorzaken, moeten de structuren zorgvuldig worden geoptimaliseerd om meer uitstekende meerlaagse hangende structuren te fabriceren. SU-8 fotoresist hangende mazen met woordpatronen zijn ook met succes bereikt (Fig. 6d-f), hoewel het moeilijker is dan NR26-25000P om de belichtingsparameters te regelen vanwege de hoge transparantie.
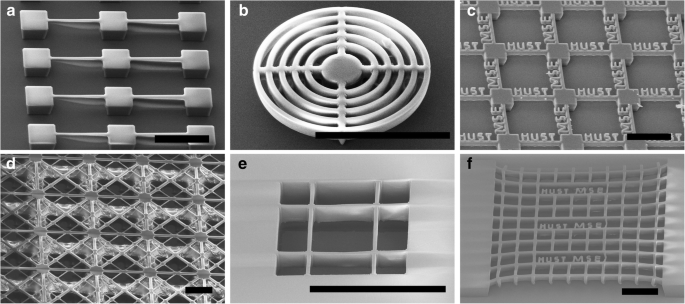
3D hangende fotoresiststructuren. een Hangende liggers met gradiëntdikte, b hangende concentrische ringen, c onderbroken woordstructuren, en d meerlagige hangende mazen, waarbij de fotoresist NR26-25000P is. e Hangende SU-8 mesh. v Hangende SU-8 mazen met woordpatronen. De schaalbalken zijn 100 m. De hangende constructies in d wordt bereikt door een belichting in twee stappen, en de andere worden gefabriceerd met een belichting in één stap
Vergeleken met eerdere werken [2, 11, 22, 23], vormen we een 3D-lichtintensiteitsdistributiemodel in de fotoresist door gebruik te maken van de diffractie van de kleine maskerpatronen. De 3D hangende constructies kunnen goed worden gecontroleerd en voorspeld door simulaties. Hierbij wordt ook rekening gehouden met de absorptiecoëfficiënt van de fotoresist. Hangende constructies met verschillende diktes, zoals gradiëntbalken, worden gemakkelijk gevormd door de eenstapsbelichting. Bovendien wordt het belichtingsproces uitgevoerd met een gewoon masker in een typische contactbelichtingsmodus en zijn er geen speciale maskers of apparatuur nodig, wat een uitstekende compatibiliteit vertoont met een hoge fabricageresolutie.
Pyrolytische koolstofstructuren
SU-8 is een typische voorloper voor de fabricage van koolstofmicrostructuren, terwijl andere fotoresists zoals NR26-25000P de structuren niet onder hoge temperatuur kunnen ondersteunen. Figuur 7a-c toont de gesuspendeerde SU-8-structuren, terwijl de overeenkomstige pyrolytische koolstofstructuren worden weergegeven in figuur 7d-f. Grote krimp treedt op tijdens het pyrolyseproces vanwege de meerdere gelijktijdige reacties, waaronder dehydrogenering, cyclisatie, condensatie, waterstofoverdracht en isomerisatie [8, 28]. Er zal dus een aanzienlijke restspanning bestaan in de pyrolytische structuren, vooral in de asymmetrische structuren. De pyrolytische koolstofbalken krimpen en trekken aan de pilaren aan beide uiteinden, waardoor er scheuren aan de onderkant ontstaan (Fig. 7d). Wat betreft de grootschalige mazen, de spanning handhaaft een relatief evenwicht in elke richting en er worden geen duidelijke scheuren gevonden in de pyrolytische koolstofstructuren (Fig. 7e, f). Er worden vrijstaande koolstofgaasjes met een afmeting van 12 mm × 20 mm bereikt, zoals weergegeven in Fig. 7g–i. De plaatweerstand van de koolstofmazen is ongeveer 182 Ω/sq, en de lichtdoorlatendheid bereikt ~ -67% in de hele golflengte. De zoals geprepareerde koolstofgaas met superieure geleidbaarheid en transparantie kan worden toegepast in perovskiet-zonnecellen als elektrode [29,30,31], wat een beschikbare methode biedt voor het vervaardigen van semi-transparante zonnecellen. Bovendien bezitten de geprepareerde koolstofgaasjes een uitstekende flexibiliteit, wat een groot potentieel aantoont in de toepassingen van flexibele transparante elektroden.

Hangende SU-8 mazen en pyrolytische koolstof mazen. een Hangende SU-8 balken. b , c Hangende SU-8 mazen met steunpilaren. d Opgehangen koolstofbalken, waar grote spanningen in de koolstofstructuren achterbleven en scheuren ontstonden aan de onderkant van de pilaar. e , v Hangende carbon mazen. g Vrijstaand koolstofgaas na pyrolyse. u Vergroting van het vrijstaande carbon gaas. ik Een 12 mm × 20 mm vrijstaand koolstofgaas, dat flexibiliteit en transparantie biedt. De schaalbalken zijn 100 m
Conclusies
Samenvattend hebben we de fabricage van zwevende structuren gedemonstreerd via een nieuwe eenstaps-maskergebaseerde diffractielithografiemethode. De 3D-lichtintensiteitsverdeling in de fotoresist werd gesimuleerd, waaruit blijkt dat de belichtingsdiepte toenam met de toename van de breedte van de lijnpatronen onder d < 5 μm. Dit fenomeen zou kunnen worden gebruikt om hangende structuren te fabriceren met een gedefinieerde dikte van SU-8-fotoresist, die bijna transparant was en moeilijk om hangende structuren te vormen met grijsschaallithografie. Hier werden ook de bijbehorende experimenten uitgevoerd. We ontdekten dat de dikte van de hangende SU-8-stralen heel dicht bij de simulatieresultaten lag, terwijl die van de NR26-25000P veel dunner was dan de belichtingsdiepte in de simulaties. Dit werd veroorzaakt door de hoge lichtabsorptie-eigenschap van NR26-25000P. Vervolgens werd de absorptiecoëfficiënt van fotoresist geïntroduceerd in het optische model en de simulatieresultaten kwamen goed overeen met de experimenten. Er werden drie verschillende kruisverbindingspatronen ontworpen voor het vervaardigen van hangende 3D-mazen met of zonder ondersteunende pilaren, en de oppervlaktestructuren werden goed gerepliceerd. Ook mazen met pilaren en volledig opgehangen mazen werden met succes gerealiseerd. Andere complexe 3D hangende fotoresiststructuren, waaronder hangende balken met gradiëntdikte, hangende concentrische ringen en hangende woordstructuren, werden verkregen door middel van de eenstapsmaskergebaseerde diffractielithografie.
Met koolstof gesuspendeerde structuren en vrijstaande koolstofmazen werden verder vervaardigd met een typisch tweestaps pyrolyseproces. De zwevende 3D-koolstofstructuren kunnen vanwege hun grote oppervlak worden toegepast in elektrochemische elektrodes, supercondensatoren en sensoren. De vrijstaande mazen vertoonden uitstekende geleidbaarheid, flexibiliteit en hoge transparantie. Zo hebben we een vereenvoudigde en veelbelovende methode ontwikkeld voor de fabricage van 3D-opgehangen structuren en koolstofgaas, die een groot potentieel vertoonde in de toepassingen van transparante elektrode, semitransparante zonnecellen en energieopslagapparaten.
Afkortingen
- 3D:
-
Driedimensionaal
- C-MEMS:
-
Koolstof micro-elektromechanische systemen
Nanomaterialen
- SIGHT:For the Blind
- IBM-wetenschappers vinden een thermometer uit voor de nanoschaal
- Het belang van CAD-modellen voor metaalproductieprojecten
- Wat zijn de voordelen van roestvrij staal voor fabricageprojecten?
- Wat zijn de voordelen van poedercoating voor metaalbewerkingsprojecten?
- 5 tips voor het kiezen van het juiste aangepaste fabricagebedrijf
- De beste manieren om uw fabriek voor te bereiden op een nieuwe machine
- Bedankt voor de herinneringen!
- Hoe selecteert u de juiste plaatmaterialen voor flexibele PCB-fabricage?
- Een focus op belangrijke ontwerprichtlijnen voor het gemak van PCB-fabricage
- De voordelen van zandstralen voor uw op maat gemaakte metaalproductieproject



