Strain-gecontroleerde recombinatie in InGaN/GaN meerdere kwantumputten op siliciumsubstraten
Abstract
Dit artikel rapporteert de fotoluminescentie (PL) eigenschappen van InGaN/GaN meervoudige kwantumbron (MQW) lichtemitterende diodes die zijn gegroeid op siliciumsubstraten die zijn ontworpen met verschillende trekspanningsregulerende architectuur zoals periodieke Si δ-doping op de n-type GaN-laag of het inbrengen van een InGaN/AlGaN-laag voor het onderzoeken van het spanningsgestuurde recombinatiemechanisme in het systeem. PL-resultaten toonden aan dat door trekspanning vrijgegeven monsters betere PL-prestaties hadden, aangezien hun externe kwantumefficiëntie toenam tot 17%, 7 keer groter dan die van reguliere monsters. Gedetailleerde analyse bevestigde dat ze kleinere niet-radiatieve recombinatiesnelheden hadden ((2.5~2.8)×10 −2 s −1 vergeleken met (3,6~4,7)× 10 −2 s −1 ), wat werd geassocieerd met de betere kristallijne kwaliteit en afwezigheid van dislocaties of scheuren. Bovendien bleken hun stralingsrecombinatiesnelheden stabieler en veel hoger ((5.7~5.8) ×10 −3 s −1 vergeleken met [9~7] ×10 −4 s −1 ) op kamertemperatuur. Dit werd toegeschreven aan de onderdrukking van ondiepe gelokaliseerde toestanden op MQW-interfaces, waardoor de diepe stralingslokalisatiecentra in InGaN-lagen de stralingsrecombinatie domineren.
Achtergrond
InGaN/GaN-structuren met meerdere quantumbronnen (MQW) die zijn gekweekt op siliciumsubstraten in plaats van op conventionele saffier, hebben steeds meer aandacht getrokken voor hun potentiële toepassingen in goedkope solid-state verlichting, paneelweergave en siliciumfotonica [1,2,3,4, 5]. Het kritieke obstakel bij het vervaardigen van hoogwaardige GaN-film op Si is de thermische uitzettingsmismatch (56%) tussen GaN en Si, die grote trekspanningen en scheuren in de gegroeide GaN-films veroorzaakte [6,7,8,9]. Verder is een Si-gedoteerde n-type GaN-laag onder MQW-lagen nodig voor lichtemitterende diodes (LED's) of laserdiodes (LD's). In deze gevallen zal extra trekspanning door Si-doping worden ingebracht. De afgelopen jaren zijn er pogingen gedaan om deze moeilijkheden te overwinnen door tussenlagen met geschikte drukspanning te gebruiken om de trekspanning op te vangen [10,11,12,13,14, 15,16], delta-doping voor spanningsrelaxatie [17, 18], of de op roosters afgestemde bufferlaagafzetting [19, 20]. Volgens eerdere werken [17] zou de periodieke Si δ-doteringsarchitectuur van de n-type GaN-laag een gladdere GaN-laag kunnen bereiken met een hogere kristallijne kwaliteit en een lagere scheurdichtheid dan op Si uniform gedoteerd GaN. Dit werd toegeschreven aan de vermindering van de trekspanning. Er zijn verschillende werkzaamheden verricht voor het onderzoeken van de oppervlaktemorfologie, dislocatiedichtheid en elektrische eigenschappen van kristallijne GaN/Si -dotering van GaN-lagen op saffier [21, 22] of siliciumsubstraten [23]. Helaas hebben weinigen van hen de luminescentie-eigenschappen van InGaN/GaN MQW-structuren bovenop een Si δ-doping GaN-laag direct onderzocht en de relatie verduidelijkt tussen verbetering van de luminescentie-efficiëntie en spanningsafgifte veroorzaakt door de verbeteringen aan de filmstructuur, die cruciaal zijn voor het apparaat. fabricage. Het is ook vermeldenswaard dat het moeilijk is om rechtstreeks rek te meten of roostervervormingen waar te nemen zonder de LED-monsters af te breken. Indirecte methoden worden altijd toegepast om de interne spanning te evalueren. Er werd bijvoorbeeld mechanische druk uitgeoefend om de interne spanning te moduleren, wat leidde tot de veranderingen van het piëzo-elektrische veld binnen MQW's en de opto-elektronische prestaties van LED-apparaten [24,25,26,27]. In al deze gevallen bleken luminescentiespectra-metingen onmisbaar voor het onderzoeken van de spanningsgerelateerde apparaatprestaties.
Daarom werden in dit werk InGaN/GaN MQW LED-structuren afgezet op kristallijne siliciumsubstraten. Ter vergelijking werd ofwel met Si uniform gedoteerd GaN ofwel periodiek Si δ-gedoteerd GaN, dat als n-type GaN-laag werkte, gegroeid. Verder werden nog twee controlemonsters op basis van Si uniform gedoteerde n-type GaN-lagen, ingevoegd door een dunne laag van respectievelijk AlGaN of InGaN, ook voorbereid ter ondersteuning van de analyse van de invloed van drukspanning of trekspanning op de prestaties van het apparaat, zoals AlGaN heeft een kleinere roosterconstante dan GaN, waardoor de trekspanning op het oppervlak gedeeltelijk wordt opgeheven, en de ingevoegde InGaN-laag zal de trekspanning juist verergeren. Relatieve fotoluminescentie (PL) efficiëntie en recombinatie levensduur (snelheden) voor elk monster werden geëxtraheerd uit temperatuurgevarieerde steady-state (SS) PL-spectra en tijdopgeloste (TR) PL-spectra en vervolgens systematisch geanalyseerd. De resultaten toonden aan dat door trekspanning vrijgegeven monsters betere PL-prestaties hadden, aangezien zowel de niet-stralingsrecombinatie gerelateerd aan structuurdefecten onderdrukking en stralingsrecombinatie meer verbonden zijn met diepe recombinatietoestanden in InGaN-putlagen, wat leidde tot stralingsrecombinatie die stabieler is met de temperatuur .
Methoden
Zoals getoond in het schema van Fig. 1 werd de epitaxiale groei van InGaN/GaN MQW's uitgevoerd door metaal-organische chemische dampafzetting die werd gerapporteerd in eerder werk [17]:100 nm AlN-laag, 660 nm lineair gegradeerde AlGaN-laag en 200 nm nominaal niet-gedoteerde GaN-laag werden gekweekt op het Si (111)-substraat als buffer bij respectievelijk 1060, 1060 en 1020 ° C. Voor monsters S1, S3 en S4 werd 1 μm Si uniform gedoteerde GaN-laag op de buffer afgezet met de geschatte Si-atoomconcentratie rond 10 18 cm −3 . Voor monsters S3 en S4 werd een 20 nm InGaN ingevoegde laag met In% ~ 10at% of 20 nm AlGaN ingevoegde laag met Al% ~ 20% afgezet na de n-type Si uniform gedoteerde GaN-laag. Voor monster S2 werden 20 perioden van Si δ-gedoteerde vlakken elk gevolgd door 50 nm nominaal niet-gedoteerde GaN met een totale dikte van 1 μm in plaats van een Si uniform gedoteerde GaN-laag op de buffer. Daarna werden op elk monster van S1-S4 6 perioden van InGaN / GaN QW's gekweekt bij 800 ° C, waarbij de indiumsamenstelling ongeveer 22,0 at% is. De gemiddelde dikte van de put/barrière werd geschat op 2,4 nm/10 nm. Daarna werden 220 nm Mg gedoteerde p-type GaN-lagen gekweekt bij 1020 ° C. Voor PL-spectratests werd een Zolix-750 PL-systeem met een 10 mW, 377 nm gepulseerde laser gebruikt als excitatielichtbron en een ANDOR Newton CCD met een resolutie van 0,09 nm als fotodetector. Bij TRPL-metingen werd het PL-verval geregistreerd door een tijdgecorreleerd enkel-foton-telsysteem in 10-300 K.
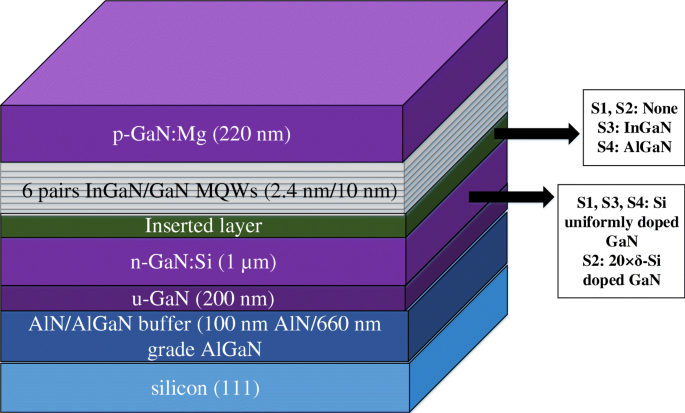
Structuren van de MQW LED-monsters gekweekt op Si-substraten. S1, S3 en S4 bevatten 1 μm Si uniform gedoteerde n-type GaN-laag. S3 bevat een ingevoegde laag van 20 nm InGaN. S4 bevat 20 nm AlGaN ingevoegde laag. S2 bevat 20 perioden van Si-δ-gedoteerde vlakken, elk gevolgd door 50 nm nominaal niet-gedoteerde GaN met een totale dikte van 1 μm in plaats van Si uniform gedoteerde n-type GaN-laag
Resultaten en discussie
Het overzicht van SSPL-eigenschappen voor elk getest MQW-monster bij 10 K wordt getoond in Fig. 2. Zoals te zien is in de bijlage, vertoont de originele MQW op Si-gestructureerde S1 emissiepieken rond 500-650 nm met Fabry-Perot-oscillatie. PL-spectra voor alle vier de monsters hebben hetzelfde karakter. Dit fenomeen wordt vaak waargenomen bij op GaN gebaseerde LED's die zijn gekweekt op Si-substraten [28,29,30], omdat de buffer/Si-interface een grote reflectie heeft, dus een opmerkelijke neerwaartse fractie van PL-intensiteit van MQW's wordt gereflecteerd en interfereert met de direct opwaartse fractie. Deze oscillatiepieken kunnen eenvoudig worden beschreven als Gaussiaanse PL-signalen vermenigvuldigd met oscillatie-item (1 + Acos (4πnd /λ )) (aangetoond als de rode curve in het invoegsel van Afb. 1), waarin A vertegenwoordigt de oscillatiesterkte, n is de gemiddelde brekingsindex van MQW-film, d is de hele dikte van MQW-film, en λ is de PL-golflengte. Volgens het bovenstaande model kan de oorspronkelijke Gaussiaanse PL-piek worden gemonteerd en geëxtraheerd uit de complexe oscillatiepieken (aangetoond als de blauwe curve in het inzetstuk van figuur 1). Het SSPL-resultaat bleek dat S1 een scherpe groene PL-piek heeft bij 531 nm, volgens de bandgap-energie van InGaN-kristal met In% ~ 22at%. Ter vergelijking:S2 met Si δ-gedoteerde n-type GaN-laag heeft een opmerkelijk roodverschoven PL-piek bij 579 nm, S3 met InGaN ingevoegde laag heeft een licht blauwverschoven PL-piek bij 517 nm, en S4 met AlGaN ingevoegde laag heeft een enigszins roodverschoven PL piek op 545 nm. Gezien het feit dat de ingevoegde AlGaN-laag de rol speelt van het vrijgeven van de trekspanning die bekend is met de functie van Si δ-doping, terwijl de ingevoegde InGaN-laag de trekspanning verergert, geven deze resultaten aan dat trekspanning op het substraat zal leiden tot de blauwverschuiving van de MQW PL-positie of vergroting van de gemiddelde bandgap van InGaN-put. Het spanningsvrijmakende effect van de Si δ-gedoteerde GaN-laag is veel sterker dan dat van de introductie van een ingevoegde laag.
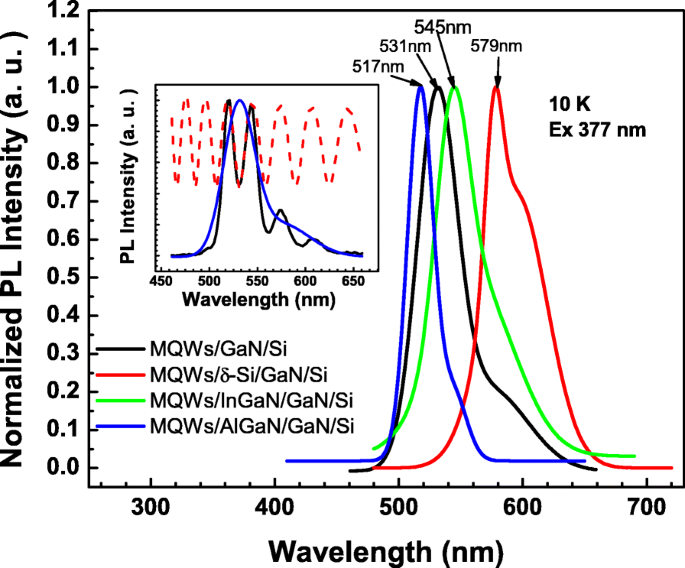
Overzicht van SSPL voor S1-S4 geëxciteerd door 377 nm laser bij 10 K. De originele PL-signalen bevatten Fabry-Perot-oscillatie die wordt weergegeven als de zwarte curve in het inzetstuk (S1 als voorbeeld). Het oscillatie-item (rode streepcurve) en Gaussiaanse PL-piek (blauwe curve) worden gesplitst door de originele signalen aan te passen. Alle PL-gegevens voor S1-S4 worden op dezelfde manier behandeld en vervolgens worden de gesplitste Gauss-PL weergegeven in de afbeelding
Om de recombinatie-aard in MQW's te begrijpen, is het van cruciaal belang om hun PL-vervaleigenschappen te testen, omdat PL-levensduren die verband houden met de recombinatiesnelheden van straling/niet-straling direct uit de vervalcurven kunnen worden geëxtraheerd. Hier werden de PL-vervalwaarden gemeten door de gedetecteerde golflengte vast te stellen op piekwaarden van S1-S4, en de metingen werden gedaan bij verschillende temperaturen variërend van 10 tot 300 K. Figuur 3 toont drie typische PL-vervalcurves voor S1 getest op 10, 100 , en 300 K. Het is gebleken dat het PL-verval voor alle S1-S4 de neiging heeft te variëren met de temperatuur. Dit fenomeen weerspiegelt de temperatuurafhankelijkheid van zowel stralingsrecombinatiesnelheden als niet-stralingsrecombinatiesnelheden in de monsters. De volgende enkele exponentiële vervalfunctie werd gebruikt om op elke vervalcurve te passen:
$$ I(t)={I}_0{e}^{-t/\tau } $$ (1)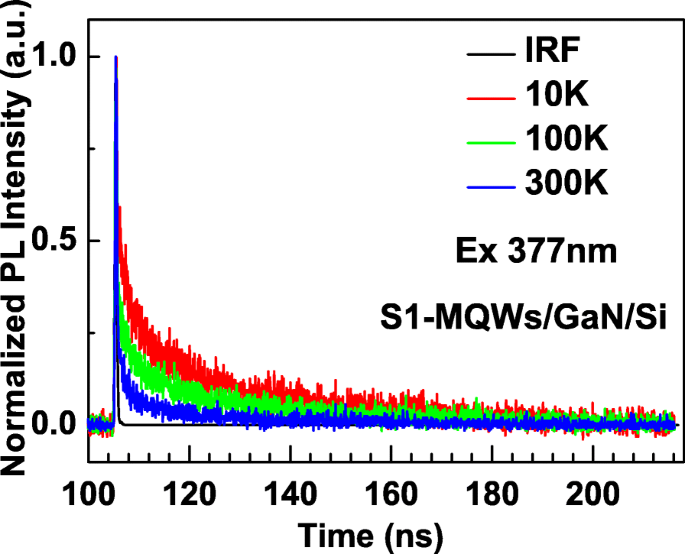
PL-vervalcurves voor S1 geëxciteerd door 377 nm gepulseerde laser bij 10 K, 100 K en 300 K
waar ik 0 vertegenwoordigt de PL-intensiteit bij t = 0 en τ vertegenwoordigt de levensduur van de PL. Het is vermeldenswaard dat niet alle vervalcurves perfect kunnen worden aangepast door de bovenstaande enkele exponentiële vervalfunctie. Dit is uitgebreid besproken door verschillende groepen [31,32,33,34]. Een redelijke aanname was dat er meerdere recombinatiecentra in het systeem bestaan. Soms werd de multi-exponentiële vervalfunctie gebruikt om de curven te passen. Om te voorkomen dat er te veel aannames worden geïntroduceerd die uiteindelijk moeilijk te verifiëren zijn, of om te voorkomen dat de analyse alleen de kleine delen van de hele PL-eigenschappen onjuist weergeeft, hebben we het eenvoudigste model gebruikt om een gemiddelde PL-levensduur voor elk monster te extraheren, die kan de algemene dynamische eigenschappen van PL weerspiegelen. De verkregen levensduren voor S1-S4 werden samengevoegd in figuur 4a. Om de dynamische PL-resultaten te verbinden met de recombinatiekans, recombinatiesnelheid k werd gedefinieerd als k = 1/τ . Spots van k versus temperatuur voor S1-S4 worden ook getoond in Fig. 4b. De resultaten laten duidelijk twee verschillende soorten evolutie van k . zien met een temperatuur dat de recombinatiesnelheden voor de door trekspanning vrijgegeven monsters S2 en S4 kleiner zijn dan die voor het oorspronkelijke monster S1 of door trekspanning verergerde monster S3 over het gehele temperatuurbereik en sterker toenemen met toenemende temperatuur. Merk op dat k = k r + k nr , waarin k r staat voor stralingsrecombinatiesnelheid en k nr vertegenwoordigt niet-radiatieve recombinatiesnelheid. Verwacht wordt dat k nr neemt toe als de temperatuur stijgt, en domineert k bij kamertemperatuur, omdat het altijd betrekking heeft op energie-uitwisselingsprocessen met warmte [35]. Dus de k resultaten bij hoge temperatuur in Fig. 4b tonen het solide bewijs dat spanningsafgifteprocessen zoals Si δ-doping en AlGaN-insertie positieve invloeden hebben op het onderdrukken van niet-stralingsrecombinatie in MQW's door het verminderen van dislocatiedefecten of scheuren die grote invloed hebben op k nr . Maar k r wordt niet te verwaarlozen bij lage temperatuur. Daarom is aanvullende informatie en verdere analyse nodig om het gedrag van k . te verklaren bij lage temperatuur.

een PL-levensduur versus temperatuur voor S1-S4. De gedetecteerde golflengte wordt op elke piekpositie gehouden volgens de SSPL-resultaten in figuur 2. b Overeenkomstige recombinatiesnelheden voor S1-S4, die worden verkregen door k = 1/τ
Dus voor het splitsen van k r en k nr van elke k waarde, werden SSPL-spectra op verschillende temperatuuromstandigheden voor elk monster gemeten. Vervolgens werd de intensiteit van elke PL-piek die overeenkomt met hun gedetecteerde golflengten bij eerdere TRPL-tests geregistreerd als I (T ). Daarna werd de relatieve PL-efficiëntie gedefinieerd als η = Ik (T )/Ik 0 , waarin ik 0 vertegenwoordigt PL-intensiteit bij 0 K. De verkregen PL-efficiënties voor S1-S4 werden samengevoegd in Fig. 5a. Er kan worden vastgesteld dat de PL-efficiëntie voor S2 en S4 beide ongeveer 17% is, wat 7 keer groter is dan die van S1. Het is bekend dat alleen stralingsrecombinatie bijdraagt aan de PL-intensiteit; daarom weerspiegelt deze relatieve PL-efficiëntie de verhouding van de stralingsrecombinatiesnelheid in de totale recombinatiesnelheid:
$$ \eta ={k}_r/\left({k}_r+{k}_{nr}\right)={k}_r/k $$ (2)
een Relatieve PL-efficiëntie versus temperatuur voor S1-S4. De gedetecteerde golflengte wordt op elke piekpositie gehouden volgens de SSPL-resultaten in figuur 2. b Totale recombinatiesnelheid, stralingsrecombinatiesnelheid en niet-stralingsrecombinatiesnelheid versus temperatuur voor S1
Het is dus in staat om k . op te lossen r = kη en k nr = k (1 − η ) van de TRPL-resultaten gecombineerd met η . De respectievelijke berekening voor k r en k nr van S2 werd als voorbeeld getoond in Fig. 5b. De resultaten toonden aan dat zelfs voor S2 met Si δ-dopingmodificatie, de niet-stralingsrecombinatiesnelheid groter is dan de stralingsrecombinatiesnelheid tot een zeer lage temperatuur van 50 K. Dit verklaart de reden waarom k blijft toenemen als de temperatuur stijgt omdat het dominant is in k nr . Het geeft ook aan dat er veel vraag is naar verdere verbetering van de kristallijne kwaliteit voor MQW op Si-structuren. De stralingsrecombinatiesnelheid k r bleek monotoon af te nemen met de groeitemperatuur, wat niet overeenkomt met de typische PL-eigenschappen die ontstaan door recombinatie van vrije elektron-gatparen die k r is vrij van temperatuur. Het is echter redelijk als het PL-proces dominant is in de lokalisatie van excitonen. Excitonen hebben de neiging om te delokaliseren in een hoger temperatuurbereik; als gevolg hiervan zal een stijging van de temperatuur leiden tot een afname van de lokalisatiesnelheid [32]. k nr en k r versus temperatuur voor S1-S4 werden respectievelijk samengevat in Fig. 6a, b. Zoals getoond, zijn de resultaten van k nr bij 300 K voor S2 en S4 zijn 2,5×10 −2 s −1 en 2,8 ×10 −2 s −1 , die lager zijn dan die voor S1 (3,6 ×10 −2 s −1 ) en S4 (4,7 ×10 −2 s −1 ). Deze bevestigen verder dat spanningsafgifteprocessen de vorming van dislocatie en scheuren in MQW's onderdrukken, en bijgevolg de dichtheden van niet-radiatieve recombinatiecentra verminderen. Dit onderdrukkingseffect wordt gevoeliger wanneer de temperatuur daalt. De verkregen k r resultaten zijn ingewikkelder. Zoals getoond, k r voor S1 en S3 dalen veel sterker dan die voor S2 en S4 na temperatuurstijging. Als resultaat verkregen k r bij 300 K voor S2 (5,7×10 −3 s −1 ) en S4 (5.8 ×10 −3 s −1 ) zijn veel hoger dan die voor S1 (9×10 −4 s −1 ) en S3 (7 ×10 −4 s −1 ). Het is redelijk om dit fenomeen toe te schrijven aan de spanningsafgifteprocessen:volgens de bovenstaande discussie zijn de stralingsprocessen in deze MQW-monsters voornamelijk gerelateerd aan exciton-recombinatie in gelokaliseerde toestanden. Hier, k r wordt voornamelijk bepaald door de lokalisatiesnelheid van excitonen k loc . De dramatische achteruitgang van k loc met groeiende temperatuur geeft aan dat de gemiddelde diepte van gelokaliseerde toestanden relatief klein is in het systeem, waardoor het exciton gemakkelijk te delokaliseren is bij hoge temperatuur. Met andere woorden, de gemiddelde diepten van gelokaliseerde toestanden in monsters met spanningsvrijgave als S1 en S3 zijn kleiner dan die zonder spanningsvrijgave. Gebaseerd op de eerdere werken [36], worden de gelokaliseerde stralingsrecombinatiecentra in InGaN/GaN MQW's vaak geboden door structurele defecten in InGaN-putlagen, zoals putdiktevariaties en indiumrijke clusters, waarin putdiktevariaties ondiepe toestanden bieden evenals indiumrijke clusters bieden staten met veel diepere diepten [33]. Hier het resultaat van k r geeft aan dat sterke trekspanning op MQW-interfaces geleid door Si-substraat en Si-gedoteerde GaN de vorming van ondiepe structurele defecten door straling kan verbeteren, dus de diepte van gelokaliseerde toestanden voor S1 en S3 is kleiner en diktevariaties zijn dominant in de exciton-lokalisatieprocessen . Voor S2 en S4 worden de variaties van de putdikte onderdrukt, dus de excitonlokalisatieprocessen zijn dominant in de diepe toestanden binnen InGaN-putten, met veel grotere gemiddelde diepten van gelokaliseerde toestanden en stabielere k r versus temperatuur. Bijgevolg demonstreren monsters S1 en S3 een hogere k r dan S2 en S4 aan de lage temperatuurzijde waar het excitondelokalisatie-effect zwak is, maar veel kleiner k r bij kamertemperatuur.

een Niet-radiatieve recombinatiesnelheden versus temperatuur voor S1-S4. b Stralingsrecombinatiesnelheden versus temperatuur voor S1-S4
Conclusies
Samenvattend werden temperatuurgevarieerde SSPL- en TRPL-spectra bestudeerd voor verschillende InGaN/GaN MQW's op Si-structuren met of zonder behandelingen voor het opheffen van trekspanning. Er werd gevonden dat het monster met Si δ-doping GaN-laag of AlGaN-ingevoegde laag een kleinere recombinatiesnelheid en hogere PL-efficiëntie (tot 17%) had dan het reguliere monster (2,5%) of monster met InGaN-ingevoegde laag (1,6%). Nadere analyse verduidelijkte dat de kleinere recombinatiesnelheden voornamelijk werden geleid door kleinere dominante niet-radiatieve recombinatiesnelheden (2,5 ×10 −2 s −1 voor δ-dopingmonster, 3,6 ×10 −2 s −1 voor AlGaN-ingevoegd monster vergeleken met 3,6 ×10 −2 s −1 voor normaal monster en 4,7 ×10 −2 s −1 voor InGaN ingevoegd monster), die toe te schrijven waren aan de onderdrukking van de vorming van dislocaties of scheuren. Naast kleinere niet-stralingsrecombinatiesnelheden, werden de betere PL-prestaties ook geleid door de stralingsrecombinatiesnelheden die stabieler en hoger waren bij kamertemperatuur (5,7 ×10 −3 s −1 voor δ-dopingmonster, 5,8 ×10 −3 s −1 voor AlGaN-ingevoegd monster vergeleken met 9 ×10 −4 s −1 voor normaal monster en 7 ×10 −4 s −1 voor InGaN ingevoegd monster). Ze waren ook toe te schrijven aan de onderdrukking van variaties in putdikte op MQW-interfaces, waardoor de diepe stralingslokalisatiecentra in InGaN-lagen het stralingsrecombinatieproces domineren. De bovenstaande resultaten lieten een duidelijk beeld zien van de recombinatieprocessen van InGaN/GaN MQW LED-apparaten op siliciumsubstraten, die de fabricage van het apparaat in de toekomst kunnen leiden.
Afkortingen
- IQE:
-
Interne kwantumefficiëntie
- LD:
-
Laserdiode
- LED:
-
Lichtgevende diode
- MQW:
-
Meerdere kwantumbronnen
- PL:
-
Fotoluminescentie
- SSPL:
-
Steady-state fotoluminescentie
- TRPL:
-
Tijdsopgeloste fotoluminescentie
Nanomaterialen
- Quantum Transport Goes Ballistic
- Qubits met één atoom onder een microscoop bouwen
- Nanosilicium om waterstof te produceren
- Nanocoating voor meerdere kleuren
- Nano grafeem, op silicium gebaseerd flexibel transparant geheugen
- De atoomherschikking van op GaN gebaseerde meerdere kwantumbronnen in H2/NH3 gemengd gas voor het verbeteren van structurele en optische eigenschappen
- Meerkleurige emissie van op ultraviolet GaN gebaseerde fotonische quasicrystal nanopiramidestructuur met semipolaire InxGa1−xN/GaN meerdere kwantumbronnen
- Glijdende snelheidsafhankelijke tribochemische slijtage van oxidevrij silicium
- Bismut Quantum Dots in gegloeide GaAsBi/AlAs Quantum Wells
- Onderzoek naar oppervlaktepolarisatie van Al2O3-capped GaN/AlGaN/GaN heterostructuur door middel van hoek-opgeloste röntgenfoto-elektronspectroscopie
- Optimale siliciumdoteringslagen van kwantumbarrières in de groeireeks die een zacht opsluitingspotentieel vormen van acht-periode In0.2Ga0.8N/GaN Quantum Wells of Blue LED's



