Verandering in oppervlaktegeleiding van elastisch vervormde p-Si-kristallen bestraald door röntgenstralen
Abstract
Veranderingen in geleidbaarheid van bestraalde en niet-bestraalde p-Si monokristallen onder invloed van elastische uniaxiale mechanische spanning werden in dit artikel onderzocht. Er werd een analytische uitdrukking voorgesteld om de afhankelijkheid van oppervlaktegeleidbaarheid te beschrijven als een functie van mechanische spanning en röntgenstralingsdosis. Er werd aangetoond dat 4-hoekige nanodeeltjes op het oppervlak van "zonne" silicium de elektrogeleidingsveranderingen onder mechanische belasting beïnvloeden. Er werd vastgesteld dat röntgenstraling de vorming van puntdefecten in silicium veroorzaakt. Deze defecten onderdrukken de beweging van de dislocaties. Er werd aangetoond dat de soortelijke weerstand van eerder bestraalde monsters van "elektronisch" silicium slechts in geringe mate gevoelig is voor de invloed van uniaxiale compressie bij een bepaalde vervormingssnelheid.
Achtergrond
Een wijdverbreid gebruik van halfgeleiderinrichtingen op het gebied van moderne elektronische technologieën vereist onderzoek van nieuwe halfgeleidende materialen die een hoge stabiliteit bezitten onder invloeden van buitenaf, zoals röntgenstraling en mechanische vervorming. Tegenwoordig wordt silicium actief gebruikt in zeer gevoelige detectoren en andere halfgeleidersensoren die in de stralingsvelden werken [1].
De meeste artikelen zijn gewijd aan de impact van plastische vervorming op de geleidbaarheid van n-Si [2, 3]. Daarom wordt de impact van elastische vervorming op de eigenschappen van p-Si-kristallen nog steeds als een belangrijke wetenschappelijke taak beschouwd. Herverdeling van de concentratie van dragers en onzuiverheden in vervormde kristallen worden vaak gekenmerkt door de aanwezigheid van dislocaties die een effectieve oorzaak zijn van defecten, vooral op het oppervlak van het kristal [4, 5]. Het is bekend [3, 6] dat de excitatie van elektronische kristalsubsystemen ook gepaard gaat met de overeenkomstige veranderingen in de dislocatiemobiliteit. Excitatie van de elektronische subsystemen kan het gevolg zijn van externe invloeden, zoals straling en elektrostatisch veld. Kenmerkend voor dislocaties in siliciumkristallen is de aanwezigheid van puntdefecten (Cottrell cloud) met een hoge concentratie rondom dislocaties.
Het oppervlak van de kristallen is het meest gevoelig voor ioniserende straling. Daarom wordt het onderzoek naar stralingsgeïnduceerde processen op de oppervlaktelagen van siliciumkristallen nog steeds relevant geacht. Het oppervlak met de afgezette Al-contacten is een effectieve getter voor de structurele defecten [5,6,7]. Onder de afgezette metaalfilm verschijnen de mechanische spanningen als gevolg van inconsistenties in de roosterparameters van de film en de halfgeleider [5, 7]. Deze spanningen stimuleren de processen van het weghalen van defecten (onzuiverheidsatomen, interstitiële siliciumatomen en vacatures) in de contactlaag.
Methoden
Monokristallen van silicium met geleidbaarheid van het p-type, gegroeid met de Czochralski-methode (ρ = 10–20 Ω cm), werden gebruikt in het onderzoekspaper. Deze monokristallen zijn van twee soorten:(1) silicium voor elektronica - de zogenaamde dislocatievrije (of elektronische) monokristallen op het oppervlak (111) waarvan de concentratie driehoekige etsputten niet groter is dan 10 2 cm −2 (Fig. 1a en 2), en (2) "zonne" monokristallen van silicium op het oppervlak (111) waarvan de defecten in de vorm van 4-hoekige piramides (Fig. 1b) werden ontdekt als gevolg van een relatief grote concentratie van de achtergrondkoolstof (≈5 × 10 16 cm −3 ) en zuurstof (≈1.8 × 10 18 cm −3 ) onzuiverheden. Vierhoekige piramides bevinden zich op dezelfde manier. De grootte van de piramidebasis is van 10 nm tot 10 μm.
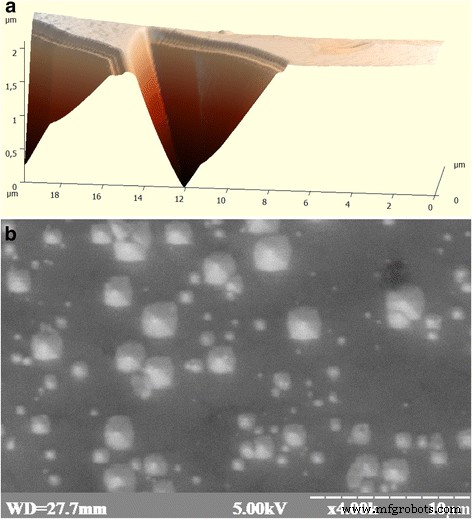
Het uiterlijk van het oppervlak van de experimentele monsters:a verschijning van dislocatie-etsputten op het oppervlak van het p-Si-kristal verkregen op het gebied van atomaire krachtmicroscoop en b verschijning van submicroscopisch oppervlak (111) van zonnekristallen

Afhankelijkheid van longitudinale weerstand van primair dislocatievrij monster tijdens de elastische vervorming met de vervormingssnelheid 8 μm/min
Er werd aangetoond [8, 9] dat bij de vorming van clusters, die overeenkomen met 4-hoekige piramidale etsgaten, oxidelagen van silicium, puntdefecten en lagen met verschillende structurele toestanden van silicium, in het bijzonder alfa-silicium, kunnen deelnemen.
Experimentele monsters verkregen afmetingen 4 × 3.7 × 7.6 mm na schuren en chemisch polijsten. Ohmse contacten in de vorm van twee strips met een breedte van 1,5 mm aan de uiteinden van de monsteroppervlakken (111) werden gecreëerd door thermische verdamping van aluminium in een vacuüm (10 −4 Pa) bij verhitting tot 593 K-monster. Meting van elektrische geleidbaarheid werd uitgevoerd in een vacuüm cryostaat bij restgasdruk 10 −3 Pa bij toepassing van uniaxiale compressie op de uiteinden (naar [\( 11\overline{2} \)]) met een vermogen van 15 tot 40 MPa en een vervormingssnelheid van 8 of 32 μm/min. De monsters werden bestraald met een volledige reeks röntgenstraling (W -anode, 50 kV, 10 mA), aan beide zijden, waarop aluminium contacten zijn gecoat. De afstand tussen de bron van röntgenstralen en kristallen was minimaal (1-2 mm). Het bleek dat de geabsorbeerde dosis elke 30 minuten met 130 Gy toenam. In het werk hebben we eerst de experimentele monsters bestraald en daarna hebben we de weerstand in het vervormingsproces gemeten.
Resultaten en discussie
Het onderzoeksresultaat over de verandering van geïnduceerde mechanische geleidbaarheid langs de richting van vervorming (ρ (σ )) van "dislocatievrije" monsters van p-type geleidbaarheid onder invloed van uniaxiale spanning (σ ) is weergegeven in Fig. 2. De toename van de belasting van 0 tot 40 MPa (bij een vervormingssnelheid van 8 μm/min) duurt 45 min.
Tijdens het vervormingsproces neemt de weerstand van dislocatievrije monsters enigszins toe. Opgemerkt moet worden dat in het geval van niet-bestraalde kristallen de verandering van de vervormingssnelheid praktisch geen effect had op het algemene beeld van afhankelijkheden ρ (σ ) [10, 11]. Soortgelijke afhankelijkheden werden verkregen voor bestraalde monsters (figuur 3). Een toename van de weerstand werd waargenomen na de inwerking van röntgenstraling. Echter, de aard van afhankelijkheid ρ (σ ) bleek iets anders te zijn dan voor niet-bestraalde monsters.
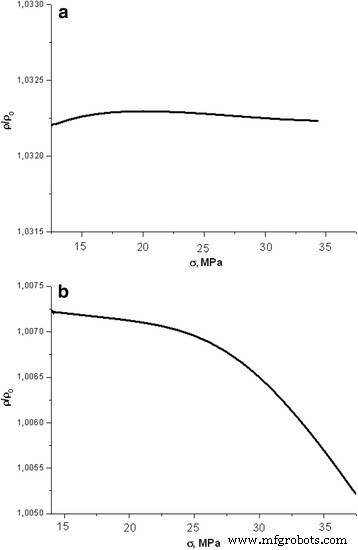
Afhankelijkheid van longitudinale weerstand van bestraalde (D = 130 Gy) dislocatievrij monster van silicium tijdens elastische vervorming met een toenemende compressiesterkte met een snelheid van 8 μm/min (a ) en 32 μm/min (b )
Te zien is dat de weerstand vrijwel onveranderlijk blijft (Fig. 3a) tijdens compressie met een snelheid van 8 m/min vanwege het effect van röntgenstraling. De grafieken van afhankelijkheden van monsters die waren blootgesteld aan 260 en 480 Gy hadden een vergelijkbaar uiterlijk. In eerdere onderzoeken [11] is aangetoond dat de weerstand tijdens het bestralingsproces proportioneel toenam met de vierkantswortel van de geabsorbeerde dosis.
Een viervoudige toename van de compressiesnelheid (van 8 tot 32 m/min) leidt tot veranderingen in de aard van de afhankelijkheid van de soortelijke weerstand van de belasting (figuur 3b). Er is een kleine (<0,2%) afname in de weerstand van bestraalde monsters tijdens het compressieproces. Opgemerkt moet worden dat alle metingen aan geleidbaarheidsveranderingen zijn uitgevoerd met een hoge mate van nauwkeurigheid (±0,045%) zodat het mogelijk was om kleine veranderingen in weerstand in het experiment correct te analyseren.
Opgemerkt moet worden dat de afhankelijkheid, weergegeven in Fig. 3, 7 dagen na het meten van veranderingen in de longitudinale weerstand is ontvangen (D = 130 Gy) van dislocatievrije monsters met een snelheid van 8 m/min (figuur 3a). Gedurende het gegeven tijdsbestek keerde de weerstand bijna terug naar zijn oorspronkelijke waarde, d.w.z. de waarde van weerstand, die werd waargenomen na de bestraling en de toepassing van mechanische spanning.
Vergelijkbare onderzoeken naar het meten van de weerstandsafhankelijkheid van de werking van elastische compressie en na blootstelling aan straling werden ook uitgevoerd (Fig. 4) voor experimentele monsters op basis van "zonne-silicium" van p-type geleidbaarheid, waaraan inherente 4-hoekige piramides op het oppervlak (111).
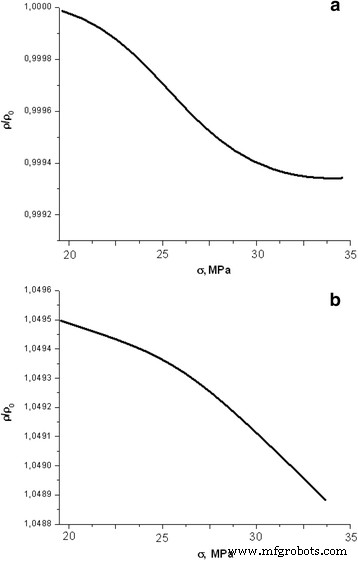
Afhankelijkheid van longitudinale weerstand van zonne-silicium tijdens elastische vervorming met een toenemende druksterkte:a D = 0 Gy, compressiesnelheid 32 μm/min; b D = 130 Gy-compressiesnelheid 8 μm/min
Allereerst werd gevonden dat de aard van de weerstandsverandering van "zonne" silicium van het p-Si-type op de grootte van de mechanische spanning onafhankelijk is van de snelheid van compressie. Een soortgelijk kenmerk werd waargenomen in zowel niet-bestraalde als bestraalde monsters. De afhankelijkheid van de longitudinale weerstand van mechanische spanning verandert met een relatief kleine waarde (<0,5%), en deze neemt iets af bij toenemende belasting (Fig. 4a).
Bestraling van experimentele monsters met röntgenstralen (480 Gy) heeft vrijwel geen invloed op de algemene aard van de verandering in longitudinale weerstand van "zonne" silicium tijdens de elastische vervorming (figuur 4b). Wat elektronische monsters betreft, is de weerstand evenredig met de vierkantswortel van de geabsorbeerde dosis [11]. Tijdens de mechanische belasting neemt de soortelijke weerstand af met een zeer kleine waarde (±0,1%).
Zoals is aangetoond in onze eerdere studies [12, 13], is de diëlektrische film SiO2 heeft een positieve lading. Daarom is de oppervlaktelaag van de ruimtelading uitgeput in gaten (met hoge weerstand) en met een dikte w (Fig. 5) is gemaakt in silicium. Hoe dichter de Si-SiO2 naar de interface, hoe minder gaten er zijn.

Vervorming van de energiebanden in de p-type geleider onder verschafte positieve lading op het grensvlak van halfgeleider-isolator
De concentratie van gaten in de oppervlaktelaag van silicium en bijgevolg de geleidbaarheid verandert bij verandering van de oppervlaktepotentiaal (φ S ). Laten we eens kijken naar een vlakke vierkante plaat (Fig. 6). Laat de stroom evenwijdig lopen aan het vlak van de plaat in de richting van een van zijn randen.

Berekeningen van geleidbaarheid
Er is een dunne parallelle laag genomen met een dikte dy en dwarsdoorsnede dS [14] op enige afstand (y ) van het oppervlak. Deze laag kan worden beschouwd als een homogene halfgeleider, waarvan de weerstand kan worden bepaald met de volgende formule:
$$ d R=\rho \frac{l}{dS}, $$ (1) $$ d S=a d y. $$ (2)Omdat de plaat vierkant is (l = een ), de geleidbaarheid van de laag is
$$ d\lambda =\frac{1}{dR}=\sigma d y, $$ (3)waarbij \( \sigma =\frac{1}{\rho} \) de elektrische geleidbaarheid is van de laag met dy dikte bij y afstand van het oppervlak. Voor een p-type halfgeleider kan de geleidbaarheid worden geschreven als \( \sigma \circa e p(y){\mu}_p \). Dan krijgen we
$$ d\lambda =e p(y){\mu}_p dy. $$ (4)Laten we de totale oppervlaktegeleiding vinden (λ ). Je moet de laatste uitdrukking integreren in het bereik van nul tot een dikte van meerdere duurzame Debye-screening, of, bijvoorbeeld, de breedte van het ruimteladingsgebied beperken w :
$$ \lambda ={\displaystyle \underset{0}{\overset{w}{\int }} ep(y){\mu}_p dy=e{\mu}_p{\displaystyle \underset{0}{ \overset{w}{\int }} p(y) dy}}. $$ (5)Over het algemeen hangt de concentratie van gaten in de uitgeputte oppervlaktelaag niet alleen af van de coördinaten (y ) maar ook op de uitgeoefende mechanische spanning (σ meh ). Het wordt bepaald door twee componenten:p (j , σ meh ) = p 1 (j ) − p 2 (σ meh ), waarbij p 1 (j ) is een component die overeenkomt met een verandering in de dragerconcentratie met de verandering van de afstand tot het oppervlak van de halfgeleider en p 2 (σ meh ) is een component die laat zien met hoeveel de concentratie van gaten wordt verminderd als gevolg van hun opname op dislocaties tijdens de mechanische belasting. Bovendien is de mobiliteit van gaten geen constante waarde. Het hangt af van de mechanische belasting. Daarom kan de uitdrukking voor de totale oppervlaktegeleidbaarheid in de volgende vorm worden geschreven:
$$ \lambda =e{\mu}_p\left({\sigma}_{meh}\right){\displaystyle \underset{0}{\overset{w}{\int }}\left({p} _1(y)-{p}_2\left({\sigma}_{meh}\right)\right) dy}. $$ (6)Mechanisch geïnduceerde verandering in geleidbaarheid kan als volgt worden geschreven:
$$ \lambda \left({\sigma}_{meh}\right)=e{\mu}_p\left({\sigma}_{meh}\right)\cdot \Big({\displaystyle \underset{ 0}{\overset{w}{\int }}{p}_1(y) dy-{\displaystyle \underset{0}{\overset{w}{\int }}{p}_2\left({\ sigma}_{meh}\right) dy}\Big)=e{\mu}_p\left({\sigma}_{meh}\right)\cdot \left\{{\beta}_1-{\beta }_2\left({\sigma}_{meh}\right)\right\}}, $$ (7)waarbij \( {\beta}_1={\displaystyle \underset{0}{\overset{w}{\int }}{p}_1(y) dy;\kern1em {\beta}_2\left({\sigma }_{meh}\right)={\displaystyle \underset{0}{\overset{w}{\int }}{p}_2\left({\sigma}_{meh}\right) dy}}={p}_2\left({\sigma}_{meh}\right){\displaystyle \underset{0}{\overset{w}{\int }} dy=} w\cdot {p}_2\left( {\sigma}_{meh}\right) \).
Opgemerkt moet worden dat sinds p 1 (j ) en p 2 (σ meh ) hangen ook af van het bestralingseffect, de factoren β 1 , β 2 , en μ p afhankelijk van de dosis röntgenstraling. Daarom is de formule voor oppervlaktegeleidbaarheid voor (λ (σ meh ,0 )) en na (λ (σ meh ,D )) bestraling kan als volgt worden geschreven:
$$ \lambda \left({\sigma}_{meh},0\right)=e{\mu}_p\left({\sigma}_{meh},0\right)\cdot \Big({\ displaystyle \underset{0}{\overset{w}{\int }}{p}_1\left( y,0\right) dy- w\cdot {p}_2\left({\sigma}_{meh} ,0\right)\Big)=e{\mu}_p\left({\sigma}_{meh},0\right)\cdot \left\{{\beta}_1(0)-{\beta} _2\left({\sigma}_{meh},0\right)\right\}}. $$ (8) $$ \lambda \left({\sigma}_{meh}, D\right)=e{\mu}_p\left({\sigma}_{meh}, D\right)\cdot \Big({\displaystyle \underset{0}{\overset{w}{\int }}{p}_1\left( y, D\right) dy- w\cdot {p}_2\left({\sigma }_{meh}, D\right)\Big)=e{\mu}_p\left({\sigma}_{meh}, D\right)\cdot \left\{{\beta}_1(D) -{\beta}_2\left({\sigma}_{meh}, D\right)\right\}}. $$ (9)Als het monster een rechthoekige vorm heeft met een lengte (l ) en breedte (a ), kunnen we de uiteindelijke formule voor de totale oppervlaktegeleidbaarheid als volgt schrijven:
$$ \lambda \left({\sigma}_{meh}, D\right)=\frac{a}{l} e{\mu}_p\left({\sigma}_{meh}, D\right )\left\{{\beta}_1(D)-{\beta}_2\left({\sigma}_{meh}, D\right)\right\}, $$ (10)waar
$$ {\beta}_1(D)={\displaystyle \underset{0}{\overset{w}{\int }}{p}_1\left(y, D\right) dy,\kern1em}{\ beta}_2\left({\sigma}_{meh}, D\right)=w\cdot {p}_2\left({\sigma}_{meh}, D\right). $$ (11)De verandering van oppervlaktegeleidbaarheid van bestraalde p-Si-kristallen onder invloed van mechanische spanning wordt voornamelijk bepaald door de verandering van drie parameters:β 1 , β 2 , en μ p .
Volgens onze eerdere studies [10,11,12,13], gaat het effect van röntgenblootstelling aan het elektronische silicium gepaard met een lichte toename van de positieve lading in de diëlektrische oppervlaktelaag van SiO2 . Het resultaat is dat de factor β 1 :β 1 (D ) > β 1 (0 ) lichtjes toe. Voor het "zonne" silicium worden tegengestelde afhankelijkheden waargenomen:β 1 (D ) < β 1 (0 ).
Over de factor β 2 , worden de wijzigingen voornamelijk bepaald door de wijziging van p 2 (σ meh , D ) onder stralingseffect. Deze wijzigingen zijn veel ingrijpender in vergelijking met de wijziging van de parameter β 1 . Röntgenstraling veroorzaakt het genereren van puntdefecten in silicium, die fungeren als stoppers voor dislocatiebeweging. Dientengevolge, na de blootstelling aan straling, de factor β 2 voor deze monsters neemt sterk af (vermindert het aantal opgesloten gaten in de dislocatie) voor beide soorten experimentmonsters p-Si:β 2 (D ) < β 2 (0 ).
In niet-bestraalde kristallen van "zonne" silicium, spelen de bestaande defecten, die overeenkomen met 4-hoekige piramidale etsputten, de rol van stoppers voor dislocatiebeweging. Bijkomende defecten veroorzaakt door bestraling speelden geen significante rol op de achtergrond van een sterke concentratie van bestaande oppervlaktedefecten.
De mobiliteit van gaten neemt iets af tijdens blootstelling aan straling door de toename van de verstrooiing bij stralingsdefecten:μ p (D ) < μ p (0 ). Door dit mechanisme kan de experimenteel bevestigde afname van de geleidbaarheid van bestraalde siliciummonsters worden verklaard. Zo bevestigt een analyse van de formules (8) en (9) de groei van de weerstand onder de toename van de waarde van de geabsorbeerde dosis röntgenstraling, voornamelijk door de mobiliteit te verminderen (μ p (D ) < μ p (0 )) en de concentratie van gratis dragers - gaten (β 2 (D ) < β 2 (0 )).
Als we de vergelijkingsgegevens met een vaste dosis beschouwen, kunnen we de volgende conclusies trekken, die de hierboven gegeven experimentele afhankelijkheden van de weerstand tegen mechanische stress bevestigen:
- 1.
De weerstand van niet-bestraalde monsters van elektronisch silicium neemt toe onder compressie (figuur 2). Dit gebeurt als gevolg van een aanzienlijke groei van factor β 2 onder invloed van mechanische belasting. Tijdens compressie, de verandering (groei) van factor β 2 aanzienlijk groter is dan de verandering (toename) in mobiliteit van gaten onder de toename van mechanische belasting. Wat betreft de parameter β 1 , de waarde ervan is niet afhankelijk van σ meh .
Dus in ons geval kan de toename van weerstand (compressie) en afname (decompressie) van de belasting voor niet-bestraalde kristallen op basis van elektronisch silicium worden verklaard door de beweging van dislocaties, die de belangrijkste dragers overnemen. Krachten die beweging van defecten, de coagulatie van clusters en de condensatie van clusters op dislocaties [15] veroorzaken, verschijnen in het elastisch vervormde kristalrooster. Defecten worden centra van het vangen van grote dragers terwijl ze coaguleren in grotere clusters als microporiën, clusters van internodiënsilicium en onzuiverheden. De opeenhoping van defecten in de oppervlaktelaag van silicium heeft de neiging om zijn geleidbaarheid te verminderen. Het wordt weergegeven door overeenkomstige groeifactor β 2 in de formule voor de oppervlaktegeleidbaarheid.
- 2.
De weerstand van bestraalde monsters van elektronisch silicium verandert enigszins onder compressie (figuur 3a). Dit wordt veroorzaakt door de vermindering van verandering (groei) van factor β 2 , als gevolg van belemmerde dislocatiebeweging. Met andere woorden, wederzijds concurrerende veranderingen van parameters β 2 en μ p zijn evenredig onder compressie van bestraalde monsters van elektronisch silicium.
Weerstandsvermindering van elektronische siliciumkristallen in combinatie met spanningstoename (figuur 3b) treedt op als gevolg van de afname van de longitudinale effectieve massa van zware gaten [16, 17] en een overeenkomstige toename van hun mobiliteit onder compressie. Dit wordt weergegeven door overeenkomstige mobiliteitstoename μ p in de formule voor de oppervlaktegeleidbaarheid.
- 3.
De weerstand van bestraalde en niet-bestraalde monsters van zonne-silicium neemt enigszins af onder compressie (figuur 4). Dislocatie bewegingsproces is erg moeilijk voor deze experimentele monsters. Bovendien leveren extra defecten die zich verplaatsen van het midden naar het oppervlak van silicium de niet-essentiële bijdrage aan het huidige transport tegen de achtergrond van een hoge concentratie van bestaande oppervlaktedefecten in kristallen van zonne-silicium. De werking van straling verhoogt bovendien de concentratie van oppervlaktedefecten in kristallen van zonne-silicium. Dus, wederzijds concurrerende veranderingen van parameters β 2 en μ p zijn evenredig onder compressie van bestraalde en niet-bestraalde monsters van zonne-silicium.
Het effect van straling (figuur 4b) verhoogt bovendien de concentratie van oppervlaktedefecten in kristallen van zonne-silicium. Daarom leveren extra defecten, die door getteren in beweging zijn, een kleine bijdrage aan het huidige transport dan voor niet-bestraalde kristallen.
Conclusies
Tijdens de mechanische belasting moet rekening worden gehouden met twee hoofdfactoren die de weerstand van p-Si-kristal beïnvloeden. De eerste factor is een toename van de weerstand met een toename van de belasting (compressie) en een afname van de weerstand met een afname van de belasting (ontgrendelen) als gevolg van het proces van dislocatiebeweging, dat de belangrijkste dragers overneemt. De tweede factor is de afname van de weerstand van siliciumkristallen met een toename van de belasting als gevolg van de afname van de effectieve massa van gaten en een overeenkomstige toename van hun mobiliteit.
Röntgenstraling veroorzaakt het ontstaan van vacatures en interstitiële atomen in silicium, die fungeren als stoppers voor de beweging van dislocaties. Door de toename van verstrooiing van stralingsdefecten neemt de mobiliteit van gaten tijdens röntgenbestraling enigszins af. In niet-bestraalde kristallen van zonne-silicium spelen de bestaande defecten de rol van stoppers voor de beweging van dislocaties.
Voorbestraalde experimentele p-Si-kristallen (elektronisch en "op zonne-energie gebaseerd" silicium) hebben de eigenschap om de soortelijke weerstand (±0,2%) enigszins te veranderen onder invloed van uniaxiale compressie (snelheid van spanningstoevoer 8 μ/min), binnen de elastische vervorming langs de stroom [\( 11\overline{2} \)].
In de voorbestraalde elektronische p-Si-monsters hangt de afhankelijkheid van de weerstand van uniaxiale mechanische spanning aanzienlijk af van de mate van compressie. Bij een lage snelheid van spanningstoevoer (8 m / min), neemt de weerstand toe met de toename van mechanische spanning; bij hoge snelheden (32 m/min), neemt af. Voor kristallen op basis van p-type silicium op zonne-energie is de afhankelijkheid van weerstand onder mechanische belasting onafhankelijk van de compressiesnelheid.
Afkortingen
- ρ (σ ):
-
De verandering van geïnduceerde mechanische geleidbaarheid in de richting van vervorming
Nanomaterialen
- Silicium
- Apparaat wijzigen
- Atomen afbeelden op 2D-atoomkristallen in vloeistoffen
- Nanosilicium om waterstof te produceren
- Nano grafeem, op silicium gebaseerd flexibel transparant geheugen
- Oppervlakte-effect op olietransport in Nanochannel:een onderzoek naar moleculaire dynamiek
- Glijdende snelheidsafhankelijke tribochemische slijtage van oxidevrij silicium
- Synthese van elektrisch geleidende silica nanovezel/gouden nanodeeltjescomposiet door laserpulsen en sputtertechniek
- Afhankelijkheid van gelokaliseerde oppervlakteplasmonresonantie van verkeerd uitgelijnd afgeknot Ag-nanoprismadimeer
- Amorfe silicium nanodraden gegroeid op siliciumoxidefilm door gloeien
- Defecten op het oppervlak van Ti-gedoteerde MgAl2O4-nanofosfor



