Het detecteren van ruimtelijk gelokaliseerde excitatie in zelfgeorganiseerde InAs/InGaAs Quantum Dot Superroosters:een manier om de fotovoltaïsche efficiëntie te verbeteren
Abstract
Dit artikel rapporteert over experimenteel en theoretisch onderzoek van atypische temperatuurafhankelijke fotoluminescentie-eigenschappen van multi-gestapelde InAs-kwantumdots in de nabijheid van InGaAs-spanningsontlasting die ten grondslag ligt aan de kwantumput. De InAs/InGaAs/GaAs QD-heterostructuur werd gekweekt door middel van solid-source moleculaire bundelepitaxie (SS-MBE) en onderzocht via fotoluminescentie (PL), spectroscopische ellipsometrie (SE) en picoseconde tijdsopgeloste fotoluminescentie. Onderscheidende dubbele-emissiepieken worden waargenomen in de PL-spectra van het monster. Uit de excitatievermogensafhankelijke en temperatuurafhankelijke PL-metingen worden deze emissiepieken geassocieerd met de overgang van grondtoestand van InAs QD's met populaties van twee verschillende groottes. Luminescentiemetingen werden uitgevoerd als functie van de temperatuur in het bereik van 10-300 K door de PL-techniek. De lage temperatuur PL heeft een abnormale emissie vertoond die verscheen aan de lage energiekant en wordt toegeschreven aan de recombinatie door de diepe niveaus. De PL-piekenergie vertoont een abnormaal gedrag als gevolg van het concurrentieproces tussen gelokaliseerde en gedelokaliseerde dragers. We stellen het gelokaliseerde-state ensemble-model voor om het gebruikelijke fotoluminescentiegedrag te verklaren. De kwantitatieve studie toont aan dat de toestanden van het kwantumputcontinuüm fungeren als een doorvoerkanaal voor de herverdeling van thermisch geactiveerde dragers. We hebben de lokalisatiediepte en het effect ervan op de toepassing van de onderzochte heterostructuur voor fotovoltaïsche cellen bepaald. Het model geeft een overzicht van een mogelijke verbetering van de eigenschappen van de InAs/InGaAs/GaAs QDs SCs op basis van de theoretische berekeningen.
Achtergrond
Zelf-geassembleerde kwantumdots (QD's) zijn op grote schaal onderzocht voor mogelijke toepassingen in opto-elektronica vanwege de aard van driedimensionale opsluiting van dragers en de δ-achtige dichtheid van toestanden. Onlangs werden QD-structuren voorgesteld om de tussenliggende band zonnecellen (IBSC's) te realiseren, die extra fotodragers introduceren via de valentie-IB- en IB-geleidingsbandabsorpties [1]. De op GaAs gebaseerde IBSC's met QD's die een kleinere energiebandafstand hebben dan GaAs, vormen tandemstructuren die in staat zijn om fotonen te absorberen bij energieën die lager zijn dan de GaAs-energiekloof, wat resulteert in een hogere energieomzettingsefficiëntie [2]. De vorming van een QD-tussenband vereist een dicht opeengepakte meerlaagse structuur van QD's met een hoge dichtheid [3, 4]. De kristalkwaliteit van InAs QD's neemt echter af naarmate het aantal QD-lagen toeneemt en de laagafstand afneemt als gevolg van de opbouw van interne drukspanning. De overmatige spanning zal dislocaties en defecten veroorzaken die vanuit de QD's naar het oppervlak opstijgen. Daarom nemen de prestaties van een InAs/GaAs QD SC ook af naarmate het aantal QD-lagen toeneemt [5]. Om deze problemen op te lossen, is een groeitechniek met rekcompensatie gedemonstreerd met GaAsN-, GaAsP- en GaP-bufferlaag voor InAs/GaAs-materiaalsystemen [6,7,8]. Een andere techniek om deze problemen op te lossen, is om de InAs/GaAs QDs-laag te bedekken met een dunne InGaAs-laag met verminderde spanning. Vergeleken met InAs/GaAs QD's, veroorzaakt deze laag een roodverschuiving in de fotorespons vanwege de aanwezigheid van een kleine roostermismatch tussen InAs en InGaAs. Het temperatuurafhankelijke fotoluminescentieonderzoek levert nuttige informatie over de meervoudig gestapelde InAs/GaAs QD's SC, die van aanzienlijk praktisch en theoretisch belang is. Klassiek wordt de bandafstand van een halfgeleidermateriaal monotoon kleiner bij toenemende temperatuur. Speciale materialen, zoals InAs/GaAs QD's, hebben een anomalie aangetoond in de PL bij lage temperaturen als gevolg van thermisch geactiveerde drageroverdrachtsmechanismen binnen het ensemble van de kwantumstippen. Deze afwijkingen verdwijnen echter geleidelijk na vermengingsprocessen na de groei in de InAs/InGaAs/GaAs QD-heterostructuren, zoals aangetoond door Ilahi et al. [9]. Heterostructuren vergelijkbaar met die van de huidige studie zijn onderzocht op hun efficiëntie in fotovoltaïsche toepassingen door Sayari et al. [10]. Er zijn de afgelopen decennia veel modellen voorgesteld, zoals die van Passler, Vina en Varshni. Om betrouwbare apparaten te produceren, moet het temperatuurgedrag van dergelijke InAs/InGaAs/GaAs QD-heterostructuren goed worden begrepen en dit is door het gebruik van het best passende model. We gebruiken hierbij het klassieke Passler-model gecorrigeerd voor de thermische herverdelingscoëfficiënt, om de waargenomen S-vorm temperatuurafhankelijkheid van de excitonische bandafstand beter te begrijpen. Onze studie geeft aanleiding tot een zelfconsistent nauwkeurig beeld voor de lokalisatie en overdracht van dragers in een InAs/InGaAs/GaAs QD-heterostructuur, wat een uiterst technologisch belangrijk energiemateriaal is voor het vervaardigen van zeer efficiënte fotovoltaïsche apparaten.
Experimentele details
Afbeelding 1 illustreert een schematisch diagram van de InAs/InGaAs/GaAs QD-heterostructuur die in ons onderzoek is onderzocht. De heterostructuur bestaat uit vijf stapels InAs/In0.11 Ga0,89 As/GaAs QD-lagen gesandwiched door 80 nm intrinsieke GaAs-laag. De epitaxiale lagen werden gekweekt op epiready n + -GaAs (100) substraat met behulp van solid-source moleculaire bundelepitaxie (SS-MBE) met Riber MBE 32P-systeem. Na oxidedesorptie wordt een 250 nm n + -gedoteerde GaAs-buffer met een doteringsdichtheid van 2 × 10 18 cm −3 werd gekweekt bij 520 °C gevolgd door een 1000 nm n-gedoteerde GaAs-basislaag met een doteringsdichtheid van 10 17 cm −3 . De substraattemperatuur wordt vervolgens verlaagd en gestabiliseerd op 500 ° C voor de afzetting van het intrinsieke gebied. Zoals weergegeven in Fig. 1 bestaan de herhaalde lagen uit 2,5 monolagen (ML) met InAs-dekking, 5 nm dikke In0,11 Ga0,89 As en 33 nm dikke GaAs. De vorming van de QD's werd in situ gecontroleerd door het diffractiepatroon van hoogenergetische elektronen (RHEED) te volgen. Het doel van de 5 nm dikke In0.11 Ga0,89 Zoals om de emissie- en absorptiespectra rood te verschuiven, terwijl het 33 nm dikke GaAs als een afstandslaag fungeert. De groeipercentages voor InAs, In0,11 Ga0,89 As- en GaAs-lagen waren respectievelijk 0,08 ML/s, 0,78 ML/s en 0,7 ML/s, gemeten met RHEED-spiegelende spotoscillaties. Aan het einde, een 500 nm p-gedoteerde GaAs-emitterlaag (2 × 10 17 cm −3 ) gevolgd door een 100-nm GaAs p + -gedoteerde contactlaag (5 × 10 18 cm −3 ) werden bovenop de heterostructuur gekweekt. Silicium (Si) en beryllium (Be) werden respectievelijk gebruikt als n- en p-type doteringsmiddelen. Tijdens de groei werd de temperatuur gekalibreerd door een pyrometer.
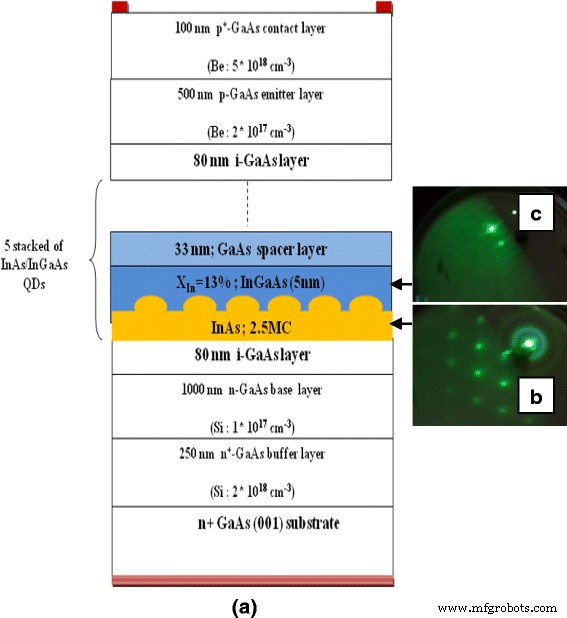
een Schematische laagstructuur van de vijflaagse gestapelde InAs/InGaAs QD's SC gegroeid op (001) n + -GaAs-substraat. b RHEED-patroon na groei van 2,5 ML InAs (driedimensionale groei). c RHEED-patroon tijdens groei van 5 nm InGaAs (tweedimensionale groei) [10]
Spectroscopische ellipsometrie (SE) werd uitgevoerd bij kamertemperatuur tussen 1 en 6 eV, met behulp van een J.A. Woollam spectroscopische ellipsometer met variabele hoek (VASE) M-2000. De SE-metingen werden uitgevoerd onder invalshoeken variërend van 45° tot 60°. Bij PL-metingen wordt een argon-ion (Ar + ) laser met een golflengte van 514,5 nm werd gebruikt als een excitatiebron om elektron-gatparen te genereren. Het luminescentielicht van de monsters werd verspreid door een spectrometer met hoge resolutie en gedetecteerd door een thermo-elektrisch gekoelde Ge-fotodetector met een ingebouwde versterker. Voor de excitatievermogensafhankelijke en temperatuurafhankelijke PL-metingen werden de monsters gemonteerd in een gesloten cyclus, temperatuurgecontroleerde helium-cryostaat. De PL-spectra werden genomen in het nominale uitgangsvermogensbereik van 1,5-350 mW en het temperatuurbereik van 11-300 K. De tijdopgeloste PL-metingen werden uitgevoerd in een helium met variabele temperatuur (10-240 K), gesloten cyclus cryostaat. De 514 nm-lijn werd gebruikt als een excitatiegolflengte, van een mode-locked Ti:saffier picoseconde pulslaser met een herhalingssnelheid van 80 MHz met een pulsbreedte van 1,2 ps.
Resultaten en discussies
Figuur 2 toont de gemeten reële (a) en denkbeeldige (b) delen van de diëlektrische functie van de InAs/InGaAs/GaAs QD heterostructuur bij 300 K voor het energiebereik 1-6 eV. De echte en imaginaire delen volgen verschillende patronen. De variatie van de diëlektrische functie met fotonenergie geeft aan dat sommige interacties tussen fotonen en elektronen in de films worden geproduceerd in het energiebereik van 1-6 eV. De twee belangrijkste spectrale kenmerken zijn de E1 en E2 kritieke puntstructuren (CP) bij respectievelijk ~ 3 en ~ 4,5 eV [11, 12]. Om de energiepositie van de verschillende interbandovergangen kwantitatief te bepalen, hebben we de nuldoorgang van het tweede afgeleide spectrum van het denkbeeldige deel van de pseudo-diëlektrische functie genomen. De verschillende verkregen overgangsenergieën zijn samengevat in tabel 1.
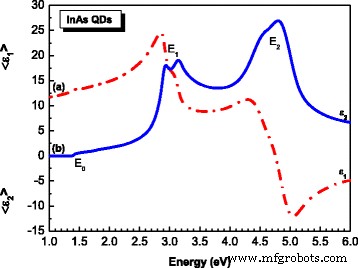
Echt (ϵ 1 ) (rode stippellijn ) en denkbeeldige (ϵ 2 ) (ononderbroken blauwe lijn ) delen van diëlektrische functies van de InAs/InGaAs QD-heterostructuur verkregen uit SE-metingen [10]
Figuur 3 toont het tweede energiederivaatspectrum van het denkbeeldige deel van de pseudo-diëlektrische functie getoond in figuur 2. De twee pieken bij 2,9 en 3,1 eV komen respectievelijk overeen met de E 1 en E 1 + Δ1 , interbandovergangen in GaAs. De twee dicht bij elkaar gelegen pieken van ongeveer 4,4 en 4,7 eV worden echter veroorzaakt door de CP-overgangen E 0 ’ en E 2 , respectievelijk in InAs QD-lagen [12]. We merken op dat de bijdrage van de E 1 + Δ1 CP-energie (2,74 eV) [12] van InAs naar de E 1 één (2,91 eV) [11] van GaAs kan niet worden uitgesloten vanwege het kleine verschil tussen de twee energiewaarden. Bij lage energie is de band gap van GaAs duidelijk te onderscheiden in de ε spectrum bij ongeveer 1,4 eV. Ook toont het tweede energiederivaatspectrum (Fig. 3) een interbandovergang bij 1,75 eV, wat overeenkomt met de E 0 + Δ0 CP-energie van GaAs [11]. Het is bekend dat ε 2 is een graadmeter en maatstaf voor de materiaalkwaliteit; de hoogste waarde impliceert de meest abrupte interface [13]. Volgens de literatuur, ε 2 waarden van ongeveer 25, met als hoogste waarde 26,8 in ons geval, verkregen in de regio van de E 2 bandafstand in de buurt van 4,7 eV, geeft de hoge kwaliteit aan van de materialen die de InAs/InGaAs/GaAs QD-heterostructuur vormen die is gegroeid door SS-MBE.
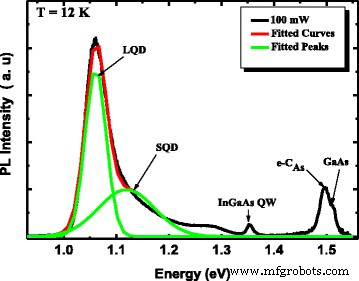
Tweede afgeleide spectrum van denkbeeldig deel (ϵ 2 ) van diëlektrische functie als functie van de fotonenergie voor de InAs/InGaAs QD heterostructuur. De overgangsenergieën die voortkomen uit InAs QD-lagen en GaAs-lagen zijn aangegeven [10]
Figuur 4 toont het PL-spectrum van het actieve gebied in de InAs/InGaAs/GaAs QD-heterostructuur met een excitatievermogen van 100 mW bij lage temperatuur (12 K). Het is duidelijk dat het spectrum een asymmetrische vorm heeft die zich aan de hoogenergetische kant bevindt en die door Gauss-aanpassing in twee subbanden kan worden gedeconvolueerd [14]. Gezien de afhankelijkheid van de kwantumopsluitingspotentiaal van de puntgrootte, wordt de meest intense piek bij 1,06 eV toegeschreven aan de emissie uit de grondtoestanden van grotere QD's (LQD's), terwijl de hogere energiepiek bij 1,11 eV verwijst naar de emissie van de grondtoestanden van kleinere QD's (SQD's) [15]. Dus, bij een zeer laag excitatievermogen en lage temperatuur, leiden we af dat de asymmetrische vorm te wijten is aan luminescentie afkomstig van een bimodale grootteverdeling van stippen [16]. Daarnaast pieken afkomstig van de InGaAs-kwantumbronlaag, de recombinatie tussen elektronen in de GaAs-geleidingsband en gaten op het koolstofacceptorniveau (e-CAs ) [17] en GaAs-bandafstand worden gezien rond respectievelijk 1,35, 1,49 en 1,51 eV. Om deze toeschrijving aan de asymmetrische vorm te bevestigen, hebben we PL-metingen uitgevoerd bij verschillende laservermogens variërend van 10 tot 100 mW. We hebben ook AFM-metingen uitgevoerd op een niet-afgetopte structuur vergelijkbaar met de onderzochte. Uit figuur 5 is het duidelijk dat de heterostructuur een machtsonafhankelijke PL-vorm heeft. Afgezien van het hoogste excitatiespectrum, zijn de PL-intensiteit en lijnbreedte van de heterostructuur hoogenergetische PL-piek niet significant veranderd. Ook is de energiescheiding tussen de twee PL-pieken (Fig. 5) ongeveer 50 meV. Zoals verwacht laat het AFM-beeld zien dat de QD's in de vijfde laag een bimodale grootteverdeling hebben met een hele QDs-dichtheid van 7 × 10 10 cm^(−2). Ervan uitgaande dat de zijpieken met lage energie van de heterostructuur overeenkomen met de grondtoestand van grote QD's (LQD's), kunnen we zeggen dat de pieken met hoge energie bij hoog vermogen het resultaat lijken te zijn van de grondtoestanden van relatief kleine QD's (SQD ).
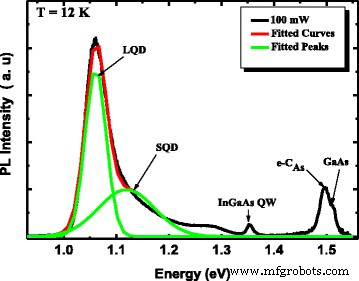
PL-spectrum gemeten bij lage temperatuur (12 K) van de vijflaagse gestapelde InAs/InGaAs QD-heterostructuur. Een lijnvormanalyse van spectra bewijst dat het QD PL-signaal een convolutie is van twee Gauss-vormige pieken zoals weergegeven door ononderbroken lijnen

Excitatievermogen-afhankelijke genormaliseerde PL-spectra van de InAs/InGaAs QD-heterostructuur gemeten bij 12 K
Om inzicht te krijgen in de PL-recombinatiemechanismen, worden temperatuurafhankelijke PL-metingen uitgevoerd op de heterostructuur van 10 tot 300 K en weergegeven in Fig. 6. Figuur 7 toont de PL-energiepositie van de hoofdpiek geassocieerd met emissie van LQD's. Deze piek vertoont een abnormale temperatuurafhankelijkheid tussen 10 en 100 K vergeleken met andere III-V ternaire legeringen zoals conventionele GaAlAs [18]. In dit temperatuurbereik (gebied (i)) wordt een roodverschuiving van ongeveer 12 meV waargenomen. Deze verschuiving is te wijten aan recombinatie van excitonen via de gelokaliseerde sates binnen het ensemble van de inhomogeen verdeelde LQD's. Naarmate de temperatuur binnen dit temperatuurbereik stijgt, worden dragers thermisch geactiveerd en overgedragen van de kleinere naar de grotere QD's binnen het ensemble, waar ze uiteindelijk stralingshercombineren. Dit maakt dat de waargenomen verschijnselen waarschijnlijk afkomstig zijn van de grote spreiding van de stippen in onze structuur (zie AFM-inzet). De karakteristieke temperatuur waarin de twee recombinatieprocessen (gelokaliseerde en gedelokaliseerde dragers) in gelijke mate deelnemen aan het PL-signaal wordt aangeduid als T loc/deloc . Dan, tussen 100 en 120 K (regio (ii)), neemt de piekenergie toe. Dit komt door de ontsnapping van dragers van de ondiepere staten naar de hogere. De karakteristieke temperatuur wordt aangegeven als T ontsnappen . Zelfs bij hoge temperaturen (regio (iii)) worden de excitonen volledig gedelokaliseerd en wordt een band-naar-band-recombinatie hersteld.

Temperatuurafhankelijke PL-spectra van de InAs/InGaAs QD-heterostructuur, gemeten bij een excitatievermogen van 100 mW

LQD PL piekenergieën van de onderzochte InAs/InGaAs QD heterostructuur gemeten bij verschillende temperaturen
Voor een beter begrip van het recombinatieproces in InAs/InGaAs/GaAs multi-stacked QD's, hebben we de tijdsopgeloste PL bestudeerd met behulp van de fototellende tijdgecorreleerde techniek. Er werd theoretisch voorspeld dat de levensduur van het excitonverval van QD's temperatuurgevoelig is [19]. Experimentele metingen hebben aangetoond dat de levensduur inderdaad een temperatuurconstante is onder een kritische temperatuur [20]. Markus et al. [21] rapporteerde een constante levensduur van ongeveer 950 ps over een breed temperatuurbereik binnen de experimentele fout.
Afbeelding 8a geeft het PL-vervalspectrum weer, tussen 17 en 240 K voor een detectie-energie vastgesteld op 1,06 eV en een excitatie-energie (λ exc = 514 nm). Die spectra zijn theoretisch goed passend door een mono-exponentiële functie, met een vervaltijd van ~1000 ps bij lagere temperatuur. Deze langzame vervaltijd, vergeleken met III-V dunne halfgeleiderfilms [22], is een kenmerk van de aanwezigheid van gelokaliseerde toestanden [23], en de recombinatie van de dragers op de LQD-piek zou puur stralings moeten zijn. Inderdaad, bij lage temperatuur hebben door foto's gegenereerde elektronen en gaten, voordat ze recombineren, de tijd nodig om excitonen te vormen en hun energie te ontspannen om te worden opgevangen door de ondiepe gelokaliseerde toestanden. Deze verschijnselen leiden tot een langzame vervaltijd. Het temperatuureffect op de PL-vervaltijd is bestudeerd en toont de aanwezigheid van twee verschillende regimes zoals weergegeven in figuur 8b [24]. We merken op dat de vervaltijd geassocieerd met de lagere energie van de PL-band (LQD's (1,06 eV)) bijna constant is (1000 ps) tot 140 K, en dan afneemt naarmate de temperatuur stijgt.

een Vervaltijd van de LQD-piek versus de monstertemperatuur voor een golflengte-excitatie van 514 nm. b Typische vervalintensiteit van fotoluminescentie versus de temperatuur van de LQD-piek gemeten bij een excitatiegolflengte van 514 nm
Theoretische benadering
Om de afwijkende temperatuurafhankelijkheid van PL te begrijpen, is de PL-piekpositie onderzocht met behulp van het LSE-model dat is ontwikkeld door Li et al. [25, 26]. Dit kwantitatieve model biedt inderdaad een bevredigende verklaring voor de afwijkende spectrale kenmerken van de luminescentie in gelokaliseerde toestand die eerder werd waargenomen in verschillende III-V-materialen zoals op boor gebaseerde B(In)GaAs/GaAs [27, 28] legeringen en InGaAs/GaAs MQW's [29, 30]. Het model ging ervan uit dat de gelokaliseerde toestand een energieverdeling van het Gauss-type heeft voor toestandsdichtheid gegeven door:
$$ \rho (E)={\rho}_o{e}^{-{\left(\frac{E-{E}_{\mathrm{ch}}}{2{\sigma}^2}\ rechts)}^2} $$ (1)Waar σ en E ch zijn respectievelijk de verbredende parameter voor de verdeling van de gelokaliseerde toestanden (lokalisatiediepte) en het barrièreniveau dat de vervoerders moeten overwinnen om over te gaan. In quasi stationaire toestand kan de dynamiek van de gelokaliseerde excitonen worden beschreven door de volgende snelheidsvergelijkingen:
$$ \frac{dN\left( E, T\right)}{dt}=G(E)+\frac{\gamma_c N\hbox{'}\left( E, T\right)\rho (E) }{\Lambda}-\frac{N\left( E, T\right)}{\tau_{\mathrm{tr}}}{e}^{\frac{E-{E}_a}{K_B T} }-\frac{N\left( E, T\right)}{\tau_{\mathrm{r}}}=0 $$ (2)De parameters τ r , τ tr , γ c , K B , Λ, en N ' vertegenwoordigen respectievelijk de recombinatietijd van de drager (levensduur straling), de overdrachtstijd van de drager (levensduur zonder straling), de hervangingscoëfficiënt, de Boltzmann-constante, het totale aantal gelokaliseerde toestanden en het totale aantal dragers dat thermisch wordt geactiveerd weg van de gelokaliseerde staten. G (E ) vertegenwoordigt de snelheid van het genereren van dragers. De hoeveelheid \( \frac{\gamma_c N\hbox{'}\left( E, T\right)\rho (E)}{\Lambda} \) is het aantal dragers dat door de gelokaliseerde staten per eenheid opnieuw is veroverd tijd. De derde term aan de rechterkant geeft de thermische ontsnappingssnelheid van de gelokaliseerde dragers. De laatste vertegenwoordigt de ontvolkingssnelheid van dragers als gevolg van de stralingsrecombinatie. De bevolkingsdichtheid van gelokaliseerde vervoerders is evenredig met de distributiefunctie en de dichtheid van toestanden van gelokaliseerde vervoerders. In feite is de oplossing van Vgl. (2) kan worden beschreven door Vgl. (3).
$$ N\left( E, T\right)=\frac{\rho_o{e}^{-{\left(\frac{E-{E}_0}{2{\sigma}^2}\right) }^2}}{\left[\frac{\tau_{\mathrm{tr}}}{\tau_{\mathrm{r}}} + exp\left(\frac{\left( E-{E}_ {\mathrm{ch}}\right)}{K_{\mathrm{B}} T}\right)\right]} $$ (3)waar E 0 is de centrale energie. Wiskundig gezien wordt de temperatuurafhankelijkheid van de piekpositie als gevolg van thermische herverdeling van de draaggolf binnen de gelokaliseerde toestanden bepaald uit \( \frac{\partial N\left( E, T\right)}{\partial t}=0 \) gegeven door :
$$ E(T)={E}_0- x(T){K}_B T $$ (4)Waar x (T ) is de numerieke oplossing van de niet-lineaire Vgl. (5):
$$ x{e}^x=\left[{\left(\frac{\sigma}{K_b T}\right)}^2- x\right]\left(\frac{\tau_{\mathrm{r }}}{\tau_{\mathrm{tr}}}\right) exp\left[\frac{\left({E}_0-{E}_{\mathrm{ch}}\right)}{K_{ \mathrm{B}} T}\right] $$ (5)
Vergelijking 5 heeft maar één oplossing voor \( 0
Het is bekend dat de bandafstand van een geïdealiseerd halfgeleidermateriaal gewoonlijk wordt beschreven door de empirische formule van Passler [32]. Rekening houdend met de correctie als gevolg van de thermische herverdelingscoëfficiënt, de variatie van de piekpositie van luminescentie met behulp van het LSE-model beschreven door Vgl. (7):
$$ E(T)={E}_0-\frac{\alpha \theta}{2}\left[\sqrt[ P]{1+\left(\frac{2 T}{\theta}\right) }\kern0.5em -1\right]- x(T){K}_B T $$ (7)waar θ is een karakteristieke temperatuurparameter waarvan verwacht werd dat deze vergelijkbaar was met de Debye-temperatuur θ D . Voor T>>θ , zien we dat α precies de limiet van de grootte van de eerste afgeleide voorstelt, \( {\frac{dEg(T)}{dT}}_{T\to \infty } \). De exponent "p" is gerelateerd aan de vorm van de onderliggende elektron-fonon spectrale functie [33]. Het model past goed bij de experimentele evolutie die wordt bevestigd door Fig. 9. De aanpassingsparameters zijn samengevat in Tabel 2.

Temperatuurafhankelijke fotoluminescentie-evolutie van de LQD-piek (massieve zwarte vierkantjes ) gemonteerd met behulp van de empirische wet van Passler (blauwe ononderbroken lijn ) en de gewijzigde Passler-relatiewaarheid naar het LSE-model (rode ononderbroken lijn )
De PL-piekenergie hangt sterk af van de thermische herverdeling die wordt weergegeven in figuur 10. Dit laatste duidt op een snelle toename van het bereik van de cryogene temperatuur. Het maximum van thermische herverdeling komt overeen met het maximum van roodverschuiving in de energie-evolutie (~ 50-100 K). In het gebied met een hoge PL-temperatuur neemt de thermische herverdeling exponentieel af en neigt deze te verdwijnen vanaf 150 K begint het delokalisatieproces en de terugkeer naar band-naar-band overgangen. We kunnen dit ook waarnemen wanneer de klassieke en de gewijzigde curven boven elkaar worden geplaatst (Fig. 9). De exponent "p" geeft aan dat de bijdrage van de longitudinale akoestische (LA) fononen significanter is dan de bijdrage van de longitudinale optische (LO ) fononen. Deze bijdrage lijkt dominant te zijn in het gebied van hoge PL-temperatuur waar de emissie wordt ondersteund via fononen. Het bimodale distributieproces opent een koppelingskanaal tussen QD's dat wordt weergegeven door gedelokaliseerde elektronen- en gattoestanden gescheiden door een energie E ch . De oorsprong van dit koppelkanaal is nog steeds een onderwerp van controverse [34,35,36]. Het koppelingskanaal kan echter worden gezien als de tussenliggende toestanden die bestaan tussen tweedimensionale WL- en nuldimensionale QD-toestanden [37]. Het is dus voorstelbaar dat de dragers in de QD-toestanden gemakkelijker thermisch kunnen worden geëxciteerd naar het koppelingskanaal dan de WL vanwege de kleinere benodigde activeringsenergie, en vervolgens binnen een eindige afstand naar hun naburige QD's kunnen worden overgebracht. Het lijkt op het Fermi-Dirac-niveau in de Fermi-Dirac-verdeling. Deze energie E ch is kleiner dan de activeringsenergie E een geëxtraheerd uit het Arrhenius-diagram (Fig. 11). De reden waarom E een groter is, kan worden verklaard door het feit dat dragers meer energie nodig hebben om de bevochtigingslaag (WL) te bereiken, zoals schematisch weergegeven in Fig. 12. Bovendien is de grootte van het verschil ΔE = E ch − E 0 speelt een belangrijkere rol bij het bepalen van abnormale temperatuurafhankelijkheid van luminescentie van gelokaliseerde dragers. We moeten opmerken dat de twee gevallen, E ch − E 0> 0 en E ch − E 0 < 0, bestaat vanuit een fysiek oogpunt, maar wordt meestal toegewezen als "positieve" thermische activeringsenergie. In ons geval betekent dit dat E ch is 4 meV lager dan E 0 waarin gelokaliseerde dragers thermisch worden geactiveerd tot toestanden (of locaties in de echte ruimte) met hogere energieën. Het neemt af in vergelijking met een enkele InAs QD-laag met In0.15 Ga0,85 Als spanningsverminderende onderliggende laag [10]. De potentiële fluctuatiediepte toegewezen door σ is een gevolg van de inhomogeniteit van de grootteverdeling van QD's. De potentiële diepte blijkt 19 meV te zijn. Het neemt af door het aantal stapels InAs/In0.11 . te verhogen Ga0,89 As/GaAs QD's. Als resultaat kunnen we afleiden dat de afname van de potentiële diepte de structuurefficiëntie verhoogt in vergelijking met de ene laag InAs/InGaAs/GaAs QD's bestudeerd door Ilahi et al. en Helmi et al. [10, 36].

Temperatuurafhankelijke thermische herverdeling numeriek bepaald. De karakteristieke temperaturen (T loc/deloc en T ontsnappen ) worden aangegeven met betrekking tot het lokalisatie-delokalisatieproces
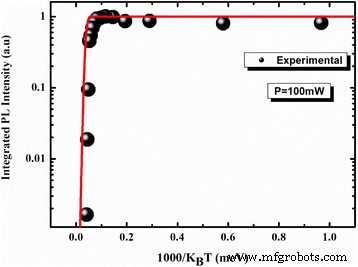
Arrhenius-aanpassing van het onderzochte monster. De genormaliseerde geïntegreerde intensiteit (zwarte cirkels ) is uitgerust met drie activeringsenergieën (rode ononderbroken lijn )
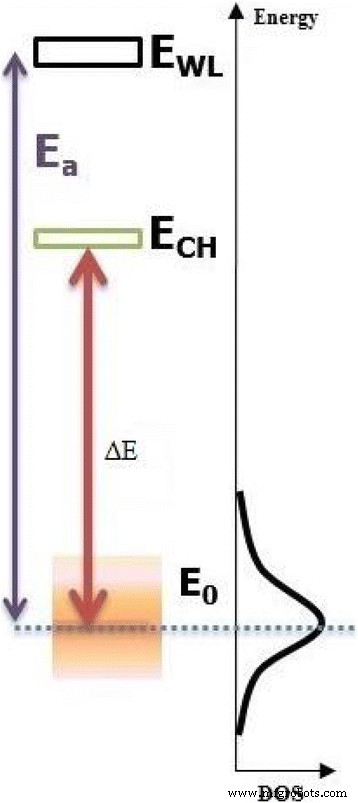
Schema van de QD-verdeling van gelokaliseerde elektron/gat (exciton) toestanden (WL bevochtigingslaag, CH carrier overdrachtskanaal)
Conclusie
Concluderend hebben we met succes op GaAs gebaseerde SC gefabriceerd met een multi-stack InAs QD's door een InGaAs-laag op de QD's af te dekken en GaAs-afstandslagen in te voegen. De twee belangrijkste spectrale kenmerken die zijn waargenomen in de diëlektrische functiespectra van de InAs/InGaAs/GaAs QD-heterostructuur bij 3 en 4,5 eV worden toegeschreven aan de E 1 en E 2 CP-structuren van respectievelijk GaAs en InAs. Het PL-spectrum van de InAs QD's in de GaAs-matrix is intens en vertoont een asymmetrische vorm, wat wijst op de groei van een hoogwaardige, meervoudig gestapelde InAs QD-structuur. De bijdrage van grotere en relatief kleinere QD's aan het PL-spectrum wordt ook aangetoond. De luminescentiemetingen werden met succes gemodelleerd en opnieuw geïnterpreteerd met behulp van het ontwikkelde LSE-model. De theoretische studie heeft de waargenomen temperatuurafhankelijke spectra kwantitatief geïnterpreteerd en heeft licht geworpen op de gecompliceerde spontane emissiemechanismen in multi-stacked InAs/InGaAs/GaAs QD's, gebaseerd op de aanpassingsparameters. Deze studie suggereert een manier om de efficiëntie van InAs/GaAs QD-structuren te verbeteren voor hun gebruik in fotovoltaïsche toepassingen. Deze resultaten helpen bij het verbeteren van het begrip van de temperatuurafhankelijke dragerdynamiek in spannings-engineering QD's om de efficiëntie van de onderzochte structuur te verbeteren. Naast dit werk zullen we het effect van oriëntatie en de toename van het aantal InAs/GaAs QD's van de multi-stack structuur op de lokalisatiediepte bestuderen.
Nanomaterialen
- Hoeken gebruiken om de toekomst van elektronica te verbeteren
- Het magnetisme van de kern van een enkel atoom detecteren
- Plastic componenten:de weg vrijmaken voor auto-efficiëntie
- Heldere enkelvoudige fotonbron op 1,3 μm gebaseerd op InAs Bilayer Quantum Dot in Micropillar
- Bipolaire effecten in fotovoltage van metamorfe InAs/InGaAs/GaAs Quantum Dot heterostructuren:karakterisering en ontwerpoplossingen voor lichtgevoelige apparaten
- Omkeerbare elektrochemische controle over foto-excited luminescentie van Core/Shell CdSe/ZnS Quantum Dot Film
- Fotovoltaïsche prestaties van een Nanowire/Quantum Dot Hybrid Nanostructure Array Zonnecel
- Eliminatie van bimodale grootte in InAs/GaAs Quantum Dots voor de voorbereiding van 1,3-μm Quantum Dot Lasers
- Interband fotogeleiding van metamorfe InAs/InGaAs Quantum Dots in het venster van 1,3–1,55 µm
- Opwarming van de aarde zal de efficiëntie van zonnecellen verminderen
- CNC 5-assig frezen leidt de weg naar efficiëntere bewerkingen



