Hoge snelheid en richtinggestuurde vorming van silicium nanodraadarrays ondersteund door elektrisch veld
Abstract
Metal-assisted chemical etching (MaCE), een goedkope en veelzijdige methode, werd beschouwd als een veelbelovende techniek voor het maken van silicium nanodraden (SiNW's), maar het ontbreken van een goede controle van de geïnjecteerde gaten in Si zou de etssnelheid kunnen verminderen, de ongewenste zijwand creëren etsen, en degraderen de structurele uniformiteit. Hierin werd in deze studie het bias-gemoduleerde MaCE-proces uitgevoerd, waarbij de etssnelheden meer dan vier keer zo groot waren als die van typische bias-vrije MaCE met uniformiteit over een groot gebied. Er werd gevonden dat de veldgemedieerde gatrectificatie het effect van vertraagde diffusie van reactieve ionen overweldigde, en dus werd de dynamiek van gedistribueerd etsen daarom overgebracht naar het directionele etsgedrag. Bovendien zou de etsoriëntatie ook kunnen worden gemanipuleerd met de externe bias. De resultaten toonden aan dat de etsrichting werd omgeschakeld naar de schuine kenmerken door de elektrische polarisatie te variëren, waardoor de speciale schuine/verticale NW-arrays werden gecreëerd, die superieure antireflectie-eigenschappen bezaten dan de conventionele verticaal uitgelijnde kenmerken.
Inleiding
Laagdimensionale silicium (Si) nanostructuren vertoonden opmerkelijke elektronische, mechanische en opto-elektronische eigenschappen die zouden kunnen fungeren als bouwelementen van functionele apparaten en toepassingen [1,2,3], zoals veldeffecttransistoren, biosensoren en fotovoltaïsche cellen [4] ,5,6,7,8,9]. Om de reguliere reeksen Si-nanostructuren te vormen, werd metaal-geassisteerd chemisch etsen beschouwd als de heersende strategie die het zelfs mogelijk maakte om Si-nanodraad (SiNW) -arrays te vormen op vlakke substraten [10, 11], poeders [12, 13] en piramidale structuren [14]. In het etsproces vonden de gateninjecties over metaalkatalysatoren naar Si eronder en vervolgens het oplossen van geoxideerd Si continu plaats, wat resulteerde in de lange etsporiën. De gegenereerde gaten zouden echter binnen de Si-matrix kunnen diffunderen in plaats van altijd verticaal te bewegen ten opzichte van het substraatvlak; het veroorzaakte meestal de vorming van talrijke Si-nanoporiën nabij de primaire etsplaatsen, waardoor de oncontroleerbare etsprofielen achterbleven [15]. Deze functie bleek bijzonder duidelijk te zijn, terwijl de oplossingen een hoge viscositeit hadden.
Het ontbreken van een goede beheersing van de geïnjecteerde gaten in Si zou de praktische toepassingen van Si-nanostructuren voor praktisch gebruik kunnen belemmeren.
Om dit veeleisende probleem op te lossen, leek de inzet van het externe veld veelbelovend. Liyi Li et al., toonden aan dat de hoge aspectverhouding (> -10:1) reguliere gaten- of striparrays kon worden gerealiseerd door gebruik te maken van MaCE met elektrische voorspanning, maar de afmetingen van de kenmerken waren op microschaal [16]. Geïnspireerd door dit werk hebben we in deze studie geprobeerd de haalbaarheid te onderzoeken van het fabriceren van SiNW-arrays door middel van bias tijdens het MaCE-proces. Zowel positieve als negatieve bias werden onderzocht om de veldafhankelijke etskinetiek te begrijpen. Naast de etssnelheid, ontdekten we dat de etsoriëntatie kon worden gemoduleerd, waarbij de SiNW's met twee segmenten in de vorm van schuine / verticale kenmerken werden gerealiseerd door de biasrichting af te stemmen. Het onderliggende etsmechanisme en de etskinetiek in aanwezigheid van een elektrisch veld werden onderzocht, en de superieure antireflectie-eigenschappen van unieke schuine/verticale SiNW-arrays werden gepresenteerd in zowel experimentele als gesimuleerde analyse.
Methoden
Substraatvoorbereiding
De enkelkristallijne (100), enkelzijdig gepolijste Si-substraten met een dikte van 525 m werden als uitgangsmaterialen gebruikt. De Si-substraten werden gedurende verschillende cycli ultrasoon gereinigd in isopropylalcohol, aceton en gedeïoniseerd water en werden vervolgens verder gereinigd in SC-1-oplossing (1 deel NH4 OH, 1 deel van H2 O2 , en 5 delen gedeïoniseerd water) gedurende 30 minuten om de oppervlakken te reinigen en resulteerde in de hydrofiele oppervlakken.
Nanosfeerlithografie
Om de sterk geordende uitgelijnde nanostructuren te fabriceren, werd nanosfeerlithografie (NSL) uitgevoerd. Kortom, polystyreen nanosferen (PS's) met een diameter van 300 nm worden langzaam gedispergeerd en geassembleerd in de zeshoekige dicht opeengepakte functies aan de lucht / water-interfaces in de petrischaal en vervolgens rechtstreeks overgebracht naar de Si-substraten. De krimp van grootschalige en uniforme PS's werd bereikt door gebruik te maken van zuurstofplasma met een vermogen van 100 W onder een procesdruk van 200 mTorr. De etstijd werd ingesteld op 120 s en de zuurstofstroom werd op 12 sccm gehouden. Vervolgens werd 30 nm zilverfilm afgezet met behulp van een elektronenstraalverdamper met een snelheid van 0,3 /s onder de vacuümconditie van 7,0 × 10 −6 Torr. Daarna werden de resterende PS's volledig verwijderd door sonicatie gedurende 2 uur in het tolueen, wat resulteerde in de vorming van zilvergaas met patronen op Si-substraten.
Vervaardiging van Si-nanodraden
De as-cleaned Si-substraten werden geplakt met koperen tapes als de elektroden als boven- en achterkant en verbonden met voeding voor het aanleggen van het elektrische veld. De aangelegde spanningen werden aangepast binnen 40 V tot 40 V. De Si-substraten met de ladingen van Ag-nanodeeltjes of Ag-lagen met patronen werden gevormd wanneer ze werden ondergedompeld in een etsmengsel bestaande uit HF (49%), H2 sub> O2 (30%) en DI-water met de concentraties van respectievelijk 4 M en 0,28 M [17,18,19,20]. Na het etsproces werden de resterende Ag-lagen verwijderd met de geconcentreerde HNO3 (65%)
Karakteriseringen
Morfologieën van zoals gevormde nanodraden werden gekarakteriseerd door veldemissie scanning elektronenmicroscopie (SEM, LEO 1530). Contacthoekanalyse werd verkregen met behulp van een Theta Lite (TL101). Luminescerend gedrag van SiNW's werd gekarakteriseerd door een fotoluminescent (PL) systeem uitgerust met een lichtemitterende diodelamp (uitgangsvermogen:780 mW) en de golflengte van de lichtbron was 365 nm. UV/Vis-reflectiespectra werden geregistreerd met een UV-vis-NIR-spectrofotometer (Varian, Cary 5000, Australië). De optische reflectie werd gesimuleerd met een tijdsdomein met eindige differentie (FDTD), waarbij de perfect op elkaar afgestemde grens werd geselecteerd langs de verlichtingsrichtingen.
Resultaten en discussie
Vergelijkingen van typische MaCE en bias-assisted MaCE die werden gebruikt op de Ag-geladen Si-substraten werden gepresenteerd in Fig. 1a. Het zou kunnen dat de H2 O2 oxidanten zorgden voor de gaten die diffundeerden naar Si, geholpen door de bestaande Ag-katalysatoren. De injectie van gaten werd niettemin niet altijd in unidirectionele oriëntatie naar voren gebracht, die in plaats daarvan werden verspreid vanwege het feit dat de ongelijke facetten van AgNP's in contact met Si, zoals weergegeven in figuur 1a. Deze kenmerken veroorzaakten expliciet het verlies van gaten die niet in staat waren om bij te dragen aan de directionele ontbinding van Si voor NW-vorming, maar in plaats daarvan werden gedistribueerd en gemakkelijk zouden kunnen leiden tot de vorming van poreuze structuren. Daarentegen zou het gebruik van voorwaartse voorspanning (+-10 V) in verticale opstelling met betrekking tot de substraatvlakken de etskinetiek dramatisch kunnen wijzigen. Het gecorreleerde ontwerp van in het veld toegepaste MaCE werd schematisch weergegeven in aanvullend bestand 1:figuur S1. In feite dwong het betrokken polarisatiepotentieel alle gaten af die diffundeerden langs de oriëntatie van het aangelegde veld die reageerden op de verbeterde etssnelheden (260 nm / min) (Fig. 1c) vergeleken met het typische MaCE-proces (220 nm / min) (Fig. 1b). De variatie van positieve bias die binnen het MaCE-proces wordt toegepast, zou daarom kunnen resulteren in de verandering van etssnelheden, zoals aangetoond in aanvullend bestand 1:figuur S2, waar het duidelijk de correctie van het gat van MaCE aantoonde omdat de positieve bias erbij betrokken was.
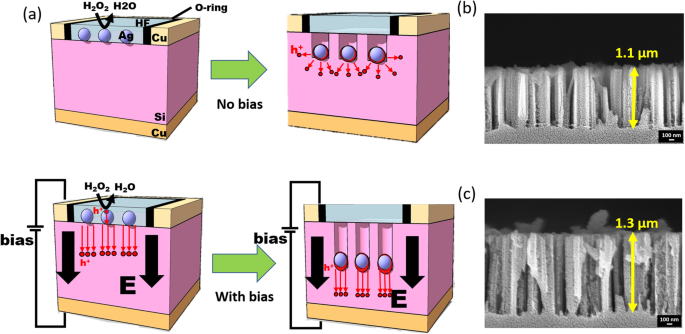
een Schematische illustraties van de typische MaCE (figuur hierboven) en bias-ondersteunde MaCE (figuur hieronder). Transversale SEM-afbeeldingen van SiNW's gemaakt door b typische MaCE en c bias-ondersteunde MaCE (+ 10 V)
Een dergelijk veldondersteund effect was aan de andere kant ook geldig terwijl het MaCE-proces werd onderworpen aan de negatieve bias. Figuur 2a gaf de tegenovergestelde rectificatie van gatdiffusie aan met betrekking tot het gatinjectiepad, dat de effectieve oplossing van Si remde door de gaten in Ag-microscopische elektroden te beperken en aanleiding gaf tot de verminderde etssnelheid (180 nm / min). Bovendien werd het algehele bereik van toegepaste bias op de etssnelheid van MaCE-reacties aangetoond in figuur 2b. Het gaf de overgang aan van de etskinetiek met betrekking tot de polarisatie van de betrokken bias. De negatieve bias veroorzaakte ondubbelzinnig de verlaging van de etssnelheid, terwijl de positieve bias bij +-10 V het effectieve etsen van Si directioneel door gat rectificatie-effect mogelijk maakte en de geleidelijke toename van de etssnelheid weerspiegelde. Met grotere bias, naast de rectificatie van het gat, introduceerde het mogelijk de nieuw gegenereerde gaten die betrokken waren bij het directionele etsen van Si, wat gecorreleerd was met het anodisatie-effect [21, 22]. Een dergelijk effect controleerde voornamelijk de etskinetiek, waardoor de etssnelheden meer dan vier keer zo groot waren als die van typische bias-vrije MaCE. We konden daarom concluderen dat de gecombineerde effecten van gatrectificatie en anodisatie plaatsvonden op Si, dat de etskinetiek en gecorreleerd gedrag zou kunnen moduleren.
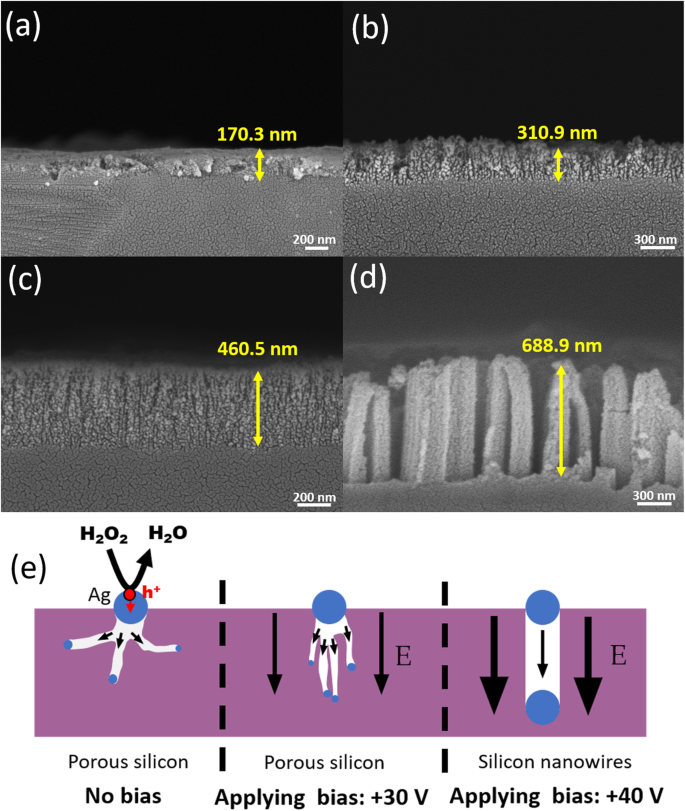
een Dwarsdoorsnede SEM-beeld van SiNW's verkregen uit bias-assisted MaCE met − 10 V aangelegd elektrisch veld. b Relatie van aangelegde spanning en corresponderende etssnelheid voor de vorming van SiNW's
Om de bias-gemoduleerde kinetiek in MaCE-reactie verder te onthullen, werden de vergelijkbare hoogviskeuze oplossingen gebruikt. Dit werd bereikt door etsregens te mengen in 90% van de IPA-oplosmiddelen. De relatie tussen de diffusiecoëfficiënt en de viscositeit kan als volgt worden uitgedrukt [23],
$$ \mathrm{D}=\mathrm{AT}/{\upeta}^{\mathrm{p}} $$ (1)waarin D is de diffusiecoëfficiënt, A is de empirische constante, T de temperatuur, η is de viscositeit van het oplosmiddel en p de viscositeitsexponent. Dienovereenkomstig is de viscositeit van IPA-oplosmiddel 2,1 mPa.s bij 25 ° C, die meer dan 2,3 keer groter is dan die van water (viscositeit =0,9 mPa s). Daarom kan men de ionendiffusiviteiten van beide H2 . verwachten O2 en F−-ionen in IPA-medium waren veel lager dan die in waterconditie. Zoals aangegeven in Fig. 3a, werden de dunne poreuze structuren met een dikte van 170,3 nm gecreëerd onder een ets van 5 minuten wanneer er geen bias werd gebruikt. Dit werd bijgedragen door het feit dat de betrokken IPA-oplosmiddelen een hoge viscositeit hadden die bedoeld waren om de gaten in een willekeurige oriëntatie uit te spreiden, en dus werden de poreuze kenmerken in plaats van eendimensionale structuren gevormd. Om de ladingsaccumulatie voor het starten van verticaal etsen van Si te vergemakkelijken, werden de verschillende positieve vooroordelen geïntroduceerd, zoals weergegeven in Fig. 3b-d. Opgemerkt moet worden dat bij een lage betrokken bias, waaronder +-20 V en +-30 V, de filmdikte van poreuze structuren duidelijk was toegenomen, wat leidde tot verbeterde etssnelheden van 34,0 nm/min (0 V), 62,2 nm/min (+ 20 V) richting 92,1 nm/min (+ 30 V).
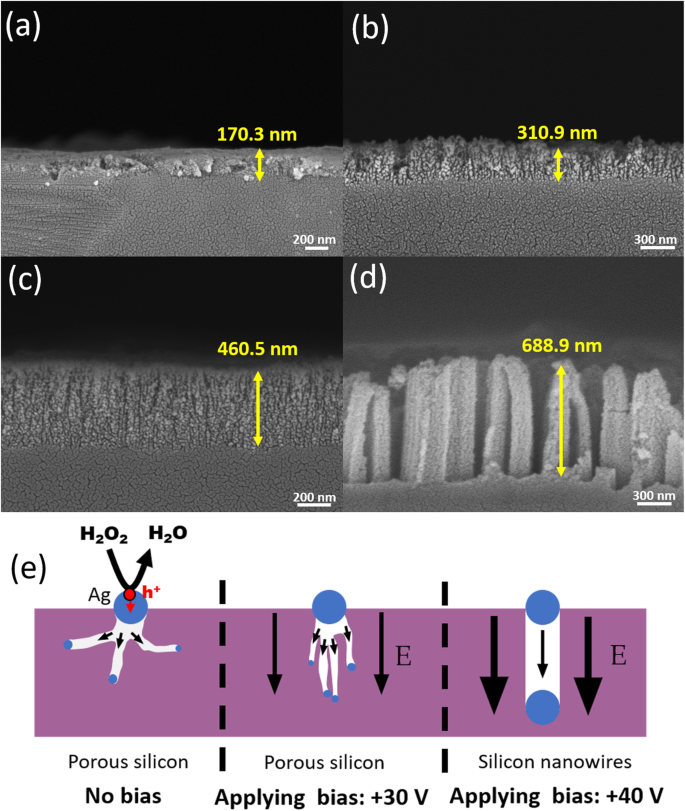
Transversale SEM-afbeeldingen van Si-nanostructuren verkregen uit a MacE zonder vooringenomenheid, b MaCE met + 20 V, c MaCE met + 30 V, en d MaCE met + 40 V. e Schematische illustraties van de vorming van nanostructuren onder verschillende bias-omstandigheden
Deze resultaten valideerden het effect van vooringenomenheid die in wezen de etskinetiek domineert, waarbij werd aangenomen dat de meeste van de gescheiden gaten werden verzameld en geaccumuleerd net onder de plaatsen van Ag-katalysatoren, waardoor de diepere etsmorfologieën werden geïnitieerd. Toen de toegepaste bias werd verhoogd tot +-40 V, bleek de veld-gemedieerde gatrectificatie de invloeden op vertraagde diffusie van reactieve ionen te overweldigen, de dynamiek van willekeurig en verdeeld etsen werd daarom overgebracht naar het directionele etsgedrag; de verticaal uitgelijnde SiNW-arrays werden gerealiseerd en vertoonden de hoogste etssnelheden tot 137, 8 nm / min onder deze vier testikelomstandigheden, zoals weergegeven in figuur 3d. Het duidelijke vormingsmechanisme met betrekking tot de aangelegde voorspanning kan worden begrepen uit figuur 3e. Het gaf aan dat de isotrope diffusieroutes van het gat leidden tot de vorming van de dunne poreuze film wanneer er geen bias werd geïntroduceerd. Daarentegen werd het relatief anisotrope gatentransport gevonden onder de betrokkenheid van een bescheiden vooringenomenheid, waarbij de gegenereerde poriën uiteindelijk langs de voorspanningsoriëntatie bewogen en de kenmerken van meerdere poriën vaststelden. Bij een hoge bias-conditie werden de geïnjecteerde gaten gedwongen zich op te hopen bij katalysator / Si-interfaces en synergetisch naar Si te bewegen na het polarisatieveld, waardoor de verticaal geëtste profielen werden gecreëerd.
Bovendien werd de bevochtigbaarheid van het oppervlak van bereide Si-texturen onderzocht, waarbij alle monsters zes keer op verschillende posities werden gemeten, zoals weergegeven in Fig. 4. Er is gemeld dat de gemeten contacthoek gecorreleerd was met de ruwheid van nanostructuren volgens aan de onderstaande vergelijking [24, 25],
$$ \mathrm{cos}\uptheta ={\mathrm{Rfcos}\uptheta}_{\mathrm{e}}-\mathrm{R}\left(1-\mathrm{f}\right) $$ (2 )waarin θ en θ e zijn de contacthoek van respectievelijk ruwe en vlakke Si-oppervlakken, en R geeft de ruwheidsfactor weer. Bovendien, f is de oppervlaktefractie van de lucht/wateroppervlakken. Het bleek dat de gemiddelde contacthoeken van vier verschillende monsters 109,8 0 waren ± 10.8 0 in het geval van etsen zonder bias, 108.4 0 ± 9.2 0 met + 20 V bias, 105,4 0 ± 7,6 0 met + 30 V voorspanning en 103,6 0 ± 1.6 0 met +-40 V bias, zoals getoond in Fig. 4. De sterk verminderde afwijking bij gemeten contacthoek van het gebruik van +-40 V kan worden toegeschreven aan de relatief uniforme topografie op geëtste oppervlakken, wat aangaf dat het gebruik van bias in MaCE niet alleen in staat om de etssnelheid te verbeteren, maar kon de uniformiteit van het geluidetsen die essentieel was voor de praktische toepassingen, verder behouden.
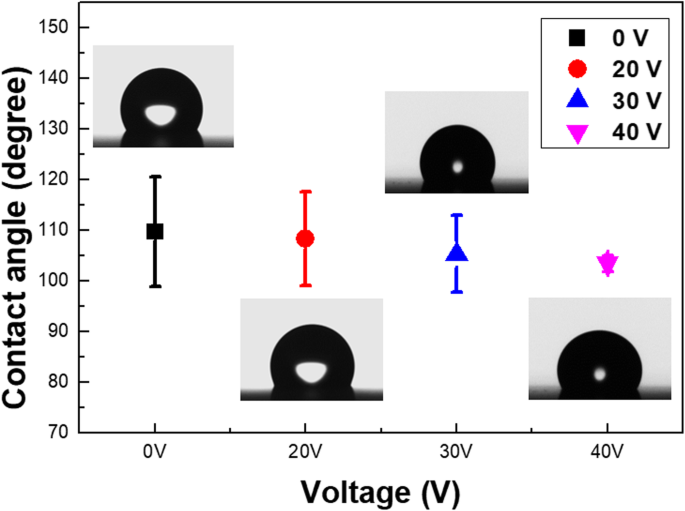
Contacthoek meetresultaten van Si-oppervlakken
Naast de modulatie van etssnelheden, zou de etsoriëntatie ook kunnen worden gemanipuleerd met de externe bias, zoals weergegeven in figuur 5a. In deze test werd de combinatie van MaCE met nanosfeerlithografie uitgevoerd voor het definiëren van de Ag-patronen door middel van zelf-geassembleerde polystyreen nanosferen [26]. Door tijdens het MaCE-proces de verticale voorspanning ten opzichte van de substraatvlakken toe te passen, werd de directionele ets langs de voorspanningsoriëntatie gecreëerd, waar de verticaal gereguleerde SiNW-arrays werden gevormd, zoals weergegeven in figuur 5b. Het omschakelen van de etsrichting van het verticale kenmerk naar een schuin profiel werd gerealiseerd door de elektrische polarisatie te variëren op 60 ° met betrekking tot de richting in het vlak. Hoewel de bias werd gemoduleerd, resulteerde dit in het algemeen in de vorming van schuine / verticale SiNW-arrays met twee segmenten, zoals weergegeven in figuur 5c.
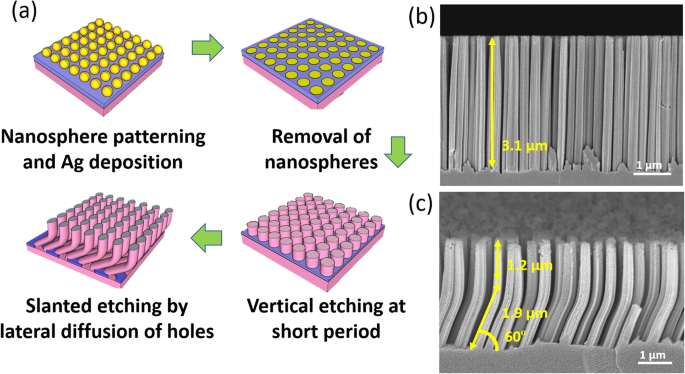
een Schematische weergave van de processtroom voor de vorming van schuine/verticale SiNW-arrays. Transversale SEM-afbeeldingen van b verticale SiNW's en c schuine/verticale SiNW's
In tegenstelling tot de typische manier om de NW-oriëntatie te variëren door de diffusie-gecontroleerde lokale verandering van etsmiddelconcentraties in de etsconditie [27, 28], bleven hier zowel de concentraties van oxidatiemiddelen als etsmiddelen consistent en dus werd de variatie van de etsrichting voornamelijk bijgedragen van de externe bias. Dit zou aanleiding kunnen geven tot de haalbaarheid van de realisatie van driedimensionale verwerkingscapaciteit. Ten slotte werd de zichtbare reflectie onderzocht van zowel verticale als op twee segmenten gebaseerde SiNW-arrays, zoals aangetoond in Fig. 6. De gemeten reflectieresultaten bevestigden duidelijk dat de schuine/verticale SiNW-arrays met een gemiddelde reflectie van 2,8% de vergelijkbaar lagere lichtsterkte bezaten. reflectievermogen dan dat van enige verticale SiNW-arrays (gemiddelde reflectie =5,4%) die de zichtbare banden bedekken. Om het experimentele onderzoek verder te bevestigen, werden de gesimuleerde reflectieresultaten ook vergeleken, zoals weergegeven in Fig. 6. Er kon worden vastgesteld dat de gesimuleerde bevindingen goed overeenkwamen met de gemeten resultaten, wat wijst op de superieure antireflectie-eigenschappen van schuine / verticale nanostructuren.
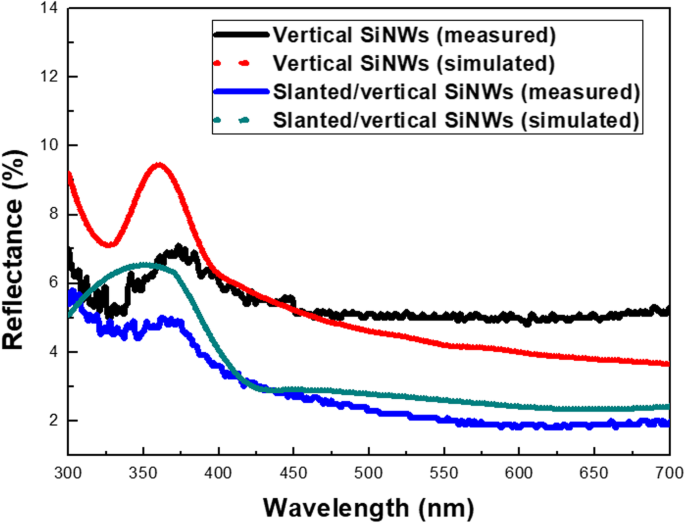
Gemeten en gesimuleerde reflectieresultaten van respectievelijk verticale en schuine/verticale SiNW-arrays
Conclusie
Elektrisch veld ondersteunde MaCE-methode voor de vorming van oriëntatie-gecontroleerde SiNW-arrays met verbeterde etssnelheid werd gepresenteerd. Het onderliggende mechanisme werd opgehelderd door de gecombineerde effecten van gatcorrectie en anodisatie die de etsmorfologieën en -kinetiek konden moduleren. Verder werd de bevochtigbaarheid van het oppervlak onderzocht, wat aangeeft dat de uniformiteit van het grote oppervlak werd gecreëerd terwijl de voorspanning +-40 V was. Door de polarisatie van het aangelegde elektrische veld te manipuleren, werd de overgang van de etsrichting van het verticale kenmerk naar het schuine profiel gerealiseerd. Dergelijke SiNW's met twee segmenten in de vorm van schuine/verticale kenmerken bezaten de sterk verbeterde antireflectie-eigenschappen, die mogelijk nuttig zouden kunnen zijn voor opto-elektronische apparaten, fotonische kristallen en andere multifunctionele toepassingen.
Beschikbaarheid van gegevens en materialen
De datasets die de conclusies van dit artikel ondersteunen, zijn in het artikel opgenomen.
Afkortingen
- FDTD:
-
Tijdsdomein met eindig verschil
- MaCE:
-
Metaal-geassisteerd chemisch etsen
- NSL:
-
Nanosfeerlithografie
- PL:
-
Fotoluminescent
- PS'en:
-
Polystyreen nanobolletjes
- SEM:
-
Scanning elektronenmicroscoop
- SiNW's:
-
Silicium nanodraden
Nanomaterialen
- Elektrische velden en capaciteit
- Magnetische velden en inductie
- Principes van radio
- C++-aanwijzers en arrays
- Relatie tussen arrays en pointers
- Configureerbare inductieve sensor ondersteunt snelle auto- en industriële elektromotoren.
- Modulatie van elektronische en optische anisotropie-eigenschappen van ML-GaS door verticaal elektrisch veld
- Ontrafeling van de morfologische evolutie en etskinetiek van poreuze silicium nanodraden tijdens metaalondersteunde chemische etsing
- Au-Capped GaAs-nanopillar-arrays gefabriceerd door metaalondersteunde chemische etsing
- Optische en elektrische kenmerken van silicium nanodraden bereid door stroomloos etsen
- Laseretsen en lasergraveren



