Optimalisatie van ohmse contacten naar p-GaAs nanodraden
Abstract
De prestaties van ohmse contacten die worden toegepast op halfgeleider nanodraden (NW's) zijn een belangrijk aspect om hun gebruik in elektronische of opto-elektronische apparaten mogelijk te maken. Vanwege de kleine afmetingen en specifieke oppervlakteoriëntatie van NW's, kan de standaardverwerkingstechnologie die op grote schaal is ontwikkeld voor vlakke heterostructuren niet direct worden toegepast. Hier rapporteren we over de fabricage en optimalisatie van Pt/Ti/Pt/Au Ohmic-contacten voor p-type GaAs-nanodraden gegroeid door moleculaire bundelepitaxie. De apparaten werden gekenmerkt door stroom-spanning (IV) metingen. De lineariteit van de IV-karakteristieken van individuele nanodraden werd geoptimaliseerd door de lay-out van de contactmetaallagen, de oppervlaktebehandeling voorafgaand aan metaalverdamping en thermische uitgloeiing na de verwerking aan te passen. Onze resultaten laten zien dat de contactweerstand opmerkelijk wordt verminderd wanneer een Pt-laag wordt afgezet op de GaAs-nanodraad voorafgaand aan de traditionele Ti/Pt/Au meerlagige lay-out die wordt gebruikt voor p-type planaire GaAs. Deze bevindingen worden verklaard door een verbeterde kwaliteit van het metaal-GaAs-grensvlak, wat werd aangetoond door röntgendiffractiemetingen van grazingsincidentie in vergelijkbare dunne metalen films die op GaAs (110)-substraten waren afgezet. In het bijzonder laten we zien dat Ti een lage mate van kristalliniteit vertoont wanneer het wordt afgezet op het GaAs (110)-oppervlak, wat direct de contactweerstand van de NW-apparaten beïnvloedt. De afzetting van een dunne Pt-laag op de NW's voorafgaand aan Ti/Pt/Au resulteert in een afname van 95% van de totale elektrische weerstand van met Be-gedoteerde GaAs NW's, wat wordt geassocieerd met de hogere kristalliniteit van Pt dan Ti wanneer deze direct wordt afgezet op GaAs (110).
Inleiding
Een belangrijke stap in de fabricage van elektronische en opto-elektronische halfgeleiderapparaten is het verkrijgen van hoogwaardige en betrouwbare Ohmse contacten op de metaal-halfgeleiderinterface. Daartoe is GaAs een belangrijk en veelgebruikt materiaal in technologische toepassingen zoals laserapparaten, zonnecellen en fotodetectoren. Daarom is de fabricage van Ohms contact met p-type en n-type gedoteerde GaAs-lagen het doelwit geweest van een groot aantal onderzoeken [1]. Over het algemeen omvat de fabricage van ohmse contacten met halfgeleidermaterialen vier stappen:(1) verwijdering van het oorspronkelijke oxide aan het oppervlak, (2) passivering van de oppervlaktetoestanden op het grensvlak halfgeleider-metaal, (3) afzetting van metallische lagen die fungeren als de elektrische contacten, en (4) thermisch gloeien [2, 3]. Uitgaande van de selectie van metalen die een lage contactweerstand en uitstekende thermische stabiliteit bieden, zijn legeringen op basis van Au op grote schaal gebruikt, met name voor p-type GaAs in de vorm van Au/Zn/Au [1, 3, 4] en Ti/ Pt/Au [1, 5] lagen. Aan de andere kant zijn halfgeleider III-V-nanodraden (NW's) naar voren gekomen als een nieuwere klasse van veelbelovende nanoschaalmaterialen voor toepassing als LED's [6, 7], zonnecellen [8, 9] en fotodetectoren [10], en deze hebben geleid tot specifieke ontwikkelingen op het gebied van apparaatverwerking.
De meerderheid van de in de literatuur gerapporteerde technologie voor Ohmse contactfabricage is ontwikkeld voor GaAs (100) dunne films en bulkstructuren, terwijl de zelfgekatalyseerde groei van GaAs NW's (110) oppervlakteoriëntatie aan de zijwanden oplevert [11,12,13, 14,15]. Verschillende oppervlakteoriëntaties vertonen verschillende elektronische toestanden [16] die de interface-eigenschappen en Schottky-barrièrehoogten beïnvloeden [17,18,19]. Bovendien kan de oppervlakteoriëntatie de kristallisatiedynamiek van de afgezette metaalfilms beïnvloeden. Goede ohmse contacten met p-GaAs NW's werden eerder gerapporteerd [20,21,22,23,24,25,26,27,28] door een variatie aan chemische behandelingen te gebruiken om het natieve oxide, oppervlaktepassivering en verschillende metalen meerlagen te verwijderen gedeponeerd op de NW's. Vervolgens werd gerapporteerd dat het gebruik van Pt/Ti/Pt/Au elektrische contacten op p-type GaAs dunne films een lage ohmse contactweerstand opleverde, zelfs voor matige doteringsconcentraties vanwege de lage Schottky-barrièrehoogte van Pt/GaAs [29]. Bovendien bleek Pt thermisch stabiel te zijn met kleine reactiesnelheden op GaAs voor warmtebehandelingen met temperaturen van 300 tot 500 °C [29,30,31]. Pt/Ti/Pt/Au metalen meerlaags is het meest gerapporteerde [20, 23, 25, 26, 28] ohmse contact met p-GaAs NW's. Een meer uitgebreid begrip van metaaleigenschappen op Ohmse contactvorming is echter de sleutel om de elektrische contactkwaliteit op nanoschaalapparaten verder te verbeteren. Vanwege het brede scala aan NW-groeitechnieken en doteringsconcentraties in p-GaAs NW's die recentelijk zijn gerapporteerd, zou het niet haalbaar zijn om een vergelijking te maken van de contactweerstanden, wanneer deze beschikbaar zijn. In plaats daarvan zou een uitgebreid onderzoek van verschillende contactproductieroutes op dezelfde set NW-monsters geschikter zijn om het effect van NW-eigenschappen uit te sluiten.
Hier behandelen we de effecten van verschillende op Pt en Ti gebaseerde elektrische contacten en oppervlaktebehandelingen voorafgaand aan metaalverdamping op de algehele stroom-spanning (IV) kenmerken van zelfgekatalyseerde Be-gedoteerde GaAs NW's gekweekt op Si-substraten [11, 32 ]. We analyseren de veranderingen in de totale weerstand van de NW-kanalen op basis van structureel onderzoek door röntgendiffractie van Ti-, Pt- en Pt/Ti-dunne films afgezet op GaAs (110)-substraten. We laten zien dat een hoge contactweerstand geassocieerd is met een lage kristalliniteit van Ti wanneer het rechtstreeks op GaAs (110) wordt afgezet, terwijl Pt/Ti/Pt/Au elektrische contacten resulteren in een opmerkelijke afname van de contactweerstand, die wordt toegeschreven aan de verbetering van de kwaliteit van de metaallaag waargenomen in de eerste Pt/Ti-lagen afgezet op het GaAs (110)-oppervlak.
Materialen en methoden
Nanodraad-groei
De zelfgekatalyseerde Be-gedoteerde GaAs NW's werden gekweekt door solid-source moleculaire bundelepitaxie (MBE) op lithografie-vrije oxidepatronen vervaardigd op p-Si (111) substraten door druppelepitaxie en spontane oxidatie [32]. De NW-groeitemperatuur was 640 °C, zoals bepaald met een pyrometer, en er werd een Ga-flux gebruikt die overeenkomt met een vlakke groeisnelheid van 0,3 m/h op GaAs (100). Een bevochtiging van 60 s Ga ging vooraf aan de NW-groei, die werd geïnitieerd door As2 met V/III bundel equivalente drukverhouding van 9 en Be flux overeenkomend met 2.0 × 10 19 cm −3 p-type dopingconcentratie; dit werd bepaald uit de groei van vlakke Be-gedoteerde GaAs (100) kalibratiemonsters door Hall-metingen bij kamertemperatuur. De groeiduur was 60 min. Meer details over de groeimethodologie en de structurele eigenschappen van de ongedoteerde en Be-gedoteerde NW's zijn te vinden in Refs. [11, 32, 33]. Kortom, de NW's zijn samengesteld uit puur zinkblend GaAs met de vorming van enkele tweelingvlakken [33]. De NW's hebben een hexagonale vorm met zijwanden die uitsluitend zijn samengesteld uit (110) georiënteerde facetten, zoals eerder werd bepaald uit structurele analyse van de met Be-gedoteerde NW's [33] en verder bevestigd in niet-gedoteerde GaAs NW's die onder vergelijkbare omstandigheden zijn gekweekt [12].
Vervaardiging en karakterisering van contacten
De NW's werden mechanisch overgebracht naar een p-GaAs (100) substraat bedekt met een 200 nm dik SiO2 laag, die vooraf werd gevormd door fotolithografie en elektronenstraalverdamping van Ti / Au-pads voor transportkarakterisering. De positie van de overgedragen draden op het substraat werd geïdentificeerd door middel van scanning-elektronenmicroscopie met lage vergroting (SEM) beeldvorming. Positieve elektronenstraalresist werd spin-gecoat op het substraat en belicht met elektronenstraal op de elektrische contactgebieden. De resist is ontwikkeld in MIBK:IPA-oplossing na blootstelling aan een elektronenstraal en mogelijk gevolgd door een zuurstofplasmabehandeling om de resterende resist van de NW-zijwanden te verwijderen, zoals beschreven in tabel 1. De effecten van de zuurstofplasmabehandeling op de prestaties van het apparaat zijn later in de tekst besproken. Voorafgaand aan de metaalverdamping van de contactlagen, werden de monsters chemisch behandeld om het natuurlijke oxide te verwijderen en de blootgestelde NW-zijwanden te passiveren, zoals later in de tekst wordt beschreven. De lift-off werd gedaan door het monster in verwarmde aceton te dompelen, te spoelen in IPA en te föhnen met stikstof.
We hebben vijf verschillende processen ontwikkeld die verschillende oppervlaktebehandelingen van de blootgestelde NW-zijwanden combineren met verschillende metalen meerlagen die als elektrische contacten worden gebruikt. Hierdoor konden we de individuele bijdragen van elke parameter in de resulterende contactweerstand bepalen wanneer toegepast op de p-type GaAs NW's. Voor de verwijdering van natuurlijke oxide aan het oppervlak gebruikten we ofwel een 2,8% NH4 OH of 3,7% HCl verdund in H2 O gevolgd door H2 O spoelen. Voor de oppervlaktepassivering gebruikten we een 15% oplossing van (NH4 )2 Sx verdund in H2 O (verwarmd tot 45 °C) gevolgd door H2 O spoelen. De metalen meerlaagse lagen werden afgezet met behulp van e-beam-verdamping en waren ofwel Ti/Pt/Au (20/20/200 nm) of Pt/Ti/Pt/Au (5/10/10/200 nm). Een snelle thermische annealing (RTA) van 400 °C gedurende 30 s werd gebruikt voor de Pt/Ti/Pt/Au meerlaagse laag. De processen die voor elk monster worden gebruikt, worden gespecificeerd in tabel 1. Voor elk monster werden 4 gelijkmatig verdeelde elektrische contacten langs de NW-as gefabriceerd. In dit werk beperken we de IV-analyse tot de contactparen in het middengebied van het NW. De IV-gegevens zijn verkregen bij kamertemperatuur met behulp van een Keysight-sondestation.
Structureel onderzoek door begrazingsincidentie röntgendiffractie
Om de structurele eigenschappen van de elektrische contacten op de NW's te onderzoeken, werden grazing-inval röntgendiffractie (GIXRD) patronen gemeten van referentie Ti, Pt en Pt/Ti dunne films verdampt op ongedoteerde GaAs (110) substraten. We hebben de dunne-filmmonsters gemaakt die worden beschreven in tabel 2 met behulp van natuurlijke oxideverwijdering door HCl:H2 O en oppervlaktepassivering door (NH4 )2 Sx op dezelfde manier als voor de NW-apparaten. De kleine invalshoek van de röntgenstralen die in GIXRD worden gebruikt, stelt ons in staat om metaalfilms te analyseren met dezelfde dikte als gebruikt in de NW-contacten vanwege de kleine penetratiediepte. De GIXRD-patronen werden gemeten met Cu Kα-straling met een golflengte van 1,54 Å en een invalshoek van ω =0,75 ° ten opzichte van het monsteroppervlak. De diffractiepiekposities zijn geïndexeerd volgens ICDD-bestanden #00-044-1294 en #00-004-0802 voor respectievelijk hexagonaal-dicht verpakt (HCP) Ti en vlakgecentreerd kubisch (FCC) Pt, en worden gecorrigeerd door rekening te houden met het effect van breking van de röntgenstralen in GIXRD-experimenten zoals beschreven in Ref. [34].
Resultaten en discussie
Figuur 1a toont de IV-kenmerken voor monsters P1 tot P5, en figuur 1b een SEM-afbeelding van een Be-gedoteerde GaAs NW met elektrische contacten die worden gebruikt voor transportkarakterisering. De bijna symmetrische, niet-lineaire vorm van de IV's voor P1 tot P4 in Fig. 1a geeft aan dat de contacten van het Schottky-type zijn met vergelijkbare barrièrehoogten voor elk contact [35]. De niet-lineariteit van de IV voor monster P1 toont duidelijk aan dat het standaard p-GaAs-proces zoals in P1 geen Ohmse contacten oplevert zoals het geval is voor vlakke dunne GaAs-films. Gewoonlijk wordt in gedoteerde GaAs NW's HCl-oxideverwijdering gebruikt, mogelijk gevolgd door (NH4 )2 Sx oppervlaktepassivering voorafgaand aan metaalverdamping voor ohmse contactvorming [20, 21, 36, 37] in plaats van NH4 OH. Bovendien is eerder een zuurstofplasmabehandeling van het blootgestelde NW-oppervlak gebruikt om de resterende resist van de NW-zijwanden te verwijderen [36, 38]. Als bijwerking kan dit proces echter oppervlaktedefecten in GaAs veroorzaken, zoals As-vacatures, wat resulteert in donorachtige vallen die verantwoordelijk zijn voor compensatie van de drager en daardoor de uitputtingslaagbreedte vergroten [5].
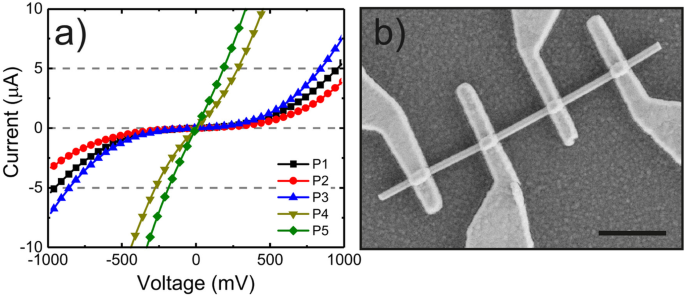
een IV van Be-gedoteerde GaAs NW's met elektrische contacten vervaardigd met behulp van de processen P1-P5 zoals beschreven in tabel 1. b SEM-afbeelding van een representatieve Be-gedoteerde GaAs NW met vier gelijkmatig verdeelde elektrische contacten. De schaalbalk is 1 μm
Om het effect van de zuurstofplasmabehandeling op de contactweerstand van p-GaAs NW's te evalueren, vergelijken we de IV van een monster met (P2) en zonder (P3) zuurstofplasmareiniging voorafgaand aan de oppervlaktebehandeling door HCl en (NH4 )2 Sx in afb. 1a. P2 levert de slechtste IV-prestatie (gedefinieerd als de elektrische stroomwaarde voor dezelfde aangelegde spanning) in alle monsters, maar monster P3 vertoont op zijn beurt een betere IV-prestatie dan het standaard p-GaAs-proces P1, en het met zuurstofplasma gereinigde P2. Dit impliceert twee significante resultaten:(i) het effect van de zuurstofplasmabehandeling is nadelig voor de contactweerstand, en (ii) de P3 met HCl-oxideverwijdering gecombineerd met (NH4 )2 Sx oppervlaktepassivering zorgt voor een lagere Schottky-barrièrehoogte van de metaal-halfgeleiderinterface in vergelijking met P1.
De IV-prestaties en het Ohmse karakter (kwalitatief beoordeeld door de IV-lineariteit) waren sterk verbeterd in P4 in vergelijking met P3 door een 5-nm Pt-laag toe te voegen onder de Ti/Pt/Au-multilaag, zoals te zien is in figuur 1a. De contactweerstand is verder verlaagd in P5 na RTA 30 s bij 400 ° C, waardoor een lineair IV-gedrag en verbeterde IV-prestaties worden bereikt in vergelijking met P4.
Om het effect van de verwerkingsparameters op de contactweerstand van monsters P1-P5 (chemische behandelingen, metallische meerlaagse lagen) te kwantificeren, tonen we in Fig. 2a de IV's van P1-P5 met een kleiner biasbereik; in dit geval vertonen de IV's lineair gedrag en worden ze voornamelijk bepaald door de contactweerstand [35]. De totale weerstand van het kanaal (contacten + NW) in het bereik van 100 mV uit figuur 2a werd berekend op basis van een lineaire passing van de IV-karakteristiekencurve, en de resultaten worden getoond in figuur 2b. Omdat de diameters van alle onderzochte NW's vergelijkbaar zijn en er slechts een kleine variatie van draad tot draad in de doteringsconcentratie is, zoals we eerder hebben gemeld [33], werden eventuele veranderingen van de totale weerstand toegeschreven aan de contactweerstand. De hogere weerstand in P2 in vergelijking met P1 en P3 bevestigt het nadelige effect van zuurstofplasmabehandeling uit de kwalitatieve analyse van de IV's in figuur 1a. Een opmerkelijk resultaat is de afname van de totale weerstand van 1400 kΩ in P3 tot 72 kΩ in P4 en een verdere afname tot 40 kΩ na RTA in P5, bereikt door een extra Pt-laag aan te brengen voorafgaand aan de Ti/Pt/Au-multilaag die wordt gebruikt in monsters P1-P3.
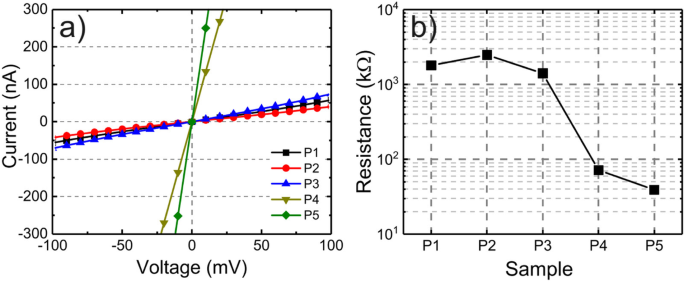
een IV van P1 tot P5 in het 100 mV toegepaste spanningsbereik. b Totale kanaalweerstand van de P1-P5 verkregen uit lineaire passing van de IV's in a
Een meer uitgebreid begrip van de microstructuur van de metaal-halfgeleiderinterface na de contactproductie is vereist om een correlatie vast te stellen van de veranderingen in de contactweerstand waargenomen in monsters P1-P5. Het gebruik van Ti en Pt in Ohmse contactfabricage met GaAs is eerder gerapporteerd [39, 40], en de structurele eigenschappen van dunne Ti- en Pt-films zijn verdampt tot GaAs (100) oppervlak [41] en amorfe glassubstraten [42, 43] ] zijn ook geanalyseerd. Er werden echter geen dergelijke gedetailleerde studies gevonden voor GaAs (110) -oppervlak. Verwacht wordt dat de verschillende oppervlakteoriëntatie de kristallisatiedynamiek van de Ti- en Pt-dunne films zal beïnvloeden. Bovendien is de oppervlaktechemische passivering door (NH4 )2 Sx zou de resulterende dunne films verder kunnen beïnvloeden. De mate van kristallisatie van Pt (5 nm), Ti (20 nm) en Pt/Ti (5/20 nm) dunne films afgezet op ongedoteerd GaAs (110) substraat werd onderzocht door GIXRD om informatie te verkrijgen over de structurele eigenschappen van de eerste metaallagen in contact met de NW's in P1-P5. Voorafgaand aan de metaalverdamping ondergingen de GaAs (110)-substraten de natuurlijke oxideverwijdering door HCl:H2 O en de (NH4 )2 Sx oppervlaktepassiveringstappen als de NW-monsters P3-P5. De details van de oppervlaktebehandelingen en metallische dunne films die zijn verdampt op GaAs (110)-substraat zijn samengevat in tabel 2.
De GIXRD-patronen van monsters S1-S4 worden getoond in het diffractiehoekbereik van 30 tot 60 ° in figuur 3a en in het bereik van 60 tot 90 ° in figuur 3b. De diffractiepatronen in figuur 3 zijn verticaal verschoven en gescheiden in twee diffractiehoekbereiken om een betere schaling voor visualisatie te bieden. Eerst richten we ons op het effect van (NH4 )2 Sx oppervlaktepassivering op de mate van kristalliniteit van Ti-films verdampt op GaAs (110) substraat door monsters S1 en S2 te vergelijken. In Fig. 3a zien we overlappende lage intensiteit Ti (002) en Ti (101) pieken gecentreerd op respectievelijk 38,4 en 40,2 ° voor zowel S1 als S2. Verder wordt voor beide monsters ook een significant bredere Ti (102)-piek gecentreerd op 53,0 ° waargenomen, wat een amorf karakter suggereert. De Ti (103)-piek gecentreerd op 70,6 ° in figuur 3b wordt alleen waargenomen voor S1, wat de enige significante ongelijkheid tussen de monsters is. In het algemeen duiden de lage intensiteiten en brede pieken van S1 en S2 op een slechte kristalliniteit van de Ti-films wanneer ze worden afgezet op GaAs (110) oppervlak na verwijdering van HCl-oxide en ongeacht het gebruik van (NH4 )2 Sx passivering. In het geval van S3, waarvoor Pt werd afgezet op GaAs (110)-substraat met dezelfde oppervlaktebehandeling als in S2, zien we veel meer uitgesproken Pt (111), Pt (200), Pt (220), Pt (311), en Pt (222) diffractiepieken gecentreerd op respectievelijk 39,8°, 46,3°, 67,5°, 81,3° en 85,7°. Dit geeft aan dat de Pt-film in S3 een hogere mate van kristalliniteit vertoont in vergelijking met de Ti-monsters. Hetzelfde geldt voor S4 die vergelijkbare Pt-diffractiesignaturen vertoont als S3 in Fig. 3a, b. De brede en asymmetrische pieken tussen 35°–45°, 65°–75° en 75°–90° voor S4 worden gevormd door de overlapping van Ti (002)-Ti (101)-Pt (111), Ti ( respectievelijk 103)-Pt (220), en Ti (004)-Pt (311)-Pt (222) diffractiepieken. Een kwalitatieve vergelijking van de GIXRD-patronen van S2, S3 en S4 impliceert dat de kristalliniteitsgraad van Ti in S4 minstens op hetzelfde niveau ligt als in S1. De Ti (103)-piek bij 70,6 ° wordt waargenomen als een duidelijke schouder op de Pt (220)-piek in Fig. 3b en de Ti (102)-piek bij 53,0 ° in Fig. 3a is aanwezig met een lage intensiteit maar smalle lijnbreedte in S4 terwijl het een zeer brede, amorfe piek vertoont in S1 en S2. Dit resultaat suggereert een verbeterde mate van kristalliniteit van Ti wanneer het wordt afgezet op Pt in plaats van op het GaAs (110)-oppervlak, wat in het volgende direct zal worden gecorreleerd met de elektrische contacteigenschappen beschreven in Fig. 1 en 2.
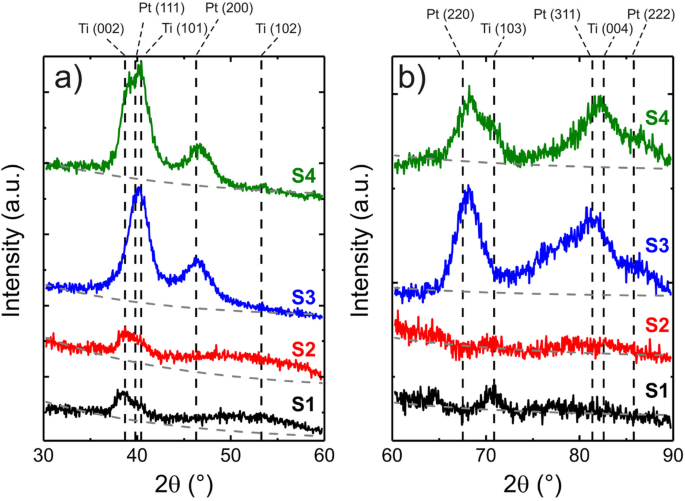
GIXRD-patronen uit samples S1-S4 van de a 30 tot 60° diffractiehoekbereik en (b ) 60 tot 90 ° bereik. De gestippelde grijze lijnen vertegenwoordigen exponentiële vervalbasislijnen die afkomstig zijn van diffuse röntgenverstrooiing. De verticale gestippelde zwarte lijnen komen overeen met de verschillende diffractievlakken van Ti en Pt, aangeduid bovenaan a en b
De GIXRD-analyse van de metaallagen in S1-S4 stelt ons in staat om de mate van kristalliniteit van Ti en Pt afgezet op GaAs (110) -substraat en de totale weerstandsresultaten van P1-P5 in figuur 2b te correleren. Het is belangrijk om te benadrukken dat we in dit werk onze correlaties van de veranderingen in de totale weerstand van P1-P5 voornamelijk baseren op de GIXRD-gegevens verkregen van S1-S4. We nemen aan dat andere factoren, zoals de kwaliteit van de metaal-NW-interface vanwege de hexagonale geometrie van de NW-zijwanden, een verwaarloosbare bijdrage leveren aan de totale weerstandsveranderingen die worden waargenomen in P1-P5. De (NH4 )2 Sx oppervlaktepassivering heeft een gunstig effect op de eigenschappen van het GaAs-metaalgrensvlak, zoals blijkt uit vergelijking van de IV en totale weerstand van monsters P1 en P3, maar met een lage mate van kristalliniteit van de Ti-film wanneer deze rechtstreeks op het GaAs-oppervlak (110) wordt afgezet , zoals waargenomen in S1 en S2. Dit zou het gevolg kunnen zijn van een reactie van zwavel met het overgroeide Ti. Bovendien is gemeld dat Ti zeer reactief is met de resterende onzuiverheden in de verdampingskamer tijdens metaalafzetting [41], waardoor extra lagen tussen het metaal/GaAs worden gevormd en daardoor de contactweerstand toeneemt [5]. Zoals eerder besproken, werd de toename van de contactweerstand in P2 toegeschreven aan de mogelijke oppervlaktebeschadigingen veroorzaakt door de zuurstofplasmareiniging. De toevoeging van een dunne Pt-laag tussen het Ti- en GaAs (110)-oppervlak zoals in S4 resulteert in een hogere mate van kristalliniteit van de Ti-film in vergelijking met S1 en S2. Dit resultaat kan worden gecorreleerd met de afname van de totale kanaalweerstand van 1400 kΩ in P3 naar 72 kΩ in P4, wat gepaard gaat met een afname van de contactweerstand. De RTA verlaagt verder de totale kanaalweerstand tot 40 kΩ in P5 naast de toename van het Ohmse karakter van de IV getoond in Fig. 2a. Dit resultaat geeft aan dat er geen schadelijke reacties optreden tussen Pt en GaAs-oppervlak in de gebruikte gloeitemperatuur en tijd [29,30,31].
Conclusies
De invloed van chemische oppervlaktebehandeling voorafgaand aan metaalverdamping en de vorming van Ohmse contacten met Be-gedoteerde zelfgekatalyseerde GaAs NW's werd onderzocht door de transportkarakterisering van enkele NW's te correleren en structurele analyse van Ti-, Pt- en Pt/Ti-dunne films afgezet op GaAs-substraten. We laten zien dat Ti een lage mate van kristalliniteit vertoont wanneer het wordt afgezet op een GaAs (110)-oppervlak, wat direct de contactweerstand van de NW-apparaten beïnvloedt. De afzetting van een dunne Pt-laag op de NW's voorafgaand aan Ti/Pt/Au resulteert in een afname van 95% van de totale elektrische weerstand van met Be-gedoteerde GaAs NW's, wat wordt geassocieerd met de hogere kristalliniteit van Pt dan Ti wanneer deze direct wordt afgezet op GaAs (110). Daarnaast laten we zien dat thermisch gloeien van de metaallagen de contactweerstand verder verlaagt. Deze bevindingen zijn van technologisch belang bij het ontwerpen van Ohmse contacten voor op GaAs NW's gebaseerde apparaten en tonen de individuele bijdragen van elke verwerkingsstap, beschreven in tabel 1, in de totale weerstand en het ohmse karakter van de NW-apparaten. Om de prestaties van het apparaat verder te verbeteren, zou een systematische optimalisatie van de parameters van elke afzonderlijke stap vereist zijn. We laten in het bijzonder zien dat de metaal-halfgeleiderinterface aan de NW-zijwanden een belangrijke rol speelt in de prestaties van het apparaat en de weg opent naar verder onderzoek naar het kristallisatieproces van metallische dunne films die zijn afgezet op verschillende oppervlakteoriëntaties van III-V halfgeleidermaterialen.
Beschikbaarheid van gegevens en materialen
De datasets die de conclusies van deze studie ondersteunen, zijn opgenomen in het artikel.
Afkortingen
- FCC:
-
Gezichtsgecentreerd kubisch
- GIXRD:
-
Begrazingsincidentie Röntgendiffractie
- HCP:
-
Zeshoekig-gesloten verpakt
- IV:
-
Stroom–spanning
- NW:
-
Nanodraad
- RTA:
-
Snel thermisch gloeien
- SEM:
-
Scanning elektronenmicroscopie
Nanomaterialen
- Wolfraamcontacten voor elektrische apparaten
- Switch contactontwerp
- Contact opnemen met "Bounce"
- Tijdvertragingsrelais
- Digitale logische functies
- Contactlens
- Materiaalwetenschappers leren nanodraden te 'dansen'
- Hoogreflecterende dunnefilmoptimalisatie voor micro-LED's met volledige hoek
- Multi-Layer SnSe Nanoflake Field-Effect Transistors met Au Ohmic-contacten met lage weerstand
- Au-Capped GaAs-nanopillar-arrays gefabriceerd door metaalondersteunde chemische etsing
- Amorfe silicium nanodraden gegroeid op siliciumoxidefilm door gloeien



