Uniform-sized Indium Quantum Dots gegroeid op het oppervlak van een InGaN epitaxiale laag door een tweestaps koelproces
Abstract
Er wordt een nieuwe methode voorgesteld om met MOCVD Indium-kwantumdots (in QD's) op het oppervlak van een epitaxiale InGaN-laag te laten groeien. Er is gevonden dat kwantumdots van uniforme grootte zich vormen op het oppervlak van een InGaN-laag wanneer een koelproces in twee stappen wordt uitgevoerd. Door analyse hebben we ontdekt dat de vorming van In QD's op het oppervlak te wijten is aan de reactie tussen de In-rijke oppervlaktelaag en het dragergas H2 bij de lagere temperatuurperiode in het koelproces in twee stappen. Tegelijkertijd biedt dit ons een manier om de oppervlakte-eigenschap van de InGaN-laag rechtstreeks te bestuderen, aangezien de dichtheid van In-QD's sterk afhankelijk is van de In-rijke oppervlaktelaag.
Inleiding
De afgelopen jaren hebben (Al, In, Ga)N-gebaseerde materialen veel aandacht getrokken vanwege hun succesvolle toepassing in een lichtgevend apparaat (LED) en laserdiode (LD) [1,2,3,4, 5]. InGaN heeft een hoge absorptie, brede spectrale dekking en stralingshardheid en wordt altijd gebruikt als een actief materiaal voor de fabricage van opto-elektronische apparaten. Het telen van hoogwaardige InGaN-materialen is echter een grote uitdaging vanwege een aantal problemen. Het grote verschil in roosterconstante tussen InN en GaN resulteert bijvoorbeeld in een mengkloof in vaste fase [6, 7]. De relatief hoge dampdruk van InN in vergelijking met GaN leidt tot een lage indiumopname in de InGaN-legering [8]. Bovendien veroorzaakt een groot verschil in formatie-enthalpieën voor InN en GaN een sterke indium-oppervlaktesegregatie op het groeifront [9]. Aan de andere kant, in het proces van InGaN-laaggroei, bestaat er altijd een In-rijke laag op het oppervlak vanwege het trekkende effect, wat de kwaliteit van de volgende laag van InGaN/GaN meervoudige kwantumput (MQW) zal beïnvloeden door het introduceren van indiumatomen in de daaropvolgende groei van de GaN-laag [10]. Om de hoge prestaties van InGaN-gebaseerde opto-elektronische apparaten te krijgen, moeten we al deze obstakels overwinnen. Tijdens het onderzoek wordt altijd de groei van een enkele InGaN-laag gebruikt om de groeiparameter van InGaN/GaN MQW te optimaliseren. In dit artikel vonden we af en toe kwantumdots van uniforme grootte op het oppervlak van de enkele InGaN-laag bij het uitvoeren van een tweestaps afkoelingsproces dat het normale eenstaps afkoelingsproces vervangt na de groei van de enkele InGaN-laag. Door analyse hebben we ontdekt dat de vorming van In QD's gerelateerd is aan de In-rijke laag die bestaat op het oppervlak van de InGaN-laag, en dat biedt ons een manier om de In-rijke oppervlaktelaag rechtstreeks te bestuderen.
Experiment
Monsters die in deze studie werden gebruikt, waren enkele InGaN-lagen die waren gegroeid op c-vlak saffiersubstraat door een AIXTRON 6 × 2 in een nauw gekoppelde douchekopreactor metaalorganische chemische depositie (MOCVD) in een N2 atmosfeer. Trimethylgallium (TMGa), trimethylindium (TMIn) en ammoniak (NH3 ) worden gebruikt als respectievelijk Ga-, In- en N-bronvoorlopers. De enkele InGaN-lagen met een dikte van minder dan 60 nm en het In-gehalte van minder dan 15% werden gekweekt op een 2 μm dikke onbedoelde doping GaN-laag na een 25-nm GaN-bufferlaag die was gegroeid op een saffiersubstraat. Het structuurschema wordt getoond in Fig. 1. H2 en N2 worden in verschillende perioden van het groeiproces als dragergas gebruikt. Conventioneel is de N2 wordt gebruikt als dragergas in het proces van InGaN-laaggroei omdat H2 heeft een corrosief effect op de InGaN-laag, wat de efficiëntie van In-opname grotendeels zal verminderen [11, 12]. Echter, H2 aangezien draaggas de oppervlaktemobiliteit van atomen aanzienlijk kan verbeteren en de onzuiverheidsconcentratie kan verminderen. Daarom, H2 wordt bij voorkeur gebruikt als dragergas tijdens de groei van de GaN-laag om de kristalkwaliteit te verbeteren. In het algemeen werd, wanneer de groei van de InGaN-laag voltooid was, de temperatuur direct verlaagd tot kamertemperatuur in een stikstofatmosfeer. Hier noemen we zo'n proces "eenstapskoeling". In dit artikel is na de groei van de InGaN-laag een zogenaamd tweestaps koelproces toegepast, waarbij de temperatuur in de eerste koelperiode in een stikstofatmosfeer werd verlaagd tot 400 ° C en vervolgens wordt teruggebracht tot kamertemperatuur in een H2 atmosfeer. Röntgendiffractie met hoge resolutie (XRD), atoomkrachtmicroscopie (AFM), scanning-elektronenmicroscoop (SEM) en energiedispersieve spectrometer (EDS) worden gebruikt om de InGaN-monsters te karakteriseren.
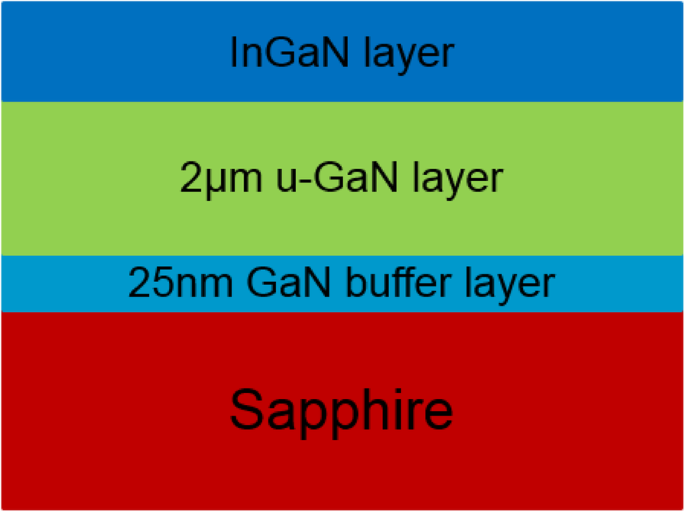
Het structuurschema van de enkele InGaN-laag gegroeid op een GaN-sjabloon met behulp van een saffiersubstraat
Resultaat en discussie
Er is een abnormale oppervlaktetopografie van de InGaN-laag gevonden bij kweek op een enkele InGaN-laag op de GaN-sjabloon met een tweestaps afkoelproces. De AFM-oppervlaktemorfologie van de InGaN-monsters met eenstapskoeling en tweestapskoeling wordt respectievelijk getoond in Fig. 2a en b. Figuur 2a toont een typische oppervlaktemorfologie van de InGaN-epillaag, waaruit we kunnen opmaken dat de InGaN-laag een duidelijke stappenstroom 2D-groei heeft. Tegelijkertijd zijn er veel 3D-eilanden op het monsteroppervlak waarvan wordt toegeschreven dat ze verband houden met schroefdislocatielijnen in de GaN-laag. Het is ook te zien dat er een donkere stip op de bovenkant van elk 3D-eiland zit, waarvan is bewezen dat het de v-put is die is gevormd langs de dislocatie van de schroef [13, 14]. In tegenstelling tot figuur 2a, behalve het stapstroomoppervlak en de 3D-eilanden, zijn er ook veel kwantumstippen van uniforme grootte (de kleine witte stippen in de afbeelding) in figuur 2b. Gecombineerd met de inzet van Fig. 2b in de linker bovenhoek, wat een 3D-diagram van het oppervlak is, kunnen we krijgen dat de gemiddelde grootte voor deze kwantumstippen ongeveer 100 nm × 100 nm is, de gemiddelde hoogte ongeveer 20 nm, en de dichtheid is ongeveer 1,6 × 10 8 cm −2 . Opgemerkt wordt dat het belangrijkste verschil tussen deze twee verschillende manieren van monsterkoeling is dat H2 wordt gebruikt als draaggas in plaats van N2 in de tweede afkoelperiode van het tweestapskoelproces. Daarom is de vorming van kwantumdots op het oppervlak van de InGaN-laag gerelateerd aan het dragergas H2 in het koelproces bij lage temperatuur.
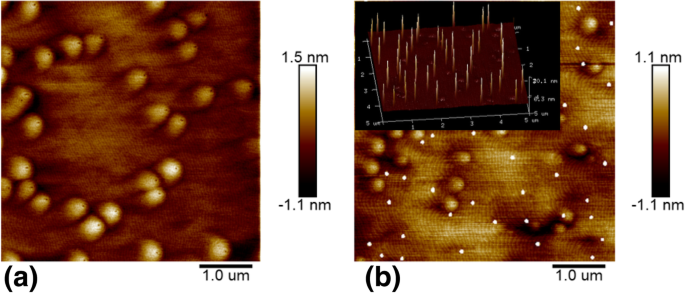
AFM oppervlaktetopografie van a InGaN-monster met koeling in één stap en b InGaN-monster met koelproces in twee stappen waarbij de inzet een 3D-diagram van het oppervlak is
Om te begrijpen hoe dit gebeurt wanneer een koelproces in twee stappen wordt uitgevoerd op InGaN-monsters, doen we een koelexperiment in twee stappen op GaN in plaats van op InGaN. Deze GaN-laag werd gekweekt onder dezelfde omstandigheden als de enkele InGaN-laagmonsters die in dit werk werden bestudeerd, d.w.z. bij een relatief lagere groeitemperatuur van 740 °C en N2 wordt gebruikt als draaggas. De AFM-oppervlaktopografie van de GaN-laag na een tweestaps koelproces wordt getoond in figuur 3a. We kunnen ontdekken dat er geen kwantumstippen op het oppervlak bestaan en dat het oppervlak precies hetzelfde is als eenstaps-koelende MOCVD-gegroeide GaN-laagmonsters zoals algemeen is gerapporteerd [15]. Daarnaast hebben we gekeken wat er gebeurt als het tweestaps koelproces wordt gebruikt voor een InGaN-laagmonster met een zeer laag In-gehalte waarbij het In-gehalte slechts 1% is. Fig. 3b toont de AFM-oppervlaktemorfologie van dit InGaN-monster met een laag In-gehalte na een tweestaps koelproces. Het blijkt dat de dichtheid van kwantumdots een zeer grote afname heeft in vergelijking met het hierboven genoemde InGaN-monster met hoog In-gehalte, waarvan het In-gehalte ongeveer 13% is. Deze resultaten betekenen dat de vorming van kwantumdots op het oppervlak van de InGaN-laag in het tweestapskoelproces gecorreleerd is met het In-atoom, en deze kwantumdots kunnen een van de In-toestand zijn die wordt gevormd door de reactie tussen de InGaN laag en draaggas H2 bezig met tweede koeling.
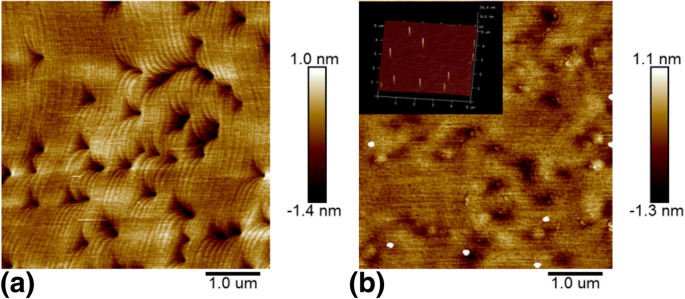
AFM-oppervlaktopografie van monsters met tweestapskoeling. een GaN-laag. b InGaN-laag met In-gehalte 1%
Eerdere studies hebben aangetoond dat er drie verschillende toestanden van In-atomen bestaan in het proces van InGaN-laaggroei [16, 17]. De eerste is de In-atomen in het kristalrooster van een InGaN-legering, het belangrijkste onderdeel en het doelproduct van de groei van de InGaN-laag; de tweede is de InN-legering die altijd op het oppervlak van de InGaN-laag verschijnt; en de derde is de In-druppel die in een speciale groeiconditie kan verschijnen. Verschillende toestanden van het In-atoom kunnen worden onderscheiden door XRD-spectra omdat ze verschillende diffractiepieken hebben in de ω/2θ-scanmodus. Om te bepalen tot welke In-toestand deze stippen behoren, is XRD-meting gedaan voor de InGaN-monsters met een- of tweetraps koelprocessen. Figuur 4 toont de typische XRD ω/2θ-spectra voor monsters met koeling in twee stappen (rode lijn) en koeling in één stap (blauwe lijn). Er werden drie karakteristieke pieken gevonden voor de monsters met tweestapskoeling, terwijl er slechts twee karakteristieke pieken zijn voor monsters met eenstapskoeling. Dus de extra karakteristieke piek voor de monsters met tweestapskoeling kan de kwantumstippen vertegenwoordigen die zich op het oppervlak vormen. De twee karakteristieke pieken die gewoonlijk in deze monsters voorkomen, bevinden zich rond 33,5° en 34,5°. Ze behoren respectievelijk tot InGaN- en GaN-kristal. Hoewel is geverifieerd dat de extra karakteristieke piek op de 2θ = 32,8° afkomstig is van de In-druppel [16, 17]. We kunnen dus concluderen dat de kwantumstippen die we op het InGaN-oppervlak hebben waargenomen met het tweestapskoelproces de In-druppel is. Om deze conclusie te bevestigen, is SEM-meting uitgevoerd op de monsters met een tweestaps koelproces, het resultaat wordt getoond in Fig. 5a, waaruit we ook kunnen zien dat de stippen op het oppervlak bestaan. Om deze punten te identificeren, is EDS op dezelfde plaats genomen, Fig. 5b-d toont de oppervlakte-atoomverdeling voor respectievelijk In, Ga en N, waaruit we kunnen afleiden dat het atoom van Ga en N gelijkmatig is verdeeld over het oppervlak, terwijl de concentratie aan In-atomen op de stippen veel groter is dan de omgeving, wat aangeeft dat deze stippen rijk zijn aan In. Dus gecombineerd met de bovenstaande analyse kunnen we concluderen dat draaggas H2 kan bij lage temperatuur reageren met de InGaN-laag en druppels vormen op het oppervlak.
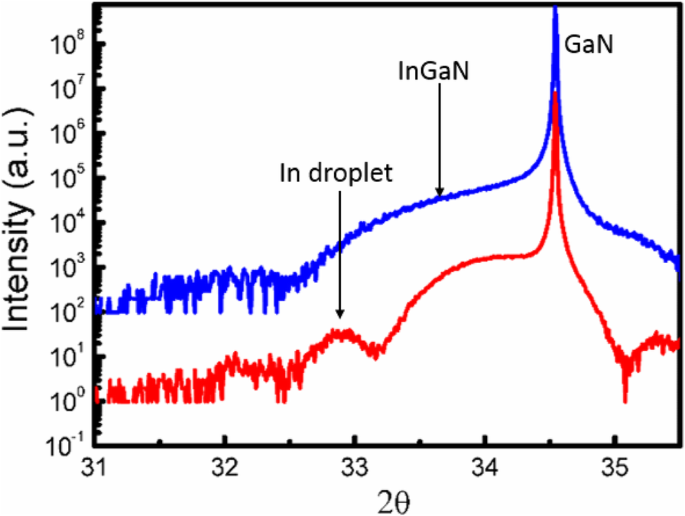
De XRD-spectra voor monster met koeling in twee stappen (rode lijn) en koeling in één stap (blauwe lijn)
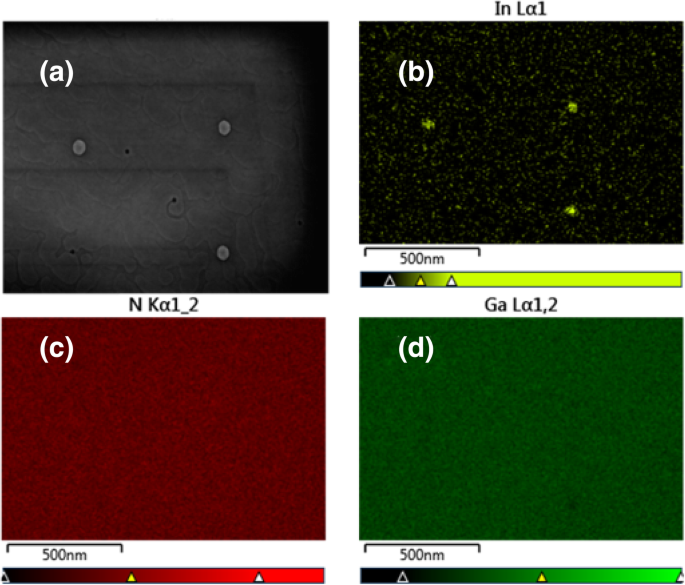
een De SEM-oppervlaktefotografie voor het monster met een koelproces in twee stappen, b –d is het resultaat van de EDS-elementanalyse voor respectievelijk atoom In, N en Ga
Er is gemeld dat er vaak een In-rijke laag wordt gevormd op het oppervlak van de InGaN-epitaxiale laag vanwege het oppervlaktetrekkende effect [10]. In ons experiment werden de monsters direct afgekoeld tot kamertemperatuur na de groei van een enkele InGaN-laag, wat betekent dat de In-rijke oppervlaktelaag nog steeds op het oppervlak aanwezig is tijdens het koelproces. Daarom zijn er twee mogelijkheden voor de oorsprong van het In-atoom voor de In QD's die we hebben waargenomen:respectievelijk de InGaN-laag en de In-rijke oppervlaktelaag. Om te weten wat de oorsprong is van het In-atoom van de In-kwantumstippen en hoe de reactie verloopt, zijn verdere experimenten uitgevoerd. Het is bekend dat een gloeiproces de In-rich laag kan wegvegen [18]. Daarom nemen we een thermisch gloeiproces voor de InGaN-monsters vóór het tweestaps koelproces. De tijd van het thermische gloeiproces is ingesteld op 60 s en de temperatuur is ongeveer 800 °C, wat 60° hoger is dan de groeitemperatuur van de InGaN-laag. De AFM-topografie van het InGaN-monster met een gloeiproces vóór het tweestaps koelproces wordt getoond in Fig. 6, er zijn duidelijk geen kwantumstippen op het oppervlak. In vergelijking met Fig. 2a kan echter een grote verandering van de oppervlaktetopografie worden gevonden, het oppervlak wordt ruwer. Het ontbreken van In-quantumdots op het oppervlak laat zien dat de InGaN-laag geen In QD's zou vormen met H2 in het tweede koelproces, omdat thermisch gloeien alleen de in-rijke laag kan wegvagen. Dus de vorming van In-quantumdot op het oppervlak van de InGaN-laag in het tweestapskoelproces is te wijten aan de reactie tussen de In-rijke oppervlaktelaag en het dragergas H2 in het lage temperatuurbereik.
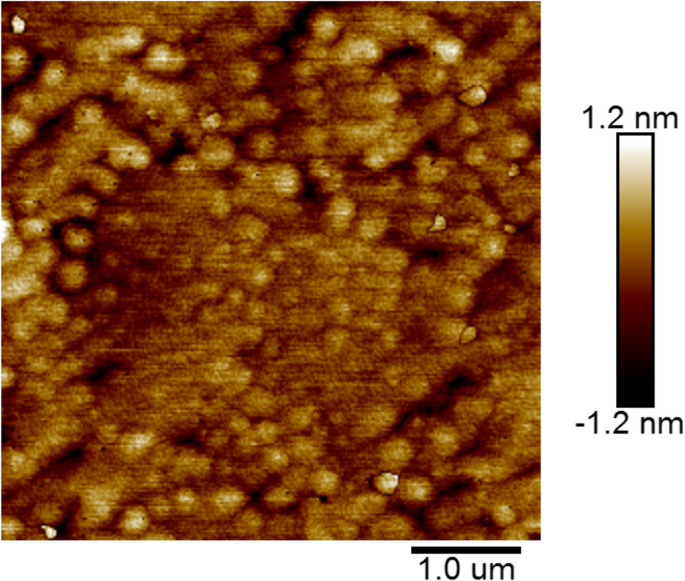
De AFM-oppervlaktopografie van de InGaN-laag met een thermische uitgloeiing vóór de tweestapskoeling.
Het corrosieve effect van H2 over de groei van de InGaN-laag is grotendeels gerapporteerd. Het is bekend dat H2 kan verhinderen dat de In-atomen in het rooster worden opgenomen [19, 20], en dat is de belangrijkste reden waarom conventioneel alleen N2 wordt gebruikt als dragergas in de MOCVD-groei van InGaN-lagen. Het corrosieve effect van H2 op de InGaN-laag kan worden gezien als een omgekeerd proces van de groei van de InGaN-laag, wat kan worden uitgedrukt door de volgende chemische reactie:
$$ {3\mathrm{H}}_2+2\mathrm{In}\mathrm{N}\to 2\mathrm{In}+{2\mathrm{NH}}_3 $$De vorming van In-quantumdots in het tweestapskoelproces kan worden gezien als een soort corrosief effect, maar er zijn enkele verschillen tussen hoge temperatuur (om InGaN te laten groeien met H2 ) en lage temperatuur (om InGaN af te koelen en In QD's te vormen met H2 ). Bij hoge temperatuur heeft het In-atoom gevormd door het corrosieve effect op het oppervlak voldoende energie om over de grenslaag van het oppervlak te ontsnappen, waardoor de efficiëntie van In-opname afneemt. Bij lage temperaturen (onder 400 °C) laten onze resultaten echter zien dat H2 heeft alleen een corrosief effect op de sterk ingesloten oppervlaktelaag, aangezien deze laag onstabieler is dan de InGaN-laag. Aan de andere kant, aangezien de temperatuur lager is dan 400 °C, kunnen de In-atomen op het oppervlak veel minder tijdig over de oppervlaktegrens ontsnappen, zodat ze op het monsteroppervlak migreren en dan In-druppels op het oppervlak vormen.
In onze studie, aangezien de vorming van In QD's gerelateerd is aan de hoge In-laag op het InGaN-oppervlak, kunnen ze direct wat informatie geven over de InGaN-rijke oppervlaktelaag van InGaN. De InGaN-laagmonsters met verschillende In-inhoud en dikte worden gebruikt om tweestaps koelbehandelingsexperimenten uit te voeren. Figuur 7 toont de oppervlaktetopografie van InGaN-lagen met verschillende In-inhoud en dikte. Het In-gehalte is respectievelijk 7,65%, 8,45% en 9,6% voor monsters A, B en C, en de dikte van de InGaN-laag voor deze drie monsters is bijna hetzelfde (ongeveer 13,4 nm). Uit de AFM-oppervlaktemorfologieën van monster A, B en C kunnen we vinden dat de dichtheid van In QD's toeneemt met het In-gehalte in de InGaN-laag. En de dichtheid van QD's is ongeveer 2,4 × 10 7 cm −3 , 4,8 × 10 7 cm −3 , en 9,2 × 10 7 cm −3 respectievelijk voor monsters A, B en C, terwijl de grootte van QD's voor deze monsters bijna hetzelfde is. Aan de andere kant heeft monster D hetzelfde In-gehalte als monster A (7,65%), terwijl de laagdikte ongeveer 41 nm is. Vergelijk het oppervlak voor twee monsters van A en D, het is duidelijk dat de dichtheid van In-quantumdots toeneemt wanneer de dikte van de InGaN-laag toeneemt. Uit onze hierboven genoemde analyse blijkt dat de vorming van deze In quantum dots wordt veroorzaakt door de reactie van H2 met de in-rijke oppervlaktelaag bij lage temperatuur. Dus de veranderende neiging van In QDs-dichtheid kan de toestand van de In-rijke oppervlaktelaag weerspiegelen, dat wil zeggen, de onstabiele In-atomen die bestaan in de In-rijke oppervlaktelaag, ze nemen toe samen met de toename van het In-gehalte en de dikte van de InGaN laag. Dit resultaat is consistent met eerdere theoretische studies die hebben aangetoond dat het In-gehalte van de In-rijke oppervlaktelaag gerelateerd is aan het In-gehalte en de dikte van de InGaN-lagen [21]. Dit bewijst ook dat het vormingsmechanisme van In-quantumdots inderdaad gerelateerd is aan het oppervlak van de In-rijke laag.
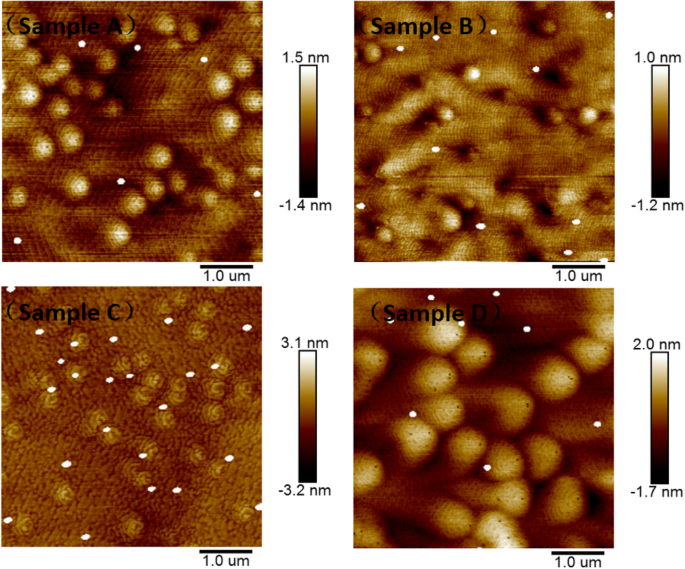
De AFM-oppervlaktopografie van InGaN-lagen a , b , c , en d met verschillende In inhoud en dikte (zie tekst)
Conclusie
In dit artikel hebben we een nieuwe methode geïntroduceerd om In QD's van uniforme grootte op het oppervlak van een InGaN-laag te verkrijgen. We vonden een uniforme In QD-vorm op het oppervlak van een InGaN-laag bij het uitvoeren van een koelproces in twee stappen. Door een gedetailleerde analyse hebben we ontdekt dat de vorming van In-quantumdots op het oppervlak te wijten is aan de reactie tussen de In-rijke oppervlaktelaag en het dragergas H2 bij een lage temperatuur. Tegelijkertijd laten onze experimenten zien dat H2 heeft alleen een corrosief effect op de In-rich oppervlaktelaag wanneer de temperatuur lager is dan 400 ° C, en dit corrosieve proces zal In QD's op het oppervlak vormen. Aan de andere kant, aangezien de vorming van In QD's nauw verwant is aan de In-rijke laag op het oppervlak, kan een dergelijk proces ons een manier bieden om de eigenschap van deze laag rechtstreeks te bestuderen.
Methode
Het doel van dit artikel is om een nieuwe methode te introduceren om In QD's van uniforme grootte op het oppervlak van de InGaN-laag te krijgen. Monsters die in deze studie werden gebruikt, werden gekweekt door een AIXTRON 6 × 2 in een close-coupled showerhead reactor metalorganic chemical deposition (MOCVD). Röntgendiffractie met hoge resolutie (XRD), atoomkrachtmicroscopie (AFM), scanning-elektronenmicroscoop (SEM) en energiedispersieve spectrometer (EDS) worden gebruikt om de InGaN-monsters te karakteriseren. Alle deelnemers aan deze studie zijn de wetenschapper van de University of Chinese Academy of Sciences of China.
Beschikbaarheid van gegevens en materialen
De datasets die tijdens het huidige onderzoek zijn gebruikt en/of geanalyseerd, zijn op redelijk verzoek verkrijgbaar bij de corresponderende auteur.
Afkortingen
- AFM:
-
Atoomkrachtmicroscopie
- EDS:
-
Energiedispersieve spectrometer
- GaN:
-
Galliumnitride
- In QD's:
-
Indium kwantumstippen
- InGaN:
-
Indium-galliumnitride
- InN:
-
Indiumnitride
- LD:
-
Laserdiode
- LED:
-
Lichtgevend apparaat
- MOCVD:
-
Metaalorganische chemische afzetting
- MQW:
-
Meerdere kwantumbronnen
- NH3 :
-
Ammoniak
- QD's:
-
Kwantumstippen
- SEM:
-
Scanning elektronenmicroscoop
- TMGa:
-
Trimethylgallium
- TMIn:
-
Trimethylindium
- XRD:
-
Röntgendiffractie
Nanomaterialen
- N,N-dimethylformamide die de fluorescentie van MXene Quantum Dots reguleert voor de gevoelige bepaling van Fe3+
- Het ontwerp van de emissielaag voor elektronenvermenigvuldigers
- Bismut Quantum Dots in gegloeide GaAsBi/AlAs Quantum Wells
- Amorfe silicium nanodraden gegroeid op siliciumoxidefilm door gloeien
- De oppervlaktemorfologieën en eigenschappen van ZnO-films afstemmen door het ontwerp van grensvlakken
- Defecten op het oppervlak van Ti-gedoteerde MgAl2O4-nanofosfor
- Groei beheersen Hoge uniformiteit Indiumselenide (In2Se3) nanodraden via het snelle thermische gloeiproces bij lage temperatuur
- Vervaardiging en karakterisering van ZnO-nanoclips door het door polyol gemedieerde proces
- Interband fotogeleiding van metamorfe InAs/InGaAs Quantum Dots in het venster van 1,3–1,55 µm
- Subtiele nanostructurering van het Au/Ru(0001) oppervlak
- Belangrijkste factoren die de resultaten van het vlakslijpproces beïnvloeden



