Low-power resistieve schakelkarakteristiek in HfO2/TiOx bi-layer resistief willekeurig geheugen
Abstract
Resistive random-access geheugenapparaten met atomaire laagafzetting HfO2 en radiofrequentiesputteren TiOx aangezien resistieve schakellagen met succes werden vervaardigd. Laagvermogenkarakteristiek met 1,52 μW ingesteld vermogen (1 μA@1,52 V) en 1,12 μW resetvermogen (1 μA@1,12 V) werd verkregen in de HfO2 /TiOx resistieve RRAM-apparaten (Random Access Memory) door het zuurstofgehalte van de TiOx . te regelen laag. Daarnaast is de invloed van het zuurstofgehalte tijdens de TiOx sputterproces op de resistieve schakeleigenschappen zou in detail worden besproken. Uit de onderzoeken bleek dat "zachte storing" gemakkelijk optrad tijdens het elektrische vormings-/hardingsproces in de HfO2 /TiOx RRAM-apparaten met een hoog zuurstofgehalte van de TiOx laag, wat resulteert in een hoog resistief schakelvermogen. Low-power karakteristiek werd verkregen in HfO2 /TiOx RRAM-apparaten met een voldoende hoge zuurstofdichtheid van TiOx laag, wat suggereert dat de juiste dichtheid van de zuurstofvacature in de TiOx laag zou "zachte afbraak" door de hele diëlektrische lagen kunnen voorkomen tijdens het vormings- / instelproces, waardoor de stroom die door het RRAM-apparaat vloeit wordt beperkt en het bedrijfsstroomverbruik wordt verminderd.
Inleiding
Resistief random-access memory (RRAM) biedt een veelbelovende oplossing voor het verkleinen van het traditionele, op ladingen gebaseerde geheugen dankzij de eenvoudige celstructuur, niet-vluchtige opslag, snelle werking en hoge aan/uit-verhouding [1,2,3, 4,5,6,7,8,9,10]. Onlangs is één transistor één weerstand (1T1R) een algemeen aanvaarde structuur om onnauwkeurige weerstandsmetingen te voorkomen die worden veroorzaakt door een sluippadstroom in 1R-array [11, 12]. Bovendien is het opkomende geheugen, met name op oxide gebaseerde RRAM, voorgesteld voor plastic synaptische apparaten vanwege de geleidelijke geleidingsmodulatie met pulsgetal, dat biologisch synaptisch gedrag kan nabootsen om signalen van pre- en postsynaptische neuronen te ontvangen [13,14,15 ,16,17]. Hoge resistieve schakelstroom is echter de belangrijkste beperking voor toepassingen met laag vermogen en hoge dichtheid [18,19,20]. De 1T1R-array wordt ook geconfronteerd met schaaluitdagingen als de bedrijfsstroom van RRAM dienovereenkomstig niet kan worden geschaald. Wanneer de CMOS-technologie bijvoorbeeld wordt verkleind tot 27 nm, zal de aandrijfstroom afnemen tot 40 μA [21]. Daarom is het nodig om de bedrijfsstroom van het RRAM-apparaat terug te brengen tot 10 A door de structuur en het materiaal te optimaliseren om de 1T1R-schaalbaarheid voort te zetten [22]. Bovendien verbruiken biologische synapsen ongeveer 1 ~ 10 fJ per gebeurtenis in het complexe menselijke brein, waardoor het energieverbruik van elektrische synaptische apparaten zo weinig als biologische synapsen belangrijk is voor de ontwikkeling van neuromorfe kunstmatige neurale netwerken (ANN's) [23, 24,25]. Daarom zal het beperken van de apparaatstroom en het verminderen van het stroomverbruik het praktische proces voor gegevensopslag en neuromorfische computertoepassingen ten goede komen.
In dit werk, Pt/HfO2 /TiOx /Pt-apparaten met een ander zuurstofgehalte van TiOx film werden vervaardigd, en low-power karakteristiek bij een laag zuurstofgehalte werd gedemonstreerd. Het geheugenapparaat bereikte een ingesteld vermogen van 1,52 μW en een resetvermogen van 1,12 μW door het verlagen van het zuurstofgehalte van de TiOx film tijdens het sputteren. Het geleidende mechanisme voor low-power karakteristieken is verder geanalyseerd om inzicht te krijgen in het ontwerp van oxide RRAM.
Methoden
De Pt/HfO2 /TiOx /Pt-apparaatstructuur en fabricageproces worden getoond in Fig. 1a en b. In eerste instantie op Si/SiO2 /Ti-substraat, werd een 100 nm Pt-bodemelektrode (BE) bereid door gelijkstroom (DC) sputteren bij kamertemperatuur. Vervolgens 3 nm HfO2 werd afgezet door atomaire laagafzetting (ALD) (Picosun R200) techniek bij 300 ° C met behulp van TEMAH en H2 O als voorlopers. Vervolgens 30 nm TiOx werd afgezet met verschillende zuurstofgehalte door sputteren op radiofrequentie. Tijdens TiOx filmsputterproces, fixeert de totale gasstroom van argon (Ar) en zuurstof (O2 ) als 20 sccm en het veranderen van de partiële zuurstofdruk met 9%, 11% en 13%, werden drie monsterapparaten (S1, S2 en S3) verkregen om de invloed van het zuurstofgehalte van TiOx film over de resistieve schakelprestaties. Daarna werd een 70-nm Pt-topelektrode (TE) afgezet door DC-sputteren en van een patroon voorzien met lithografie. Ten slotte werden 100 m × 100 μm vierkante apparaten gevormd door reactieve ionenetsing (RIE). Bias-spanning werd toegepast op de TE en de BE was verbonden met de grond. De hoge resolutie transmissie-elektronenmicroscoop (HRTEM) beelden van de dwarsdoorsnede van de Pt/HfO2 /TiOx /Pt worden getoond in Fig. 2. De elektrische kenmerken van de apparaten werden gemeten met Agilent B1500A halfgeleiderparameteranalysator. De chemische toestanden van atomen in de TiOx films werden onderzocht met röntgenfoto-elektronenspectroscopie (XPS, Axis Ultra).
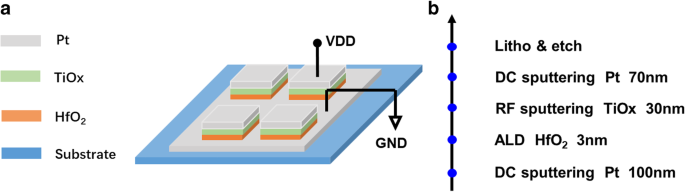
een De structuur van Pt/HfO2/TiOx /Pt-apparaat. b De fabricageprocesstroom
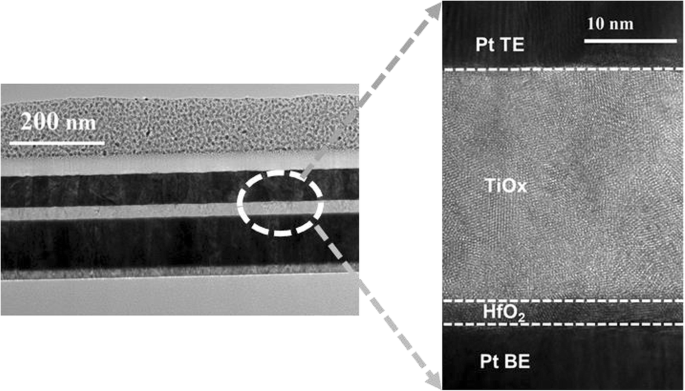
TEM-doorsneden van de Pt/HfO2 /TiOx /Pt-apparaat
Resultaten en discussie
Afbeelding 3a, b en c tonen de XPS O 1s-spectra op kernniveau van TiOx films. Om de chemische binding van zuurstof in de films te verduidelijken, worden de asymmetrische O 1s-pieken verdeeld in twee pieken, die over het algemeen worden toegeschreven aan de O 2− gebonden door metaalionen en O 2− in het zuurstofarme gebied [26]. Partiële zuurstofdruk tijdens TiOx het filmsputterproces werd ingesteld op respectievelijk 9%, 11% en 13%, en het overeenkomstige zuurstofarme gehalte in drie monsters is ongeveer 28,23%, 24,06% en 23,63%, wat aangeeft dat het gehalte aan niet-roosterzuurstofionen en zuurstofvacatures nemen af met toenemende partiële zuurstofdruk.

O 1s XPS-scanspectra van TiOx films in S1, S2 en S3. De partiële zuurstofdruk is ingesteld als a 9%, b 11%, en c 13% tijdens TiOx film sputterproces
Voor de nieuwe apparaten bevindt de oorspronkelijke staat zich in de hoge weerstandsstatus (HRS). Zoals weergegeven in figuur 4, wordt stroomvorming (CF) toegepast om de vorming van de geleidende gloeidraad te initiëren en de apparaatstatus te veranderen in een lage weerstandsstatus (LRS) [27]. Bij het toepassen van 1 μA stroomcompliantie, wordt een geleidend pad gevormd in S1 en kan het stabiele set/reset-proces worden bereikt in de daaropvolgende bewerking. Voor S2 en S3 is de resetbewerking niet succesvol vanaf de middelste status van het apparaat tijdens het CF-proces totdat de huidige compliantie maximaal 20 mA is.
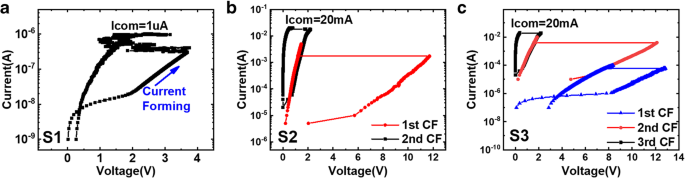
Huidig vormingsproces van de Pt/HfO2/TiOx /Pt RRAM-apparaat in a S1, b S2 en c S3
Om de elektrische prestaties van het RRAM-apparaat te testen, worden DC-metingen onder spanningszwaai uitgevoerd. Positieve voorspanning in het vormings- en instelproces wordt toegepast op TE om de geleidende gloeidraad te voltooien, en een negatieve voorspanning in het resetproces is om de gloeidraad te breken. Wanneer de bias heen en weer wordt geveegd, worden 100 cycli van bipolaire schakelstroom-spanning (IV) curves van drie monsters getoond in Fig. 5. De S1-apparaten bereiken stabiele resistieve schakelprestaties onder 10 μA stroomcompliantie, maar de bedrijfsstroom is tot 10 mA voor de andere twee monsters. Het lage-vermogenskenmerk van S1 kan worden toegeschreven aan het hoge zuurstofvacature-gehalte dat al aanwezig was in TiOx film, die de stroom effectief beperkt tijdens het vormings-/setproces.
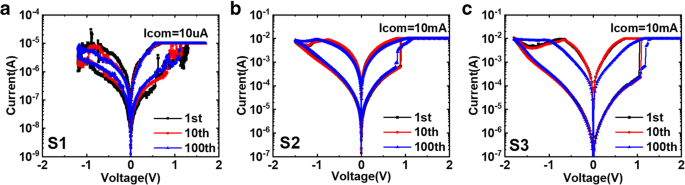
100 cycli stabiele bidirectionele IV-curven in a S1, b S2 en c S3
Afbeelding 6 en 7 geven de cyclus-naar-cyclus en apparaat-naar-apparaat-variatie weer (relatieve standaarddeviatie, (σ /μ )) van drie monsters, en de statistieken zijn samengevat in tabellen 1 en 2. Voor S1 veroorzaakt een zwakke springstroom een bescheiden weerstandsverdeling, en de sterk geleidende filamenten gevormd in S2 en S3 garanderen de relatief stabiele weerstandsverdeling. Hoewel er na tientallen cycli een kleine degradatie is voor S3, is de aan/uit-verhouding nog steeds meer dan 100.

Cyclus-tot-cyclus variatie van RLRS en RHRS voor 100 cycli in a S1, b S2 en c S3

Apparaat-naar-apparaat variatie van RLRS en RHRS voor 20 apparaten in a S1, b S2 en c S3
Zoals weergegeven in Afb. 8, worden het ingestelde vermogen (Pset) 1,52 μW en het resetvermogen (Preset) 1,12 μW bereikt bij een lage compliantiestroom van 1 μA. Het stroomverbruik van de andere twee monsters is tientallen milliwatt vanwege 10 mA bedrijfsstroom. Bovendien kunnen de weerstandstoestanden van S1 de retentiekenmerken behouden boven 10 4 s onder 85°C met een aan/uit-verhouding van ongeveer 100, wat stabiel is voor toepassingen voor gegevensopslag.
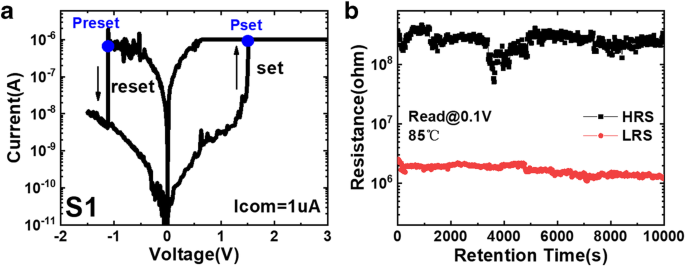
een Resistieve schakelprestaties onder 1 μA stroombegrenzing. b Retentiekarakteristiek in S1 is meer dan 10 4 s onder 85 °C
Om het geleidende mechanisme van de laagvermogenkarakteristiek op te helderen, hebben we temperatuurmetingen uitgevoerd voor S1 en S3 met verschillende bedrijfsstroom en het bijbehorende mechanisme onderzocht, zoals getoond in Fig. 9 en 10. Van 25 °C tot 125 °C neemt de weerstand van S1 af met de temperatuur, maar de weerstand van S3 verandert bijna niet. De experimentele geleiding en temperatuur zijn uitgerust met Mott's variabel bereik hopping-model [28], zoals weergegeven in Fig. 11, wat aangeeft dat het belangrijkste geleidende mechanisme van S1 elektronen hoppen is via gelokaliseerde defecten in zuurstofvacatures in diëlektrisch oxide [29]. Bij het verlagen van de partiële zuurstofdruk tijdens de TiOx sputterproces, zoals weergegeven in S1, het zuurstofvacature-gehalte in initiële TiOx laag neemt toe en de filmweerstand neemt af [30]. De spanning op de TE wordt voornamelijk toegepast op de HfO2 laag en een massa zuurstofvacatures worden gemotiveerd om het geleidende filament te vormen. Daarna worden ook nieuwe zuurstofvacatures gemotiveerd in de TiOx laag, maar de verbinding tussen zuurstofvacatures is zwak. Daarom is de geleiding van elektronen in TiOx is dominant, wat zorgt voor een lage 1-μA resistieve schakelstroom.

een De weerstand verandert met de temperatuur in S1. b Het bijbehorende schematische diagram van geleidend mechanisme

een De weerstand verandert met de temperatuur in S3. b Het bijbehorende schematische diagram van geleidend mechanisme

Temperatuurafhankelijkheid van de conductantie van S1 in a LRS en b HRS
Echter, zoals getoond in Fig. 10, na verhoging van het zuurstofgehalte tijdens TiOx sputterproces, HRS en LRS blijven vrijwel onveranderd met de temperatuur, die hoogstwaarschijnlijk geassocieerd is met het metaalachtige transportmechanisme, geïnduceerd door elektronentransport door geleidende gloeidraad, bestaande uit geconcentreerde zuurstofvacatures. Vergeleken met het RRAM-apparaat van S1, minder zuurstofvacatures in initiële TiOx laag van S3 zijn niet genoeg voor elektronen hopping geleiding. Bovendien, vanwege de verhoogde weerstand van TiOx film, wordt de spanningsbias toegepast op beide HfO2 laag en TiOx laag tegelijk. Elektrische initialisatie leidt tot voldoende zuurstofvacatures gemotiveerd in HfO2 en TiOx lagen. Deze zuurstofvacatures vormen een sterk geleidend filament in beide twee diëlektrische lagen, en de overvloedige verlengde elektronen stromen door de twee aangrenzende zuurstofvacatures, wat een hoge bedrijfsstroom veroorzaakt tijdens het resistieve schakelproces.
In principe is het mogelijk om het zuurstofgehalte zorgvuldig te regelen om prestaties met een laag vermogen te bereiken in andere oxide-resistieve geheugens (OxRRAM) die verband houden met de zuurstofleegte. De vereiste voor de oxidelaag is dat er in de begintoestand voldoende zuurstofvacatures moeten zijn voor elektrische hopping-geleiding in het geval dat het apparaat uitvalt. De overmatige zuurstoftekorten zullen echter een onstabiele uithoudingskarakteristiek veroorzaken en de prestaties van het apparaat verslechteren. Daarom zijn de juiste zuurstoftekorten nodig om de bedrijfsstroom te beperken en het stroomverbruik te verminderen.
Tabel 3 vergelijkt enkele van de belangrijkste parameters van de Pt/HfO2 /TiOx /Pt-apparaat met andere recente rapporten. Het apparaat heeft belangrijke voordelen van een laag resistief schakelvermogen van 1,12 W en een verhouding van meer dan 100 HRS/LRS tussen verschillende RRAM-apparaten.
Conclusies
In dit werk werd 1-μA resistieve schakelstroom gedemonstreerd in Pt/HfO2 /TiOx /Pt structuur apparaat. Voor het geleidende mechanisme is de geleiding van elektronensprongen dominant bij een laag zuurstofgehalte van de TiOx laag, die de bedrijfsstroom beperkt en het stroomverbruik verlaagt. Metaalachtig transport is dominant bij een hoog zuurstofgehalte van de TiOx laag en "zachte afbraak" van twee diëlektrische lagen veroorzaakt een hoge bedrijfsstroom en een hoog stroomverbruik. Het juiste zuurstofgehalte van TiOx film kan de RRAM-stroom beperken en bijdragen aan de low-power-karakteristiek, wat een oplossing biedt voor grote bedrijfsstroom- en high-power-problemen en veelbelovend is voor toekomstige embedded niet-vluchtige geheugens en het Internet of Things (IoT)-toepassingen.
Afkortingen
- 1T1R:
-
Eén-transistor één-weerstand
- ALD:
-
Atoomlaagafzetting
- ANN's:
-
Kunstmatige neurale netwerken
- BE:
-
Onderste elektrode
- CF:
-
Huidige vorming
- HRS:
-
Staat met hoge weerstand
- HRTEM:
-
Transmissie-elektronenmicroscoop met hoge resolutie
- IoT:
-
Internet der dingen
- I-V:
-
Stroom-spanning
- LRS:
-
Staat met lage weerstand
- Aan/uit-verhouding:
-
HRS/LRS
- OxRRAM:
-
Oxide resistief geheugen
- Voorinstelling:
-
Stroom resetten
- Pset:
-
Vermogen instellen
- RIE:
-
Reactieve ionenetsing
- RRAM:
-
Resistief willekeurig toegankelijk geheugen
- TE:
-
Bovenste elektrode
- XPS:
-
Röntgenfoto-elektronenspectroscopie
- σ /μ :
-
Relatieve standaarddeviatie
Nanomaterialen
- Zuurstof
- Nano grafeem, op silicium gebaseerd flexibel transparant geheugen
- Bipolaire resistieve schakelkenmerken van HfO2/TiO2/HfO2 drielaagse structuur RRAM-apparaten op Pt- en TiN-gecoate substraten vervaardigd door atomaire laagafzetting
- Compliance-vrij ZrO2/ZrO2 − x /ZrO2 resistief geheugen met controleerbaar interfaciaal multistate schakelgedrag
- Een RRAM-geïntegreerde 4T SRAM met zelfremmende resistieve schakelbelasting door puur CMOS logisch proces
- Een collectief onderzoek naar modellering en simulatie van resistief willekeurig toegankelijk geheugen
- Door ferro-elektrisch veldeffect geïnduceerd asymmetrisch resistief schakeleffect in BaTiO3/Nb:SrTiO3 epitaxiale heterojuncties
- Zuurstofreductiereactie op PtCo-nanokatalysator:(Bi)sulfaatanionvergiftiging
- Een onderzoek naar de variabiliteit in contactresistief willekeurig toegankelijk geheugen door stochastisch vacaturemodel
- Vervaardiging van optische schakelpatronen met structureel gekleurde microvezels
- Nieuwe methode maakt computergeheugen van titaniumoxide



