Nieuwe SCR met hoge houdspanning met ingebouwde draaggolfrecombinatiestructuur voor aangrijpende immuniteit en robuuste ESD-bescherming
Abstract
Een nieuwe CMOS-procescompatibele siliciumgestuurde gelijkrichter (HHV-SCR) met hoge houdspanning voor bescherming tegen elektrostatische ontlading (ESD) wordt voorgesteld en gedemonstreerd door simulatie en transmissielijnpulstests (TLP). Het nieuw geïntroduceerde gat (of elektron) recombinatiegebied H-RR (of E-RR) recombineert niet alleen de minderheidsdrager in parasitaire PNP (of NPN) transistorbasis door N+ (of P+) laag, maar biedt de extra recombinatie om de oppervlaktelawinedragers door nieuw toegevoegde P+ (of N+) laag in H-RR (of E-RR), wat zorgt voor een verdere verbetering van de houdspanning (V) u ). Vergeleken met de gemeten V u van 1,8 V laagspanningsgestuurde siliciumgestuurde gelijkrichter (LVTSCR), de V u van HHV-SCR kan worden verhoogd tot 8,1 V met behoud van een voldoende hoge uitvalstroom (I t2> 2.6A). Een verbetering van meer dan vier keer in het cijfer van verdienste (FOM) wordt bereikt.
Inleiding
Met de ontwikkeling van geïntegreerde halfgeleidertechnologie en de consistente miniaturisering van de grootte van halfgeleiderapparaten, wordt de door ESD veroorzaakte schade aan het apparaat ernstiger. Ten koste van een groot chipgebied werden de conventionele apparaten zoals diode- en gate-geaarde N-kanaal MOSFET (ggNMOS) met normale ESD-robuustheid gerapporteerd [1]. Om verbeterde ESD-capaciteit te realiseren met een kleinere apparaatafmeting, werd de laagspanningsgestuurde siliciumgestuurde gelijkrichter (LVTSCR) beschouwd als een aantrekkelijk apparaat vanwege zijn hoge stroomcapaciteit per oppervlakte-eenheid [2]. Voor laagspanningstoepassingen, dankzij de ingebouwde lage triggerspanning (V t1 ) ggNMOS, de LVTSCR met uitstekende ESD-robuustheid is in staat een snellere ESD-reactiesnelheid te bieden dan die verkregen bij conventionele SCR. De sterke inherente positieve feedback veroorzaakt echter een extreem lage V u (1~2 V), die verantwoordelijk is voor vastlopen en voorbijgaande mis-trigger [3]. Dergelijke negatieve effecten kunnen effectief worden onderdrukt door simpelweg V . te verhogen u [3,4,5,6,7,8,9,10,11]. Het apparaat zal vrij zijn van de vergrendeling en voorbijgaande mis-trigger, terwijl de V u hoger is dan de voedingsspanning (VDD). Dienovereenkomstig werden de N+ESD-regio en P+LDD-regio toegevoegd aan SCR met extra maskers en ionenimplantatiestappen om V te verbeteren u [3]. De robuustheid van de ESD kan echter verslechteren als gevolg van de extra vermogensdissipatie samen met de verhoogde V u . Bovendien is de emitterspanningsklemtechnologie voor V u verbetering met acceptabele uitvalstroom (I t2 ) werd ook voorgesteld [5]. Niettemin, de V u in de bovengenoemde benaderingen is niet aanpasbaar, wat nog steeds ongemak en beperking oplevert in veelzijdige toepassingen.
In deze brief wordt een nieuwe siliciumgestuurde gelijkrichter met hoog houdspanning (HHV-SCR) voorgesteld en gedemonstreerd door TCAD-simulatie en TLP-tests. Het apparaat bereikt tegelijkertijd een hoge V u , hoog ik t2 , en instelbare V u zonder extra maskers en stappen. De TLP-test is uitgevoerd om te valideren dat de V u kan effectief worden verbeterd met behoud van een voldoende hoge I t2 . Volgens de geteste resultaten heeft de HHV-SCR een meer dan vier keer hogere V u dan die in de LVTSCR met de verwaarloosbare degradatie in I t2 .
Methode
In dit werk wordt een nieuwe SCR met hoge houdspanning met een ingebedde draaggolfrecombinatiestructuur onderzocht. De fysieke modellen IMPACT.I, BGN, CONMOB, FLDMOB, SRH en SRFMOB worden gebruikt in numerieke simulatie. Op basis van het model zijn H-RR en E-RR geoptimaliseerd om hoge V . te bereiken u en hoge P M . De gefabriceerde HHV-SCR's en LVTSCR zijn getest door het TLP-systeem.
Structuur en mechanisme
De schematische dwarsdoorsnede van de voorgestelde HHV-SCR en het lay-outdiagram worden respectievelijk getoond in Fig. 1a, b. De nieuw geïntroduceerde H-RR en E-RR gevormd door zwevende N+ en P+ zijn identiek aan de N+ en P+ in respectievelijk de anode- en kathodegebieden. De zwevende N+ in H-RR (of zwevende P+ in E-RR) wordt naast het P+-gebied in de anode (of N+-gebied in de kathode) geplaatst. Bovendien bevindt de nieuwe zwevende P+ in H-RR (of zwevende N+ in E-RR) zich ook naast de eerder genoemde zwevende N+ in H-RR (of zwevende P+ in E-RR). De lage-trigger N+ in H-RR (TN+) en lage-trigger P+ in E-RR (TP+) worden ook vervaardigd door dezelfde processen als het N+ (of P+) gebied in de anode (of kathode) om de V t1 binnen een acceptabel bereik. Als een positieve ESD-spanning (V ESD ) stijgt tot een bepaald niveau, zal de TN+/P-well/TP+-junctie met een lage doorslagspanning eerst doorslaan, gevolgd door de terugslag van de parasitaire transistoren die worden geactiveerd door de lawinestroom. De sterke positieve feedback van de parasitaire BJT's is verantwoordelijk voor de aanzienlijk lage V u van de LVTSCR. In de HHV-SCR zal de N+ in H-RR (of de P+ in E-RR) de minderheidsdragers die zijn geïnjecteerd vanaf de rand van anode P+ (of kathode N+), recombineren, wat de stroomversterking vermindert (β ) van de parasitaire PNP (of NPN) en elimineert het bipolaire oppervlakeffect. Belangrijk is dat de P+ in H-RR (of de N+ in E-RR) het pad met lage weerstand aan het oppervlak blokkeert door de oppervlakte-elektronen (of gaten) te recombineren. Vergeleken met de H-RR zonder P+ (of E-RR zonder N+), biedt de nieuwe P+ in H-RR (of de N+ in E-RR) de extra recombinatie om de oppervlakte-elektronen (of gaten) die door kathode ( of anode) en die veroorzaakt door impactionisatie (getoond in Fig. 3a), die de verdere toename van V teweegbrengt u . Door deze aanpassingen te combineren, een aanzienlijke verbetering in FOM wordt geverifieerd. Het cijfer van verdienste (FOM) wordt geciteerd uit [7] en gedefinieerd als de toelaatbare vermogensdichtheid van een enkel apparaat gegeven door FOM=(V u ·Ik t2 )/(N ·W ) om de V . te evalueren u en ik t2 prestaties van één apparaat. Over het algemeen vergezeld van de verbetering van V u prestaties, veroorzaakt het nog steeds de verslechtering van I t2 vanwege de hogere vermogensdissipatie. Daarom betekent de hogere FOM dat het enkele apparaat de hogere stroomcapaciteit op de hogere V . kan bereiken u niveau (N is het nummer van de stapelinrichting; W is de apparaatbreedte).
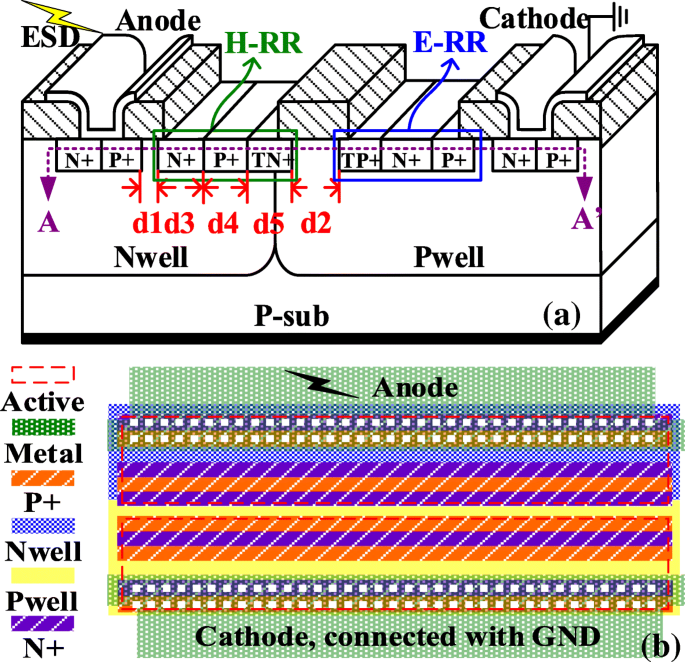
een De schematische dwarsdoorsnede van de voorgestelde HHV-SCR. b Het lay-outdiagram van de voorgestelde HHV-SCR
Resultaten en discussie
Gesimuleerde resultaten
De apparaatkenmerken werden bestudeerd en gesimuleerd door TCAD Medici, waarbij de bijbehorende modellen zoals impactionisatie en concentratieafhankelijk mobiliteitsmodel werden gebruikt. De gesimuleerde IV-curves van de LVTSCR en HHV-SCR's worden getoond in Fig. 2. De V u van de LVTSCR is slechts 1,8 V, terwijl de V u van de HHV-SCR is verbeterd van 4,6 V naar 8,1 V, waarbij d1 is verlaagd van 0,6 m naar 0 m voor d2 =0,5 m. In feite heeft de kleinere d1 de voorkeur voor een verbeterd recombinatievermogen van N+ in H-RR (of P+ in E-RR) om een lagere β te verkrijgen , wat verklaart dat de HHV-SCR altijd de hoogste V . behaalt u voor d1 =0 m. De gesimuleerde resultaten in Fig. 2b geven aan dat de V u van HHV-SCR is verder verbeterd met d2 verhoogd van 0,5 naar 1 m als gevolg van de toename van de lengte van het apparaat. Ter demonstratie is de P+ in H-RR (of N+ in E-RR) ook een sleutelfactor om V te verhogen u . De gesimuleerde resultaten worden getoond in Fig. 2c. Wanneer de H-RR (of E-RR) met vaste d3 + d4 volledig wordt gevormd door zware doping N+ (of P+) (bijv. d3 =3,5 m, d4 =0 μm), wordt de gesimuleerde V u is 7,1 V. Door de P+ in H-RR en N+ in E-RR in te voegen met vaste d3 + d4 (bijv. d3 =2,5 m, d4 =1,0 m), wordt de gesimuleerde V u kan worden verhoogd tot ongeveer 9,5 V. Er kan worden geconcludeerd dat de nieuwe P+ in H-RR (of N+ in H-RR) effectief is in het recombineren van lawine-elektronen aan het oppervlak (of gaten) om het oppervlaktestroompad te blokkeren. Daarom een hogere V u is vereist om de HHV-SCR dezelfde houdstroom te laten ondersteunen (I u ). De recombinatiecurve alleen AA′-lijn getoond in Fig. 3a toont de toename van de recombinatiesnelheid geïnduceerd door nieuwe P+ in H-RR (of N+ in E-RR). De TN+ en TP+ zijn gebruikt om de V . te garanderen t1 binnen een acceptabel bereik. Door de d2 en d5 af te stellen op de vaste d5 + d2 + d5, wordt de V t1 van HHV-SCR kan aanzienlijk worden verlaagd van 12 V naar 9,0 V om te voldoen aan het ontwerpvenster van 5 V-circuits met een verwaarloosbare impact op V u , getoond in Fig. 2d. De stroomverdelingsdiagrammen van de gesimuleerde apparaten op het vasthoudpunt worden ook getoond in respectievelijk Fig. 3b, c. Vergeleken met de stroomverdeling in de HHV-SCR met d3 =3,5 m, d4 =0 m, is het oppervlaktestroompad in de voorgestelde HHV-SCR geblokkeerd vanwege de extra recombinatiesnelheid die wordt geprofiteerd van P+ in H-RR en de N+ in E -RR.

Gesimuleerde snapback IV-kenmerken van conventionele LVTSCR en voorgestelde HHV-SCR waarbij de d1 toeneemt van 0 m tot 0,6 m bij a d2 =0,5 m en b d2 =1μm. c De IV-curven van HHV-SCR met verschillende d3 en d4 voor de vaste d3 + d4 (d3 + d4 =3,5 m). d De I-V-curven van HHV-SCR met verschillende V t1
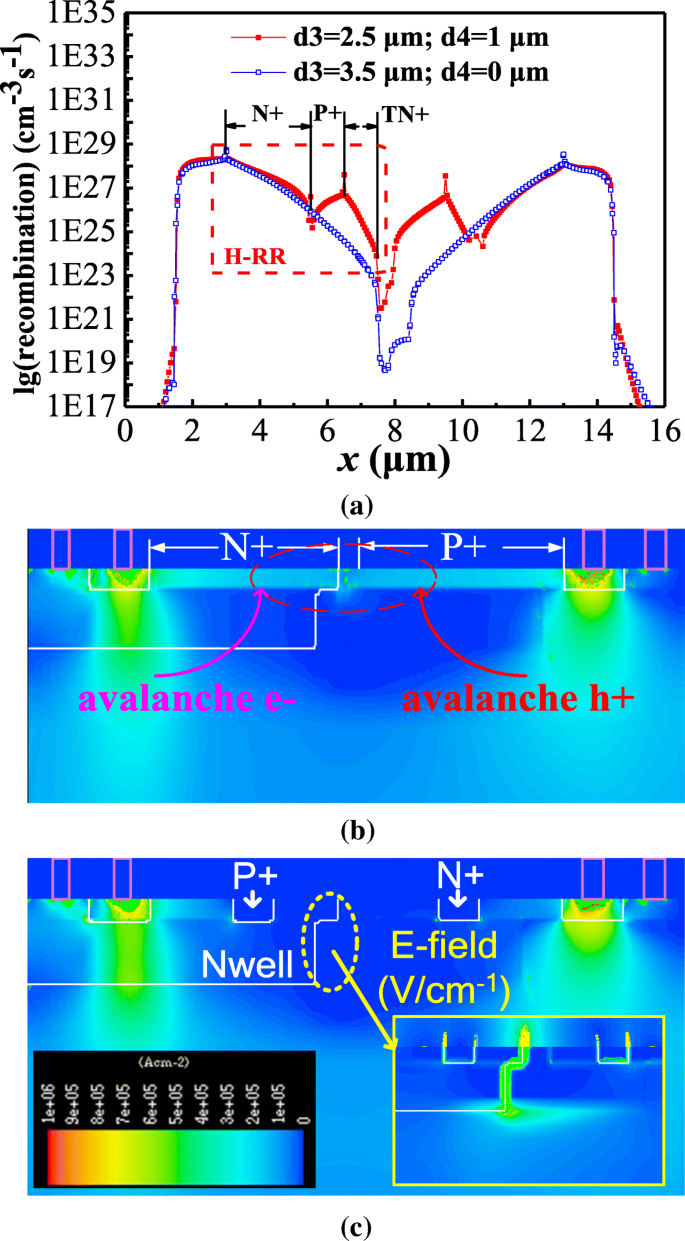
een De recombinatieverdelingscurven en de huidige verdelingen van HHV-SCR met (b ) d3 =3,5 m, d4 =0 m en (c ) d3 =2,5 m, d4 =1 m
Experimentele resultaten
De gefabriceerde apparaten worden getest door het TLP-systeem. De totale breedten (W) van alle geteste SCR zijn 50 m en met één vinger voor de vergelijking van de parameter (tabel 1). Alle geteste apparaten bezetten hetzelfde lay-outgebied. De apparaatparameters worden weergegeven in tabel 2. Afbeelding 4a toont de TLP-meetcurves van de HHV-SCR's met d2 =0,5 m (apparaten B1 genoemd) en de LVTSCR. Volgens de experimentele resultaten is de V u van HHV-SCR wordt verhoogd van 5,5 tot 8,0 V, terwijl de d1 is verlaagd van 0,6 m tot 0,0 m, wat veel hoger is dan 1,8 V verkregen in de conventionele LVTSCR. Naarmate de d2 toeneemt van 0,5 tot 1 m, verkrijgen de overeenkomstige HHV-SCR's (apparaten B2) een hogere V u getoond in Fig. 4b. Gezien het ontwerpvenster is de klemspanning (V CL ) onder de gegeven index is ook een belangrijke parameter om het klemvermogen te evalueren. Uit de geteste resultaten blijkt de V CL van enkele vinger HHV-SCR wordt ook binnen het acceptabele bereik gehouden bij de HBM =2 kV (I TLP =1,3 A), hoewel de vingerbreedte slechts 50 m is. Alle apparaten kunnen echter niet de in aanmerking komende V CL onder de sterkere ESD-stress als gevolg van de hoge V u en grote dynamische weerstand (R dy ) veroorzaakt door ondermaatse apparaatbreedte. Om te voldoen aan de hogere on-chip ESD-vereiste, wordt de vingerbreedte uitgebreid tot de acceptabele 300 m voor d1 =0,6 m, d4 =0,5 m en d1 =0,6 m, d4 =0 m. De TLP-tests getoond in Fig. 5 tonen aan dat de HHV-SCR met d4 =0,5 m de extreem lage R heeft dy (ongeveer 0,7 Ω), superieure ESD-robuustheid (I t2> 10 A) en hoge V u van 6,7 V. Men kan zien dat de V CL is slechts 6,7 V bij de I TLP =5,4 A (HBM =8 KV). Bovendien, de hogere V u geprofiteerd van P+ in H-RR (of N+ in E-RR) is ook bewezen, in vergelijking met de TLP-curve van SCR met d4 =0 m. De geteste resultaten van 50 μm apparaten met één vinger staan vermeld in tabel 1.

Experimentele storingsstroom bij de eenheidsbreedte en overeenkomstige TLP IV-kenmerken van conventionele LVTSCR en voorgestelde HHV-SCR's met a d2 =0,5 m en b d2 =1 μm bij W =50 μm
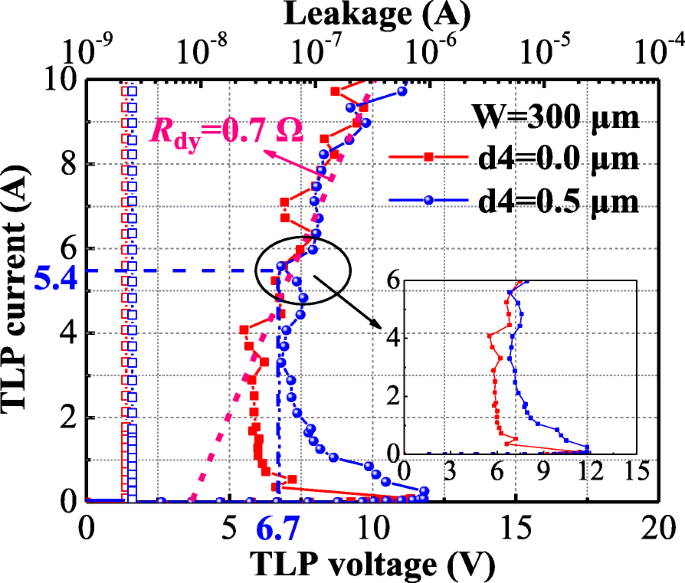
Experimentele TLP-karakteristiek van HHV-SCR met d4 =0,0 m en d4 =1,0 m bij d1 =0,6 m, W =300 m
Conclusie
Een nieuwe CMOS-proces-compatibele HHV-SCR wordt bestudeerd en gemeten door TCAD-simulatie en TLP-systeem. Vergeleken met de conventionele LVTSCR heeft de HHV-SCR aanzienlijk verbeterde V u (een verbetering van meer dan 450% in de V u wordt bereikt) en zonder het chipoppervlak op te offeren. Verder is de V u van de HHV-SCR kan worden aangepast van 5,5 V tot 8,1 V om te voldoen aan de verschillende V u vereisten met verwaarloosbare degradatie in I t2 . In termen van P M , vergeleken met de conventionele LVTSCR, wordt ook een verbetering van meer dan 200% bereikt.
Beschikbaarheid van gegevens en materialen
Alle gegevens die tijdens dit onderzoek zijn gegenereerd of geanalyseerd, zijn opgenomen in dit gepubliceerde artikel.
Nanomaterialen
- Een kort overzicht van IC-technologie voor microcontrollers en ingebedde systemen
- Maxim:dubbele IO-Link-transceiver met DC-DC-regelaar en overspanningsbeveiliging
- TRS-STAR:robuuste en ventilatorloze embedded systemen van avalu
- Nieuwe biocompatibele Au Nanostars@PEG-nanodeeltjes voor in vivo CT-beeldvorming en eigenschappen voor nierklaring
- Monodispergerende koolstofnanosferen met hiërarchische poreuze structuur als elektrodemateriaal voor supercondensator
- Frequentiemodulatie en absorptieverbetering van THz-microbolometer met microbrugstructuur door spiraalvormige antennes
- Nieuwe dubbele mitochondriale en CD44-receptor richtende nanodeeltjes voor door Redox Stimuli geactiveerde afgifte
- Morfologie, structuur en optische eigenschappen van halfgeleiderfilms met GeSiSn-nano-eilanden en gespannen lagen
- Nieuwe Anodic Catalyst Support voor Direct Methanol Fuel Cell:Karakteriseringen en Single-Cell Performances
- Automatisering en cyberbeveiliging:volledige bescherming voor klanten
- PCB-materialen en ontwerp voor hoogspanning



