Een uiterst nauwkeurige AlGaN/GaN Reverse Blocking CRD (RB-CRD) met hybride sleufkathode
Abstract
Een AlGaN/GaN laterale blokkeerdiode (RB-CRD) met sleuf Schottky-anode en hybride sleufkathode is voorgesteld en experimenteel gedemonstreerd op siliciumsubstraat. De in de anode geïntegreerde Schottky-barrièrediode (SBD) vertoont een inschakelspanning van 0,7 V en een omgekeerde doorslagspanning van 260 V. De hybride sleufkathode werkt als een CRD, die in serieverbinding staat met de anode SBD. Voor de RB-CRD kan een kniespanning van 1,3 V en een voorwaartse bedrijfsspanning van meer dan 200 V worden bereikt. De RB-CRD kan een uitstekende constante stroom leveren in een breed temperatuurbereik van 25 tot 300 °C. Bovendien vertoont de voorwaartse regelstroom kleine negatieve temperatuurcoëfficiënten van minder dan − 0,152%/ o C.
Achtergrond
Halfgeleiders met een brede bandgap hebben veel aandacht getrokken voor de volgende generatie apparaten met hoog vermogen, hoge frequentie en hoge temperatuur. GaN is een van de meest veelbelovende halfgeleiders met een brede bandgap vanwege zijn superieure eigenschappen zoals een grote bandgap, hoge elektronenmobiliteit en een hoog kritisch elektrisch veld [1,2,3,4,5]. Bovendien kan door de combinatie van spontane polarisatie en piëzo-elektrische polarisatie een tweedimensionaal elektronengas met hoge dichtheid (2DEG) worden bereikt op het AlGaN/GaN-hetero-interface. Dergelijke uitstekende eigenschappen zorgen ervoor dat de op AlGaN/GaN gebaseerde stroomapparaten met een lage aan-weerstand kunnen werken terwijl een hoge doorslagspanning behouden blijft. Het GaN-on-silicium (GaN-on-Si)-platform [6,7,8] wordt beschouwd als de meest veelbelovende technologie voor hoogwaardige en goedkope stroomapparatuur, vanwege de beschikbaarheid van siliciumwafels met grote diameter en de compatibiliteit met het bestaande gerijpte CMOS-fabricageproces. Tot op heden is er een verscheidenheid aan vermogensapparaten [9,10,11,12,13,14,15,16] gedemonstreerd op AlGaN/GaN-op-Si en sommige zijn in de handel verkrijgbaar. Tegelijkertijd kan de ontwikkeling van een AlGaN/GaN-apparaat met nieuwe functionaliteit het toepassingspotentieel van AlGaN/GaN-op-Si vergroten, wat gunstig is voor het stimuleren van de uitgebreide commercialisering van AlGaN/GaN-technologie.
Zoals weergegeven in Fig. 1a, werd in dit werk een nieuw type apparaat genaamd reverse blocking current regulator diode (RB-CRD) experimenteel gedemonstreerd op AlGaN/GaN-on-Si. De RB-CRD heeft een sleuf-Schottky-anode en een hybride sleufkathode. Een sleuf Schottky barrièrediode (SBD) wordt gevormd aan de anode terwijl een CRD wordt bereikt in de hybride sleufkathode. De RB-CRD kan worden beschouwd als een SBD in serieschakeling met een CRD. Een typische toepassing van de RB-CRD is het opladen van de batterij, zoals weergegeven in Fig. 1b. In het bovengenoemde batterijlaadcircuit fungeert de CRD als een constante stroombron, die een constante stroom afgeeft om de batterij [17,18,19] op te laden, ongeacht de voorwaartse spanningsfluctuatie tussen de ingang en de batterij. Als de ingangsspanning onder de batterijspanning komt, zal de SBD met omgekeerde voorspanning in het circuit voorkomen dat de batterij ontlaadt.
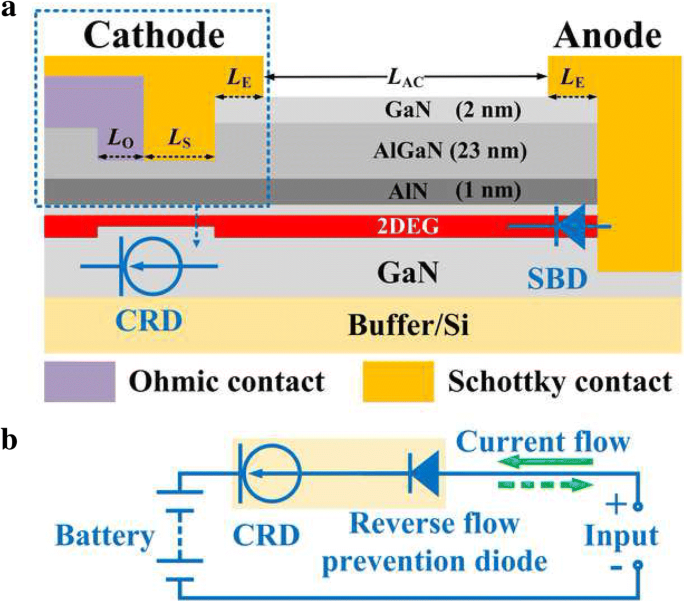
een Schematische dwarsdoorsnede van de RB-CRD. b Schakelschema van het opladen van de batterij met behulp van de RB-CRD
Methoden
De epitaxiale AlGaN / GaN-heterostructuur die werd gebruikt voor het fabriceren van de RB-CRD's werd gekweekt op 6-in (111) siliciumsubstraat door metaalorganische chemische dampafzetting (MOCVD). De epitaxiale lagen bestaan uit een 2-nm GaN-kap, een 23-nm AlGaN-barrière, een 1-nm AlN-tussenlaag, een 300-nm GaN-kanaal en een 3,5-μm-buffer. De gemeten dichtheid en mobiliteit van het Hall-effect van de 2DEG was 9,5 × 10 12 cm −2 en 1500 cm 2 /V·s, respectievelijk. Het fabricageproces van het apparaat wordt getoond in Fig. 2. Eerst werd een ondiepe greppel (zie Fig. 3) geëtst in de kathode van de RB-CRD door een laag vermogen Cl2 /BCl3 etstechniek op basis van inductief gekoppeld plasma (ICP). Een etssnelheid van 7 nm/min werd waargenomen met behulp van het ontwikkelde etsrecept met een RF-vermogen van 20 W, een ICP-vermogen van 60 W, een Cl2 stroom van 5 sccm en een BCl3 stroom van 10 sccm. Vervolgens werd mesa-isolatie met een diepte van 300 nm gevormd met behulp van dezelfde ICP-etstechniek om de apparaten los te koppelen. De anodegeul werd gelijktijdig door dit proces tot stand gebracht. Daarna werden de Ti/Al/Ni/Au (20/150/55/60 nm nm) metaalstapels afgezet door de elektronenstraalverdamping, gevolgd door de snelle thermische uitgloeiing bij 880 °C gedurende 35 s in N 2 omgeving. De ohmse contactweerstand van 1,1 mm en de plaatweerstand van 400 /vierkant werden geëxtraheerd met de transmissielijnmethode. Ten slotte eindigde het fabricageproces van het apparaat met de Ni/Au (50/300 nm) Schottky-metaalstapelafzetting. De afstand tussen de anode en kathode (L AC ) is 4 m. De lengtes van het ohmse contact (L O ) en de Schottky-contactpersoon (L S ) in de kathodegeul zijn respectievelijk 0,5 m en 1 m. De verlengde overhang (L E ) van het Schottky-contact is 0,5 m.
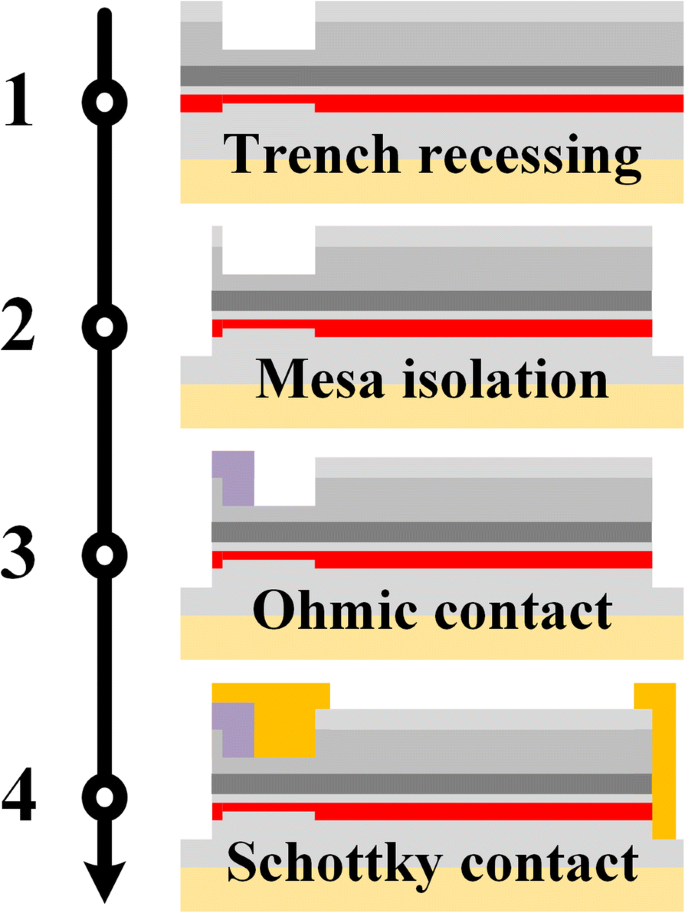
Productieprocesstroom van de RB-CRD
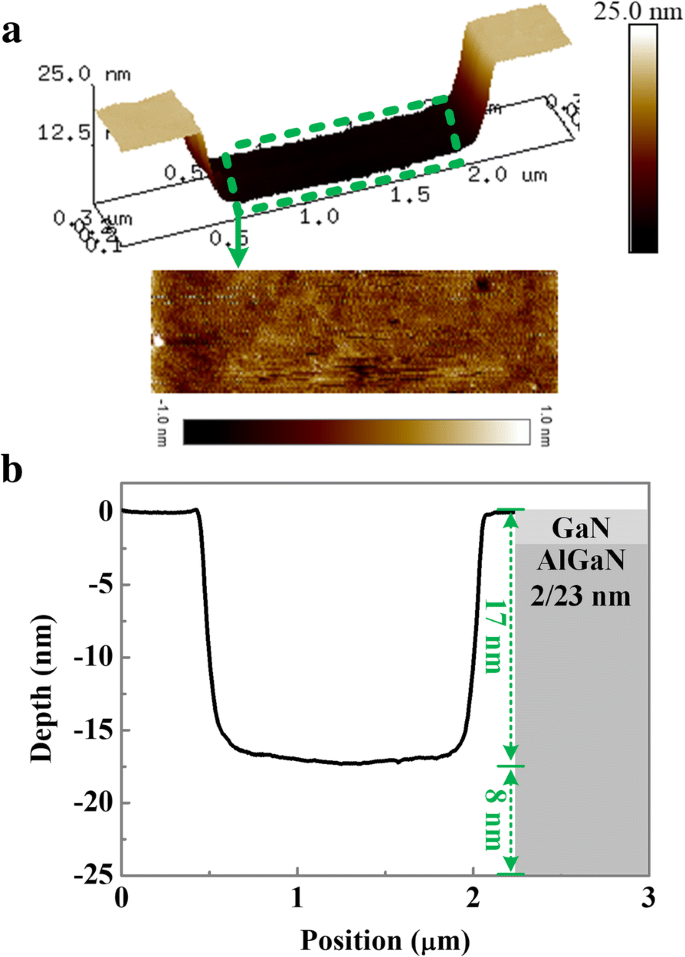
een AFM-beelden van de kathodegeul. b Hoogteprofiel genomen vanaf de kathodesleuf
Resultaten en discussie
Figuur 3a toont het 3D-beeld van de atomic force microscope (AFM) van de gefabriceerde kathodegeul. De oppervlakteruwheid van de bodem van de kathodesleuf is 0,3 nm. Zo'n kleine oppervlakteruwheid is gunstig voor het volgende metaal-halfgeleidercontact. Zoals getoond in figuur 3b, blijft de 8-nm AlGaN-barrièrelaag in het kathodegeulgebied met een kathodegeuluitsparing met een diepte van 17 nm. Een dergelijke resterende AlGaN-barrièrelaag maakt het mogelijk dat het 2DEG-kanaal in het kathodegeulgebied altijd zonder voorspanning bestaat.
Afbeelding 4 illustreert het bedieningsmechanisme van de RB-CRD. Wanneer een nulvoorspanning wordt toegepast op de anode (V AC = 0 V) (zie figuur 4a), is de RB-CRD analoog aan een Schottky-drain-uitputtingsmodus HEMT waarbij de gate-source-elektroden zijn aangesloten. Wanneer een negatieve bias wordt toegepast op de anode (V AC < 0 V) (zie figuur 4b), zullen de elektronen zich ophopen in het kathodegeulgebied, terwijl het 2DEG-kanaal in het anodegebied zal opraken als gevolg van de omgekeerd voorgespannen Schottky-overgang. Er volgt geen gewenste stroom tussen de anode en de kathode, en de RB-CRD werkt als een omgekeerde voorgespannen SBD. Zoals getoond in Fig. 4c, wanneer een positieve bias die groter is dan de inschakelspanning (V T , bij 1 mA/mm) van de anode SBD wordt toegepast op de anode (V AC> V T ), zullen de elektronen tussen het ohmse contact in de kathode en het Schottky-contact in de anode stromen. Ondertussen is de Schottky-overgang in de kathode in tegengestelde richting voorgespannen en zal het 2DEG-kanaal onder het Schottky-contact geleidelijk uitgeput raken met toenemende voorwaartse voorspanning. Daarom zal de uitgangsstroom aanvankelijk toenemen met de aangelegde anodespanning en vervolgens geleidelijk verzadiging bereiken. In dat geval kan een constante uitgangsstroom worden verkregen.
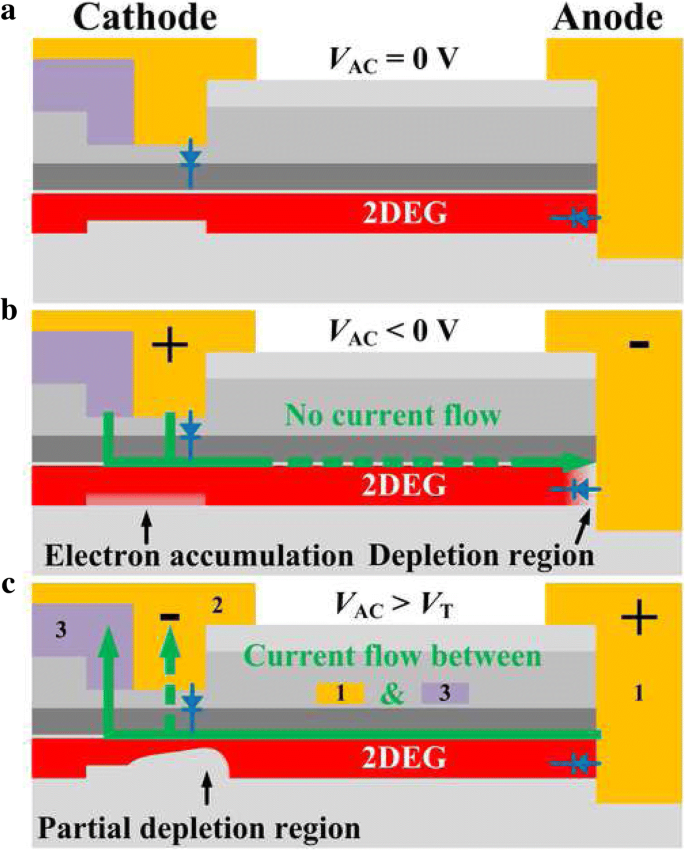
Schematisch bedieningsmechanisme van de RB-CRD onder a nul vooringenomenheid, b omgekeerde bias, en c voorwaarden voor voorwaartse bias
De temperatuurafhankelijke voorwaartse I-V kenmerken van de RB-CRD op de wafer worden getoond in Fig. 5. Zoals getoond in Fig. 5a, voor de RB-CRD, een kniespanning (V K , bij 80% van de constante regelstroom) van 1,3 V wordt verkregen, wat hoger is dan die van onze eerder gerapporteerde CRD's (bijv. typische waarde 0,6 V) [20, 21]. Dit komt door de extra spanningsval (bijv. typische waarde 0,7 V) op de anode SBD van de RB-CRD. Met een temperatuurstijging van 25 tot 300 °C (zie Fig. 5a), een negatieve verschuiving in de V T wordt waargenomen, wat kan worden verklaard door het thermionische emissiemodel (d.w.z. er is minder energie nodig voor elektronen om de Schottky-barrière te overwinnen bij hogere temperaturen). De RB-CRD kan een constante regelstroom afgeven tot 200 V (zie figuur 5b), wat hoger is dan de gerapporteerde maximale bedrijfsspanning van de op Si gebaseerde commerciële CRD's [22,23,24]. Bij 25°C is de regelstroomverhouding (I 200 V /Ik 25 V ) van de voorgestelde RB-CRD is 0,998, wat aangeeft dat de uitgangsstroom vrij stabiel is. Dankzij de intrinsieke werking bij hoge temperaturen van het AlGaN/GaN-platform, vertoont de RB-CRD een verwaarloosbare degradatie in de stabiliteit van de I A tot 200 V bij temperaturen tot 300 °C. Ondertussen, terwijl de temperatuur opliep van 25 tot 300 °C, begon de voorwaartse I A vermindert van 31,1 naar 23,1 mA / mm vanwege de verminderde elektronenmobiliteit bij verhoogde temperaturen, zoals weergegeven in figuur 5b. De temperatuurcoëfficiënten (α ) van de regelstroom bij verschillende temperatuurbereiken kan worden berekend met de volgende formule
$$ \alpha =\frac{I_1-{I}_0}{I_0\left({T}_1-{T}_0\right)}\times 100\% $$waar ik 0 is de uitgangsstroom bij temperatuur T 0 en ik 1 is de uitgangsstroom bij temperatuur T 1 . Een kleine temperatuurcoëfficiënt van minder dan − 0,152%/ o C wordt waargenomen, wat aangeeft dat de gefabriceerde RB-CRD een uitstekende thermische stabiliteit heeft.

Temperatuurafhankelijke voorwaartse bias I -V kenmerken van de RB-CRD. Anodespanningsbereiken:a 0–2 V, b 0–200 V
Zoals weergegeven in de inzet van Fig. 6, is de omgekeerde doorslagspanning van de RB-CRD 260 V bij 25°C. Het overeenkomstige gemiddelde kritische elektrische veld wordt berekend op 0,65 MV/cm. De temperatuurafhankelijke omgekeerde I-V kenmerken van de RB-CRD zijn weergegeven in Fig. 6. De toename van de omgevingstemperatuur van 25 naar 300 °C geeft aanleiding tot een toename van de lekstroom met twee ordes van grootte.

Temperatuurafhankelijke omgekeerde bias I -V kenmerken van de RB-CRD
Conclusies
Concluderend kan worden gesteld dat een nieuwe AlGaN/GaN-op-Si RB-CRD met sleuf Schottky-anode en hybride sleufkathode voor het eerst met succes is gedemonstreerd. De gefabriceerde RB-CRD vertoont een V K van 1,3 V, een voorwaartse bedrijfsspanning van meer dan 200 V en een omgekeerde doorslagspanning van 260 V. Een uitstekende nauwkeurigheid en een kleine negatieve temperatuurcoëfficiënt van minder dan − 0,152%/ o C zijn behaald voor de RB-CRD. De multifunctionele RB-CRD met hoge nauwkeurigheid heeft een groot potentieel om te worden geïntegreerd in opkomende GaN-vermogenselektronicasystemen.
Afkortingen
- 2DEG:
-
Tweedimensionaal elektronengas
- AFM:
-
Atoomkrachtmicroscoop
- ICP:
-
Inductief gekoppeld plasma
- MOCVD:
-
Metaal organische chemische dampafzetting
- RB-CRD:
-
Omgekeerde blokkeerstroomregeldiode
- SBD:
-
Schottky-barrièrediode
Nanomaterialen
- Hybride Blockchain/Cloud-applicaties bouwen met Ethereum en Google
- Verbeteren van additieve productie met reverse engineering
- Infineon:omgekeerd geleidende IGBT met beschermende functies
- Python-arrays:maken, omkeren, knallen met voorbeelden van Python-arrays
- Impact van oppervlaktetoestanden en aluminiummolfractie op oppervlaktepotentiaal en 2DEG in AlGaN/GaN HEMT's
- Meerkleurige emissie van op ultraviolet GaN gebaseerde fotonische quasicrystal nanopiramidestructuur met semipolaire InxGa1−xN/GaN meerdere kwantumbronnen
- De elektrische eigenschappen van hybride composieten op basis van meerwandige koolstofnanobuisjes met grafiet-nanoplaatjes
- Synthese en elektrochemische eigenschappen van LiNi0.5Mn1.5O4-kathodematerialen met Cr3+ en F− composietdoping voor lithium-ionbatterijen
- Zeer geleidende PEDOT:PSS transparante gattransportlaag met oplosmiddelbehandeling voor hoogwaardige silicium/organische hybride zonnecellen
- Onderzoek naar oppervlaktepolarisatie van Al2O3-capped GaN/AlGaN/GaN heterostructuur door middel van hoek-opgeloste röntgenfoto-elektronspectroscopie
- Endotheelcellen targeten met multifunctionele GaN/Fe-nanodeeltjes



