Op de p-AlGaN/n-AlGaN/p-AlGaN Current Spreading Layer voor op AlGaN gebaseerde Deep Ultraviolet Light-Emitting Diodes
Abstract
In dit rapport zijn op AlGaN gebaseerde diepe ultraviolette lichtgevende diodes (DUV-LED's) met verschillende p-AlGaN/n-AlGaN/p-AlGaN (PNP-AlGaN) gestructureerde stroomspreidingslagen beschreven en onderzocht. Volgens onze resultaten kan de aangenomen PNP-AlGaN-structuur een energiebarrière induceren in de gatinjectielaag die de laterale stroomverdeling kan moduleren. We vinden ook dat het huidige verspreidingseffect sterk kan worden beïnvloed door de dikte, de doteringsconcentratie, de PNP-lus en de AlN-samenstelling voor de ingevoegde n-AlGaN-laag. Daarom, als de PNP-AlGaN-structuur goed is ontworpen, kunnen de voorwaartse spanning, de externe kwantumefficiëntie, het optische vermogen en de wall-plug-efficiëntie voor de voorgestelde DUV-LED's aanzienlijk worden verbeterd in vergelijking met de conventionele DUV-LED zonder de PNP -AlGaN-structuur.
Inleiding
Sinds het eerste optreden in 2003 hebben op AlGaN gebaseerde diepe ultraviolette licht-emitterende diodes (DUV-LED's) veel belangstelling getrokken vanwege hun brede scala aan toepassingen, zoals watersterilisatie en luchtzuivering [1,2,3,4,5, 6,7]. De externe kwantumefficiëntie (EQE) voor DUV-leds is echter lager dan 10% wanneer de emissiegolflengte korter is dan 300 nm [8], wat hun verdere toepassing aanzienlijk beperkt. De lage EQE komt gedeeltelijk voort uit de slechte interne kwantumefficiëntie (IQE). Er is veel aandacht besteed aan het feit dat de IQE opmerkelijk wordt beïnvloed door de injectie van de drager en de uitgebreide dislocaties [8]. Op AlGaN gebaseerde DUV-LED's die worden gekweekt op isolerende saffiersubstraten, maken gebruik van de flip-chipstructuur voor een betere lichtextractie-efficiëntie. Niettemin vereist de flip-chip DUV LED-structuur dat de n-elektrode en de p-elektrode zich aan dezelfde kant bevinden. Daarom treedt gemakkelijk de niet-homogene laterale stroomverdeling op, d.w.z. het stroomverdringingseffect [9]. Het huidige crowding-effect kan gemakkelijk het lokale Joule-verwarmingseffect en de ongelijkmatige lichtemissie veroorzaken [10,11,12]. Vermeldenswaard is dat de plaatselijke oververhitting de levensduur van DUV-leds ernstig verslechtert. Bovendien leidt de zeer slechte Mg-doteringsefficiëntie voor de op Al-rijke p-AlGaN-gebaseerde gateninjectielaag tot de slechte elektrische geleidbaarheid [13], wat verder het belang aantoont voor het verbeteren van de stroomspreiding voor DUV-LED's. Hoewel Khan et al. hebben erop gewezen dat in hun reviewartikel [14] aandacht zal worden besteed aan de huidige crowding, gedetailleerde analyse van de huidige crowding en de oplossingen daarvoor worden tot nu toe minder besproken voor DUV LED's.
Er zijn uitgebreide technieken beschreven voor het bevorderen van stroomspreiding voor op GaN gebaseerde blauwe LED's, en de stroomspreiding kan worden verbeterd door bijvoorbeeld selectieve ionenimplantatie van de p-GaN-laag [15, 16], het invoegen van een stroomblokkerende laag (CBL) [17,18,19], waarbij selectief stikstofvacatures worden geproduceerd om de gaten in de p-GaN-laag te compenseren [20], waardoor het uitgloeiproces voor Ohms contact wordt geoptimaliseerd [21]. Naast het gebruik van de post-fabricage benaderingen, kan de huidige verspreidingslaag ook worden verkregen door in situ epitaxiale groei in het metaal-organische chemische dampafzetting (MOCVD) systeem. Belangrijke voorbeelden zijn de volgende:de p-GaN/i-InGaN-superroosterstructuur met een korte periode tussen de structuur van meerdere kwantumputten (MQW's) en de p-GaN-laag [22, 23], de tunnelovergangen [24, 25] en de barrière kruispunten [10]. Desalniettemin zijn er zelden rapporten over epistructuren om de stroomspreiding voor DUV-leds te verbeteren. In deze brief stellen we voor om p-AlGaN/n-AlGaN/p-AlGaN (PNP-AlGaN)-laag te gebruiken om de zijstroom voor DUV-leds beter te spreiden. De PNP-AlGaN-structuur kan de energiebarrière genereren in de valentieband van de p-type gatinjectielaag. De energiebarrière kan de elektrische weerstand voor de p-type gatinjectielaag moduleren en daarom kan het stroompad worden afgestemd. Door de PNP-AlGaN stroomspreidingslaag goed te ontwerpen, kunnen de EQE, de wall-plug efficiency (WPE) en de voorwaartse spanning worden verbeterd. Verder onderzoekt dit werk ook uitgebreid de gevoeligheid van de stroomspreiding, de EQE, de WPE en de voorwaartse spanning naar de PNP-AlGaN-lus, de Si-dopingconcentratie, de dikte en de AlN-samenstelling voor de ingevoegde n-AlGaN-laag van de PNP-AlGaN-architectuur.
Onderzoeksmethoden en natuurkundige modellen
Om de huidige verspreidingsmechanismen voor op AlGaN gebaseerde DUV-LED's beter te verduidelijken, zijn verschillende DUV LED-apparaten ontworpen (zie figuur 1a). Alle DUV-leds bestaan uit een 4 μm dik n-type Al0.60 Ga0,40 N-laag met de Si-dopingconcentratie van 5 × 10 18 cm −3 . Vervolgens vijf perioden van 3-nm Al0,45 Ga0,55 N/12 nm Al0,56 Ga0,44 N MQW's volgen. Vervolgens sluiten we de MQW's af met een 18 nm dikke p-type Al0.60 Ga0,40 N elektronenblokkerende laag (p-EBL), waarop een 198 nm dik p-type Al0.40 Ga0.60 N-laag en een 50 nm dikke p-type GaN-deklaag worden gebruikt als de gateninjectielaag. De gatenconcentratie voor de p-type lagen is ingesteld op 3 × 10 17 cm −3 . Voor de DUV-LED's met de voorgestelde PNP-AlGaN-structuren, is de conventionele p-type bulk Al0,40 Ga0.60 N laag wordt vervangen door p-Al0.40 Ga0.60 N/n-Alx Ga1-x N/p-Al0.40 Ga0.60 N laag. Figuur 1b geeft het schematische structuurdiagram voor de PNP-AlGaN-laag weer. Figuur 1c toont het schematische valentiebanddiagram voor de PNP-AlGaN-structuur, waaruit we de barrière voor gaten kunnen zien. De barrière wordt gegenereerd vanwege de uitputting van de Si-doteermiddelen in de dunne n-Alx Ga1-x N-laag [26]. Deze barrière is erg belangrijk bij het bepalen van het stroompad en de apparaatprestaties voor DUV-leds. Gedetailleerde analyse zal later worden gegeven.
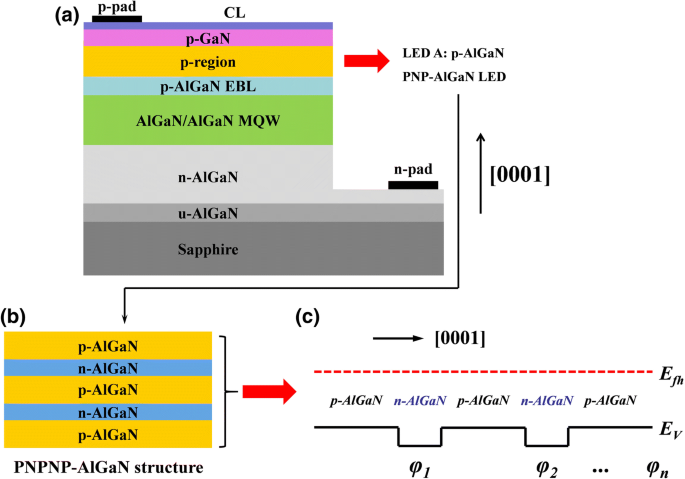
een Schematische diagrammen voor de bestudeerde apparaten (referentie-LED A en PNPNP-AlGaN LED), b schematische diagrammen voor de PNP-AlGaN-structuur met twee PNP-AlGaN-juncties, c schematisch valentiebanddiagram voor de PNP-AlGaN-structuur met meerdere PNP-AlGaN-juncties, waarin φ 1 , φ 2 , en φ n geven de barrièrehoogte aan voor elke PNP-AlGaN-junctie langs de oriëntatie en n staat voor het PNP-AlGaN-knooppuntnummer
Om het mechanisme van de PNP-AlGaN-structuur bij het verspreiden van de stroom verder te illustreren, laten we het vereenvoudigde equivalente circuit en de stroomstroompaden zien voor de DUV-LED die is gegroeid op saffiersubstraten in figuur 2a. De stroom vloeit zowel verticaal als lateraal van het p-AlGaN-gebied naar het n-AlGaN-gebied. Normaal gesproken is de huidige dikte van de spreidingslaag (CL) (d.w.z. 200 nm voor onze apparaten) veel kleiner dan die van de n-AlGaN-laag (d.w.z. 4 μm voor onze apparaten). Daarom is de elektrische weerstand voor de CL veel groter dan die voor de n-AlGaN-elektroneninjectielaag. Dan heeft de stroom de neiging zich onder de p-elektrode te verdringen, d.w.z. J 1> J 2> J 3> J 4> .....> J n , wat bekend staat als het huidige crowding-effect [27]. Gelukkig kan het huidige crowding-effect worden onderdrukt door de PNP-AlGaN-overgang in de p-type gatinjectielaag op te nemen, en het onderliggende mechanisme kan worden geïnterpreteerd met behulp van Fig. 2b, zodat we de totale stroom in een verticaal deel verdelen ( J 1 ) en een horizontaal gedeelte (J 2 ). Volgens Ref. [27], de relatie tussen J 1 en J 2 kan worden gekoppeld door Vgl. (1) als volgt,
$$ \frac{J_1}{J_2}\cong \frac{l}{\frac{\rho_p}{\rho_{\mathrm{CL}}}{t}_p+\frac{N\cdot {\rho}_ {\mathrm{PNP}}}{\rho_{\mathrm{CL}}}}, $$ (1)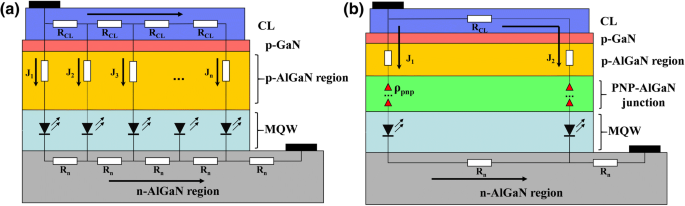
een Equivalent circuit van DUV-LED's met lateraal stroominjectieschema (J 1> J 2> J 3> J 4> …… > J n ) en b vereenvoudigd equivalent circuit van de LED met PNP-AlGaN-structuur, de stroompaden (J 1 en J 2 ) worden ook weergegeven
waar l is de lengte van het horizontale stroompad, t p is de dikte, ρ p staat voor de verticale soortelijke weerstand voor p-type gatinjectielaag, ρ CL geeft de soortelijke weerstand aan van de ex situ afgezette stroomspreidingslaag, ρ PNP betekent de specifieke grensvlakweerstand die wordt geïnduceerd in elke PNP-AlGaN-junctie, en N staat voor het nummer van de PNP-AlGaN-junctie. Gebaseerd op vgl. (1), concluderen we dat we J . kunnen vergroten 2 door ρ . te verkleinen CL . Vergelijking (1) geeft ook aan dat de juiste toename van de verticale weerstand (d.w.z. ρ p × t p ) helpt ook om J . te verbeteren 2 . Als alternatief kan de verticale weerstand groter worden door de N·ρ . op te nemen PNP . De waarde van N·ρ PNP kan worden beïnvloed door het aantal PNP-AlGaN-juncties. Bovendien is de waarde van ρ PNP is onderhevig aan de doteringsconcentratie, de dikte en de AlN-samenstelling van de n-Alx Ga1-x N laag. Daarom zullen details over verschillende PNP-AlGaN-juncties later worden besproken.
Onderzoeken naar de apparaatfysica worden uitgevoerd met behulp van APSYS [28]. De energieband-offsetverhouding tussen de geleidingsband-offset en de valentieband-offset voor de AlGaN/AlGaN-heterojunctie is ingesteld op 50:50 [29]. Het polarisatieniveau is ingesteld op 40% voor het berekenen van de polarisatie-geïnduceerde ladingen op de rooster-mismatch interfaces [30, 31]. De Auger-recombinatiecoëfficiënt en de Shockley-Read-Hall (SRH)-recombinatielevensduur zijn ingesteld op 1,0 × 10 −30 cm 6 /s [27] en 10 ns [32], respectievelijk. De efficiëntie van de lichtextractie is ingesteld op ~ 8% voor DUV-leds [33]. Andere parameters voor stikstofhoudende III-V-halfgeleiders zijn elders te vinden [34].
Resultaten en discussies
Bewijs van de effectiviteit van de PNP-AlGaN-junctie bij het verspreiden van de stroom voor DUV-LED's
Om de effectiviteit van de PNP-AlGaN-structuur bij het verspreiden van de stroom voor DUV-LED aan te tonen, zijn de referentie-DUV-LED (dwz LED A) zonder PNP-AlGaN-structuur en de DUV-LED met de PNP-AlGaN-structuur (dwz LED B) bestudeerd. Merk op dat de architectuurinformatie voor de DUV-LED's is gegeven in de sectie Onderzoeksmethoden en natuurkundige modellen, behalve de PNP-AlGaN-configuratie voor LED B. LED B heeft twee PNP-AlGaN-lussen, d.w.z. de PNPNP-AlGaN-structuur. Elke PNP-AlGaN-junctie omvat de p-Al0.40 Ga0.60 N/n-Al0.40 Ga0.60 N/p-Al0.40 Ga0.60 N-structuur, waarvoor de Si-doteringsconcentratie in de 20 nm dikke n-Al0,40 Ga0.60 N invoeglaag is 5,3 × 10 17 cm −3 . We berekenen en tonen het energiebanddiagram voor LED B bij de stroomdichtheid van 170 A/cm 2 in afb. 3a. We kunnen zien dat, in vergelijking met LED A (energieband wordt hier niet getoond), de gaten twee barrières zullen tegenkomen voordat ze in de MQW's worden geïnjecteerd. De barrières in de valentieband hier kunnen de stroom effectief verspreiden en de gaten lateraal beter homogeniseren. Om ons punt verder te bespreken en voor het doel van de demonstratie, tonen we het laterale gatconcentratieprofiel in de kwantumbron die het dichtst bij de p-EBL [dwz de laatste kwantumbron (LQW)] in Fig. 3b, waaruit blijkt dat de gatenverdeling in LED B vertoont inderdaad een meer uniform profiel in de LQW. De waarnemingen in figuur 2b komen goed overeen met de energiebanddiagrammen in figuur 3a en onze analyse eerder, zodat de PNP-AlGaN-structuur nuttig blijkt bij het verbeteren van het huidige spreidingseffect.
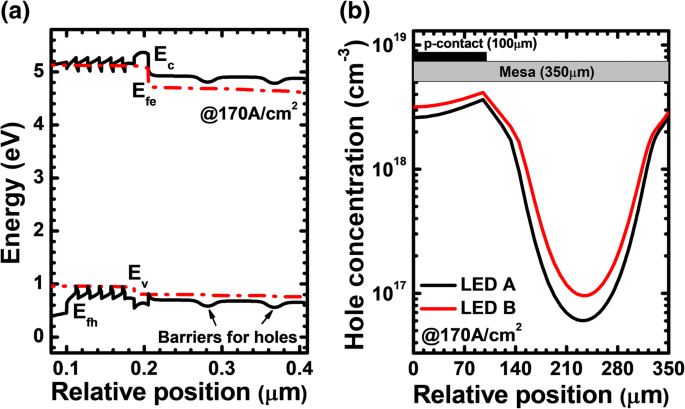
een Energiebanddiagram voor LED B bij de stroomdichtheid van 170 A/cm 2 . E c , E v , E fe , en E fh geven de geleidingsband, de volantband en quasi-Fermi-niveaus voor respectievelijk elektronen en gaten aan, b laterale gatenverdeling in de laatste kwantumput voor LED's A en B bij een stroomdichtheid van 170 A/cm 2 , respectievelijk
Vervolgens tonen we de profielen voor de gatenconcentratie en de stralingsrecombinatiesnelheid in het MQW-gebied voor LED's A en B in respectievelijk Fig. 4a, b. Merk op dat om het huidige spreidingseffect te controleren, de gegevens in Fig. 4a, b worden verzameld op de positie van 230 m van de linker mesarand. Het is gebleken dat de verbeterde stroomspreiding voor LED B ook de bevorderde injectie van gaten in de MQW's mogelijk maakt. De verbetering van de gatenconcentratie in de MQW's genereert de verbeterde stralingsrecombinatiesnelheid voor LED B volgens figuur 4b.

een Gatenconcentratieprofielen en b stralingsrecombinatiesnelheid in het MQW-gebied voor LED's A en B bij een stroomdichtheid van 170 A/cm 2 , respectievelijk
Figuur 5a toont vervolgens de EQE en de optische vermogensdichtheid in termen van het injectiestroomdichtheidsniveau voor LED's A en B. De EQE-niveaus voor LED's A en B zijn respectievelijk 3,38% en 4,13%, wat een prestatieverbetering van 22,2% aangeeft bij de stroomdichtheid van 170 A/cm 2 . Deze waargenomen verbeteringen worden toegeschreven aan het betere stroomspreidingseffect en de verbeterde gateninjectie in het MQW-gebied voor LED B. Zoals eerder vermeld, kan de goedkeuring van de PNP-AlGaN-structuur leiden tot de energiebarrière in de valentieband, die kan de doorlaatspanning beïnvloeden. De speculatie wordt bewezen wanneer wordt verwezen naar figuur 5b die de licht verhoogde voorwaartse spanning voor LED B demonstreert. Ondanks de hogere voorwaartse spanning voor LED B, is de efficiëntie van de wall-plug voor LED nog steeds groter dan die voor LED A volgens figuur 5c , zodanig dat de cijfers 3,56% en 4,27% zijn voor LED's A en B bij het stroomdichtheidsniveau van 170 A/cm 2 , respectievelijk. Als we Fig. 5a, c verder vergelijken, kunnen we zien dat de WPE een meer uitgesproken droop heeft voor LED B, en dit wordt toegeschreven aan de extra spanningsval bij de PNP-AlGaN-junctie. Daarom is het van essentieel belang om een uitgebreidere studie uit te voeren die de gevoeligheid van de EQE, doorlaatspanning en de WPE voor verschillende PNP-AlGaN-ontwerpen onthult.
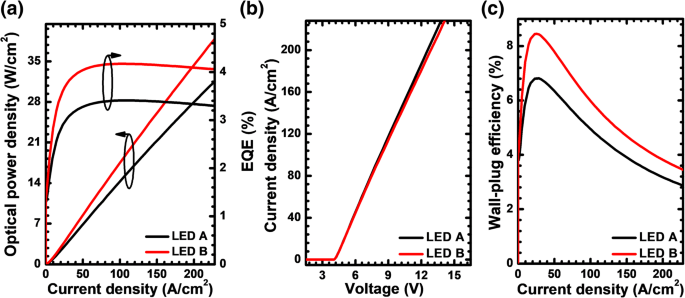
een Optische uitgangsvermogensdichtheid en EQE als functie van de injectiestroom, b stroom-spanningskarakteristiek, c WPE in termen van de injectiestroom voor respectievelijk LED's A en B
Impact van de dikte voor de n-AlGaN-laag op de apparaatprestaties
Volgens vgl. (1), kunnen we concluderen dat een verbeterde horizontale stroom kan worden verkregen door de waarde van N·ρ te verhogen PNP . De barrièrehoogte in de PNP-AlGaN-junctie neemt toe wanneer de n-Al0,40 Ga0.60 N laag wordt dik zodat een grotere ρ PNP kan worden verkregen, wat gunstig is voor het verbeterde stroomspreidingseffect. Echter, zodra de n-Al0,40 Ga0.60 N laag is te dik, meer gaten in de p-Al0.40 Ga0.60 De N-laag kan uitgeput raken, wat de elektrische geleidbaarheid kan opofferen. Daarom, om de relatie tussen de dikte van n-Al0,40 . beter te illustreren Ga0.60 N-laag en prestaties voor DUV-LED's, is het noodzakelijk om de impact van de n-Al0.40 te onderzoeken Ga0.60 N laagdikte voor de PNP-AlGaN-junctie op de stroomspreiding, de gatinjectie, de EQE, de voorwaartse spanning en de WPE. Voor dat doel variëren we de waarden van de n-Al0.40 Ga0.60 N laagdikte tussen 6, 13, 20, 27 en 34 nm, en de apparaten worden respectievelijk LED's T1, T2, T3, T4 en T5 genoemd. Tabel 1 geeft een samenvatting van de valentieband-barrièrehoogte voor elke PNP-AlGaN-junctie, waaruit blijkt dat de barrièrehoogte toeneemt naarmate de n-Al0,40 Ga0.60 N laagdikte neemt toe, wat bewijst dat de toename van de n-Al0,40 Ga0.60 N laagdikte maakt de grote N·ρ . mogelijk PNP , waardoor de horizontale stroom J . toeneemt 2 . Figuur 6a toont vervolgens de laterale gatenconcentratieprofielen in de laatste kwantumput voor LED A zonder de PNP-AlGaN gestructureerde stroomspreidingslaag en de LED's met verschillende n-Al0,40 Ga0.60 N laagdiktes bij de stroomdichtheid van 170 A/cm 2 . Het is blijkbaar te zien dat de gaten gelijkmatiger worden verdeeld in de laatste kwantumput als de dikte voor de n-Al0,40 Ga0.60 N invoeglaag neemt toe.
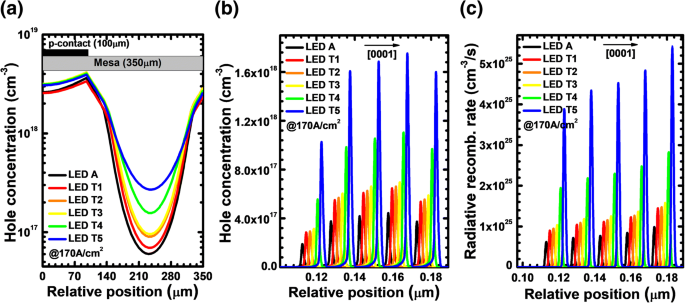
een Laterale gatenverdeling in de laatste kwantumput, b gatenconcentratieprofielen en c stralingsrecombinatiesnelheidsprofielen in het MQW-gebied voor LED's A, T1, T2, T3, T4 en T5 bij een stroomdichtheid van 170 A/cm 2 . De uitgezette curven voor panelen b en c zijn opzettelijk met 2 nm verschoven voor een betere resolutie
Vervolgens laten we de gatenconcentratieprofielen en stralingsrecombinatiesnelheidsprofielen in het MQW-gebied zien voor alle bestudeerde apparaten met een stroomdichtheid van 170 A/cm 2 in Fig. 6b, c, respectievelijk. De gatenconcentratie en stralingssnelheidsprofielen worden verzameld op de positie van 230 m van de linker mesarand. Voor een betere visuele resolutie zijn de gatenconcentratie- en stralingsrecombinatiesnelheidsprofielen voor LED's A, T1, T2, T3, T4 en T5 ruimtelijk verschoven met 2 nm in respectievelijk Fig. 6b, c. Het is duidelijk aangetoond dat LED A de laagste gatenconcentratie heeft en dus de laagste stralingsrecombinatiesnelheid in het MQW-gebied. De gatenconcentratie en de stralingsrecombinatiesnelheid in het MQW-gebied nemen toe met de toenemende dikte van de n-Al0,40 Ga0.60 N laag.
De waargenomen resultaten getoond in Fig. 6c komen goed overeen met de EQE en de optische vermogensdichtheid die worden weergegeven in Fig. 7a, zodat de toenemende dikte van de n-Al0.40 Ga0.60 N-laag in de PNP-AlGaN-junctie kan de EQE en de optische vermogensdichtheid verbeteren. De hoogte van de valentiebandbarrière voor gaten in elke PNP-AlGaN-junctie wordt echter groot zodra de n-Al0,40 Ga0.60 N-laag is verdikt volgens tabel 1, die dienovereenkomstig de voorwaartse spanning voor de voorgestelde DUV-LED's verhoogt, zoals weergegeven in figuur 7b. Daarom is de impact van de n-Al0,40 Ga0.60 De N-laagdikte voor de PNP-AlGaN-stroomspreiding op de LED-prestaties moet worden geëvalueerd door de relatie tussen de WPE en de injectiestroomdichtheid aan te tonen (zie Fig. 8). We kunnen zien dat de WPE niet monotoon toeneemt met de toenemende n-Al0,40 Ga0.60 N laagdikte. De EQE en de WPE in termen van de n-Al0.40 Ga0.60 N-laagdiktes worden geïllustreerd in de inzet van figuur 8. Voor de voorgestelde apparaatarchitecturen in dit werk bereikt de WPE de hoogste waarde wanneer de n-Al0,40 Ga0.60 N-invoeglaag is 20 nm dik en neemt af naarmate de n-Al0,40 Ga0.60 N insteeklaag wordt dikker. We schrijven dit fenomeen toe aan de verhoogde verticale weerstand wanneer de n-Al0.40 Ga0.60 N laagdikte wordt dikker, en dit verbruikt meer elektrisch vermogen. Daarom zal de dikte van de n-AlGaN-invoeglaag voor de PNP-AlGaN-junctie zorgvuldig worden geoptimaliseerd. In deze sectie stellen we de AlN-samenstelling van 40% in, d.w.z. n-Al0,40 Ga0.60 N voor demonstratiedoeleinden, en we zijn van mening dat de geoptimaliseerde dikte voor de n-AlGaN-invoeglaag kleiner zal worden als men de AlN-samenstelling verhoogt.
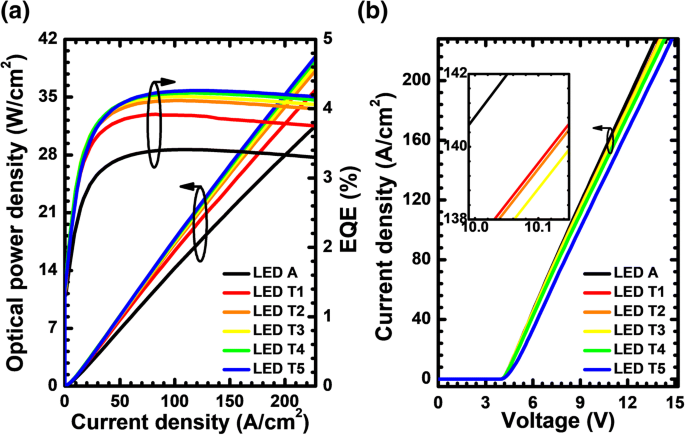
een Optische uitgangsvermogensdichtheid, b stroom-spanningskarakteristieken voor LED's A, T1, T2, T3, T4 en T5. Inzetfiguur toont de ingezoomde stroom-spanningscurven
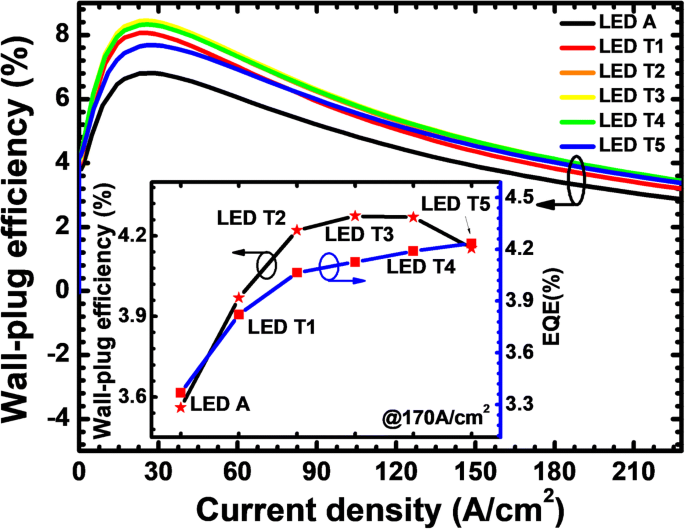
WPE als functie van de injectiestroom voor LED's A, T1, T2, T3, T4 en T5. Inzetfiguur toont de WPE en EQE voor de bestudeerde LED's met verschillende diktes van de n-Al0,40 Ga0.60 N-laag voor de PNP-AlGaN-junctie bij de stroomdichtheid van 170 A/cm 2
Impact van de dopingconcentratie van de n-AlGaN-laag op de prestaties van het apparaat
Naast de dikte van de n-AlGaN-laag, kan de doteringsconcentratie voor de n-AlGaN-laag ook de hoogte van de valentiebandbarrière voor gaten wijzigen, waardoor N·ρ wordt beïnvloed. PNP . Om de impact van de dopingconcentratie voor de n-AlGaN-laag op het stroomspreidingseffect en de optische prestaties voor DUV-LED's met de PNP-AlGaN-juncties nauwkeuriger te bestuderen, hebben we de dopingconcentratie van 1,3 × 10 17 , 5,3 × 10 17 , 9,3 × 10 17 , 1.33 × 10 18 , en 1,73 × 10 18 cm −3 van de n-AlGaN-lagen voor respectievelijk LED's D1, D2, D3, D4 en D5. De dikte voor de n-AlGaN-laag is ingesteld op 20 nm en er worden twee PNP-AlGaN-overgangen toegepast. De AlN-samenstelling is 40%, d.w.z. n-Al0,40 Ga0.60 N.
Tabel 2 laat zien dat de hoogte van de valentiebandbarrière voor gaten toeneemt wanneer de Si-doteringsconcentratie voor de n-Al0,40 Ga0.60 N-laag van de PNP-AlGaN-junctie wordt hoog. De verhoogde valentieband barrièrehoogte geeft de grote N·ρ . aan PNP , die tegelijkertijd de hoge horizontale stroom van J . oplevert 2 . Volgens vgl. (1), de verhoogde stroomspreiding gaat gepaard met het meer uniforme laterale gatconcentratieprofiel, en daarom laten we in figuur 9a zien dat de laterale gatverdeling in de laatste kwantumput meer gehomogeniseerd wordt zodra de PNP-AlGaN junctie is gedoteerd voor DUV-LED's in vergelijking met LED A. Bovendien worden de laterale gaten gelijkmatiger verdeeld zodra de Si-doteringsconcentratie voor de n-Al0,40 Ga0.60 N-laag van de PNP-AlGaN-junctie neemt toe.
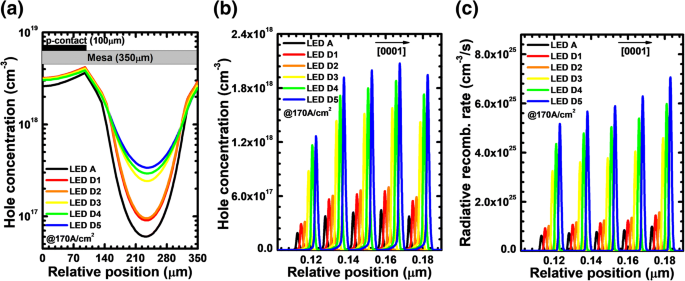
een Laterale gatenverdeling in de laatste kwantumput, b gatenconcentratieprofielen, en c stralingsrecombinatiesnelheidsprofielen in het MQW-gebied of LED's A, D1, D2, D3, D4 en D5 bij een stroomdichtheid van 170 A/cm 2 . De uitgezette curven voor panelen b en c zijn opzettelijk met 2 nm verschoven voor een betere resolutie
Vervolgens laten we de gatenconcentratieprofielen en stralingsrecombinatiesnelheidsprofielen in het MQW-gebied zien voor alle bestudeerde apparaten met een stroomdichtheid van 170 A/cm 2 in Fig. 9b, respectievelijk c, die worden verzameld op de positie van 230 m van de linker mesarand. Het is duidelijk aangetoond dat LED A de laagste gatenconcentratie en de laagste stralingsrecombinatiesnelheid in het MQW-gebied heeft. De gatenconcentratie en de stralingsrecombinatiesnelheid in het MQW-gebied nemen toe met de toenemende doteringsconcentraties van de n-Al0,40 Ga0.60 N lagen voor de LED's met PNP-AlGaN-juncties. Het verbeterde gatenconcentratieniveau in de MQW voor LED's D1, D2, D2, D3, D4 en D5 wordt toegeschreven aan het betere stroomspreidingseffect, dankzij de PNP-AlGaN-junctie.
Vervolgens berekenen en presenteren we de EQE en de optische vermogensdichtheid in termen van de injectiestroomdichtheid voor de onderzochte apparaten in figuur 10a. De waargenomen EQE is consistent met de resultaten in Fig. 9b, c, zodat de EQE kan worden verbeterd zodra de PNP-AlGaN-overgang wordt gebruikt. Meer dan dat, aangezien de Si-doteringsconcentratie in de n-Al0,40 Ga0.60 N-laag voor de PNP-AlGaN-junctie neemt toe, de EQE kan verder worden bevorderd, dankzij de betere stroomspreiding. Afbeelding 10b vergelijkt de voorwaartse bedrijfsspanning voor de onderzochte apparaten. Er wordt aangetoond dat de voorwaartse bedrijfsspanning toeneemt met de toename van de doteringsconcentratie in de n-Al0,40 Ga0.60 N laag. Merk op dat aangezien de Si-dopingconcentraties 1,33 × 10 18 . zijn en 1,73 × 10 18 cm −3 , vertoont de inschakelspanning een significante toename, wat aangeeft dat de PNP-AlGaN ingebouwde junctie zich een parasitaire diode gedraagt wanneer de Si-doping in de n-Al0,40 Ga0.60 N-laag neemt toe tot een zeer hoog niveau. Om de prestaties van de DUV-LED's met verschillende PNP-AlGaN-juncties nauwkeuriger te beoordelen, toont Fig. 11 WPE als een functie van de injectiestroomdichtheid voor LED A, D1, D2, D3, D4 en D5. We kunnen duidelijk zien dat de WPE de laagste is voor LED D5, wat komt door het grootste voorwaartse spanningsverbruik. De inzet voor Fig. 11 geeft ook aan dat de WPE gevoeliger is voor de Si-dopingconcentratie van de n-Al0,40 Ga0.60 N laag dan de EQE. Het is de moeite waard om te concluderen dat de hoge Si-doteringsconcentratie van de n-Al0,40 Ga0.60 N-laag kan inderdaad de huidige spreidingslaag verbeteren en de snelheid van het genereren van fotonen verhogen. Desalniettemin verbruikt de extra voorwaartse spanningsval bij de PNP-AlGaN-knooppunten meer elektrisch vermogen, waardoor de WPE wordt beperkt. De bevindingen in deze sectie illustreren ook dat de Si-dopingconcentratie in de n-Alx Ga1-x N-laag moet op de juiste manier worden verminderd als men de AlN-samenstelling en/of de dikte van de n-Alx verhoogt Ga1-x N-laag voor de PNP-AlGaN-junctie, omdat men hierdoor zowel de verbeterde EQE als de fatsoenlijke WPE kan verkrijgen.
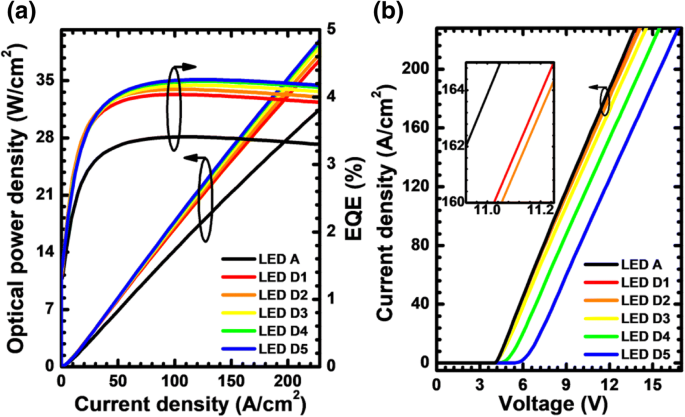
een Optische uitgangsvermogensdichtheid en EQE als functie van de injectiestroom, b stroom-spanningskarakteristieken voor LED's A, D1, D2, D3, D4 en D5. Inzetfiguur toont de ingezoomde stroom-spanningscurven
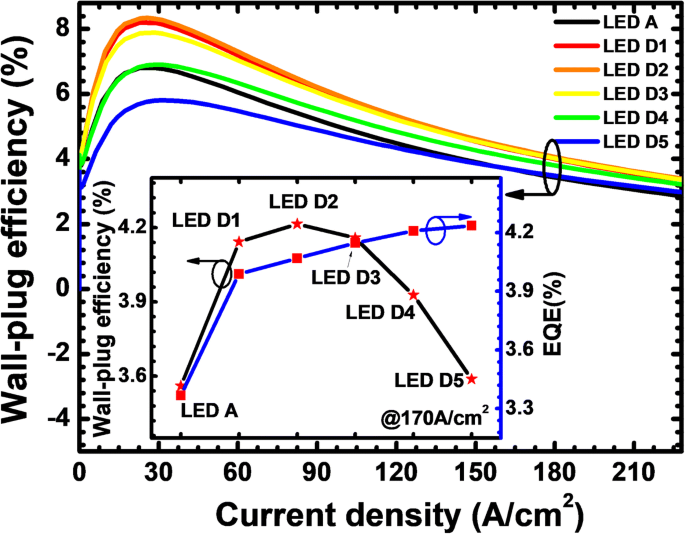
WPE als functie van de injectiestroom voor LED's A, D1, D2, D3, D4 en D5. Inzetfiguur toont de WPE en EQE voor de bestudeerde LED's met verschillende dopingconcentraties van de n-Al0,40 Ga0.60 N laag met een stroomdichtheid van 170 A/cm 2
Impact van PNP-AlGaN-knooppuntnummer op de apparaatprestaties
In deze sectie wordt de impact bestudeerd van het aantal PNP-AlGaN-juncties op de elektrische en optische prestaties van DUV-leds. Ter demonstratie stellen we de dopingconcentratie en de dikte van de n-AlGaN-laag vast op 5,3 × 10 17 cm −3 en 20 nm, respectievelijk. De AlN-samenstelling is geselecteerd op 0,40, zoals n-Al0,40 Ga0.60 N. We gebruiken verschillende lussen voor de PNP-AlGaN-junctie, d.w.z. de lusnummers zijn ingesteld op 1, 2, 3 en 4 voor respectievelijk LED's N1, N2, N3 en N4. We berekenen en presenteren eerst de hoogte van de valentiebandbarrière voor elke PNP-AlGaN-junctie in Tabel 3. Het is duidelijk te lezen dat de toename van het PNP-AlGaN-junctienummer de totale N·ρ maakt PNP hoog. Vervolgens berekenen en demonstreren we de laterale verdeling voor de gaten in de laatste kwantumput voor LED's A, N1, N2, N3 en N4 bij een stroomdichtheid van 170 A/cm 2 (zie afb. 12a). Het laat zien dat de gatenverdeling in de laatste kwantumput uniformer wordt naarmate er meer PNP-AlGaN-overgangen worden ingebouwd. De resultaten in Fig. 12a ondersteunen verder de voorspellingen van Vgl. (1).
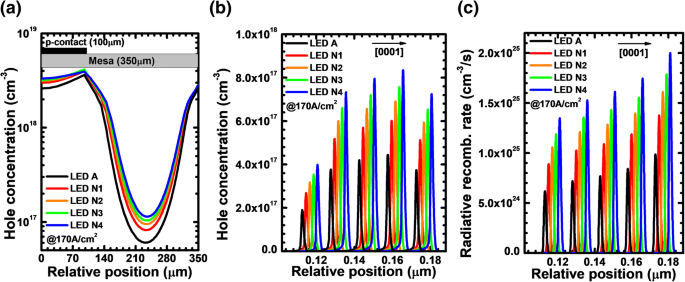
een Laterale gatenverdeling in de laatste kwantumput, b gatenconcentratieprofielen, en c stralingsrecombinatiesnelheidsprofielen in het MQW-gebied voor LED's A, N1, N2, N3 en N4 bij een stroomdichtheid van 170 A/cm 2 . De uitgezette curven voor panelen b en c are purposely shifted by 2 nm for better resolution
Then, we show the hole concentration and radiative recombination rate profiles in the MQW region for LEDs A, N1, N2, N3, and N4 at the current density of 170 A/cm 2 in Fig. 12b, c, respectively. The hole and radiative recombination rate profiles are probed at the position of 230 μm apart from the left mesa edge. It is indicated that the hole concentration and radiative recombination rate increase if the number of the PNP-AlGaN junction is more. It is worth mentioning here that we do not increase the value of N beyond 4, since when the N is further increased, the thickness of the remaining p-Al0.40 Ga0.60 N layer becomes so thin that the holes may be depleted by the ionized Si dopants and the hole supply can be insufficient.
Thanks to the improved current spreading effect, the enhanced hole concentration in the MQW region, LEDs N1, N2, N3, and N4 consequently promote the EQE and optical power density when compared with LED A (see Fig. 13a). Figure 13b demonstrates that the forward operating voltage for the suggested DUV LEDs also increases if more PNP-AlGaN junctions are incorporated. Fortunately, the increase of the forward voltage for LEDs N1, N2, N3, and N4 does not reduce the WPE according to Fig. 14. Further investigations into the inset of Fig. 14 can illustrate that both the EQE and WPE tend to approach a saturation level as the number of the PNP-AlGaN junction increases. Therefore, we believe that, as has also been pointed out previously, further increase of the number for the PNP-AlGaN junction may deplete the holes and correspondingly degrade the hole supply capability, hence making little contribution in enhancing the EQE and the WPE for the proposed device architectures in this work.
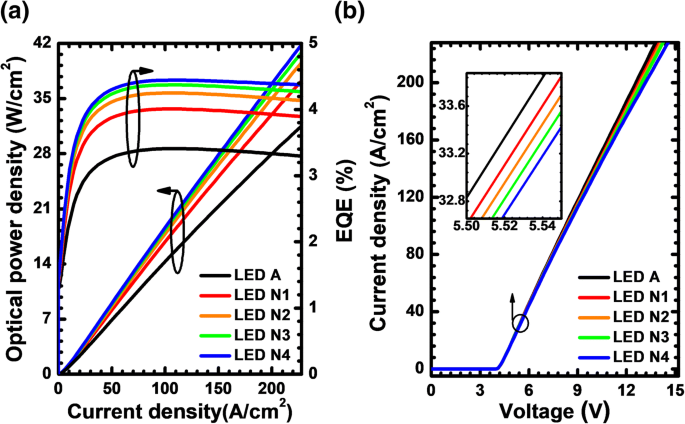
een Optical output power density and EQE as a function of the injection current, b current-voltage characteristic for LEDs A, N1, N2, N3, and N4. Inset figure shows the zoom-in current-voltage curves
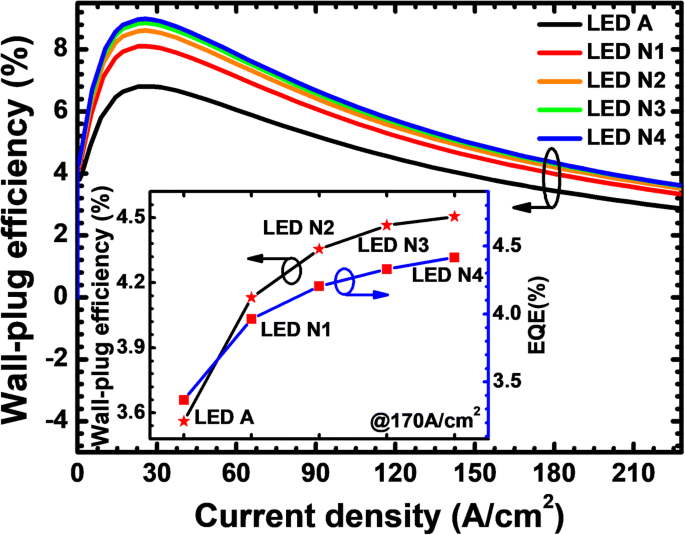
WPE as a function of the injection current for LEDs A, N1, N2, N3, and N4. Inset figure shows the WPE and EQE for LEDs with various number of PNP-AlGaN junction at the current density of 170 A/cm 2
Impact of the AlN Composition for n-AlGaN Layer on the Device Performance
Lastly, we modify the ρ PNP by varying the AlN composition of the n-AlGaN layer for the PNP-AlGaN junction. The values for the AlN composition of the n-AlGaN layer are set to 0.40, 0.43, 0.46, 0.49, and 0.51 for LEDs C1, C2, C3, C4, and C5, respectively. The thickness and the Si doping concentration of the n-AlGaN layer are set to 20 nm and 5.3 × 10 17 cm −3 , respectievelijk. We adopt two PNP-AlGaN junctions for LEDs C1, C2, C3, C4, and C5. The AlN composition for the rest p-AlGaN layers is fixed to 0.40. Table 4 demonstrates the valence band barrier height for the PNP-AlGaN junction with different AlN compositions in the n-AlGaN insertion layer. It is easily understandable that the increased AlN composition in the n-AlGaN layer gives rise to the larger valence band barrier height for holes. Figure 15a exhibits the lateral distributions for holes in the last quantum well for LEDs A, C1, C2, C3, C4, and C5 at the current density of 170 A/cm 2 . The current spreading effect is significantly improved as the AlN composition of the n-AlGaN layer increased up to 0.43. It seems that the holes cannot be further soundly spreaded when the AlN composition of the n-AlGaN layer exceeds 0.43 for our structures, because a too much high AlN composition in the n-AlGaN may block the hole injection.

een Lateral hole distribution in the last quantum well, b hole concentration profiles, and c radiative recombination rate profiles in the MQW region for LEDs A, C1, C2, C3, C4, and C5 at the current density of 170 A/cm 2 . The plotted curves for panels b en c are purposely shifted by 2 nm for better resolution
The hole concentration and radiative recombination rate profiles in the MQW region for LEDs A, C1, C2, C3, C4, and C5 at the current density of 170 A/cm 2 are presented in Fig. 15b, c, respectively. The data are also collected at the position of 230 μm apart from the left mesa edge. The conclusions here are similar to that for Fig. 6b, Fig. 9b and Fig. 12b, i.e., the adoption of the PNP-AlGaN current spreading layer increases the hole injection, and the hole concentration in the MQW region becomes even more improved once the AlN composition in the n-AlGaN layer increases. We then further calculate and present the EQE and the optical power density in terms of the injection current for the investigated devices in Fig. 16a. Clearly, we can see that the EQE can be improved once the PNP-AlGaN junction is employed. In addition, as the AlN composition in the n-AlGaN layer for the PNP-AlGaN junction increases, the EQE can be further promoted, thanks to the better current spreading, which homogenizes the hole concentration in each quantum well plane as has been shown previously.
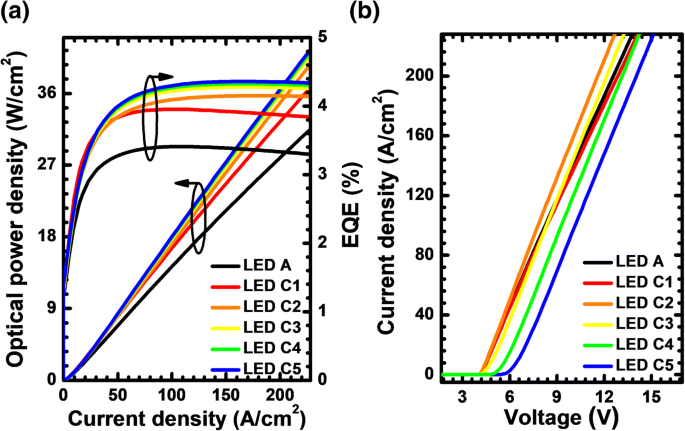
een Optical output power density and EQE as a function of the injection current and b current-voltage characteristics for LEDs A, C1, C2, C3, C4, and C5
Figure 16b investigates the current-voltage characteristics for LEDs A, C1, C2, C3, C4, and C5. The device exhibits a slight increase in the forward operating voltage for LED C1 with the PNP-Al0.40 Ga0.60 N junction when compared to the LED A. Meanwhile, the device consumes more forward voltage for LEDs C4 and C5. The observation here is consistent with that in Fig. 7b, Fig. 10b and Fig. 13b, such that the adoption of the PNP-AlGaN junction causes the additional valence band barrier height for holes, which, as a result, increases the forward voltage and even the turn-on voltage (e.g., LEDs C4 and C5). However, it is worth mentioning that the forward operating voltage for LEDs C2 and C3 decreases when compared to LED A. The underlying mechanism is not clear at this moment. However, we tentatively attribute the reduced forward voltage for LEDs C2 and C3 to the hole acceleration effect [35].
Figure 17 shows the relationship between the WPE and the injection current density for the tested LEDs. We can get that the WPE can be enhanced for all the proposed LEDs especially when the injection current density is beyond 89 A/cm 2 . Insightful study into LED C5 shows that the WPE for LED C5 is lower than that for LED A when the current density is smaller than 89 A/cm 2 . Nevertheless, the WPE for LED C5 overwhelms that for LED A when the injection current density become higher (i.e.,> 89 A/cm 2 ). As is well known, the current easily gets crowded when the LED device is biased at a high current level. The WPE for LED C5 reflects that the PNP-Al0.51 Ga0.49 N junction is indeed effective in improving the current spreading effect. However, considering the additional voltage consumption in the PNP-AlGaN junction, one shall be very careful when setting the AlN composition for the n-AlGaN layer so that the WPE can be maximized according to the inset in Fig. 17.
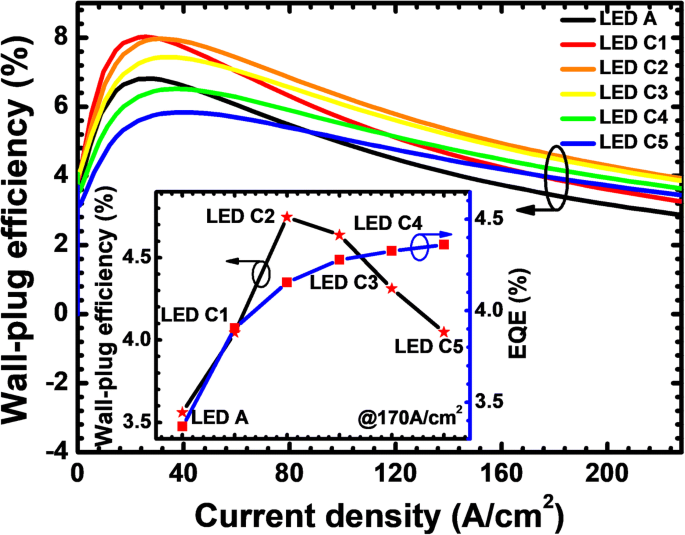
WPE as a function of the injection current for LEDs A, C1, C2, C3, C4, and C5. Inset figure shows the WPE and the EQE for the studied LEDs with various AlN compositions for the n-AlGaN layer at the current density of 170 A/cm 2
Conclusies
To summarize, the PNP-AlGaN junction for DUV LEDs are explored and demonstrated. Assisted by the proposed PNP-AlGaN junctions, the current spreading effect can be improved. The improved current spreading effect is well attributed to increased the vertical resistance and the enhanced horizontal current flow. Moreover, we have also conducted the parametric study to reveal different PNP-junctions on the current spreading effect, the EQE and the WPE. We find that by properly increasing the thickness, the doping concentration, the AlN composition for the n-AlGaN insertion layer, and the number for the PNP-AlGaN junction, the current spreading effect can be improved. On the other hand, we also find that the current spreading effect can indeed enhance the EQE. However, the forward voltage may be increased if the PNP-AlGaN junction is not fully optimized, the cost of which is the reduced WPE. It is also worthy pointing out that the current spreading feature is the cooperative function of the thickness, the doping concentration, the AlN composition for the n-AlGaN insertion layer, and the number for the PNP-AlGaN junction. As a result, there is no unique answer for the best design of the PNP-AlGaN current spreading layer for DUV LEDs. However, we strongly believe that the findings in this work introduce the additional physical understanding to the PNP-AlGaN current spreading layer and the current spreading effect for DUV LEDs. Hence, this work is very useful for the community of optical semiconductor devices.
Afkortingen
- APSYS:
-
Advanced Physical Models of Semiconductor Devices
- CBL:
-
Current blocking layer
- CL:
-
Current spreading layer
- DUV LEDs:
-
Deep ultraviolet light-emitting diodes
- EQE:
-
Externe kwantumefficiëntie
- IQE:
-
Internal quantum efficiency
- LQW:
-
Last quantum well
- MOCVD:
-
Metal-organic chemical vapor deposition
- MQWs:
-
Multiple quantum wells
- PNP-AlGaN:
-
p-AlGaN/n-AlGaN/p-AlGaN
- SRH:
-
Shockley-Read-Hall
- WPE:
-
Wall-plug efficiency
Nanomaterialen
- Pleidooi voor neuromorfe chips voor AI-computing
- IBM-wetenschappers vinden een thermometer uit voor de nanoschaal
- Het ontwerp van de emissielaag voor elektronenvermenigvuldigers
- Groene synthese van InP/ZnS Core/Shell Quantum Dots voor toepassing in licht-emitterende diodes zonder zware metalen
- De optimale titaniumvoorloper voor het vervaardigen van een TiO2-compacte laag voor perovskietzonnecellen
- Bijna efficiëntie-Droop-Free AlGaN-gebaseerde ultraviolette lichtemitterende diodes met een speciaal ontworpen superrooster p-Type elektronenblokkerende laag voor hoge Mg-dopingefficiëntie
- Perovskiet light-emitting diodes met hoge luminantie met een alcoholoplosmiddel met hoge polariteit die PEDOT:PSS behandelen als gatentransportlaag
- Invloed van de breedte van de kwantumput op de elektroluminescentie-eigenschappen van AlGaN Deep Ultraviolet Light-Emitting Diodes bij verschillende temperaturen
- Integratie van milieuvriendelijke perovskieten voor zeer efficiënte witte lichtgevende diodes
- Effecten van meshed p-type contactstructuur op het lichtextractie-effect voor Deep Ultraviolet Flip-Chip Light-Emitting Diodes
- Wat zijn de meest voorkomende toepassingen voor wisselstroom?



