Structuurverschuiving van GaN tussen Nanowall-netwerk, Nanocolumn en Compact Film Grown on Si (111) door MBE
Abstract
Structuurverschuiving van GaN-nanowandnetwerk, nanokolom en compacte film werden met succes verkregen op Si (111) door plasma-geassisteerde moleculaire bundelepitaxie (MBE). Zoals verwacht, werd groei van de GaN-nanokolommen waargenomen in N-rijke toestand op kale Si, en de groei verschoof naar compacte film toen de Ga-flux werd verbeterd. Interessant is dat als een aluminium (Al) pre-depositie gedurende 40 s werd uitgevoerd voorafgaand aan de GaN-groei, GaN groeit in de vorm van het nanowall-netwerk. De resultaten laten zien dat het vooraf afgezette Al naar buiten komt in de vorm van druppeltjes met een typische diameter en hoogte van respectievelijk ~ -80 en ~ -6,7 nm. Een groeimodel voor het nanowall-netwerk wordt voorgesteld en het groeimechanisme wordt besproken. GaN groeit in het gebied zonder Al-druppeltjes, terwijl de groei boven Al-druppeltjes wordt belemmerd, wat resulteert in de vorming van een continu GaN-nanowandnetwerk dat de obstakels van de fabricage van nano-apparaten verwijdert.
Achtergrond
Als directe halfgeleiders met brede bandafstand hebben GaN en verwante verbindingen veel succes geboekt in lichtemitterende diodes [1,2,3], laserdiodes [4] en transistors met hoge elektronenmobiliteit [5, 6]. De heteroepitaxy van GaN-film op saffier, siliciumcarbide of monokristallijn silicium veroorzaakt echter een hoge dichtheid van dislocatie. Er wordt aangenomen dat hun nanostructuren superieure prestaties hebben vanwege dislocatievrije, spanningsvrije en grote oppervlakte-tot-volumeverhouding [7, 8]. Er is intensief onderzoek gedaan naar de GaN-nanokolommen en nanodraden [9,10,11,12]. De GaN-nanozuilvormige nucleatie vindt spontaan plaats door het groeimechanisme van Volmer-Weber [13], terwijl een stikstofrijke (N-rijke) toestand verhindert dat de nucleatieplaatsen samenvloeien. Veel aandacht is besteed aan de fabricage van een elektrisch apparaat op de GaN-nanodraden of op de nanokolommen. De GaN-nanodraden werden mechanisch gedispergeerd op SiO2 /Si-substraat en ohmse contacten die willekeurig aan twee zijden van een individuele nanodraad zijn gevormd [14]. In een ander geval [15] werd de ene kant van de nanodraad bevestigd aan een platform dat was verbonden met de negatieve elektrode, terwijl een andere kant werd uitgelijnd met de positieve elektrode door middel van een scanning elektronenmicroscoop (SEM), waardoor een elektrisch apparaat voor wetenschappelijk onderzoek werd gevormd.
Als alternatief is een speciale nanostructuur, namelijk het GaN-nanowandnetwerk dat elektrisch geleidend in het vlak is, veelbelovend, omdat er geen complex proces nodig is voor de fabricage van nano-apparaten. In 2007 werd de groei van het GaN-nanowall-netwerk verkregen door de groep van Kishino met behulp van een Ti-laag met een patroon van elektronenstraallithografie als een masker [16]. Enkele jaren geleden werd de groei van het GaN nanowall-netwerk zonder enige lithografie met succes verkregen op saffier- en siliciumsubstraten [17,18,19]. De emissie-intensiteit van de band-edge van het GaN-nanowall-netwerk is vergelijkbaar met de GaN-nanokolommen en de gele luminescentie is niet duidelijk, wat wijst op een hoge kwaliteit van het GaN-nanowall-netwerk. Anders dan de gescheiden nanostructuur zoals de nanokolommen, is het nanowall-netwerk elektrisch geleidend in het vlak [18, 20, 21] dat het net zo gemakkelijk als de film tot een nano-apparaat kan worden gefabriceerd [22]. Daarom zou het obstakel van de fabricage van apparaten op de gescheiden nanokolommen kunnen worden verwijderd door de elektrische geleiding in het vlak van het nanowall-netwerk. Het is cruciaal om het groeimechanisme van het nanowall-netwerk te bestuderen. Dislocatie-geïnduceerde spontane vorming van nanowall-netwerk wordt beschouwd als het groeimechanisme van GaN nanowall-netwerk op blote c -vlakke saffier [23]. Omdat de door dislocatie geïnduceerde vorming van nanowall-netwerk weinig controle heeft, is de nanowall-netwerkgroei op Si (111) substraat met Al-bufferlaag [18] uitgevoerd. Het groeimechanisme van de nanowand op Si (111) is significant verschillend van dat op kale saffiersubstraat; er wordt echter geen onderzoek naar gedaan, hoewel het groeimechanisme op Si (111) de sleutel is voor de groei van het nanowall-netwerk.
In dit werk wordt de groei van GaN in verschillende structuren, waaronder het nanowandnetwerk, de nanokolommen en compacte film, systematisch bestudeerd. Verschillende hierboven genoemde GaN-structuren werden gekweekt op Si (111) met behulp van plasma-geassisteerde moleculaire bundelepitaxie (MBE). De resultaten laten zien dat de structuurverschuiving van GaN-groei kan worden bereikt door de Ga/N-verhouding aan te passen en door de vooraf afgezette Al-druppeltjes toe te voegen. De morfologie en fotoluminescentie van het GaN-nanowall-netwerk werden gemeten met veldemissie-scanning-elektronenmicroscopie (FESEM) en een fotoluminescentiespectrumanalysator met He-Cd-laser (325 nm, 200 mW) als de excitatiebron. Atomic Force Microscoop (AFM) werd gebruikt voor de karakterisering van de vooraf gedeponeerde Al-laag. Het groeimechanisme van GaN nanowall-netwerk op Si (111) met metalen Al-druppeltjes wordt voorgesteld.
Experimenteel
GaN-structuren werden gekweekt op de Si (111)-substraten door een Riber 32 MBE-systeem uitgerust met een N2 RF-plasmabron (Veeco, RFS-N/TH). De druk van de groeikamer werd opgepompt tot 3,0 × 10 − 10 Torr voorafgaand aan de groei. De N2 gas, Ga en Al met een zuiverheid van 99,9999% werden in dit experiment gebruikt. Si (111)-substraat (zonder dotering, één zijde gepolijst voor groei, 380 ± 20 m, geleverd door Sigma-Aldrich) met een soortelijke weerstand> 5000 Ω cm werd gereinigd met een standaard RCA-proces, gevolgd door dompelen in HF:H2 O = 1:50 gedurende een paar seconden om de siliciumoxidelaag op het oppervlak van het Si-substraat te verwijderen en om een op waterstof eindigend oppervlak te vormen.
Voor de groei van de GaN-nanokolommen zijn de luiken van de N2 plasma en de Ga-bron werden gelijktijdig geopend en het kale Si (111) werd verwarmd tot 973 K. Het vermogen en de druk van de N2 plasmabron die in alle monsters in dit werk werd gebruikt, was vastgesteld op 400 W en 4,2 × 10 − 5 Torr, respectievelijk. Voorafgaand aan de groei van het GaN-nanowandnetwerk werden de Al-druppeltjes met een diameter van ongeveer 80 nm afgezet op het kale Si (111) verwarmd tot 973 K. De Al-bron werd op 1323 K gehouden. De pre-afzetting van de Al-druppeltjes resulteerde in een andere nucleatie en groei van GaN, wat leidde tot de groei van het nanowall-netwerk. De Ga-flux voor de groei van het nanowall-netwerk was hetzelfde met de nanokolommen (φ Ga = 1.2 × 10 − 7 Torr bij 1169 K). Voor de groei van GaN-film werd de Ga-flux verhoogd tot 5,3 × 10 − 7 Torr terwijl de N-flux constant werd gehouden.
Resultaten en discussie
Wanneer de luiken van N2 plasma en Ga werden gelijktijdig geopend, GaN (S1 ) groeide in de vorm van nanokolommen op het kale Si (111) zoals weergegeven in figuur 1a. De Ga-flux was 1,2 × 10 − 7 Torr en het Si (111)-substraat werden op 973 K gehouden, zoals weergegeven in tabel 1. Er wordt waargenomen dat de diameter van de GaN-nanokolommen varieert van 52 tot 125 nm met een lengte van ~ -460 nm. De dichtheid van de nanokolommen geteld vanaf de SEM-afbeelding is ~ 10 7 mm − 2 . Het is duidelijk dat de meeste nanokolommen die zijn waargenomen in figuur 1b niet loodrecht op het substraat staan, maar kantelen met een hoek van ~-30 °. Het bovenoppervlak van de nanokolommen is glad, in overeenstemming met het rapport van Bertness [9]. Er wordt aangenomen dat de nanokolommen spontaan kiemen en zich vervolgens voortplanten omdat de kleefcoëfficiënt op de (0 0 01) c -vlak is hoger dan dat op de {110 0} m -vlak. De diffusielengte L van het geabsorbeerde Ga-atoom (Gaab ) is essentieel voor de groei van de nanokolommen. Zoals beschreven in Vgl. (1), de diffusielengte L hangt af van de gemiddelde sprongafstand a , de Gaab desorptie-energie Q des , en de activeringsenergie voor een oppervlaktediffusiesprong Q d [13].
$$ L=\sqrt{2}a\ \exp \left(\frac{Q_{\mathrm{d}\mathrm{es}}-{Q}_{\mathrm{d}}}{2 kT}\ rechts) $$ (1)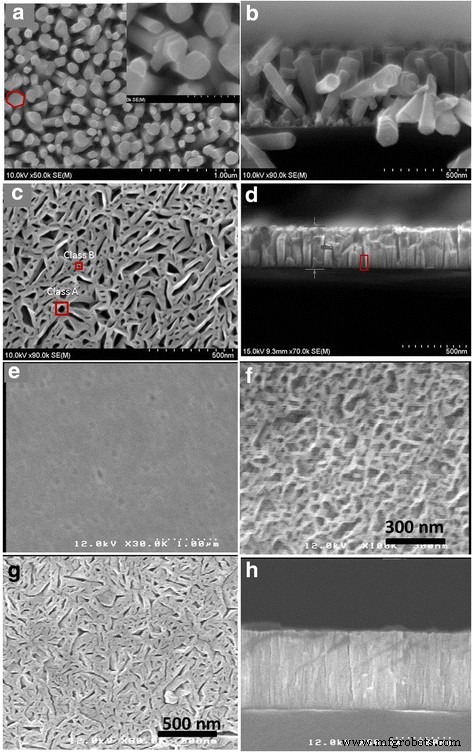
FESEM-afbeeldingen van monsters die onder verschillende omstandigheden zijn gekweekt. een , b Overeenkomend met de GaN-nanokolommen (voorbeeld S1 ). c , d Komt overeen met het GaN nanowall-netwerk (voorbeeld S2 ), e Komt overeen met de compacte film (voorbeeld S3 ), f Komt overeen met het GaN nanowall-netwerk (voorbeeld S4 ) in het begin van de groeifase. g , u Komt overeen met het GaN-nanowall-netwerk dat is gegroeid bij een lagere temperatuur van 900 K (voorbeeld S5 )
Aangezien de atomair vlakke zijwanden van de nanokolom weinig adsorptieplaatsen bieden, wordt aangenomen dat de Gaab diffusielengte L op de m -vlak van zijwanden is veel hoger dan dat op de c -vlak, wat resulteert in de verticale groei van GaN naar nanokolommen. Als deze veronderstelling waar zou zijn, zou de anisotropie van de sterke groeisnelheid worden gewijzigd wanneer de Ga/N-verhouding wordt verbeterd. Inderdaad, de GaN (S3 ) structuur veranderde van de nanokolom naar de compacte film (Fig. 1e) toen de Ga-flux werd verhoogd tot 5,3 × 10 − 7 Torr. Daarom kan de GaN-groei in de vorm van de nanokolom of de compacte film worden gecontroleerd door de Ш/V-verhouding aan te passen.
Hoewel de GaN-nanokolommen superieure prestaties vertonen dan de film, is de fabricage van een elektrisch apparaat een grote moeilijkheid omdat de gescheiden nanokolom moet worden uitgelijnd voorafgaand aan de fabricage van het elektrische contact. Een elektrisch geleidende nanostructuur in het vlak heeft daarom de voorkeur. Voor de groei van monster S2 , werd metallische Al-pre-afzetting uitgevoerd in de MBE-groeikamer gedurende 40 s. Dan, de N2 plasma en de Ga-bron werden gelijktijdig geopend. De Ga-flux voor de S2 groei is samengevat in tabel 1, hetzelfde als die van S1 . Afbeelding 1c toont de FESEM-afbeelding in bovenaanzicht van het monster S2. Het is best interessant dat de GaN groeit in de vorm van het nanowall-netwerk op de Al/Si (111). De nanowalls met een diameter van 50~100 nm overlappen en verweven met elkaar, waardoor een continu netwerk in het vlak wordt gevormd, namelijk het nanowall-netwerk. Er zijn twee klassen gaten waarneembaar, genaamd klasse A en klasse B. De diameters van de gaten van klasse A en klasse B zijn doorgaans respectievelijk 50~100 en 10~ 49 nm. De continue karakteristiek in het vlak maakt het nanowall-netwerk in-pane elektrisch geleidend [18], waardoor de obstakels voor de fabricage van nano-apparaten tot op zekere hoogte worden weggenomen. Het bovenoppervlak van de nanowanden is relatief vlak, anders dan de gefacetteerde GaN-matrix die wordt gerapporteerd in Ref. [13]. Het is waarneembaar dat de gaten in het bovenaanzicht zich uitstrekken tot nabij het substraat, zoals aangegeven door de rechthoek in Fig. 1d.
Men kan zich afvragen hoe de hierboven genoemde gaten ontstaan. We hebben een monster S5 gekweekt bij een lagere groeitemperatuur van 900 K. De overige groeiparameters zijn hetzelfde met het monster S2 , zoals weergegeven in tabel 1. Uit Fig. 1g zien we dat het monster S5 groeide ook in de vorm van het nanowall-netwerk met kleinere gaten. Afbeelding 1h is de afbeelding in dwarsdoorsnede van S5 , met een compactere laag dan S2. Om de beginnende groei van het GaN-nanowall-netwerk te zien, hebben we nog een monster S4 . gekweekt in een korte tijd met Al pre-depositie. Alle groeiparameters van S4 zijn hetzelfde als die van voorbeeld S2 behalve de groeitijd (20 vs 120 min). De dikte van S4 is ongeveer 50 nm en het bovenaanzicht wordt getoond in Fig. 1f. Het is waargenomen dat er in dit stadium gaten zijn gevormd en dat de GaN-gaN in het vlak een continu netwerk in het vlak is, in plaats van de GaN-nanodraden of -eilanden. Uit de studie van monsters S1 , S2 , S4 , en S5 , is het duidelijk dat de pre-depositie van de Al-laag het groeigedrag van GaN aan het begin verandert, van de nanokolom naar het continue nanowandnetwerk in het vlak.
Merk op dat alle groeicondities van S2 behalve dat de pre-depositie van Al hetzelfde is als die van S1 . Dan kunnen we ons afvragen wat de structuur van het vooraf gedeponeerde Al is en hoe het de daaropvolgende groei van het GaN beïnvloedt. Om deze antwoorden te vinden, wordt Al-predepositie gedurende 40 s op het kale Si (111) onderzocht door FESEM en AFM. Afbeelding 2a toont het bovenaanzicht van het vooraf gedeponeerde Al. Er is gevonden dat het Al op het Si-substraat bestaat in de vorm van druppels (witte stippen) anders dan film. De metalen Al-druppels met een dichtheid van ~ 4 × 10 7 mm − 2 relatief uniform verdelen zonder significante accumulatie. Onlangs werden de Al-druppeltjes met succes gekweekt met behulp van MBE door Li et al. om de kwaliteit van As-grown GaN te verbeteren en de stress te verminderen [24]. Om de morfologie van de Al-druppeltjes verder te bestuderen, werd AFM gebruikt om hun driedimensionale afbeeldingen en gerelateerde parameters te meten, zoals weergegeven in Fig. 2b, c. De druppeltjes zijn bol zoals weergegeven in figuur 2b, in overeenstemming met het SEM-resultaat. De hoogte en diameter van de gemeten Al-druppel zijn respectievelijk 6,7 en 80 nm. Poppitz et al. [25] hebben de groei van het GaN-nanowall-netwerk op kale 6H-SiC (0001) onderzocht door middel van ijzerstraal-geassisteerde MBE. Hun resultaten laten zien dat de extreem N-rijke groeiomstandigheden in combinatie met de hoge substraattemperatuur en de energetische N-ionenbestraling tijdens de groei de belangrijkste redenen zijn voor de vorming van het nanowall-netwerk op kale 6H-SiC (0001). Als pionier hebben Kesaria et al. [17] hebben het GaN-nanowall-netwerk op kale saffiersubstraat onderzocht met behulp van PA-MBE. In hun onderzoek wordt aangenomen dat de GaN-nanowanden kiemen aan de rand en de schroefdislocaties en groeien onder een N-rijke atmosfeer.
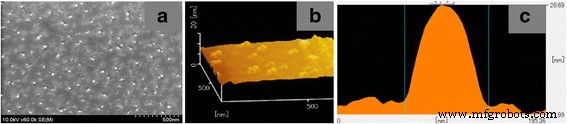
FESEM (een ) en AFM (b ) afbeeldingen van het vooraf gedeponeerde Al op Si-substraat. c Een parametermeting van één Al-druppel door AFM
In ons geval zou het groeimechanisme van het GaN-nanowall-netwerk anders moeten zijn, aangezien de nanowalls groeien met de vereiste van de metallische Al-pre-depositie. Natuurlijk, voor zover wij weten, worden alle GaN-nanowall-netwerken, inclusief in ons experiment, gekweekt onder de N-rijke atmosfeer. N-rijk is nodig om de coalescentie van de nanowanden te verminderen. Laten we ons nu concentreren op de rol van de Al-druppeltjes bij de vorming van het nanowall-netwerk. Net als de Au-druppeltjes die als een katalysator werken [26], als de Al-druppeltjes als een katalysator werken, zou de GaN naar de nanokolommen moeten groeien in plaats van naar het nanowandnetwerk. De rol van de Al-druppels is daarom geen katalysator in ons onderzoek. De smelttemperatuur van het Al-metaal is 933 K, terwijl de substraattemperatuur tijdens de groei op 973 K wordt gehouden. Aan het begin van de GaN-groei zijn de Al-druppeltjes dus vloeibare druppels. Volgens eerder rapport, in het geval van GaN op Si (111) met Ga-druppeltjes [13], fungeren de Ga-druppeltjes als reservoirs die Ga-atomen naar hun directe omgeving leveren. De Ga-druppeltjes zelf belemmeren echter de GaN-groei erop, aangezien de oorspronkelijke Ga-druppelplaatsen holle cirkels zijn. In ons geval is de diameter van de Al-druppels ~ 80 nm, vergelijkbaar met de grootte van de klasse A-gaten in figuur 1a. Daarom kunnen de Al-druppeltjes de groei van GaN erop belemmeren, wat leidt tot de vorming van de klasse A-gaten die worden waargenomen in het GaN-nanowall-netwerk. Vanwege dezelfde Ш/V-verhouding van monsters S1 en S2 , de Ga-diffusielengte L op Si voor de nanowall-netwerkgroei zal naar verwachting hetzelfde zijn als die voor de nanokolommen. De typische grootte van het kale Si-substraat (het gebied zonder Al-druppeltjes) is ~ -80 nm, binnen de waarde van de nanokolomdiameter in figuur 1a. Met andere woorden, de Ga-diffusielengte L beslaat de grootte van het kale Si-substraat, wat resulteert in de continue groei van GaN in het gebied zonder de Al-druppeltjes, d.w.z. het GaN-nanowall-netwerk.
Op basis van de bovenstaande analyse wordt een groeimodel van het GaN-nanowall-netwerk voorgesteld en weergegeven in figuur 3. GaN kiemt op het kale Si-substraat zoals geïllustreerd in figuur 3a. Sinds de Gaab diffusielengte L bedekt het kale Si-substraat, GaN groeit in het hele kale Si-substraat terwijl de GaN-groei boven de Al-druppeltjes wordt belemmerd (figuur 3b). Bovendien heeft GaN onder N-rijke omstandigheden de neiging verticaal te groeien, zoals weergegeven in figuur 3c. Omdat het kale Si-substraat een continu netwerk in het vlak is, is de groei van GaN hierboven ook een continu netwerk dat het nanowall-netwerk wordt genoemd, zoals geïllustreerd in figuur 3d. Deze aanname wordt bevestigd door het bovenaanzicht van het monster S4 in afb. 1f. Vanwege de N-rijke voorwaarde voor het monster S2 groei is de laterale groei beperkt die de gaten kunnen reserveren in de volgende groei. Merk op dat zowel de Al-druppeltjes als de N-rijke toestand essentieel zijn voor de groei van het GaN-nanowall-netwerk.
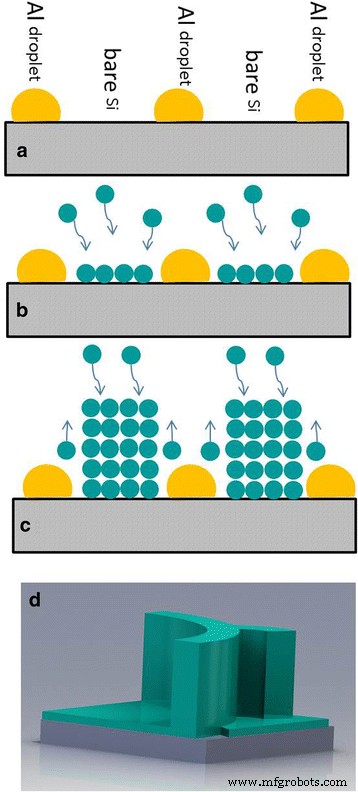
Groeimodellen van het GaN nanowall-netwerk. een De vooraf afgezette Al-druppeltjes op het Si-substraat. b Nucleatie van het GaN nanowall-netwerk op het kale Si. c Dwarsdoorsnede van het GaN-nanowall-netwerk dat verticaal is gegroeid in de N-rijke toestand. d Kantelillustratie van het GaN nanowall-netwerk
Röntgendiffractie werd gebruikt voor de karakterisering van de kristalstructuur van het GaN-nanowall-netwerk, zoals weergegeven in figuur 4. Twee diffractiepieken van de GaN(002) en de GaN(004) worden waargenomen samen met de Si (111)-piek van de Si substraat. Het resultaat laat zien dat het GaN nanowall-netwerk hexagonaal is en sterk oriënteert langs C as. Naast het XRD-patroon werd ook de ω-scan-schommelcurve van de GaN(002) gemeten, zoals weergegeven in de inzet van figuur 4. De volledige breedte op het halve maximum is 52,2 arcmin, vergelijkbaar met het vorige rapport gegroeid op de saffier substraat [27]. De elektrische eigenschappen zijn ook gemeten met het Van der Pauw Hall-meetsysteem (HL5500PC, Nanometrics) bij 293 K. De elektrische geleidbaarheid, de hall-mobiliteit en de elektronenconcentratie van het GaN-nanowall-netwerk zijn 10,2 S/cm, 31 cm 2 /Vs, en 2.1×10 18 cm − 3 , respectievelijk. Wat de GaN-film betreft, neemt de elektrische geleidbaarheid toe tot 666,7 S/cm vanwege de hogere elektronenconcentratie van 2,2×10 20 cm − 3 . De hoge dragerconcentratie in de film wordt waarschijnlijk toegeschreven aan de hoge intrinsieke defectconcentratie die wordt gegenereerd door de niet-geoptimaliseerde Ga/N-verhouding. Wat betreft de zaalmobiliteit van de film, de waarde is 18,7 cm 2 /Vs.

Röntgendiffractiepatroon van het GaN nanowall-netwerk (S2 ). De inzet is de ω-scan schommelcurve van het monster S2
Figuur 5 toont de fotoluminescentiespectra van het GaN-nanowall-netwerk met een He-Cd-laser als excitatiebron. Volgens het rapport van Kesaria et al. [17] werd een directe vergelijking van kathodoluminescentie tussen GaN-film, nanowall-netwerk en nanokolom gekweekt op kale saffiersubstraat uitgevoerd. Hun resultaten laten zien dat de band-edge-emissie van het nanowall-netwerk iets hoger is dan die van de nanokolom en veel hoger dan die van de film. Een brede defectemissie gecentreerd op 520 tot 620 is waarneembaar voor het nanowandnetwerk, terwijl er geen defectemissie kon worden waargenomen voor de nanokolom. In figuur 5 wordt een sterke band-edge-emissie gecentreerd op 363,7 nm waargenomen met de volledige breedte op half maximum 14,1 nm. In overeenstemming met het rapport van Kesaria et al. [17], in het bereik van 520 tot 620 nm, is een brede groengele emissie die wordt toegeschreven aan puntdefecten [28] detecteerbaar maar zeer zwak, wat wijst op een hoge kwaliteit van de GaN-nanowand netwerk. Daarom is de luminescentie van het GaN-nanowandnetwerk dat is gegroeid op het kale saffiersubstraat en op het Si-substraat met de Al-druppeltjes bijna hetzelfde, hoewel het groeimechanisme anders is.

Fotoluminescentie (PL) spectra van het GaN nanowall-netwerk gemeten bij kamertemperatuur
Conclusies
In dit werk werd de structuurverschuiving van de GaN-groei tussen de nanokolom, het nanowandnetwerk en de compacte film met succes bereikt op Si (111) substraat met behulp van MBE. De GaN-nanokolommen werden gekweekt op het kale Si-substraat onder N-rijke omstandigheden, terwijl de compacte film werd gekweekt met een verbeterde Ga-flux. Door een vooraf gedeponeerde Al-laag toe te voegen, verschuift de groei van GaN van de nanokolommen naar het continue nanowandnetwerk in het vlak. De vooraf afgezette Al-laag bestaat in de vorm van druppeltjes met de typische hoogte en diameter van respectievelijk 6,7 en 80 nm. Het groeimechanisme van het nanowall-netwerk komt aan bod. GaN groeit continu op het kale Si-substraat terwijl de GaN-groei op de Al-druppeltjes wordt belemmerd, wat resulteert in de vorming van het nanowall-netwerk. Zowel Al-druppels als N-rijke toestand zijn essentieel voor de groei van het nanowall-netwerk.
Nanomaterialen
- C# Bitsgewijze en Bit Shift-operators
- C Structuur en functie
- Team Chemie en Industrie 4.0
- 5G en GaN:de verschuiving van LDMOS naar GaN
- 5G en GaN:toekomstige innovaties
- IoT en blockchain – Een paradigmaverschuiving
- Verschil tussen structuur en unie
- Onthulling van de atomaire en elektronische structuur van gestapelde koolstof nanovezels
- Structuur en elektronische eigenschappen van met overgangsmetaal gedoteerde kaoliniet nanoklei
- Infraroodreflectieanalyse van epitaxiale n-type gedoteerde GaN-lagen gegroeid op saffier
- Amorfe silicium nanodraden gegroeid op siliciumoxidefilm door gloeien



