Zelfgekatalyseerde groei van verticale GaSb-nanodraden op InAs-stengels door metaal-organische chemische dampafzetting
Abstract
We rapporteren de eerste zelfgekatalyseerde groei van hoogwaardige GaSb-nanodraden op InAs-stelen met behulp van metaal-organische chemische dampafzetting (MOCVD) op Si (111)-substraten. Om de groei van verticale InAs/GaSb heterostructuur nanodraden te bereiken, worden de tweestaps stroomsnelheden van trimethylgallium (TMGa) en trimethylantimoon (TMSb) gebruikt. We gebruiken eerst relatief lage TMGa- en TMSb-stroomsnelheden om de Ga-druppeltjes op de dunne InAs-stelen te behouden. Vervolgens worden de stroomsnelheden van TMGa en TMSb verhoogd om de axiale groeisnelheid te verbeteren. Vanwege de langzamere radiale groeisnelheid van GaSb bij hogere groeitemperatuur, vertonen GaSb-nanodraden gekweekt bij 500 ° C grotere diameters dan die gekweekt bij 520 ° C. Met betrekking tot de axiale groei, vanwege het Gibbs-Thomson-effect en de vermindering van de oververzadiging van de druppeltjes bij toenemende groeitemperatuur, zijn GaSb-nanodraden die bij 500 ° C zijn gekweekt echter langer dan die bij 520 ° C. Gedetailleerde transmissie-elektronenmicroscopie (TEM) -analyses onthullen dat de GaSb-nanodraden een perfecte zink-blende (ZB) kristalstructuur hebben. De hier gepresenteerde groeimethode kan geschikt zijn voor andere antimonide nanodraadgroei, en de axiale InAs/GaSb heterostructuur nanodraden kunnen een sterk potentieel hebben voor gebruik bij de fabricage van nieuwe op nanodraad gebaseerde apparaten en bij de studie van fundamentele kwantumfysica.
Achtergrond
III-V halfgeleider-nanodraden zijn erkend als veelbelovende kandidaten voor elektronische, optische en kwantumapparaten van de volgende generatie op nanoschaal vanwege hun unieke elektronische, optische en geometrische eigenschappen [1,2,3]. Onder de III-V-halfgeleidermaterialen hebben III-antimoniden, vanwege hun unieke voordelen, zoals een smalle directe bandgap, een kleine effectieve massa van de drager en de hoogste dragermobiliteit, een sterk potentieel voor gebruik bij de fabricage van midden- en langegolf-infrarood fotodetectoren [4], low-power high-speed transistors [5,6,7] en in de studie van fundamentele kwantumfysica [8,9,10]. Vanwege hun zware atomaire massa, de lage vluchtigheid van elementair Sb en de lage smelttemperatuur van III-antimonideverbindingen, is het echter uiterst uitdagend om de groei van op antimonide gebaseerde nanodraden te bereiken [11].
Met name GaSb-nanodraden, die als uiterst belangrijke p-type antimonide-nanodraden worden beschouwd, zijn voornamelijk gekweekt met behulp van Au-katalysatoren [12,13,14,15,16]. De introductie van Au kan echter ongewenste recombinatiecentra op diep niveau vormen in de Si-bandkloof en de elektronische en optische eigenschappen van III-V-nanodraden verslechteren [17, 18]. Daarom is het zeer wenselijk om GaSb-nanodraden te kweken zonder vreemde katalysatoren. Bovendien is voor verticale antimonide nanodraadgroei directe nucleatie op het substraat erg moeilijk. Om het nucleatieprobleem te voorkomen, wordt altijd eerst een korte steel van een ander materiaal gekweekt om de groei van verticale GaSb-nanodraden te ondersteunen. Onlangs is de zelfgekatalyseerde groei van GaSb-nanodraden op GaAs-stelen gerealiseerd door moleculaire bundelepitaxie (MBE) [19], maar voor zover wij weten, zijn er geen rapporten over de groei van hoogwaardige GaSb-nanodraden zonder de gebruik van vreemde katalysatoren op basis van een metaal-organische chemische dampafzetting (MOCVD) techniek. Hier presenteren we de zelfgekatalyseerde groei van GaSb-nanodraden met behulp van InAs-stengels met behulp van MOCVD op Si (111)-substraten. Enerzijds is de groei van GaSb-nanodraden op InAs-nanodraadstelen door een zelfgekatalyseerd mechanisme moeilijk vanwege de verandering van zowel anionen als kationen van de InAs-stengel naar het bovenste GaSb. Aan de andere kant, vanwege de lage roostermismatch van 0,6% en de unieke type-II-gebroken banduitlijning tussen InAs en GaSb, maakt de groei van GaSb-nanodraden op InAs-stengels om InAs/GaSb axiale heterostructuur-nanodraden te vormen een nieuw platform mogelijk voor veel toepassingen, waaronder op tunneling gebaseerde apparaten [7, 14, 20, 21], high-speed complementaire metaaloxide-halfgeleider (CMOS)-transistoren [22, 23], onderzoek naar elektron-gathybridisatie [9] en exciton- en spinfysica-onderzoeken [24].
In dit artikel werden hoogwaardige GaSb-nanodraden met gladde zijwanden bereikt door zorgvuldige controle van de groeiomstandigheden. Om de groei van verticale InAs/GaSb heterostructuur nanodraden te bereiken, werden eerst relatief lage stroomsnelheden van trimethylgallium (TMGa) en trimethylantimoon (TMSb) gebruikt om de Ga-druppeltjes op de InAs-stelen te behouden. Vervolgens werden de TMGa- en TMSb-stroomsnelheden verhoogd om de axiale groei van de GaSb-nanodraden te verbeteren. Vanwege de langzamere radiale groeisnelheid van GaSb bij hogere groeitemperatuur, hebben GaSb-nanodraden gekweekt bij 500 ° C grotere diameters dan die gekweekt bij 520 ° C. Bovendien zijn, vanwege het Gibbs-Thomson-effect en de vermindering van de oververzadiging van de druppeltjes met toenemende groeitemperatuur, GaSb-nanodraden die bij 500 ° C zijn gekweekt, groter in zowel diameter als lengte dan die gekweekt bij 520 ° C. Gedetailleerde transmissie-elektronenmicroscopie (TEM)-analyses onthullen dat de kristalstructuur van de InAs-stengels is samengesteld uit een polytype van wurtziet (WZ) en zink-blende (ZB) structuren, terwijl de axiaal gegroeide GaSb-nanodraden een zuivere ZB-kristalstructuur hebben die volledig vrij is van vlakke defecten.
Methoden
Nanodraad-groei
De InAs / GaSb heterostructuur-nanodraden werden gekweekt door een MOCVD-systeem met nauw gekoppelde douchekop (AIXTRON Ltd, Duitsland) bij een kamerdruk van 133 mbar. Trimethylindium (TMIn) en TMGa werden gebruikt als voorlopers van groep III, en arsine (AsH3 ) en TMSb werden gebruikt als voorlopers van groep V. Ultrazuivere waterstof (H2 ) werd gebruikt als dragergas en de totale stroomsnelheid van H2 was 12 sl. De nanodraden werden gekweekt op Si (111)-substraten. Voorafgaand aan de groei werden de substraten verwarmd tot 635 °C om te gloeien en vervolgens afgekoeld tot 400 °C onder AsH3 flux om (111)B-achtige oppervlakken te vormen [25]. De InAs-stelen werden gedurende 45 seconden bij 545 °C gekweekt met TMIn en AsH3 stroomsnelheden van 1,0 × 10 −6 mol/min en 2.0 × 10 −4 mol/min, respectievelijk. Vervolgens werden de bronfluxen omgeschakeld van TMIn en AsH3 aan TMGa en TMSb, en de substraten werden afgekoeld tot de specifieke temperatuur voor de axiale groei van GaSb-nanodraden. Ten slotte werden de monsters afgekoeld tot kamertemperatuur met TMSb als beschermend middel.
Karakterisatiemethoden
De morfologie van de nanodraden werd gekarakteriseerd door scanning-elektronenmicroscopie (SEM) (Nova Nano SEM 650), en TEM (JEM2010F TEM; 200 kV) in combinatie met röntgenenergie-dispersieve spectroscopie (EDS) werd gebruikt om de kristalstructuur en respectievelijk de elementaire samenstellingsverdeling. Voor TEM-waarnemingen werden de als gegroeide nanodraden mechanisch overgebracht van de monsters naar koperen roosters bedekt met een koolstoffilm. Raman-metingen werden uitgevoerd in terugverstrooiingsgeometrie bij kamertemperatuur met behulp van een laser met een golflengte van 532 nm als de excitatiebron (Jobin-Yvon HR Evolution Raman System). De monsters werden geëxciteerd met een laservermogen van 0,36 mW over een spotgrootte van ongeveer 1 m.
Resultaten en discussie
Figuur 1 toont een schematische weergave van de axiale groei van GaSb-nanodraden op InAs-stelen en de source-supply-sequenties voor de groei van de nanodraden. De nanodraden groeien via een zelfgekatalyseerd mechanisme, en katalytische druppeltjes veranderen geleidelijk van In naar Ga na het omschakelen van de fluxen van TMIn en AsH3 naar TMGa en TMSb. Vergeleken met de stengel-nanodraden hebben GaSb-nanodraden altijd een veel dikkere diameter, wat betekent dat de grootte van de katalytische Ga-druppels veel groter is dan die van de In-druppels. Dan kan een te snelle verzameling van Ga-adatomen door de druppels op de dunne InAs-stelen ervoor zorgen dat de druppels naar beneden glijden (zoals weergegeven in aanvullend bestand 1:figuur S1). Om ervoor te zorgen dat de katalytische druppeltjes voldoende tijd hebben om Ga-adatomen te verzamelen tijdens de overgangsfase van InAs naar GaSb, hebben we eerst relatief lage stroomsnelheden van TMGa en TMSb gebruikt om de Ga-druppeltjes op de InAs-stelen te beschermen, zoals weergegeven in Fig. 1. Tijdens de eerste stap waren de TMGa- en TMSb-stroomsnelheden 0,35 × 10 −6 mol/min en 2.0 × 10 −6 mol/min, wat overeenkomt met een V/III-verhouding van ~5,7, en het groeiproces bleef 15 min (regio 2 in Fig. 1). Daarna werden, om de axiale groeisnelheid te verhogen, de stroomsnelheden van TMGa en TMSb verhoogd tot 0,7 × 10 −6 mol/min en 4.0 × 10 −6 mol/min voor de daaropvolgende groei van GaSb-nanodraden (respectievelijk de V/III-verhouding constant houdend). Door de tweestaps TMGa- en TMSb-stroomsnelheden te gebruiken, hebben we met succes de verticale groei van GaSb-nanodraden op InAs-stelen gerealiseerd. Gezien de ongewijzigde groeitijd van de GaSb-nanodraden met de lage stroomsnelheden, tenzij specifiek vermeld, zijn de groeitijden voor GaSb-nanodraden die in de volgende paragrafen worden genoemd identiek aan die van GaSb-groei met de hoge stroomsnelheden (regio 3 in Fig. 1) .
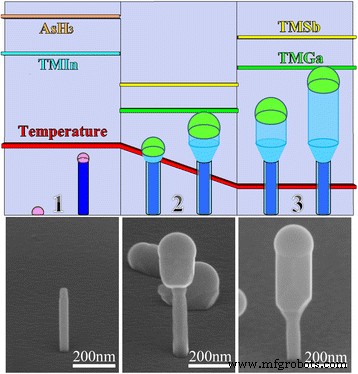
De illustratie van de axiale groei van GaSb-nanodraden op InAs-stelen en de source-supply-sequenties voor de groei van de nanodraden. De hier gepresenteerde GaSb-nanodraden zijn gekweekt bij 520 ° C
Typische SEM-afbeeldingen van de GaSb-nanodraden gekweekt op InAs-stelen bij verschillende temperaturen van 480, 500, 520 en 545 ° C worden respectievelijk getoond in Fig. 2a-d (de InAs-stengels vóór de GaSb-groei worden weergegeven in aanvullend bestand 1:Figuur S2). De groeitijd van GaSb is 10 min. Het groeigedrag van de GaSb blijkt zeer gevoelig te zijn voor de groeitemperatuur. Het is duidelijk dat bij 480 ° C, in plaats van axiale groei, de GaSb de neiging heeft om radiaal rond de InAs-stelen of langs de vlakke richting te groeien (figuur 2a). Details over de radiale groei van GaSb-schillen op InAs-kernen en de vlakke groei van antimonide-nanodraden zijn elders gerapporteerd [26,27,28]. De situatie verandert echter naarmate de GaSb-groeitemperatuur stijgt tot 500 of 520 ° C, waar axiale groei van GaSb-nanodraden wordt gerealiseerd op de vrijstaande InAs-stelen (Fig. 2b, c). De Ga-druppeltjes aan de uiteinden van de nanodraad duiden op een zelfgekatalyseerd groeimechanisme van damp-vloeistof-vaste stof (VLS) van de GaSb-nanodraden. De diameter van de bovenste GaSb-segmenten is over het algemeen dikker dan die van de InAs-segmenten, en de toenemende breedte van de GaSb-segmenten op het InAs/GaSb-interface geeft aan dat de grootte van de katalytische Ga-druppeltjes geleidelijk toeneemt in de initiële groeifase van GaSb. Bovendien kunnen de veel dunnere stengelsegmenten in figuur 2c impliceren dat de radiale groei van GaSb geleidelijk afnam naarmate de groeitemperatuur toenam van 500 tot 520 ° C. Wanneer de temperatuur echter verder wordt verhoogd tot 545 ° C, lijkt het alsof GaSb-nanodraden langs de vlakke of hellende richting groeien. Bovendien zijn de meeste InAs-stelen verdwenen en is de diameter van de resterende InAs-stelen erg dun (gemarkeerd door de rode cirkels in Fig. 2d, en meer SEM-afbeeldingen worden getoond in Aanvullend bestand 1:Afbeelding S3). We speculeren dat de InAs-stengels ernstig worden afgebroken bij de hoge groeitemperatuur van 545 ° C, wat resulteert in het naar beneden vallen van de GaSb-nanodraden tijdens het groeiproces. Om de verticale groei van GaSb-nanodraden op InAs-nanodraadstelen te verkrijgen, moet daarom de groeitemperatuur van de GaSb-nanodraad zorgvuldig worden gecontroleerd.

De 80° gekantelde SEM-beelden van de GaSb-nanodraden die op InAs-stengels zijn gegroeid op a 480 °C, b 500 °C, c 520 °C en d 545 ° C gedurende 20 minuten. De groeiomstandigheden van de InAs-nanodraadstengels werden constant gehouden. Inzetstukken in b en c tonen hogere vergroting SEM-afbeeldingen. De rode cirkels in d markeer de resterende InAs-stelen
Figuur 3 toont de statistische verdelingen van de diameter en lengte van de GaSb-segmenten getoond in Fig. 2b, c, waarbij de groeitemperaturen van GaSb respectievelijk 500 en 520 ° C zijn. Het is duidelijk dat de grootteverdeling van GaSb-nanodraden die bij dezelfde temperatuur zijn gegroeid (rode of blauwe stippen in Fig. 3) aantoont dat de dikkere nanodraden meestal langer zijn. Dit fenomeen is ook gemeld voor de Ga-gekatalyseerde groei van GaAsP-nanodraden door MBE [29] en voor de Au-gekatalyseerde groei van InAs/InSb heterostructuur-nanodraden door chemische bundelepitaxie (CBE) [30] en InGaSb-nanodraden door MOCVD [31] ]. De reden wordt voornamelijk toegeschreven aan de lagere effectieve oververzadiging (Δμ ) in de kleinere katalytische druppeltjes. Voor het VLS-groeimechanisme is de oververzadiging Δμ , wat de verandering in chemische potentiaal per III-V-paar in de katalytische druppel en de nanodraad is, is de belangrijkste drijvende kracht voor de groei van nanodraad. Tijdens het zelfgekatalyseerde groeiproces worden nanodraden gekweekt in een groep III-rijke omgeving en de concentratie van de groep V-atomen opgenomen in de katalytische druppel domineert de effectieve oververzadiging. Voor de zelfgekatalyseerde groei van GaSb-nanodraden, de effectieve oververzadiging Δμ wordt gedomineerd door de concentratie van Sb-atomen die zijn opgenomen in de katalytische druppeltjes van Ga. Daarom is de effectieve oververzadiging Δμ kan worden gepresenteerd als [32, 33]
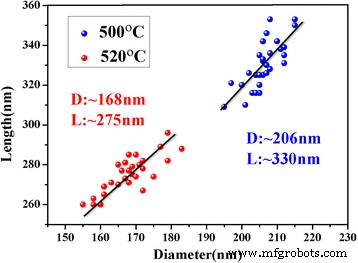
Statistische gegevens van de diameter en lengte van de GaSb-nanodraden gekweekt bij 500 en 520 °C
.
$$ \varDelta \mu ={k}_{\mathrm{B}} T \ln \left({x}_{\mathrm{Sb}}/{x}_{\mathrm{Sb},\mathrm{ eq}}\rechts) $$ (1)waar k B is de Boltzmann-constante, T is de absolute temperatuur. x Sb en x Sb,eq zijn respectievelijk de atoomfractie van Sb in de katalytische druppeltjes van Ga tijdens het groeiproces van de nanodraad en in evenwicht met het kristal van de nanodraad van GaSb. Bovendien, gebaseerd op de klassieke theorie van kristalgroei, is de axiale groeisnelheid van de nanodraad (v ) kan worden uitgedrukt als [34].
$$ v\sim {\left(\varDelta \mu /{k}_{\mathrm{B}} T\right)}^2 $$ (2)Het is duidelijk dat de groeisnelheid van nanodraad sterk afhankelijk is van de Sb-concentratie x Sb in de Ga-druppeltjes. Vanwege het Gibbs-Thomson-effect kan de dampdruk van Sb in de katalytische druppeltjes aanzienlijk toenemen naarmate de diameter kleiner wordt [35, 36]. Dan kunnen de kleinere druppeltjes Sb-atomen gemakkelijker van de Ga-katalytische deeltjes desorberen, wat zal resulteren in de lagere Sb-concentratie (x Sb ) in de kleinere katalytische druppeltjes van Ga. Als gevolg hiervan is de effectieve oververzadiging in de kleinere druppeltjes lager dan die in de grotere, waardoor de axiale groeisnelheid van de GaSb-nanodraden door het zelfgekatalyseerde groeimechanisme wordt verminderd.
Bovendien, bij het vergelijken van de grootteverdelingen van GaSb-nanodraden gegroeid bij 500 en 520 ° C, wordt waargenomen dat de GaSb-nanodraden gegroeid bij 500 ° C (blauwe stippen in Fig. 3; gemiddelde diameter en lengte -206 en ~ 330 nm) hebben zowel een grotere diameter als een grotere lengte dan de GaSb-nanodraden gegroeid bij 520 ° C (rode stippen in Fig. 3; gemiddelde diameter en lengte -168 en ~275 nm). De dunnere nanodraden die bij 520 ° C zijn gegroeid, kunnen worden toegeschreven aan de langzamere radiale groeisnelheid van GaSb bij hogere groeitemperatuur. Voor de axiale groei, anders dan het Gibbs-Thomson-effect, kan de toename van de groeitemperatuur echter ook de oververzadiging van de druppeltjes verminderen en de axiale groeisnelheid van de GaSb-nanodraden verder verminderen [29, 37]. De GaSb-nanodraden die bij 500 °C zijn gekweekt, zijn dus groter in zowel diameter als lengte dan de GaSb-nanodraden die bij 520 °C zijn gekweekt.
Om de voordelen van de hulp van de stengel-nanodraden verder te bepalen, vergeleken we vervolgens de GaSb-nanodraden die direct op Si-substraten en op korte InAs-stelen waren gegroeid, zoals te zien in Fig. 4. De GaSb-nanodraden getoond in Fig. 4a, b werden gekweekt bij 500 ° C, terwijl de GaSb-nanodraden gepresenteerd in Fig. 4c werden gekweekt bij 520 ° C. Het is duidelijk dat de InAs-nanodraadstelen een cruciale rol spelen in de succesvolle groei van verticale GaSb-nanodraden. Zoals getoond in Fig. 4a, groeien de GaSb-nanodraden die direct op Si (111)-substraten zijn gekweekt het liefst in de vlakke richting (meer SEM-afbeeldingen zijn beschikbaar in aanvullend bestand 1:figuur S4), en we speculeren dat deze kwestie van antimonide-nanodraden direct genucleëerd op substraten wordt geassocieerd met het oppervlakteactieve effect van Sb-adatomen, wat de contacthoek tussen de vooraf afgezette Ga-druppeltjes en het Si-substraatoppervlak kan verkleinen [38, 39]. Terwijl, zoals getoond in Fig. 4b, c, verticale GaSb-nanodraden worden bereikt met behulp van de korte InAs-stelen. We merken op dat in Fig. 4b, c, de groeitijd van de InAs-nanodraadstelen is verminderd tot 20 s (wat resulteert in een lengte van InAs-nanodraden die over het algemeen minder dan 120 nm is), terwijl de groeitijd van de GaSb-nanodraden wordt verhoogd tot 30 minuten. Alle GaSb-nanodraden hebben extreem gladde zijwanden over de gehele lengte zonder zichtbare versmalling. Met name hebben de InAs-stamsegmenten bijna dezelfde diameter als de bovenste GaSb-nanodraden (zoals weergegeven in de inzet van Fig. 4b, c), wat aangeeft dat de radiale groeisnelheid van GaSb rond InAs-stelen sneller is dan die rond bovenste GaSb-nanodraden . Dit verschil kan worden geassocieerd met het feit dat de reactant-adatomen die van het substraatoppervlak worden verspreid, de neiging hebben zich rond de zijwanden van de dunne en korte InAs-nanodraden te verzamelen, wat resulteert in de lokale verbetering van de radiale groeisnelheid van GaSb rond de InAs-stelen. Ten slotte hebben de gekweekte nanodraden, met voldoende groeitijd, een bijna uniforme diameter langs de groeirichting; hetzelfde gedrag is ook waargenomen bij de groei van InSb-nanodraden op basis van korte InAs-stelen door MOCVD [40].

De 80° gekantelde SEM-beelden van de GaSb-nanodraden die zijn gekweekt zonder InAs-stengels (a ), en op de korte InAs-stelen (b , c ). De GaSb-nanodraden weergegeven in a en b werden gekweekt bij 500 °C, terwijl de GaSb-nanodraden in c werden gekweekt bij 520 ° C. Inzetstukken in b en c SEM-afbeeldingen met hogere vergroting weergeven
Om de structurele kenmerken van de verkregen nanodraden te onderzoeken, werden gedetailleerde TEM-metingen uitgevoerd. Figuur 5a toont een helderveld (BF) TEM-beeld met lage resolutie van een typische GaSb-nanodraad gegroeid op een InAs-stam bij 520 ° C (zoals weergegeven in figuur 2c). Na de daaropvolgende groei van de GaSb-nanodraad heeft de dunnere InAs-nanodraad een ruwe morfologie. Dit kan worden toegeschreven aan de pyrolyse van InAs en de onregelmatige radiale groei van GaSb tijdens het GaSb-nanodraadgroeiproces. Afbeelding 5b-e vertegenwoordigen de overeenkomstige TEM-afbeeldingen (HRTEM) met hoge resolutie die zijn genomen uit de regio's die zijn gemarkeerd met vier rode rechthoeken in Fig. 5a. De HRTEM-microfoto en het bijbehorende snelle Fourier-transformatie (FFT) -patroon in Fig. 5b onthullen dat de axiaal gegroeide GaSb-nanodraad een zuivere ZB-kristalstructuur heeft die volledig vrij is van vlakke defecten, wat vaak wordt waargenomen bij de groei van antimonide-nanodraden. De occasionele planaire defecten (tweelingvlakken (TP's) en stapelfouten (SF's)) die zich voordoen in het bovenste en vroege groeigebied van de GaSb-nanodraad (Fig. 5c, d) kunnen echter worden veroorzaakt door een lichte fluctuatie van lokale groeiomstandigheden tijdens het uiteindelijke koelproces en de eerste overgangsfase van InAs naar de bovenste GaSb. Daarnaast kunnen de resterende As-atomen ook een rol spelen bij de vorming van planaire defecten in het overgangsgebied (zoals weergegeven in de EDS-analyses hieronder). Daarentegen, zoals getoond in Fig. 5e, is de kristalstructuur van de InAs-stam samengesteld uit een polytype van WZ- en ZB-structuren met een groot aantal vlakke defecten langs de groeirichting ervan; vanwege het naast elkaar bestaan van WZ- en ZB-structuren, splitsen de overeenkomstige FFT-spots zich en zijn ze enigszins langwerpig langs de groeirichting (inzet in figuur 5e). Het is aangetoond dat structurele defecten in nanodraden ongewenste remming van de mobiliteit van dragers [41] kunnen veroorzaken en daardoor de transporteigenschappen in het InAs/GaSb-heterostructuursysteem kunnen verminderen. Onlangs is gemeld dat de opname van Sb de kristalkwaliteit van InAs-nanodraden [42, 43] effectief verbetert, waardoor het potentieel van de kristalfase-engineering van InAs-nanodraden zonder vreemde katalysatoren aanzienlijk wordt vergroot.
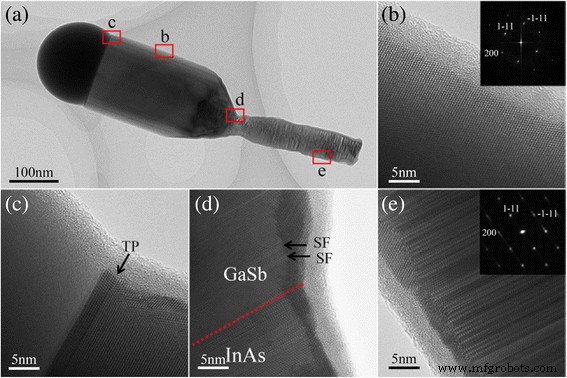
een Een TEM-beeld met een lage vergroting van een typische InAs/GaSb heterostructuur nanodraad. b –e TEM-afbeeldingen (HRTEM) met hoge resolutie, genomen uit de regio's die zijn gemarkeerd met rode rechthoeken in (een ) respectievelijk. Alle HRTEM-beelden worden verkregen van de zone-as 〈110〉. De rode stippellijn in d geeft de interface aan tussen de InAs-stam en de bovenste GaSb-nanodraad. De inzet in b en e zijn de overeenkomstige snelle Fourier-transformatie (FFT) -patronen van respectievelijk de GaSb-nanodraad en de InAs-stam
Figuur 6a-f toont een TEM-beeld van een andere InAs/GaSb heterostructuur nanodraad en de bijbehorende EDS-analyses. Alle EDS-metingen gebruiken de Lα-emissiesignalen van In, As en Sb en het Kα-emissiesignaal van Ga. De EDS-lijn scant langs de axiale richting (Fig. 6b) en elementaire mapping van de nanodraadsamenstelling (Fig. 6c-f) laten zien dat de druppel voornamelijk Ga en een kleine hoeveelheid In bevat, terwijl bijna geen As of Sb wordt waargenomen, wat het zelfgekatalyseerde groeimechanisme van de GaSb-nanodraden direct bevestigt (atoompercentage van kwantitatieve EDS-puntanalyse in plek 1:Ga, 96,13%; In, 3,8%; As, 0; Sb, respectievelijk 0,07% EDS-spectra van puntanalyses op de twee plekken worden weergegeven in aanvullend bestand 1:figuur S5). Deze zwakke In-concentratie in de druppel wordt voornamelijk toegeschreven aan het oplossen van de In-atomen in de Ga-druppel tijdens de eerste overgangsfase van InAs naar GaSb. Bovendien begint, volgens de EDS-lijnscan in Fig. 6b, de groei van GaSb-nanodraden op de InAs-stelen en uit de EDS-puntanalyse van de elementaire samenstellingsverdeling in plek 2 (Ga, 48,86%; In, 0,91%; As, 0,70%; Sb, 49,53%), de stoichiometrische verhouding van Ga- en Sb-atomen in het gegroeide GaSb-segment is ongeveer 1:1. De relatief hoge signalen van Ga en Sb in de InAs-sectie zijn echter afkomstig van de radiale groei van de GaSb rond de InAs-stam, en de elementaire gradiënt voor de In-, As-, Ga- en Sb-signalen nabij het grensvlak kan voornamelijk worden veroorzaakt door de resterende In en As na de TMIn en AsH3 fluxen zijn uitgeschakeld.

een De illustratie van de axiale InAs/GaSb-heterostructuur-nanodraden en een TEM-beeld met lage vergroting van een volwassen InAs/GaSb-nanodraad gegroeid bij 520 °C. b EDS-lijnscan langs de rode lijn gemarkeerd in (a ). c –f EDS-compositiekaarten van de nanodraad in (a ), met de Ga-, Sb-, In- en As-verdeling. Twee plekken in een markeer de posities waar EDS-puntanalyses werden uitgevoerd
Om de optische eigenschappen van de gegroeide GaSb-nanodraden te analyseren, werden Raman-metingen uitgevoerd. Figuur 7 toont de Raman-spectra van een GaSb (100)-substraat en de GaSb-nanodraden die op de korte InAs-stelen zijn gegroeid. Er worden twee verstrooiingspieken waargenomen in het spectrum van de bulk GaSb bij ongeveer 226,5 en 235,2 cm −1 (rode lijn in Fig. 7) en worden toegeschreven aan respectievelijk de transversale optische (TO) en longitudinale optische (LO) fonon-modi van GaSb. Voor GaSb-nanodraden werden vergelijkbare twee pieken ook duidelijk waargenomen bij ongeveer 225,0 en 233,6 cm −1 in het Raman-spectrum (blauwe lijn in Fig. 7), wat wijst op een hoge fotonica-kwaliteit van de verkregen GaSb-nanodraden. In Raman-terugverstrooiingsmetingen is de TO-fononmodus verboden in de (100) richting, een kleine TO-fononmoduspiek voor het bulk GaSb (100)-substraat kan worden toegeschreven aan een lichte verkeerde oriëntatie of imperfectie van het substraat [44]. Voor de GaSb-nanodraden kunnen echter, omdat de nanodraden in verticale (111) richting en met zes {110} zijwanden worden gegroeid, zowel de TO- als LO-fononmodi duidelijk worden waargenomen in het Raman-spectrum. Bovendien vertonen de TO- en LO-fononmodi van GaSb-nanodraden, in vergelijking met bulk-GaSb, een zwakke terugschakeling. In Raman-verstrooiingsmetingen kunnen zowel de kwantumopsluiting als defecten de frequentie-downshift van fononpieken induceren [45]. Terwijl we, vanwege de grote diameter van de gegroeide GaSb-nanodraden die bijna geen kwantumopsluitingseffect vertonen, speculeren dat deze zwakke verschuiving van de fononfrequentie geassocieerd kan zijn met oppervlaktedefecten van de GaSb-nanodraden. Met de tweestaps stroomsnelheden van de TMGa en TMSb hebben we de verticale groei van pure ZB GaSb-nanodraden op InAs-stelen gerealiseerd door MOCVD zonder vreemde katalysatoren. We verwachten dat door verdere optimalisatie van de groeiparameters, zoals de groeitemperatuur en verschillende combinaties van de TMGa- en TMSb-stroomsnelheden in het tweestapsgroeiproces, GaSb-nanodraden met een hogere aspectverhouding kunnen worden bereikt.

Raman-spectra van een GaSb (100)-substraat (rode lijn ) en de GaSb-nanodraden (blauwe lijn ). De groene lijnen zijn resultaten van Lorentziaanse fit met meerdere pieken
Conclusies
Samenvattend hebben we de zelfgekatalyseerde groei van GaSb-nanodraden op InAs-stelen door MOCVD aangetoond. Om de groei van de verticale InAs/GaSb heterostructuur nanodraden te realiseren, gebruiken we eerst relatief lage TMGa- en TMSb-stroomsnelheden om de Ga-druppeltjes op de InAs-stelen te behouden. Vervolgens worden de stroomsnelheden van TMGa en TMSb verhoogd om de axiale groeisnelheid te verbeteren. Vanwege de langzamere radiale groeisnelheid van GaSb bij hogere groeitemperatuur, hebben GaSb-nanodraden gekweekt bij 500 ° C een grotere diameter dan die gekweekt bij 520 ° C. Voor de axiale groei, vanwege het Gibbs-Thomson-effect en de vermindering van de oververzadiging van de druppeltjes met de toenemende groeitemperatuur, zijn de GaSb-nanodraden die bij 500 ° C zijn gekweekt echter langer dan die bij 520 ° C. Gedetailleerde TEM-metingen laten zien dat de kristalstructuur van de InAs-stengels een mengsel is van WZ- en ZB-structuren, terwijl de bovenste GaSb-nanodraden een perfecte ZB-kristalfase hebben en Raman-analyses wijzen op een hoge optische kwaliteit van de verkregen GaSb-nanodraden. De hier gepresenteerde groeimethode kan geschikt zijn voor de groei van andere op antimonide gebaseerde nanodraden. Bovendien kunnen de as-grown GaSb-nanodraden op InAs-stengels nieuwe mogelijkheden introduceren voor toepassingen in op nanodraad gebaseerde apparaten en voor de studie van kwantumfysica.
Afkortingen
- CMOS:
-
Complementaire metaaloxide-halfgeleider
- EDS:
-
Energiedispersieve spectroscopie
- FFT:
-
Snelle Fourier-transformatie
- LO:
-
Longitudinaal optisch
- MBE:
-
Moleculaire bundelepitaxie
- MOCVD:
-
Metaal-organische chemische dampafzetting
- SEM:
-
Scanning elektronenmicroscopie
- SF:
-
Stapelfout
- TEM:
-
Transmissie-elektronenmicroscopie
- TMGa:
-
Trimethylgallium
- TMSb:
-
Trimethylantimoon
- NAAR:
-
Transversaal optisch
- TP:
-
Tweelingvliegtuig
- VLS:
-
Damp-vloeistof-vast
- ZB:
-
Zinkmengsel
Nanomaterialen
- Wat is chemische dampafzetting?
- Materiaalwetenschappers leren nanodraden te 'dansen'
- Geavanceerde atoomlaagdepositietechnologieën voor micro-LED's en VCSEL's
- Ontrafeling van de morfologische evolutie en etskinetiek van poreuze silicium nanodraden tijdens metaalondersteunde chemische etsing
- De antibacteriële polyamide 6-ZnO hiërarchische nanovezels vervaardigd door afzetting van atoomlagen en hydrothermische groei
- Groot-gebied WS2-film met grote afzonderlijke domeinen gekweekt door chemische dampafzetting
- Groei beheersen Hoge uniformiteit Indiumselenide (In2Se3) nanodraden via het snelle thermische gloeiproces bij lage temperatuur
- Uniaxiale magnetisatieprestaties van getextureerde Fe-nanodraadarrays die door middel van een gepulseerde potentiaalafzettingstechniek zijn elektrolytisch afgezet
- Elektrische eigenschappen van midwave en longwave InAs/GaSb-superroosters gekweekt op GaAs-substraten door middel van moleculaire bundelepitaxie
- Zelfgezaaide MOCVD-groei en dramatisch verbeterde fotoluminescentie van InGaAs/InP Core-Shell-nanodraden
- Vormingsmechanismen van InGaAs-nanodraden geproduceerd door een vaste-bron tweestaps chemische dampafzetting



