Ontrafeling van de morfologische evolutie en etskinetiek van poreuze silicium nanodraden tijdens metaalondersteunde chemische etsing
Abstract
Veel potentiële toepassingen van poreuze silicium nanodraden (SiNW's) vervaardigd met metaal-geassisteerde chemische etsen zijn in hoge mate afhankelijk van de nauwkeurige controle van de morfologie voor apparaatoptimalisatie. De effecten van belangrijke etsparameters, zoals de hoeveelheid afgezette metaalkatalysator, HF–oxidant molverhouding (χ ) en oplosmiddelconcentratie, op de morfologie en etskinetiek van de SiNW's zijn nog steeds niet volledig onderzocht. Hier zijn de veranderingen in de nanostructuur en etssnelheid van gedegenereerd gedoteerd p-type silicium in een HF–H2 O2 –H2 O-etssystemen met stroomloos afgezette zilverkatalysator worden systematisch onderzocht. De oppervlaktemorfologie blijkt te evolueren van een microporeuze en kraterachtige structuur naar een uniforme reeks SiNW's bij voldoende hoge χ waarden. De etssnelheden aan de basis en punt van de nanostructuur zijn gecorreleerd met het primaire etsen dat wordt geïnduceerd door Ag en het secundaire etsen dat wordt geïnduceerd door respectievelijk metaalionen en diffuse gaten. De H2 O-concentratie heeft ook invloed op de χ venster waar SiNW's zich vormen en de etssnelheden, voornamelijk door de reactantverdunning en diffusiesnelheid te moduleren. Door de secundaire etsing en reactantdiffusie te regelen via χ en H2 O-concentratie, respectievelijk de fabricage van sterk gedoteerde SiNW's met onafhankelijke controle van de porositeit van de lengte is met succes aangetoond, wat mogelijk kan worden gebruikt om de prestaties van op SiNW gebaseerde apparaten te verbeteren.
Achtergrond
Ondanks onderzoeksdoorbraken op verschillende nieuwe materialen, blijft silicium een van de meest aantrekkelijke substraten voor het vervaardigen van nanostructuren vanwege de overvloed in de natuur en het bestaan van goed ontwikkelde technieken voor apparaatintegratie. De afgelopen jaren hebben eendimensionale siliciumnanostructuren, zoals siliciumnanodraden (SiNW's) en nanopilaren, de aandacht blijven trekken in een breed scala aan toepassingen, zoals fotovoltaïsche energie [1, 2], thermo-elektrische technologie [3, 4], energieopslag [5,6,7], flexibele elektronica [8], biochemische detectie [9] en biologische interfacing [10]. Afgezien van de unieke elektrische, optische, thermische en mechanische eigenschappen van dergelijke nanostructuren, is een belangrijke drijfveer voor hun aanhoudende aantrekkingskracht de ontwikkeling van nieuwe fabricagetechnieken die een gemakkelijke vorming van de nanostructuren mogelijk maken met behoud van uitstekende controle over morfologie en fysieke eigenschappen. Van de verschillende fabricagetechnieken onderscheidt metaal-geassisteerd chemisch etsen (MACE) zich vanuit industrieel oogpunt vanwege zijn eenvoud, lage kosten en flexibiliteit [11, 12]. Met behulp van MACE kunnen defectvrije SiNW's op wafelschaal met gedefinieerde lengte, porositeit, geleidbaarheid, doteringsniveau en kristaloriëntatie worden verkregen door eenvoudigweg de juiste Si-wafel, etsmiddelsamenstelling, reactietemperatuur en reactietijd te selecteren [13,14, 15,16,17,18,19,20,21,22,23]. Controle van SiNW-diameter, dwarsdoorsnede en array-pitch kan ook worden bereikt door middel van katalysatorpatroontechnieken, zoals nanosfeerlithografie [24], interferentielithografie [25] en blokcopolymeerlithografie [26]. Dit in tegenstelling tot andere fabricagetechnieken, zoals reactief ionen-etsen en damp-vloeistof-vaste stof-methoden, die dure apparatuur vereisen en nanodraden kunnen produceren met oppervlaktedefecten, ongecontroleerde kristallografische oriëntaties en beperkte dwarsdoorsnedevormen [11].
In het afgelopen decennium was de fabricage van SiNW's van sterk gedoteerde Si-wafels met behulp van MACE van bijzonder belang vanwege de resulterende poreuze SiNW's met een hoge kristallijne kwaliteit [14, 17, 19]. Door de poreuze structuur kunnen de nanodraden zeer gewenste eigenschappen verwerven, zoals afstembare fotoluminescentie [15], lage thermische geleidbaarheid [27] en een hoog specifiek oppervlak [28], waardoor ze veelbelovende materialen zijn voor opto-elektronica [14, 16], thermo-elektriciteit [ 3, 27], fotokatalyse [28, 29] en energieopslag [5]. In combinatie met hun fotoluminescentie en hoge oppervlakte, maken de biocompatibiliteit en biologische afbreekbaarheid van poreuze SiNW's in fysiologische omgevingen ze ook geschikte kandidaten voor biolabeling [15] en toepassingen voor medicijnafgifte [30]. Hoewel relatief poreuze SiNW's kunnen worden verkregen met laag gedoteerde Si-wafels door gebruik te maken van hoge concentraties aan oxidatiemiddel in het etsmiddel [15], is het gebruik van hoog gedoteerd Si voordelig wanneer een hoge elektrische geleidbaarheid nodig is, aangezien het de noodzaak van dotering na het etsen overbodig maakt. stap. Dit is met name het geval bij thermo-elektrische toepassingen van poreuze SiNW's, waar de toename van de verdienste te wijten is aan de afname van de thermische geleidbaarheid zonder significante verslechtering van de elektrische geleidbaarheid [27]. Aan de andere kant is gemeld dat de weerstand van poreuze SiNW's vrij groot is in vergelijking met die van vaste SiNW's [14], wat een afweging impliceert tussen de mate van porositeit en elektrische geleidbaarheid.
Om het potentieel van poreuze SiNW's in de bovengenoemde toepassingen te realiseren, is het absoluut noodzakelijk om de effecten van verschillende etsparameters tijdens MACE van sterk gedoteerd Si volledig te begrijpen. Een aantal studies [13,14,15,16,17, 19,20,21, 23] hebben met succes sterk gedoteerde SiNW's gefabriceerd met verschillende lengtes en porositeiten met behulp van MACE in HF–H2 O2 etsmiddel. Hun onderzoeken hebben licht geworpen op het effect van H2 O2 concentratie [14,15,16,17, 20, 21, 23], HF-concentratie [21], HF–H2 O2 volumeverhouding [19], etsduur [14, 16, 17, 19,20,21, 23] en etstemperatuur [19,20,21, 23] op de porositeit [14, 16, 17, 19, 20] , lengte [16, 17, 19,20,21, 23], etssnelheid [15] en algemene morfologie [15, 16, 21] van de SiNW-arrays. Niettemin, systematische studies naar het effect van etsmiddel HF–H2 O2 molaire verhouding, gedefinieerd als χ = [HF]/([HF] + [H2 O2 ]), en H2 O-concentratie op de vorming van sterk gedoteerde Si-nanostructuren is beperkt. Dit ondanks het feit dat χ is een belangrijke parameter bij het bepalen van de morfologie en etssnelheid van Si-nanostructuren [18, 31], terwijl [H2 O] is cruciaal bij de vorming van SiNW's in gebieden met micropatronen [18]. Tot op heden hebben alleen Chiappini et al. [15] en Balasundaram et al. [19] hebben een breed scala aan χ . gebruikt waarden (respectievelijk 0,4-0,98 en 0,7-0,99) bij de fabricage van sterk gedoteerde SiNW's, terwijl geen enkele het effect van etsmiddel [H2 volledig heeft onderzocht. O]. Bovendien, ondanks een aantal studies die het mechanisme voor de morfologische evolutie, porosificatie en tapsheid van zowel licht als sterk gedoteerde SiNW's, vervaardigd met MACE [15, 17, 32], ophelderen, is het mechanisme van lengte-evolutie als gevolg van de concurrerende effecten van gedeponeerd metaal etsen, etsen van opnieuw genucleëerde metalen, gatdiffusie en reactantdiffusie is niet volledig onderzocht. In deze studie, tweestaps MACE [33] op gedegenereerd gedoteerde p-type Si-wafels met behulp van stroomloos afgezette Ag-katalysator en H2 O2 oxidant werd uitgevoerd. Vergeleken met MACE die een Au-katalysator met patroon gebruikt, kan stroomloze afzetting alleen willekeurig verdeelde SiNW's met verschillende diameters vormen [13], terwijl Ag de haalbare SiNW-aspectverhoudingen kan beperken vanwege de snellere oplossing ervan dan Au [11]. Niettemin wordt het gebruik van stroomloze depositie en Ag-katalysator in MACE beschouwd als de eenvoudigste en goedkoopste manier om Si-nanostructuren te vormen, inclusief SiNW's. Om de effecten van etsmiddelsamenstelling op de resulterende nanostructuren en etssnelheden te onderzoeken, zijn etsmiddelen met een relatief groot bereik van χ en [H2 O]-waarden werden gebruikt. Door de etskinetiek aan de punt en basis van de Si-nanostructuren te bepalen, inzicht in de effecten van gatinjectie en Si-oplossingssnelheden, secundair etsen veroorzaakt door opgeloste metaalionen en diffuse gaten, en diffusiesnelheid van reactanten op de resulterende morfologie en lengte van de nanostructuren is voorzien. Sterk gedoteerde SiNW's van dezelfde lengte werden ook vervaardigd met behulp van etsmiddelen die waren samengesteld uit verschillende χ en [H2 O]-waarden, waarmee wordt aangetoond dat porositeit effectief kan worden afgesteld door middel van etsmiddelsamenstelling, ondanks variërende etsduur.
Methoden
Enkelzijdig gepolijste met boor gedoteerde p-type Si (100) wafels met een soortelijke weerstand van 0,001-0,005 Ω cm en een thermische oxidelaag van 50 nm aan de gepolijste zijde werden als uitgangsmateriaal gebruikt. De wafels werden grondig gereinigd met gedeïoniseerd (DI) water, aceton en ethanol, en het thermische oxide werd verwijderd met verdund HF, wat resulteerde in H-getermineerde Si-oppervlakken. Om het etsen op het gepolijste Si-oppervlak te beperken, werd de achterkant van de Si-wafels gecoat met fotoresist (AZ5214). Si-monsters voor de MACE-experimenten werden verkregen door de wafels te splitsen in 1 × 1 cm 2 stukken. Voor elke reeks experimenten werden Si-monsters van dezelfde wafel gebruikt.
MACE werd uitgevoerd met behulp van een tweestaps etsproces bestaande uit stroomloze afzetting van Ag-katalysator en vervolgens etsen in HF–H2 O2 oplossingen, zoals schematisch weergegeven in Fig. 1. De Si-stukken werden eerst 3 minuten ondergedompeld in 5% HF. Vervolgens werd stroomloze afzetting van Ag-nanodeeltjes (AgNP's) op het Si-substraat uitgevoerd in een waterige oplossing met 4,8 M HF en 0,005 M AgNO3 voor verschillende tijdsduren (Fig. 1a). Na mild spoelen met DI-water werden de AgNP-gecoate Si-monsters geëtst in waterig HF–H2 O2 oplossingen met verschillende χ en [H2 O]-waarden (zie Aanvullend bestand 1:Tabel S1) voor verschillende tijdsduren (Fig. 1b). De geëtste Si-monsters werden grondig gespoeld met DI-water en vervolgens ondergedompeld in 1:1 (v /v ) HNO3 gedurende 10 minuten om de AgNP's op te lossen. Na nog een grondige spoeling met DI-water werden de Si-monsters gedurende 3 minuten in 5% HF geweekt om eventuele gevormde oxidelaag te verwijderen en vervolgens meerdere keren gespoeld met DI-water. Ag-afzetting en HF–H2 O2 etsen werden uitgevoerd in het donker. Alle monsters zijn bij kamertemperatuur (22-23 °C) verwerkt in aparte plastic bekers met 15 ml van de vereiste oplossing.

Schematische dwarsdoorsnede van de fabricage van Si-nanostructuren met behulp van tweestaps MACE. een In de eerste stap worden AgNP's stroomloos op het Si-oppervlak afgezet in een waterige oplossing die AgNO3 bevat. en HF. b In de tweede stap katalyseren de AgNP's het etsen van het Si-substraat in een oplossing bestaande uit HF, H2 O2 , en H2 O, wat leidt tot de vorming van Si-nanostructuren
De geëtste Si-oppervlakken werden gekarakteriseerd met scanning-elektronenmicroscopie (SEM, Phenom Pro of FEI/Philips XL-30) en transmissie-elektronenmicroscopie (TEM, Philips CM20). Om de monsters voor te bereiden op SEM-waarneming, werd de fotoresist aan de achterkant verwijderd met aceton. De Si-monsters werden vervolgens gespoeld met ethanol en gedroogd op een kookplaat om SiNW-agglomeratie als gevolg van waterverdamping te minimaliseren [19].
Resultaten en discussie
Zilveren katalysatorafzetting en vorming van poreuze SiNW's
Het effect van Ag-afzettingsduur (10 s tot 15 min) in een oplossing van 0,005 M AgNO3 en 4,8 M HF op de vorming van sterk gedoteerde SiNW's werd onderzocht. Toen de met Ag geladen monsters werden geëtst in een oplossing met 4,8 M H2 O en χ = 0,95 gedurende 30 min, korte afzettingstijden (≤2 min) resulteerden in een dichte reeks verticale poriën met enkele laterale putjes, zoals weergegeven in figuur 2a. De poriën waren echter niet dicht genoeg om goed gescheiden nanodraadstructuren te vormen als de depositietijd ≤1 min is. Aan de andere kant werden SiNW's die bijna geen defecten hadden verkregen met een Ag-afzettingstijd van 4 min (figuur 2b), met hogere depositietijden resulterend in pitvrije SiNW's. Afgezien van veranderingen in de SiNW-morfologie, werd ook een niet-monotone variatie in SiNW-etssnelheid met betrekking tot Ag-afzettingstijd waargenomen, zoals weergegeven in figuur 2c (ruitsymbolen). De SiNW-etssnelheid nam toe van een afzettingstijd van 10 s tot 4 min, maar nam onverwacht af tussen 4 min en 6 min. Daarna nam de etssnelheid weer toe tot 15 min, zij het met relatief lagere etssnelheidswaarden.
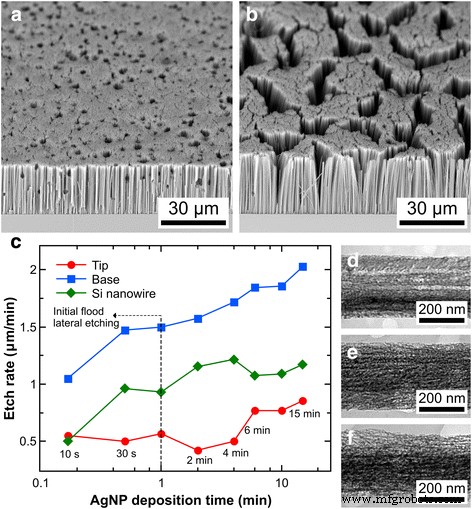
Gefabriceerde SiNW's met behulp van een Ag-depositieoplossing met 0,005 M AgNO3 en 4,8 M HF en een etsoplossing bestaande uit 48 M H2 O en 0,95 HF–H2 O2 molaire verhouding. SEM-beelden van de SiNW's voor Ag-depositietijden van a 30 s en b 4 min. c Etssnelheid van de SiNW's voor verschillende Ag-afzettingstijden. TEM-afbeeldingen van het middelste gedeelte van de SiNW's voor Ag-depositietijden van d 4, e 10, en f 15 toont de mate van porositeit. Etsduur voor alle monsters was 30 min
Om rekening te houden met de eigenaardige trend in de SiNW-etssnelheid, werden de etssnelheden aan de punt en basis van de SiNW's ook bepaald uit de transversale SEM-afbeeldingen door de microfoto van een geëtst Si-monster uit te lijnen met die van een niet-geëtste Si monster van dezelfde wafer aan de achterzijde (zie aanvullend bestand 1:figuur S1). Uit figuur 2c blijkt dat de etssnelheid op de SiNW-basis (vierkante symbolen) monotoon toeneemt met de AgNP-afzettingstijd. Aan de andere kant kunnen drie domeinen worden gezien uit de trendlijn van de SiNW-puntetssnelheid (cirkelsymbolen):(a) ≤1 min, waarbij de etssnelheid relatief hoog is; (b) tussen 1 en 6 min, waarbij de etssnelheid relatief laag is; en (c) ≥6 min, waarbij de etssnelheid het hoogst is. De initiële toename van de SiNW-etssnelheid van de afzettingstijd van 10 s tot 1 minuut was dus het gevolg van de constante toename van de etssnelheid aan de basis, terwijl de daaropvolgende toename van de etssnelheid bij afzettingstijden van 2 en 4 minuten te wijten was aan de relatief lage etssnelheden aan de tips. Ondertussen werden de daling van de SiNW-etssnelheid bij de afzettingstijd van 6 min en de relatief lage etssnelheden in de daaropvolgende afzettingstijden veroorzaakt door de toename van de etssnelheid aan de uiteinden.
Aangezien de oppervlaktedekking van AgNP's direct gerelateerd is aan de Ag-depositietijd [22, 34, 35], kan de laterale pitting voor lage depositietijden worden toegeschreven aan een dun Ag-netwerk [18, 34, 36] met enkele geïsoleerde AgNP's die naar binnen bewegen. willekeurige <100> richtingen vanwege hun onregelmatige vorm [37]. De SiNW-etssnelheid aan de basis zal naar verwachting toenemen met de Ag-afzettingstijd als gevolg van de toename van de hoeveelheid Ag-katalysator, die door H2 meer oppervlakte biedt voor gatinjectie O2 . Bovendien betekent een grotere hoeveelheid Ag ook meer geoxideerd Ag door H2 O2 [15, 17], wat resulteert in een hogere concentratie Ag + ionen die kunnen bijdragen aan het oplossen van Si via een galvanische verplaatsingsreactie [31]. Aan de andere kant kunnen de relatief hoge etssnelheden aan de uiteinden voor Ag-afzettingstijden ≤ 1 min worden verklaard door een aanvankelijke laterale overstroming, veroorzaakt door onregelmatig gevormde AgNP's uit het schaarse Ag-netwerk. De daaropvolgende toename van de etssnelheid van de tip met toenemende Ag-afzettingstijd kan worden toegeschreven aan toenemende snelheden van hernucleatie van metaal [17, 38] aan de tips en, in mindere mate, gatdiffusie [31, 39].
Er was een algehele toename van de porositeit van de gefabriceerde SiNW's naarmate de Ag-afzettingstijd toenam, zoals weergegeven in Fig. 2d-f. (Zie aanvullend bestand 1:figuur S2a–c voor aanvullende TEM-afbeeldingen.) Dergelijke toenames in porosificatie worden verwacht vanwege hogere concentraties Ag + ionen, wat resulteert in opnieuw genucleëerd metaal en ion-geïnduceerd etsen [15, 17, 38]. Bovendien zouden hogere snelheden van gateninjectie ook kunnen hebben geleid tot meer diffuse gaten, wat kan bijdragen aan porievorming [19, 39]. De poreuze structuur van de SiNW's lijkt voor te komen als een poreuze schil in de meeste nanodraden, vergelijkbaar met wat werd waargenomen in eerdere studies [14, 17]. Voor sommige SiNW's met een Ag-afzettingstijd van 15 minuten lijken de zijwanden aanzienlijk ruwer met relatief grote (≈20 nm diameter) donkere vlekken, waarschijnlijk als gevolg van grotere opnieuw genucleëerde Ag-deeltjes. De porositeitsverdeling is echter niet duidelijk:sommige SiNW's met een Ag-afzettingstijd van 4 min hebben bijna dezelfde porositeit als die van SiNW's met een Ag-depositietijd van 10 min; hetzelfde kan gezegd worden van SiNW's met Ag-afzettingstijden van 10 en 15 minuten. Dit was waarschijnlijk te wijten aan SiNW's verkregen uit verschillende delen van het monster, die enigszins verschillende porosificatiesnelheden ervoeren, afhankelijk van de werkelijke hoeveelheid afgezette (of opnieuw genucleëerde) AgNP's en de concentratie van niet-gereageerd etsmiddel, die naar verwachting hoger zal zijn naar de zijkanten toe. van het monster. Desalniettemin geeft de algemene trend die hier wordt waargenomen aan dat de totale hoeveelheid afgezet Ag een andere mate van vrijheid biedt bij het beheersen van de porositeit van SiNW's.
De mate van porositeit neemt toe van de basis tot de punt van de SiNW's (zie aanvullend bestand 1:figuur S2d–l), vergelijkbaar met die in eerdere studies [16, 19]. Dit wordt verwacht door de langere blootstelling van de bovenste regionen van de nanodraden aan het etsmiddel [19]. Aan de andere kant hebben de meeste SiNW's een taps toelopend longitudinaal profiel, wat kenmerkend is voor sterk gedoteerde SiNW's die zijn gefabriceerd met Ag-MACE vanwege de continue oplossing van de AgNP's aan de SiNW-basis en hernucleatie op andere locaties [15, 17 ]. Niettemin waren er enkele SiNW's met een enigszins biconisch of zandloperprofiel, d.w.z. de middelste doorsnede is respectievelijk groter of kleiner dan zowel de bovenste als de onderste doorsnede. Dit suggereert dat de mobiele Ag + ionen kunnen zich niet alleen opnieuw afzetten op de bovenste delen van nanodraden, maar ook op naburige AgNP's aan de basis.
Etchanische samenstelling en morfologische evolutie van Si-nanostructuren
De morfologie van de resulterende nanostructuren in gedegenereerd gedoteerd Si werd bepaald met behulp van χ waarden van 0,7 tot 0,99 en H2 O-concentraties van 46, 48 en 50 M. Stroomloze afzetting van AgNP's werd uitgevoerd in een oplossing van 0,005 AgNO3 en 4,8 M HF gedurende 4 min, tijdens het etsen in HF–H2 O2 –H2 O-oplossingen werden gedurende 30 minuten uitgevoerd. Figuur 3 toont de morfologie van het Si-oppervlak zoals gezien vanaf de SEM. Voor [H2 O] = 46 M en 48 M, de kenmerken op het geëtste Si komen voort uit microporeus Si met kraters (χ = 0,7 en 0,75, Fig. 3d, e), tot macroporiën met diepe poriën (χ = 0,75 en 0,80, Fig. 3f), en vervolgens naar SiNW's (χ ≥ 0,85). Voor [H2 O] = 50 M, de evolutie van het Si-oppervlak is iets anders:van gepolijst Si (χ = 0,7), naar macroporiën met diepe poriën (χ = 0,75), tot microporeus Si met kraters (χ = 0,8–0,85), en vervolgens naar SiNW's (χ ≥ 0.9). In tegenstelling tot het werk van Chiappini et al. [15], SiNW's bovenop een poreuze Si-film voor 0,7 < χ < 0.95 werden niet waargenomen, en SiNW-only structuren werden verkregen in een grotere χ bereik (χ ≥ 0,85 in plaats van χ> 0.95). Deze verschillen waren hoogstwaarschijnlijk te wijten aan de variaties in de hoeveelheid gedeponeerde AgNP's, etstijd, H2 O-concentraties en HNO3 en HF-na-etsbehandelingen.

SEM-afbeeldingen van het Si-oppervlak geëtst in oplossingen met H2 O concentraties van a 46 M, b 48 M, en c 50 M en HF–H2 O2 molaire verhoudingen van (i) 0,7, (ii) 0,75, (iii) 0,8, (iv) 0,85, (v) 0,9, (vi) 0,95, en (vii) 0,99. d –g SEM-afbeeldingen met hoge vergroting van de monsters in a (i) , (ii ), (iii ), en (vii ), respectievelijk. Monsters werden geëtst in HF–H2 O2 gedurende 30 min
De verkregen Si-morfologieën kunnen worden verklaard in termen van zowel stroomdichtheid aan het Ag-Si-grensvlak als Ag + ion-geïnduceerd etsen [15, 17, 31, 38]. De vorming van SiNW's bij hoge χ waarden (-0,85 of 0,9) kunnen worden toegeschreven aan microporeuze Si-vorming bij lage stroomdichtheden met daaropvolgend oplossen van het microporeuze Si door polijsten [31, 38]. Een soortgelijk mechanisme was hoogstwaarschijnlijk verantwoordelijk voor de vorming van macroporeus Si met diepe poriën bij lagere χ waarden, behalve dat de hogere stroomdichtheden aan het porie-uiteinde resulteerden in oxidevorming en daaropvolgende gatdiffusie [31], resulterend in de ondiepe macroporiën aan het bovenoppervlak. Een dergelijke diffusie van gaten zal naar verwachting bijzonder belangrijk zijn voor sterk gedoteerd p-type Si vanwege de positieve Schottky-barrièrehoogte die geïnjecteerde gaten wegtrekt van het metaal-Si-grensvlak [40]. Het is ook mogelijk dat de relatief hoge [H2 O2 ] tot [HF] verhouding leidde tot significante Ag-oplossing, wat op zijn beurt resulteerde in de lage dichtheid van diepe poriën in het Si-substraat. Aan de andere kant, het verschijnen van microporeus Si met kraters op χ = 0,7–0,85 geeft het voorkomen van lage stroomdichtheden aan in deze χ bereik, wat consistent is met de waarneming van Chartier et al. [31] Bovendien gelijktijdige porosificatie van Si door Ag + ionen zullen naar verwachting ook in dit regime voorkomen. De vorming van SiNW's bij een hogere χ waarde voor het meest verdunde etsmiddel (50 M H2 O) komt overeen met de waarneming van Chiappini et al. [15] dat hogere ethanolconcentraties de vorming van poreus en gepolijst Si bevorderen in plaats van SiNW's. Deze resultaten kunnen te wijten zijn aan de langzame diffusie van reactanten naar de nanostructuurbasis als gevolg van de lage HF en H2 O2 concentratiegradiënten langs de Si-nanostructuurdiepte. In dit geval wordt de impact van het etsen aan de uiteinden relatief aanzienlijk en kunnen er geen diepe poriën worden gevormd door de metaaldeeltjes.
Opgemerkt moet worden dat voor relatief lage waarden van χ (≤0,8), de morfologie over het hele Si-oppervlak was niet uniform (zie aanvullend bestand 1:figuur S3). Voor [H2 O] = 50 M, niet-uniform etsen kwam ook voor voor χ = 0,85. In alle gevallen werd alleen een uniform geëtst oppervlak verkregen wanneer SiNW's werden gevormd. Voor niet-uniform geëtste oppervlakken hebben secties met homologe morfologieën de neiging om op ongeveer dezelfde algemene locatie vanaf het midden van het monster voor te komen. De niet-uniforme etsdynamiek op verschillende delen van het monster kan worden verklaard door de toename van de concentratie van opgeloste katalysatorionen in de oplossing en hun daaropvolgende diffusie naar en herkiemvorming op andere delen van het monster. Dit werd tot op zekere hoogte vergemakkelijkt door de gelijktijdige uitwendige diffusie van H2 bubbels terwijl de Si werd geëtst.
Met een zeer hoge χ waarde (0,99), werd een zeer dichte reeks fijne SiNW's verkregen, wat leidde tot een zwart monsteroppervlak (zie aanvullend bestand 1:figuur S3a-c (vii)). Veel van deze SiNW's hadden echter schuine zijwanden en enkele laterale putjes, die beide voorkomen in de buurt van de basis (figuur 3g) en bij lange etstijden (aanvullend bestand 1:figuur S4d). Ook zijn een aantal hobbels te zien waar de vorming van nanodraad voortijdig is beëindigd. Dergelijke kenmerken werden waarschijnlijk veroorzaakt door de uitputting van H2 O2 in de etsoplossing die leidde tot verschillende snelheden van zinken van verschillende delen van de AgNP-film. Toen het Ag-netwerk uiteenviel, begonnen sommige AgNP- of kleine Ag-filmsecties in horizontale <100> richtingen te etsen.
Kinetiek van Si-nanostructuren etsen tijdens MACE
De variatie van de etssnelheid met χ voor verschillende [H2 O]-waarden worden getoond in Fig. 4. De schijnbare etssnelheid van de nanostructuren neemt over het algemeen toe met χ en piekt bij χ = 0.95, waarna de etssnelheden aanzienlijk dalen. Deze trend is waar, ongeacht de [H2 O] en de morfologie van de Si-nanostructuur. Echter, [H2 O] blijkt de grootte van de etssnelheden aanzienlijk te hebben beïnvloed, waarbij de grootte toenam voor afnemende [H2 O]-waarden (d.w.z. meer geconcentreerde etsmiddelen). Afbeelding 4b laat zien dat de etssnelheid aan de punt sterk afnam na χ = 0,85 voor [H2 O] = 46 en 48 M en na χ = 0,9 voor [H2 O] = 50 M. Aan de andere kant laat figuur 4c zien dat de etssnelheid aan de basis aanzienlijk toenam bij χ = 0,85 en 0,9 voor de 46 M H2 O etsmiddel, maar slechts in geringe mate voor de 48 en 50 M H2 O etsmiddelen. De etssnelheid aan de basis bleef hoog bij χ = 0,95 maar nam significant af bij χ = 0,99.

Schijnbare etssnelheden waargenomen na 30 min etsen in oplossingen die zijn samengesteld uit verschillende HF–H2 O2 molaire verhoudingen en H2 O concentraties. een Etchsnelheid van de Si-nanostructuren op basis van de resulterende lengte. b , c Etchsnelheid van het bulk Si ten opzichte van respectievelijk de punt en basis van de Si-nanostructuren
Uit de trends in etssnelheden aan de punt en basis van de Si-nanostructuren kan worden bepaald dat de toename in SiNW-lengte voor [H2 O] = 46 M was voornamelijk te wijten aan de versnelling van het etsen aan de basis, terwijl de verlenging van de SiNW's voor [H2 O] = 48 en 50 M werden voornamelijk bepaald door de onderdrukking van het etsen aan de uiteinden. Bovendien is de trend van de totale etssnelheid van de nanostructuur niet precies hetzelfde als de trend van de etssnelheid aan de basis. In het bijzonder de χ waarde waarbij de piek etssnelheid aan de basis optreedt en de χ waarden waarbij de grootste nanostructuurhoogte wordt bereikt, zijn niet dezelfde (respectievelijk 0,9 versus 0,95) vanwege het concurrerende effect van de etssnelheid van de tip.
De χ waarde waar de piek SiNW-lengte optrad (0,95) ligt dicht bij die verkregen door Qi et al. [21] (χ =0,91) voor een sterk gedoteerd n-type Si-substraat. De aanvankelijke afname van de etssnelheid van de tip die optreedt in de buurt van χ = 0,85 is consistent met de waargenomen morfologische evolutie van het Si-oppervlak, waarbij diffusie van kleine gaten en Ag-hernucleatie de vorming van SiNW's bij χ mogelijk maakten € 0,85. De bijna gelijktijdige daling van de etssnelheid van de tip en de sprong in de basisetssnelheid rond χ = 0,85 betekent dat gaten en Ag + ionen die voorheen van het etsfront diffundeerden bij lagere χ waarden werden nu beperkt aan de basis vanwege de remming van oxidevorming aan het Ag-Si-interface. Tegelijkertijd nam de verhoogde [HF] bij hogere χ waarden versnelde Si-oplossing, wat leidde tot een toename van de Ag-penetratiesnelheid. Aangezien zowel [HF] als [H2 O2 ] afnemen wanneer [H2 O] neemt toe voor een gegeven χ waarde (zie Aanvullend bestand 1:Tabel S1), de afname in etssnelheid bij de tips en basis voor hogere [H2 O]-waarden worden verwacht. De kleinere verhogingen van de basisetssnelheid tussen χ = 0,85 en 0,95 voor [H2 O] = 48 en 50 M zijn te wijten aan de langzamere diffusie van reactanten door de SiNW-lengte voor meer verdunde etsmiddelen.
Bij χ = 0,9, de etssnelheid aan de basis is maximaal vanwege de optimale snelheden van gateninjectie door H2 O2 en Si-oplossing door HF. Beneden deze waarde is [HF] de snelheidsbepalende factor omdat het oplossen van geoxideerd Si niet snel genoeg gaat; boven deze waarde, [H2 O2 ] bepaalt de reactiesnelheid omdat het aantal geïnjecteerde gaten te laag is. Deze uitputting van H2 O2 in de oplossing legt uit waarom de etssnelheid aan de basis begint af te nemen bij χ = 0,95 en daalt steil bij χ = 0,99. Een dergelijke afhankelijkheid van de etssnelheid van zowel [HF] als [H2 O2 ] werd eerder waargenomen [21] en impliceert dat beide reactantconcentraties moeten worden overwogen in elke uitdrukking voor de reactiesnelheid van MACE van Si. Aan de andere kant, een maximale waarde voor χ blijkt niet uit de etssnelheid van de punt. In plaats daarvan wordt de etssnelheid van de tip voornamelijk bepaald door [H2 O2 ]. Aangezien het etsen aan de punt van de Si-nanostructuren voornamelijk kan worden toegeschreven aan hernucleatie van metaalionen en gatdiffusie, is deze correlatie redelijk als hoger [H2 O2 ] waarden met betrekking tot [HF] leiden tot hogere concentraties van mobiel Ag + ionen [15, 17] en geïnjecteerde gaten [31, 32].
Evolutie van SiNW-lengte met tijd voor verschillende etscomposities
De lengte van SiNW's is een belangrijke parameter in fotovoltaïsche [2], energieopslag [6], detectie [41] en thermo-elektrische toepassingen [4]. Om SiNW's van een gespecificeerde lengte te fabriceren, werd de temporele variatie van de SiNW-lengte bepaald voor etsmiddelen met χ = 0,9, 0,92, 0,95 en 0,98 en [H2 O] = 46, 48 en 50 M. Voor deze experimenten werd de AgNP-afzettingstijd verhoogd tot 10 minuten om laterale pitting in de SiNW's die zijn vervaardigd met lange etstijden te minimaliseren (zie aanvullend bestand 1:figuur S4a-c). Evenzo, de hoogste χ gebruikte waarde was 0,98 omdat SiNW's met schuine zijwanden en laterale putjes werden verkregen voor χ = 0,99 zelfs met een AgNP-afzettingstijd van 10 min (zie aanvullend bestand 1:figuur S4d).
Figuur 5a laat zien dat de lengte van de gevormde SiNW's toeneemt met de MACE-reactietijd, in overeenstemming met waarnemingen in eerdere onderzoeken [14, 16,17,18,19, 21, 23]. Men kan echter zien dat de toename in SiNW-lengte in de loop van de tijd afneemt, dwz de etssnelheid neemt af (zie aanvullend bestand 1:figuur S5a), wat te wijten kan zijn aan toenemende etssnelheden aan de SiNW-tips of afnemende etssnelheden bij de basis of beide. Afbeelding 5d toont de toenemende etssnelheid van de tip in de loop van de tijd voor χ = 0,92 en 0,95, waarbij de stijging meer uitgesproken is in de eerste (zie Aanvullend bestand 1:Figuur S5b). Dit duidt op een toenemende hoeveelheid opnieuw genucleëerd Ag bij de SiNW-tips, wat naar verwachting significanter zal zijn voor lagere χ waarden. Aan de andere kant laat figuur 5e zien dat bij etstijden van meer dan 5 min de etssnelheid aan de SiNW-basis bijna constant was voor χ = 0.9 and 0.92 but decreasing for χ = 0.95 and 0.98 (see Additional file 1:Figure S5c). The latter was probably due to impeded diffusion of reactants to the SiNW base caused by the longer diffusion lengths (SiNW lengths were longer for χ = 0.95 and 0.98) and depletion of H2 O2 in the etching solution.

Evolution of SiNW length with time for different HF–H2 O2 molar ratios at 48 M H2 O. a Effect of etch time on SiNW length. b , c SEM images of SiNWs after etching for 1 h in a solution composed of 48 M H2 O and HF–H2 O2 molar ratios of 0.9 and 0.98, respectively. d , e Etched bulk Si thickness with respect to the tip and base of the SiNWs over time
It should be noted from Fig. 5 that at χ = 0.9, the evolution of length with time is erratic because of the non-monotonic trend of the etch rate at the tip (see Additional file 1:Figure S5b). This may be due to differing amounts of re-nucleated Ag as more mobile Ag + ions were generated. Nevertheless, lower χ values have the advantage of forming defect-free SiNWs (Fig. 5b) as higher χ may result in some lateral pits, as shown in Fig. 5c for χ = 0.98. The trend of the overall etch rates and etch rates at the tip and base of the SiNWs with respect to χ mirrors those observed in Fig. 4. However, it can be seen in Fig. 5e that χ = 0.92, which is not included in Fig. 4, actually results in a higher base etch rate than χ = 0.9.
The SiNW length also increases with etch duration for more concentrated (46 M H2 O) and dilute (50 M H2 O) etchants, as shown in Fig. 6a. Likewise, the etch rate decreases with etch time for all H2 O concentrations used (see Additional file 1:Figure S6a). Figure 5d, e show that, while the etch depth at the tip and base of the SiNWs both increase with time, the amount of increase at the tip is almost constant but that at the base is decreasing (see Additional file 1:Figure S6b, c). These trends are consistent with those observed for χ = 0.95 in Fig. 5 and Additional file 1:Figure S5. Hence, for χ = 0.95, the increase in the amount of re-nucleated Ag at the SiNW tips with time is negligible, while the increasing SiNW lengths progressively hampers reactant diffusion to the SiNW base. Figure 6 also shows that regardless of the etching time point, lower [H2 O] generally results in more etched Si, similar to what was observed in Fig. 4. However, Fig. 6b, c show that low [H2 O] solutions may result in some lateral pitting in the SiNWs whereas high [H2 O] solutions do not. This could be due to fast etching at sites with re-nucleated Ag particles for low [H2 O] etchants.

Evolution of SiNW length with time for different H2 O concentrations at a fixed HF–H2 O2 molar ratio of 0.95. een Effect of etch time on SiNW length. b , c SEM images of SiNWs after etching for 1 h in a solution composed of HF–H2 O2 molar ratios of 0.95 and H2 O concentrations of 46 and 50 M, respectively. d , e Etched bulk Si thickness with respect to the tip and base of the SiNWs over time
Fabrication of Highly Doped SiNWs with Controlled Porosity
SiNW porosity is another key parameter in SiNW-based devices [5, 16, 27, 29], making its controlled formation during SiNW fabrication highly important. The degree of porosity of SiNWs fabricated using two-step MACE is directly related to the H2 O2 concentration [14,15,16,17, 20], etching time [14, 16, 17, 20], and temperature [20] and inversely related to the HF–H2 O2 volume ratio [19] and wafer resistivity [17]. In our Ag deposition experiment, SiNW porosity was also found to be directly related to the amount of deposited Ag. However, the extent of SiNW porosification cannot be easily tuned without affecting other parameters. For example, length and porosity are expected to vary together if one of them is adjusted using either [H2 O2 ], etch time, or temperature. If a SiNW of a specific length needs to have higher porosity, the [H2 O2 ] can be increased, but the etch duration needs to be decreased as higher [H2 O2 ] may have a higher etch rate. This raises the question of whether the desired porosity can still be achieved given the shorter etch time.
Here, the extent of SiNW porosification caused independently by χ and [H2 O] was compared for χ = 0.92, 0.95, and 0.98 ([H2 O] fixed at 48 M) and [H2 O] = 46, 48, and 50 M (χ fixed at 0.95). The SiNW length was fixed at 20 μm by using different etch durations based on the etch rate of the respective etchant composition (see Additional file 1:Table S2). The porosity, in general, was found to be inversely related to χ and directly related to [H2 O], as shown in Fig. 7a–c and Fig. 7d, b, e, respectively. (The trends are more apparent in Additional file 1:Figure S7 where more samples are shown.) Comparing the SiNWs for χ = 0.95 and χ = 0.98 (Fig. 7b, c), the samples for χ = 0.95 appear to have a higher pore density and most are surrounded by a thin porous shell [14, 17]. Meanwhile, for χ = 0.98, some SiNWs appear to be rough and solid rather than porous, which indicates a much lesser degree of porosification. On the other hand, the overall porosity obtained for χ = 0.92 (Fig. 7a and Additional file 1:Figure S7a) appears to depart from the expected trend. While some SiNWs have a porous shell, others seem to be only roughened although to a higher extent compared with those for χ = 0.98. In contrast, the increase of porosity with [H2 O] is more consistent. Although no rough solid SiNWs were obtained for [H2 O] = 46 M, highly porous SiNWs were formed for [H2 O] = 50 M unlike in the case of χ = 0.92.

TEM images of fabricated SiNWs with a length of ≈20 μm showing the variation of porosity at the middle section with a –c HF–H2 O2 molar ratio and d , b , c H2 O concentration. een –c HF–H2 O2 molar ratio of the etchant was 0.92, 0.95, and 0.98, respectively, with [H2 O] = 48 M. d , b , c H2 O concentration of the etchant was 46, 48, and 50 M, respectively, with HF–H2 O2 molar ratio = 0.95. TEM images of SiNWs with f –h low and i –k high porosity corresponding to those shown in c and e , respectively, but including the f , ik top en h , k bottom sections. The scale bar in e and k also applies to the images in a –d en f –j , respectievelijk
The higher SiNW porosity obtained for χ = 0.95 than χ = 0.98 is consistent with the fact that metal re-nucleation, metal ion-induced etching, and hole diffusion are higher for lower χ values. It also shows that the longer etch time utilized for χ = 0.98 to obtain 20-μm long SiNWs did not overcome the porosification caused by the etchant χ value. The seemingly lesser degree of porosification for χ = 0.92 could not have been due to the difference in etch time as a longer etching period was utilized for it than for χ = 0.95. It is possible that more porous SiNWs were actually obtained for χ = 0.92; however, due to the very high porosity, HF–H2 O2 etching of porous Si both at the surface and inside the pore walls resulted, leading to the rapid collapse of the porous shells [42] and subsequent exposure of the less porous Si surface underneath. That more porous SiNWs were obtained for higher [H2 O] values confirms that etch duration has a significant effect on porosity [14, 16, 17, 20]. (Note the large differences in etch times in Additional file 1:Table S2 for different [H2 O] values.) The high degree of porosity obtained for 50 M H2 O without the collapse of the porous shell could be due to minimized HF–H2 O2 etching inside the pore walls because of the lower diffusion rate of reactants in dilute etchants.
Examination of the surface roughness along the length of the SiNWs reveals the characteristic increase in porosity from the base to the tip of highly doped SiNWs fabricated with MACE [16, 19], as shown in Fig. 7f–k (also in Additional file 1:Figure S8). The increase in porosity towards the tip of the SiNWs is due to the longer exposure time of these portions in the etchant solution [19]. Figure 6f–k and Additional file 1:Figure S8 also show that the SiNWs are tapered, with the tapering being more severe in SiNWs which are more porous (Fig. 7i–k and Additional file 1:Figure S8a–c). This is expected considering that porosification is directly related to the amount of dissolution of the metal catalyst at the SiNW base [15, 17]. However, a closer look at the SiNWs reveals that some nanowires exhibit a slightly biconic or hourglass longitudinal profile, which seems to occur more often among those with higher porosity. Likewise, more porous SiNWs generally have larger diameters than the less porous ones (see Additional file 1:Figure S7). In order to achieve highly porous SiNWs with smaller diameters, it might be necessary to use a more inert catalyst like Au [32].
Based on the results obtained here, porosity control in highly doped SiNWs of a given length is possible through the use of the appropriate etchant composition. To achieve low porosity, it is best to use high χ values as rough solid nanowires could be obtained. To achieve highly porous SiNWs, on the other hand, the use of dilute etchants with moderate χ values (≈0.95) is advisable as this avoids the disintegration of the porous shell which occurs in etchants with low χ values. It is conceivable that lower porosities could be achieved using an etchant of both high χ and low [H2 O] values and higher porosities using an etchant of both (slightly) lower χ and high [H2 O] values. In the case of low-porosity SiNWs, the maximum χ and minimum [H2 O] values would probably be dictated by the values where considerable lateral pitting occurs. On the other hand, for high-porosity SiNWs, the minimum χ and maximum [H2 O] values would be determined by the values where the porous shell dissolves and the SiNW structures are lost, respectively. These methods can be combined with our earlier finding of porosity control via the amount deposited Ag in order to obtain a wide range of SiNW porosities.
Conclusies
Porous SiNWs were fabricated from degenerately doped p-type Si substrates using metal-assisted chemical etching in HF–H2 O2 with electrolessly deposited Ag catalyst. The effect of Ag deposition time, etchant HF–H2 O2 molar ratio, and etchant H2 O concentration on the morphology and etch rate of the Si nanostructures was systematically studied. It was shown that there is an optimal amount of deposited Ag particles necessary to form damage-free SiNWs. Furthermore, the amount of deposited Ag particles affects the SiNW etch rate in a non-monotonic manner and provides an additional mechanism to control the porosity of the resulting nanowires. Likewise, the etchant composition has a significant effect on the resulting nanostructures. There is an appropriate χ window within which uniform SiNW arrays can be formed. For H2 O concentrations between 46 and 48 M, this χ range is 0.85–0.98; more dilute etchants increase the minimum χ due to sluggish etching at the SiNW base. The formation of Si nanostructures during Ag-catalyzed chemical etching is a result of the competing effects of different factors, namely, deposited Ag-catalyzed Si dissolution, re-nucleated Ag-catalyzed Si dissolution, hole diffusion, and reactant diffusion through etched pores, as reflected by the etching kinetics at the tip and base of the Si nanostructures. These factors result in a gradually decreasing etch rate over time, with re-nucleated Ag-catalyzed etching being dominant for low χ values and impeded diffusion being more pronounced for high χ values. These mechanisms can be exploited to control the porosity of SiNWs of the same length fabricated with different etch times. In particular, suppressing Ag re-nucleation and hole diffusion using higher χ values can effectively decrease pore density, while more controlled porosification can be achieved using dilute etchants owing to slower reactant diffusion and longer etch times. Since the general mechanism of Ag- and Au-catalyzed MACE of Si is similar [11, 33, 35], the findings of this study may also apply to porous SiNWs fabricated with Au metal catalyst, except that metal ion-induced etching is expected to be greatly suppressed and hole diffusion acts as the main mechanism of porosification and tip etching.
Afkortingen
- AgNP:
-
Ag nanoparticle
- DI:
-
Deionized
- MACE:
-
Metal-assisted chemical etching
- SEM:
-
Scanning elektronenmicroscopie
- SiNW:
-
Silicon nanowire
- TEM:
-
Transmissie-elektronenmicroscopie
- χ :
-
HF–oxidant molar ratio
Nanomaterialen
- Helden in Silicon Valley (en op de RTI User's Group Meeting)
- De evolutie van de markt voor 3D-printmaterialen:trends en kansen in 2019
- De evolutie van SLS:nieuwe technologieën, materialen en toepassingen
- Benzeenbewakingsinstrumenten voor de chemische, farmaceutische en petrochemische industrie
- Au-Capped GaAs-nanopillar-arrays gefabriceerd door metaalondersteunde chemische etsing
- Optische en elektrische kenmerken van silicium nanodraden bereid door stroomloos etsen
- Ontrafeling van de complexiteit van anti-omkopings- en corruptiewetten
- De evolutie en toekomst van Retail Curbside Delivery
- De verbazingwekkende evolutie van 3D-printen in de ruimtevaart en defensie
- Preventieve onderhoudssystemen en CMMS-software:de evolutie
- Roestvrij staal en de evolutie van de achtbaan



