Retentiemodel van TaO/HfO x en TaO/AlO x RRAM met zelfherstellende schakelkenmerken
Abstract
Een retentiegedragsmodel voor zelfcorrigerende TaO/HfO x - en TaO/AlO x -gebaseerd resistief willekeurig toegankelijk geheugen (RRAM) wordt voorgesteld. Trapping-type RRAM kan een hoge weerstandsstatus (HRS) en een lage weerstandsstatus (LRS) hebben; de degradatie in een LRS is meestal ernstiger dan die in een HRS, omdat de LRS tijdens het SET-proces wordt beperkt door de interne weerstandslaag. Als TaO/AlO x elementen zijn in lagen gestapeld, de LRS-retentie kan worden verbeterd. De door de extrapolatiemethode geschatte LRS-retentietijd is meer dan 5 jaar bij kamertemperatuur. Beide TaO/HfO x - en TaO/AlO x -gebaseerde RRAM-structuren hebben dezelfde afdeklaag van TaO en de activeringsenergieniveaus van beide soorten structuren zijn 0,38 eV. Bovendien is de extra AlO x schakellaag van een TaO/AlO x structuur creëert een hogere O-diffusiebarrière die de retentie aanzienlijk kan verbeteren, en de TaO/AlO x structuur toont ook een vrij stabiele LRS onder vooringenomen omstandigheden.
Achtergrond
Omdat NAND-flashtechnologie te maken heeft met een schaallimiet, zijn VRRAM-ontwerpen (vertical resistive random-access memory) met lage filmstapels, hoge productieopbrengsten en geen kruiskoppelingsproblemen veelbelovende kandidaten voor geheugentoepassingen met hoge dichtheid [1,2,3 ]. De 1TnR-architectuur met driedimensionale (3D) verticale structuur helpt bij het realiseren van ultralage bitkosten voor zeer compacte, dichte arrays [4,5,6]. Verschillende onderzoekers hebben voorgesteld om RRAM bij lage stroomniveaus te gebruiken door het weerstandsschakelmechanisme te veranderen van een filamentair type naar een defect-trapping-, vacature-modulerend of interface-type geleidend padmodel [7,8,9]. De vragen die centraal staan bij het falen van retentie en de migratie van zuurstofvacatures zijn echter nog steeds niet opgelost [3, 10]. In sommige retentieonderzoeken van het draadtype zijn veel verschillende modellen voorgesteld om retentieverliezen te verklaren [11,12,13]. De verandering van het schakelmechanisme geeft ook een andere richting aan die de retentie zou kunnen verbeteren [11]. Onze eerdere onderzoeken hebben aangetoond dat TaO/HfO x apparaten kunnen gunstige niet-lineariteitswaarden van ongeveer 40, duurzaamheidswaarden van meer dan 1000 cycli en gegevensbehoud van 85 °C vertonen [6, 7]. Desalniettemin is het nog steeds een uitdaging om een stabiele retentie te verkrijgen bij zulke lage bedrijfsstroomniveaus. In deze brief wordt een retentiemodel voorgesteld om het retentieverlies in twee verschillende defect-trapping-type apparaten te realiseren met de Arrhenius-methode. De geëxtraheerde activeringsenergie verklaart de retentieverbetering door de AlO x . niet overtuigend laag. Hoewel het origineel dubbelzinnig was, is de meest waarschijnlijke interpretatie dat dichte binding retentie vergemakkelijkt.
Methoden
Bij de fabricage van TaO/HfO x en TaO/AlO x apparaten voor de huidige studie, is de onderste elektrode (BE) samengesteld uit TiN-metaal dat is afgezet door fysieke dampafzetting (PVD) op 8-in. thermische oxide/Si-substraten. Elke BE werd van een patroon voorzien en geëtst met een conventioneel lithografie- en etsproces. Nadat elke TiN BE was geëtst met gas op chloorbasis, werden de resterende fotoresist (PR) en etsresten verwijderd met behulp van een plasmasysteem op afstand dat O2 aanbracht en H2 O bij 180 °C. Tijdens het PR-verwijderingsproces werd een dunne oxidatielaag van TiON gevormd op het oppervlak van elk TiN BE. Vervolgens resistieve schakellagen van HfO x en AlO x werden bereid door atomaire laagafzetting (ALD) met HfCl4 -H2 O en TMA-H2 O voorlopers, respectievelijk. De twee resistieve elementen HfO x en AlO x werden afgezet bij 300 en 250°C. Op de top van resistieve schakellagen werd de TaO-laag vervolgens afgezet door PVD door middel van plasma-oxidatie bij lage temperatuur (LTPO) [14]. Deze fabricage deponeert Ta-metaal met een ultralage snelheid (0,2 / s). Stabiele plasma-oxidatie werd uitgevoerd met een mengsel van Ar en O2 gassen. Deze TaO-laag diende als een interne zelf-conformiteitsweerstand, die relatief lek was in vergelijking met eerdere resistieve schakelfilms [7]. De bovenste elektrode was ook PVD-TiN. De dwarsdoorsneden en dikte-informatie van de TaO/HfO x en TaO/AlO x geheugenapparaten worden respectievelijk geïllustreerd in Fig. 1a, b. De filmdikte van TaO/HfO x werd gecontroleerd door transmissie-elektronenmicroscopie (niet getoond). Nadat de cellen van een patroon waren voorzien, werd het oxide bij lage temperatuur afgezet voor passivering bij 250°C. Ten slotte werd een conventioneel back-endproces toegepast om de fabricage van contact- en metalen padstructuren te voltooien.

Celschema's met dikte-informatie voor a TaO/HfO x apparaten en b TaO/AlO x apparaten. Beide grafieken beschrijven apparaten waarvoor PVD de TaO-lagen heeft afgezet met LTPO-processen, en de onderste TiON-grensvlaklagen werden gevormd door plasma-oxidatie tijdens het verwijderen van fotoresist
Resultaten en discussie
De elektrische metingen werden uitgevoerd met een HP4156C halfgeleiderparameteranalysator. De ingestelde en reset stroomdichtheid (J ) versus spanning (J –V ) krommen van TaO/HfO x en TaO/AlO x apparaten worden respectievelijk getoond in Fig. 2a, b. Beide initiële weerstandstoestanden (R initiaal ) van de TaO/HfO x en TaO/AlO x apparaten waren HRS. De maagdelijke geheugenapparaten waren geprogrammeerd op LRS met positieve vooringenomenheid en werden teruggeveegd. Vervolgens werd elke cel overgeschakeld van LRS naar HRS door aangelegde negatieve spanning. Beide J–V plots bevatten drie celgroottes, namelijk 0,1, 0,56 en 25 m 2 . In de J–V plots lijken alle curven van apparaten met verschillende oppervlakten op elkaar, wat zowel TaO/HfO x aangeeft en TaO/AlO x apparaten hadden (i) dezelfde stroomdichtheid in de begintoestand, (ii) vergelijkbare set- en resetspanningen, en (iii) dezelfde stroomdichtheid in LRS en HRS. Bovendien wordt de eigenschap van constante stroomdichtheid duidelijk geïllustreerd door de weerstand versus oppervlakte (R –A ) plots in Fig. 2c, d. De sterke gebiedsafhankelijkheid in beide R initiaal en LRS kan worden waargenomen door de regeling van de stroomdichtheid. Ongeacht de schaal van het celoppervlak en de compliantiestroom, wordt in beide apparaten dezelfde aan/uit-weerstandsverhouding behouden. Deze schakelkarakteristiek met constante stroomdichtheid houdt in dat de geheugencellen uniform worden geprogrammeerd of gewist door het elektrische veld. Van deze apparaten wordt aangenomen dat ze schakeleigenschappen van het trapping-type hebben, die sterk verband houden met de modulatie van vacatures [8]. In het geval van trapping-type RRAM is er geen scherpe stroomsprong waargenomen tijdens het instelproces, maar scherpe stroomsprongen zijn vaak waargenomen voor draadvormig RRAM. In het huidige onderzoek werden verschillende schakelspanningen waargenomen voor de verschillende schakellagen met HfO x of AlO x . Het ingestelde spanningsbereik van een TaO/AlO x apparaat is 4 tot 4,5 V, wat groter is dan dat van een TaO/HfO x apparaat (3 tot 4 V). Het resetspanningsbereik van een TaO/AlO x apparaat is −1,5 tot −2,5 V, wat groter is dan die van een TaO/HfO x apparaat (−0,5 tot −1,5 V). Een AlO x systeem verbruikt meer energie om de set- en resetschakelaars te voltooien dan een HfO x systeem verbruikt. Tijdens het instellen van schakelaars worden de schakellagen HfO x en AlO x bereik zachte storingen bij spanningen van respectievelijk ongeveer 3 en 3,5 V. In beide soorten apparaten wordt de stroom, voordat zich filamenten vormen in de schakellaag, beperkt door de interne weerstand van de TaO-laag. Tijdens het zelf-nalevingsproces van trapping-type RRAM, worden overmatige zuurstofvacatures gegenereerd in de schakellaag [7]. Die zuurstofvacatures worden opnieuw gecombineerd tijdens het resetproces met negatieve voorspanning. In tegenstelling tot draadvormig RRAM, is de HRS altijd lager dan de initiële weerstandstoestand (IRS) na een reset-operatie [15,16,17]. Samenvattend, defect-trapping is een proces dat vacatures moduleert door middel van zuurstof-ion-vacature-recombinatie om de weerstandsvariatie in de schakellaag te beheersen. Vergeleken met een HfO x schakellaag, defect-trapping veroorzaakt hogere spanning en vermogen in de AlO x laag tijdens zowel het instellen als het resetten van een schakelaar.
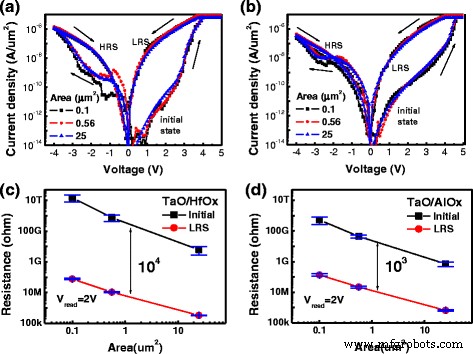
Stroomdichtheid met spanningsgrafiek van a TaO/HfO x apparaten met verschillende celgroottes. b TaO/AlO x apparaten met verschillende celgroottes. De weerstand versus de oppervlaktegrafiek van c a TaO/HfO x apparaat en d a TaO/AlO x apparaat. Beide grafieken bevatten de IRS en LRS met leesspanning = 2 V. Elk datapunt levert het gemiddelde van 10 apparaten en de bijbehorende standaarddeviatie
Nadat het schakelgedrag was onderzocht, werd het HRS- en LRS-retentiegedrag van de geheugeneenheden van het trapping-type onderzocht. De grafieken van weerstandsvariatie versus tijd bij 85°C en 1 V voor de TaO/HfO x en TaO/AlO x apparaten worden getoond in Fig. 3a, b. In beide plots is de LRS-variatie meer uitgesproken dan de HRS-variatie. De weerstandsstabiliteit van TaO/AlO x is hoger dan die van TaO/HfO x . De figuren illustreren dat de HRS's voor beide soorten apparaten de neiging hadden om naar de IRS's te drijven; de IRS's zijn gemarkeerd met stippellijnen in Fig. 3a, b. De trend van weerstand die terugkeert naar de maagdelijke staat van het apparaat wordt weergegeven in figuur 3c voor TaO/AlO x en in Fig. 3d voor TaO/HfO x . Om dit te realiseren, werden beide typen apparaten aanvankelijk geprogrammeerd op LRS bij kamertemperatuur, zoals weergegeven in de I–V veegt (zwarte lijn). Vervolgens wordt de TaO/AlO x en TaO/HfO x apparaten werden respectievelijk 48 uur in ovens bij 150 ° C en 120 uur bij 120 ° C gebakken. Voor beide gevallen is de I–V sweep na te zijn gebakken was vergelijkbaar met de eerste sweep. Door deze procedure werden de LRS's van apparaten van het trapping-type na verloop van tijd in een omgeving met hoge temperaturen teruggebracht naar de oorspronkelijke toestand. In tegenstelling tot apparaten van het filamenttype, die een opmerkelijke beweging van zuurstofatomen vertonen, hebben apparaten van het vangtype paren zuurstofionen en vacatures die door korte afstanden van elkaar zijn gescheiden. De neiging van weerstand die afdrijft naar de begintoestand houdt verband met de oorspronkelijke kristalliniteit, die voornamelijk wordt geregeld door de procestemperatuur van ALD. Als gevolg hiervan kunnen de LRS'en in beide typen apparaten worden gereset naar HRS'en (of IRS's) door negatieve voorspanning of thermische energie. Deze eigenschap is anders bij filamentair RRAM.
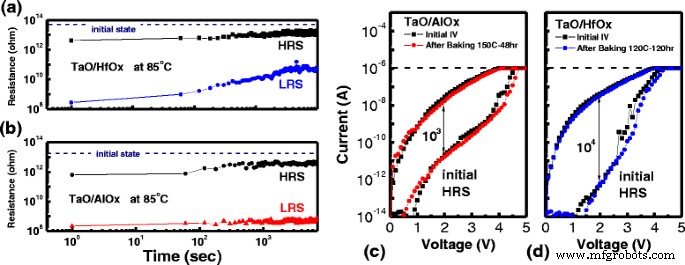
Plots van weerstandsvariatie versus tijd voor a TaO/HfO x en b TaO/AlO x apparaten. Beide grafieken bevatten HRS- en LRS-variatie bij leesspanning =-1 V bij 85 °C. Na de ik –V sweeps van elk nieuw apparaat waren ingesteld, het apparaat werd gebakken en vervolgens opnieuw op LRS geprogrammeerd:c TaO/AlO x (150 °C gedurende 48 uur); d TaO/HfO x (120 °C gedurende 120 u)
Bij standaardretentietests voor niet-vluchtig geheugen wordt dataretentie getest bij zowel kamertemperatuur als bij hoge temperatuur; apparaten moeten gegevens bij zowel kamertemperatuur als bij hoge temperatuur kunnen vasthouden om bruikbaar te zijn in echte toepassingen. Activeringsenergie (E een ) extractie met de Arrhenius-methode in de retentieplot is een gebruikelijke methode om gegevensretentie te evalueren [18, 19]. Zoals te zien is in figuur 3a, is de LRS-variatie meer uitgesproken dan de HRS-variatie. Daarom is de weerstandsverhouding (R verhouding ) van LRS versus baktijd bij temperaturen variërend van 30 tot 150 ° C werd geanalyseerd. Een voorbeeld van extractie van retentietijd uit een TaO/AlO x apparaat wordt getoond in Fig. 4a. De degradatiesnelheid van de weerstand kan worden berekend door de helling van lineaire aanpassing in log(R verhouding )-log(tijd) schaal. Door rekening te houden met de maximale aan/uit-weerstandsverhouding van ongeveer 10 3 voor een TaO/AlO x apparaat, zoals weergegeven in Afb. 3c, een retentietijd met 10 3 keer kan de LRS-variatie worden berekend. De geschatte bewaring van LRS-gegevens bij meettemperaturen van 30 tot 150 °C wordt weergegeven in figuur 4b. Elk datapunt vertegenwoordigt informatie van meer dan 18 apparaten voor beide apparaattypen. In een TaO/AlO x apparaat, het bewaren van gegevens is zo hoog als 10 6 s bij 150 °C en 2 × 10 8 s (ongeveer 5 jaar) bij kamertemperatuur; die tijden zijn bijna 10 1,5 keer langer dan die van een TaO/HfO x apparaat. Het meest interessante punt is dat zowel TaO/HfO x en TaO/AlO x apparaten tonen dezelfde E een = 0,38 eV, zoals berekend op basis van de geëxtraheerde helling. Dezelfde E een houdt in dat beide soorten apparaten vergelijkbare chemische reacties ondergaan in het LRS-degradatieproces. Deze E een is betrokken bij alle thermisch geactiveerde kinetische processen, inclusief het vrijkomen van zuurstofionen nabij TaO-interfaces en de zuurstofdiffusieprocessen in AlO x en HfO x lagen. De zuurstof-zelfdiffusiecoëfficiënten van HfO x en AlO x lagen zijn verschillend bij hoge temperaturen (>1000 °C); exacte metingen zijn te vinden in de literatuur [20, 21]. De zuurstofdiffusiecoëfficiënt bij lage temperatuur (<200 °C) hangt ook af van de dikte van HfO x diëlektrica [22]. Als de diffusieprocessen in schakellagen de chemische reactie domineren, dan is de E een waarden moeten verschillend zijn vanwege de verschillende diffusiecoëfficiënten in HfO x en AlO x lagen. Beide soorten apparaten in dit werk vertoonden dezelfde E een = 0,38 eV; dit had te maken met het feit dat beide typen apparaten dezelfde afdeklaag van TaO bovenop de schakellagen hadden. LRS-degradatie is een proces van recombinatie van vacatures en ionen, wat betekent dat de TaO-laag deze chemische reactie regelt en dat de meeste vacatures dicht bij het grensvlak tussen de TaO en de schakellaag zitten. Die vacatures blijven liever op de TaO/switching layer-interface; dit fenomeen zou kunnen worden ondersteund door het oogpunt van thermodynamische stabiliteit, zoals gerapporteerd door Zhong et al. [23]. In hun simulatie van TiN/Ta/HfO x /TiN-stacks, de zuurstofionen bleven liever op de Ta/HfO x interface omdat er een laag energieverschil bestond tussen Ta en HfO x [23]. In hun simulatie, zoals in de huidige experimenten, ving de TaO-weerstandslaag de meeste zuurstofionen op en domineerde dit vacature-recombinatieproces. LRS-degradatie is schematisch weergegeven in figuur 4c. De zuurstofionen keren tijdens het bakproces terug naar de vorige thermische evenwichtstoestand, wat resulteert in retentieverlies. Er kunnen verschillen worden opgemerkt tussen de Ta/HfO x apparaat zoals voorgesteld door Zhong et al. en de TaO/HfO x apparaat in deze studie, maar in beide studies werd de TaO-laag gevormd door verschillende cycli van metaal Ta-afzetting en LTPO-processen [14]. Door het LTPO-proces wordt het metaalrijke TaO/HfO x interface kan worden beschouwd als een zuurstofionenreservoir. Tijdens het recombinatieproces van zuurstofionen en vacatures speelt de atoompakkingsdichtheid een essentiële rol. De superieure LRS-retentie-eigenschappen verkregen in de AlO x schakellaag kan worden verklaard door de hoge atoomdichtheid van de AlO x laag. Het is algemeen bekend dat de bindingslengte van Al–O korter is dan die van Hf–O [24, 25]. De korte binding in de AlO x vermindert de mobiliteit van zuurstofionen als gevolg van hoge coulomb-interactie, wat resulteert in een hoge diffusiebarrière voor zuurstofvacatures. Deze barrière zorgt ervoor dat de retentietijd langer is in een TaO/AlO x apparaat dan in een TaO/HfO x een.
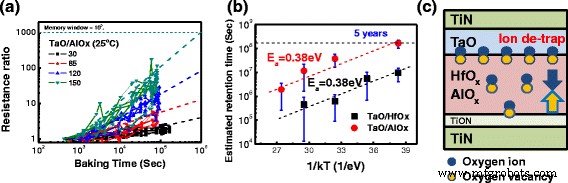
een Weerstandsvariatieverhouding versus baktijd voor verschillende temperaturen in TaO/AlO x apparaten. De gemiddelde initiële weerstand was 179 MOhm met een leesspanning van 2 V, en de degradatiesnelheid van de LRS-weerstand werd berekend met de lineaire aanpassingsmethode in log(R verhouding )–log(T) schaal. b Geschatte retentietijd (1000×) versus 1/kT-plot. Elk punt bevat gegevens van 18 apparaten die zijn genomen bij een leesspanning van 2 V. De geëxtraheerde activeringsenergieën waren 0,38 eV in zowel de TaO/AlO x en TaO/HfO x apparaten. c Retentieschema van verschillende zuurstofdiffusiebarrières in HfO x of AlO x met een TaO afdeklaag
Bovendien is het retentieverliesmodel van een apparaat van het draadtype anders dan dat van een apparaat van het defectvangende type. Het retentiegedrag voor filamentair-type RRAM is gerelateerd aan filamentbreuk en de vacaturediffusierichting is lateraal [11, 19, 24]. Bij defect-trapping RRAM is de diffusierichting van het defect longitudinaal, wat evenwijdig is aan het externe elektrische veld. Daarom kan het retentiegedrag worden beïnvloed door de richting en grootte van de bias. Afbeelding 5a, b toont de on-bias retentie door de weerstandsverhouding voor de twee apparaten. De weerstandsverhouding wordt gedefinieerd als de weerstand van het stressapparaat tegen de weerstand van de LRS. Een positieve bias kan helpen om de LRS te behouden, maar een negatieve bias versnelt het degradatieproces. Die on-bias-eigenschappen kunnen worden verklaard door de interactie tussen het gelokaliseerde veld van paren zuurstofionen en vacatures en het externe elektrische veld. Als de richting van het externe veld hetzelfde is als de ingestelde richting (positief), verlengt dit de retentietijd; als het externe veld zich in de resetrichting (negatief) bevindt, veroorzaakt dit degradatie. In een laag elektrisch veld met ± 100 mV is de on-bias-degradatie hetzelfde als de non-bias-degradatie in beide typen apparaten. Deze afwijking van ± 100 mV kan worden gedekt door de bandoffsets van TiON-HfO x , TiON-AlO x , en TiN-TaO-knooppunten. Een TaO/AlO x apparaat onder een hoge positieve bias van 500 mV vertoont geen duidelijke degradatie.
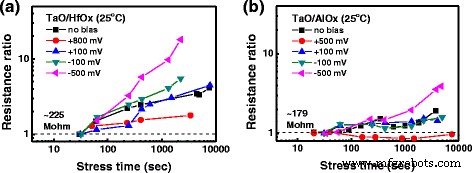
On-bias weerstandsverhouding versus stresstijd voor a TaO/HfO x en b TaO/AlO x apparaten op kamertemperatuur
Conclusies
Samenvattend hebben we twee soorten zelfherstellende RRAM-apparaten vergeleken op basis van hun schakelkarakteristieken en hun retentiegedrag geanalyseerd. De TaO/AlO x apparaat vertoonde een hogere schakelspanning en een robuustere LRS thermische stabiliteit dan de TaO/HfO x apparaat deed. Het voordeel van robuuste retentie van de AlO x schakellaag is te wijten aan de hoge zuurstofdiffusiebarrière in plaats van activeringsenergie. De activeringsenergie van retentieverlies is gerelateerd aan het ion-de-trapproces in de TaO-resistieve laag. De hoge atoomdichtheid van AlO x film kan de LRS-retentie verbeteren. Er is een schematisch model voor retentieverlies voorgesteld en de on-bias retentieresultaten ondersteunden dit model. Dit model zou gunstig kunnen zijn voor de ontwikkeling van zelfcorrigerende RRAM-apparaten met een lage stroomsterkte en een lange retentie, voor toekomstige geheugentoepassingen met hoge dichtheid.
Nanomaterialen
- Kenmerken en toepassingen van titanium
- Circuit met een schakelaar
- Leidinggevend met volharding en doorzettingsvermogen
- switch ... case in C (Switch Statement in C) met voorbeelden
- Slim nanomateriaal en nanocomposiet met geavanceerde agrochemische activiteiten
- Bipolaire resistieve schakelkenmerken van HfO2/TiO2/HfO2 drielaagse structuur RRAM-apparaten op Pt- en TiN-gecoate substraten vervaardigd door atomaire laagafzetting
- Kenmerken van grensvlak-, elektrische en banduitlijning van HfO2 / Ge-stapels met in situ gevormde SiO2-tussenlaag door plasma-versterkte atomaire laagafzetting
- Optische en elektrische kenmerken van silicium nanodraden bereid door stroomloos etsen
- Eenvoudige synthese van gekleurd en geleidend CuSCN-composiet gecoat met CuS-nanodeeltjes
- Verbeterde biocompatibiliteit in anodische TaO x Nanotube-arrays
- Geleidingsmechanisme en verbeterd uithoudingsvermogen in HfO2-gebaseerd RRAM met nitridatiebehandeling



