Geavanceerde atoomlaagdepositietechnologieën voor micro-LED's en VCSEL's
Abstract
In de afgelopen jaren hebben de procesvereisten van nano-apparaten geleid tot de geleidelijke vermindering van de schaal van halfgeleiderapparaten, en de daaruit voortvloeiende niet-verwaarloosbare zijwanddefecten veroorzaakt door etsen. Aangezien plasma-versterkte chemische dampafzetting niet langer voldoende stapdekking kan bieden, worden de kenmerken van de ALD-technologie voor atomaire laagafzetting gebruikt om dit probleem op te lossen. ALD maakt gebruik van zelfbeperkende interacties tussen het precursorgas en het substraatoppervlak. Wanneer het reactieve gas een enkele laag chemische stof vormt die op het substraatoppervlak is geadsorbeerd, treedt er geen reactie tussen hen op en kan de groeidikte worden gecontroleerd. Op het Å-niveau kan het een goede stapdekking bieden. In deze studie werd recent onderzoek naar de ALD-passivering op micro-licht-emitterende diodes en oppervlakte-emitterende lasers met verticale holtes beoordeeld en vergeleken. Er is aangetoond dat verschillende passiveringsmethoden leiden tot verbeterde lichtefficiëntie, minder lekkage en verbeterde betrouwbaarheid.
Inleiding
De ontwikkeling van atomic layer deposition (ALD) technologie begon in de jaren zeventig. In 1977 vroeg Dr. Tuomo Suntola uit Finland formeel het eerste patent voor ALD-technologie aan [1]. Tussen 1983 en 1998 werd ALD-technologie toegepast bij de productie van elektronische displays op de luchthaven van Helsinki in Finland. Als gevolg van de introductie van het ALD-proces in de halfgeleiderindustrie aan het eind van de jaren negentig werden aanzienlijke onderzoeks- en ontwikkelingsfondsen en mankracht geïnvesteerd, wat aanzienlijk heeft bijgedragen aan de snelle groei van de ALD-procestechnologie. In 2007 gebruikte Intel de ALD-procestechnologie om hafniumdioxide (HfO2 ) gate-passiveringslaag, die werd aangebracht op een metaaloxide half-veldeffecttransistor op een 45 nm microprocessor, wat het belang van ALD-procestechnologie in de halfgeleiderindustrie verder consolideerde [2].
ALD is gebaseerd op chemische oppervlaktereacties [3] en wordt gekenmerkt door uitstekende diktenauwkeurigheid op atomair niveau, grote uniformiteit en conformiteit van de film op de structuur met een hoge aspectverhouding. In tegenstelling tot traditionele chemische dampafzetting (CVD) of fysieke dampafzetting (PVD), zoals weergegeven in figuur 1, gebruikt het ALD-proces gewoonlijk twee verschillende chemische voorlopers. Deze worden op verschillende tijdstippen in de reactiekamer geleid om twee halve-cyclusreacties te vormen, en alle chemische reacties worden door chemisorptie tot het oppervlak beperkt. Deze twee halve-cyclusreacties, die een ALD-cyclus vormen die de afzetting van een monolaagfilm vergemakkelijkt, kunnen laag voor laag worden herhaald om de film te laten groeien. Deze chemische oppervlaktereacties vinden plaats onder de omstandigheden van een zelfbeperkende reactie, het ALD-procesvenster. Het gebruik van twee halve-cyclusreacties om de film af te zetten vermijdt de gelijktijdige aanwezigheid van twee chemische voorlopers in de reactiekamer, en een depositiemodus zoals CVD wordt gevormd, waardoor de ALD-technologie de filmdikte en uniformiteit nauwkeurig kan regelen [4, 5,6,7].

Schematische weergave van thermische en plasma-ondersteunde ALD
De groeisnelheid van ALD-films wordt uitgedrukt door de groei per cyclus (GPC) [8, 9]. Over het algemeen varieert de GPC in dikte van 0,05 tot 0,1 nm. De keuze van chemische voorlopers beïnvloedt de kwaliteit van de film, de groeisnelheid en de tijd die nodig is voor het proces. De ALD-afzettingsprocedure bestaat uit vier opeenvolgende stappen:puls A, schone A, puls B en schone B. Puls A bestaat uit metalen voorloperdampen en puls B bestaat uit niet-metalen voorloperdampen. Inactieve gassen zoals stikstof of argon en vacuümpompen worden gebruikt om gasvormige bijproducten van de reactie en resterende reactantmoleculen uit de reactieruimte te verwijderen tijdens reiniging A en reiniging B. De afzettingsvolgorde omvat ten minste één afzettingscyclus. De afzettingscyclus wordt herhaald totdat de afzettingssequentie een film van de gewenste dikte heeft geproduceerd.
De zelfbeperkende reactie vormt de kern van ALD [10,11,12,13]. Het instellen en aanpassen van de procesparameters (zoals procestemperatuur, selectie van chemische precursoren, dosering, enz.) om de chemische oppervlaktereactie in staat te stellen de zelfbeperkende toestand te bereiken, is de eerste stap in de ontwikkeling van het ALD-proces. In het geval dat wordt voldaan aan het ALD-procesvenster, vinden alle chemische reacties plaats aan het oppervlak, waarbij wordt voldaan aan de zelfbeperkende voorwaarden. Daarom, als er voldoende chemische voorlopermoleculen worden geïntroduceerd in elke ALD-cyclus, hangt de totale hoeveelheid chemische voorlopers die deelnemen aan de chemische oppervlaktereactie af van het aantal oppervlakte-reactieve groepen. Als de procestemperatuur wordt gecontroleerd op een niveau waarbij de chemische voorlopermoleculen niet binnen het bereik van fysieke adsorptie en autothermisch kraken vallen, kan een atomaire laag uniform worden afgezet op alle substraatoppervlakken in elke ALD-cyclus. Bijgevolg heeft ALD-technologie een uitstekende uniformiteit en conformiteit en kan de dikte van de film worden verminderd. De nauwkeurigheid van de besturing is een sleutelfactor op atomair niveau [14,15,16,17].
De belangrijkste toepassing van ALD ligt op het gebied van halfgeleiders [18,19,20,21,22], zoals de bereiding van hoge-k-diëlektrica, dunne metaalfilms, koperbarrièrefilms en etsstoplagen voor fin field- effecttransistoren (FinFET's) [23,24,25,26,27,28], oxidepassiveringslagen en antireflectielagen voor LED's en VCSEL's. De zeer uniforme dekking en filmeigenschappen van hoge dichtheid van ALD maken het geschikt voor apparaten die gevoelig zijn voor water en zuurstof. Daarom is ALD de beste coatingtool geworden voor beschermende lagen van apparaten die een hoge betrouwbaarheid vereisen. De waterdamptransmissiesnelheid (WVTR) is een belangrijke indicator voor het meten van de weerstand van de film tegen water en zuurstof, met name voor flexibele OLED-schermen (Organic Light Emitting Diode), die gevoelig zijn voor waterdamp [29,30,31, 32,33,34,35,36,37]. De waarde moet 10 −4 . bereiken g/m 2 -dag of minder. Voor andere krachtige VCSEL's, stroomapparaten en hoogwaardige LED's moet hun WVTR ten minste minder zijn dan 10 −3 g/m 2 -dag om betrouwbaarheid in ruwe omgevingen te garanderen. Daarom zijn deze apparaten begonnen met het gebruik van ALD-passivering om de stabiliteit ervan te waarborgen [38,39,40,41,42,43,44]. Naast de bovengenoemde toepassingen gebruiken fotovoltaïsche apparaten [45,46,47], lithiumbatterijen [48,49,50], brandstofcellen en micro-elektromechanische systemen (MEMS) ook veel ALD-processen [6, 51, 52,53]. In dit artikel richten we ons op de effecten van ALD-technologieën op apparaatprestaties en bespreken we het geval van VCSEL's. Daarnaast geeft dit artikel een overzicht van ALD-processen voor het verbeteren van de prestaties van VCSEL's.
ALD-technologieën voor micro-LED's
De blauwgroene LED bestaat voornamelijk uit materialen op basis van InGaN. Door zijn kristalstructuur is het een piëzo-elektrisch materiaal. Het heeft een sterk ingebouwd elektrisch veld, dat de emissiegolflengte en de recombinatie-efficiëntie van het actieve gebied beïnvloedt. Dit fenomeen wordt het kwantumbegrensde Stark-effect (QCSE) genoemd, wat een van de belangrijkste redenen is voor de lichtopbrengst van LED's [54]. Daarom gebruikte het onderzoeksteam de kenmerken van de QCSE via een ringvormige nanostructuur op een groene epitaxiale wafer. De fabricage van de structuur laat de spanning in het actieve gebied van de LED los om golflengtemodulatie te bereiken. Het moduleert de emissiegolflengte van groen naar blauw omdat de nanostructuur een deel van het lichtoppervlak opoffert en de lichtintensiteit vermindert [55]. Afbeelding 2 toont een schema van de micro-LED (μ-LED). Naarmate de grootte van de μ-LED afneemt, hebben de defecten aan de zijwanden een grotere impact op de wafer, wat leidt tot een afname van de lichtopbrengst van de chip [56,57,58]. Passivering in micro-sized LED's wordt meestal bereikt met behulp van plasma-enhanced chemical vapour deposition (PECVD), die op waterstof gebaseerde voorlopers gebruikt om snelle depositiesnelheden te bereiken [30, 32]. ALD heeft de voorkeur voor LED's van microformaat. In vergelijking met de passiveringslagen die door PECVD zijn afgezet, is ALD in staat zeer compacte diëlektrische films met een dikte op nanometerschaal af te zetten. ALD biedt een veelbelovende benadering voor de passivering van μ-LED's door compacte en dichte diëlektrische films aan te bieden, samen met een betere controle over de filmdikte. Daarom hebben veel onderzoeksteams ALD dunne-film passiveringsbeschermingstechnologie geïntroduceerd om de traditionele PECVD-methode te vervangen. F Koehler et al. hebben gemeld dat standaard PECVD film kan afzetten bij gematigde temperaturen (400 ° C), maar lijdt aan sterke belastingseffecten. ALD heeft het voordeel van een goede conformiteit bij lage temperaturen. Bovendien vertoont ALD superieure wafer-to-wafer en binnen-wafer uniformiteit [59,60,61]. Bovendien rapporteerde Milojevic [38] dat de toename van lekstroom in kleinere μ-LED's te wijten kan zijn aan de diëlektrische kwaliteit van PECVD. Deze toename onthulde dat PECVD-passivering van de zijwand onvoldoende was om de lekstroom voor μ-LED's met een grote omtrek/oppervlak-verhouding te verminderen; Nakamura et al. hebben de opto-elektronische effecten van zijwandpassivering op Μicro-LED's met behulp van ALD en PECVD onderzocht, en deze resultaten lieten ook zien dat ALD gunstiger is voor de verbetering van de optische en elektrische effecten [62]. De ALD-passiveringsbeschermingslaag heeft een hoge dichtheid, hoge stapdekking, effectieve reparatie van defecten en andere kenmerken die voorkomen dat dragers vast komen te zitten door defecten op het oppervlak van het apparaat. De lichtsterkte van het apparaat neemt dus enorm toe, wat resulteert in een verbeterde efficiëntie [44, 55, 60, 63,64,65,66,67].
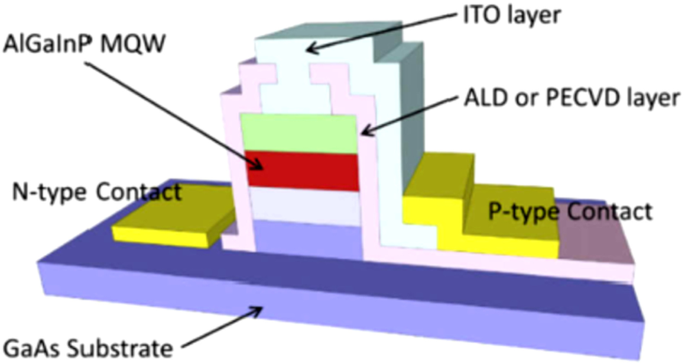
Schema van een μ-LED [67]
Gezien de invloed van de door PECVD en ALD gegroeide passiveringsbeschermingslaag op de lekstroom, toont Fig. 3 de lekstroomdiagrammen van de rode μ-LED na PECVD en ALD passiveringsbescherming [66,67,68]. De gemiddelde lekstroom van het apparaat dat ALD gebruikt, blijkt veel lager te zijn dan die verkregen met PECVD. Verder neemt de lekstroom gelijkmatig toe naarmate de componentgrootte kleiner wordt vanwege de toename van de oppervlakte-tot-volumeverhouding van de kleine apparaten en een extra lekpad onder omgekeerde voorspanning.
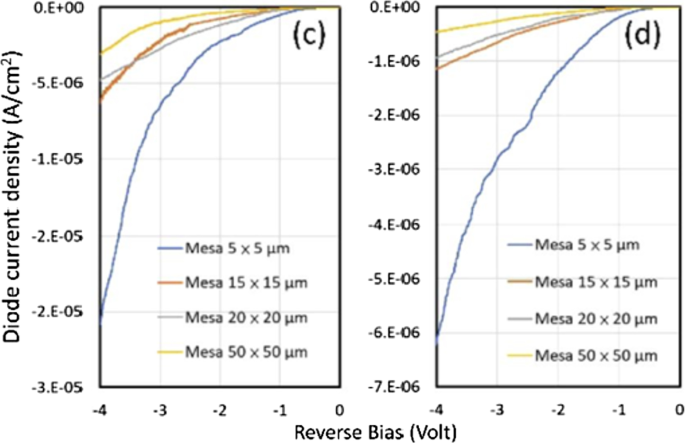
Reverse bias J-V-curven van a PECVD-monsters en b ALD-voorbeelden [68]
Om de invloed van de passiveringsbeschermingslaag op het optische vermogen van de roodlicht-μ-LED te illustreren, vergelijkt figuur 4 het optische vermogen van de PECVD- en ALD-passiveringsbeschermingslagen voor verschillende afmetingen en stroomdichtheden. Het is te zien dat wanneer de componentgrootte groter is dan 15 µm, het optische vermogen van de PECVD- en ALD-passiveringslagen bevredigende niveaus kan bereiken, maar wanneer de componentgrootte kleiner is dan 5 µm, presteert ALD beter dan de passiveringsbescherming die wordt geboden door PECVD. Uit de vergelijking tussen apparaten met verschillende coatings en verschillende stroomniveaus kan een dramatische daling in termen van geïntegreerd optisch vermogen worden waargenomen. Bij dezelfde stroomdichtheid en verschillende afmetingen is het verschil in het optische vermogen van ALD 570 keer, terwijl de componenten die PECVD gebruiken maar liefst 850 keer zo hoog zijn. Dit toont aan dat ALD nog steeds een uitstekende passivering biedt voor kleine componenten. De beschermende laag maakt de continue onderdrukking van oppervlaktedefecten mogelijk en verhoogt de efficiëntie van de stralingsrecombinatie. Verder verhoogt de passiveringsbescherming van ALD de betrouwbaarheid van het apparaat. Aangezien het droge etsproces schade en defecten aan de zijwanden kan veroorzaken, kan de impact van de zijwanddefecten proportioneel toenemen wanneer de grootte van het apparaat wordt verkleind, wat leidt tot voortijdige prestatievermindering. De kwaliteit van de passiveringslaag is dus bijzonder belangrijk. De bovenstaande resultaten tonen aan dat naarmate het apparaat kleiner wordt, de apparaten die worden beschermd door ALD-passivering beter presteren onder verschillende omstandigheden. In toekomstige geavanceerde productieprocessen zal ALD-technologie naar verwachting een belangrijke rol blijven spelen.
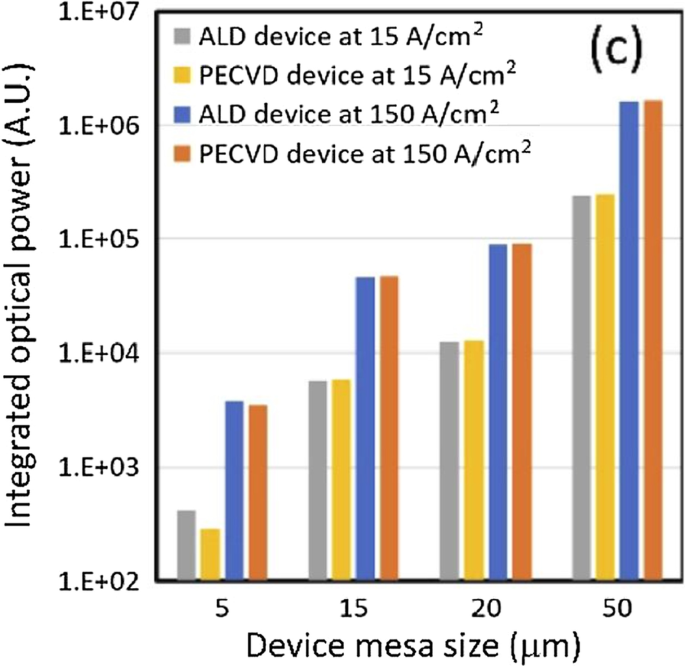
Geïntegreerde spectrale intensiteit tussen ALD- en PECVD-monsters onder hoge/lage stroomdichtheden [68]
Gezien de invloed van de EQE, heeft de huidige studie de aanwezigheid van een passiveringslaag op de zijwand bepaald en de effecten van de door ALD en PE-CVD geproduceerde passiveringslagen op de EQE als volgt vergeleken:LED-1:μ-LED niet onderworpen aan de zijwand passivering; LED-2:μ-LED onderworpen aan passivering van de ALD-zijwand en inductief gekoppeld plasma-etsen; LED-3:μ-LED onderworpen aan passivering van de PE-CVD-zijwand en HF-etsing; LED-4:μ-LED onderworpen aan passivering van de ALD-zijwand en HF-etsing. Afbeelding 5a, b geeft de EQE's weer die zijn verkregen voor 100 × 100 μm 2 en 20 × 20 μm 2 respectievelijk apparaten om de effecten van verschillende zijwandpassiveringstechnieken te illustreren. Alle gepassiveerde 100 × 100 μm 2 μ-LED's hadden een vergelijkbare piek-EQE (LED-1, 40%; LED-2, 36%; LED-3, 38%; en LED-4, 41%). Vanwege de kleine omtrek-oppervlakteverhouding had de schade aan de zijwand weinig effect op de prestaties van het apparaat. Daarom had passivering van de zijwand geen significante invloed op grote μ-LED's. Bovendien heeft de EQE bij grotere apparaten minder last van zijwandschade en verbetert deze niet bij passivering van de zijwand. Voor de 100 × 100 μm 2 ongeacht de gebruikte passiveringsmethode van de zijwand, varieerde de EQE-daling hoewel de maximale EQE constant bleef. Voor μ-LED's met een oppervlakte van 20 × 20 μm 2 , was de EQE bereikt met en zonder ALD-passivering respectievelijk 33% en 24%. Dit resultaat wordt toegeschreven aan de gecombineerde effecten van verbeterde lichtextractie, oppervlaktereorganisatie en verminderde lekstroom veroorzaakt door schade aan de zijwand.
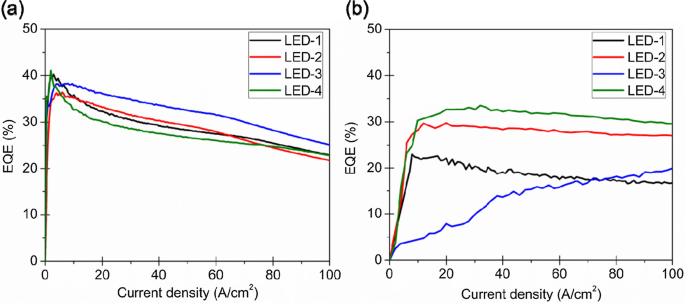
Afhankelijkheid van de EQE van stroom voor a 100 × 100 μm 2 en b 20 × 20 μm 2 apparaten met verschillende zijwandpassiveringsmethoden [63]
Dientengevolge heeft μ-LED-technologie een groot potentieel voor het veranderen van de solid-state verlichtingsindustrie, en het zal zeker een baanbrekende weergavetechnologie zijn. Passivering van de zijwanden is essentieel om de betrouwbaarheid te behouden die nodig is voor hoge prestaties met een verdere verkleining van de afmetingen van het apparaat. Over het algemeen is ALD een sleuteltechniek voor het uitvoeren van passivering van de zijwanden om een daling van de efficiëntie van μ-LED's te voorkomen, aangezien hun karakteristieke grootte wordt verkleind tot de microschaal als gevolg van de lekstroom [69].
ALD-technologieën voor VCSEL
Er zijn veel voordelen in oxide VCSEL's, zoals een betere modale stabiliteit en lage jitter voor datatransmissietoepassingen, evenals lage kosten in niet-hermetische transceiverpakketten. Vanwege de hoge vermogensdichtheid van de laser vereist de oxide VCSEL echter ook meer beschermende methoden om de mutatie van laserkarakteristieken te voorkomen.
De VCSEL bestaat uit drie delen:de Bragg-reflector met bovenste distributie (p-DBR), holte en onderste n-DBR. De DBR bestaat uit 20-40 paar dunne films. De holte is in het algemeen enkele micron dik. Vergeleken met de versterkingslengte van de zij-emitter, is de versterkingslengte van de actieve laag van de VCSEL erg klein (enkele tientallen nanometers). Om de gestimuleerde emissie van stralingslicht te verkrijgen, moet de DBR een zeer hoge reflectiviteit hebben om gestimuleerde emissie van stralingslicht te laten plaatsvinden. Om de eigenschappen van VCSEL's te verbeteren, is ALD toegepast om de passiveringslaag, DBR, meerdere kwantumputten (MQW's) en zelfs de transparante elektroden van VCSEL's voor te bereiden.
ALD-technologieën voor de passiveringslaag van VCSEL's
ALD is toegepast voor de verbetering van de betrouwbaarheid van kwantumdots en LCD [31, 32, 70, 71], voor de passiveringslaag van VCSEL, de uniforme en dichte coating van de dunne film van ALD kan de betrouwbaarheid ervan vergroten. Het inbrengen van de dichte film als een oxide-passiveringslaag voor VCSEL's is erg belangrijk voor het beschermen van de holte van de VCSEL. Vroeger werden beschermende films meestal geplateerd met PECVD. Meestal is echter een dikke film vereist om de compactheid van de film te behouden, wat overmatige spanning veroorzaakt en de betrouwbaarheid van VCSEL's aantast. ALD-technologie kan Al2 . deponeren O3 dunne films met kenmerken die vergelijkbaar zijn met die van de passiveringslaag van VCSEL's, en de uniforme en dichte dunne film met coating kunnen de beschermingschip volledig isoleren. Zo is ALD gebruikt om PECVD te vervangen als het beste coatingproces voor de passiveringslagen van VCSEL's.
De betrouwbaarheid van de oxide-VCSEL's was zeer hoog in de 85/85-test (85 ° C en 85% relatieve vochtigheid, RH) vanwege de oxidatielaag van AlGaAs met een hogere Al-concentratie in vergelijking met de DBR-lagen. Een hogere Al-oxide-opening leidde tot corrosiedelaminatie aan het oxide-halfgeleiderinterface. Xie et al. toonde aan dat dislocatiegroei, grove scheuren en degradatie van het apertuuroppervlak voorkwamen in een significant percentage van oxide-VCSEL's die waren blootgesteld aan vocht [72]. Herrick et al. observeerde ook soortgelijke storingen als gevolg van blootstelling aan vocht in een kamer van 85/85 [73]. In de afgelopen twintig jaar hebben veel onderzoekers en bedrijven geïnvesteerd in onderzoek naar het voorkomen van veroudering in VCSEL-elementen veroorzaakt door het binnendringen van vocht en hebben ze een breed scala aan beschermende passieve film en lay-outontwerpwijzigingen voorgesteld. In 2004 stelde Agilent Technologies bijvoorbeeld voor om gaten in het polymeer te etsen en te vullen om blootstelling aan vocht te voorkomen [74]. In 2006 stelde Debrabander de mesa-passivatiefilm-pinhole-detectiemethode [75] voor, terwijl TrueLight in 2014 de SiON-passiveringsfilm [76] voorstelde. We noemen hier slechts enkele studies als voorbeeld. Deze studie gebruikte voornamelijk Al2 O3 films gegroeid door ALD en vormden een complex gestapeld voor vochtbestendige passiveringsfilms met PECVD-gegroeide SiNx . We hebben het experiment ontworpen en een vergelijkende studie uitgevoerd om de verbetering van de 85/85-testfout met de ALD-laag aan te tonen, en de resistente vochtdiëlektrische lagen van de VCSEL-structuur afgezet door PECVD en ALD werden respectievelijk aangeduid als apparaat A en apparaat B. .
Afbeelding 6 toont de structuur van de VCSEL, inclusief n-type DBR, MQW-lagen, een hoog Al-gehalte (~ 0,98) AlGaAs-oxide-apertuurlaag en p-type DBR-lagen. De volgende beschrijving heeft betrekking op de etiketten. De vochtbestendige passiveringslagen werden pas na oxidatie door ALD op de zijwand van apparaat B afgezet.
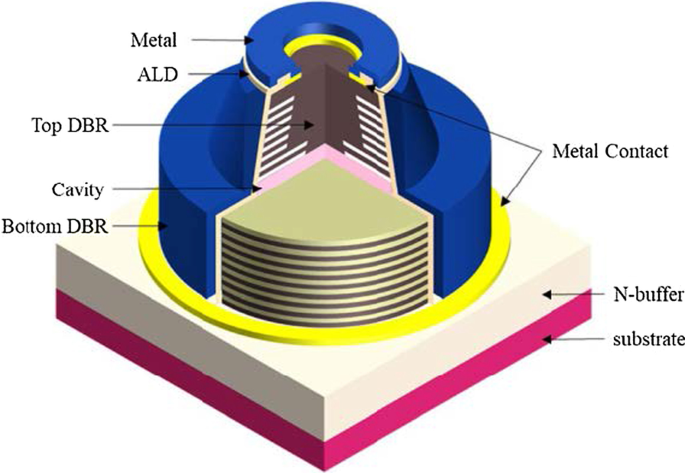
Schema van de VCSEL [42]
Tabel 1 toont de vergelijking van VCSEL's in dit werk en andere groepen. In dit werk zijn het LIV, S 21, oogdiagram en de WHTOL-levensduur (WHTOL) van VCSEL's met en zonder ALD bestudeerd, en deze resultaten laten zien dat ALD geen invloed had op de foto-elektrische en communicatie-eigenschappen van hoge- snelheid VCSEL's, maar de betrouwbaarheid van snelle VCSEL's verbeteren.
Zoals weergegeven in figuur 7, wordt de 53 Gb/s foutloze transmissie tot 100 m in GI single-mode fiber (SMF) onder pre-nadruk NRZ-OOK-modulatie verkregen met de 6 μm diameter van oxide-opening in de weinige -modus (FM) VCSEL. In dit werk is de techniek van ALD gebruikt om de betrouwbaarheid van FM VCSEL te verbeteren.

Oogdiagrammen van 53 Gb/s foutloze transmissie tot 100 m met de 6 μm diameter van oxide-opening in de VCSEL na ALD
De DC-, AC- en transmissieprestaties van apparaat B worden gedemonstreerd. Afbeelding 8a, b toont de lichtstroomcurve (L-I) en de kleinsignaalmodulatierespons van apparaat B bij 25 °C. Afbeelding 9 toont het pulsamplitudemodulatie-oogdiagram met 4 niveaus (PAM4) bij 56 Gb/s onder een bias van I = 8 mA bij 25 °C. Afbeelding 10a, b toont het aan-uit-toetsdiagram (OOK) met 28 Gb/s onder een bias van I = 8 mA van apparaat B bij 25°C en 75°C.
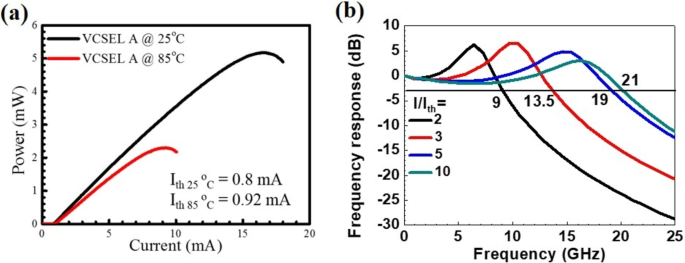
een Lichtstroomkarakteristieken van een 850 nm VCSEL bij 25 °C en 85 °C, b kleinsignaalmodulatierespons voor apparaat B bij 25 °C

Oogdiagram van PAM4-signaal verzonden door de 850 nm VCSEL met 56 Gb/s onder een bias van I = 8 mA bij 56 Gb/s bij 25 °C
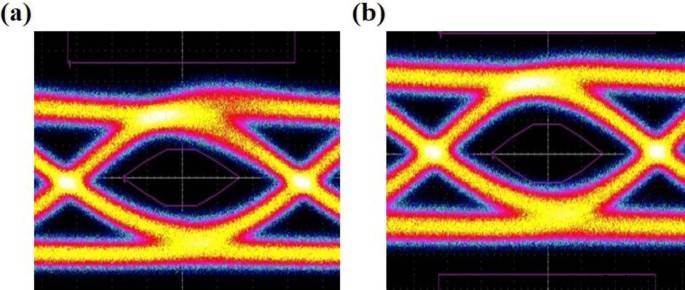
Oogdiagram van OOK-signaal verzonden door de 850 nm VCSEL met 28 Gb/s onder een bias van I = 8 mA bij a 25 °C en b 75 °C
Onderzoek naar de verbetering van de vochtbestendigheid door passivering van de Al2 O3 ALD-laag, twee apparaten gecoat met diëlektrische lagen werden gedefinieerd. In apparaat A bedekte de diëlektrische laag alleen SiNx , terwijl het in apparaat B Al2 . bedekte O3 ALD en SiNx samen. SiNx , polyimide, SiNx en metallisatie werden achtereenvolgens voltooid. 1e p-metaal vormde een ohms contact met het GaAs topmateriaal. 2e p-metaal is een bindingspad metaal. De complexe gestapelde passiveringsfilms bedekten het mesa-oppervlak in apparaat B efficiënt. Het pakket met verouderde apparaten werd voorbereid in open-can TO.
De omgevingsomstandigheden voor veroudering waren 85 ° C en 85% RV, met een 6 mA-bias voor een natte levensduur bij hoge temperaturen (WHTOL). De hoeveelheden input voor apparaten A en B waren respectievelijk 18 en 18. De resultaten worden weergegeven in Fig. 11. In apparaat A waren er vijf storingschips en storingen werden willekeurig binnen 500 uur gevonden. In tegenstelling tot apparaat B trad er tot 960 uur geen storing op. De resultaten worden getoond in Fig. 11a, b. Deze resultaten geven aan dat de door ALD gekweekte Al2 O3 ALD-film heeft een betere inkapseling op de mesa-zijwand dan alleen de PECVD-gegroeide SiNx film om het binnendringen van vocht te voorkomen.
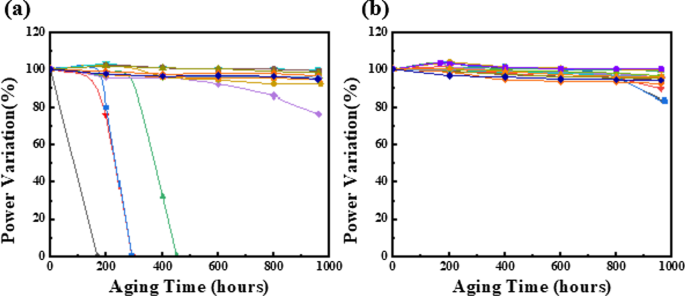
WHTOL-prestaties (85 °C/85% vochtigheid) van VCSEL-chips, a apparaat A, alleen SiNx als passiveringslaag, b apparaat B, Al2 O3 /SiNx als passiveringslagen
ALD-technologieën voor de DBR van VCSEL
De DBR van VCSEL-afzetting door ALD heeft het voordeel van een goede hechting met saffiersubstraat en een goede staat op het grensvlak van verschillende diëlektrische lagen van DBR [80]. Volgens de structuur van de VCSEL wordt de holte in de verticale richting van de laser gevormd door twee groepen spiegels die de actieve laag vastklemmen, en het licht wordt meerdere keren gereflecteerd tussen de p-DBR en n-DBR voordat het zich in de lucht voortplant . De structuur van de DBR bestaat uit twee soorten halfgeleidermaterialen met verschillende brekingsindices, en de periodieke dikte van de DBR moet nauwkeurig worden geregeld op λ/4 (λ geeft de middengolflengte aan). De ontwerp- en groeimethoden vormen de basis voor de fabricage van hoogreflecterende DBR. Voor een hoogwaardige DBR helpt het fase-interferentie-effect bij het versterken van het licht in de holte, terwijl de hoge reflectiviteit van DBR (> 99%) de drempelversterking en kwantumefficiëntie van VCSEL's aanzienlijk kan verbeteren. Om een hoge reflectiviteit, brede stopband en zachte faserespons te bereiken, moeten de perioden van de DBR tussen 20 en 40 liggen, en de materialen die bij de fabricage worden gebruikt, moeten een groot verschil in brekingsindex hebben. In dit geval hebben veel groepen gemeld dat AIA's/GaAs, Al2 O3 , HfO2 , SiO2 , enz., zijn geschikt voor de groei van DBR.
Er zijn verschillende groeimethoden voor DBR, waaronder moleculaire bundelepitaxie (MBE) en metaal-organische dampafzetting (MOCVD). ALD is echter ook een precieze groeimethode voor DBR. Omdat de door ALD bereide DBR met een lage dikte, hoge reflectiviteit en lage ruwheid de eigenschappen van VCSEL's effectief kan verbeteren, hebben veel onderzoekers technieken onderzocht om de DBR te verbeteren met behulp van ALD-technieken. In 1997 stelde Huffaker [81] bijvoorbeeld voor dat de spanning als gevolg van de lagere DBR kan worden verminderd door Alx te gebruiken. O1-x lagen waarvan de dikte kleiner was dan die van een kwartgolf. In 2013 Guo et al. [82] meldde dat het DBR gemaakt door het ALD-proces een betere kwaliteit heeft dan dat gemaakt door EBE, en dat de ALD-procestijd bijna hetzelfde is als het EBE-proces of zelfs minder. Bovendien is het voor het kweken van een DBR die is samengesteld uit ten minste twee of meer soorten materialen, in het algemeen nodig om de temperatuur regelmatig te verhogen en te verlagen in het EBE-proces, terwijl de temperatuur hetzelfde kan worden gehouden in het ALD-proces voor het afzetten van verschillende materialen. In 2017 meldde Liu [83] dat de ALD-methode zou kunnen worden toegepast om hoogwaardige lagen te maken met een scherpe interface en goede uniformiteit. ALD is dus geschikt voor het deponeren van hoogwaardige DBR.
Bijvoorbeeld Sakai et al. stelde de fabricage op de wafel voor van UV-C-laserdiodes (LD's) met geëtste spiegels met een door ALD gedeponeerde DBR, die bijdragen aan het verminderen van de stroomdichtheid van de laserdrempel. In deze studie werden vier perioden van HfO2 en Al2 O3 werden gedeponeerd met behulp van ALD voor de DBR. Al2 O3 werd gekozen als materiaal met een lagere brekingsindex omdat de afzettingssnelheid opmerkelijk hoger is dan die van SiO2 . Afbeelding 12 toont het TEM-beeld van DBR dat is gedeponeerd door ALD, wat de uitstekende dikte en kwaliteit van DBR laat zien.
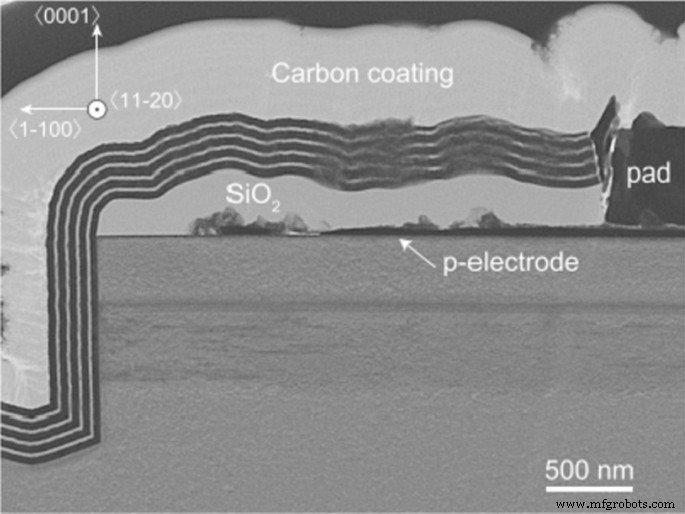
TEM-beeld van de DBR gedeponeerd bij ALD [84]
De techniek van MOCVD is op grote schaal gebruikt bij de afzetting van DBR voor vele voordelen, zoals nauwkeurige groeicontrole van film en de afzetting van hoogwaardige film. In het eigenlijke productieproces zal de interfaceconditie echter worden beïnvloed op het grensvlak van verschillende diëlektrische lagen van DBR; anders zou de ontwerpmethode van DBR een complexe optimalisatie vereisen, zoals de afzetting van nog een extra bufferlaag op het grensvlak van verschillende diëlektrische lagen. Afbeelding 13a toont de berekening van de transfermatrixmethode (TMM) voor de reflectiviteit van DBR met MOCVD zonder het inbrengen van een bufferlaag. De reflectiviteitsspectra van de HfO2 /Al2 O3 DBR gedeponeerd met ALD komen meer overeen met het berekende TMM-spectrum in Fig. 13b [85]. In dit geval kan de techniek van ALD DBR afzetten met een betere interface tussen verschillende diëlektrische lagen in vergelijking met MOCVD (Fig. 14).
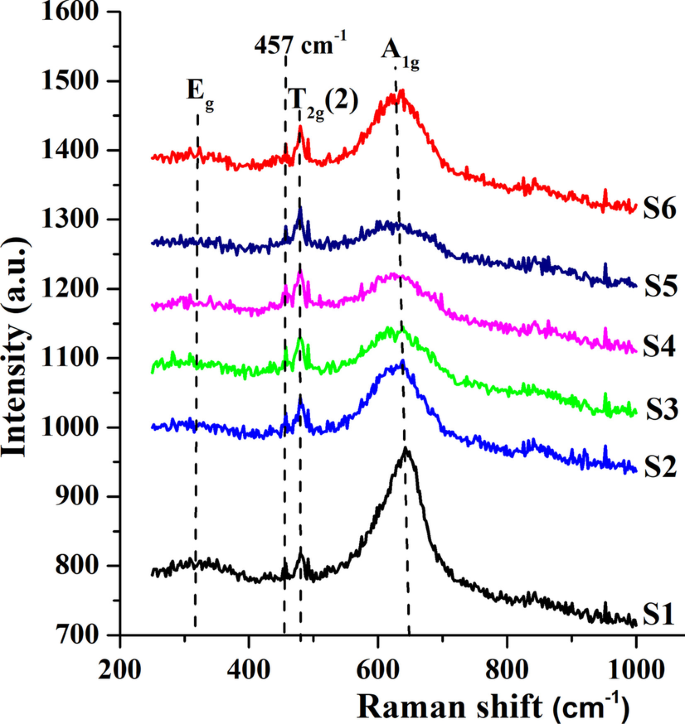
Gemeten en berekende reflectiespectra van de ontworpen DBR gedeponeerd met a MOCVD, b ALD [84, 85]
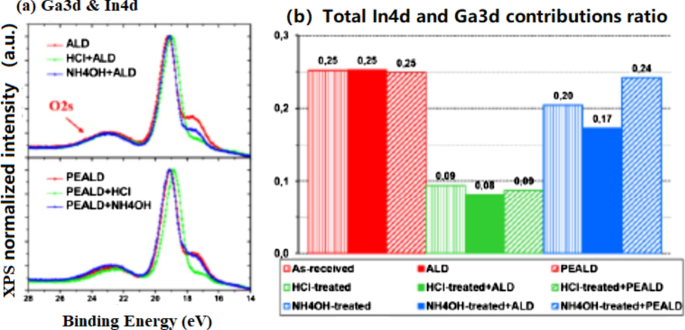
een Superpositie van genormaliseerde Ga3d-In4d-spectra voor ALD- en PEALD-monsters zonder, met HCl of met NH4 OH oppervlaktebehandeling, b Ga3d-In4d-verhoudingen voor dezelfde monsters in vergelijking met Al2 O3 vrije oppervlakken [86]
ALD-technologieën voor de meerdere kwantumbronnen van VCSEL's
Vanwege de hoge vereiste voor optische versterking in VCSEL's, gebruiken de meeste apparaten MQW's als het actieve gebied. In general, when the MQW period increases to a certain value, the threshold current density of the VCSEL is mainly caused by the following three factors. First, for the width of the quantum well, the active region cannot overlap with the peak position of the waveform. The farther the quantum well from the peak position, the lower is its gain efficiency. Therefore, distant quantum well regions cannot play a significant role in improving the optical gain. Second, there is a direct proportional relationship between the total transmittance current and period of MQWs. The total transmittance current increases with the MQW period because the transmittance current is a part of the threshold current of the device. Therefore, the threshold current of the device will increase with the transmittance current. Third, as the current increases, the slope of the optical gain to current curve will decrease, increasing the threshold current of the device. Hence, thin MQWs with high crystalline quality and optical properties are promising candidates for realizing VCSELs.
For the MQWs of VCSEL, ALD can optimize the interface properties and surface recombination of MQWs [80, 83,84,85]. In the last several decades, methods for optimizing MQWs using ALD have been studied. In 2008, Lo et al. reported the successful growth of high-quality ultraviolet (UV) AlGaN/GaN MQWs structures using ALD [87]. In the same year, Bosund et al. [88] proposed that a thick TiN passivation layer deposited by ALD on top of InGaAs/GaAs can significantly increase the photoluminescence intensity and carrier lifetime of the MQWs, while Li et al. reported that a low dislocation density ultraviolet (UV) AlGaN/GaN MQW structure can be grown using the ALD technique. In 2019, Lee et al. [89] proposed that the emission intensity of the 860 nm GaAs VCSEL with SiN anti-reflection film was significantly increased (compared to the VCSEL without the SiN anti-reflection film) to improve the light extraction efficiency of a VCSEL. Here, we cite a few studies as examples.
A deep understanding of semiconductor–dielectric interface properties will provide guidelines for optimizing efficient passivation solutions for InGaN/GaN-based µ-LEDs. To this end, quantum well (QW) semiconductors are of tremendous interest because many surface recombinations are likely to occur at the edges of the LED active regions and are probably responsible for the low µ-LED efficiencies. Thus, Le Maoult et al. [86] studied the X-ray photoemission (XPS) and wavelength dispersive X-ray fluorescence (WDXRF) characteristics of In0.1 Ga0.9 N surfaces after acid, base, or sulfur-based chemical treatments followed by ALD of Al2 O3 thin films with TMA/H2 O or TMA/O2 plasma (plasma-enhanced ALD) at 250 °C.
The ALD of Al2 O3 with H2 O as a weak oxidizer does not seem to significantly modify the InGaN surface. Indium depletion occurs as the In4d intensity decreases, as observed previously in the case of the HCI or NH4 OH-treated surfaces only (upper portion of Fig. 15a, b). On the contrary, during the PEALD of A12 O3 (strong oxidizer), the NH4 OH-treated surfaces changed compared to HCl because the In4d component level is indistinguishable from the PEALD reference (as illustrated by Fig. 15a, bottom, and 15b). Then, if indium is assumed to be the main species sensitive to plasma-induced oxidation, the indium-depleted surfaces after HCI treatment would indeed remain in a stable state of oxidation regardless of the ALD or PEALD process. On the contrary, a higher proportion of indium from the NH4 OH-treated surfaces is more likely to be oxidized by the plasma species.
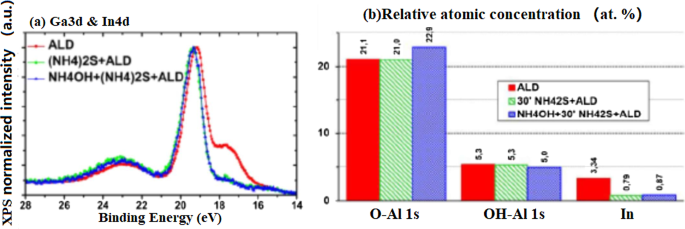
een Superposition of normalized Ga3d-In4d spectra for ALD and PEALD samples without, with a 30’ (NH4 )2 S or with a NH4 OH + 30’ (NH4 )2 S surface treatment, b proportion of O1s components and total indium contribution using In4d line [86]
If a 30' (NH4 )2 S surface treatment with or without prior treatment with NH4 OH is performed before ALD, the quantitative analysis seems to report (Fig. 15b) results similar to those observed previously without the alumina layer. As an example, a similar decrease in the indium proportion was observed (~ 75%). However, a slight increase in the O–Al-related component from the O1s line was observed for the sample that underwent the double surface treatment, probably owing to the increased surface hydrolysis by the first NH4 OH treatment. Thus, ALD does not seem to significantly modify the initial state of the (NH)S-treated surfaces. However, these results do not provide quantitative information regarding the proportion of sulfur after the deposition of Al2 O3 by ALD. Considering that sulfur was adsorbed on InGaN before deposition, further investigations are required to determine the evolution of sulfur bonds after ALD of Al2 O3 , especially if binding state differences with stronger oxidizing processes such as PEALD are evident.
ALD Technologies for the Transparent Electrode of VCSEL
For the transparent electrode of VCSEL, ALD can deposit the electrode with high transparency and good current spreading properties [90]. In terms of the current spreading of the conventional VCSEL, the metal electrode has good current spreading properties, but strongly absorbs the emitted light. Hence, the conventional VCSEL relies on the upper heavily-doped layer for current spreading. However, since the upper heavily-doped layer has poor current spreading performance and absorbs part of the emitted light, the light output power of the device is lowered. Therefore, a transparent conductive oxide (TCO) film deposited by ALD, exhibiting excellent photoelectric performance, can solve the current spreading problem described above.
Figure 16 shows the SEM images of ZnO films deposited on Si with ALD and CVD modes as the transparent conductive materials, which can be applied to new-generation photovoltaic devices. So far, there are few studies and reports on the application of TCO films in VCSEL devices. At present, the indium tin oxide (ITO) films are used in VCSEL devices. In 1997, C. L. Chua et al. [91] first reported the top-emitted VCSEL with a transparent tin oxide electrode. In this study, the peak transmittance of ITO is 96%. In 2002, Jiang et al. [92] studied the P-type ohmic contact of ITO as an 850 nm GaAs-based oxide restricted type VCSEL. In comparison with VCSELs with traditional Ti/Au contact, they found output power of the VCSEL with ITO contact is 1.27 times higher than the VCSEL with T/Au contact. In 2014, Meng et al. [93] found that the output power of the 850 nm GaAs oxide-confined VCSEL with an ITO transparent conductive film is 1.18 times higher than the traditional VCSEL.
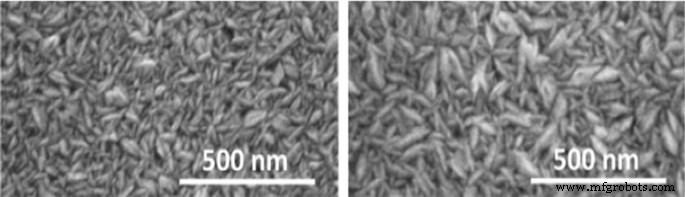
SEM images of ZnO films deposited on Si using ALD and CVD [90]
At present, the commonly used techniques for preparing TCO are magnetron sputtering, pulsed laser deposition, CVD, ALD, etc. However, it is difficult to achieve large-scale and large-area film formation using magnetron sputtering, the film deposited by pulsed laser deposition is uniform, and it is difficult to prepare large-area films while the deposition temperature for CVD is high, which renders it unsuitable for some devices that need to be prepared at low temperature. ALD possesses the advantage of highly controllable deposition parameters and the film deposited by it is characterized by good uniformity, absence of pinholes, and excellent shape preservation for film graphics. In this case, the oxide (TCO) film deposited by ALD can improve the properties of VCSELs.
Conclusions
This article reviews the application of ALD technology to the optoelectronic devices, µ-LEDs and VCSELs. Since sidewall damage is prominently observed in μ-LEDs when their sizes are reduced to the microscale level, this issue must be addressed to achieve high device performance. ALD sidewall passivation is a crucial technique because the sidewall damage can be reduced after passivating a surface with an ALD-grown dielectric. ALD passivation has also been found to help in protecting the quantum dot (QD) conversion layer in full-color displays. Different approaches involving the deposition of passivation layers have been established for reducing sidewall damage. In addition, an 85 °C/85% RH test with bias, which is a very difficult challenge for oxide-confined VCSEL devices, was conducted. In this study, we demonstrate that complex stacked dielectric layers as passivation films resist moisture ingress. The stacked passivation layers consist of Al2 O3 growth by ALD film and SiNx growth by PECVD film. A very good encapsulation that prevented damage from moisture and excellent reliability was observed. In addition, the effects of ALD on the accurate control of DBR growth are specified. This technique has also been found to enhance the optical properties of MQWs, such as the deposition of an anti-reflection layer for improving the light extraction efficiency of a VCSEL and the accurate control of the growth of MQWs for improving its crystalline quality. In addition, because the output power of the VCSEL with an ITO transparent conductive film exceeds that of the traditional VCSEL, this study addresses the potential applications of ALD for preparing the TCO films of VCSELs.
Beschikbaarheid van gegevens en materialen
The data used and analyzed during the current study are available from the corresponding authors upon reasonable request.
Afkortingen
- PECVD:
-
Plasma-enhanced chemical vapor deposition
- ALD:
-
Atomic layer deposition
- LED:
-
Light emitting diode
- VCSEL:
-
Vertical cavity surface emitting laser
- CVD:
-
Chemical vapor deposition
- PVD:
-
Physical vapor deposition
- GPC:
-
Growth per cycle
- HKMG:
-
High-K metal gate
- FinFET:
-
Fin field-effect transistor
- WVTR:
-
Water vapor transmission rate
- OLED:
-
Organic light-emitting diode
- MEMS:
-
Micro-electro mechanical systems
- μLED:
-
Micro-LED
- WHTOL:
-
Wet high-temperature operation life
- OOK:
-
On–off keying
- PAM4:
-
Amplitude modulation 4-level
Nanomaterialen
- Mitsubishi Chemical Advanced Materials streeft naar klimaatneutraliteit tegen 2023 en klimaatpositiviteit tegen 2030
- Bipolaire resistieve schakelkenmerken van HfO2/TiO2/HfO2 drielaagse structuur RRAM-apparaten op Pt- en TiN-gecoate substraten vervaardigd door atomaire laagafzetting
- Kenmerken van grensvlak-, elektrische en banduitlijning van HfO2 / Ge-stapels met in situ gevormde SiO2-tussenlaag door plasma-versterkte atomaire laagafzetting
- De antibacteriële polyamide 6-ZnO hiërarchische nanovezels vervaardigd door afzetting van atoomlagen en hydrothermische groei
- Fotokatalytische eigenschappen van Co3O4-gecoate TiO2-poeders bereid door plasma-versterkte afzetting van atoomlagen
- Fermi-niveau-afstemming van ZnO-films door middel van supercyclische atoomlaagafzetting
- Synthese en onderzoek van CuGeO3-nanodraden als anodematerialen voor geavanceerde natrium-ionbatterijen
- Afhankelijkheid van dikte van grensvlak- en elektrische eigenschappen in atoomlaag afgezet AlN op c-vlak GaN
- Een geavanceerd koelsysteem voor computers en batterijen
- Bekleding en vrije-vormafzetting voor het afsluiten van koelvloeistofkanalen
- SIGRABOND® Chemical CFRP voor componenten en samenstellingen



