ZrO2 ferro-elektrische veldeffecttransistoren mogelijk gemaakt door de schakelbare zuurstofleegstanddipolen
Abstract
Dit artikel onderzoekt de effecten van post-rapid thermal anneal (RTA) en de dikte van ZrO2 op de polarisatie P en elektrische kenmerken van TaN/ZrO2 /Ge-condensatoren en FeFET's, respectievelijk. Na de RTA variërend van 350 tot 500 °C, TaN/ZrO2 /Ge condensatoren met 2,5 en 4 nm dikke amorfe ZrO2 film exposeren de stabiele P . Er wordt voorgesteld dat het ferro-elektrische gedrag voortkomt uit de migratie van de spanningsgestuurde dipolen gevormd door de zuurstofvacatures en negatieve ladingen. FeFET's met 2,5 nm, 4 nm en 9 nm ZrO2 demonstreer het fatsoenlijke geheugenvenster (MW) met 100 ns programmeer-/wispulsen. Een 4-nm dikke ZrO2 FeFET heeft aanzienlijk verbeterde vermoeidheids- en retentiekenmerken vergeleken met apparaten met 2,5 nm en 9 nm ZrO2 . De retentieprestaties van de ZrO2 FeFET kan worden verbeterd met de verhoging van de RTA-temperatuur. Een MW van ~ 0,46 V wordt geëxtrapoleerd om gedurende 10 jaar te worden gehandhaafd voor het apparaat met 4 nm ZrO2 .
Achtergrond
Gedoteerd poly-HfO2 ferro-elektrische veldeffecttransistoren (FeFET's) hebben veel belangstelling gewekt voor toepassingen met niet-vluchtig geheugen (NVM) vanwege hun CMOS-procescompatibiliteit [1]. Hoewel de fatsoenlijke elektrische prestaties zijn aangetoond in gedoteerde HfO2 gebaseerde FeFET's [2], kwellen nog steeds enkele fundamentele beperkingen hun praktische toepassingen, waaronder het hoge thermische budget van 500 °C annealing dat nodig is om orthorhombische kristalfasen te vormen en de ongewenste lekstroom langs de korrelgrenzen met het verkleinen van de ferro-elektrische dikte. Ferro-elektriciteit is op grote schaal waargenomen in een verscheidenheid aan verschillende materialen, bijvoorbeeld Sb2 S3 nanodraden [3], GaFeO3 film [4], LaAlO3 -SrTiO3 film [5] en amorf Al2 O3 die nanokristallen bevatten [6, 7]. Onlangs hebben we de FeFET's gerapporteerd met gedeeltelijk gekristalliseerd ZrO2 poortisolator functioneert als NVM en analoge synaps [8]. Hoewel de ZrO2 transistors vertoonden behoorlijke elektrische prestaties met de dunnere dikte in vergelijking met de gerapporteerde gedoteerde HfO2 , het onderliggende mechanisme voor de ferro-elektriciteit in ZrO2 film blijft onduidelijk. Het is van cruciaal belang om de oorsprong van de schakelbare polarisatie P . op te helderen voor het evalueren van de prestatielimiet van ZrO2 FeFET's.
In dit werk, TaN/ZrO2 /Ge FeFET's met isolatoren van 2,5 nm, 4 nm en 9 nm dik worden gefabriceerd. De schakelbare P in TaN/ZrO2 Er wordt voorgesteld dat de /Ge-condensator afkomstig is van de migratie van spanningsgestuurde zuurstofvacatures en negatieve ladingen. De effecten van ZrO2 dikte en de post-rapid thermal annealing (RTA) op de P van TaN/ZrO2 /Ge en het geheugenvenster (MW), uithoudingsvermogen en retentiekenmerken van FeFET's worden onderzocht.
Methoden
FeFET's met ZrO2 poortisolator werden vervaardigd op 4-in. n-Ge(001) substraat met een soortgelijk proces in [8, 9]. Na de pre-gate reiniging in de verdunde HF (1:50) oplossing, werden Ge wafers geladen in een atomaire laag depositie (ALD) kamer. ZrO2 films met diktes van 2,5 nm, 4 nm en 9 nm werden gedeponeerd bij 250 ° C met behulp van TDMAZr en H2 O als voorlopers van respectievelijk Zr en O. Een 100 nm dikke TaN-poortelektrode werd afgezet door reactief sputteren. Na de vorming van de poortelektrode werden de source/drain (S/D)-regio's geïmplanteerd door BF2 + in een dosis van 1 × 10 15 cm −2 en een energie van 20 keV. Een totaal van 15 nm nikkel (Ni) S/D-contacten werden gevormd door een lift-off-proces. Ten slotte werd de RTA bij 350, 450 en 500 °C gedurende 30 s uitgevoerd.
Figuur la toont het schema van de gefabriceerde transistor. Figuur 1b–d toont de transmissie-elektronenmicroscoop (TEM) beelden van de TaN/ZrO2 /Ge-samples met 2,5, 4 en 9 nm dikke ZrO2 , respectievelijk. Alle monsters ondergingen gedurende 30 seconden een RTA bij 500 °C. De 2,5 nm ZrO2 monster blijft een isolatiefilm na het uitgloeien. Voor het 4 nm-monster, hoewel sommige nanokristallen worden waargenomen, ZrO2 blijft een amorfe laag. Terwijl volledige kristallisatie optreedt voor de 9 nm ZrO2 film. Met name een grenslaag (IL) van GeOx bestaat tussen de ZrO2 en Ge-kanaalgebied, hoewel het te dun is om te worden waargenomen in de TEM-afbeeldingen.
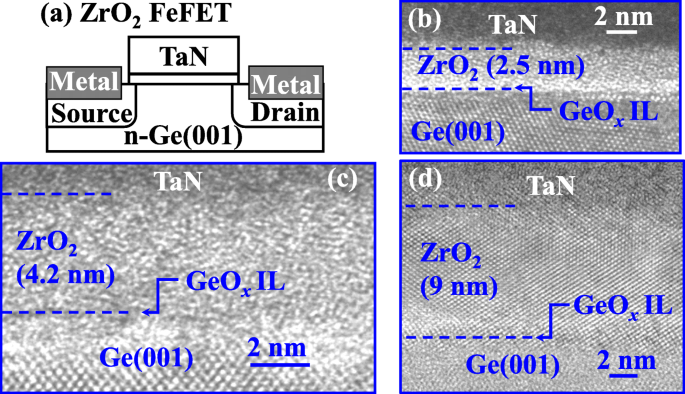
een Schema van de gefabriceerde TaN/ZrO2 /Ge FeFET. b , c , en d HRTEM-beelden van de TaN/ZrO2 /Ge-stacks met verschillende ZrO2 diktes. De monsters ondergingen een RTA bij 500 °C gedurende 30 s
Resultaten en discussie
Afbeelding 2 toont de P vs. spanning (V ) krommen voor de TaN/ZrO2 /Ge condensatoren met verschillende ZrO2 diktes en verschillende gloeitemperaturen. De ononderbroken lijnen met verschillende kleuren vertegenwoordigen de kleine lussen met verschillende zwaaiende spanningsbereiken (V bereik ). De meetfrequentie is 1 kHz. De 2,5 nm en 4 nm ZrO2 apparaten kunnen stabiele ferro-elektriciteit vertonen na een RTA bij 350 ° C. Figuur 3 plot het overblijfsel P (P r ) als functie van de vegende V bereikcurves voor de condensatoren gegloeid bij verschillende temperaturen.

Gemeten P vs. V kenmerken van de TaN/ZrO2 /Ge condensatoren met verschillende ZrO2 diktes en verschillende gloeitemperaturen
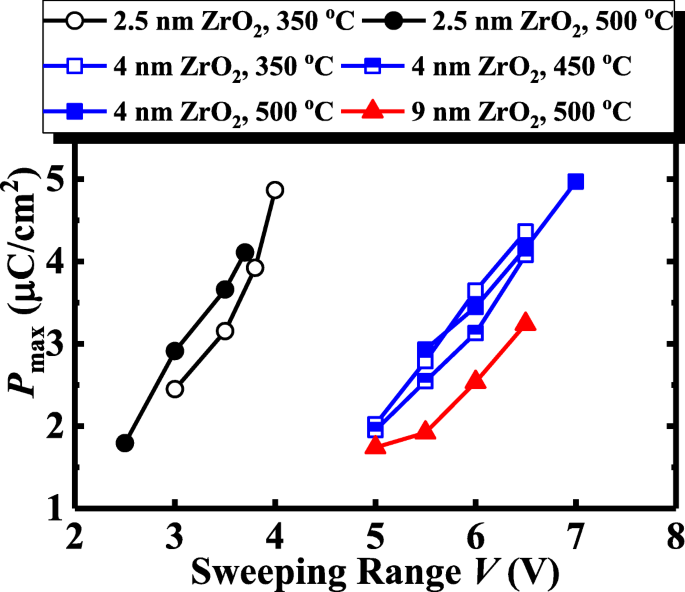
Vergelijking van P max als een functie van V bereik voor de TaN/ZrO2 /Ge condensatoren met verschillende ZrO2 diktes en verschillende gloeitemperaturen
Afbeelding 3 toont de vergelijking van P max als een functie van V bereik voor de TaN/ZrO2 /Ge condensatoren met de verschillende ZrO2 diktes en de verschillende RTA-temperaturen. Voor de 4 nm ZrO2 apparaten, naarmate de gloeitemperatuur stijgt van 350 tot 450 °C, een grotere V bereik is vereist om een vaste P . te verkrijgen max . Dit wordt toegeschreven aan het feit dat de hogere uitgloeitemperatuur de dikkere grensvlaklagen (IL's) produceert tussen bij Ge/ZrO2 en ZrO2 /TaN-interfaces, wat leidt tot een grotere uniforme capaciteitsequivalentdikte (CET). Voor de 2,5 nm ZrO2 condensatoren, heeft het monster met 500 °C annealing een lagere V bereik dan het 350 °C gloeimonster met dezelfde P max . Hoewel de IL's dikker worden met de verhoogde RTA-temperatuur, zijn sommige ZrO2 werd verbruikt door het wegvangen van zuurstof en interdiffusie op het grensvlak. Voor de zeer dunne ZrO2 apparaat, de laatste is dominant. Vergeleken met de 2,5 nm ZrO2 condensator, een veel grotere V bereik is vereist om een vergelijkbare P . te bereiken max . De 9 nm ZrO2 condensator vertoont niet de hogere V bereik in vergelijking met het 4 nm-apparaat. Dit komt door het kristal ZrO2 die een veel hogere κ . heeft waarde dan de amorfe film, die de CET van het 9 nm-apparaat aanzienlijk vermindert.
Figuur 4a toont de geëxtraheerde evolutie van de positieve en negatieve P r , aangegeven met respectievelijk \( {P}_{\mathrm{r}}^{+} \)en \( {P}_{\mathrm{r}}^{-} \), voor de 4 nm- dikke ZrO2 condensatoren met RTA bij verschillende temperaturen boven 10 6 veegcycli gemeten bij 1 kHz. Apparaten die zijn uitgegloeid bij 350 ° C en 450 ° C vertonen het duidelijke wake-up-effect. Er wordt geen activering of afdruk waargenomen voor de 4 nm ZrO2 ferro-elektrische condensator onderging gloeien bij 500 ° C. Figuur 4b vergelijkt de P r als functie van veegcycli voor de apparaten met de verschillende ZrO2 diktes. De 4 nm ZrO2 ferro-elektrische condensator bereikt verbeterde stabiliteit van P r uithoudingsvermogen vergeleken met de 2.5 nm- en 9 nm-apparaten tijdens de 10 6 duurtest.

een P r vs. het aantal ms-puls-zwaaicycli voor 4 nm ZrO2 condensatoren met verschillende RTA-temperaturen. b P r vs. aantal ms-puls-zwaaicycli voor de ZrO2 condensatoren na gloeien bij 500 °C
De schakelende P wordt waargenomen in amorf ZrO2 capaciteit, en er wordt geconcludeerd dat het mechanisme anders moet zijn dan dat van de gerapporteerde gedoteerde poly-HfO2 ferro-elektrische films. We stellen voor dat het onderliggende mechanisme voor ferro-elektrisch gedrag gerelateerd is aan de zuurstofvacature-dipolen. Het is algemeen bekend dat, naarmate TaN-metaal wordt afgezet, de Ta-zuurstofvangende lagen de zuurstofvacatureconcentratie in ZrO2 zullen verhogen. [10]. Zuurstofvacatures verschijnen ook op de ZrO2 /Ge-interface. Figuur 5 toont het schema van de schakelbare P in TaN/ZrO2 /Ge afkomstig van de migratie van zuurstofvacatures en negatieve ladingen om de positieve en negatieve dipolen te vormen. Er wordt gespeculeerd dat de negatieve ladingen in ZrO2 zijn gerelateerd aan de Zr-vacature [11], die vergelijkbaar is met die in Al2 O3 filmpje [12]. De migratie van de spanningsgestuurde zuurstofvacatures is op grote schaal aangetoond in resistieve willekeurig toegankelijke geheugenapparaten [13, 14]. Dit is met name de eerste demonstratie van niet-vluchtige transistors met drie aansluitingen die worden gedomineerd door de spanningsgestuurde zuurstofvacatures.
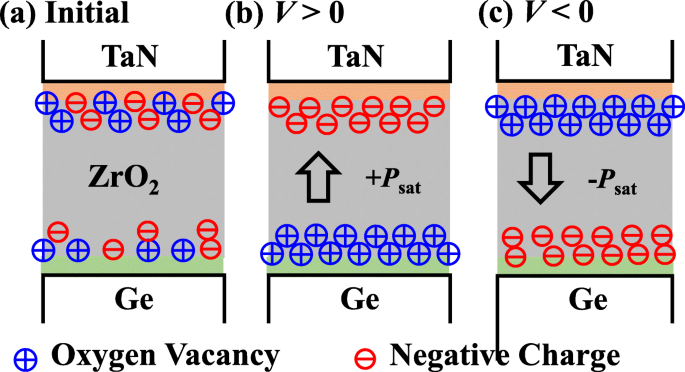
Schema's van het mechanisme voor schakelbare P in ZrO2 condensatoren, wat wordt toegeschreven aan de migratie van spanningsgestuurde zuurstofvacatures en negatieve ladingen om dipolen te vormen
De P-V hysterese schakelt de ZrO2 . in FeFET's om een groot en stabiel MW te verkrijgen voor de embedded NVM (eNVM) toepassingen. Afbeelding 6 toont de gemeten I DS -V GS krommen van 2,5, 4 en 9 nm ZrO2 FeFET's voor de twee polarisatietoestanden met 1 μs program/erase (P/E) voorwaarden. De transistoren werden uitgegloeid bij 500 °C. Programmeren (wissen) wordt bereikt door positieve (negatieve) spanningspulsen toe te passen op de poort van de ZrO2 FeFET's, om de drempelspanning te verhogen (verlagen) (V TH ). V TH is gedefinieerd als V GS bij 100 nA·W/L, en MW wordt gedefinieerd als de maximale verandering in V TH . Alle FeFET's met verschillende ZrO2 diktes hebben de MW boven 1 V met 1 μs P/E pulsen. Om een vergelijkbaar MW te bereiken, is een hogere wisspanning nodig voor de 9 nm ZrO2 FeFET vergeleken met de andere twee transistoren. Het is te zien dat een grotere magnitude wissen V GS is vereist om de ongeveer gelijke verschuiving van I-V . te verkrijgen ten opzichte van de initiële curve vergeleken met het programma V GS . Er wordt gespeculeerd dat de zuurstofvacatures die bijdragen aan de P komen voornamelijk uit de reactie tussen TaN en ZrO2 , zoals de begintoestand van het apparaat in Fig. 5a. Als een positieve V GS (programma) wordt toegepast, diffunderen de zuurstofvacatures en hopen zich op in de laag nabij de ZrO2 /Ge-interface (Fig. 5b), waar de verdeling van de zuurstofvacature-dipolen behoorlijk verschilt van de oorspronkelijke toestand. Het is dus gemakkelijk om de I-V . te verschuiven curve naar een hogere |V TH | met een positieve V GS . Echter, als een negatieve V GS (wissen) wordt toegepast, brengt de terugdiffusie van zuurstofvacatures de poortstapel terug naar zijn oorspronkelijke staat (figuur 5c). Dus de grootte van de negatieve wissen V GS moet worden verhoogd om de equivalente verschuiving van I-V . te bereiken naar het positieve programma V GS .
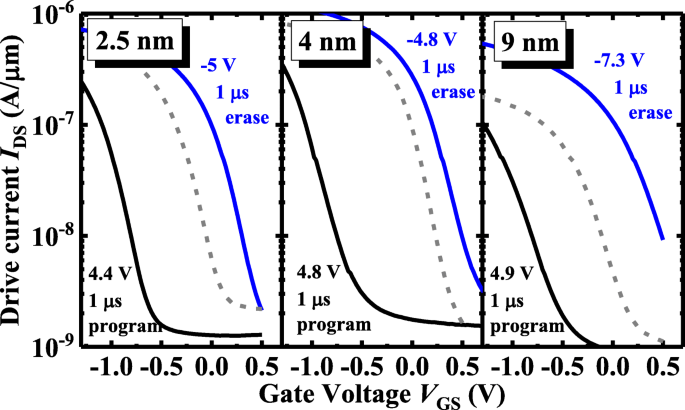
Gemeten I DS -V GS krommen van de 2,5, 4 en 9 nm dikke ZrO2 FeFET's voor de initiële en twee polarisatietoestanden met 1 μs P/E-pulsen
Omdat de P/E-pulsbreedte wordt teruggebracht tot 100 ns, zal de ZrO2 FeFET's demonstreren nog steeds de fatsoenlijke MW, zoals getoond in figuur 7a. Vooral de transistor met 2,5 nm ZrO2 gegloeid bij 350 ° C bereikt een MW van 0,28 V. Figuur 7b plot MW versus cyclusnummer voor de FeFET's met verschillende ZrO2 diktes met 100 ns P/E pulsconditie. De 4 nm ZrO2 apparaat behaalt aanzienlijk verbeterde duurzaamheidsprestaties in vergelijking met de 2,5 nm en 9 nm ZrO2 FeFET's, die het duidelijke wekeffect en vermoeidheid vertonen binnen 10 3 cycli.
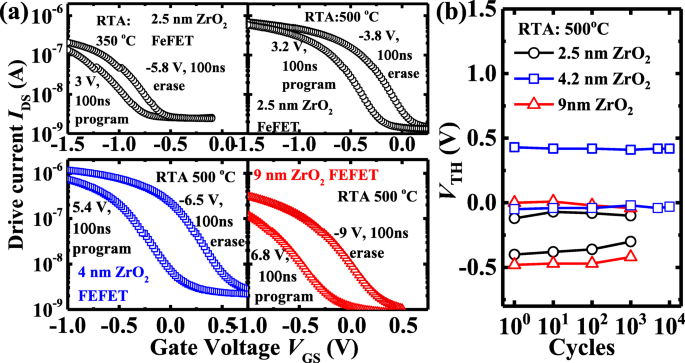
een Ik DS -V GS krommen van de 2,5, 4 en 9 nm dikke ZrO2 FeFET's voor de twee polarisatietoestanden met 100 ns P/E-pulsen. De apparaten ondergingen een RTA bij 500 °C. b FeFET met 4 nm ZrO2 heeft een verbeterd uithoudingsvermogen vergeleken met de 2,5 en 9 nm ZrO2 transistoren
Tot slot de retentietesten van de ZrO2 FeFET's wordt gekarakteriseerd en getoond in Fig. 8 en 9. Figuur 8a toont de evolutie van I DS -V GS krommen voor de twee polarisatietoestanden van de 4 nm ZrO2 FeFET's ondergingen RTA bij 350, 450 en 500 ° C. De ladingsvangst leidt tot de vermindering van de apparaten met de tijd. Zoals getoond in figuur 8b, kunnen de retentieprestaties van de apparaten worden verbeterd met de verhoging van de RTA-temperatuur. Een MW van ~ 0,46 V wordt geëxtrapoleerd om over 10 jaar te worden gehandhaafd. Figuur 9 vergelijkt de retentiekenmerken van de FeFET's met verschillende ZrO2 diktes. De 4 nm ZrO2 apparaat heeft een verbeterde retentieprestatie vergeleken met de transistors met 2,5 en 9 nm dik ZrO2 .
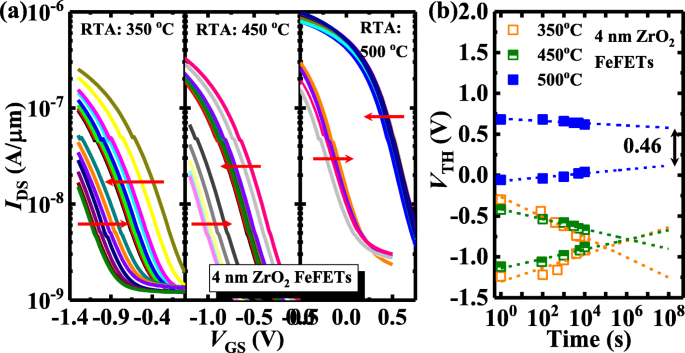
een De evolutie van I DS -V GS krommen voor de twee polarisatietoestanden van de 4 nm ZrO2 FeFET's met verschillende RTA-temperaturen. b De 4 nm ZrO2 apparaat gegloeid bij 500 ° C heeft een veel betere retentieprestatie vergeleken met de transistors met RTA bij lagere temperaturen
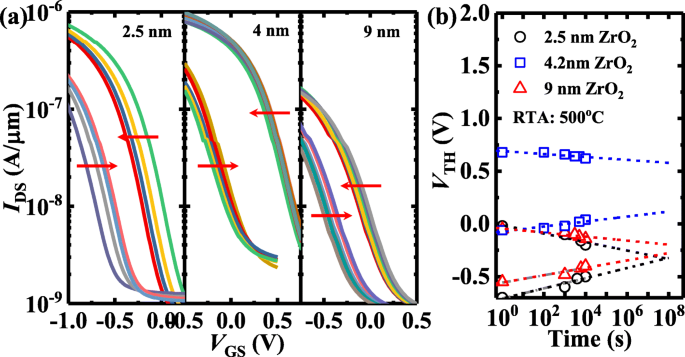
een De evolutie van I DS -V GS krommen voor de twee polarisatietoestanden voor de 2,5, 4 en 9 nm dikke ZrO2 FeFET's ondergingen een RTA bij 500 ° C. b De 4 nm ZrO2 apparaat heeft een verbeterde retentieprestatie vergeleken met de transistors met 2,5 en 9 nm dik ZrO2
Conclusies
Samengevat, amorf ZrO2 ferro-elektrische condensatoren zijn experimenteel gedemonstreerd en er wordt gespeculeerd dat de ferro-elektriciteit het gevolg is van de migratie van de spanningsgestuurde dipolen gevormd door de zuurstofvacatures en negatieve ladingen. FeFET's met 2,5 nm, 4 nm en 9 nm ZrO2 hebben de MW boven 1 V met 1 μs P/E pulsen. De verbeterde vermoeidheids- en retentiekenmerken worden verkregen in de 4 nm dikke ZrO2 FeFET in vergelijking met de apparaten met 2,5 nm en 9 nm ZrO2 . De retentietest geeft aan dat de 4 nm ZrO2 transistor behoudt een geëxtrapoleerde 10-jarige MW van ~ 0,46 V.
Beschikbaarheid van gegevens en materialen
De datasets die de conclusies van dit artikel ondersteunen, zijn in het artikel opgenomen.
Afkortingen
- RTA:
-
Snel thermisch gloeien
- IL:
-
Tussenlaag
- TaN:
-
Tantaalnitride
- FeFET:
-
Ferro-elektrische veldeffecttransistors
- TDMAZr:
-
Tetrakis (dimethylamido) zirkonium
- Ge:
-
Germanium
- ZrO2 :
-
Zirkoniumdioxide
- ALD:
-
Atoomlaagafzetting
- HF:
-
Fluorwaterstofzuur
- BF2 + :
-
Boorfluoride-ion
- MW:
-
Geheugenvenster
- NVM:
-
Niet-vluchtig geheugen
- P r :
-
Resterende polarisatie
- TEM:
-
Transmissie elektronenmicroscoop
- Ni:
-
Nikkel
- P max :
-
Maximale polarisatie
- RTA:
-
Terugbetaald thermisch gloeien
- V bereik :
-
Groot spanningsbereik
Nanomaterialen
- Web-enabled DDS, het IoT en de cloud
- Transistors, junction field-effect (JFET)
- Transistors, Insulated-gate Field-effect (IGFET of MOSFET)
- Junction Field-effect Transistors
- Insulated-gate Field-effect Transistors (MOSFET)
- Inleiding tot Junction Field-effect Transistors (JFET)
- Inleiding tot veldeffecttransistoren met geïsoleerde poort
- De toxiciteit van reactieve zuurstofsoorten afstemmen op geavanceerde tumortherapie
- Multi-Layer SnSe Nanoflake Field-Effect Transistors met Au Ohmic-contacten met lage weerstand
- Effect van in situ gloeibehandeling op de mobiliteit en morfologie van op TIPS pentaceen gebaseerde organische veldeffecttransistoren
- De voordelen van on-site zuurstofproductie



