Ferro-elektrisch-achtig gedrag afkomstig van zuurstofgebrek dipolen in amorfe film voor niet-vluchtig geheugen
Abstract
Traditionele ferro-elektrische apparaten hebben een gebrek aan schaalbaarheid. Gedoteerde HfO2 dunne film is veelbelovend om het schaalprobleem op te lossen, maar wordt uitgedaagd door de hoge lekstroom en uniformiteitsproblemen door de polykristallijne aard. Stabiel ferro-elektrisch gedrag wordt eerst gedemonstreerd in een 3,6 nm dik amorf Al2 O3 film. De amorfe Al2 O3 apparaten zijn zeer schaalbaar, waardoor multi-gate non-volatile field-effect transistor (NVFET) met vinafstand op nanometerschaal mogelijk is. Het heeft ook de voordelen van een lage procestemperatuur, een hoge frequentie (~GHz), een breed geheugenvenster en een lange levensduur, wat wijst op een groot potentieel in VLSI-systemen. De schakelbare polarisatie (P ) geïnduceerd door de spanningsgemoduleerde dipolen voor zuurstofvacatures wordt voorgesteld.
Achtergrond
Ferro-elektrisch willekeurig toegankelijk geheugen (FeRAM) op basis van conventionele perovskiet-ferro-elektriciteit (bijv. PZT) is een van de commerciële niet-vluchtige geheugens (NVM's) [1], hoewel het niet kan worden geschaald en niet CMOS-compatibel. Ferro-elektriciteit werd op grote schaal waargenomen in een verscheidenheid aan verschillende materialen, zoals aortawanden van varkens [2], Sb2 S3 nanodraden [3], GaFeO3 film [4], gedoteerd poly-HfO2 films [5], nanokristallijne hydroxyapatietfilms [6] en LaAlO3 -SrTiO3 filmpje [7]. Onder deze materialen, gedoteerd-HfO2 films hebben speciale interesse gewekt voor de NVM-toepassing vanwege hun CMOS-procescompatibiliteit. Maar de polykristallijne structuur is onvermijdelijk om ferro-elektriciteit te genereren in gedoteerd HfO2 , waardoor de toepassing van het apparaat als volgt werd overwonnen:1) het is onverenigbaar met de gate-last-verwerking met betrekking tot het thermische budget van 500 ° C dat nodig is om orthorhombische kristalfasen te vormen [8]; 2) stroomverbruik wordt veroorzaakt door ongewenste lekstroom langs de korrelgrenzen, die exponentieel toeneemt samen met het verkleinen van de ferro-elektrische dikte. Onlangs stelde een theoretische studie voor dat de extra ferro-elektriciteit in dik poly-HfO2 (>5 nm) kunnen afkomstig zijn van de lange-afstandscorrelaties in de assemblage van elektrische dipolen gecreëerd door zuurstofvacatures [9]. Er werd waargenomen dat het defecte ladingsvang-/detrapping-mechanisme het ferro-elektrisch-achtige gedrag produceerde in een 5 nm dik amorf Al2 O3 voor een multi-state geheugen, dat echter lijdt aan een zeer lage trapping/detrapping-frequentie (bijv. ~500 Hz) [10].
In dit werk wordt stabiel ferro-elektrisch gedrag aangetoond in een 3,6 nm dik amorf Al2 O3 film, waarbij de schakelbare polarisatie (P ) wordt voorgesteld te worden geïnduceerd door de spanningsgemoduleerde zuurstofvacature-dipolen. De amorfe Al2 O3 film heeft de voordelen van een lage procestemperatuur en de werkfrequentie tot ~ GHz, die multi-gate non-volatile field-effect transistor (NVFET) met nanometer-schaal fin pitch mogelijk maken. Al2 O3 NVFET-geheugen met een pulsbreedte van 100 ns voor programma/wis (P/E) spanningen en meer dan 10 6 P/E cycli uithoudingsvermogen is aangetoond. De effecten van elektroden en filmdikte op de P in Al2 O3 Ook condensatoren worden onderzocht. De amorfe niet-vluchtige apparaten laten een veelbelovende toekomst zien in VLSI-geheugens.
Methoden
Amorf Al2 O3 films werden gekweekt op Si(001), Ge(001) en TaN/Si-substraten door atomaire laagafzetting (ALD). TMA en H2 O-damp werd gebruikt als de voorlopers van respectievelijk Al en O. Tijdens de depositie werd de substraattemperatuur op 300°C gehouden. Verschillende metalen topelektroden, waaronder TaN/Ti, TaN en W, werden afgezet op Al2 O3 oppervlakken door reactief sputteren. Condensatoren met verschillende elektroden werden vervaardigd door middel van lithografiepatronen en droog etsen. Snelle thermische uitgloeiing (RTA) bij 350 ° C gedurende 30 seconden werd uitgevoerd. NVFET's met TaN/Al2 O3 gate-stack werden gefabriceerd op Ge (001). Na poortvorming werden source/drain (S/D)-regio's geïmplanteerd door BF2 + met een dosis van 1 × 10 15 cm -2 en een energie van 20 keV, en 20 nm dikke nikkel S/D-metaalelektroden werden vervolgens gevormd door het opstijgproces. Figuur 1a en b tonen de schema's van de gefabriceerde Al2 O3 condensator en de p-kanaal NVFET. Er is een grenslaag (IL) tussen de elektrode en de Al2 O3 film. Figuur 1c en d tonen de hoge resolutie transmissie-elektronenmicroscoop (HRTEM) beelden van de TaN/Al2 O3 /Ge stapels met verschillende amorfe Al2 O3 diktes (t AlO ) na een RTA bij 350 °C.
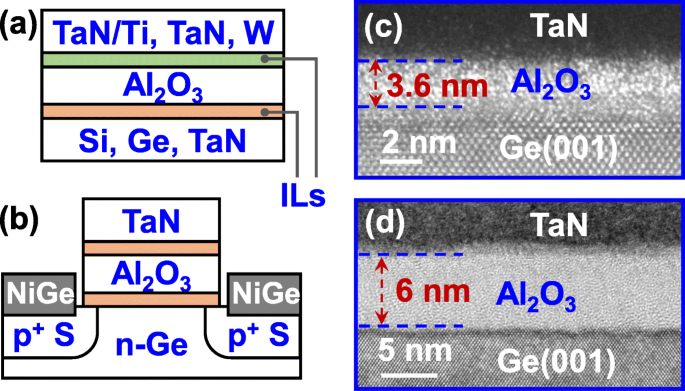
Schema's van de gefabriceerde a Al2 O3 condensatoren met verschillende elektroden en b Al2 O3 NVFET. c en d HRTEM-beelden van de gefabriceerde TaN/Al2 O3 /Ge stapels met verschillende t AlO , met de amorfe Al2 O3 films na een RTA bij 350 °C
Resultaten en discussie
Figuur 2 toont de gemeten P vs. spanning V kenmerken voor het amorfe Al2 O3 condensatoren met verschillende t AlO en verschillende boven- en onderelektroden. De meetfrequentie is 1 kHz. Zoals getoond in Fig. 2a-c, met een vaste 3,6 nm van t AlO , TaN/Al2 O3 /Ge condensator bereikt een hogere verzadiging P (P zat ) vergeleken met de apparaten met TaN/Ti- en W-topelektroden. Het ferro-elektrisch-achtige gedrag is sterk gecorreleerd met grensvlakken, en er wordt voorgesteld dat de vorming van TaAlOx IL tussen TaN en Al2 O3 produceert meer zuurstofvacatures, wat bijdraagt aan een sterkere schakeling P , vergeleken met de TiAlOx en WAlOx IL's. P-V krommen in Fig. 2d geven aan dat TaN/Al2 O3 /TaN condensator heeft een veel hogere P zat in vergelijking met TaN/Al2 O3 /Ge, wat wordt toegeschreven aan het feit dat dubbele TaAlOx IL's zorgen voor een hogere zuurstofvacatureconcentratie. Terwijl P zat is significant lager dan die met Si-bodemelektrode (Fig. 2e), vergeleken met de Ge-elektrode. Dit resultaat geeft aan dat Al2 O3 /Si-interfacekwaliteit is beter, d.w.z. minder zuurstofvacatures, vergeleken met die van het apparaat op basis van Ge-substraat. Afbeelding 2f toont de P-V krommen van een TaN/Al2 O3 (6 nm)/Ge-condensator, met een hogere V c en een bijna identieke P zat in vergelijking met dat van het apparaat met 3,6 nm Al2 O3 film in Fig. 2b. Opgemerkt wordt dat de reden voor de niet-gesloten P -V lussen is omdat er inderdaad een lekkage is. Er werd gemeld dat de grote offset bij een elektrisch veld van nul altijd optrad met een groot veld, en altijd geleidelijk verdween met het kleinere bereik van V [11, 12].
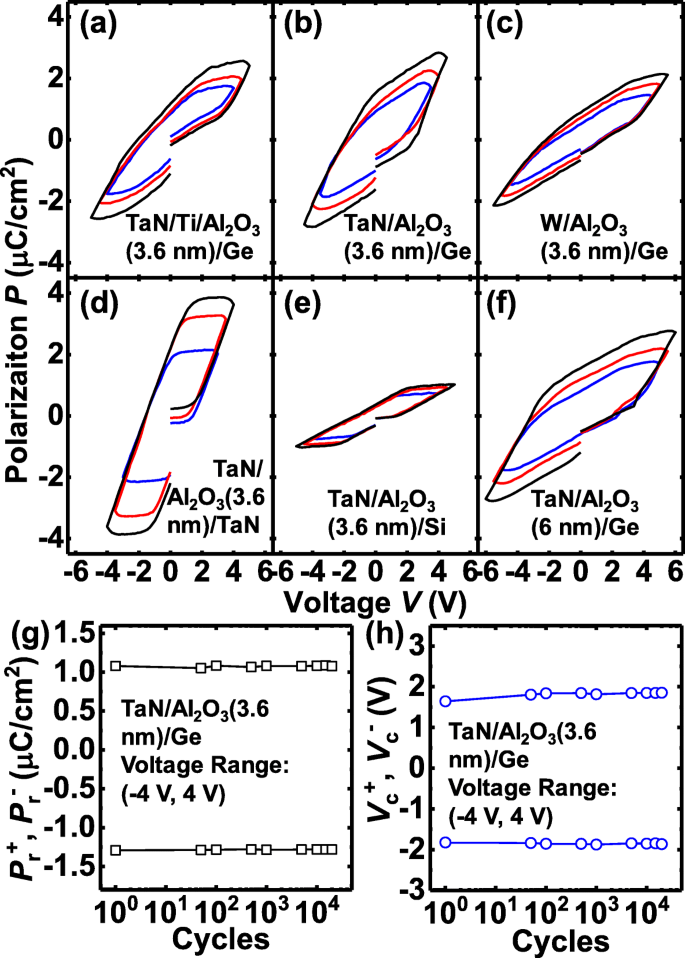
Gemeten P vs. V kenmerken van de Al2 O3 condensatoren met verschillende elektroden. een , b , en c met de P -V krommen van TaN/Ti/Al2 O3 /Ge, TaN/Al2 O3 /Ge, en W/Al2 O3 /Ge, respectievelijk, met een 3,6-nm t AlO . d en e waaruit blijkt dat de P zat wordt verbeterd (gereduceerd) door TaN(Si) als bodemelektrode te gebruiken in plaats van Ge. v TaN/Al2 O3 (6 nm)/Ge condensator heeft een hogere V c en een soortgelijke P zat vergeleken met het 3,6 nm dikke apparaat in b . g en h Duurmetingen die geen achteruitgang van P . tonen r en V c waargenomen na 10 4 veegcycli voor een TaN/Al2 O3 (3,6 nm)/Ge-condensator
Figuur 2g en h tonen de geëxtraheerde evolutie van het positieve en negatieve overblijfsel P (P r ) en dwingen V (V c ) waarden, respectievelijk meer dan 10 4 veegcycli voor een TaN/Al2 O3 /Ge condensator. Er wordt geen wakker-, afdruk- of vermoeidheidseffect waargenomen. V c van het apparaat is ~1.8 V, wat aangeeft dat de E in de Al2 O3 film is 4~6 MV/cm en kan in de IL's meer dan 8 MV/cm bedragen, wat hoog genoeg is om de zuurstofvacatures aan te drijven [13, 14]. P zat van de apparaten varieert van 1 tot 5 μC/cm 2 , overeenkomend met een redelijke zuurstofconcentratie in het bereik van 3~15×10 12 cm -2 ervan uitgaande dat ze de leiding hebben over plus twee.
Het onderliggende mechanisme voor ferro-elektrisch gedrag geassocieerd met zuurstofvacatures in Al2 O3 apparaten wordt besproken. De migratie van de spanningsgestuurde zuurstofvacatures is op grote schaal aangetoond in resistieve willekeurig toegankelijke geheugenapparaten [15, 16]. Figuur 3 toont het schema van de schakelbare P in TaN/Al2 O3 /Ge, dat afkomstig is van de scheiding van spanningsgemoduleerde zuurstofvacatures en negatieve ladingen om de elektrische dipolen te vormen. Het is redelijk om te concluderen dat de beweegbare zuurstofvacatures voornamelijk ontstaan door de vorming van TaAlOx IL en bevinden zich in de begintoestand in de buurt van de bovenste interface (figuur 3a). Figuur 3b en c geven aan hoe de positieve en negatieve P worden gevormd, respectievelijk met de modulatie van de zuurstofvacature en negatieve ladingsdipolen onder de aangelegde spanning. Röntgenfoto-elektronenspectra (XPS) van Al2 O3 /Ge en (Ti, TaN en W)/Al2 O3 /Ge-monsters worden gemeten en weergegeven in Fig. 4). Voor al het metaal/Al2 O3 /Ge monsters, er is een metaaloxide IL gevormd tussen metaal en Al2 O3 , die worden voorgesteld als het reservoir van zuurstofionen en vacatures, wat consistent is met Ref. [17].
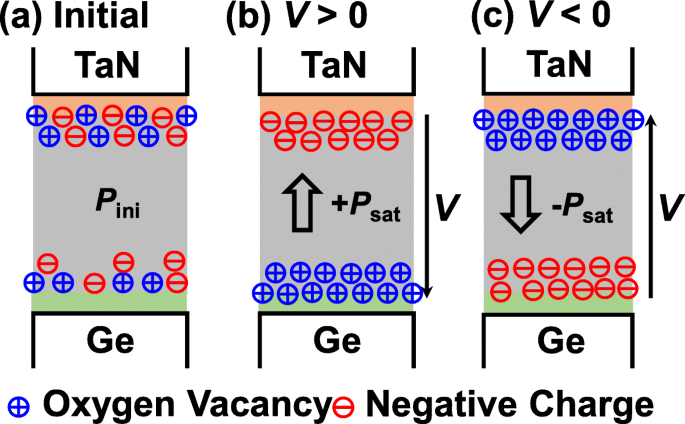
Schema's van het mechanisme voor ferro-elektrisch-achtig gedrag in Al2 O3 condensatoren. Schakelbare P is te wijten aan de migratie van zuurstofvacatures en negatieve ladingen om dipolen te vormen

Kernniveau XPS-spectra van a Al2 O3 /Ge, b TaN/Al2 O3 /Ge, c Ti/Al2 O3 /Ge, en d W/Al2 O3 /Ge voorbeelden
Om de elektrische prestaties van Al2 . te karakteriseren O3 NVFET als NVM, programma (wissen) wordt bereikt door positieve (negatieve) spanningspulsen aan de poort toe te passen, om de drempelspanning (V) te verhogen (verlagen) TH ). Figuur 5a laat zien hoe de lineaire-regio-overdrachtskarakteristieken van de Al2 O3 NVFET-verschuiving ten opzichte van de initiële I DS -V GS curve gemeten met ±4 V programmeer (wis) spanningen met een pulsduur van 100 ns. Hier, V TH wordt gedefinieerd als een V GS bij 100 nA⋅W/L, en MW wordt gedefinieerd als de maximale verandering in V TH . De Al2 O3 NVFET verkrijgt een MW van 0,44 V, hoewel amorf Al2 O3 film heeft kleinere P r dan de gerapporteerde gedoteerde HfO2 films [5, 8]. Opgemerkt wordt dat de hoge werkfrequentie tot 10 MHz van Al2 O3 NVFET-geheugen, wat indicatief is voor die schakelbare P in Al2 O3 komt voort uit de migratie van spanningsgestuurde zuurstofleegte om dipolen te vormen, niet van defecten die lading vangen/detrappen. Er werden afwisselend programma- en wispulsen toegepast op de Al2 O3 apparaten om het uithoudingsvermogen van het apparaat verder te bestuderen. Figuur 5b toont de grafieken van V TH vs. P/E-cyclusnummer, wat suggereert dat een stabiel MW kan worden gehandhaafd zonder een significante achteruitgang van meer dan 10 6 P/E-cycli voor een 3,6 nm dikke Al2 O3 NVFET.
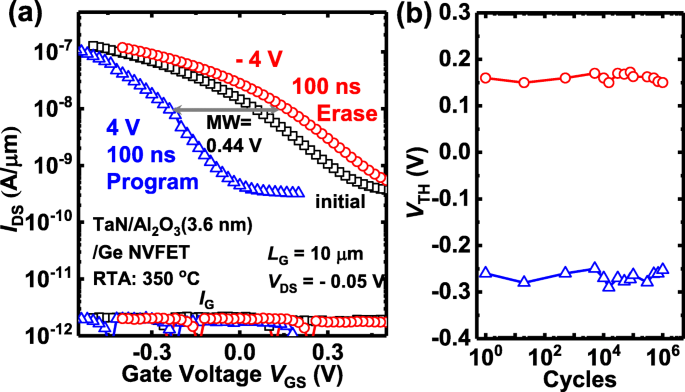
een Gemeten I DS -V GS krommen van een 3,6 nm dikke Al2 O3 NVFET voor de initiële en twee polarisatietoestanden. Er wordt een MW van 0,44 V verkregen. b Duurmeting toont aan dat er geen MW-degradatie wordt waargenomen na 10 6 P/E-cycli
Met name het ferro-elektrische gedrag dat wordt waargenomen in het amorfe Al2 O3 apparaten kunnen worden uitgebreid tot de universele amorfe oxiden, bijv. hafniumoxide (HfO2 ) en zirkoniumoxide (ZrO2 ).
Conclusies
Stabiel ferro-elektrisch gedrag wordt voor het eerst gerealiseerd in condensatoren met een dun amorf Al2 O3 isolator. Schakelbare P in amorf Al2 O3 condensatoren wordt gedemonstreerd door P-V loops en NVFET-test. Er wordt voorgesteld dat het ferro-elektrische gedrag afkomstig is van de zuurstofvacatures en ionendipolen van het grensvlak. De 3,6 nm dikke Al2 O3 NVFET bereikt een MW van 0,44 V en meer dan 10 6 cyclusduurzaamheid onder ± 4 V bij 100 ns P/E-conditie. Al met al opende dit werk een nieuwe wereld voor amorfe oxide-ferro-elektrische apparaten, die veelbelovend zijn voor NVFET's met meerdere poorten (vinvormig, nanodraad of nanosheet) met mogelijk nano-geschaalde vinpitch in VLSI-systemen.
Beschikbaarheid van gegevens en materialen
De datasets die de conclusies van dit artikel ondersteunen, zijn in het artikel opgenomen.
Afkortingen
- Al2 O3 :
-
Aluminiumoxide
- ALD:
-
Atoomlaagafzetting
- BF2 + :
-
Boorfluoride-ion
- E c :
-
Gedwongen elektrisch veld
- Ge:
-
Germanium
- GeOx :
-
Germaniumoxide
- HRTEM:
-
Transmissie-elektronenmicroscoop met hoge resolutie
- Ik DS :
-
Afvoerstroom
- MOSFET's:
-
Metaaloxide-halfgeleider veldeffecttransistoren
- MW:
-
Geheugenvenster
- Ni:
-
Nikkel
- NVFET:
-
Niet-vluchtige veldeffecttransistor
- P r :
-
Resterende polarisatie
- P zat :
-
Verzadigingspolarisatie
- RTA:
-
Terugbetaald thermisch gloeien
- TaAlOx :
-
Tantaal aluminiumoxide
- t AlO :
-
Dikte aluminiumoxide
- TaN:
-
Tantaalnitride
- V GS :
-
Poortspanning
- V TH :
-
Drempelspanning
- XPS:
-
Röntgenfoto-elektronenspectra
Nanomaterialen
- Een slimmer geheugen voor IoT-apparaten
- Niet-vluchtige geheugenfamilie verhoogt de dichtheid
- Sluitertijdtester voor filmcamera's
- Antifog pc-film voor vizieren, lenzen en brillen
- Verwarmde diëlektroforese voor uitgelijnde enkelwandige koolstof nanobuisfilm met ultrahoge dichtheid
- Amorfe silicium nanodraden gegroeid op siliciumoxidefilm door gloeien
- Magnetische koolstofmicrosferen als herbruikbaar adsorbens voor het verwijderen van sulfonamide uit water
- Een eenvoudige aanpak voor het synthetiseren van fluorescerende koolstofkwantumstippen uit tofu-afvalwater
- Solvay folie op epoxybasis voor prepregs
- Sensorfilm voor ruimtevaart
- Nieuwe methode maakt computergeheugen van titaniumoxide



