Herstelprestaties van met gedoteerde verticale GaN Schottky-barrièrediodes
Abstract
Verticale GaN Schottky-barrièrediodes (SBD's) werden vervaardigd op Ge-gedoteerde vrijstaande GaN-substraten. De kristalkwaliteit van de SBD's werd gekarakteriseerd door kathodeluminescentiemeting en de dislocatiedichtheid werd bepaald als ~ 1.3 × 10 6 cm − 2 . Met de uitgevoerde elektrische prestatiemetingen tonen de SBD's een lage inschakelspanning V aan (0,70~0,78 V) en hoge stroom I aan /Ik uit verhouding (9,9 × 10 7 ~1.3 × 10 10 ). De kenmerken van het omgekeerde herstel werden onderzocht. De omgekeerde hersteltijd werd verkregen als 15,8, 16,2, 18,1, 21,22 en 24,5 ns voor respectievelijk de SBD's met een diameter van 100, 200, 300, 400 en 500 μm. Ondertussen vertonen de omgekeerde hersteltijd en de omgekeerde herstellading beide een significante positieve correlatie met het elektrodegebied.
Inleiding
Onlangs heeft een halfgeleider met brede bandafstand, zoals GaN, met de inherente voordelen, enorme onderzoeksaandacht getrokken voor de volgende generatie elektronische apparaten, met name op het gebied van hoge frequentie, hoog vermogen en hoge prestaties [1,2,3 ,4,5,6]. Ondertussen, dankzij de ontwikkelingen van hydride dampfase-epitaxie (HVPE), lage dislocatiedichtheid (≤ 10 6 cm − 2 ) GaN-substraten zijn nu in de handel verkrijgbaar [7,8,9,10]. Vergeleken met laterale apparaten, worden apparaten van het verticale type die met deze substraten zijn vervaardigd, beschouwd als een meer geavanceerde structuur die bevorderlijk is voor het bereiken van een grotere stroom, minder lekpad en betere betrouwbaarheid voor het systeem [11, 12]. Onder hen is op GaN gebaseerde Schottky-barrièrediode (SBD) een essentieel onderdeel in de schakelapparatuur. Verschillend van een bipolaire diode, vermindert de SBD met zijn unipolaire aard het opslageffect van minderheidsdragers aanzienlijk en biedt dienovereenkomstig een hoge schakelsnelheid met een laag terugwinningsverlies. Er zijn echter maar weinig groepen die een systematische studie hebben uitgevoerd naar de reverse recovery-kenmerken voor verticale GaN SBD's [13,14,15,16,17], waarvan de studies meer gericht waren op de vergelijking van de schakeltijd in apparaten met verschillende structuren. Er is dus nog steeds dringend behoefte aan een diepgaand onderzoek naar het mechanisme van herstelprestaties voor GaN SBD's, vooral voor de verticale.
Ondertussen, aangezien de ohmse contacttechniek continu is onderzocht om de prestaties van apparaten te verbeteren in veel gepubliceerde artikelen [18], is zwaar gedoteerde n-type GaN een belangrijke schakel voor het vervaardigen van nitride-apparaten. De laatste tijd wordt Ge voorgesteld als een alternatief voor Si-doteringsstof in GaN, omdat beide een vergelijkbaar kenmerk hebben van onzuiverheid op een laag niveau (de activeringsenergie is naar verluidt respectievelijk 20 en 17 meV voor Ge en Si) en de veroorzaakte roostervervorming door Ge-atomen die substitueren in Ga-sites zouden kleiner zijn vanwege hun nauwere ionische stralen [19, 20]. Aangenomen wordt dat de Ge-doping een gladder oppervlak vormt met minder defecten [21, 22]. Bovendien, met de lagere roostervervorming en filmspanning, toont deze doping ook een belofte in elektronische apparaten op hoge temperatuur die meer nadruk leggen op de thermische stabiliteit. Hoewel de Ge-gedoteerde GaN theoretisch is bestudeerd, is het essentieel om de werkelijke impact op het betreffende apparaat te onderzoeken. In dit artikel worden de nieuwe verticale GaN SBD's gefabriceerd op Ge-gedoteerde vrijstaande (FS) GaN-substraat voorgesteld. De verticale GaN SBD's vertonen een superieure kristalkwaliteit en elektronische eigenschappen. Ondertussen worden de herstelprestaties van verticale SBD's systematisch onderzocht. De omgekeerde hersteltijd en omgekeerde herstellading laten uiteindelijk een significante positieve correlatie zien met het elektrodegebied.
Methoden en experimenten
Het schema van apparaatstructuren voor de gefabriceerde SBD's wordt weergegeven in Fig. 1a, die voornamelijk bestaat uit een 390 μm FS n + -GaN-substraat en een 9-μm n − -GaN driftlaag. In dit werk wordt de (0001)-georiënteerde GaN-substraatlaag met een Ge-concentratie van 1 × 10 18 cm − 3 en een dislocatiedichtheid van 1 × 10 6 cm − 2 werd gekweekt door HVPE. En de ongedoteerde epitaxiale laag op dit substraat werd gekweekt door metaal-organische chemische dampafzetting, met een groeisnelheid van ~ 2 μm/h. Voor SBD-fabricage werden Ti/Al/Ni/Au ohmse contacten gevormd op het achteroppervlak van het GaN-substraat. Ni / Au Schottky-elektroden werden gevormd op het vooroppervlak van de epitaxiale laag met vijf verschillende diameters (100, 200, 300, 400 en 500 m), zoals weergegeven in figuur 1b. Meer informatie over het fabricageproces is te vinden in ons vorige rapport [23, 24].
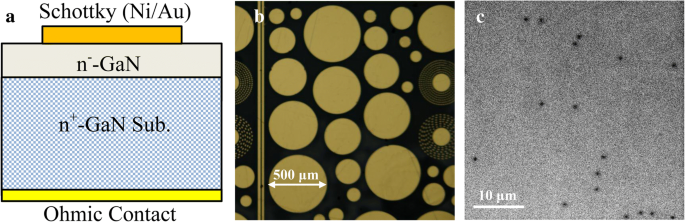
een Schematische dwarsdoorsnede van de gefabriceerde verticale SBD. b Optische microscopie opname van de verschillende elektroden. c Panchromatisch CL-beeld van de epitaxiale laag
De kathodoluminescentie (CL) beelden werden verkregen met behulp van een Quanta 400 FEG scanning elektronenmicroscoop (SEM) met een 10 kV versnellende spanning om de ruimtelijke verdeling van dislocatiedichtheid voor de epitaxiale laag te bestuderen. Capaciteit-spanning (C-V ) en stroom-spanning (I-V ) metingen werden uitgevoerd met behulp van een Keithley 4200 halfgeleiderparameteranalysator om de elektronische eigenschappen van de SBD's te evalueren. En temperatuurafhankelijke metingen werden uitgevoerd in het bereik van 300 tot 500 K met een aangepaste experimentele opstelling.
Resultaten en discussie
Het CL-resultaat van de epitaxiale laag wordt weergegeven in figuur 1c. Aangezien wordt aangenomen dat de dislocatie een niet-radiatief recombinatiecentrum is, verschijnt deze op het CL-beeld in de vorm van een donkere vlek. Aangezien er geen merkbaar verschil in ruimtelijke verdeling wordt waargenomen, werd de gemiddelde waarde van de dislocatiedichtheid berekend als ~ 1.3 × 10 6 cm − 2 , waarbij de CL-metingen in verschillende regio's werden uitgevoerd. Dit resultaat geeft aan dat er een hoogwaardige epitaxiale laag is verkregen voor verticale SBD's.
Omdat de verticale SBD's in een parallelle modus werden gekarakteriseerd, werd de C-V en G-V curven werden verkregen met een frequentie van 1 MHz. De resultaten van de SBD's worden weergegeven in respectievelijk Fig. 2a en b, waarbij (1/C 2 ) versus aangelegde spanning V is uitgezet in de inzet. Hier, dragerconcentratie N d kan worden geëvalueerd met de uitdrukking:\( {N}_d=\frac{-2}{A^2 q\varepsilon \left[d\left(1/{C}^2\right)/ dV\right]} \), waarbij A is het gebied van Schottky-elektroden, q is de elektronenlading (1,602 × 10 − 19 C), en ε is de diëlektrische constante van GaN (8.854 × 10 − 11 V/m). Vandaar dat de N d van de epitaxiale laag werd bepaald als ~ 6.2 × 10 15 cm − 3 . En de fasehoek θ kan ook worden berekend met de volgende vergelijking:\( \theta ={\tan}^{-1}\left(\frac{2\pi fC}{G}\right) \), waarbij f is de toegepaste frequentie, C is de capaciteit, en G is de gemeten geleidbaarheid (poortlekkage). Aangezien de resultaten voor verschillende diameters vergelijkbaar zijn, is de berekende hoek θ versus aangelegde spanning V van de SBD's met een diameter van 300 m wordt als voorbeeld weergegeven in de inzet van figuur 2b. Merk op dat de θ zeer dicht bij 90 ° is, bevestigt dit dat in deze studie een uitstekende Schottky-poort met een laag lekpad wordt bereikt. De J-V kenmerken worden ook weergegeven in Fig. 2c. Het is duidelijk te zien dat de I aan /Ik uit verhoudingen zijn 3,8 × 10 9 , 5,9 × 10 8 , 1,3 × 10 10 , 6.5 × 10 8 , en 9,9 × 10 7 voor respectievelijk de SBD's met een diameter van 100, 200, 300, 400 en 500 μm, waarvan de I aan en ik uit worden gedefinieerd als de stroom bij de poortspanning van respectievelijk 1,6 en − 2 V. Na lineaire montage is de inschakelspanning V aan van verticale SBD's wordt bepaald op respectievelijk 0,70, 0,76, 0,72, 0,70 en 0,78 V, waarbij de elektrodediameters toenemen van 100 tot 500 m. Deze resultaten geven aan dat er een goede elektronische eigenschap is verkregen voor de verticale SBD's.
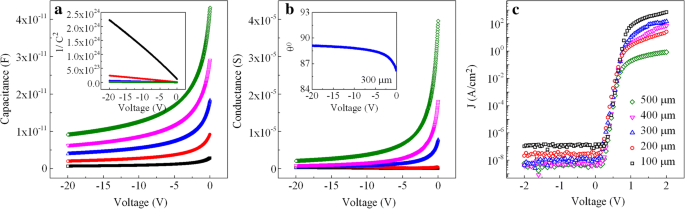
een Kamertemperatuur C-V curve van verticale SBD's voor elke verschillende elektrode met een frequentie van 1 MHz. De inzet is een plot van (1/C 2 ) versus spanning V . b G-V curve van verticale SBD's voor elke verschillende elektrode. De inzet is een plot van fasehoek θ versus spanning V voor SBD's met een diameter van 300 m. c J-V curve van verticale SBD's voor elke verschillende elektrode
Een typisch testcircuit werd gebruikt om de omgekeerde herstelkarakteristieken van de verticale SBD's te meten, zoals weergegeven in figuur 3a. De periodieke blokgolfspanningssignalen (van +-20 tot -20 V) werden achtereenvolgens toegepast op een te testen apparaat (DUT), waar een parasitaire inductor de magnetische energie zou opslaan en de stroom zou beïnvloeden. Wanneer het spanningssignaal verandert, kan gedurende de periode een oscillatiestroom plaatsvinden. Een hogesnelheidsstroomsonde met een Tektronix MDO 4104-3-oscilloscoop werd geplaatst voor het detecteren van de tijdelijke stroomvariatie in de verticale SBD's. Aangezien de schematische golfvorm van omgekeerde herstelstroom wordt getoond in Fig. 3b, wordt in deze studie t een wordt gedefinieerd als de opslagtijd terwijl t b wordt gedefinieerd als de vertragingstijd van de tegenstroom. En de omgekeerde hersteltijd T rr wordt gedefinieerd als de tijd dat de tegenstroom zich herstelt tot 10% van de maximale tegenstroom I RM , wat de som is van t een en t b . En de terugvorderingstoeslag Q rr wordt verkregen door de tegenstroom te integreren tot T rr wat overeenkomt met de geaccumuleerde lading in een diode.

een Het testcircuit dat wordt gebruikt om de omgekeerde herstelkarakteristieken van verticale SBD's te meten. b Schematische golfvorm van omgekeerde herstelkarakteristieken van verticale SBD's
Afbeelding 4 toont de omgekeerde herstelcurve van verticale SBD's voor elke elektrodediameter wanneer de aangelegde spanning overschakelde van +-20 naar -20 V. Hier, voor de SBD's met een diameter van 100, 200, 300, 400 en 500 μm , de T rr waarden werden verkregen als 15,8, 16,2, 18,1, 21,22 en 24,5 ns, terwijl de Q rr waarden werden geïntegreerd om respectievelijk 0,0127, 0,0536, 0,150, 0,280 en 0,405 nC te zijn. Deze verticale apparaten vertoonden allemaal een snelle schakeltijd (minder dan 25 ns). Er wordt ook een aanzienlijk lage tegenstroom waargenomen in de resultaten, wat te wijten kan zijn aan de kleinere hoeveelheid opgeslagen lading in de SBD's [13]. Ondertussen is ook duidelijk te zien dat de waarde van T rr en Q rr beide nemen toe samen met de vergroting van de elektrodediameters, en de kleinste toont de snelste T rr van 15,8 ns.
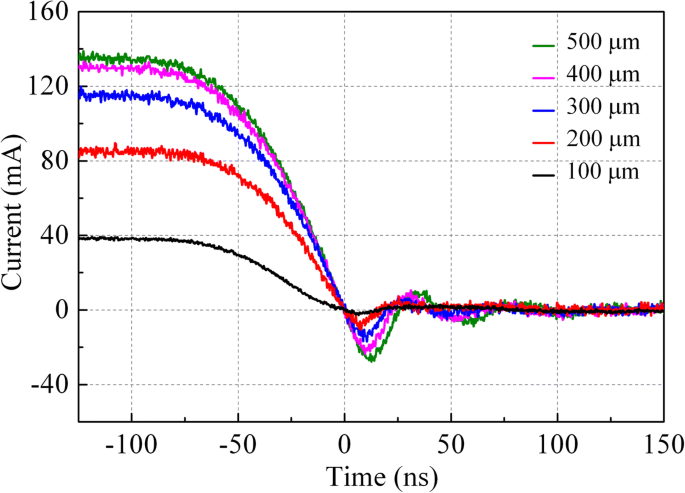
Omgekeerde herstelstroom van verticale SBD's voor elke verschillende elektrode
Om het mechanisme dat aan die veranderingen ten grondslag ligt verder te onderzoeken, werden de verticale SBD's ook gemeten wanneer de spanning overschakelde van +-10 naar -10 V. Als de omgekeerde hersteltijd T rr versus de diodediameter d is uitgezet in Fig. 5, de waarde van T rr voor elke diode was niet merkbaar veranderd. De terugvorderingstoeslag Q rr versus de d wordt tegelijkertijd weergegeven in Fig. 6, waar de gegevens van twee curven naar dezelfde trend wijzen. Ondertussen is het opmerkelijk dat de Q rr van beide tests blijkt een significant positieve correlatie met de d 2 , dat wil zeggen, het elektrodegebied.
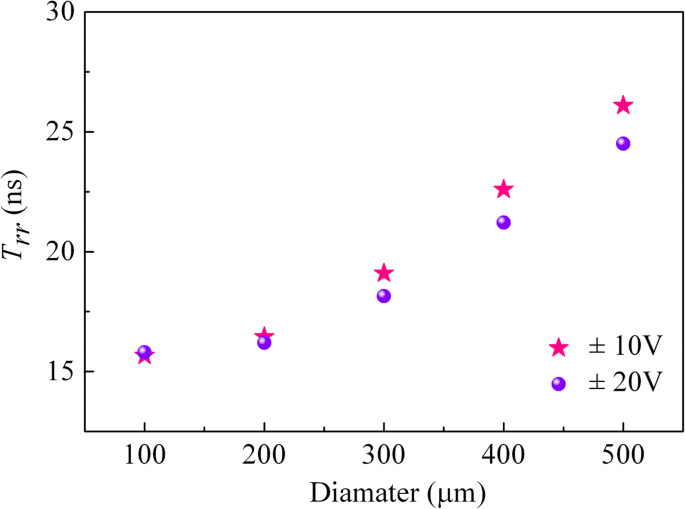
Omgekeerde hersteltijd T rr versus elektrodediameter d
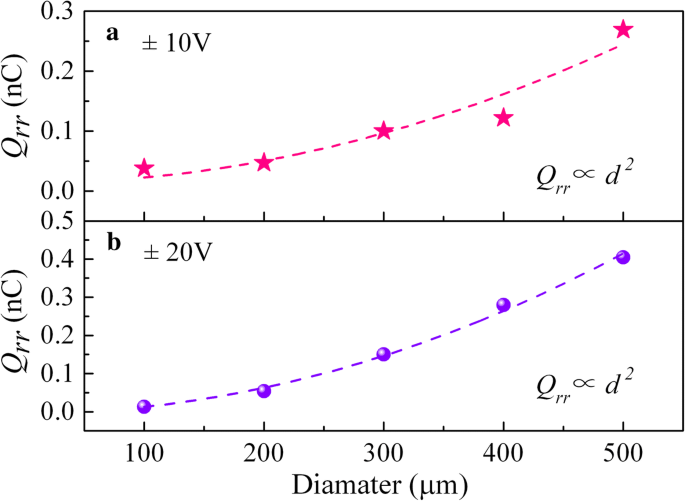
Terugvorderingstoeslag Q rr versus elektrodediameter d
Er is zelfs gemeld dat het omgekeerde hersteleffect voornamelijk afkomstig zou moeten zijn van de parasitaire inductantie en interface-trapping van SBD's [25, 26]. Aangezien de bijdrage van parasitaire inductantie wordt gekenmerkt in de vorm van oscillatiestroom die niet duidelijk wordt waargenomen in deze omgekeerde herstelcurven, zou de verandering van de omgekeerde hersteltijd en omgekeerde herstellading het gevolg moeten zijn van de vallen [27, 28]. Aangezien de concentratie van vallen uniform is in verticale SBD's, is de Q rr zou afhangen van het contactoppervlak van het apparaat en uiteindelijk toenemen met het elektrodegebied zoals weergegeven in Fig. 6. De vallen fungeren dus als een elektrische veldstopper in de interface. Tijdens de t een periode werd de vertraging sterk beïnvloed door carrier trapping in de Schottky-junctie, terwijl in de t b periode, wordt de herstelsnelheid in achteruit ook vertraagd door de tijd om de opgeslagen lading uit de kruising te vegen. Deze resultaten komen overeen met ons vorige rapport [29], waarin de RC . werd gesuggereerd tijdconstante neemt toe met de toename van de apparaatdiameter en vertoont een goede afhankelijkheid met de omgekeerde hersteltijd. En een verdere verbetering van de reverse recovery-eigenschappen kan worden verwacht van een kleinere elektrode of dunnere driftlaag in deze apparaten.
Bovendien wordt de herstelprestatie van verticale SBD's verder onderzocht bij een hogere temperatuur. Afbeelding 7 toont de omgekeerde herstelstroom voor GaN SBD's met een diameter van 500 μm die werden gemeten bij respectievelijk 300, 400 en 500 K. Noch de omgekeerde hersteltijd noch de omgekeerde herstellading wordt waargenomen veranderd met de temperatuurstijging. Deze resultaten zijn consistent met de bovenstaande analyse, aangezien de concentratie van de val niet erg gevoelig is voor de temperatuur. Omgekeerd is gemeld dat de omgekeerde hersteltijd van op Si gebaseerde SBD's met 191% zou toenemen als de temperatuur stijgt van 300 tot 425 K [17]. Hier wordt aangetoond dat GaN SBD's, met een korte levensduur van de draaggolf en een grotere bandgap, aanzienlijke verbeteringen bieden in de stroomafhandelingscapaciteit, omgekeerd herstel en energieverlies. Aangezien de thermische stabiliteit van op GaN gebaseerde SBD's superieur is dan die van traditionele halfgeleiders met smalle bandgap [30], kan worden geconcludeerd dat GaN ook een geschikt materiaal is voor het schakelen van apparaten die worden toegepast in een omgeving met hoge temperaturen.
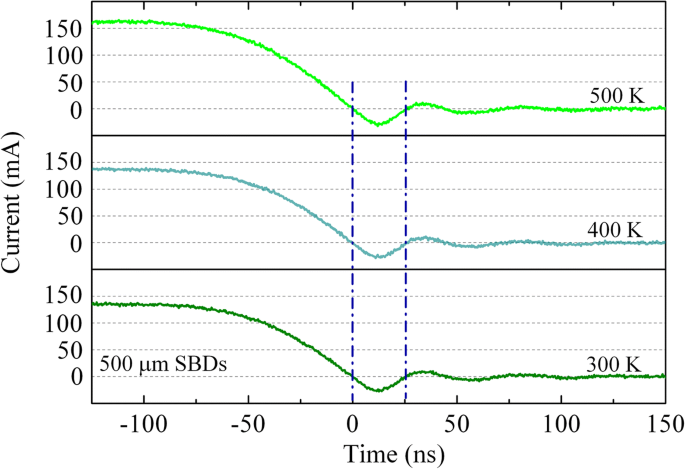
Omgekeerde herstelkarakteristieken voor SBD's met een diameter van 500 μm, gemeten bij respectievelijk 300, 400 en 500 K
Conclusies
Samenvattend hebben we verticale GaN SBD's gefabriceerd op Ge-gedoteerde FS GaN-substraten gekweekt door HVPE. Met de uitgevoerde materiaalkarakterisering en stroom-spanningsmetingen geeft dit aan dat een uitstekende kristalkwaliteit en elektronische eigenschap werd verkregen voor de verticale SBD's. De kenmerken van reverse recovery werden systematisch onderzocht. De omgekeerde hersteltijd werd verkregen op 15,8, 16,2, 18,1, 21,22 en 24,5 ns voor respectievelijk de diodes met een diameter van 100, 200, 300, 400 en 500 μm. Ondertussen vertonen de omgekeerde hersteltijd en de omgekeerde herstellading beide een significante positieve correlatie met het elektrodegebied. Onze resultaten kunnen dienen als referentie voor het verder verbeteren van de herstelprestaties van op GaN gebaseerde SBD's.
Afkortingen
- CL:
-
Kathodoluminescentie
- C-V :
-
Capaciteit-voltage
- DUT:
-
Apparaat onder test
- FS:
-
Vrijstaand
- GaN:
-
Galliumnitride
- HVPE:
-
Hydride dampfase epitaxie
- I-V :
-
Stroom-spanning
- SBD's:
-
Schottky-barrièrediodes
- SEM:
-
Scanning elektronenmicroscoop
Nanomaterialen
- Diodes
- Kwantumapparaten
- Diodes voor speciale doeleinden
- Navistar:zware prestaties
- HDPE-technologie met hoge vochtbarrière voor flexibele meerlaagse verpakkingen
- Effect van ultraviolette bestraling op 4H-SiC PiN-diodes Kenmerken
- Onderzoek naar oppervlaktepolarisatie van Al2O3-capped GaN/AlGaN/GaN heterostructuur door middel van hoek-opgeloste röntgenfoto-elektronspectroscopie
- Endotheelcellen targeten met multifunctionele GaN/Fe-nanodeeltjes
- Zichtbare, door licht aangedreven fotokatalytische prestaties van N-gedoteerde ZnO/g-C3N4-nanocomposieten
- Optimale siliciumdoteringslagen van kwantumbarrières in de groeireeks die een zacht opsluitingspotentieel vormen van acht-periode In0.2Ga0.8N/GaN Quantum Wells of Blue LED's
- 3 manieren om de prestaties van uw verticale pomp te verbeteren



