Een hoogwaardige rechthoekige Gate U-kanaal-FET's met slechts 2 nm afstand tussen bron- en afvoercontacten
Abstract
In dit artikel wordt een nieuwe, krachtige rechthoekige gate U-kanaal-FET (RGUC FET) voor extreem geïntegreerde afstand tussen bron- en afvoercontacten voorgesteld. De RGUC FET vertegenwoordigt bijna ideale subthreshold-karakteristieken totdat de afstand tussen source/drain (S/D)-contacten is teruggebracht tot 2 nm. Anders dan de andere verzonken of U-vormige FET's op kanaalbasis, hoeven de poortcontacten niet in het verzonken gebied te worden gevormd, maar alleen in een laag afstandhouder voor de isolatie tussen de twee verticale delen aan beide zijden van het U-kanaal. De structurele voordelen maken het mogelijk om geïntegreerde schakelingen te vervaardigen met een hogere integratie voor extreme geïntegreerde afstanden tussen bron- en afvoercontacten. De elektrische eigenschappen van de RGUC FET werden nauwgezet onderzocht door de invloed van ontwerpparameters te bestuderen, waaronder de horizontale afstand tussen S/D-contacten, de verlengingshoogte van het S/D-gebied en de dikte en het materiaal van de poortoxidelaag. De elektrische eigenschappen van de RGUC FET worden geverifieerd door kwantumsimulatie. Vergeleken met de andere niet-planner kanaal multi-gate FET's, is de nieuwe RGUC FET geschikt voor hogere integratie.
Inleiding
Als een van de meest veelbelovende apparaten die worden gebruikt in geïntegreerde schakelingen op nanoschaal (IC), is de junctionless field-effecttransistor (JL FET) die opmerkelijke elektrische eigenschappen vertoont in vergelijking met conventionele junction-based metaaloxidehalfgeleider (MOS) FET's, naast de eenvoud van fabricage, is de afgelopen jaren grondig bestudeerd [1,2,3,4]. Terwijl het verhogen van de gate-spanning het accumulatiegebied in het kanaal vormt, resulterend in een grotere stroom [5], versterkte de introductie van de multiple-gate (MG) FET de beheersbaarheid van de source-to-drain-stroom van de gate-spanning, resulterend in tot veel betere subthreshold-eigenschappen van het apparaat. De junctionless multiple-gate (JL MG) FET's zijn ook jarenlang uitgebreid bestudeerd [6,7,8]. Hoewel de verticale kanaal-gate-all-round MOSFET een bijna ideale I . laat zien -V prestaties met een straal van slechts enkele nanometers, het verticale kanaal ervan maakt het bron- en afvoercontact niet in dezelfde laag kunnen worden vervaardigd, waardoor de lay-out van IC's onverenigbaar is met de planner-technologie. Bovendien, aangezien de halfgeleiderfabricage is gedwongen om de kanaallengte te verkleinen tot minder dan 10 nm, worden de MG FET's opnieuw geconfronteerd met het korte-kanaaleffect [9,10,11]. Om het korte-kanaaleffect te overwinnen, zijn verzonken kanaal-MOSFET's de laatste jaren een hot topic geworden [12,13,14,15,16]. Het modellerings- en simulatiewerk van verzonken kanaal-MOSFET's wordt ook uitgebreid uitgevoerd [17,18,19,20]. Een inbouwkanaal MOSFET heeft zowel planner verticale kanaaldelen onder zowel source- als draincontacten en een horizontaal vlak kanaaldeel. Het verlengde in feite de effectieve kanaallengte in vergelijking met conventionele MOSFET's met alleen het horizontale vlakke kanaal. Voor het apparaat met dezelfde afstand tussen source- en draincontacten, kan het immuun zijn voor het kortekanaalseffect in vergelijking met conventionele MOSFET's met planair kanaal; de experimentele gegevens laten echter zien dat de subdrempelzwaai van MOSFET's met uitsparingskanaal geen ideale subdrempelzwaai kan realiseren met een effectieve kanaallengte van minder dan 100 nm. Dat komt omdat hoewel de kanaallengte wordt verlengd, de stuurbaarheid van de poort niet wordt versterkt als MG FET's. Opgemerkt moet worden dat het beter is om een nieuwe geometrische sleutelparameter te definiëren die verband houdt met de beschrijving van integratie, in plaats van de kanaallengte. De afstand tussen source- en draincontacten is realistischer en effectiever omdat het uiteindelijke doel van het ontwerp van het apparaat op nanoschaal het realiseren van de beste prestaties in een beperkt gegeven chipgebied is, en de werkelijke apparaatgrootte gerelateerd is aan de kanaalbreedte en de afstand tussen bron- en afvoercontacten. Om de voordelen van zowel de MG FET's als de verzonken kanaal-MOSFET's te combineren, hebben we in ons vorige werk zadelvormige poort-FET's voorgesteld met een U-vormig kanaal [21,22,23], wat de bestuurbaarheid van de poort naar de horizontale bevordert. kanaaldeel van het verzonken kanaal van een vlak type met enkele poort tot een 3D-type met drie poorten. Daarna upgraden we deze 3D-functie met drie poorten, niet alleen gevormd in het horizontale kanaalgedeelte, maar ook in beide verticale kanaalgedeelten. Dit apparaat wordt genoemd als H-gate U-kanaal-FET's, en het verzonken kanaal is dienovereenkomstig ook opgewaardeerd tot een 3D U-vormig buiskanaal [24]. Zoals hierboven vermeld, is het uiteindelijke doel van het ontwerp van het apparaat op nanoschaal het realiseren van de beste prestaties in een beperkt gegeven chipgebied door middel van optimalisatie. Om een geoptimaliseerd apparaat met hoge prestaties te realiseren, moeten zowel de poortstructuur als de bijbehorende kanaalstructuur goed worden overwogen en ontworpen. Ook de fabricage complexiteit moet goed worden overwogen. De hierboven genoemde apparaten, zoals de verzonken kanaalinrichting, de eerder voorgestelde zadel-FET's en HGUC FET's hebben een gemeenschappelijke basis, een sandwichstructuur van poortoxide/poort/poortoxide moet goed worden gevormd in het kleine verzonken gebied. Dit structurele kenmerk beperkt de verdere bevordering van integratie. Het lijkt erop dat een goede manier om de integratie te bevorderen is om het structurele kenmerk in het verzonken gebied te vereenvoudigen en tegelijkertijd het vermogen van de poortbesturing naar het verticale kanaalgedeelte en het horizontale kanaalgedeelte van het U-vormige kanaal te behouden. Om deze apparaatkenmerken en -functies te realiseren, hebben we in dit artikel een nieuwe rechthoekige gate U-kanaal FET (RGUC FET) voorgesteld voor extreem geïntegreerde afstand tussen source- en draincontacten. Het heeft een U-vormig kanaal dat de lengte van het effectkanaal kan verlengen zonder de afstand tussen source- en draincontacten te vergroten. Vergeleken met de andere U-vormige kanaal-FET's, heeft de RGUC FET een eenvoudigere binnenstructuur in het verzonken gebied van het U-vormige kanaal; daarna kan het een eenvoudigere fabricage in het binnenste deel van het verzonken gebied en een kleinere afstand tussen source- en draincontacten realiseren (hogere integratie). De voorgestelde structuur heeft een betere beheersbaarheid van de poort en een kleinere omgekeerde lekstroom, vergezeld van een hogere I AAN /Ik UIT verhouding. De afstand tussen broncontact en afvoercontact kan worden verkleind tot minder dan 2 nm. De hele elektrische eigenschappen worden geanalyseerd door kwantumsimulaties.
Methoden
Figuur 1a geeft de 3D schematische weergave van de RGUC FET weer, en figuur 1b tot d zijn profielen van het apparaat dat door de vlakken A, B, C en D in figuur 1a is gesneden. W is de lichaamsbreedte van het silicium, t b is de lichaamsdikte van het silicium, h in is de binnenhoogte van de afstandhouder in het verzonken gebied, h ex is de hoogte van het bron/afvoergebied van de extensie, t os is de dikte van het poortoxide rond het siliciumlichaam, en t sp is de afstandsdikte van de isolatielaag die is afgezet in het verzonken gebied van het U-vormige kanaal, die gelijk is aan de afstand tussen broncontact en afvoercontact.
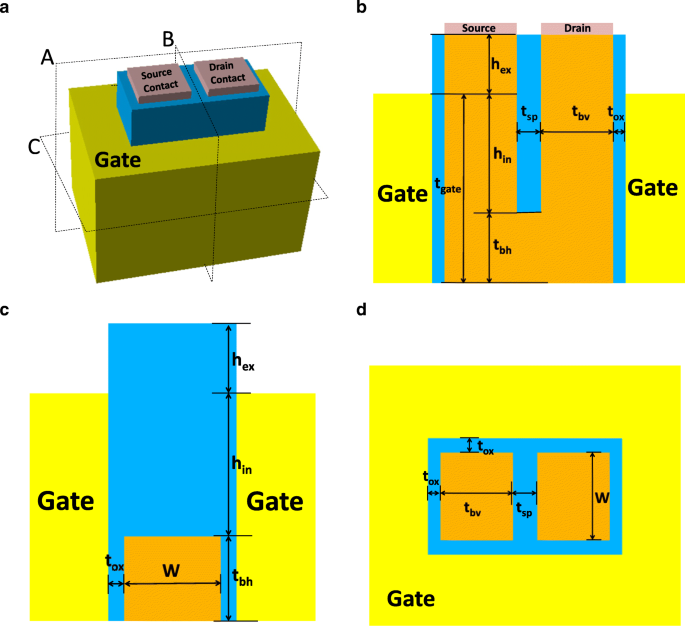
een 3D schematisch aanzicht van de RGUC FET. b Profielen van het apparaat snijden door vlak A van a . c Profielen van het apparaat snijden door vlak B van a . d Profielen van het apparaat snijden door vlak C van a
Aangezien de dikte van het siliciumlichaam minder is dan 6 nm, worden in dit artikel kwantumsimulaties geïntroduceerd in plaats van klassieke simulaties om nauwkeurigere simulatieresultaten te verkrijgen. Alle simulaties worden uitgevoerd met behulp van de TCAD van SILVACO Atlas 3D-apparaatsimulatie, met behulp van het concentratieafhankelijke mobiliteitsmodel, concentratieafhankelijke Shockley-Read-Hall-model, Auger-recombinatiemodel, bandgap-verkleiningsmodel, standaard band-naar-band tunnelmodel, en Bohm kwantumpotentiaalmodel [25]. De simulatieparameters staan vermeld in Tabel 1. De twee verticale lichaamsdelen zijn eigenlijk kubussen met vier zijden, waarvan de bovenvlakken zijn bedekt met het bron- of afvoergebied en het ondervlak beide zijn verbonden met het horizontale lichaamsdeel. De buitenste drievoudige zijden van de verticale lichaamsdelen zijn omgeven door het poortoxide en het rechthoekige poortcontact, en de andere binnenkant is verbonden met de binnenste afstandhouder in het uitgespaarde gebied. De vier zijden van het horizontale lichaam zijn allemaal omgeven door het poortoxide en het rechthoekige poortcontact. Het is aannemelijk dat de rechthoekige poort een sterk veldeffectcontrolevermogen heeft voor zowel het horizontale lichaam als de twee verticale delen vanwege de hierboven genoemde structuurkenmerken. En de binnenste spacer verlengde in feite de afstand van het kortste pad tussen source- en draincontacten in het silicium, wat het korte-kanaaleffect zou kunnen elimineren dat niet kan worden vermeden voor apparaten met meerdere poorten met vlakke kanaalkenmerken. In vergelijking met andere 3D-kanaalapparaten [21,22,23,24] heeft de voorgestelde structuur geen poortvorming nodig in het verzonken gebied, wat de complexiteit van de binnenstructuur van het verzonken gebied grotendeels vermindert.
Resultaten en discussies
Het Bohm-quantumpotentiaal (BQP) -model berekent een positieafhankelijke potentiële energieterm met behulp van een hulpvergelijking die is afgeleid van de Bohm-interpretatie van de kwantummechanica. Dit model is afgeleid van pure fysica en stelt het model in staat om het kwantumgedrag van verschillende klassen apparaten en een reeks materialen te benaderen. De effecten van kwantumopsluiting op de prestaties van het apparaat, waaronder I -V kenmerken, worden dan tot een goede benadering berekend. Eerdere studies tonen aan dat de lekstroom van de poort verwaarloosbaar is voor gevallen met een oxidedikte groter dan 0,5 nm [7, 26].
Figuur 2a toont de vergelijkingen van de drain-source huidige gate-source spanning (I DS -V GS ) kenmerken van de RGUC FET met verschillende h in s op zowel logaritmische als lineaire schalen. Afbeelding 2b toont de vergelijkingen van subthreshold swings (SS) en I AAN /Ik UIT verhouding van de RGUC FET met verschillende h in s. Met de toename van h in , wordt het verticale pad van het hele kanaal van bron tot afvoer continu vergroot, vervolgens neemt de kortste effectieve kanaallengte geleidelijk toe en het korte-kanaaleffect verzwakt geleidelijk en wordt uiteindelijk geëlimineerd. De SS kan een bijna ideale waarde van 65 mV/dec realiseren voor h in bereikt 10 nm. De ik AAN /Ik UIT verhouding neemt ook ongeveer 35 keer toe voor u in neemt toe van 2 naar 10 nm vanwege de continu verminderde SS. De verlengde h in maakt de afstand van het kortste pad van bron naar afvoer groter van 6 naar 22 nm, wat gelijk is aan 2 h in + t sp en is gelijk aan de effectieve kanaallengte van de voorgestelde constructie. Figuur 2c en d tonen een 2D-elektronenconcentratieverdeling in het siliciumlichaam in uitgeschakelde toestand voor het apparaat met 2 nm en 10 nm h in , respectievelijk. Voor het geval van 2 nm is de hoogste elektronenconcentratie in het horizontale lichaamsgebied ongeveer 10 12 cm −3 en de afstand tussen source/drain contact en het horizontale lichaamsgebied is zeer kort. Daarna beïnvloedt de source/drain-bias de elektronendistributie in het horizontale lichaamsgebied ernstig; de oplossing is om het verticale kanaal te verlengen dat de bron/afvoer weghoudt van het horizontale lichaamsgebied. Voor het geval van 10 nm kunnen we in figuur 2d zien dat de hoogste elektronenconcentratie in het horizontale lichaamsgebied wordt verlaagd tot 10 9 cm −3 , en het maakt een meer ideaal volledig uitgeput gebied voor de uit-toestand die een veel lager niveau van lekstroom met zich meebrengt.

een De vergelijkingen van de I DS -V GS kenmerken van de RGUC FET met verschillende h in s op zowel logaritmische als lineaire schalen. b De vergelijkingen van subthreshold swings (SS) en I AAN /Ik UIT verhouding van de RGUC FET met verschillende h in s. c 2-D elektronenconcentratieverdeling in het siliciumlichaam in uitgeschakelde toestand voor het apparaat met 2-nm h in . d 2-D elektronenconcentratieverdeling in het siliciumlichaam in uitgeschakelde toestand voor het apparaat met 10 nm h in
Afbeelding 3a toont de vergelijkingen van de I DS -V GS kenmerken van de RGUC FET met verschillende t sp s op zowel logaritmische als lineaire schalen. Afbeelding 3b toont de vergelijkingen van subthreshold swings (SS) en I AAN /Ik UIT verhouding van de RGUC FET met verschillende t sp s. Met de afname van t sp , wordt ook de afstand tussen source- en draincontacten continu kleiner. De lekstroom wordt voornamelijk geïnduceerd door band-naar-band tunnelstroom. De tunnelkans is evenredig met de bandbuiging die gelijk kan zijn aan de elektrische veldintensiteit op een bepaald punt. De totale tunnelstroom is de som van de tunnelstroom die in elk punt van het lichaamsgebied wordt gegenereerd.
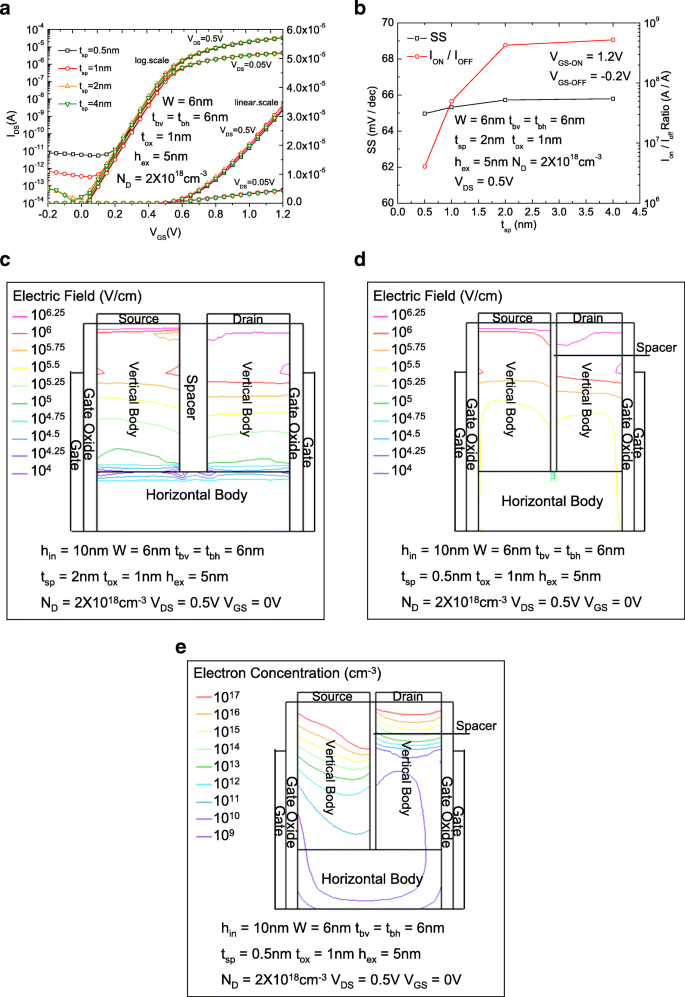
een De vergelijkingen van de I DS -V GS kenmerken van de RGUC FET met verschillende t sp s op zowel logaritmische als lineaire schalen. b De vergelijkingen van subthreshold swings (SS) en I AAN /IUIT verhouding van de RGUC FET met verschillende t sp s. c 2-D elektrische veldverdeling in het siliciumlichaam in uitgeschakelde toestand voor het apparaat met 2 nm t sp . d 2-D elektrische veldverdeling in het siliciumlichaam in uitgeschakelde toestand voor het apparaat met 0,5 nm t sp . e 2-D elektronenconcentratieverdeling in het siliciumlichaam in uitgeschakelde toestand voor het apparaat met 0,5 nm t sp
Afbeelding 3c en Afbeelding 2d tonen een 2D-elektrische veldverdeling in het siliciumlichaam in uitgeschakelde toestand voor het apparaat met 2 nm en 0,5 nm t sp , respectievelijk. Voor een grotere afstandsdikte of een kleinere afvoer-bronspanning (V DS ) bias, is de elektrische veldintensiteit op de interface tussen de spacer in het verzonken gebied niet sterk genoeg om een grote hoeveelheid lekstroom te produceren. De sterkste elektrische veldintensiteit verschijnt nabij het grensvlak tussen het poortoxide en het verticale lichaamsdeel, wat wordt bepaald door V GD . Als de source-to-drain-afstand echter wordt verkleind tot minder dan 1 nm (minder dan de gate-oxidedikte), verschijnt de sterkste veldintensiteit nabij het grensvlak tussen de spacer in het verzonken gebied en de twee verticale lichaamsdelen. Het is te zien dat wanneer t sp kleiner is dan 1 nm, voor een grotere V DS (bijvoorbeeld 0,5 V), de lekstroom is bijna onafhankelijk van de gate-bias en wordt voornamelijk bepaald door de V DS . De SS is bijna onafhankelijk met t sp en handhaaft een bijna ideale waarde van 65 mV/dec gedurende een u in = 10 nm hoofdlettergebruik tot t sp kleiner is dan 2 nm. De ik AAN /Ik UIT verhouding handhaaft 10 8 tot t sp = 2 nm en is ernstig aangetast voor t sp minder dan 2 nm als gevolg van de toename van de lekstroom die wordt veroorzaakt door het sterke elektrische veld, verschijnt nabij het grensvlak tussen de afstandhouder in het verzonken gebied en de twee verticale lichaamsdelen. De elektrische veldintensiteit van het siliciumlichaam in het lichaamsgebied is uitgebreid verbeterd voor de 0,5 nm t sp geval. Afbeelding 3e toont de 2D-elektronenconcentratieverdeling in het siliciumlichaam in uitgeschakelde toestand voor het apparaat met 0,5 nm t sp . In vergelijking met figuur 2d is duidelijk te zien dat de elektronenconcentratie in het horizontale lichaamsgebied is vergroot van 10 9 tot 10 10 cm −3 . Bovendien ligt de afmeting van een afstandsstukdikte van 0,5 nm zeer dicht bij een laag met één molecuul, wat tot op zekere hoogte schade aan de isolatie-eigenschap van de afstandslaag kan veroorzaken. Om de hierboven genoemde reden is de t sp wordt voorgesteld om 2 nm te zijn voor een ontwerp met hoge integratie en lage lekkage en laag stroomverbruik.
Afbeelding 4 toont de I DS -V DS van de voorgestelde RGUC FET met geoptimaliseerde structuur onder verschillende.
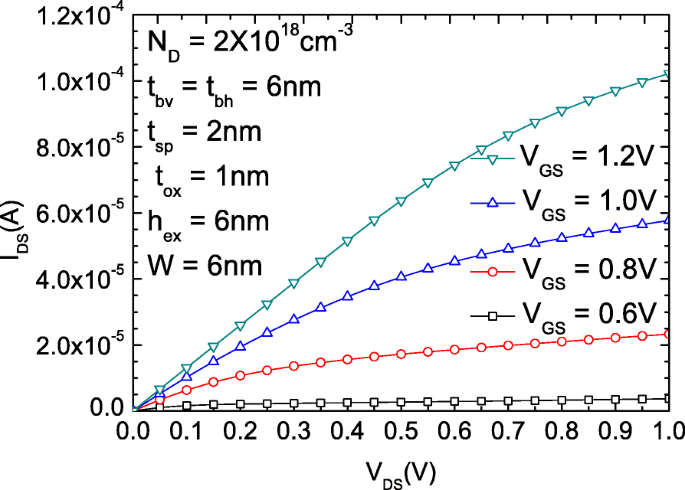
Ik DS -V DS kenmerk van de voorgestelde RGUC FET met geoptimaliseerde apparaatparameters
V GS waarden, waarvan de SS ongeveer 63 mV/dec is, en de I AAN/Ik UIT is 10 9 ~ 10 10 . De verzadigde stroom neemt toe met V GS neemt toe.
Conclusies
In dit artikel wordt een nieuwe RGUC FET met hoge integratie en hoge prestaties voorgesteld, die schommelingen met een lage subdrempel en hogere I presenteert. AAN /Ik UIT verhouding. De afstand tussen source/drain (S/D) contacten kan worden teruggebracht tot 2 nm, met bijna ideale eigenschappen zoals SS, omgekeerde lekstroom en I AAN /Ik UIT verhouding. Alle elektrische eigenschappen worden gesimuleerd met kwantummodellen om nauwkeurigere resultaten te garanderen.
Afkortingen
- BQP:
-
Bohm kwantumpotentiaal
- FET:
-
Veldeffecttransistor
- h ex :
-
Uitbreidingshoogte van afstandhouder tussen S/D-gebied
- h in :
-
Binnenhoogte van afstandhouder in verzonken gebied
- Ik UIT :
-
Uit stroom
- Ik AAN :
-
Op huidige
- JL:
-
Verbindingsloos
- MOS:
-
Metaaloxide halfgeleider
- N D :
-
Dopingconcentratie
- RGUC:
-
Rechthoekig poort U-kanaal
- S/D:
-
Bron/afvoer
- SS:
-
Subdrempelzwaai
- t bh :
-
Horizontale lichaamsdikte
- t bv :
-
Verticale lichaamsdikte
- t poort :
-
Verticale lengte van de poort
- t os :
-
Dikte poortoxidelaag
- t sp :
-
Dikte afstandhouder tussen S/D-gebied
- V DS :
-
Afvoer-bronspanning
- V GS :
-
Poort-bronspanning
- W:
-
Lichaamsbreedte
Nanomaterialen
- Verschil tussen structuur en klasse:uitgelegd met C++-voorbeeld
- Verschil tussen while en do-while:uitgelegd met voorbeelden
- Slim nanomateriaal en nanocomposiet met geavanceerde agrochemische activiteiten
- Multi-Layer SnSe Nanoflake Field-Effect Transistors met Au Ohmic-contacten met lage weerstand
- Eenvoudige synthese van zilveren nanodraden met verschillende beeldverhoudingen en gebruikt als hoogwaardige flexibele transparante elektroden
- UV-uitgeharde inkjet-geprinte zilveren poortelektrode met lage elektrische weerstand
- Verminderde contactweerstand tussen metaal en n-Ge door invoeging van ZnO met argonplasmabehandeling
- Kanaalplasmonnanodraadlasers met V-groefholten
- Grafeen-ondersteunde thermische interfacematerialen met een tevreden interfacecontactniveau tussen de matrix en vulstoffen
- Hoogwaardig kathodemateriaal van FeF3·0.33H2O gemodificeerd met koolstofnanobuisjes en grafeen voor lithium-ionbatterijen
- Op Baliga's Figure-Of-Merits (BFOM) verbetering van een nieuwe GaN Nano-Pillar Vertical Field Effect Transistor (FET) met 2DEG-kanaal en Patroonsubstraat



