Een overzicht van de Ultrawide Bandgap Ga2O3-halfgeleider-gebaseerde Schottky-barrièrediode voor toepassingen in vermogenselektronica
Abstract
Galliumoxide (Ga2 O3 ) is een nieuw halfgeleidermateriaal dat het voordeel heeft van een ultrabrede bandgap, een hoog elektrisch veld doorslag en een grote Baliga's figure of merit (BFOM), dus het is een veelbelovende kandidaat voor de volgende generatie krachtige apparaten, waaronder Schottky-barrièrediode (SBD ). In dit artikel worden de fysieke basiseigenschappen van Ga2 O3 halfgeleider zijn geanalyseerd. En de recente onderzoeken op de Ga2 O3 -gebaseerde SBD zijn beoordeeld. Ondertussen zijn verschillende methoden voor het verbeteren van de prestaties, waaronder doorslagspanning en aan-weerstand, samengevat en vergeleken. Eindelijk, het vooruitzicht van Ga2 O3 -gebaseerde SBD voor toepassingen in vermogenselektronica is geanalyseerd.
Achtergrond
Met de snelle ontwikkeling van elektrische energie, industriële besturing, auto-elektronica en consumentenelektronica, is er een enorme vraag naar krachtige halfgeleiderapparaten met hoge prestaties. Halfgeleidermaterialen met brede en ultrabrede bandgap kunnen aan deze vraag voldoen [1, 2]. Onder de vijf structuren van Ga2 O3 eenkristal, monokliene β -Ga2 O3 is het meest stabiel en heeft een ultrabrede bandgap (E g ~ 4,8 eV) en een zeer hoog elektrisch doorslagveld (E br ~ 8 MV cm −1 ), vergeleken met het traditionele Si en later ontwikkelde SiC- en GaN-materiaal. Als gevolg hiervan, β -Ga2 O3 toont een veel grotere verdienste van Baliga (BFOM =\( \varepsilon \mu {E}_{\mathrm{b}}^3 \); ε is de relatieve diëlektrische constante, en μ is de elektronenmobiliteit). BFOM is een belangrijk criterium om de geschiktheid van een materiaal voor toepassing van stroomapparatuur te beoordelen [3,4,5,6,7,8,9,10,11]. Tabel 1 vergelijkt de fysieke basiseigenschappen van Si, brede bandgap (GaN, SiC) en ultrabrede bandgap (β -Ga2 O3 ) halfgeleidermateriaal. Bovendien, voor de groei van eenkristal β -Ga2 O3 substraat, zijn er gemakkelijke, goedkope en in massa produceerbare smeltgroeimethoden bij atmosferische druk, zoals drijvende zone (FZ) [12, 13] en de edge-defined film-fed growth (EFG) [14,15 ,16,17]. Dit is weer een superioriteit van Ga2 O3 in het aspect van hoogwaardige eenkristalgroei, vergeleken met SiC en GaN. Daarom, β -Ga2 O3 is een veelbelovende kandidaat voor high-power halfgeleiderapparaten van de volgende generatie, zoals Schottky-barrièrediode (SBD) [18,19,20,21,22,23,24] en metaaloxide-halfgeleider-veldeffecttransistor (MOSFET) [ 25,26,27,28,29]. Het is vermeldenswaard dat veel studies over de Ga2 O3 materiaalgroei en fabricage en karakterisering van stroomapparatuur zijn de afgelopen jaren uitgevoerd, dus in dit artikel hebben we de materiaaleigenschappen van de ultrabrede bandgap Ga2 besproken O3 halfgeleider en de onderzoeken van de Ga2 O3 -gebaseerde SBD voor toepassing in vermogenselektronica. In SBD zijn de belangrijkste prestatieparameters doorslagspanning (V br ) en aan-weerstand (R aan ), dus door het samenvatten en vergelijken van de verschillende methoden voor het verbeteren van de V br en R aan prestaties, hopen we dat ons beoordelingswerk gunstig is voor de ontwikkeling van Ga2 O3 -gebaseerde stroomapparaten.
Fysieke eigenschappen van galliumoxidehalfgeleider
Galliumoxide (Ga2 O3 ) is een nieuw oxidehalfgeleidermateriaal, maar het heeft een lange onderzoeksgeschiedenis. Het onderzoek naar de fase-evenwichten in de Al2 O3 -Ga2 O3 -H2 O-systeem kan worden teruggevoerd tot 1952, en R. Roy et al. bepaalde het bestaan van polymorfen van Ga2 O3 en hun stabiliteitsrelaties [30]. In 1965, H.H. Tippins et al. bestudeerde de optische absorptie en fotogeleiding in de bandrand van β -Ga2 O3 en bevestigde de bandgap met een waarde van 4,7 eV [6]. In de jaren negentig werd een aantal methoden voor de smeltgroei van Ga2 O3 bulk eenkristal en epitaxiale groei van Ga2 O3 film was ontwikkeld. In de afgelopen 5 jaar is Ga2 dankzij zijn bijzondere eigenschappen en de succesvolle groei van hoogwaardig en groot formaat eenkristalsubstraat O3 materiaal heeft veel onderzoeksinteresse gewekt.
Tot nu toe hebben mensen vijf kristallijne fasen van Ga2 . gevonden O3 , d.w.z. α , β , γ , δ , en ε fasen. De transformatierelaties tussen deze vijf fasen worden getoond in figuur 1 [30]. De monokliene fase β- Ga2 O3 heeft de beste thermische stabiliteit, terwijl de andere vier fasen metastabiel zijn en de neiging hebben om te transformeren naar β- Ga2 O3 bij hoge temperaturen. Daarom richten de meeste onderzoeken zich momenteel op β- Ga2 O3 . Sommige recente onderzoeken hebben ook aangetoond dat andere fasen enkele speciale materiaaleigenschappen vertoonden die β fase niet gehad. Bijvoorbeeld α- Ga2 O3 heeft een korund kristalstructuur vergelijkbaar met die van saffier (Al2 O3 ), dus het is relatief eenvoudig om epitaxiaal hoogwaardige α- . te kweken Ga2 O3 monokristallijne film op de momenteel bestaande Al2 O3 eenkristalsubstraat. Zeshoekige fase ε- Ga2 O3 is de tweede stabiele fase en vertoont een sterk spontaan polarisatie-effect dat gunstig is voor de vorming van 2D-elektronengas met hoge dichtheid in het heterojunctie-interface [31], vergelijkbaar met de toestand in de AlGaN/GaN-junctie. In de afgelopen jaren, dankzij de succesvolle groei van grote β- Ga2 O3 eenkristalsubstraat en zijn beste stabiliteit, tot nu toe, de studies op β- Ga2 O3 zijn veel meer dan die in de andere vier fasen. In dit artikel bespreken we dus voornamelijk het onderzoek naar β- Ga2 O3 .
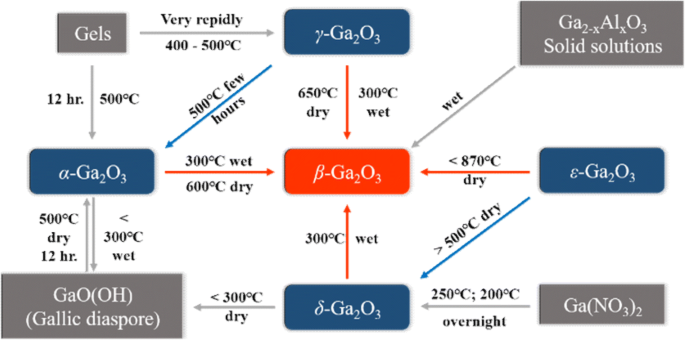
Transformatierelaties tussen de kristallijne fasen van Ga2O3 en hun hydraten [30]
β- Ga2 O3 behoort tot het monokliene systeem en is thermisch stabiel. De roosterconstanten zijn a = 1.22 nm, b = 0.30 nm, en c = 0,58 nm, zoals weergegeven in Fig. 2. De kristallijne structuur van β- Ga2 O3 bepaalt dat het een bepaalde geleidbaarheid heeft, maar die wordt beperkt door zijn ultrabrede bandgap (4,7-4,9 eV), de grootste van alle bekende transparante halfgeleidermaterialen. Alleen als er enkele defecte energieniveaus bestaan in de bandgap en vrije elektronen genereren, heeft het materiaal een relatief sterke geleidbaarheid. Voor de meeste halfgeleiders met een brede bandgap wordt geleidbaarheid gevormd alleen vanwege het bestaan van defectniveaus in de bandgap, zoals ZnO-halfgeleider [32]. De intrinsieke elektrische geleiding van β- Ga2 O3 is afkomstig van de vrije elektronen die worden geleid door de puntdefecten die in het grootste deel van het kristal zijn gevormd. De meeste onderzoeken hebben aangetoond dat de zuurstofvacatures de belangrijkste defecten zijn voor de elektrische geleiding [33,34,35].

De roosterstructuur van β-Ga2 O3 kristal. Herdrukt van ref. [5]
Het is interessant dat vanwege het bestaan van de overvloed aan zuurstofvacatures in polykristallijne β- Ga2 O3 , het is gemakkelijk om een soort gas te absorberen om de soortelijke weerstand te veranderen, dus er zijn veel rapporten geweest over het gebruik van β- Ga2 O3 om gassensoren te fabriceren voor de detectie van H2 , CH4 , CO en O2 [36,37,38,39]. Bovendien, omdat de roosterconstante van β- Ga2 O3 in de richting [100] veel groter is dan die in de richtingen [001] en [010], is het gemakkelijk om ultradunne film in de richting [100] af te pellen voor de fabricage van het apparaat [27, 40,41,42,43]. Tegelijkertijd, dankzij deze kristalstructuurkarakteristiek, bij de fabricage van β- Ga2 O3 wafels, die de bulk in de richting [100] snijden, kunnen een vlak oppervlak krijgen met een zeer lage ruwheid.
Vergeleken met SiC en GaN, β- Ga2 O3 bezit bepaalde elektrische eigenschappen, waarvan de ultrawide bandgap (4,7-4,9 eV) de meest prominente is. Dit zorgt ervoor dat het een zeer hoog elektrisch doorslagveld heeft (E br ≈8 MV/cm), ongeveer twee keer die van SiC en GaN. Het elektrische doorslagveld van materiaal is een zeer belangrijke parameter voor unipolaire stroomapparaten. Als een materiaal een hogere E . heeft br , in het materiaal van de eenheidsdikte, kan een hoger elektrisch veld worden gehandhaafd, wat voordelig is voor de vermindering van de apparaatgrootte en verbetering van het integratieniveau van vermogensmodules. Afbeelding 3 toont de fundamentele limieten van aan-weerstand (R aan ) als functie van doorslagspanning (V br ) voor verschillende belangrijke halfgeleiders, waaronder Si, GaAs, SiC, GaN, Ga2 O3 , en diamant [5]. Uit deze figuur kunnen we afleiden dat het geleidingsverlies van Ga2 O3 apparaten is één orde van grootte lager dan die van SiC- en GaN-apparaten bij dezelfde V br . Dus, Ga2 O3 toont zijn grote potentieel in unipolaire apparaten. Als de verzadigingselektronenmobiliteit van β- Ga2 O3 is relatief laag (~ 200 cm 2 V − 1 s − 1 ), β- Ga2 O3 is niet geschikt voor hoogfrequente apparaten in vergelijking met GaN. De brede bandgap kan dit nadeel echter compenseren, aangezien een dunnere driftlaag een kleinere uitputtingsbreedte heeft; dus kan de parasitaire capaciteit worden verlaagd om te voldoen aan de vereisten van hoogfrequente toepassingen. Bovendien maakt de bandgap van ongeveer 4,8 eV Ga2 O3 beschikken over een speciale absorptiegolfband (250-280 nm) die zich net in het bereik van zonneblinde ultraviolette (UV) straling bevindt, dus Ga2 O3 is een natuurlijk goed materiaal voor het vervaardigen van UV-detectoren [44,45,46,47].
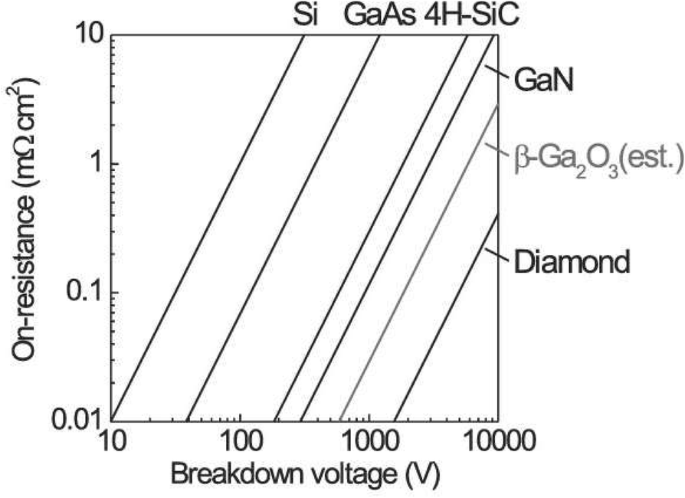
Theoretische limieten van aan-weerstand (R aan ) als functie van doorslagspanning (V br ) voor β-Ga2 O3 en representatieve halfgeleiders. Herdrukt van ref. [26]
In de afgelopen jaren heeft de n-type doping van β- Ga2 O3 is in wezen gerealiseerd. Si- en Sn-elementen hebben als donoronzuiverheden met een laag energieniveau een lage activeringsenergie. Dopingconcentratie kan goed worden gemoduleerd om in het bereik van 10 15 . te liggen –10 19 cm −3 [47], met de hoogste waarde van 10 20 cm −3 bereikt. Tegelijkertijd zullen met de verandering van de dopingconcentratie ook de optische en elektrische eigenschappen veranderen. Bijvoorbeeld de soortelijke weerstand van n-type β- Ga2 O3 veranderingen in het bereik van 10 −3 − 10 12 Ω cm met de veranderende dopingconcentratie [48, 49]. De bandgap verandert ook met verschillende dopingconcentraties, dus de lichtabsorptie-eigenschappen van Ga2 O3 worden beïnvloed [50].
Van de ontwikkeling van Ga2 O3 , heeft dit materiaal nog enkele nadelen als volgt. (1) P-type doping is een grote uitdaging voor Ga2 O3 materiaal. Omdat de acceptorniveaus ver verwijderd zijn van de valentieband van β- Ga2 O3 , is de activeringsenergie van acceptorverontreinigingen zeer hoog. Ondertussen zijn de n-type achtergrondonzuiverheden in Ga2 O3 kristal zal ook een zelfcompenserend effect hebben op acceptorverontreinigingen, wat resulteert in zelfisolatie van het materiaal. Daarom is er nog steeds geen effectief p-type gedaan. (2) De thermische geleidbaarheid van Ga2 O3 is te laag. Experimenteel en theoretisch onderzoek heeft aangetoond dat de thermische geleidbaarheid van β- Ga2 O3 is slechts 0,1–0,3 W cm −1 K −1 [51,52,53]. Dit is nadelig voor het stroomapparaat dat wordt gebruikt in omstandigheden met hoge spanning en hoge stroomsterkte. Overmatige warmteaccumulatie zal de prestaties en betrouwbaarheid van het apparaat ernstig aantasten. (3) De mobiliteit van dragers is laag. De theoretische mobiliteit van Ga2 O3 is beperkt tot ongeveer 200 cm 2 /V s door de invloed van verstrooiing [54]. Lage mobiliteit heeft een negatieve invloed op de frequentie- en stroomkarakteristieken.
Het basisconcept van Schottky-barrièrediode
Schottky-contact, ohms contact en elektrische veldverdeling zijn de belangrijkste factoren in SBD om hoge prestaties te bereiken, inclusief aan-weerstand (R aan ) en doorslagspanning (V br ), dus verschillende methoden om ze te verbeteren zijn vooral belangrijk.
Volgens het concept van de Schottky-barrière is de barrièrehoogte gerelateerd aan de werkfunctie van Schottky-metaal en de elektronenaffiniteit van halfgeleiders. De werkfunctie van verschillende metalen verandert periodiek en metaal moet een grotere werkfunctie hebben dan halfgeleider om een Schottky-barrière te vormen. Nikkel (Ni) en platina (Pt) zijn de gebruikelijke Schottky-metalen voor β- Ga2 O3 , en hun barrièrehoogten zijn afgeleid met verschillende methoden [55,56,57,58,59,60,61,62,63,64,65,66,67,68,69,70,71,72,73,74 ,75,76,77]. Het uitputtingsgebied onder het oppervlak van de halfgeleider heeft de nodige dikte nodig om tunneling van de drager te voorkomen, en dit vereist de beperkte doteringsconcentratie van halfgeleiders. Gebruikelijke waarden van dopingconcentratie zijn 10 16 –10 17 cm −3 in de β- Ga2 O3 substraat of epitaxielaag [56,57,58,59,60,61,62]. De hoogte van de barrière wordt feitelijk beïnvloed door de interfacetoestanden en wijkt af van een eenvoudige relatie met de werkfunctie. De voorbehandeling van het oppervlak is bedoeld om de interfacetoestanden te verminderen, inclusief de zuurstoftekorten in de buurt van het oppervlak en bungelende bindingen [78].
Het ohmse contact is de basisverbinding tussen metaal en halfgeleider. Een lage specifieke weerstand van ohms contact is nuttig voor de apparaten om de contactweerstand te verminderen (R s ) en aan-weerstand (R aan ). De traditionele methoden om een lage contactweerstand te bereiken, zijn het kiezen van metaal met een lage werkfunctie en zware doping. In feite is de werkfunctie van contactmetaal altijd niet van invloed op de vorming van ohms contact vanwege het vastzetten van interfacetoestanden. De zware dotering van halfgeleiders wordt de primaire techniek voor het ohmse contact. De belangrijkste doelen zijn het verbeteren van de concentratie van dragers en het verlagen van de interfacebarrière. De RTA (rapid thermal annealing) verbetert de grensvlakkenmerken en reduceert de contactweerstand. Y. Yao et al. testte negen metalen als ohmse contactmetalen voor de β- Ga2 O3 en vonden dat titanium (Ti) en indium (In) goed ohms gedrag vertonen onder specifieke omstandigheden [79]. Na gloeien bij hoge temperaturen kan alleen titanium de continue morfologie behouden. Evenzo pasten de meeste onderzoeken titanium toe als het ohmse contactmetaal met β- Ga2 O3 en behaalde gunstige apparaatprestaties [60,61,62,63,64,65,66,67,68,69,70].
Het doorslaggedrag is gerelateerd aan de verdeling van het elektrische veld in de apparaten, en cilindrische juncties en sferische juncties hebben een groter elektrisch veld dan parallelle vlakken in dezelfde toestand [1]. Daarom zijn enkele randafsluitingsbeschermingsmethoden nodig, zoals veldplaat om de doorslagspanning te verbeteren [19, 23, 68]. De interfacetoestanden waarnaar wordt verwezen als interfaceladingen beïnvloeden normaal gesproken het elektrische veld dichtbij het halfgeleideroppervlak en veroorzaken de voortijdige storing. De lekstroom is de indicator van doorslaggedrag en wordt vaak beïnvloed door de interne defecten van halfgeleiders, inclusief dislocaties. Beide situaties veroorzaken instabiliteit van apparaten en kunnen de doorslagspanning verlagen, wat moet worden vermeden. De gebruikelijke praktijk voor het verminderen van de impact van interfacetoestanden is oppervlaktepassivering, en een hoogwaardig substraat is ook vereist voor het verhogen van de doorslagspanning.
Schottky-barrièrediode gebaseerd op β- Ga2 O3
De moeilijkheden bij de groei van hoogwaardige en goedkope eenkristalsubstraten hebben de commercialisering van SiC- en GaN-apparaten beïnvloed. Terwijl Ga2 O3 eenkristalsubstraten kunnen worden gekweekt door middel van een goedkope smeltmethode, de krachtapparaten op basis van Ga2 O3 monokristallijn heeft de afgelopen jaren veel aandacht getrokken. Op dit moment is de n-type dopingtechnologie van Ga2 O3 is behoorlijk volwassen, maar het ontbreken van p-type doping maakt Ga2 O3 kan niet worden toegepast in bipolaire apparaten. De ultragrote bandgap maakt het een groot voordeel bij de toepassing van unipolaire apparaten. Daarom is de ontwikkeling van de Ga2 O3 vermogensapparaten worden gedomineerd door twee soorten unipolaire apparaten, namelijk de Schottky-barrièrediode (SBD) en de metaaloxide-halfgeleider-veldeffecttransistor (MOSFET) [23, 55, 56].
Met de ontwikkeling van de wide bandgap (WBG) halfgeleidermateriaaltechnologie, begint het SBD-apparaat op basis van WBG-halfgeleider de p-n-junctiediode te vervangen om toe te passen in het vermogenselektronische systeem, omdat er geen minderheidsdrageropslageffect bestaat in SBD en het schakelverlies is vrij laag. In theorie, vergeleken met SiC en GaN SBD, Ga2 O3 SBD kan dezelfde doorslagspanning bereiken met een veel dunnere driftlaag. Tegelijkertijd zorgt een dunnere driftlaag voor een lagere parasitaire capaciteit, waardoor de hersteltijd van het apparaat wordt verkort. De belangrijkste ontwikkelingsvoortgang van Ga2 O3 SBD wordt getoond in Fig. 4. Met de ontwikkeling van de epitaxietechnologie heeft de SBD-structuur zich ontwikkeld van de initiële op substraat gebaseerde eenvoudige structuur tot de substraat en epitaxiale filmgebaseerde complexe structuur. Vervolgens zijn door de geleidelijke verkenning van de fabricageprocessen van het apparaat geavanceerde terminalstructuren verschenen, waaronder een gevijlde plaat en greppel, waardoor de prestaties van het apparaat verder zijn verbeterd. Ga2 O3 SBD begint zijn potentieel te presenteren in toepassingen voor vermogenselektronica.
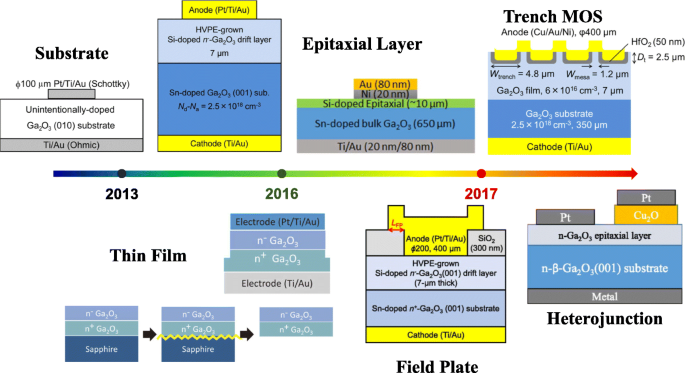
De ontwikkeling van Ga2 O3 SBD in de afgelopen jaren [16, 18, 62, 68–71]
Als een nieuw halfgeleidermateriaal met een brede bandgap, werden mensen geconfronteerd met veel basisproblemen in de initiële ontwikkelingsfase van Ga2 O3 , dus de ontwikkelingsvoortgang van Ga2 O3 SBD weerspiegelt de evolutie van power SBD heel goed. Het belangrijkste onderdeel in SBD is de Schottky-junctie, dus in het vroege onderzoek wordt gewerkt aan Ga2 O3 SBD, er zijn een aanzienlijk aantal die zich richten op het onderzoek naar de Schottky-junctie, voornamelijk met inbegrip van het contact tussen Ga2 O3 en verschillende Schottky-elektroden (Ni、Cu、Au、Pt、TiN) [57,58,59], het elektronentransportmechanisme van de Schottky-junctie, de problemen van interfacetoestanden, barrière-inhomogeniteit en beeldkracht in het Schottky-contact, en de methoden voor het verkrijgen van perfect ohms contact in de kathode-interface [60, 61].
Met de geleidelijke doorzichtigheid van de fysieke eigenschappen en de toenemende verbetering van de fabricageprocessen, worden de prestaties van het apparaat geleidelijk verbeterd. Hieronder volgen enkele typische werken bij de ontwikkeling van Ga2 O3 SBD.
In 2013 K. Sasaki et al. in Tamura Corporation vervaardigde SBD op basis van hoogwaardige (010) β –Ga2 O3 eenkristalsubstraat gekweekt met de drijvende zone-methode [62]. Ze onderzochten de impact van de verschillende dopingconcentraties in het substraat op de prestaties van het apparaat en ontdekten dat een hogere dopingconcentratie een lagere aan-weerstand induceerde, maar een lagere omgekeerde doorslagspanning en een grotere omgekeerde lekstroom. Afbeelding 5 toont de kenmerken van de omgekeerde afbraak van de twee SBD's die zijn vervaardigd met (010) β –Ga2 O3 substraten met verschillende dopingconcentraties. De doorslagspanning bereikt 150 V. De idealiteitsfactor van beide apparaten ligt dicht bij 1. En de Schottky-barrièrehoogte van de Pt/β –Ga2 O3 interface werd geschat op 1,3–1,5 eV.
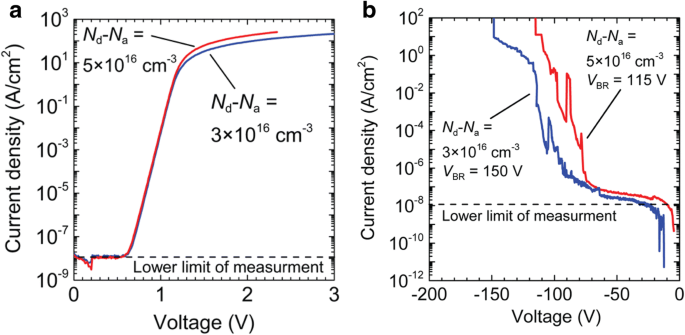
een , b Voorwaartse en achterwaartse elektrische kenmerken van de SBD op basis van (010) β -Ga2 O3 substraten met verschillende dopingconcentraties. De ondergrens van de meting van de stroomdichtheid is 10 -8 A/cm 2 . Herdrukt van ref. [62]
Onderzoekers van het Institute of Microelectronics of Chinese Academy of Sciences (IMECAS) en de Shandong University hebben samengewerkt om de SBD te onderzoeken op basis van (100)-georiënteerde β –Ga2 O3 bulksubstraat. In 2017 meldden ze een Pt/β –Ga2 O3 SBD en zijn temperatuurafhankelijke elektrische eigenschappen. Röntgendiffractie (XRD) en transmissie-elektronenmicroscopie met hoge resolutie (HRTEM) analyse toonden aan dat de β –Ga2 O3 bulk eenkristal gegroeid door edge-defined film-fed growth (EFG) techniek vertoonde een goede (100) oriëntatie en goede kristalkwaliteit (figuren 6a, b). Door middel van IV-metingen en thermionische emissiemodellering werd de gefabriceerde Pt/β –Ga2 O3 SBD-apparaat vertoonde goede prestaties, inclusief rectificatieverhouding van 10 10 , idealiteitsfactor (n ) van 1.1, Schottky-barrièrehoogte (Φ B ) van 1,39 eV, drempelspanning (V twee ) van 1,07 V, aan-weerstand (R aan ) van 12,5 mΩ cm 2 , voorwaartse stroomdichtheid bij 2 V (J @2V ) van 56 A/cm 2 , en effectieve donorconcentratie (N d − N een ) van 2,3 × 10 14 cm −3 (Fig. 6c, d). Goede temperatuurafhankelijke prestaties werden ook gevonden in het apparaat (afb. 6e, f). Met de toename van de temperatuur, R aan en J @2V werd beter, wat aantoont dat het apparaat goed kon werken bij hoge temperaturen. In hun volgende werk onderzochten ze de temperatuurafhankelijkheid van de idealiteitsfactor en de Schottky-barrièrehoogte verder en ontdekten dat dit soort temperatuurkenmerken verklaard kunnen worden door de Gauss-verdeling van de inhomogeniteit van de barrièrehoogte [61]. In 2018 hebben ze de kristalgroeiparameters verder geoptimaliseerd en de Sn-dopingconcentratie verbeterd (N d − N een = 2.3 × 10 14 cm −3 ). De nieuwe Pt/β –Ga2 O3 SBD-apparaat vertoont duidelijk verbeterde prestaties, inclusief voorwaartse stroomdichtheid (J @2V = 421 A/cm 2 ), ON-status weerstand (R aan = 2.9 mΩ cm 2 ), een korte omgekeerde hersteltijd (20 ns) en een omgekeerde doorslagspanning hoger dan 200 V [63]. Hun werk geeft aan dat EFG β . is gegroeid –Ga2 O3 eenkristal is een veelbelovende toepassing voor stroomapparaten.

een Röntgendiffractie (XRD) curve van (100) β -Ga2 O3 eenkristalsubstraat, dat duidelijk de toppen van (400), (600) en (800) vlakken laat zien. b Transmissie-elektronenmicroscoop (HRTEM) beeld met hoge resolutie van Pt/β -Ga2 O3 Schottky-contact en snelle Fourier-getransformeerde (FFT) microfoto van β -Ga2 O3 kristal. c Voorwaartse en achterwaartse J–V-curve van een Pt/β -Ga2 O3 SBD en het schema van de SBD (inzet). d Voorwaartse J-V-curve in lineaire en semi-logaritmische plot. e Temperatuurafhankelijke J-V-curven en de Richardson-plot (inzet). v Afhankelijkheid van AAN-weerstand en voorwaartse stroomdichtheid op temperatuur. Herdrukt van ref. [60]
Q. Feng et al. van de Xidian University hebben de voorbereidingsprocessen voor pulsed laser deposition (PLD) en de fysieke basiseigenschappen van de met Al-gedoteerde β bestudeerd. –Ga2 O3 film [64,65,66]. Doping Al is in staat om de bandgap van β . af te stemmen –Ga2 O3 door verschillende Al-atoomverhoudingen op te nemen. Gebaseerd op dit soort Al-gedoteerde film, Ni/β -(AlGa)2 O3 SBD-apparaat werd gefabriceerd en gekarakteriseerd. De hoogte van de Schottky-barrière is 1,33 eV. De huidige aan-uit-verhouding en aan-weerstand bereiken 10 11 en 2,1 mΩ cm 2 , respectievelijk [65]. Ze bestudeerden ook de invloed van de temperatuur op de idealiteitsfactor en Schottky-barrièrehoogte en kwamen ook tot de conclusie dat deze temperatuurafhankelijkheidskenmerken van n en Φ B werden toegeschreven aan de inhomogeniteiten van de Schottky-barrière door aan te nemen dat er een Gauss-verdeling van de barrièrehoogte bestaat [66].
Met de ontwikkeling van de filmepitaxietechnologie werd halidedampfase-epitaxie (HVPE) gebruikt om Ga2 te laten groeien O3 film. Vanwege de voordelen van hoge snelheid van de epitaxie en hoge kwaliteit van de film, HVPE-gegroeid Ga2 O3 is zeer geschikt voor het vervaardigen van de driftlaag van de hoogspannings-SBD. In 2015 M. Higashiwaki et al. in het National Institute of Information and Communications Technology (NICT) groeide 7 μm dik licht gedoteerd (~ 1 × 10 16 cm −3 ) epitaxiale laag op de zwaar gedoteerde (N d − N een = 2.5 × 10 18 cm −3 ) (001) β- Ga2 O3 substraat via HVPE-methode en verder gefabriceerd SBD-apparaat. De C-V- en I-V-kenmerken van het apparaat bij verschillende temperaturen werden onderzocht. Er werd gewezen op de veranderingstrend van de Schottky-barrièrehoogte, drempelspanning, C-V- en I-V-curves met temperatuur. Afbeelding 7 toont de apparaatstructuur en de voorwaartse en achterwaartse J–V–T-curves [16]. Het bleek dat bij 21-200 ° C de barrièrehoogte bijna constant bleef. De voorwaartse en achterwaartse stroom kwamen goed overeen met respectievelijk het thermionische emissie (TE) en thermionische veldemissie (TFE) model. Hun resultaten toonden het potentieel aan van de toepassing van de Ga2 O3 SBD in stroomapparaten van de volgende generatie.
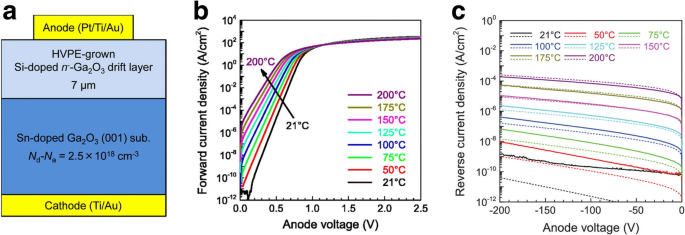
een Structuur van het SBD-apparaat op basis van de HVPE-gegroeide 7-μm dikke n − - Ga2 O3 homoepitaxiale driftlaag op n + - Ga2 O3 eenkristalsubstraat. b Voorwaartse J–V-kenmerken van het apparaat gemeten bij 21–200 °C. c Reverse J-V bij 21-200 ° C (ononderbroken en stippellijnen vertegenwoordigen respectievelijk de experimentele en gesimuleerde resultaten). Herdrukt van ref. [16]
In 2016 hebben M. Oda et al. in FLOSFIA Inc. publiceerde een werk over α -Ga2 O3 SBD [18]. Door middel van een mist-chemische dampafzetting (CVD)-techniek, d.w.z. MIST EPITAXY®, groeiden ze achtereenvolgens zwaar (3–4 μm dik) en licht gedoteerd α -Ga2 O3 films op saffier (Al2 O3 ) ondergronden. Na het optillen van de α -Ga2 O3 lagen van de substraten, kathode en anode werden afgezet op het onder- en bovenoppervlak van de n − - Ga2 O3 /n + - Ga2 O3 respectievelijk lagen (Fig. 8). Het apparaat met een 2580 nm dikke n − - Ga2 O3 laag vertoonde een hoge doorslagspanning van 855 V en een aan-weerstand van 0,4 mΩ cm 2 . Terwijl het apparaat met een dunnere (430 nm) n − - Ga2 O3 laag SBD's vertoonden een zeer lage aan-weerstand van 0,1 mΩ cm 2 en een doorslagspanning van 531 V. In 2018 meldden ze verder dat dit soort apparaten uitgevoerd waren met een TO220-pakket [67]. Er werd een junctiecapaciteit van 130 pF verkregen, dus het apparaat vertoonde een betere omgekeerde herstelkarakteristiek in vergelijking met SiC SBD en Si SBD. Tegelijkertijd vertoonde het apparaat na verpakking een thermische weerstand van 13,9 °C/W, vergelijkbaar met die van de SiC SBD met dezelfde verpakking (12,5 °C/W), wat aantoont dat het gebruik van een dunne driftlaag de nadeel van de slechte thermische geleidbaarheid van Ga2 O3 materiaal. In dit rapport wezen de auteurs er ook op dat α -(Rh,Ga)2 O3 kan fungeren als een effectieve p-type kanaallaag van α -Ga2 O3 apparaten.

Fabricageprocessen van de α -Ga2 O3 SBD voorgesteld door FLOSFIA Inc. Overgenomen van ref. [18, 67]
In 2017 hebben K. Konishi et al. in NICT meldde een Pt/HVPE-n − - Ga2 O3 /(001)n + - Ga2 O3 SBD-apparaat met een doorslagspanning van 1076 V en een aan-weerstand van 5,1 mΩ cm 2 (Afb. 9) [68]. Field plate (FP) engineering, een soort edge-termination-technologie, werd voor het eerst gebruikt in Ga2 O3 SBD. Door een anode toe te voegen aangesloten SiO2 FP, het maximale elektrische veld in de gehele apparaatstructuur werd onder het kritische veld gehouden, vooral het elektrische veld rond de anode kan duidelijk worden verminderd. Door gebruik te maken van deze methode kunnen zowel een hoge doorslagspanning als een lage aan-weerstand worden bereikt. In hetzelfde jaar werd een hogere doorslagspanning (1600 V) gemeld door J. Yang, et al. van de Universiteit van Florida in hun SBD-apparaat met een Ni/MOCVD-n − - Ga2 O3 /(− 201) n + - Ga2 O3 structuur [69], maar de aan-weerstand is erg groot (25 mΩ cm 2 ). Er is geen randafsluiting gebruikt. Uit hun onderzoek bleek dat de grootte van de Schottky-elektrode een invloed had op de doorslagspanning en de aan-weerstand, omdat een grotere elektrode meer defecten zou hebben en tot een gemakkelijkere doorslag zou leiden.
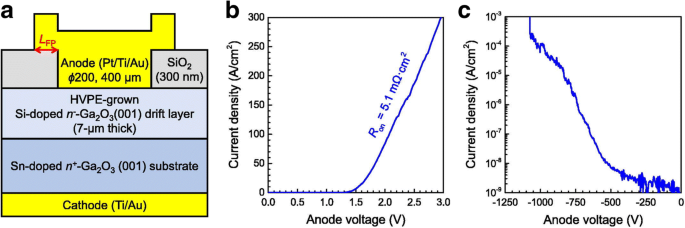
een Opbouw van de SBD met veldplaat. b , c Voorwaartse en achterwaartse elektrische kenmerken (V br = 1076 V). Herdrukt van ref. [68]
In 2017 hebben K. Sasaki et al. from Novel Crystal Technology Inc. first fabricated β -Ga2 O3 SBD with trench termination structure (Fig. 10) [70]. By adopting this kind of structure, the electric field in the Schottky junction can be effectively decreased; thus, the leakage current can be greatly reduced while the forward properties are well maintained. The on-resistance of the device was 2.9 mΩ cm 2 , and the breakdown voltage reached about 240 V. At the same time, the threshold voltage was remarkably reduced compared with the previous reports. This work is a valuable exploration on the advanced fabrication process of Ga2 O3 SBD. In the 2nd International Workshop on Gallium Oxide and Related Materials (IWGO 2017) held in Italy, they further reported the improved trench SBD. The threshold voltage decreased to 0.5 V. On-resistance was 2.4 mΩ cm 2 , and breakdown voltage was over 400 V. Compared to the commercialized 600 V SiC SBD, the improved trench Ga2 O3 SBD exhibited superiority in switching loss.
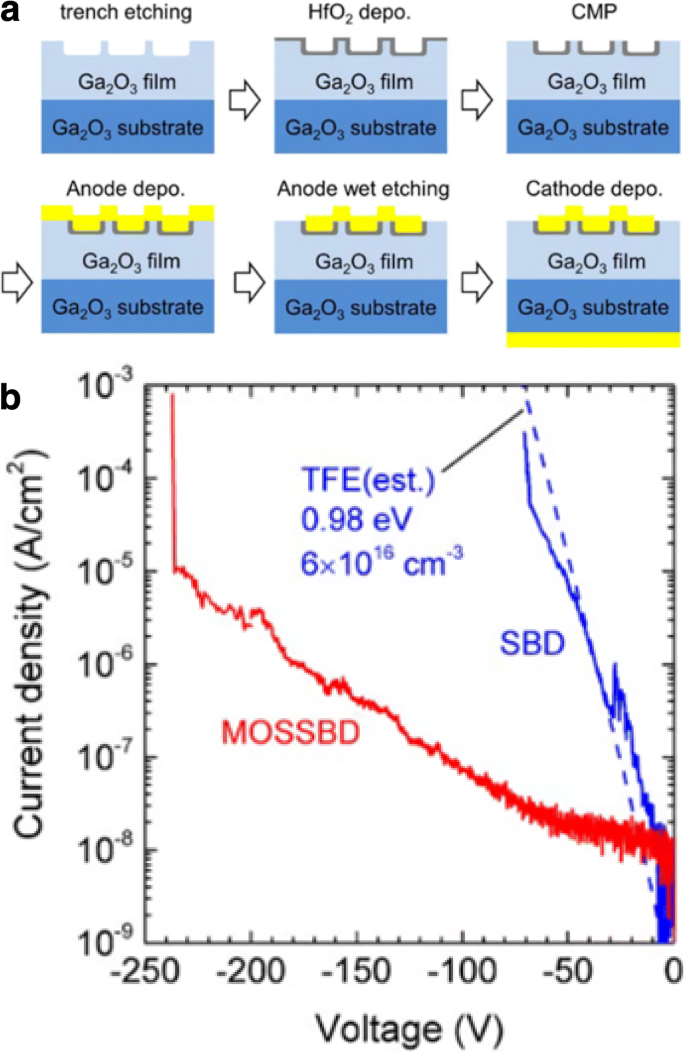
een Fabrication processes of the MOS-type Ga2 O3 SBD with trench termination structure. b Comparison of the reverse characteristics of the Ga2 O3 SBDs with and without trenches. Reprinted from ref. [70]
To date, there has been no effective p-type doping in Ga2 O3 , so bipolar devices are not easy to be realized. In 2017, T. Watahiki et al. from Mitsubishi Electric Corporation reported a heterojunction p-Cu2 O/n-Ga2 O3 p-n diode without local termination structure [71]. Figure 11 shows the schematic, band diagram and J–V curves of this p-n diode. Pt/Ga2 O3 SBD was simultaneously fabricated and measured for comparison. The breakdown voltage of the p-n diode reached as high as 1.49 kV. The on-resistance was 8.2 mΩ cm 2 , much lower than that of the SBD with a thick drift layer reported by J. Yang et al. [69]. So, it can be found that bipolar Ga2 O3 device has a certain advantage over unipolar device in regard to the low on-resistance. This work provides a possible solution for the design Ga2 O3 -based bipolar devices. However, this p-n diode exhibited a high threshold voltage (1.7 V). Moreover, in bipolar device, there is the minority carrier storage effect. With the improvement of SBD device structure, this p-n diode appears to show significant competitivity in the aspect of 600–1200 V voltage-resistant level and high frequency. It is believed that with the continuous exploration on the materials, SBD might still be a more effective approach for development of the high-voltage Ga2 O3 device before the successful preparation of p-type Ga2 O3 .
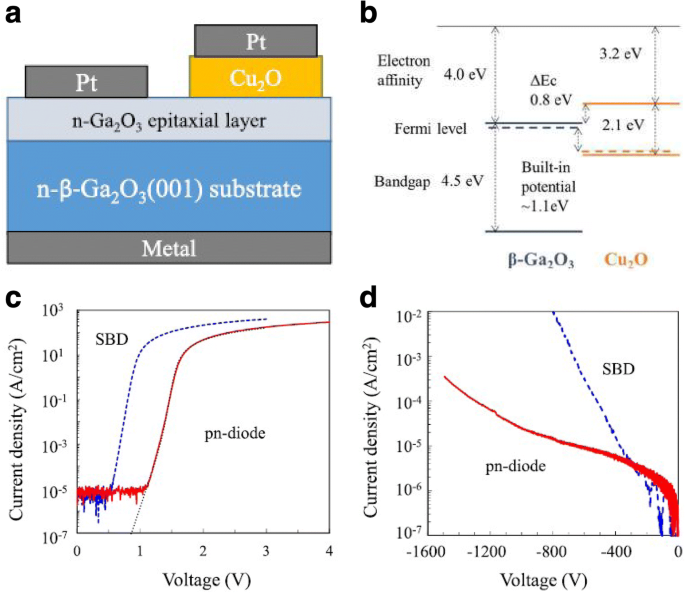
een Schematic of the cross-sectional Pt/Ga2 O3 SBD and p-Cu2 O/n-Ga2 O3 diode. b Band diagram of the p-Cu2 O/n-Ga2 O3 interface. c , d Forward and reverse J–V characteristics of the SBD and p-n diode. Reprinted from ref. [71]
In practical applications, SBD is usually used to rectify the AC or pulse signals as a rectifier in a circuit. It should work at different frequencies. Q. He et al. from IMECAS investigated the rectification characteristics of the Pt/Ga2 O3 SBD under the AC frequency under 10 kHz to 1 MHz by using a half-wave rectification circuit (Fig. 12) [63]. The testing result proves that the device has the ideal working frequency of 100 kHz, which is equivalent to that of SiC. This work is beneficial for people to further explore how Ga2 O3 Schottky rectifier can operate at higher frequency and also to construct power circuit modules based on Ga2 O3 SBD single device.

een Rectification circuit. b –e Rectifying effect of Pt/Ga2 O3 SBD on the AC signals under frequency of 10 kHz, 100 kHz, 500 kHz, and 1 MHz. Reprinted from ref. [63]
Table 2 lists and compares the basic performance parameters of some typical Ga2 O3 Schottky barrier diode reported since 2012. From this table, it is apparent that with the improvement of device structure and fabrication processes, the performances are getting better and better.
Conclusies
Currently, Ga2 O3 SBD is still in its early stage. With the continuous development of fabrication processes, device structure becomes more and more complicated. At the same time, the improvement of the quality of single-crystal substrates and epitaxial films also significantly push forward device performances. However, to date, the development process of Ga2 O3 SBD is very similar to those of previous Si SBD and SiC SBD. Furthermore, the research works on the intrinsic properties of Ga2 O3 materials are still very few. But it is believed that on the basis of its ultrawide bandgap of 4.7–4.9 eV and the development of device structure, Ga2 O3 will better display its unique application value, which requires the joint efforts of the researchers.
Afkortingen
- AC:
-
Alternating current
- BFOM:
-
Baliga’s figure of merit
- CVD:
-
Chemische dampafzetting
- EFG:
-
Edge-defined film-fed growth
- FFT:
-
Fast Fourier transform
- FP:
-
Field plat
- FZ:
-
Floating zone
- HRTEM:
-
Transmissie-elektronenmicroscopie met hoge resolutie
- HVPE:
-
Halide vapor-phase epitaxy
- IMECAS:
-
Institute of Microelectronics of Chinese Academy of Sciences
- MOCVD:
-
Metal-organic chemical vapor deposition
- MOSFET:
-
Metal-oxide-semiconductor field-effect transistor
- NICT:
-
National Institute of Information and Communications Technology
- PLD:
-
Gepulseerde laserdepositie
- SBD:
-
Schottky barrier diode
- TE:
-
Thermionic emission
- TFE:
-
Thermionic field emission
- WBG:
-
Wide bandgap
- XRD:
-
Röntgendiffractie
Nanomaterialen
- De beste kwaliteit oplosmiddelkleurstoffen kiezen voor een perfecte applicatie
- WiFi-locatietracking:is dit de juiste technologie voor uw toepassing?
- 10 factoren voor het vinden van de perfecte switch voor uw toepassing
- De kracht van slimme steden benutten voor een betere toekomst
- In elektronica wil India een 'fabriek voor de wereld' worden
- De zoektocht naar een reservegenerator:4 essentiële vragen
- De beste productiemogelijkheden voor elektronicabehuizingen
- Een snel overzicht van de vooruitzichten voor de kraanmarkt voor de komende jaren
- De juiste stroomgenerator kiezen voor uw bedrijf
- Het juiste elektrodemateriaal voor uw weerstandslastoepassing
- Hoe u het juiste filter kiest voor uw toepassing



