Afhankelijkheid van dikte van grensvlak- en elektrische eigenschappen in atoomlaag afgezet AlN op c-vlak GaN
Abstract
De grensvlak- en elektrische eigenschappen van atomaire laag afgezet AlN op n-GaN met verschillende AlN-diktes werden onderzocht. Volgens capaciteit–spanning (C –V ) kenmerken, vertoonde het monster met een AlN van 7,4 nm dik de hoogste dichtheid van het grensvlak en de oxidevanger. Toen de AlN-dikte 0,7 nm was, vertoonden röntgenfoto-elektronspectroscopie (XPS) spectra de dominante piek geassocieerd met Al-O-bindingen, samen met geen duidelijke AlN-piek. De hoeveelheid overgebleven zuurstofatomen nabij het GaN-oppervlak bleek af te nemen voor het dikkere AlN. Er waren echter veel zuurstofatomen aanwezig over de AlN-laag, mits de zuurstofgerelateerde defecten, die uiteindelijk de dichtheid van de interfacetoestand verhoogden. De barrière-inhomogeniteit met thermionische emissie (TE) -model was geschikt om de voorwaartse biasstroom voor het monster met een 7,4-nm dik AlN te verklaren, wat niet juist was voor het monster met een 0,7-nm dik AlN. De omgekeerde lekstromen voor beide monsters met 0,7 en 7,4 nm dik AlN werden beter verklaard met Fowler-Nordheim (FN) in plaats van Poole-Frenkel-emissies.
Achtergrond
Vanwege de grote bandgap, de hoge elektronenverzadigingssnelheid en het hoge doorslagveld zijn III-nitridematerialen van groot belang, niet alleen voor opto-elektronische apparaten zoals blauwe lichtemitterende diodes (LED's), laserdiodes (LD's) en UV-detectoren, maar ook voor elektronische apparaten zoals hoge-elektronenmobiliteitstransistoren (HEMT's) en stroomapparaten [1,2,3,4]. Het realiseren van op GaN gebaseerde apparaten met hoge prestaties vereist een metaal/GaN-interface met een minimale dichtheid van de interfacetoestand, die kan fungeren als elektronenvallen of kan worden beperkt om de barrièrehoogten te moduleren volgens de metaalbewerkingsfunctie door het Fermi-niveau vast te pinnen [5, 6]. Voor andere op GaN gebaseerde technieken voor apparaatverbetering, sommige methoden, zoals coalescentie-overgroei van GaN-nanokolommen, niet-polaire m -plane GaN, nano-imprint GaN-template en semi-polaire GaN-nanostaafjes zijn ook aangetoond [7,8,9,10,11]. Onder III-nitride samengestelde halfgeleiders kan aluminiumnitride (AlN) worden toegepast op UV-detectoren, kortegolfstralers en detectoren, vanwege de hoge bandgap (∼ 6.2 eV), hoge thermische geleidbaarheid, hoge elektrische weerstand en lage uitzetting bij hoge temperaturen [12, 13]. Bovendien kan AlN worden afgezet in een complementair metaaloxide-halfgeleider (CMOS)-compatibel proces door atomaire laagafzetting (ALD) (~ -300 ° C), wat een groot voordeel is. Polykristallijne en amorfe ALD-gegroeide AlN-films kunnen worden gebruikt als diëlektrische laag voor micro-elektronische apparaten [14]. Ondanks de vooruitgang van AlN-groeitechnieken, vertoont ALD-gegroeid AlN nog steeds niet-stoichiometrische eigenschappen die een grote hoeveelheid zuurstofgerelateerde onzuiverheden bevatten [15]. De hoeveelheid zuurstofatomen in AlN kan de elektrische en optische eigenschappen van AlN sterk beïnvloeden [16].
Hoge k diëlektrische oxiden zoals Al2 O3 en HfO2 zijn gebruikt als een passiveringslaag in AlGaN/GaN-transistors met hoge elektronenmobiliteit (HEMT's) [17, 18]. Maar de vorming van Ga–O-bindingen aan de Al2 O3 Van de /(Al)GaN-interface is bekend dat deze een hoge dichtheid van diepe (en langzame) interfacetoestanden produceert [19]. Als alternatief passiveringsmateriaal met lage interfacetoestanden is AlN overwogen voor op GaN gebaseerde apparaten vanwege de kleinere roostermismatch met GaN [20, 21]. Bovendien is modulatie van elektrische eigenschappen zoals barrièrehoogten in metaal/halfgeleider (MS) contacten door het inbrengen van een zeer dunne oxidelaag gerapporteerd in GaN [22, 23]. Verhoging van de slagboomhoogte in Pt/HfO2 /GaN metaal-isolator-halfgeleider (MIS) diodes met een 5 nm dikke HfO2 laag werd gerapporteerd [22]. Het inbrengen van een MgO-laag van 3 nm op een Fe/GaN-grensvlak bleek de effectieve barrièrehoogte te verminderen tot 0,4 eV [23]. Er is echter nog steeds een beperkt aantal artikelen die rapporteren over de gemanipuleerde contacteigenschappen met ALD-gegroeid AlN op GaN. In dit werk hebben we AlN-lagen op n-GaN afgezet door ALD met verschillende diktes en de eigenschappen van de AlN/n-GaN-interface onderzocht.
Methoden
Materialen en apparaatfabricage
Hydride dampfase-epitaxie (HVPE)-gegroeid, ongedoteerd, c -vlak (0001) bulk GaN (dikte 300 m, dragerconcentratie 5 × 10 14 cm −3 , threading dislocatiedichtheid 1,5 × 10 7 cm −2 ) gekocht bij Lumilog werd in dit werk gebruikt. Nadat de wafel in kleine stukjes was gesneden, werden sommige ervan in een ALD-kamer geladen na een reinigingsproces in een HCl:H2 O (1:1) oplossing. Vervolgens werd de temperatuur verhoogd tot 350 ° C om de AlN-laag af te zetten. AlN-dunne films werden afgezet door een thermisch ALD-systeem (fabrikant:CN-1 in Korea; model:Atomic Classic) met behulp van trimethylaluminium (TMA) en NH3 als voorlopers. Drie verschillende dikke AlN-lagen (0,7, 1,5 en 7,4 nm) werden bereid door het aantal ALD-cycli te variëren. De diktes van AlN-film werden gemeten met behulp van een FS-1 multi-golflengte ellipsometer (fabrikant:Film Sense in de VS; model:FS-1). Om de elektrische eigenschappen van de films te onderzoeken, werden MIS-diodes gefabriceerd met een Pt Schottky-elektrode (diameter 500 m, dikte 50 nm) en een Al-achtercontact (dikte 100 nm). Als referentie werden ook Pt/n-GaN Schottky-diodes (d.w.z. zonder AlN-laag) vervaardigd.
Karakterisering
Temperatuurafhankelijke stroom-spanning (I –V –T ) metingen werden uitgevoerd met een HP 4155B halfgeleiderparameteranalysator na het plaatsen van monsters op een hete boorkop verbonden met een temperatuurregelaar, en capaciteit–spanning (C) –V ) metingen werden uitgevoerd met een HP 4284A LCR-meter. Röntgenfoto-elektronspectroscopie (XPS) metingen werden uitgevoerd met behulp van een monochromatische Al Κα Röntgenbron om het vormingsmechanisme bij de AlN/GaN-interface te observeren.
Resultaten en discussie
Figuur 1a-c toont de transversale scanning transmissie-elektronenmicroscopie (STEM) afbeeldingen rond de AlN-laag. De geschatte dikten van de AlN-lagen waren vergelijkbaar met de waarden van de ellipsometer. De typische semilogaritmische stroomdichtheid-spanning (J –V ) curven worden getoond in Fig. 2a. Vergeleken met het monster zonder AlN (d.w.z. referentiemonster), stegen de huidige waarden voor het monster met een 0,7 nm dik AlN en daalden voor de monsters met 1,5 en 7,4 nm dik AlN. Met behulp van het thermionische emissie (TE) -model [24] werd het voorwaartse voorspanningsstroomtransport van een Schottky-diode geanalyseerd om zowel de barrièrehoogte als de idealiteitsfactor te verkrijgen. De barrièrehoogten werden berekend op 0,77 (±-0,03), 0,61 (±-0,01), 0,83 (±-0,05) en 1,00 (±-0,08) eV voor de monsters met 0-, 0,7-, 1,5- en 7,4-nm- dik AlN, respectievelijk. De idealiteitsfactoren bleken 1,63 (±-0,18), 4,19 (±-0,16), 1,83 (±-0,33) en 1,57 (±-0,03) te zijn voor de monsters met een dikte van 0, 0,7, 1,5 en 7,4 nm. AlN, respectievelijk. Met een 0,7 nm dik AlN nam de barrièrehoogte af en nam de idealiteitsfactor toe. Met dikkere AlN-lagen was de idealiteitsfactor vergelijkbaar, maar de barrièrehoogte nam toe in vergelijking met het referentiemonster. In figuur 2c is te zien dat bij toenemende AlN-dikte de barrièrehoogte eerst afnam en vervolgens toenam als gevolg van de tunnelweerstand die wordt geïnduceerd door een dikke AlN-laag. Dit geeft aan dat ongeveer 0,7 nm een keerpunt is voor de hoogte van de barrière in termen van AlN-dikte.
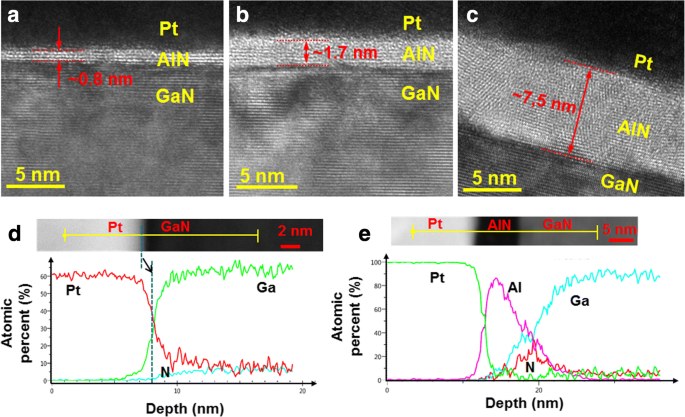
Cross-sectionele scanning transmissie elektronenmicroscopie (STEM) beelden met a 0,7-, b 1.5-, en c 7,4 nm dik AlN. d , e Atoompercentage versus diepteprofielen verkregen uit energiedispersieve röntgenspectroscopie (EDS) lijnscans voor de monsters met respectievelijk 0- en 7,4-nm dik AlN

een Typische semilogaritmische stroom-spanning (I –V ) kenmerken. b Barrièrehoogte versus idealiteitsfactorplots. c Barrièrehoogtes en idealiteitsfactoren als functie van AlN-dikte
Afbeelding 3 toont de C –V curven gemeten bij verschillende frequenties. Wanneer de AlN-diktes 0 en 0,7 nm zijn, werd de inversie in de capaciteitswaarden waargenomen onder 10 kHz. In plaats van inversie wordt normaal gesproken diepe uitputting waargenomen voor materialen met een brede bandgap zoals GaN vanwege de lage generatiesnelheid van minderheidsdragers (gaten) [25, 26]. Zoals getoond in Fig. 3c, d, werd een dergelijke inversie niet waargenomen voor dikkere AlN-lagen. Hier moet worden opgemerkt dat in de Au / GaN-overgang geen inversie werd waargenomen bij lage frequenties. Met behulp van transiënte spectroscopie op diep niveau (DLTS), Auret et al. waargenomen door e-beam geïnduceerde defecten in Pt/n-GaN Schottky-juncties [27]. Hier hebben we energiedispersieve röntgenspectroscopie (EDS) -metingen uitgevoerd en de diepteprofielen voor de monsters met 0- en 7,4-nm dik AlN worden respectievelijk getoond in Fig. 1d, e. In figuur 1d is duidelijk te zien dat Pt-atomen in de GaN-laag diffundeerden, terwijl de diffusie van Pt-atomen in de GaN-laag effectief werd onderdrukt vanwege de AlN-laag. Daarom zou het mogelijk zijn om te suggereren dat door Pt-afzetting veroorzaakte defecten nabij het GaN-oppervlak de inversiecapaciteit bij lage frequenties produceerden en dat de vorming van deze defecten werd onderdrukt met een relatief dikke AlN-laag (>-1, 5 nm).
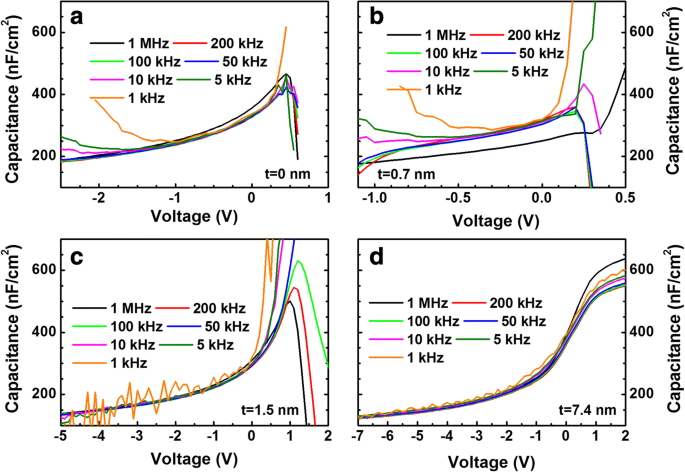
Capaciteit–spanning (C –V ) gegevens gemeten bij verschillende frequenties voor de monsters met a 0-, b 0,7-, c 1.5-, en d 7,4-nm dik AlN
Behalve het monster met een AlN van 7,4 dik, vertoonden alle andere monsters de afwijkende piek in de C –V curve met toenemende voorspanning, die verband hielden met de verdeling van diepe vallen in de opening, de serieweerstand en interfacetoestanden [28, 29]. De frequentiespreiding in het accumulatiegebied gaat gepaard met de vorming van een inhomogene laag op het grensvlak. De capaciteit van een dergelijke laag werkt in serie met de oxidecapaciteit die de dispersie in de accumulatie veroorzaakt [30]. De spreiding in uitputting is te wijten aan de aanwezigheid van interfacetoestanden die reageren op de toegepaste frequentie. Als de tijdconstanten van de interfacetoestanden vergelijkbaar zijn met de frequentie van een klein signaal, leveren de interfacetoestanden een zodanige bijdrage aan de totale capaciteit dat de drempelcapaciteit toeneemt bij verlaging van de frequentie [31].
Figuur 4 toont de conductantie-spanning (G /ω –V ) curven gemeten bij verschillende frequenties. Onder voldoende hoge voorwaartse en achterwaartse vooroordelen zouden de geactiveerde defecten effectiever kunnen communiceren met aangrenzende interfacetoestanden bij lage frequenties en daardoor de geleiding verhogen. Ongeveer in het bereik van -1 en 0 V vertoonden alle monsters de toename van de geleiding met toenemende frequentie. Dit gedrag werd prominenter voor het monster met een AlN van 7,4 nm dik. De toename van de geleiding bij het verhogen van de frequentie was geassocieerd met de recombinatiecentra die recombinatiestroom in het uitputtingsgebied bevorderen en de interfacetoestanden die laad- en ontlaadstroom of hopping-geleidingsproces bieden dat optreedt bij hoge frequentie [32]. De resultaten geven daarom aan dat interfacetoestanden met verschillende tijdconstanten aanwezig zijn voor alle monsters, en de aanwezigheid van dergelijke defecten is het meest significant voor het monster met een AlN van 7,4 nm dik.
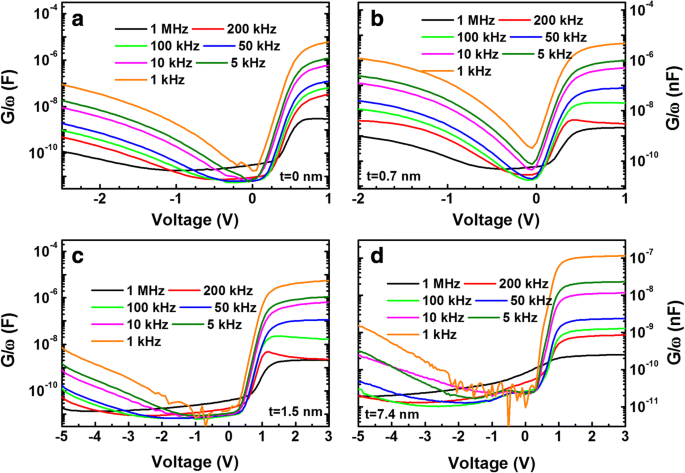
Geleidingsspanning (G /ω –V ) gegevens gemeten bij verschillende frequenties voor de monsters met a 0-, b 0,7-, c 1.5-, en d 7,4-nm dik AlN
Zoals getoond in Fig. 5a, een schatting van de dichtheid van de interfacetoestand (D het ) werd gemaakt door de Terman-methode toe te passen op de experimentele C–V curven gemeten bij 1 MHz [33]. De verkregen D het vs. E C –E t (locatie van de interfacestatus) wordt weergegeven in Fig. 5b. Hier hebben we de C–V . niet geanalyseerd kromme van het monster met een 0,7 nm dik AlN omdat het monster lek was en de exacte oxidecapaciteit (C OX ) was niet goed gedefinieerd. Het monster met een AlN van 7,4 nm dik vertoonde de hoogste dichtheid van de interfacetoestand, vooral voor E C –E t> 0,4 eV. Bovendien zijn de gemiddelde dichtheid van het grensvlak en de oxidevanger (Q T ) langs de GaN-bandgap (E g ) werden berekend door C . te analyseren –V hysteresisplots, met behulp van de flatband-spanningsverschuiving (ΔV FB ) door de vergelijking Q T = (C OX ΔV FB )/qE g [34]. De kleine vlakbandspanningsverschuiving en het kleine hysteresevenster duiden op een lage trapdichtheid. De inzet in Fig. 4b toont C –V hysterese plots. De ingevangen ladingsdichtheden werden berekend als 4,2 × 10 9 , 9,3 × 10 9 , en 3,6 × 10 11 cm −2 eV −1 voor de monsters met respectievelijk 0-, 1,5- en 7,4 nm dik AlN. De hysterese kan afkomstig zijn van de interface traps van AlN/GaN en de border (of bulk) traps in de AlN laag. Net als de Terman-methode onthulde de 7,4-nm dikke AlN-laag de hoogste dichtheid van het grensvlak en de oxidevanger. Daarom is het in dit voorbeeld mogelijk om te suggereren dat de grensvallen in de AlN-laag en de interface-vallen aanzienlijk hebben bijgedragen aan de verschuiving in C –V percelen.
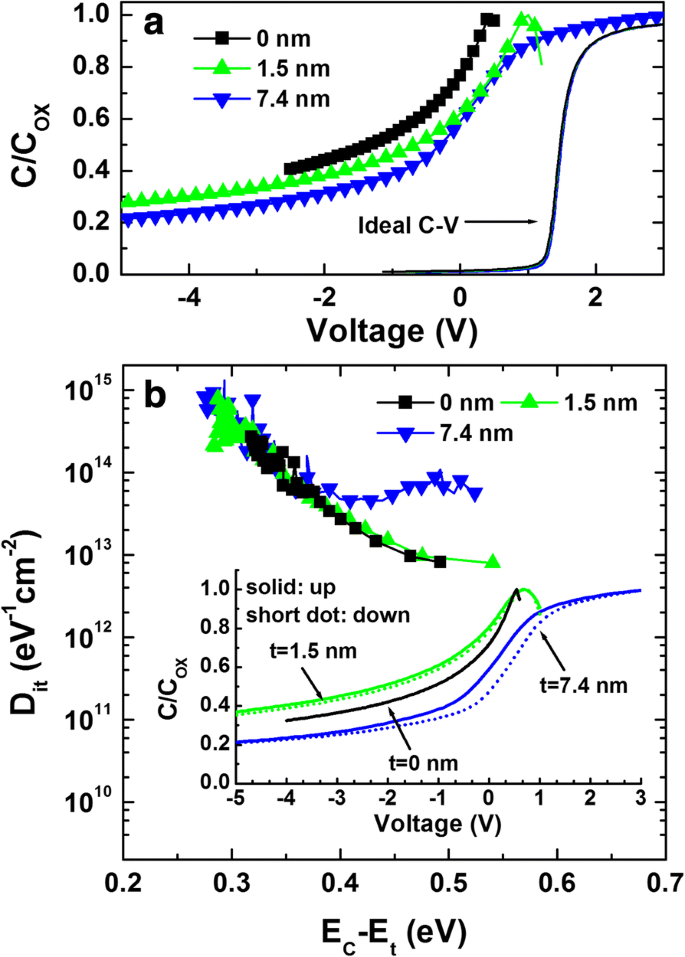
een Vergelijking van experimentele capaciteit-spanning (C –V ) gegevens gemeten bij 1 MHz en ideale C–V gegevens en b dichtheid van interfacestatus (D het ) verdelingen bepaald door toepassing van de Terman-methode voor de monsters met een AlN-laag van 0, 1,5 en 7,4 nm dik. De inzet in b toont de C –V hysteresisplots gemeten bij 1 MHz
De chemische samenstelling aan het AlN/GaN-interface werd onderzocht met behulp van XPS-metingen voor twee monsters met 0,7- en 7,4-nm dik AlN. Hier werd een sputter-etsbehandeling op het monster uitgevoerd met een AlN van 7,4 nm dik omdat de dikte van AlN te dik was om de exacte informatie in de buurt van de AlN/InP-interface te verkrijgen. Bare GaN werd ook als referentie aan het oppervlak gescand. Figuur 6a toont de XPS-diepteprofielen voor elk element verkregen uit het monster met een 7,4-nm dik AlN. De diffusie van Ga-atomen in de AlN-laag was duidelijk te zien. Er bleken vrij grote hoeveelheden zuurstofatomen aanwezig te zijn over de AlN-laag. Zowel O- als Al-atomen werden echter niet goed waargenomen in de buurt van het AlN / GaN-interface. De grotere hoeveelheid zuurstof nabij het AlN-oppervlak, vergeleken met het AlN/GaN-interface, geeft aan dat een aanzienlijk deel ervan het gevolg was van de atmosferische oxidatie, niet van het ALD-afzettingsproces zelf. Vervolgens selecteerden we de smal gescande XPS-spectra op één etsdiepte (dikte van het overgebleven AlN was ongeveer 1, 5-2, 0 nm) en vergeleken ze met de gegevens van andere monsters. Figuur 6b toont de Ga 2p 3/2 spectra op kernniveau. De pieken bij ~-1118,0 eV en ~-1119,2 eV voor zowel het kale GaN als het monster met een 0,7 nm dik AlN zijn geassocieerd met GaN en Ga2 O3 , respectievelijk [35, 36]. De piek bij ~-117.4 eV voor het monster met een AlN van 7,4 nm dik is te wijten aan Ga gebonden aan AlN [37]. We kunnen echter niet uitsluiten dat het afkomstig is van Ga2 O-piek (~ 1117,3 eV) [38].

een XPS-diepteprofielen voor elk element verkregen uit het monster met een AlN van 7,4 nm dik. XPS-spectra op kernniveau van b Ga 3p 3/2, c O 1s , en d Al 2p voor de monsters met 0-, 1.5- en 7.4-nm dik AlN
Zoals getoond in Fig. 6c, worden de pieken bij ~~530.2 en ~~531.9 eV toegeschreven aan de chemisch gesorbeerde O en Ga2 O3 , respectievelijk [39]. Bovendien is de piek bij ~-532,8 eV geassocieerd met Al-OH [40]. Er werd echter geen bijzondere piek waargenomen voor het monster met een 7,4-nm dik AlN op de geselecteerde diepte. Evenzo werd geen piek waargenomen bij de diepere etsdiepten (niet getoond). Wanneer de AlN-dikte dun is (0,7 nm), werden de chemisch gesorbeerde zuurstofatomen verwijderd maar Al-atomen gebonden met OH. Toen de AlN-dikte toenam, waren er zeer weinig zuurstofatomen aanwezig in de buurt van het GaN-oppervlak, wat wijst op het opruimende effect. Er waren echter grote hoeveelheden zuurstofatomen aanwezig in het overwoekerde AlN-gebied, mits oxideladingen. O 1s spectra op kernniveau op de etsdiepten waar de hoeveelheid Ga-atomen verwaarloosbaar is (ongeveer 0 ~ 3 nm van het AlN-oppervlak in Fig. 6a) bleken de dominante piek te vertonen bij ~ -531.8 eV, geassocieerd met Al2 O3 [41]. Dit betekent dat een deel van de AlN-laag is samengesteld uit Al2 O3 . Zoals getoond in Fig. 6d, wordt de piek gerelateerd aan AlN niet goed waargenomen voor het monster met een 0,7 nm dik AlN. In plaats daarvan worden twee pieken waargenomen bij ~ 74.1 en ~ 75.6 eV, geassocieerd met AlOx en Al-OH, respectievelijk [42]. Deze Al–O binding-gerelateerde pieken zoals AlOx en Al-OH kan fungeren als defecten. De piek bij ~-73,6 eV voor het monster met een AlN van 7,4 nm dik is geassocieerd met AlN [43].
De stroomtransporteigenschappen voor de monsters met 0,7- en 7,4 nm dik AlN werden verder onderzocht met behulp van temperatuurafhankelijke stroom-spanning (I –V –T ) afmetingen. Zoals getoond in Fig. 7, namen zowel de voorwaartse als de achterwaartse biasstroom in een vergelijkbare mate toe voor het monster met een dikte van 0,7 nm. Voor het monster met een AlN van 7,4 nm dik waren de omgekeerde lekstromen echter meer temperatuurafhankelijk dan de voorwaartse stromen. Onder omgekeerde voorspanning zou een hogere temperatuur thermische emissie van gaten kunnen veroorzaken vanuit de diepe niveaus in de AlN-valentieband en zo een nieuwe toevoer van elektronen introduceren [44]. Volgens inhomogeen barrièremodel [24] is de temperatuurafhankelijke effectieve barrièrehoogte (φ B ) is gerelateerd aan een nul-bias gemiddelde barrièrehoogte (\( {\overline{\varphi}}_B \)) en een standaarddeviatie (σ 0 ) als \( {\varphi}_B={\overline{\varphi}}_B-q{\sigma_0}^2/2 kT \). De σ 0 waarden werden verkregen als 0,147 en 0,204 V voor de monsters met respectievelijk 0,7 en 7,4 nm dik AlN. Met behulp van deze waarden kunnen de gewijzigde Richardson-plots van ln(I 0 /T 2 ) − q 2 σ 0 2 /2k 2 T 2 vs. 1/kT werden verkregen, getoond in Fig. 8a. De onderscheppingen op de ordinaat produceerden de Richardson-constanten van A ** als 397,3 en 27,1 A cm −2 K −2 voor de monsters met respectievelijk 0,7- en 7,4-nm dik AlN. De waarde voor het monster met een AlN van 7,4 nm dik is vergelijkbaar met de theoretische waarde van 26,4 A cm −2 K −2 voor n-GaN, wat aangeeft dat de barrière-inhomogeniteit met het TE-model het huidige transport kan verklaren. Voor het monster met een AlN van 0,7 nm dik is de waarde echter te hoog in vergelijking met de theoretische waarde, wat aangeeft dat het TE-model, zelfs inclusief de barrière-inhomogeniteit, het huidige transport niet kan verklaren. Figuur 8b toont de waarden van nkT als een functie van kT . De rechte lijn met hellingen van 1,15 komt goed overeen met de experimentele gegevens voor het monster met een 7,4-nm dik AlN met behulp van TE-model. Voor het monster met een 0,7 nm dik AlN bleek de helling echter 5,11 te zijn. Zo'n grote afwijking van eenheid zou kunnen voortvloeien uit de interfacetoestanden, isolatorlaag en tunnelstroom.
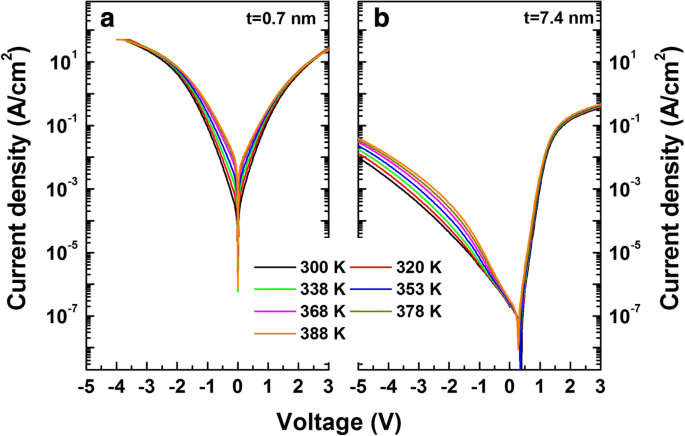
Temperatuurafhankelijke stroomdichtheid–spanning (J –V ) kenmerken voor de samples met a 0,7- en b 7,4-nm dik AlN
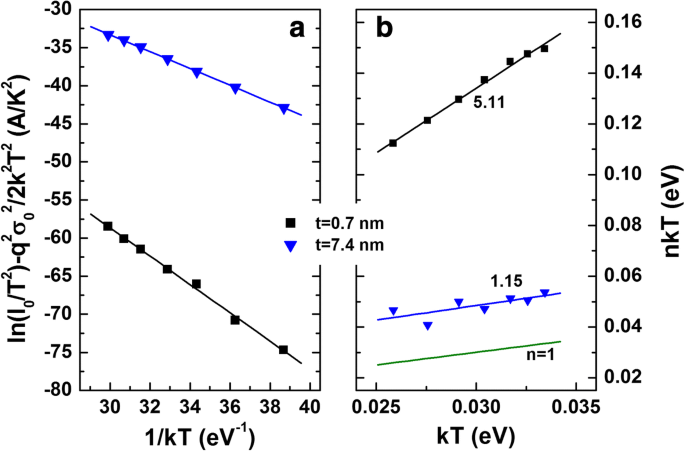
een Gewijzigde Richardson-plots en b nkT vs. kT plots met de lineaire aanpassingen aan de experimentele gegevens. In b , de lijn met een helling van 1 (n = 1) werd ook als referentie opgenomen
De omgekeerde lekstroomdichtheid werd geanalyseerd met behulp van het Fowler-Nordheim (FN) tunnelmodel, gegeven door [45].
$$ J=\alpha {E}^2\exp \left(-\beta /E\right) $$ (1)waar α = 1.54 × 10 −6 /m ∗ ΦB en β = 6.83 × 10 −7 (m ∗ ) 1/2 (ΦB ) 3/2 ; m * (m * = 0,30 voor AlN [46]) is de effectieve elektronenmassa in de isolator en ΦB is de tunneling barrière hoogte. Figuur 9a, b laat zien dat FN-emissie werd waargenomen voor de monsters met 0,7- en 7,4-nm dik AlN, wanneer de voorspanningen hoger zijn dan respectievelijk − 0,9 V en − 3 V. Hogere spanning voor het monster met een 7,4-nm dik AlN is te wijten aan het feit dat dikker AlN een hogere tunnelspanning nodig heeft. Van de helling getoond in Fig. 9 werden de tunnelingbarrièrehoogten bepaald voor elke temperatuur, die worden weergegeven in de inzet in Fig. 9b. Bij kamertemperatuur werden de barrièrehoogten voor de monsters met 0,7- en 7,4-nm dik AlN berekend op respectievelijk ongeveer 1,67 en 0,78 eV. Deze waarden zijn lager dan de gerapporteerde geleidingsband-offset van 2,58 eV bij AlN/GaN-interface [47]. De slechte grensvlakkwaliteit in de buurt van het AlN/GaN-interface zou zulke lagere waarden kunnen opleveren. De lagere barrièrehoogte voor het monster met een AlN van 7,4 nm dik kan ook worden geassocieerd met de hoge interface- en oxidevaldichtheid nabij de AlN/GaN-interface en zuurstofgerelateerde defecten in de AlN-laag. Als gevolg hiervan trad trap-geassisteerde tunneling gemakkelijker op en verhoogde de omgekeerde lekstroom.
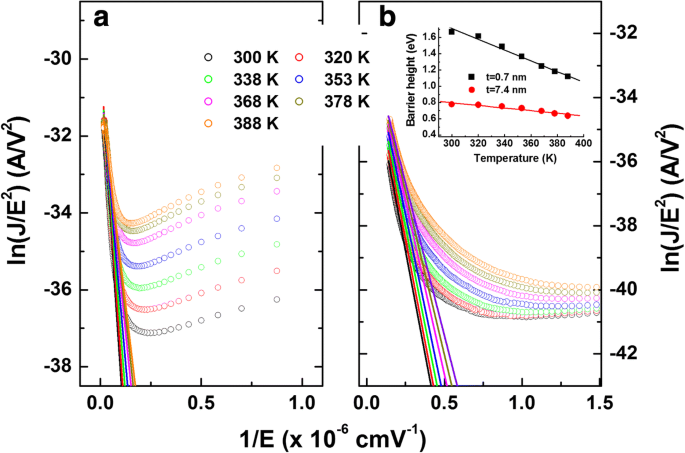
Fowler-Nordheim (FN) tunnelplots van ln(J .) /E 2 ) versus 1/E met de lineaire passingen op de experimentele gegevens voor de monsters met a 0,7- en b 7,4 nm dik AlN. De inzet in b presenteert de berekende barrièrehoogtes als functie van de temperatuur
Het Poole-Frenkel (PF) emissiemodel werd ook toegepast op de omgekeerde lekstroom, gegeven door [48].
$$ \ln \left(J/E\right)=m(T){E}^{1/2}+b(T)\Big) $$ (2)met
$$ m(T)=\frac{q}{kT}\sqrt{\frac{q}{{\pi \varepsilon}_0{\varepsilon}_{\mathrm{AlN}}}},b(T) =-\frac{q{\varphi}_t}{kT}+\ln C $$ (3)waar ϕ t is de hoogte van de elektronenemissiebarrière vanuit de traptoestanden, ε AlN is de relatieve diëlektrische permittiviteit van de poortisolator bij hoge frequentie (ε AlN 4.77 [49]), ε 0 is de permittiviteit van vrije ruimte, en C is een constante. De geldigheid van de PF-emissiearmatuur werd geverifieerd door de temperatuurafhankelijkheid van de lineaire coëfficiënt m . te controleren (T ) verkregen uit de lineaire fit van de PF-plots ln(J /E ) als functie van E 1/2 [50], weergegeven in Fig. 10. Vanaf de m (T ) waarden verkregen uit de lineaire aanpassing aan deze plots (inzet in Fig. 10a), ε AlN bleek 64,9 en 959,0 te zijn voor de monsters met respectievelijk 0,7 en 7,4 nm dik AlN. De verkregen waarden zijn te hoog in vergelijking met de theoretische waarde van 4,77, wat erop wijst dat de PF-emissie het huidige transport niet correct kan verklaren voor beide monsters. Daarom is FN-tunneling een meer geschikt transportmechanisme in de omgekeerde lekstroom.
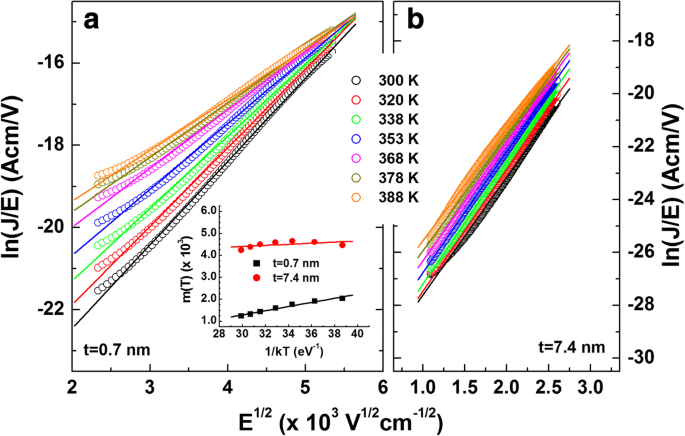
Poole-Frenkel (PF) emissiegrafieken van ln(J .) /E ) versus E 1/2/ met de lineaire aanpassing aan de experimentele gegevens voor de steekproef met a 0,7- en b 7,4 nm dik AlN. De inzet in a presenteert de berekende m (T ) waarden vs. temperatuur
Hoewel vgl. (1) bevat geen temperatuurafhankelijkheid, de verkregen barrièrehoogten namen af met toenemende temperatuur. De hellingen werden verkregen als -6,67 meV/K en -1,62 meV/K voor de monsters met respectievelijk 0,7- en 7,4-nm dik AlN. In de SiO2/4H-SiC-structuur is gerapporteerd dat de FN-tunneling een temperatuurafhankelijkheid heeft met een helling van -7,6 meV/K [51]. De uitgeworpen elektronen van de Pt-elektrode volgden de Fermi-Dirac-verdeling [52], en dus zou de omgekeerde lekstroom door de tunneling ook kunnen toenemen met de temperatuur. In dit geval zou de toename met de temperatuur groter zijn voor een dunnere AlN-laag.
Ondertussen is gemeld dat de huidige transportmechanismen bij een hoog elektrisch veld niet alleen kunnen worden verklaard door de FN-tunneling [53, 54]. Zelfs inclusief de veranderingen in de ladingen in het oxide- en Fermi-niveau van het substraat, en de elektronenenergieverdeling op de SiO2 /SiC-interface met temperatuur, de omgekeerde lekstroom in SiO2 /4H-SiC werd niet bevredigend verklaard [53]. Er werd voorgesteld dat thermisch geactiveerde PF-emissie van gevangen elektronen uit de grensvlak-elektronenvallen significant bijdraagt aan de toename van lekstroom [54]. Daarom is het verminderen van dergelijke defecten in AlN tijdens het ALD-proces cruciaal voor de prestaties van het op AlN/GaN gebaseerde apparaat, vooral tijdens gebruik bij hoge temperaturen.
Zoals blijkt uit de grafiek van barrièrehoogte versus AlN-dikte in Fig. 2c, Li et al. vergelijkbaar gedrag waargenomen in metaal/n-Ge-contacten met Y2 O3 lagen [55]. Ze schreven de vermindering van de barrièrehoogte toe aan de onderdrukking van de onstabiele GeOx groei en de passivering van bungelende bindingen op het Ge-oppervlak. Karpov et al. ingevoegd Si3 N4 laag in Ni/n-GaN-contacten en ontdekte dat de barrièrehoogte afnam van 0,78 naar 0,27-0,30 eV met een Si3 N4 laag. De resultaten werden verklaard door de dipoolvorming aan de Si3 N4 /GaN-interface [56]. Verder Zheng et al. onderzocht de contactweerstand vs. Al2 O3 dikte in Al/n-SiC-structuur en ontdekte dat de interface-dipool zich begon te vormen bij een dikte van 1,98 nm [57]. Boven deze dikte nam de contactweerstand eerst af als gevolg van het dipooleffect en nam vervolgens toe door de verhoogde tunnelweerstand. Volgens XPS-gegevens in Fig. 6 is de vorming van een AlN-laag onduidelijk voor het monster met een 0,7 nm dik AlN. Daarom is de vermindering van de barrièrehoogte met een 0,7 nm dik AlN eerder te wijten aan het passiveringseffect dan aan de vorming van een interface-dipool.
Droog etsproces zoals inductief gekoppeld plasma (ICP) etsen wordt veel gebruikt in op GaN gebaseerde apparaten vanwege de chemische stabiliteit van GaN [58], hoewel ultraviolet-versterkte nat chemisch etsen werd aangetoond [59]. Een droog etsproces kan echter schade aan het GaN-oppervlak veroorzaken, waardoor de lekstroom toeneemt en het rectificatiegedrag verslechtert. Post-etsbehandeling met behulp van thermisch uitgloeien en KOH-oplossing na reactief ionenetsen (RIE) bleek de oppervlakteschade op GaN [60] effectief te verwijderen. Gezien de resultaten tot nu toe, stellen we voor dat AlN-afzetting (groter dan 1 nm) kan worden toegepast om de schade aan het geëtste GaN-oppervlak te verminderen, wat naar verwachting de interfacekwaliteit en de corrigerende eigenschappen verder zal verhogen.
Conclusies
We hebben de grensvlak- en elektrische eigenschappen onderzocht van atomaire laag afgezet AlN op n-GaN met verschillende AlN-diktes. Volgens capaciteit–spanning (C –V ) kenmerken, vertoonde het monster met een 7,4-nm dik AlN de hoogste dichtheid van het grensvlak en de oxidevanger. Volgens metingen met röntgenfoto-elektronspectroscopie (XPS) onthulde het monster met een 0,7 nm dik AlN een dominante piek gerelateerd aan Al-O-bindingen, zonder duidelijke piek geassocieerd met AlN. De overgebleven zuurstofatomen nabij het GaN-oppervlak bleken erg klein te zijn voor het monster met een AlN van 7,4 nm dik. Aan de andere kant bleken er veel zuurstofatomen aanwezig te zijn over de AlN-laag, wat zorgde voor de zuurstofgerelateerde defecten in de AlN-laag. Analyses van de omgekeerde lekstroom lieten zien dat Fowler-Nordheim (FN) in plaats van Poole-Frenkel (PF) emissie geschikter was om het huidige transport voor de monsters met 0,7 en 7,4 nm dik AlN te verklaren.
Afkortingen
- ALD:
-
Atoomlaagafzetting
- AlN:
-
Aluminiumnitride
- C –V :
-
Capaciteit–spanning
- FN:
-
Fowler–Nordheim
- J –V :
-
Stroomdichtheid–spanning
- PF:
-
Poole–Frenkel
- TE:
-
Thermionische emissie
- XPS:
-
Röntgenfoto-elektronenspectroscopie
Nanomaterialen
- Geavanceerde atoomlaagdepositietechnologieën voor micro-LED's en VCSEL's
- Kenmerken van grensvlak-, elektrische en banduitlijning van HfO2 / Ge-stapels met in situ gevormde SiO2-tussenlaag door plasma-versterkte atomaire laagafzetting
- Optische en elektrische kenmerken van silicium nanodraden bereid door stroomloos etsen
- De antibacteriële polyamide 6-ZnO hiërarchische nanovezels vervaardigd door afzetting van atoomlagen en hydrothermische groei
- Onderzoek naar oppervlaktepolarisatie van Al2O3-capped GaN/AlGaN/GaN heterostructuur door middel van hoek-opgeloste röntgenfoto-elektronspectroscopie
- Fotokatalytische eigenschappen van Co3O4-gecoate TiO2-poeders bereid door plasma-versterkte afzetting van atoomlagen
- Effecten van dubbellaagse dikte op de morfologische, optische en elektrische eigenschappen van Al2O3/ZnO-nanolaminaten
- De oppervlaktemorfologieën en eigenschappen van ZnO-films afstemmen door het ontwerp van grensvlakken
- Fermi-niveau-afstemming van ZnO-films door middel van supercyclische atoomlaagafzetting
- Afhankelijkheid van de toxiciteit van nanodeeltjes van hun fysische en chemische eigenschappen
- Effecten van grootte en aggregatie/agglomeratie van nanodeeltjes op de grensvlak-/interfase-eigenschappen en treksterkte van polymeernanocomposieten



