Recente ontwikkelingen in β-Ga2O3-metalen contacten
Abstract
Ultrabrede bandgap bèta-galliumoxide (β-Ga2 O3 ) heeft veel aandacht getrokken als een veelbelovend halfgeleidermateriaal voor de volgende generatie vermogenselektronica. Het heeft uitstekende materiaaleigenschappen, zoals een brede bandgap van 4,6-4,9 eV, een elektrisch veld met hoge doorslag van 8 MV/cm en een uitzonderlijke Baliga's figure of merit (BFOM), samen met superieure chemische en thermische stabiliteit. Deze kenmerken suggereren het grote potentieel voor toekomstige toepassingen in stroom- en opto-elektronische apparaten. Het kritieke probleem van contacten tussen metaal en Ga2 O3 beperkt de prestaties van β-Ga2 O3 apparaten. In dit werk hebben we de vorderingen op contacten van β-Ga2 . bekeken O3 MOSFET's. Om de contacteigenschappen te verbeteren, worden vier hoofdbenaderingen samengevat en in detail geanalyseerd, waaronder voorbehandeling, nabehandeling, meerlagige metalen elektrode en het introduceren van een tussenlaag. Ter vergelijking:de laatste twee methoden worden intensief bestudeerd en zijn gunstiger dan de voorbehandeling die onvermijdelijk tot oncontroleerbare schade zou leiden. Tot slot worden conclusies en toekomstperspectieven gepresenteerd om Ohmic contacten verder te verbeteren.
Inleiding
Onlangs is galliumoxide (Ga2 O3 ) wordt beschouwd als een veelbelovende kandidaat voor het maken van apparaten met een hoog vermogen en een hoog rendement vanwege zijn uitstekende materiaaleigenschappen [1,2,3]. Ga2 O3 heeft vijf verschillende polymorfen, aangeduid als α-Ga2 O3 , β-Ga2 O3 , γ-Ga2 O3 , δ-Ga2 O3 , en ε-Ga2 O3 , waaronder β-Ga2 O3 is het meest thermodynamisch stabiel en is uitgebreid bestudeerd [4]. Met een ultrabrede bandgap van 4,6–4,9 eV [5,6,7], is het theoretische doorslag-elektrische veld (E br ) van 8 MV/cm voor β-Ga2 O3 is ongeveer drie keer groter dan die van SiC of GaN [8,9,10], wat β-Ga2 mogelijk maakt O3 -gebaseerde apparaten om gigantische schakelspanningen aan te kunnen. De geschiktheid van halfgeleiders voor toepassingen in elektrische apparaten wordt meestal beoordeeld aan de hand van Baliga's figuur van verdienste (BFOM) [11]. De BFOM van β-Ga2 O3 is bijna drie keer zo hoog als die van SiC en GaN, waardoor het geleidingsverlies aanzienlijk wordt verminderd [3, 12,13,14]. Bovendien wordt de verzadigingselektronensnelheid theoretisch geschat op ongeveer 2 × 10 7 cm/s, waardoor het aantrekkelijk is voor hoogfrequente operaties [15,16,17,18,19,20]. Een ander onderscheidend belang van β-Ga2 O3 van halfgeleiders met een brede bandgap is dat hoogwaardige eenkristallen kosteneffectief kunnen worden gesynthetiseerd door gebruik te maken van smeltgroeitechnieken [21,22,23,24]. Bovendien is hoogwaardige n-type β-Ga2 O3 epitaxiale films kunnen worden gerealiseerd door precies te doteren met Sn, Si, Ge en Mg, en de verkregen elektronendichtheid varieert van 10 16 tot 10 19 cm −3 [25,26,27,28]. Vanwege de bovengenoemde voordelen ten opzichte van andere halfgeleiders met brede bandgap, is β-Ga2 O3 laat zien dat het een veelbelovend materiaal is voor vermogenselektronica en elektronica in extreme omgevingen (hoge temperatuur, hoge spanning en hoge straling).
Veel veelbelovende β-Ga2 O3 apparaten zijn gerapporteerd, waaronder Schottky-barrièrediodes [32], MOSFET's [1,2,3] en verschillende soorten zonneblinde fotodetectoren [33, 34]. Van deze apparaten zijn MOSFET's de meest voorkomende configuratie voor radiofrequentie en krachtige werking [35], waardoor de hoge E volledig wordt benut. br en BFOM. Een van de uitdagingen voor β-Ga2 O3 toepassing in MOSFET-apparaten is de moeilijkheid bij het vormen van Ohmse contacten in vergelijking met halfgeleiders met smalle bandgap [36]. Gewoonlijk is een uitstekend Ohms contact tussen de halfgeleider en de metalen elektrode essentieel voor hoogwaardige halfgeleiderinrichtingen [37, 38]. Contacten met een lage weerstand kunnen de spanningsval op het contact verminderen en bijgevolg de spanning over het kanaal verhogen, waardoor de ontworpen stroomdichtheid en hoge schakelsnelheden worden gewaarborgd. Bovendien dragen contacten met een lage weerstand bij aan het verminderen van de warmteontwikkeling, wat het zelfverhittingseffect zou kunnen verergeren.
Daarom is de fabricage van hoogwaardige Ohmse contacten een voorwaarde voor het bereiken van hoogwaardige apparaten. In deze review beginnen we met fundamentele concepten van metaal/halfgeleidercontacten. In het gedeelte "Benaderingen van Ohmse contacten" vindt u een samenvatting van recente belangrijke ontwikkelingen op het gebied van Ohmse contacten voor β-Ga2 O3 wordt gepresenteerd en benaderingen van Ohmse contacten worden besproken en geanalyseerd. Ten slotte worden enkele perspectieven gegeven voor het verbeteren van Ohmse contacten tot β-Ga2 O3 in de toekomst.
Basisfysica van ohmse contacten
Een ohms contact is een metaal/halfgeleiderovergang waarbij er geen barrière is op de interface die het transport van dragers belemmert, zoals geïllustreerd in figuur 1a. Integendeel, een energiebarrière die aan het grensvlak bestaat, zal het transport van de drager tussen het metaal en de halfgeleider belemmeren, zoals blijkt uit figuur 1b. Met name de contacten die worden gevormd tussen halfgeleiders met een brede bandafstand en metalen zijn altijd Schottky. De contactweerstand hangt dus normaal gesproken af van de Schottky-barrièrehoogte van metaal/halfgeleider (SBH) ΦB . Voor een n-type halfgeleider voldoet het aan de vergelijking:
$$ {q\Phi}_B={q\Phi}_m-{\chi}_s $$ (1)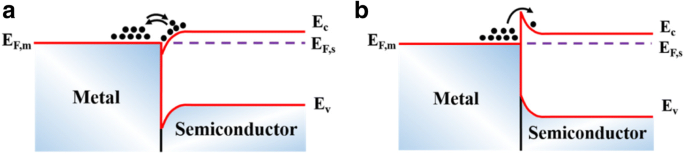
Schematische illustraties van a Ohmse contacten en b Schottky-contacten. E C , E V , E F , m , en E F , s zijn de energieniveaus van respectievelijk de geleidingsbandrand, valentiebandrand, Fermi-energie van metaal en halfgeleider
waar Φm is de werkfunctie van het metaal en χ s is de elektronenaffiniteit van de halfgeleider.
Zoals afgebeeld in Vgl. (1), het is belangrijk om de SBH te verminderen om het Ohmse contact te vormen. Bovendien zou een hoge dotering in halfgeleiders de vorming van Ohmse contacten kunnen vergemakkelijken, bijvoorbeeld voor zwaar gedoteerde halfgeleiders (ND> ~ 10 18 cm −3 ), zal de barrière smal genoeg worden en de elektronen rechtstreeks door het grensvlak laten tunnelen als gevolg van een aanzienlijke bandverbuiging van de geleidingsband [39], zoals weergegeven in figuur 2. Desalniettemin zijn de dopingniveaus die kunnen worden bereikt in β- Ga2 O3 zijn meestal lager dan wat in Si kan worden verkregen, zoals het geval is bij andere brede halfgeleiders. Afgezien daarvan spelen de oppervlaktetoestanden ook een belangrijke rol bij de vorming van Ohmse contacten, die vaak worden gedefinieerd als gebieden van snelle recombinatie. Die middelste bandgap-defectniveaus die worden veroorzaakt door de oppervlaktetoestanden, kunnen de dragers helpen transporteren. Dit houdt in dat een goed Ohms contact kan worden gevormd door de juiste oppervlaktetoestanden in halfgeleiders te introduceren [40,41,42,43].
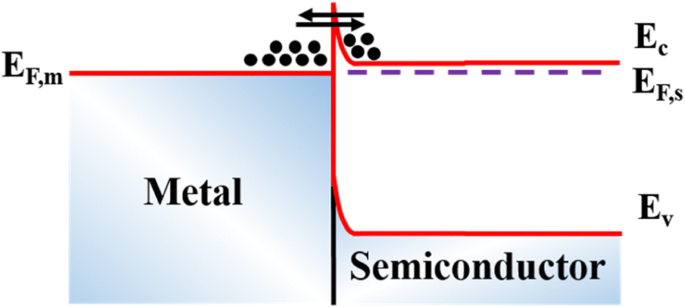
Het energiebanddiagram op de metaal/halfgeleiderinterface met sterk gedoteerde halfgeleiders
Een elektrische kwantificering van de contactkenmerken is noodzakelijk om de kwaliteit van contacten te evalueren. Momenteel is de specifieke contactweerstand ρ C is een van de meest gebruikte parameters om toegang te krijgen tot de prestaties van Ohmse contacten, meestal uitgedrukt in Ω ∙ cm 2 [44]. De specifieke contactweerstand is een zeer bruikbare grootheid die onafhankelijk is van de contactgeometrie en alleen verwijst naar de metaal/halfgeleiderinterface. Tot nu toe de laagste ρ C van 4,6 × 10 −6 Ω ∙ cm 2 werd gemeld voor Ti/Au-contacten aan β-Ga2 O3 [45]. Wong et al. behaalde ook een lage ρ C van 7,5 × 10 −6 Ω ∙ cm 2 met Ti/Au-contacten [46]. Tot nu toe zijn er veel inspanningen geleverd om contact te krijgen met lage ρ C , en de typische waarden voor specifieke contactweerstanden verspreid over een bereik van 10 −5 –10 −6 Ω ∙ cm 2 voor goede Ohmse contacten [36].
Benaderingen van Ohmic-contacten
Tot op heden zijn onderzoeken naar de intrinsieke eigenschappen van β-Ga2 O3 zijn meestal uitgevoerd op de MOSFET-structuur, waarin gewoonlijk twee soorten van de kanaalsynthesemethode worden toegepast. Een daarvan is de micromechanisch geëxfolieerde vlok (nanomembraan); de andere is de epitaxiale β-Ga2 O3 film op zijn oorspronkelijke substraat, zoals samengevat in tabel 1.
Normaal geëxfolieerd β-Ga2 O3 vlokken kunnen gemakkelijk en kosteneffectief op alle substraten worden overgebracht. Het is gebleken dat de materiaaleigenschappen van β-Ga2 O3 vlokken zouden niet degenereren tijdens de exfoliatie, zoals blijkt uit Raman-spectroscopie en atoomkrachtmicroscopie [19], wat betekent dat de prestaties van MOSFET's op basis van de geëxfolieerde vlokken vergelijkbaar zijn met die op basis van epitaxiale lagen. Vanwege deze voordelen wordt deze methode aanbevolen om de elektrische kenmerken te bestuderen, bestaande uit de dichtheid van grensvlakdefecten, doorslagspanning, optische fononverstrooiing aan het oppervlak [47,48,49] en thermische eigenschappen, dwz zelfverhittingseffect [50, 51].
Zoals samengevat in tabel 1, kunnen methoden die worden gebruikt om ohmse contacten te verbeteren in het algemeen worden onderverdeeld in drie typen:(1) voorbehandeling, (2) nabehandeling en (3) meerlagige metalen elektrode. Bovendien kan het introduceren van een tussenlaag ook superieure Ohmse contacten verkrijgen, wat niet wordt getoond in Tabel 1.
Voorbehandeling
De voorbehandeling wordt uitgevoerd vóór metaalafzetting, inclusief ionenimplantatie, plasmabombardement en reactieve ionenetsing (RIE). Higashiwaki et al. toonde aan dat de contacten gevormd met behulp van Ti/Au-stack met het RIE-voorbehandelingsproces een bijna Ohms gedrag vertoonden, terwijl het monster zonder de RIE-behandeling een Schottky-gedrag vertoonde, zoals geïllustreerd in Fig. 3 [1]. Het significante verschil kan worden toegeschreven aan het naar buiten diffunderen van de vrije zuurstofatomen die werden gegenereerd door het continue bombardement door de blootgestelde Ga-O-bindingen te verbreken, waardoor er voldoende zuurstofvacatures achterbleven die als donoren in β-Ga2 werken. sub> O3 . Aan de andere kant zou de continue RIE-behandeling ook aanzienlijke oppervlaktetoestanden genereren die een belangrijke rol spelen tijdens contactvorming [41]. Afbeelding 4 toont bijbehorende DC-uitgangskarakteristieken waaruit quasi-lineaire stroom bij lage afvoerspanning kan worden waargenomen. In hun latere werk, zoals aangetoond in figuur 5, vertoonden de uitgangskarakteristieken een goede lineariteitsrelatie tussen de stroom- en afvoerspanning waarin Si-ionenimplantatie en RIE werden toegepast op β-Ga2 O3 samen en een extreem lage specifieke contactweerstand van 8,1 × 10 −6 Ω∙cm 2 werd bereikt [12]. Het is duidelijk dat het Ohmse gedrag verkregen door RIE en Si + implantatie samen zou beter presteren dan alleen RIE, aangezien bekend is dat Si-atomen ondiepe donoren zijn met kleine activeringsenergieën in β-Ga2 O3 [34]. Bovendien, Zhou et al. meldde de krachtige β-Ga2 O3 veldeffecttransistoren met Ar-plasmabombardement voorafgaand aan contactmetaalafzetting [52]. Integendeel, het monster zonder Ar-bombardement vertoonde Schottky-contact. Het verschil kan worden toegeschreven aan het genereren van zuurstofvacatures en oppervlaktetoestanden tijdens het Ar-plasmabombardementsproces, hetzelfde als RIE-behandeling.
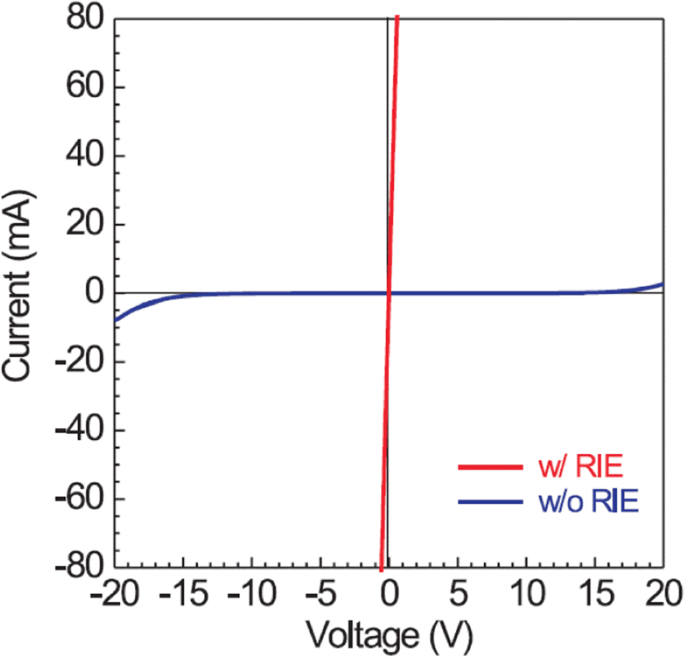
(kleur online) IV-curves gemeten tussen twee contacten (zoals gedeponeerd Ti/Au) vervaardigd met en zonder RIE-behandeling op n-Ga2 O3 substraten. Overgenomen van ref. [1]
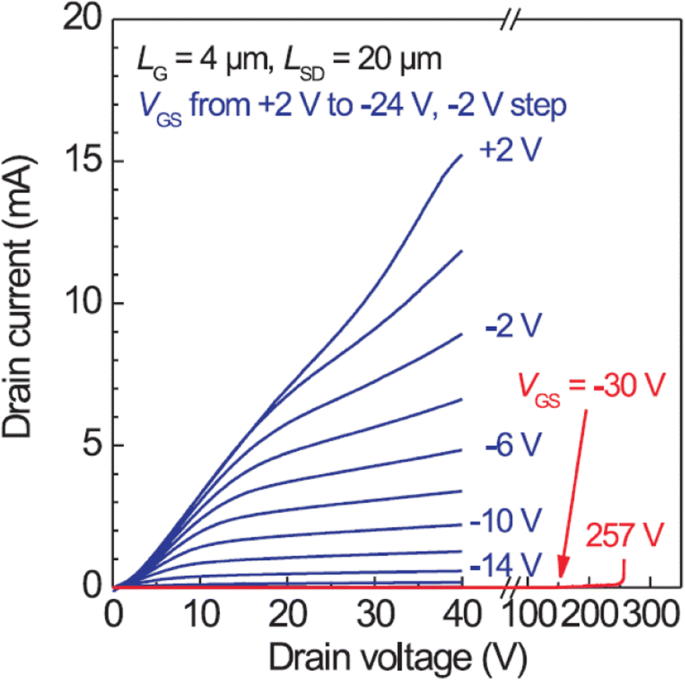
(kleur online) DC-uitgangskenmerken van Ga2 O3 metaal/halfgeleider veldeffecttransistoren. Overgenomen van ref. [1]
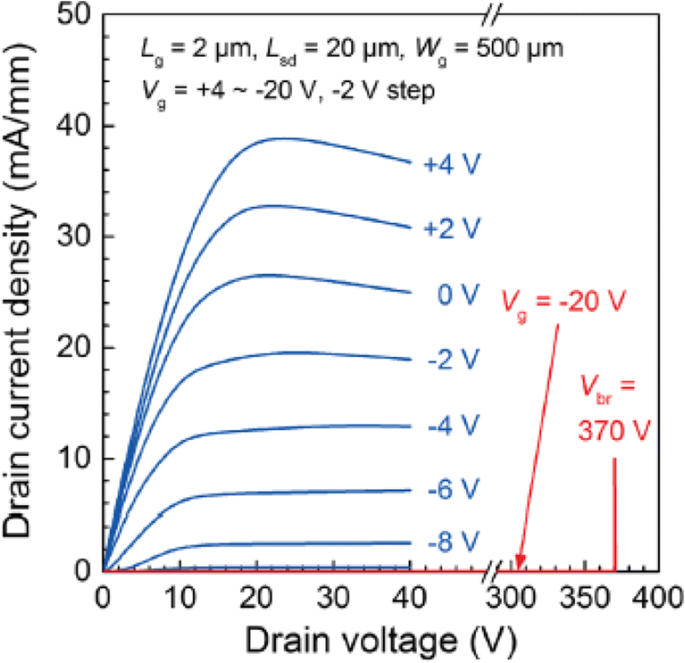
DC I–V-curven van Ga2 O3 MOSFET (L g = 2 μm) gemeten bij RT. Overgenomen van ref. [12]
Hoewel de bovengenoemde technieken de prestaties van Ohmse contacten kunnen verbeteren, zijn dergelijke technologieën niet praktisch toepasbaar omdat de veroorzaakte schade meestal het laatste is dat procesingenieurs willen in halfgeleiderapparaten, en bovendien zijn de door schade veroorzaakte Ohmse contacten niet altijd reproduceerbaar.
Om deze reden werd recentelijk, afgezien van de bovengenoemde traditionele technieken die vaak worden gebruikt voor het vormen van ohmse contacten met een lage weerstand, een relatief nieuwe techniek - spin-on-glass (SOG) doping - toegepast [53], en een specifieke contactweerstand van 2,1 ± 1.4 × 10 −5 Ω∙cm 2 werd bereikt, wat de effectiviteit van de SOG-dopingtechniek verifieerde. Afbeelding 6 toont de outputkenmerken van SOG-gedoteerde β-Ga2 O3 MOSFET's die uitstekend lineair gedrag vertoonden bij lage afvoerspanning. Vergeleken met ionenimplantatie vermindert de SOG-doping de door schade veroorzaakte diffusie van soorten en verlaagt het de kosten door de dure ionenimplanter te verlaten. Net als bij ionenimplantaties, is het basisprincipe achter deze technologie doping van de S/D-regio met ondiepe donoren. Het is duidelijk dat het superieure Ohmse contact kan worden bereikt met opzettelijk gedoteerde β-Ga2 O3 . Bijvoorbeeld de sterk gedoteerde β-Ga2 O3 werd gebruikt om β-Ga2 . te fabriceren O3 veldeffecttransistoren met afvoerstromen van meer dan 1,5 A/mm [50]. De recordhoge afvoerstroom is te wijten aan de zware dotering in β-Ga2 O3 die een zeer dunne uitputtingslaag veroorzaakt, en elektronen kunnen gemakkelijk over deze barrière tunnelen, wat leidt tot een Ohms contactgedrag. Interessant is dat de oriëntatie van de β-Ga2 O3 oppervlak kan ook invloed uitoefenen op het contactgedrag. Baik et al. meldde dat dezelfde elektroden op β-Ga2 O3 vertoonde verschillende contacteigenschappen, waarbij het monster op (\( \overline{2} \)01) substraat zich gedroeg als Ohmse contacten terwijl het controlemonster op (010) Schottky-gedrag vertoonde. Dit kan worden toegeschreven aan verschillende Ga/O-verhoudingen en dichtheid van bungelende bindingen bij specifieke oriëntaties [54].
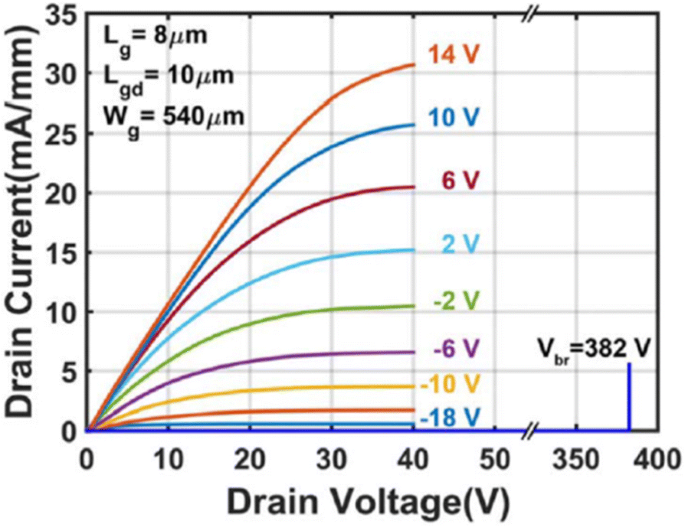
Uitgangskarakteristieken van de SOG S/D-gedoteerde MOSFET met L g = 8 μm, afstand afvoerpoort L gd = 10 μm. Overgenomen van ref. [53]
Nabehandeling
De nabehandeling wordt uitgevoerd na metaalafzetting, voornamelijk verwijzend naar het gloeiproces. Gloeien speelt een rol bij het verminderen van schade veroorzaakt door eerdere procestechnologieën zoals ionenimplantatie en plasmabombardement. Bovendien draagt het bij aan de vorming van een tussenlaag die de discontinuïteit van de geleidingsband tussen het metaal en β-Ga2 kan verminderen. O3 . Opmerkelijk is dat de parameters, waaronder temperatuur, atmosfeer en gloeitijd, een belangrijke invloed uitoefenen op de prestaties van apparaten. Het experiment op het gloeien in lucht en N2 werd geïmplementeerd om het effect van de uitgloeiende atmosfeer op β-Ga2 . te vergelijken O3 -gebaseerde Ohmse contacten [55]. Zoals te zien is in Fig. 7, zijn de prestaties van gloeien in N2 beter presteerde dan die in lucht, wat kan worden toegeschreven aan die hogere partiële zuurstofdruk in lucht, waardoor de vorming van zuurstofvacatures werd onderdrukt. De afhankelijkheid van contactkenmerken van de temperatuur, atmosfeer en gloeitijd van contactkenmerken is echter onduidelijk; daarom is het verder nodig om de parameters van het gloeiproces te optimaliseren.
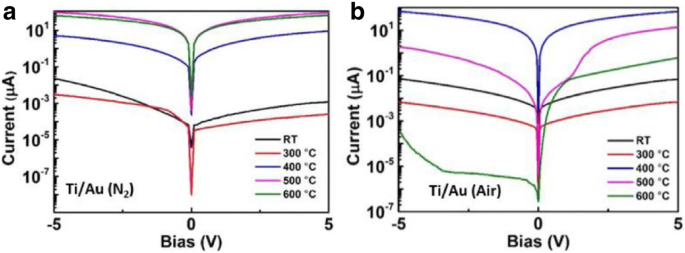
Elektrische eigenschappen van β-Ga2 O3 vlokken met verschillende thermische gloeiatmosfeer en gloeitemperatuur. Ti/Au-contacten onder a N2 en b lucht. Overgenomen van ref. [55]
Meerlagige metalen elektrode
Een andere benadering voor het vormen van Ohmse contacten is het verminderen van de SBH op de metaal/halfgeleiderinterface. De SBH is gelijk aan het verschil tussen de werkfunctie van het metaal en de elektronenaffiniteit van de halfgeleider. Op basis van deze herkenning zou men kunnen verwachten dat metalen met een lage werkfunctie Ohmse contacten zouden vormen op β-Ga2 O3 . Desalniettemin is bewezen dat de werkfunctie niet de dominante factor is bij het vormen van Ohms contact [56].
Negen metalen afgezet op β-Ga2 O3 werden geselecteerd op basis van eigenschappen zoals werkfunctie, smelttemperatuur en oxidestabiliteit [57]. De metaalbewerkingsfunctie van Ti en elektronenaffiniteit van onbedoeld gedoteerd β-Ga2 O3 waarvan bekend is dat ze respectievelijk 4,33 eV en 4,00 ± 0,05 eV zijn [19, 58, 59], dus er zou een barrière van 0,22 eV moeten zijn op de interface die naar het Schottky-contact leidt. Desalniettemin bleek dat Ti-contacten met een Au-afdeklaag Ohms waren met de laagste weerstand van negen metalen na gloeien. Ondertussen hebben Bae et al. onderzocht de afhankelijkheid van contacteigenschappen van de Ti/Au en Ni/Au voor apparaten op basis van het geëxfolieerde β-Ga2 O3 vlokken [55]. Er werd waargenomen dat de prestaties van MOSFET's met Ti/Au-metaalelektroden beter presteerden dan die met Ni/Au-metaalelektroden onder dezelfde gloeiconditie. In het begin werd aangenomen dat de werkfuncties van Ni en Ti respectievelijk 5,01 eV en 4,33 eV zijn, dus Ti kan gemakkelijker een Ohms contact vormen dan Ni; studies met behulp van energiedispersieve spectroscopie (EDS) toonden echter aan dat het atoompercentage van zuurstof in de β-Ga2 O3 gebied nam af, terwijl het atomaire zuurstofpercentage in Ti nabij het grensvlak toenam na uitgloeien, zoals geïllustreerd in Fig. 8 [55]. Dit fenomeen wordt toegeschreven aan de uitdiffusie van zuurstofatomen uit β-Ga2 O3 in Ti-metaal, wat leidt tot de vorming van zuurstofvacatures die als donoren fungeren. Bovendien, tijdens het gloeiproces, de versnelde uitdiffusie van zuurstofatomen in β-Ga2 O3 zou kunnen reageren met Ti en Ti2 . vormen O3 wat handig is voor het vormen van Ohmse contacten vanwege de lage werkfunctie (3,6–3,9 eV). Daarom is de grensvlakreactie tussen metalen en β-Ga2 O3 is een belangrijke factor bij het vormen van ohmse contacten op de metaal/halfgeleiderinterface.
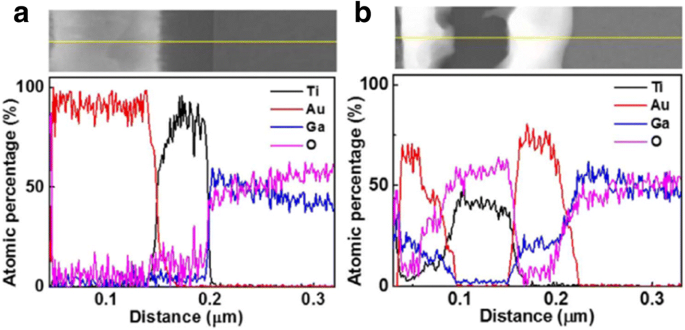
Atomaire percentageprofielen door EDS van metallisatie en β-Ga2 O3 een pre- en b nagloeien bij een temperatuur van 500 ° C. Overgenomen van Ref. [55]
Bovendien is gebleken dat de meeste Ti/Au-metaalelektroden die werden gebruikt om Ohmse contacten te vormen, werden uitgegloeid bij 450 ° C [45, 53] of 470 ° C [12, 46, 57, 60] door snel thermisch proces. Een soortgelijk degradatiegedrag van contactkenmerken werd waargenomen wanneer het uitgloeien werd uitgevoerd boven 500 ° C in ref. [55, 56], zoals geïllustreerd in Fig. 7 en 9, respectievelijk. Yao et al. gespeculeerd dat een isolerende oxidelaag mogelijk werd gevormd bij verhoogde gloeitemperatuur, resulterend in de verslechterde contacten. Niettemin, Bae et al. merkte op dat het oppervlak van het afgezette metaal veel ruwer was na 700 ° Uitgloeien door de vermenging van metalen en de diffusie van gallium- en zuurstofatomen in metaalelektroden, wat werd toegeschreven aan de oorzaak van het degradatiegedrag. Het is duidelijk dat de degradatiemechanismen van Ti/Au-contacten met β-Ga2 O3 na gloeien bij hoge temperatuur zijn nog steeds ter discussie.
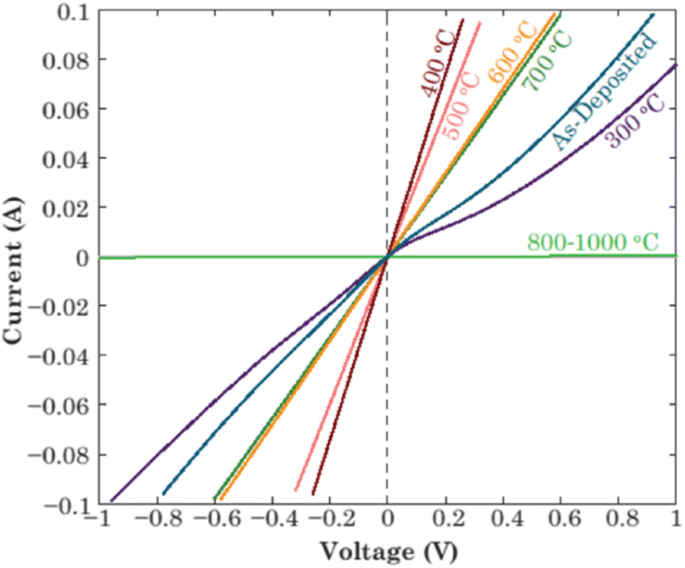
IV-plots voor Ti/Au-contacten op Sn-gedoteerde (\( \overline{2} \)01) Ga2 O3 wafel als functie van de gloeitemperatuur in Ar (gloeitijd 1 min). Overgenomen van ref. [56]
β-Ga2 O3 -gebaseerde apparaten met Ti/Au-contacten kunnen niet voldoen aan de vraag naar werken bij hoge temperaturen. Om de achteruitgang van de contactkenmerken bij verhoogde gloeitemperatuur te voorkomen, moeten daarom complexere metalen stapels worden gebruikt. Verreweg zijn Ti/Al/Au [50, 52], Ti/Au/Ni [61, 62] en Ti/Al/Ni/Au metalen stapels [13, 21, 63, 64] gebruikt om elektrische contacten op β-Ga2 O3 . Maar een uitgebreide vergelijking van contactkenmerken tussen deze metalen stapels is nog steeds onvoldoende.
Mohammad [65] en Greco et al. [36] besprak de rol van elke metaallaag in de complexe metalen stapels en gaf enkele richtlijnen voor het verbeteren van de Ohmse contacten. Het schema van de metalen stapels wordt getoond in Fig. 10. Merk op dat deze benadering momenteel wordt ontwikkeld voor op GaN gebaseerde stroomapparaten [66,67,68,69].
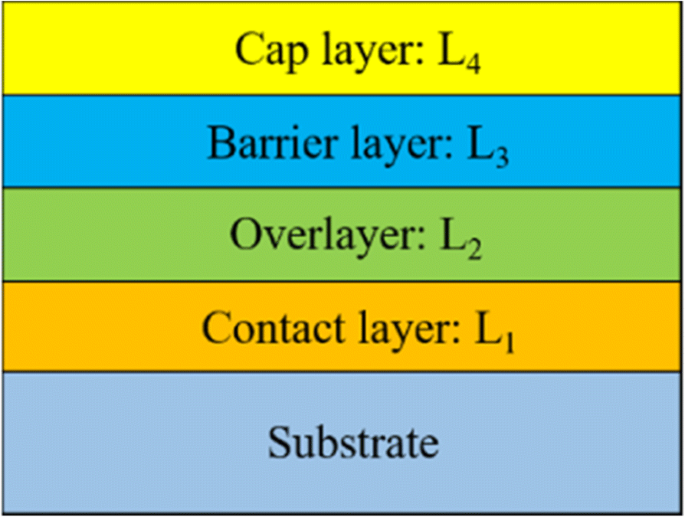
Het schema van metalen stapels voor het verkrijgen van ohmse contacten met halfgeleiders met een brede bandgap
De eerste metaallaag op de ondergrond, contactlaag genoemd, dient een lage werkfunctie en een goede hechting aan de ondergrond te hebben. Bovendien kan het ook de diffusie van metalen van de bovenste laag met grote werkfuncties in het substraat blokkeren. Momenteel is Ti het belangrijkste metaal als contactlaag voor β-Ga2 O3 vanwege zijn lage functie (4,33 eV) en goede hechting op de ondergrond. Trouwens, de vorming van Ti2 O3 en Ti3 O5 met lagere werkfuncties dan Ti aan het grensvlak heeft de voorkeur bij het vormen van Ohmse contacten, aangezien de oxiden de SBH verminderen en zuurstofvacatures achterlaten die als donoren fungeren. Andere metalen met lage werkfuncties, waaronder Ta (3,1 eV) en Hf (3,9 eV), zijn echter nog niet onderzocht. De tweede bovenlaag met een lage werkfunctie moet in staat zijn om intermetallische verbindingen te vormen met de contactlaag om hun diffusie in het grensvlak te voorkomen. Momenteel wordt Al als deklaag gebruikt omdat het aan deze vereisten kan voldoen. De derde metaallaag (barrièrelaag) dient om de indiffusie van de bovenste metaallaag en uitdiffusie van de onderste metaallagen te beperken [70, 71]. Ni is de meest gebruikte barrièrelaag voor β-Ga2 O3 . Er zijn andere goede kandidaten zoals Mo, Nb en Ir met hoge smeltpunten om Ni te vervangen, waarvan wordt verwacht dat ze een lagere reactiviteit en oplosbaarheid voor Au hebben dan Ni [72,73,74,75]. De vierde deklaag fungeert als een beschermende laag om de oxidatie van onderliggende metalen te voorkomen of te minimaliseren. In de praktijk wordt Au vaak gebruikt om dit doel te dienen.
Introductie van een tussenlaag
Er zijn hoofdzakelijk twee methoden om een tussenlaag aan te brengen op het metaal/β-Ga2 O3 koppel. Een daarvan is het vormen van een tussenliggende halfgeleiderlaag (ISL) met een lage werkfunctie door uitgloeien, bijvoorbeeld Ti2 O3 . De andere is om de gedeponeerde ISL tussen het metaal en β-Ga2 . te plaatsen O3 , die intensief is bestudeerd [76,77,78]. Vergeleken met de eerste methode is de laatste gunstiger voor het vormen van Ohmse contacten vanwege de hoge dragerconcentratie van ISL. De bandgaps van ISL's variëren van 3,5 tot 4,0 eV [79,80,81], zoals AZO (~ 3.2 eV) [82], In2 O3 (~ 2,9 eV) [83, 84] en IGZO (~ 3,5 eV) [85]. Gewoonlijk worden de SBH's van verschillende metalen afgezet op β-Ga2 O3 liggen in het bereik van 0,95-1,47 eV [86, 87], zoals weergegeven in figuur 11a. Desalniettemin vermindert de opname van een dunne ISL de SBH, waardoor het voor elektronen gemakkelijker wordt om van het metaal naar de geleidingsband van β-Ga2 te transporteren. O3 , zoals geïllustreerd in Fig. 11b. Bovendien zou de hoge dichtheid van elektronen in ISL de contactweerstand verder kunnen verminderen.
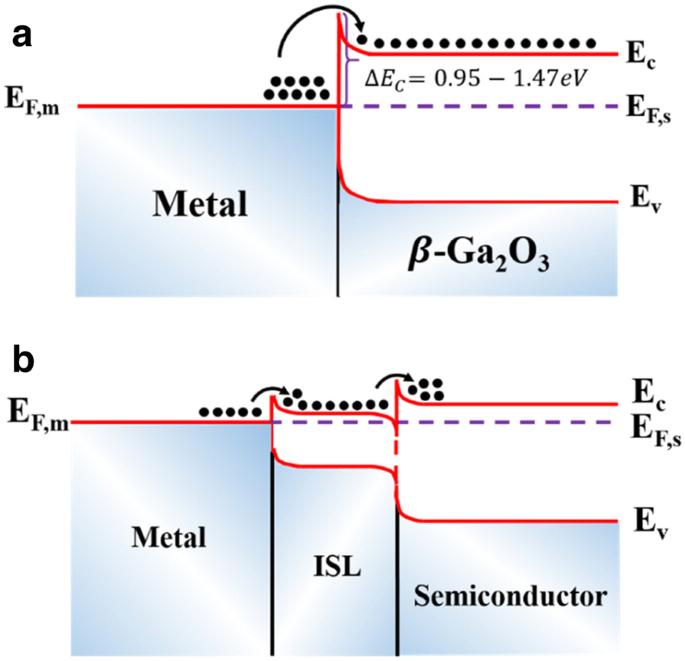
Het schema van bandoffsets voor a metaal/β-Ga2 O3 en b metaal/ISL/β-Ga2 O3 . ∆E c is gelijk aan het energieverschil tussen de Fermi-energie van metalen en de geleidingsband van halfgeleiders
De laatste tijd werd AZO/Ti/Au gebruikt als elektroden op Si + -geïmplanteerde β-Ga2 O3 , en de verkregen specifieke contactweerstand was 2,82 × 10 −5 Ω∙cm 2 na gloeien [76]. Oshima et al. bereikt platina/indium–tinoxide (Pt/ITO) Ohmse contacten met β-Ga2 O3 met een breed scala aan procestemperatuurvensters [77]. Het grote procesvenster van 900–1150 ° C maakt de realisatie van werking bij hoge temperatuur mogelijk. En ITO/Ti/Au-elektroden naar β-Ga2 O3 werden ook aangetoond door Carey et al. [78] waarin het monster Ohms gedrag vertoonde met ρ C van 6,3 × 10 − 5 Ω∙cm 2 na het gloeien. Zonder de ITO leverde hetzelfde uitgloeien geen lineaire stroom-spanningskarakteristieken op. Deze resultaten verifiëren de effectiviteit van het toevoegen van ISL voor het verkrijgen van Ohmse contacten.
Er werd met name een bel op het oppervlak van ITO/Ti/Au-contacten waargenomen terwijl er geen bubbels waren op de enkele ITO-laag zonder metaallaag erboven [78]. Het werd beschouwd als het resultaat van uitdiffusie van zuurstofatomen in de ITO-laag in de bovenste metaallagen. Daarom is het noodzakelijk om geschikte metalen of metalen stapels te kiezen als afdeklagen op ITO om de achteruitgang van de oppervlaktemorfologie te voorkomen.
Conclusies
In dit werk hebben we de aanzienlijke vooruitgang in R&D van β-Ga2 . samengevat O3 MOSFET's. Niettemin zijn de contacten op β-Ga2 O3 zijn een van de belangrijkste problemen die de potentiële toepassing ervan als hoogfrequente en hoogspanningsapparatuur in de toekomst beperken. Hoewel dit overzicht een overzicht geeft van de modernste methoden voor het vormen van Ohmse contacten, is er nog veel ruimte om te verkennen, en een reeks beknopte vooruitzichten kan als volgt worden samengevat:(i) De temperatuurafhankelijkheid en achteruitgangsmechanisme van contactkenmerken verder onderzoek nodig voor duidelijke opheldering; (ii) metalen met een lage werkfunctie zoals Ta en Hf en metalen met een hoog smeltpunt zoals Mo, Nb en Ir zijn het waard om te worden gescreend om respectievelijk als contactlaag en barrièrelaag te dienen; (iii) De optimale metaalstapels op β-Ga2 O3 zijn nog niet volledig gerealiseerd, en een uitgebreide en systematische studie van metalen stapels tot β-Ga2 O3 is absoluut noodzakelijk voor het bereiken van laagohmige en thermisch stabiele Ohmse contacten; en (iv) Andere potentiële ISL's bestaande uit ZnO, IZO, IGZO, enz. blijven onbenut, evenals de invloed van variërende dikte en verhouding van ingrediënten van ISL's op de prestaties van de contacten. Samenvattend, de onderzoeken over Ohmse contacten naar β-Ga2 O3 zijn nog vrij oppervlakkig; wij zijn van mening dat dit onderwerp in de toekomst een van de aandachtspunten zal blijven. Hopelijk zullen de benaderingen voor het vormen van Ohmse contacten die in deze review worden gepresenteerd een grote rol spelen bij het bereiken van hoogwaardige β-Ga2 O3 apparaten.
Nanomaterialen
- Wolfraamcontacten voor elektrische apparaten
- Switch contactontwerp
- Digitale logische functies
- Fabrikanten stimuleren verdere vooruitgang in 3D NAND-flash
- Vooruitgang van medische hulpmiddelen volgen
- Recente artikelen beschrijven de schaalbaarheid van koolstofnanobuisjes, doorbraken op het gebied van integratie
- Top 10 ontwikkelingen op het gebied van composietproductietechnologie
- Vooruitgang en uitdagingen van fluorescerende nanomaterialen voor synthese en biomedische toepassingen
- Multi-Layer SnSe Nanoflake Field-Effect Transistors met Au Ohmic-contacten met lage weerstand
- 5 recente geweldige lezingen in IT/OT-convergentie
- 5 recente geweldige reads in IIoT



