Doorbreken van de multi-mesa-kanaalbreedte die beperkt is tot normaal uit GaN HEMT's door modulatie van de via-gatlengte
Abstract
We presenteren nieuwe, normaal gesproken uitgeschakelde GaN-transistors met hoge elektronenmobiliteit (HEMT's) die de typische beperkingen in multi-mesa-channel (MMC) -breedte overwinnen door modulatie van de via-gatlengte om het schermeffect van ladingsneutraliteit te regelen. We hebben GaN HEMT's in de verbeteringsmodus (E-modus) voorbereid met een breedte tot 300 nm, op basis van een verbeterd oppervlak-pinning-effect. E-mode GaN HEMT's met MMC-structuren en breedtes, evenals via-hole-lengtes van respectievelijk 100 nm/2 μm en 300 nm/6 μm, vertoonden positieve drempelspanningen (V de ) van respectievelijk 0,79 en 0,46 V. De aan-weerstanden van de MMC en via-gat-lengtestructuren waren lager dan die van typische tri-gate nanoribbon GaN HEMT's. Bovendien bereikten de apparaten niet alleen de E-modus, maar verbeterden ze ook de stroomprestaties van de GaN HEMT's en verminderden ze effectief het thermische effect van het apparaat. We hebben het via-gat-lengte zijwandoppervlak-pinning-effect gecontroleerd om de E-mode GaN HEMT's te verkrijgen. Onze bevindingen suggereren dat via-gatlengtes die normaal gesproken buiten GaN HEMT's vallen, een groot potentieel hebben voor gebruik in vermogenselektronica van de volgende generatie.
Achtergrond
Wide-bandgap III-V-nitriden zijn veelbelovende halfgeleidermaterialen voor frequentie- en spanningswerking vanwege hun uitstekende materiaaleigenschappen, waaronder grote bandafstanden, hoge kritische elektrische velden, hoge verzadigingselektronensnelheden en hoge geleidbaarheid [1, 2]. Dienovereenkomstig worden ze veel gebruikt in verschillende toepassingen, waaronder lichtemitterende diodes (LED) en transistors [3]. Bovendien vormen heterostructuren van aluminiumgalliumnitride/galliumnitride (AlGaN/GaN) tweedimensionale elektronengassen (2DEG's) die geschikt zijn voor de ontwikkeling van hoogwaardige apparaten, gebruikmakend van de spontane en piëzo-elektrische polarisatie van III-nitrideverbindingen [4,5] ,6]. De hoeveelheid van een 2DEG wordt beïnvloed door het aandeel polarisatie-geïnduceerde doping, wat direct van invloed is op de kenmerken van het apparaat [7,8,9]. Hoewel ze veel aantrekkelijke eigenschappen hebben, hebben AlGaN/GaN-transistors met hoge elektronenmobiliteit (HEMT's) geen universeel nut gevonden omdat hun elektronische kenmerken complexe circuitconfiguraties kunnen vereisen voor digitale, stroom-, RF- en microgolfcircuittoepassingen. Dienovereenkomstig zou een normaal uitgeschakelde werking essentieel zijn voor toekomstige III-V-halfgeleiderapparaten [10, 11]. Hoewel enkele speciale fabricagetechnieken zijn getest (bijv. het gebruik van verzonken poorten [12,13,14], het inbrengen van p-type afdeklagen onder de poort [15, 16], tunnelverbindingsstructuren [17], implantatie van fluoride-ionen in de barrière onder de poort [18], en opname van dunne AlGaN-barrièrelagen met een speciale metalen poort en snelle thermische gloeibehandeling (RTA) [19]), kunnen ze de prestaties van het apparaat verslechteren en stabiliteitsproblemen veroorzaken door verwerkingsgeïnduceerde materiaalschade en verhoogde thermische en elektrische veldeffecten.
Als alternatief ontdekte een team van de Hokkaido University dat AlGaN/GaN HEMT's vervaardigd met fin-nanokanalen een verschuiving in de drempelspanning vertoonden (V de ) in de positieve richting [20, 21]. Een groep aan de Soochow University meldde dat de waarde van V de onderging een systematische positieve verschuiving wanneer de breedte van het nanokanaal minder dan 90 nm was [22]. Onderzoekers van de Kyungpook National University beschouwden de gedeeltelijke spanningsrelaxatie van de zijkanten van de kanalen om het gedrag te verklaren [23]. Een team van het Massachusetts Institute of Technology simuleerde de drempelspanning na oppervlaktepassivering van op GaN gebaseerde HEMT's en stelde vast dat positieve waarden optraden wanneer de breedte van het kanaal kleiner was dan 100 nm [24], het resultaat van zijwandeffecten en verhoogde trekspanning dat de elektronenconcentratie in het kanaal verminderde. Fin-vormige structuren verschuiven niet alleen de drempelspanning, maar verbeteren ook de beheersbaarheid van de poort, dankzij de 3D-structuur, die de prestaties in de staat induceert en de eigenschappen buiten de staat verbetert. De genormaliseerde maximale afvoerstroom (I D /mm) in een AlGaN/GaN HEMT met een vinvormige structuur hoger is dan die in een overeenkomstige vlakke structuur [25]. Hoewel deze methoden zijn gebruikt om E-mode HEMT's te fabriceren, blijft het een grote uitdaging om hoogwaardige, normaal gesproken uit GaN-vermogenstransistoren te ontwikkelen. Allereerst de combinatie van een lage aan-weerstand (R aan ) en een laag totaal vermogen van het apparaat moet worden bereikt wanneer de breedte van het kanaal beperkt is tot minder dan 100 nm. Hoewel de waarde van R aan van het kanaal kan worden verkleind door de lengte van de normaal uitgeschakelde poort te verkleinen, het regelen van de afvoerlekstroom in de off-state vormt een andere uitdaging omdat de poortbreedte de transconductantie en poortlekkage beïnvloedt door polarisatie-coulombveldverstrooiing en poortlekpaden [26, 27 ]. Afgezette films kunnen worden gebruikt als poortdiëlektrica om deze problemen te verbeteren [28].
In deze brief beschrijven we een doorbraak in de breedtebeperking van tri-gate-kanalen en stellen we een methode voor om de via-hole-lengte van de kanalen te moduleren. Ons apparaat bereikte de E-modus met een MMC-structuurbreedte van 300 nm en een via-gatlengte van 6 μm en vertoonde een drempelspanning van 0,46 V. Deze aanpak verminderde niet alleen de aan-weerstand van het apparaat (R aan ) maar zou ook het Joule-verwarmingseffect kunnen verminderen. Door een 3D tri-gate te combineren met verschillende kanaalbreedtes en via-gatlengtes, bereikten we normaal gesproken GaN HEMT's met positieve waarden van V de van 0,79 en 0,46 V wanneer de kanaalbreedten/via-gatlengtes respectievelijk 100 nm/2 μm en 300 nm/6 μm waren.
Methoden
De AlGaN / GaN-epi-wafel werd gekweekt op een (0001) saffiersubstraat met behulp van een Nippon Sanso SR-2000 metaal-organisch chemisch dampafzettingssysteem (MOCVD). De groei van de epitaxiale structuur begon met een GaN-kiemvormingslaag afgezet bij 600 ° C. Een 2 μm dikke onbedoeld gedoteerde GaN-bufferlaag, een 21,8 nm dikke onbedoeld gedoteerde AlGaN-barrièrelaag met nominale 23% aluminiumsamenstelling en een 2 nm dikke GaN-deklaag werden vervolgens bij 1180 ° C afgezet. Apparaatverwerking is begonnen met behulp van een inductief gekoppeld plasma (ICP) reactief ionenetssysteem (RIE) met een BCl3 /Cl2 gasmengsel om een 130 nm diepe mesa te isoleren en een periodieke greppelstructuur te etsen. Vervolgens werden twee processen toegepast om de kristallijne facetten van het uitsparingsgebied en de zijwanden van de mesa te herstellen en de niveaus van oppervlaktedefecten en schade door ionenbombardementen te verminderen. De eerste betrof het gebruik van gesmolten KOH voor kristallografische nat-chemische etsing om oppervlakteschade veroorzaakt door droog etsen te verwijderen en tegelijkertijd gladde verticale zijwanden te produceren; de tweede betrof het aanbrengen van piranha-oplossing (een mengsel van H2 SO4 en H2 O2 ) voor oppervlaktereiniging en verwijdering van organische resten. Conventionele fotolithografie met een kwiklamp werd toegepast om de afvoer-, bron-, poort- en contactvlakken voor DC-metingen te definiëren. Ohmse contacten met de AlGaN/GaN-heterojunctie, bestaande uit titanium/aluminium/nikkel/goud (Ti/Al/Ni/Au, 30/120/20/80 nm), werden afgezet op de drain/source-gebieden door middel van elektronenstraalverdamping en uitgloeien bij 850 ° C gedurende 30 s onder vacuüm. Om het transistorkanaal te voltooien, werd een poortelektrode vervaardigd door elektronenstraalverdamping van Ni/Au (20/80 nm). Afbeelding 1 biedt schematische weergaven van de dwarsdoorsnede van de HEMT-structuur, een bovenaanzicht van het apparaat en een 3D-structuurdiagram van het apparaat. De poortlengte (L g ), MMC-structuurbreedte (W MMC ), MMC-structuur via-gat-lengte (L MMC ), en MMC-structuurhoogte (H MMC ) waren respectievelijk 2 m, 100-500 nm, 1-6 m en 130 nm. Vinnen waren parallel geschakeld. Om het oppervlakte-pinning-effect te verbeteren, werd de GaN HEMT via-gat-lengtestructuur niet onderworpen aan passivering. Figuur 2a toont een bovenaanzicht scanning elektronenmicroscopie (SEM) beeld van het metalen oppervlak in het source- en draingebied. Het optische microscopie (OM) beeld in Fig. 2b onthult volledige poorten en kanalen; observeren hoeveel kanalen er in het apparaat waren, was nuttig bij het berekenen van de werkelijke stroom. Het oppervlak leek op de afbeelding ruw omdat de atomen na het uitgloeien migreerden in het kristalrooster en het aantal dislocaties afnam, waardoor de weerstand effectief werd verminderd. De SEM-afbeelding in Fig. 2c bevestigde de afmetingen van het kanaal.
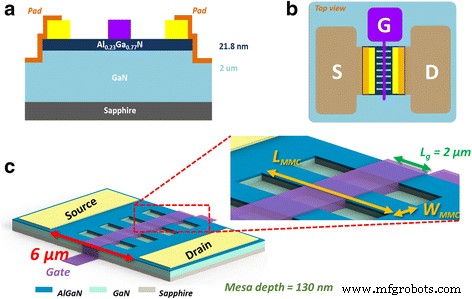
Schematische weergaven van a de dwarsdoorsnede van de HEMT-structuur, gezien vanuit een richting evenwijdig aan het transistorkanaal; b het bovenaanzicht van de HEMT-structuur; en c de 3D-structuur van de HEMT
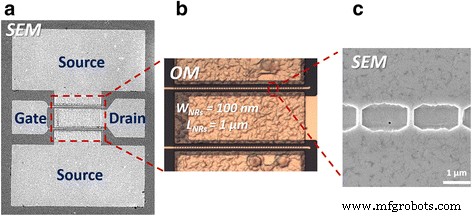
een SEM-beeld van het bovenaanzicht van het apparaat; b bovenaanzicht OM-afbeelding van het apparaat, met een kanaalbreedte en -lengte van respectievelijk 100 nm en 1 μm; en c bovenaanzicht SEM-afbeelding van het kanaal
Resultaten en discussie
Tot op heden zijn de meeste technologische ontwikkelingen in GaN-hoogspanningstransistors gebaseerd op AlGaN/GaN HEMT's, die intrinsiek depletion-mode (D-mode) apparaten zijn vanwege het polarisatie-geïnduceerde 2D-elektronengas op de AlGaN-GaN-interface [29]. Desalniettemin zijn normaal gesproken uitgeschakelde GaN-transistoren vereist als de vermogenselektronica-industrie GaN-technologieën op grote schaal wil toepassen.
Het aantal bungelende bindingen op een (Al)GaN-oppervlak is ongeveer 10 15 cm −2 ; deze bungelende bindingen induceren een verarmde bandbuiging als gevolg van een oppervlak-pinning-effect. Afbeelding 3a toont de gebieden met verarmd zijkanaaloppervlak vanaf de zijwandpoorten in de structuur met drie poorten. Onderzoekers van de Kyungpook National University rapporteerden een soortgelijk fenomeen [21]. Afbeelding 3b geeft de I . weer DS –V G overdrachtskenmerken van apparaten met een vaste waarde van L MMC van 2 μm en waarden van W MMC van 100, 300 en 500 nm. Toen de afvoer-naar-bronspanning 8 V was, waren de waarden van V de van deze apparaten waren respectievelijk +0,79, -1,32 en -2,18 V. Er trad dus een positieve verschuiving in de drempelspanning op naarmate de kanalen smaller werden. Dit fenomeen kan te wijten zijn aan de uitputting van het laterale kanaal en het vastzetten van het oppervlak van de 2 μm via-gatlengte vanaf de zijwand in de MMC via-gatlengtestructuur door de effecten van laterale kanaaluitputting en via-gatlengte oppervlaktebuiging .

een Schematische weergave van AlGaN/GaN HEMT's met brede en smalle kanalen. b Ik DS –V G overdrachtskarakteristieken gemeten voor een apparaat met een waarde van L MMC van 2 μm en verschillende waarden van W MMC
Afbeelding 4 toont de IDS –VG overdrachtskenmerken van apparaten met een vaste waarde van W MMC van 300 nm en waarden van L MMC van 1, 2 en 6 m. Toen de afvoer-naar-bronspanning 8 V was, waren de waarden van V de waren respectievelijk -2,12, -1,07 en +0,46 V. Het apparaat bereikte de normale werking wanneer de MMC-lengte en -breedte respectievelijk 6 m en 300 nm waren. Het moduleren van de via-gat-lengte en kanaalbreedte kan een apparaat opleveren dat normaal uit bedrijf weergeeft. Tabel 1 geeft een overzicht van de drempelspanningen die zijn gemeten voor verschillende via-gat-lengtes en multi-mesa-kanaalbreedten. Toen de kanaalbreedte werd vastgesteld op 500 nm en de lengte van het via-gat werd vergroot van 0,8 naar 6 μm, werd de waarde van V de nam toe van -2,62 tot -1,62 V, de verzadigingsafvoerstroom nam af van 747 tot 98 mA/mm en de transconductantie nam af van 270 tot 40 mS/mm. Toen de kanaalbreedte werd vastgesteld op 300 nm en de lengte van het via-gat werd vergroot van 0,8 naar 6 μm, werd de waarde van V de nam toe van -2,15 tot +0,46 V, de verzadigingsafvoerstroom nam af van 685 tot 6,8 mA/mm en de transconductantie nam af van 290 tot 7,4 mS/mm. Toen de kanaalbreedte werd vastgesteld op 100 nm en de lengte van het via-gat werd vergroot van 0,8 naar 2 μm, werd de waarde van V de nam toe van -0,41 tot +0,79 V, de verzadigingsafvoerstroom nam af van 547 tot 53 mA/mm en de transconductantie nam af van 400 tot 67 mS/mm. De huidige verwerkingscapaciteit van HEMT wordt sterk beïnvloed door de dragerconcentraties [20, 21]. Dienovereenkomstig werden de verzadigingsafvoerstromen en transconductanties van de apparaten sterk beïnvloed door de totale oppervlaktetoestanden van de zijwand en het oppervlakverarmde effect van het tri-gate-kanaal bij het variëren van de breedtes en via-gatlengtes van de GaN HEMT's. Vergeleken met eerder gerapporteerde apparaten [23] heeft ons apparaat een nieuwe mijlpaal bereikt voor een lage weerstand, normaal gesproken buiten GaN HEMT's.

Ik DS –V G overdrachtskenmerken van apparaten met een vaste waarde van W MMC van 300 nm en verschillende waarden van L MMC
Conclusies
We hebben E-mode GaN HEMT's voorbereid met een multi-mesa-channel (MMC) structuur; ze vertoonden een positieve drempelspanning van 0,46 V wanneer de kanaalbreedte en via-gatlengte respectievelijk 300 nm en 6 μm waren. We concluderen dat de effecten van zowel de uitputting van het laterale kanaal als het buigen van het oppervlak van de via-gatlengte. Wanneer ze een tri-gate bevatten met een MMC-via-gat-lengtestructuur, vertoonden de nieuwe normaal uit GaN HEMT's een zeer lage aan-weerstand, zelfs wanneer de MMC-structuurbreedte werd vergroot tot 300 nm (voorheen beperkt tot minder dan 100 nm). Bovendien zorgde modulatie van de MMC-structuur met een via-gatlengte normaal gesproken voor GaN HEMT's, waardoor de uitstekende vermogensprestaties werden verbeterd als gevolg van de grotere breedte van de MMC-structuur van het apparaat.
Nanomaterialen
- Weld-on versus doorlopende trekgrepen:wat is het verschil?
- De anatomie van een schroef doorbreken
- Pulsbreedtemodulatie
- Open source en het internet der dingen:innovatie door samenwerking
- Een weg banen door het IoT-beveiligingsdoolhof
- 5G en GaN:de verschuiving van LDMOS naar GaN
- De cyclus van schulden in de toeleveringsketen doorbreken
- Het inkoopproces transformeren door middel van robotica
- ProtoPompoenen door de jaren heen
- Gekoelde luchtdrogers - de basis doorbreken
- De basisprincipes van het vervaardigen van luchtkanalen doorbreken



