Compliance-vrij ZrO2/ZrO2 − x /ZrO2 resistief geheugen met controleerbaar interfaciaal multistate schakelgedrag
Abstract
Een controleerbare transformatie van grensvlak- naar draadvormige schakelmodus wordt gepresenteerd op een ZrO2 /ZrO2 − x /ZrO2 drielaags resistief geheugen. De twee schakelmodi worden onderzocht met mogelijke voorgestelde schakel- en transformatiemechanismen. Weerstandsmodulatie van de ZrO2 − x Er wordt voorgesteld dat de laag verantwoordelijk is voor het schakelen in de grensvlakschakelmodus door het injecteren / terugtrekken van zuurstofionen. Het schakelen is conformiteitsvrij dankzij de intrinsieke serieweerstand door de filamenten gevormd in de ZrO2 lagen. Door de RESET . af te stemmen spanningen, controleerbaar en stabiel multistate geheugen kan worden bereikt, wat duidelijk wijst op de mogelijkheid om het multistate high-performance geheugen van de volgende generatie te ontwikkelen.
Achtergrond
De ontwikkeling van dichter, sneller en minder energieverbruikend niet-vluchtig geheugen is van groot belang voor innovaties in de moderne informatietechnologie [1, 2]. Hoewel veel kanshebbers naar voren zijn gekomen als de volgende generatie geheugenapparaten, is resistief random access memory (RRAM) op basis van metaaloxiden een van de meest veelbelovende kandidaten vanwege de voordelen van hoge snelheid, hoge schaalbaarheid, laag stroomverbruik en goede compatibiliteit met de CMOS-proces [3]. Hoewel het gedetailleerde schakelmechanisme van het resistieve geheugen onzeker blijft, wordt algemeen aanvaard dat de migratie van zuurstofvacatures onder een aangelegd elektrisch veld een sleutelrol speelt in het schakelgedrag [4]. Afhankelijk van het schakelmechanisme kan de resistieve schakeling worden ingedeeld in filamentaire en grensvlak (homogene) modi. De filamentaire modus wordt bereikt door de vorming en breuk van zuurstofvacature-filament(en) tussen twee elektroden. Aan de andere kant wordt de weerstandsschakeling in de interfacemodus geregeld door de verdeling van zuurstofvacatures langs een interface. De stroom is gelokaliseerd in de geleidende filamenten in de filamentaire modus, terwijl deze homogeen wordt verdeeld over het apparaatgebied in de grensvlakmodus [5, 6]. De resistieve schakelmodus die wordt gekenmerkt in een geheugenapparaat is sterk afhankelijk van de structuur ervan. In het algemeen berust de weergave van de grensvlakmodus in het op metaaloxide gebaseerde systeem op het bestaan van een zuurstofgradiëntprofiel langs de verticale as [7, 8]. Onlangs is ook het naast elkaar bestaan van beide modi in één materiaalsysteem gerapporteerd [9,10,11]. Door de meetparameters te moduleren, kan ook een transformatie tussen deze twee modi worden bereikt [12]. Het schakelen in de grensvlakmodus wordt echter meestal toegeschreven aan de verandering van de Schottky-barrièrehoogte die wordt veroorzaakt door de accumulatie- en uitputtingsprocessen van dragers door defecte toestanden op de elektrode/functielaaginterface [7, 9,10,11,12,13, 14,15,16,17,18] in plaats van het effect van migratie van zuurstofvacatures op de oxide/oxide-interfaces.
De afgelopen jaren is er enorme vooruitgang geboekt om de opslagdichtheid van RRAM te vergroten. Afgezien van de inspanningen om de fysieke afmetingen van een geheugencel te verkleinen, is het gebruik van de intermediaire-weerstandstoestanden (IRS) tussen de hoge-weerstandstoestand (HRS) en de lage-weerstandstoestand (LRS) geworden om multistate-opslag binnen één geheugencel te realiseren. een populaire alternatieve oplossing [19, 20]. Dit multistate-opslaggedrag is belangrijk voor opslag met hoge dichtheid en op oxide gebaseerde elektronische synaptische apparaten [21,22,23]. Multistate opslag in filamentaire schakelmodus wordt gerealiseerd door de breedte en/of het aantal geleidende filamenten te regelen met verschillende RESET spanningen of SET huidige nalevingen. Een verscheidenheid aan metaaloxiden, waaronder TiOx , ZnO, SiOx en HfO2 , hebben multistate-gedrag aangetoond in RRAM-apparaten [24,25,26,27]. Opslag in meerdere toestanden in grensvlakschakelmodus werd ook gemeld waarbij de aanpassing van de breedtes van de zuurstofdefecte regio's verantwoordelijk was voor dit gedrag [12, 28]. Beide schakelmodi vereisen echter de huidige conformiteit in de SET proces om het apparaat te beschermen tegen defecten en, in het geval van filamentomschakeling, om meerdere toestanden met lagere weerstand te bereiken. Deze vereisten kunnen leiden tot complexiteit in het ontwerp van RRAM-circuits. Compliantievrij resistief geheugen met controleerbaar multistate-schakelgedrag zou daarom voordelig kunnen zijn, omdat het de stroomoverschrijding tijdens het schakelen minimaliseert en het potentieel heeft om de fabricagekosten aanzienlijk te verlagen [29, 30].
Onlangs is het gebruik van ZrO2 omdat de actieve schakellaag de aandacht heeft getrokken vanwege zijn hoge thermodynamische stabiliteit, eenvoudige samenstelling en compatibiliteit met halfgeleiderprocessen [31,32,33]. Bovendien, het invoegen van een buitenaardse laag in de ZrO2 film om een oxideheterostructuur te produceren is een effectieve methode gebleken om de schakelkarakteristieken in ZrO2 te verbeteren -gebaseerde apparaten [34, 35]. In dit werk demonstreren we een ZrO2 /ZrO2 − x /ZrO2 -gebaseerd resistief geheugen waarin een niet-stoichiometrische ZrO2 − x laag wordt gevormd binnen de ZrO2 laag door een Zr-laag in te voegen. Zowel grensvlak- als draadvormig worden waargenomen, en een beheersbare transformatie van grensvlak naar draadvormig kan worden gerealiseerd. De schakelkarakteristieken en de prestaties voor beide modi worden onderzocht. Terwijl de oxide/elektrode-interface een effect heeft op het schakelgedrag in de filamentaire modus, was de schakeling in de grensvlakmodus sterk afhankelijk van de oxide/oxide-interfaces in de drielaagse structuren. Het belangrijkste is dat de resistieve schakeling onder de interfacemodus een ingebouwde compliance-vrije eigenschap heeft, evenals multistate opslaggedrag onder verschillende RESET spanningen.
Methoden
ZrO2 dunne films werden bereid door middel van plasma-geassisteerde magnetron sputteren (Leybold Optics HELIOS Pro XL) bij kamertemperatuur. In dit proces roteerde het substraat met een snelheid van 180 rpm om een uniforme afzetting te verzekeren. Tijdens elke rotatie werd eerst een dunne laag Zr afgezet van een Zr-metaaldoel (99,99% zuiverheid) met een vermogen van 2000 W in een Ar-atmosfeer. Deze dunne film werd omgezet in een oxidelaag door het substraat onder de O2 . door te voeren plasma van de RF-bron. De O2 stroomsnelheid kan worden aangepast om ZrOx . te produceren films met verschillende composities. De samenstellingseigenschappen van de afgezette films werden onderzocht met behulp van energie-dispersieve röntgenstraling (EDX) waarbij een Zeiss EVO LS 25-microscoop uitgerust met een Oxford INCA x-act röntgendetector werd gebruikt. Films met een grote dikte van 1 m werden direct op Si-wafels gedeponeerd om de invloed van het substraat te minimaliseren. Röntgendiffractie (XRD) patronen werden verzameld in begrazingsincidentie (θ = 1°) met behulp van een Rigaku Smartlab-diffractometer met een 9 kW Cu–Kα bron. Röntgenfoto-elektronspectroscopie (XPS) gegevens werden verkregen met behulp van een ThermoScientific Theta Probe System met Al-Kα straling (fotonenergie = 1486.6 eV). XPS-diepteprofiel werd uitgevoerd met behulp van een Ar-ionenkanon bij een bundelspanning van 3 kV op een rastergebied van 2 × 2 mm. Transmissie-elektronenmicroscopie (TEM)-specimens werden bereid met behulp van conventioneel mechanisch polijsten gevolgd door ionenmalen tot elektronentransparantie met behulp van Ar + bij 6 keV. Een laatste maalstap met lage energie werd uitgevoerd bij 500 eV. Om oppervlaktebeschadiging te minimaliseren, werden de structuur en morfologie van de monsters geanalyseerd met behulp van een JEOL 2100 TEM uitgerust met LaB6 en JEOL ARM200F TEM/scanning TEM (STEM) met een Schottky-kanon, beide werkend op 200 kV. Ringvormige donkerveld (ADF) STEM-meting werd uitgevoerd in ARM200F, met sonde- en beeldafwijkingen CEOS-correctors. ADF-STEM-beelden werden verkregen met behulp van een JEOL-ringvormige velddetector met een sondestroom van ongeveer 23 pA, een halve convergentiehoek van ∼25 mrad en een binnenhoek van 45-50 mrad. Een Oxford Instruments X-Max N 100TLE vensterloze silicium driftdetector (SSD) werd gebruikt om STEM-EDX-analyse uit te voeren.
Het resistieve schakelgedrag van de drielaagse ZrO2 /ZrO2 − x /ZrO2 film werd onderzocht als geheugen. Een 200 nm dikke TiN-film werd reactief gesputterd (Ti-doel in een N2 atmosfeer) op de SiO2 laag om de onderste elektrode te vormen. Dit werd gevolgd door reactief sputteren van een tweede SiO2 laag (Si-doel in een O2 atmosfeer). Deze laag SiO2 werd van een patroon voorzien om actieve apparaatgebieden te vormen door fotolithografie en reactieve ionenets. Vervolgens ZrO2 /ZrO2 − x /ZrO2 (20 nm/5 nm/20 nm) drielagen werden afgezet om de schakellaag te vormen. De drielaagse structuur werd verkregen door het zuurstofplasma te stoppen tijdens de ZrO2 groei. ZrO2 laag wordt bereikt onder een O2 stroomsnelheid van 20 sccm terwijl de ZrO2 − x laag wordt verkregen door de O2 . uit te schakelen stroom gedurende 20 s. Een identieke ZrO2 /ZrO2 − x /ZrO2 drielaags werd ook afgezet op Si-substraat voor XRD- en XPS-karakterisering. Ten slotte werd een 200 nm TiN-laag gesputterd en van een patroon voorzien op de drielaagse laag om de bovenste elektrode te vormen. Alle elektrische metingen werden uitgevoerd met een Keithley 4200 halfgeleiderkarakteriseringssysteem. Tijdens de metingen werd de programmeerspanningsbias toegepast op de bovenste elektrode, terwijl de onderste elektrode geaard bleef. De sonde/puntcontacten met de boven- en onderelektroden van de apparaten werden gerealiseerd door een paar Wentworth-sondenaalden, met behulp van een Wentworth Laboratories AVT 702 semi-automatische sonde. De spannings-DC-sweepmetingen werden uitgevoerd met een constante snelheid van 0,5 V/s.
Resultaten en discussie
De eigenschappen van de drielaagse structuur werden eerst onderzocht door XRD. Figuur 1 toont het XRD-patroon van de als afgezette drielagen (rood) met twee pieken op 28,2 ° en 29,8 °. Deze twee pieken kunnen worden toegewezen aan de −111-piek van de monokliene ZrO2 fase en de 101 piek van de tetragonale ZrO2 fase, die het bestaan van twee fasen aangeeft. EDX- en XRD-karakteriseringen uitgevoerd op enkele ZrO x lagen met verschillende composities (getoond in aanvullend bestand 1:figuur S1 en S2) laten zien dat de stoichiometrische ZrO2 toont de monokliene fase (blauw) terwijl de tetragonale fase (groen) werd gedetecteerd van de zuurstofarme ZrO2 − x laag. Er werden geen XRD-pieken van metallisch Zr (roze) waargenomen in het drielaagse XRD-patroon. Dit suggereert het naast elkaar bestaan van beide stoichiometrische ZrO2 en zuurstofarm ZrO2 − x laag in de drielaagse structuur en de ingebedde Zr-laag is geoxideerd.
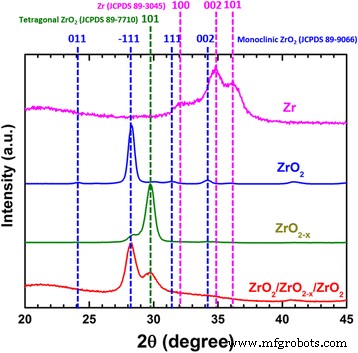
XRD-patronen van de als gedeponeerde ZrO2 /ZrO2 − x /ZrO2 drielaagse structuur (rood ), zuurstofarm ZrO2-x laag (groen ), stoichiometrische ZrO2 laag (blauw ) en pure metalen Zr-laag (roze )
Figuur 2a, b presenteren de XPS-resultaten van Zr 3d- en O 1s-piekprofielen over een etstijd van 800 s. Twee pieken gepositioneerd op ca. 182.3 en 184.5 eV kunnen worden toegeschreven aan de volledig geoxideerde Zr 4+ toestand [36, 37], die de Zr-spectra domineren tot een etstijd van ca. 300 s. Een duidelijk verhoogde intensiteit van twee pieken gepositioneerd op ca. Tussen de etstijd van 300 tot 400 s kunnen vervolgens 178,3 en 180,5 eV worden waargenomen; dit gaat ook gepaard met de vermindering van O 2− piekintensiteit bij ca. 530,0 eV. Er is gesuggereerd dat deze twee Zr 3d-pieken geassocieerd zijn met de metallische of niet-geoxideerde Zr 0 staat [36]. Dit geeft de zuurstofarme ZrO2 − x . aan laag ligt in het midden van deze drielaagse structuur. Na 400 s etstijd zal de Zr 4+ pieken hervatten hun dominantie en de intensiteit van de O 2− piek is weer normaal. De atomaire concentratie langs het diepteprofiel in figuur 2c bevestigt verder de oxidatie van de ingebedde Zr-laag in niet-stoichiometrische ZrO2 − x . Het is ook vermeldenswaard dat compositiegradiënten tussen ZrO2 en ZrO2 − x interfaces werden ook waargenomen waarvan wordt gesuggereerd dat het de vorming van grensvlakschakelgedrag vergemakkelijkt [8]. Gezien zowel de XRD- als de XPS-resultaten, is het redelijk om aan te nemen dat de monokliene fase die in de XRD wordt gedetecteerd, afkomstig is van de twee stoichiometrische ZrO2 lagen. De sandwiched zuurstofarme ZrO2 − x laag draagt daarentegen bij aan de tetragonale fase, hoewel sommige sporen van amorfe gebieden niet kunnen worden uitgesloten.
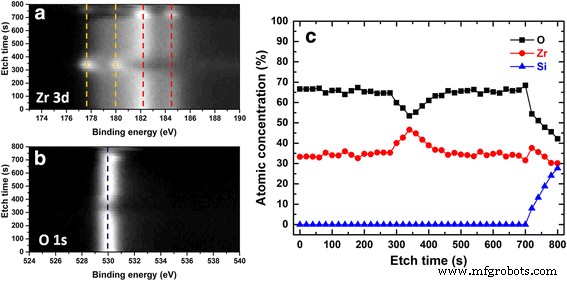
XPS-spectra van a Zr 3d en b O 1s voor de ZrO2 /ZrO2 − x /ZrO2 drielaagse structuur over een etstijd van 700 s. c XPS-diepteprofiel van de ZrO2 /ZrO2 − x /ZrO2 drielaagse structuur
TEM-meting bevestigt verder de drielaagse structuur met het zuurstofarme ZrO2 − x laag duidelijk waargenomen zoals getoond in Fig. 3a. Verder nog een grensvlaklaag tussen de ZrO2 laag en onderste TiN-elektrode is ook zichtbaar. Het overeenkomstige EDX-profiel wordt gedemonstreerd in Fig. 3b waarin interdiffusie van Ti-, O-, N- en Zr-atomen duidelijk is in de eerste 10 nm. Bovendien bevestigt de veel hogere O:Zr-verhouding (open vierkant) in de eerste 5 nm het bestaan van een TiO x N y grenslaag tussen de ZrO2 en de TiN-bodemelektrode. Inderdaad, zoals ZrO2 wordt onmiddellijk na TiN gesputterd, de O2 plasma zal reageren met het TiN-oppervlak om een TiO x . te vormen N y laag wanneer de ZrO2 laag is nog erg dun. Gelijkaardige vorming van grensvlak TiO x N y laag werd ook gerapporteerd [38, 39].
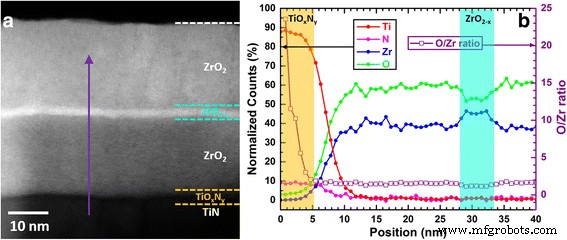
een ADF-STEM afbeelding van de doorsnede van het monster en b STEM-EDX elementaire lijnprofielen van de TiN/ZrO2 /ZrO2 − x /ZrO2 structuur
Op basis van de karakteriseringsresultaten is het schema van de ZrO2 /ZrO2 − x /ZrO2 drielaags geheugen is afgebeeld in figuur 4a. Het ongerepte apparaat wordt gemeten in de staat met hoge weerstand, zoals weergegeven in figuur 4b. Een grote negatieve vormingsspanning (I CC = 1 mA) is vereist om de zachte diëlektrische doorslag te induceren en de omschakeling te starten. Heel ongebruikelijk wordt dit geassocieerd met een vormingsproces in twee stappen, wat de opeenvolgende vorming van twee filamenten in de twee ZrO2 suggereert. lagen en het apparaat is SET in een toestand met lage weerstand. Vervolgens werd een positieve spanning toegepast op RESET het apparaat in de HRS zoals getoond in Fig. 4c. Opvallend is dat deze RESET proces wordt gekenmerkt door een geleidelijke continue afname van de stroom, een typisch kenmerk voor de grensvlak resistieve schakeling. De SET proces door een negatieve spanningsbias toe te passen, vertoont ook hetzelfde gedrag, wat suggereert dat de resistieve schakeling van de grensvlakken de dominante schakelmodus is. Het grensvlakschakelgedrag wordt verder bewezen door de gebiedsafhankelijkheid van stroom in zowel HRS als LRS (getoond in figuur 4d). Beide stromen nemen toe naarmate de elektrode groter wordt, wat aangeeft dat de stroomgeleiding niet draadvormig is. De toename van de stroom is echter niet volledig evenredig met de oppervlakte. Dit zou kunnen worden verklaard door de minder effectieve modulatie van de weerstand bij grotere celgroottes tijdens de grensvlakschakeling vanwege de grotere hoeveelheid korrelgrenzen en lekstroom [12]. Vergelijkbaar gedrag werd ook gerapporteerd in andere dubbellaagse interface resistieve schakelapparaten [8, 12]. De SET proces vertoont zelfnalevingsgedrag. Dit is gunstig voor de toepassing in resistief geheugen, omdat het de huidige overshoot tijdens het schakelen minimaliseert en de fabricagekosten aanzienlijk kan verlagen [29, 30].
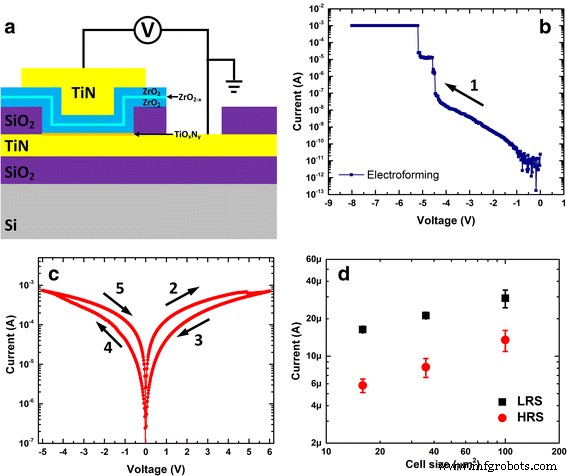
een Schema van de drielaagse TiN/ZrO2 /ZrO2 − x /ZrO2 /TiN-geheugen. b I–V kenmerken van het elektroformeringsproces voor de TiN/ZrO2 /ZrO2 − x /ZrO2 /TiN-apparaat. c I–V kenmerken van de grensvlakschakeling na vorming. d Stroom als functie van de apparaatgrootte voor zowel HRS/LRS in de interface-schakelmodus
De transformatie van de grensvlakschakelmodus naar de draadvormige schakelmodus kan worden geactiveerd door een tweede vormingsstap zoals aangetoond in figuur 5a. Een meer negatieve bias werd toegepast op het apparaat bij HRS met een stroomcompliantie van 20 mA. Dit leidt tot een abrupte toename van de stroom bij ca. -8 V, en het apparaat blijft vervolgens in een veel lagere weerstandstoestand. Na de RESET proces met een positieve bias, de schakelmodus van het apparaat is volledig getransformeerd naar filamentair, gekenmerkt door de scherpe SET (huidige bediening) en RESET overgangen. Figuur 5b toont de cumulatieve kansverdeling van de LRS's en HRS's van zowel de interface- als de draadvormige schakelmodi waarin onderscheidende verschillen kunnen worden waargenomen tussen die twee sets weerstandstoestanden, wat aangeeft dat het apparaat in verschillende modi is geschakeld. Om licht te werpen op het geleidingsmechanisme van beide schakelmodi, de logaritmische I–V curve plots en lineaire aanpassingen van de SET processen worden gepresenteerd. De I–V curve bij HRS in grensvlakmodus volgt een Ohms gedrag bij lage spanning met toevoeging van een kwadratische term bij hogere spanning, d.w.z. I ∝ aV + bV 2 , wat het typische kenmerk is van het space charge limited current (SCLC) -model zoals weergegeven in figuur 5c [40,41,42]. Gelijkaardige waarnemingen van dit SCLC-mechanisme werden ook gerapporteerd op andere interface-resistieve geheugenapparaten [8, 12]. Aan de andere kant, de logaritmische I–V curven van de SET proces bij filamentomschakeling na de transformatie wordt getoond in Fig. 5d. De curve suggereert dat de stroom wordt bepaald door het SCLC-model met vallen [40,41,42]. Hoewel een soortgelijk geleidingsmodel wordt gebruikt om de interfaciale en filamentaire schakeling te verklaren, vertonen de twee modi nog steeds verschillende kenmerken, vooral bij een toestand met lage weerstand. De stroomgeleiding voor LRS in draadvormige modus bestaat uit twee gebieden:het Ohmse gebied (I ∝ V ) en het kinderrechtgebied (I ∝ V 2 ) terwijl dit laatste niet werd waargenomen in de LRS-geleiding van grensvlakschakeling. Dit geeft aan dat de draadwisseling wordt gemedieerd door een carrier trapping/detrapping-proces [43]. We speculeren dat er tijdens het tweede vormingsproces een aanzienlijke hoeveelheid vallen worden gegenereerd in de geleidende paden, wat leidt tot de kwadratische term van stroom in LRS van de filamentaire modus.

een Ik –V kenmerken van het transformatieproces (oranje ) van de interface-omschakeling (rood ) naar de draadomschakeling (blauw ). b Cumulatieve waarschijnlijkheidsgrafiek van HRS en LRS voor beide grensvlakken (V RESET = 6 V) en filament-schakelmodi. De SET proces I–V krommen van de c grensvlak en d filamentaire schakelmodi in dubbellogaritmische plot
Enkellaags ZrO2 geheugen met een filmdikte van 40 nm werd ook gefabriceerd ter vergelijking met het schema getoond in figuur 6a. Het elektroformeringsproces (I CC = 1 mA) van de TiN/ZrO2 /TiN-apparaat heeft een enkele stap met een veel hogere spanning (Fig. 6b). Vervolgens werd bipolair schakelgedrag waargenomen (figuur 6c), wat vergelijkbaar is met de filamentaire modus in het drielaagse apparaat. De interface-schakelmodus werd echter niet waargenomen in dit enkellaagse apparaat. Figuur 6d toont de logaritmische I–V curven van de SET processen voor enkellaagse apparaten die goede overeenkomsten vertonen met het SCLC-model met traps. Dit ondersteunt ook de conclusie dat de ingeklemde ZrO2 − x laag is cruciaal voor de grensvlakschakeling die plaatsvindt op de ZrO2 − x laag of in de buurt van de ZrO2 − x /ZrO2 interface.
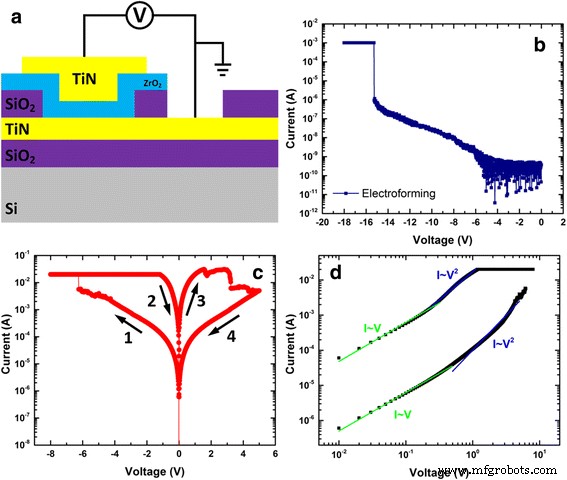
een Schema van de enkele laag TiN/ZrO2 /TiN-apparaat. b I–V kenmerken van het elektroformeringsproces voor de TiN/ZrO2 /TiN-apparaat. c I–V kenmerken van de TiN/ZrO2 /TiN-apparaat na het vormen. d I–V curven van de SET proces in dubbellogaritmische plot met lineaire aanpassing
Op basis van de karakteriseringsresultaten wordt een gedetailleerd mechanisme van beide schakelmodi en de transformatie voorgesteld, zoals weergegeven in Fig. 7. Door een negatieve vormingsspanning toe te passen, worden de zuurstofionen naar de onderste elektrode geduwd terwijl de zuurstofvacatures naar de bovenkant migreren elektrode en vormen een geleidend filament. Het grensvlak TiO x N y laag speelt een cruciale rol in het bipolaire gedrag omdat het dient als een zuurstofreservoir [38, 44]. Twee zwakke filamenten worden achtereenvolgens gegenereerd in de onderste en bovenste ZrO2 lagen, gekenmerkt door het vormingsproces in twee stappen (Fig. 7b, c). Hoewel er mogelijk enkele zuurstofionen zijn geïnjecteerd in de middelste ZrO2 − x laag, is het niveau van zuurstofvacatures nog steeds hoog genoeg om de laag in een lage resistieve toestand te houden. Het apparaat is dus overgeschakeld naar de LRS (Fig. 7c). Wanneer een positieve bias wordt toegepast, worden zuurstofionen aangetrokken uit de TiO x N y laag naar de ZrO2 − x laag, waardoor een zuurstofrijke laag ontstaat. Deze stoichiometrische modulatie van de ZrO2 − x laag verandert het geheugen in HRS (Fig. 7d). Er is nog een negatieve bias nodig om SET het apparaat in LRS door de zuurstofionen van de middelste laag terug naar de TiO x te duwen N y reservoir (afb. 7e). De conformiteitsvrije eigenschap van het apparaat kan voortkomen uit de lage geleidbaarheid van de twee filamenten, die in feite dienen als de intrinsieke serieweerstanden. De transformatie vindt plaats wanneer een aanzienlijk grote voorspanning wordt toegepast die de vorming van een veel sterker en geleidend filament door de gehele drielaagse structuur induceert (figuur 7f). De weerstand van het apparaat is niet langer afhankelijk van de ZrO2 − x laag, en de schakelmodus wordt getransformeerd van grensvlak naar draadvormig. Het apparaat kan dan AAN en UIT worden geschakeld gebruikmakend van respectievelijk positieve en negatieve bias (Fig. 7g, h).
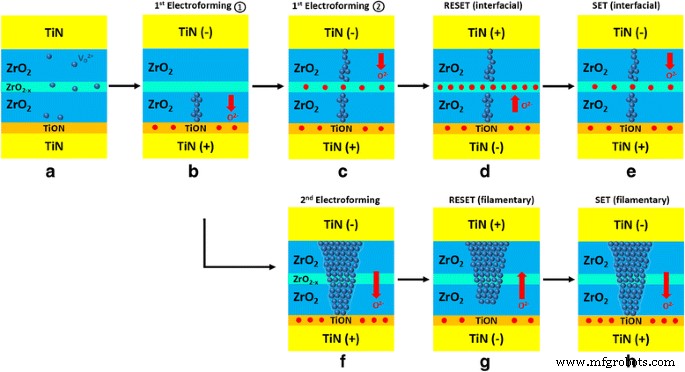
Schema's van het schakelmechanisme op de drielaagse TiN/ZrO2 /ZrO2 − x /ZrO2 /TiN-apparaat voor de interface-schakelmodus (a –e ). De transformatie van grensvlakmodus naar draadvormige modus (f ) en de filamentaire modus (g , u )
De interface-schakelmodus in dit werk biedt het potentieel voor opslag met meerdere toestanden. Aangezien de weerstand van het apparaat in de grensvlakmodus wordt gemedieerd door het niveau van zuurstofionen in de ZrO2 − x laag, kunnen meerdere weerstandstoestanden worden bereikt door de hoeveelheid zuurstofionen in de middelste laag te regelen met behulp van verschillende RESET spanningen. Afbeelding 8a toont de I–V kenmerken van het apparaat met RESET spanningen van 5,0, 5,5 en 6,0 V met een constante SET spanning van −5 V. Het is vermeldenswaard dat, aangezien de migratie van zuurstofvacatures wordt aangedreven door het elektrische veld, deze parameters schaalbaar zijn met de laagdikte. Met een dikke functionele laag van ongeveer 50 nm heeft dit gepresenteerde werk nog steeds een goed potentieel om zowel de SET en RESET spanningen. Figuur 8b toont de cycluskenmerken van deze multistate geheugenbewerking waarbij omkeerbare en reproduceerbare resistieve schakeleigenschappen worden aangetoond voor ca. 100 cycli, wat wijst op een veelbelovend uithoudingsvermogen van dit apparaat.
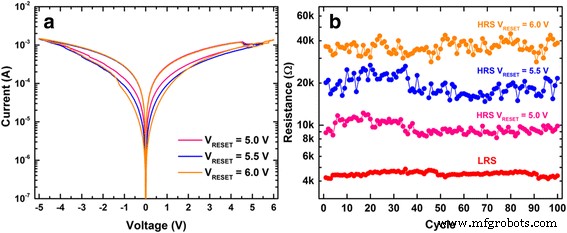
een I–V kenmerken van de grensvlakschakeling voor de drielaagse TiN/ZrO2 /ZrO2 − x /ZrO2 /TiN-apparaat met variërende RESET spanningen. b Duurtest van 100 cycli voor de grensvlakschakeling met verschillende RESET spanningen
Conclusies
Een controleerbare transformatie van de grensvlakmodus naar de filamentaire modus grensvlakmodus werd waargenomen in een ZrO2 /ZrO2 − x /ZrO2 drielaags geheugen. Het mogelijke schakel- en transformatiemechanisme wordt voorgesteld. De ingesloten ZrO2 − x laag wordt beschouwd als een cruciale laag voor de interface-schakelmodus. Deze modus vertoont een compliantievrij gedrag, mogelijk als gevolg van de intrinsieke serieweerstand door de twee dunne filamenten gevormd in de ZrO2 lagen. Door de RESET . te bedienen spanningen, multistate weerstanden bij HRS kunnen worden bereikt. Dit multistate opslaggedrag wijst duidelijk in de richting van de mogelijkheid om het multistate high-performance geheugen van de volgende generatie te ontwikkelen.
Afkortingen
- ADF-STEM:
-
Ringvormige dark-field scanning transmissie-elektronenmicroscopie
- EDX:
-
Energie-dispersieve röntgenspectroscopie
- HRS:
-
Staat met hoge weerstand
- IRS:
-
Staat van gemiddelde weerstand
- LRS:
-
Staat met lage weerstand
- RRAM:
-
Resistief willekeurig toegankelijk geheugen
- SCLC:
-
Ruimtelading beperkte stroom
- XPS:
-
Röntgenfoto-elektronenspectroscopie
- XRD:
-
Röntgendiffractie
Nanomaterialen
- Een RRAM-geïntegreerde 4T SRAM met zelfremmende resistieve schakelbelasting door puur CMOS logisch proces
- Een collectief onderzoek naar modellering en simulatie van resistief willekeurig toegankelijk geheugen
- Polarisatieconverter met regelbare dubbele breking op basis van hybride volledig diëlektrisch grafeenmetasurface
- Door ferro-elektrisch veldeffect geïnduceerd asymmetrisch resistief schakeleffect in BaTiO3/Nb:SrTiO3 epitaxiale heterojuncties
- Een onderzoek naar de variabiliteit in contactresistief willekeurig toegankelijk geheugen door stochastisch vacaturemodel
- Vervaardiging van optische schakelpatronen met structureel gekleurde microvezels
- Dubbele functies van V/SiOx/AlOy/p++Si-apparaat als selector en geheugen
- Onderzoek van de energieband bij de molybdeendisulfide- en ZrO2-heterojuncties
- Diëlektrische verbetering van door atoomlaag afgezette Al2O3/ZrO2/Al2O3 MIM-condensatoren door middel van microgolfgloeien
- High Mobility Ge pMOSFET's met ZrO2-diëlektricum:effecten van nagloeien
- Low-power resistieve schakelkarakteristiek in HfO2/TiOx bi-layer resistief willekeurig geheugen



