ZrOx negatieve capaciteit veldeffecttransistor met sub-60 subdrempelzwaaigedrag
Abstract
Hier rapporteren we de ZrOx -gebaseerde negatieve capaciteit (NC) FET's met 45,06 mV/decade subthreshold swing (SS) onder ± 1 V V GS bereik, wat nieuwe kansen kan bieden in toekomstige spanningsschaalbare NCFET-toepassingen. Het ferro-elektrische gedrag van de Ge/ZrOx Er wordt voorgesteld dat /TaN-condensatoren afkomstig zijn van de dipolen voor zuurstofvacatures. Het NC-effect van de amorfe HfO2 en ZrOx filmapparaten kunnen worden bewezen door de plotselinge daling van poortlekkage, het fenomeen van de negatieve differentiële weerstand (NDR), de verbetering van I DS en sub-60 subthreshold swing. 5 nm ZrOx -gebaseerde NCFET's bereiken een kloksgewijze hysterese van 0,24 V, lager dan 60 mV/decade SS en een I van 12% DS-verbetering vergeleken met het controleapparaat zonder ZrOx . Het onderdrukte NC-effect van Al2 O3 /HfO2 NCFET vergeleken met ZrOx NCFET is gerelateerd aan de gedeeltelijke omschakeling van dipolen voor zuurstofvacatures in de voorwaartse beweging als gevolg van negatieve grensvlakdipolen bij de Al2 O3 /HfO2 interface.
Achtergrond
Terwijl complementaire metaaloxide-halfgeleider (CMOS)-apparaten voortdurend kleiner worden, is de techniek van geïntegreerde schakelingen (IC) het tijdperk van "meer dan Moore-tijdperk" ingegaan. De drijvende kracht achter de IC-industrie en -technologie wordt de vermindering van het stroomverbruik, in plaats van de miniaturisering van transistors [1, 2]. De Boltzmann-tirannie van MOSFET's, meer dan 60 mV/decennium SS heeft de energie-/energie-efficiëntie echter beperkt [3]. In de afgelopen jaren hebben veel voorgestelde nieuwe apparaten het vermogen om een drempelschommeling van minder dan 60 mV/decennium te bereiken, waaronder MOSFET's voor impactionisatie, tunnel-FET's en NCFET's [4,5,6,7]. Vanwege de eenvoudige structuur, de steile SS en verbeterde aandrijfstroom, worden NCFET's met een ferro-elektrische (FE) film beschouwd als een aantrekkelijk alternatief onder deze opkomende apparaten [8,9,10]. De gerapporteerde experimenten met NCFET's omvatten voornamelijk PbZrTiO3 (PZT), P(VDF-TrFE) en HfZrOx (HZO) [11,12,13,14,15,16,17]. De hoge procestemperatuur en ongewenste lekstroom langs de korrelgrenzen van polykristallijne ferro-elektrische materialen hebben hun ontwikkeling voor de state-of-the-art technologieknooppunten echter beperkt [18,19,20,21,22,23,24,25 ,26]. Onlangs heeft ferro-elektriciteit in het amorfe Al2 O3 en ZrOx films die mogelijk worden gemaakt door de spanningsgemoduleerde zuurstofvacature-dipolen zijn onderzocht [27,28,29]. Vergeleken met de kristallijne tegenhanger hebben de amorfe ferro-elektrisch-achtige films significante voordelen in verminderde procestemperatuur en lekstroom. Er zijn dus massale onderzoeken naar FeFET's met amorfe poortisolator voor het niet-vluchtige geheugen en analoge synapstoepassingen [27, 30,31,32,33,34]. Het systematische onderzoek naar ZrOx . met één transistor -gebaseerde NCFET is niet uitgevoerd.
In dit werk, Ge NCFET's met 5 nm ZrOx ferro-elektrische diëlektrische laag en 5 nm Al2 O3 /HfO2 ferro-elektrische diëlektrische laag zijn respectievelijk voorgesteld. We hebben experimenteel een steile helling van minder dan 60 mV/decennium waargenomen in ZrOx (5 nm) NCFET, die kan worden toegeschreven aan het NC-effect van ZrOx ferro-elektrische laag. En we analyseerden de polarisatie P als functie van aangelegde spanning V voor de Ge/ZrOx /TaN-condensatoren. Het ferro-elektrische gedrag van de Ge/ZrOx /TaN-condensatoren worden geïnduceerd door de spanningsgeïnduceerde zuurstofleegstanddipolen. Bovendien schreven we de verbeterde I DS en de plotselinge daling van I G in de Al2 O3 /HfO2 NCFET's en ZrOx NCFET's naar het NC-effect. We hebben ook het NDR-fenomeen waargenomen in de Al2 O3 /HfO2 NCFET's en ZrOx NCFET's. Daarnaast hebben we het fysieke mechanisme van door grensvlakdipolen geïnduceerd verminderd NC-effect in de Al2 O3 /HfO2 NCFET. De ZrOx NCFET's met een steile helling van minder dan 60 mV/decennium, verbeterde afvoerspanning en lage bedrijfsspanning zijn geschikt voor het ontwerp van NCFET's met een laag stroomverbruik in het "meer dan Moore-tijdperk".
Methoden
Belangrijkste processtappen voor NCFET's met ZrOx en Al2 O3 /HfO2 fabricage worden getoond in Fig. 1a. Verschillende diëlektrische poortisolatoren, waaronder Al2 O3 /amorf HfO2 (5 nm) films en amorfe ZrOx (4,2 nm) films werden gekweekt op n-Ge (001) substraten door atomaire laagafzetting (ALD) bij 300 ° C. TMA, TDMAHf, TDMAZr en H2 O-damp werden gebruikt als de voorlopers van respectievelijk Al, Hf, Zr en O. De pulstijd en spoeltijd van de voorlopers van Hf en Zr zijn respectievelijk 1,6 s en 8 s. De pulstijd en spoeltijd van de voorlopers van Al zijn respectievelijk 0,2 s en 8 s. Een TaN-toppoortelektrode werd vervolgens afgezet op HfO2 of ZrOx oppervlakken door reactief sputteren. Source/drain (S/D)-regio's werden gedefinieerd door middel van lithografiepatronen en droog etsen. Daarna boor (B + ) en nikkel (Ni) werd afgezet in source/drain (S/D)-regio's. Ten slotte snelle thermische annealing (RTA) bij 350°C gedurende 30 s in een 10 8 Pa stikstof omgevingstemperatuur werd uitgevoerd. Figuur 1b, d toont de schema's van de gefabriceerde Al2 O3 /HfO2 NCFET's en ZrOx NCFET's. Hoge resolutie transmissie-elektronenmicroscoop (HRTEM) afbeelding in Fig. 1c toont de amorfe HfO2 (5 nm) film op Ge (001) met Al2 O3 grensvlak laag. HRTEM-afbeelding in Fig. 1e toont de amorfe ZrOx (4,2 nm) film op Ge (001). De C–V-curve van ZrOx NCFET's en de röntgenfoto-elektronenspectra (XPS) van TaN/ZrOx (4,2 nm)/Ge-condensatoren werden gemeten in aanvullend bestand 1:Fig. S1.
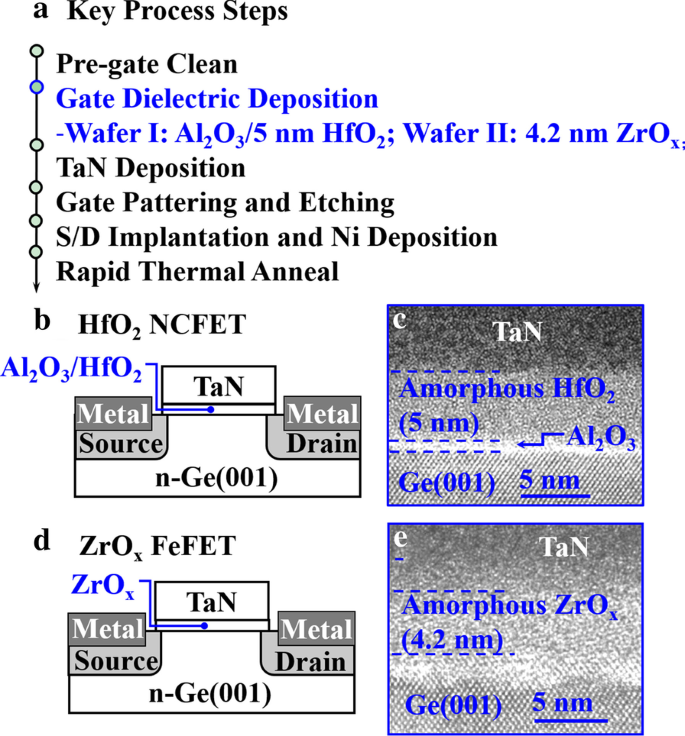
een Belangrijkste processtappen voor de fabricage van de Al2 O3 /5 nm HfO2 NCFET's en 4,2 nm ZrOx NCFET's. b Schema's en c HRTEM-beelden van de gefabriceerde ZrOx NCFET's. d Schema's en e HRTEM-beelden van de gefabriceerde Al2 O3 /HfO2 NCFET's
Resultaten en discussie
Afbeelding 2a toont de gemeten curven van polarisatie P vs. aangelegde spanning V kenmerken voor de Ge/ZrOx /TaN-condensatoren bij 3,3 kHz. De lengte van de poort (L G ) van de condensatoren zijn 8 m. Opgemerkt wordt dat de resterende polarisatie P r van de Ge/ZrOx /TaN-condensatoren kunnen worden verbeterd met een groter bereik van V . Het ferro-elektrische gedrag van de amorfe ZrOx film in de figuur 2a wordt voorgesteld afkomstig te zijn van de spanningsgestuurde zuurstofvacature-dipolen [35]. Afbeelding 2b toont de gemeten P–V krommen voor de Ge/ZrOx /TaN-condensatoren onder verschillende frequenties van 200 tot 10 kHz. We kunnen zien dat het ferro-elektrische gedrag van de amorfe ZrOx film blijft stabiel voor alle frequenties. Echter, de P r van de amorfe ZrOx film wordt verminderd met de verhoogde frequenties. Dit fenomeen kan worden verklaard door de onvolledige dipolen die schakelen bij hoge meetfrequenties [36, 37]. Naarmate de meetfrequenties toenemen, neemt de tijd voor de richtingsverandering van het elektrische veld in de amorfe ZrOx film neemt af. Een deel van de omschakeling van zuurstofvacatures is dus onvolledig, wat leidt tot een verminderde P r .

Gemeten P versus V kenmerken van de 4,2 nm ZrOx condensatoren met a verschillende veegbereiken van V en b verschillende meetfrequenties
Afbeelding 3a toont de gemeten I DS –V GS krommen van een ferro-elektrische Al2 O3 /HfO2 NCFET op de V DS van − 0,05 V en − 0,5 V. De L G van de apparaten is 3 μm. De hysteresislussen van 0,14 V (V DS = − 0,05 V, I ds = 1 nA/μm) en 0,08 V (V DS = − 0,5 V, I ds = 1 nA/μm) worden respectievelijk aangetoond. De hysteresislussen met de klok mee worden toegeschreven aan de migratie van zuurstofvacatures en gingen gepaard met negatieve ladingen. De zuurstofvacature-dipolen stapelen zich op (afnemen) in de Ge/Al2 O3 interface onder positieve (negatieve) V GS . Daarom is de drempelspanning (V TH ) neemt toe (verlaagt) onder voorwaartse (achteruit) zwaaien van poortspanningen. Zoals weergegeven in Fig. 3b, zijn de outputkenmerken van de Al2 O3 /HfO2 NCFET en de controle-FET worden vergeleken. De verzadigingsstroom van de Al2 O3 /HfO2 NCFET overschrijdt 26 μA/μm, met een stijging van 23% vergeleken met die van de controle-FET bij |V GS –V TH | =|V DS |= 0,8 V. De stroomverbetering wordt veroorzaakt door de verhoogde intensiteit van de inversielading (Q inv ) in het elektrische veld met omgekeerde polarisatie en de versterking van oppervlaktepotentiaal [38, 39]. Naast de huidige verbetering, bewijst de verkregen duidelijke NDR het NC-effect van de amorfe HfO2 film. Het NDR-effect wordt veroorzaakt door het onvolledig schakelen van dipolen voor zuurstofvacatures als gevolg van de koppeling van drain-to-channel als V DS neemt toe [40, 41]. Afbeelding 3c vergelijkt de gemeten gate-lekkage I G –V GS curven voor de 5 nm Al2 O3 /HfO2 NCFET op de V DS van − 0,05 V en − 0,5 V. De plotselinge dalingen van I G alleen tijdens de reverse sweeping geeft de verminderde spanning in de amorfe HfO2 . aan film en de versterking van oppervlaktepotentiaal [42]. De afwezigheid van NC-effect tijdens het voorwaarts vegen wordt veroorzaakt door het gedeeltelijk schakelen van zuurstofvacature-dipolen in de amorfe HfO2 filmpje [43]. Het verschillende vermogen om zuurstofatomen te bevatten tussen Al2 O3 en HfO2 laag leidt tot herverdeling van zuurstof en negatieve grensvlakdipolen aan de Al2 O3 /HfO2 interface [44, 45]. Door de aanwezigheid van negatieve grensvlakdipolen is het moeilijk voor de amorfe HfO2 film om volledige polarisatieomschakeling (NC-effect) in het voorwaarts vegen te realiseren (aanvullend bestand 1).
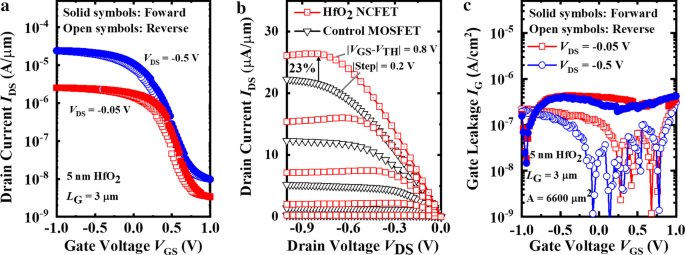
een Gemeten I DS –V GS krommen van de 5 nm HfO2 NCFET wanneer V DS = − 0,5 V en V DS = − 0,05 V. b Gemeten I DS –V DS curven van de HfO2 NCFET en de besturings-MOSFET. c Gemeten I G –V GS krommen van de 5 nm HfO2 NCFET wanneer V DS = − 0,5 V en V DS = − 0,05 V
Figuur 4a toont de gemeten overdrachtscurven van een ferro-elektrische ZrOx NCFET op de V DS van − 0,05 V en − 0,5 V. De L G van de twee apparaten is 4 μm. De hysteresislussen met de klok mee van 0,24 V (V DS = − 0,05 V, I ds = 1 nA/μm) en 0,14 V (V DS = − 0,5 V, I DS = 1 nA/μm) worden respectievelijk aangetoond. Zoals weergegeven in Fig. 4b, zijn de uitvoerkarakteristieken van de ZrOx NCFET en de controle-FET worden vergeleken. De verzadigingsstroom van de ZrOx NCFET overschrijdt 30 μA/μm, met een stijging van 12% vergeleken met die van de controle-FET bij |V GS –V TH | =|V DS |= 1 V. De verbeterde stroomverbetering en meer voor de hand liggende NDR duiden op het verbeterde NC-effect van de amorfe ZrOx film (5 nm) contrast met die van 5 nm HfO2 film. Afbeelding 4c vergelijkt de gemeten gate-lekkage I G –V GS krommen voor de 5 nm ZrOx NCFET op de V DS van − 0,05 V en − 0,5 V. Vergeleken met de plotselinge I G druppels Al2 O3 /HfO2 NCFET alleen tijdens achteruit vegen in Fig. 3c, de plotselinge dalingen van I G zowel bij voorwaarts als achterwaarts vegen in figuur 4c bewijzen ook het verbeterde NC-effect in de amorfe ZrOx film.
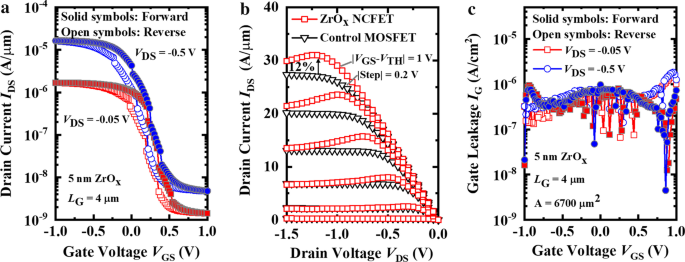
een Gemeten I DS –V GS krommen van de 5 nm ZrOx NCFET wanneer V DS = − 0,5 V en V DS = − 0,05 V. b Gemeten I DS –V DS krommen van de ZrOx NCFET en de controle-MOSFET die het voor de hand liggende NDR-fenomeen demonstreren. c Gemeten I G –V GS krommen van de 5 nm ZrOx NCFET wanneer V DS = − 0,5 V en V DS = − 0,05 V
Figuur 5a, b toont het punt SS als functie van I DS voor de Al2 O3 /HfO2 en ZrOx NCFET op de V DS van − 0,05 V en − 0,5 V. Zoals weergegeven in Fig. 5b, kan sub-60 mV/decade subthreshold swing (SS) worden bereikt tijdens voorwaarts of achterwaarts vegen van V GS bij de V DS van − 0,05 V en − 0,5 V. Wanneer V DS is− 0,05 V, een point forward SS van 45,1 mV/dec en een point reverse SS van 55,2 mV/dec werden bereikt. Wanneer V DS is− 0,5 V, een point forward SS van 51,16 mV/dec en een point reverse SS van 46,52 mV/dec werden bereikt. Vanwege het verschillende vermogen van wegvangend effect voor de Al2 O3 /HfO2 en ZrOx laag, wordt de omschakeling van de partiële dipolen veroorzaakt in de Al2 O3 /HfO2 NCFET. Daarom wordt het meer voor de hand liggende NC-effect met sub-60 mV/decade SS bereikt in 5 nm ZrOx NCFET.
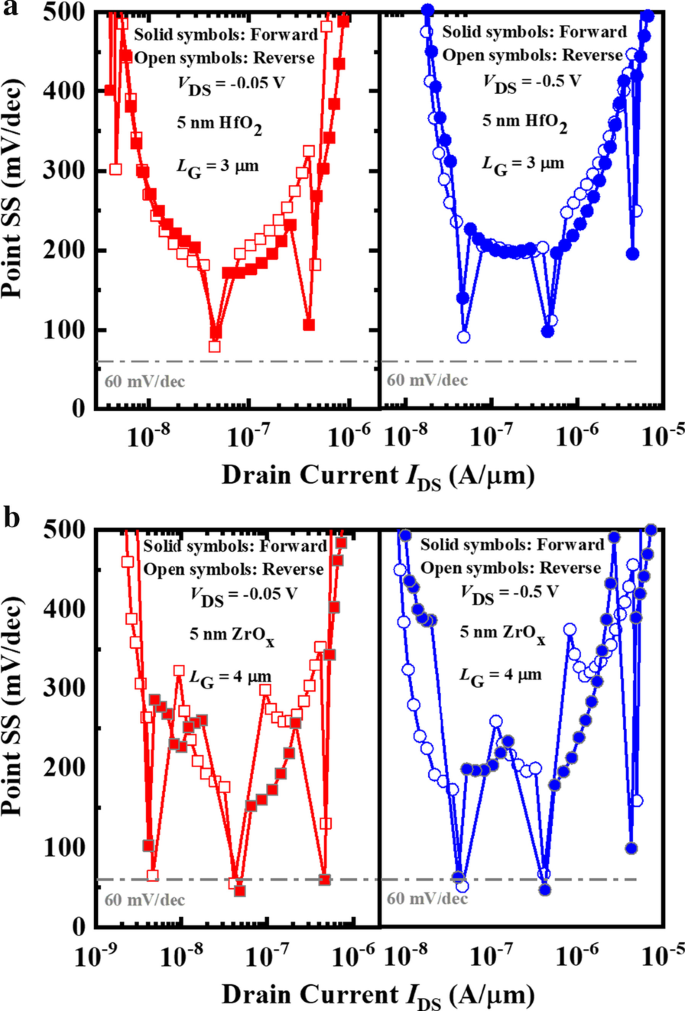
Punt SS als functie van I DS voor de een Al2 O3 /5 nm HfO2 NCFET's en b 5 nm ZrOx NCFET's
Conclusies
We rapporteren de demonstratie van ferro-elektrische NC ZrOx pFET's met een SS van minder dan 60 mV/decennium, een lage bedrijfsspanning van 1 V en een hysterese van minder dan 60 mV. De impact van de amorfe ZrOx films op het ferro-elektrische gedrag wordt verklaard door de dipolen van zuurstofvacatures. De verbeterde I DS en NDR-fenomeen worden ook verkregen in Al2 O3 /HfO2 NCFET's en ZrOx NCFET's vergeleken met het controleapparaat. Het onderdrukte NC-effect van de Al2 O3 /HfO2 NCFET kan worden toegeschreven aan partical dipool swiching als gevolg van interfical dipolen op de Al2 O3 /HfO2 koppel. De ZrOx NCFET's met een steile helling van minder dan 60 mV/decennium, verbeterde afvoerspanning en lage bedrijfsspanning banen een nieuwe weg voor het toekomstige ontwerp van NCFET's met laag stroomverbruik.
Beschikbaarheid van gegevens en materialen
De datasets die de conclusies van dit artikel ondersteunen, zijn in het artikel opgenomen.
Afkortingen
- TaN:
-
Tantaalnitride
- ZrOx :
-
Zirkoniumdioxide
- TDMAZr:
-
Tetrakis (dimethylamido) zirkonium
- P r :
-
Resterende polarisatie
- E c :
-
Gedwongen elektrisch veld
- MOSFET's:
-
Metaal-oxide-halfgeleider veldeffecttransistoren
- Ge:
-
Germanium
- ALD:
-
Atoomlaagafzetting
- B + :
-
Boor-ion
- Al2 O3 :
-
Aluminiumoxide
- HRTEM:
-
Transmissie-elektronenmicroscoop met hoge resolutie
- Ni:
-
Nikkel
- RTA:
-
Terugbetaald thermisch gloeien
- Ik DS :
-
Afvoerstroom
- V GS :
-
Poortspanning
- V TH :
-
Drempelspanning
- NCFET:
-
Negatieve capaciteit veldeffecttransistor
Nanomaterialen
- De Junction Field-effect Transistor (JFET) als switch
- Materialen:EPP-schuim met verbeterde oppervlakte-eigenschappen en geoptimaliseerd vulgedrag
- Multi-Layer SnSe Nanoflake Field-Effect Transistors met Au Ohmic-contacten met lage weerstand
- Sintergedrag van Spark Plasma Sintered SiC met Si-SiC Composite Nanodeeltjes bereid door thermisch DC-plasmaproces
- Grafeen/polyaniline-aerogel met superelasticiteit en hoge capaciteit als zeer compressietolerante supercondensatorelektrode
- Enkelwandige koolstof nanobuis gedomineerde micron-brede streeppatroon-gebaseerde ferro-elektrische veldeffect transistoren met HfO2-defect controlelaag
- Analoge/RF-prestaties van T-Shape Gate Dual-Source Tunnel Field-Effect Transistor
- Grafeen-gebaseerde nanoschaal vacuümkanaaltransistor
- Ultra-lage specifieke weerstand laterale dubbel-diffuus metaaloxide-halfgeleidertransistor met verbeterde dubbele poort en gedeeltelijk P-begraven laag
- SnSe2-veldeffecttransistor met hoge aan/uit-verhouding en polariteitsschakelbare fotogeleiding
- Hoogwaardig draaivermogen met kleine voetafdruk



