Hoogspanning β-Ga2O3 Schottky-diode met argon-geïmplanteerde randafsluiting
Abstract
De aan de rand eindigende Au/Ni/β-Ga2 O3 Schottky-barrièrediodes werden vervaardigd met behulp van argonimplantatie om de lagen met hoge weerstand aan de periferie van de anodecontacten te vormen. Met een implantatie-energie van 50 keV en een dosis van 5 × 10 14 cm −2 en 1 × 10 16 cm −2 , neemt de omgekeerde doorslagspanning toe van 209 naar 252 en 451 V (het maximum tot 550 V) en het Baliga-cijfer van verdienste (VBR 2 /Raan ) neemt ook toe van 25,7 naar 30,2 en 61,6 MW cm −2 , respectievelijk ongeveer 17,5% en 140% verbetering. Volgens de 2D-simulatie worden de elektrische velden in de junctiehoek gladgestreken na argonimplantatie en verandert de positie van de maximale elektrische doorslag, 5,05 MV/cm, van de anodehoek bij de interface naar de overlappende hoek net onder de implantatie regio. De temperatuurafhankelijkheid van de voorwaartse kenmerken werd ook onderzocht.
Achtergrond
Ontwikkeling van high-power apparaten die gebruik maken van ultra-wide-bandgap halfgeleidermaterialen zoals Ga2 O3 , AlN, diamant, enz. versnelt de laatste jaren. De bandgap van β-Ga2 O3 is zo groot als 4,8–4,9 eV en het uitsplitsingsveld van β-Ga2 O3 wordt geschat op 8 MV/cm, ongeveer drie keer groter dan die van 4H-SiC en GaN. Het verdienste van de Baliga, 3400, is minstens tien keer groter dan dat van 4H-SiC en vier keer groter dan dat van GaN [1]. Bovendien is het grote eenkristal en goedkope β-Ga2 O3 substraat kan worden vervaardigd met smeltgroeimethoden zoals floating-zone (FZ) [2] en edge-defined film-fed growth (EFG) [3, 4]. De elektronendichtheid kan worden geregeld over een breed bereik van 10 16 tot 10 19 cm −3 door doping met Sn, Si of Ge [5,6,7]. Deze uitstekende eigenschappen maken β-Ga2 O3 ideaal voor low-loss, high-voltage switching en high-power toepassingen, inclusief high-breakdown voltage Schottky barrier diode (SBD) en metaaloxide-halfgeleider veldeffecttransistor (MOSFET) [8,9,10,11,12] . Schottky-barrièrediodes hebben de voordelen van een hoge schakelsnelheid en een lage voorwaartse spanningsval in vergelijking met pn-junctiediodes, die het vermogensverlies kunnen verminderen en de efficiëntie van voedingen kunnen verbeteren.
Hoewel grote doorslagspanningen van 1016 V, 2300 V en 1600 V zijn verkregen in β-Ga2 O3 Schottky-barrièrediodes zonder randafsluiting, ze zijn allemaal ongeveer 34%, 8% en 10% van de ideale waarde [10, 13, 14]. Om het verdringingseffect van het elektrische veld te verlichten en het spanningspotentieel van β-Ga2 . volledig te realiseren O3 , moeten geschikte randafsluitingen worden ontworpen. Er zijn een aantal randafsluitingstechnieken om de doorslagspanning van het apparaat te verhogen, zoals veldplaten, zwevende metalen ringen, sleuf-MOS-structuur, geïmplanteerde beschermringen en junction-termination extension (JTE) [12, 15,16,17]. Geïmplanteerde beschermringen en JTE-structuur zijn echter niet van toepassing op Ga2 O3 Schottky-diode vanwege het ontbreken van p-type doping. H. Matsunami en BJ Baliga hebben een randbeëindigingsstructuur naar voren gebracht, waarbij argonimplantatie wordt gebruikt om een amorfe laag met hoge weerstand aan de randen van de anode te vormen, om de verdringing van het elektrische veld [18,19,20,21,22] te verminderen. een eenvoudige techniek waarvoor geen multi-fotolithografie of diepe greppel-etsstappen vereist zijn, en het wordt veel gebruikt in SiC- en GaN-gelijkrichters om de elektrische veldverdeling rond de gelijkrichtende contactperiferie af te vlakken [15, 23, 24].
In dit artikel wordt de verticale rand -Ga2 O3 Schottky-diodes werden vervaardigd met argonimplantatie aan de randen van Schottky-contacten. De capaciteit-spanning (C-V) en temperatuurafhankelijke stroomdichtheid-spanning (JV) karakteristieken werden geregistreerd met behulp van het Keithley 4200 halfgeleiderkarakteriseringssysteem en de elektrische veldverdeling werd ook geanalyseerd.
Methoden/experimenteel
De driftlaag met een dikte van 10 μm werd verkregen uit hoogwaardig Sn-gedoteerde (100)-georiënteerde β-Ga2 O3 bulksubstraat door mechanische afschilfering. De β-Ga2 O3 bulk werd gekweekt door EFG-techniek met 4 N pure Ga2 O3 poeder als uitgangsmateriaal. Uitstekende kristalkwaliteit en glad oppervlak werden bevestigd door röntgendiffractie (HRXRD) en atomic force microscope (AFM) metingen met hoge resolutie, zoals weergegeven in Fig. 1a, b. De volledige breedte bij halfmaximum (FWHM) en wortelgemiddelde (RMS) werden geschat op respectievelijk 37,4 boogseconden en 0,203 nm. Afbeelding 1c toont de verdeling van β-Ga2 O3 weerstand van het substraatvel met een dikte van 10 μm door een vierpunts-sondemeting. Gebruik van een dragerconcentratie van (1,3 ± 0,04) × 10 17 cm −3 en bladweerstand van (563 ± 18,5)Ω/□, wordt de elektronenmobiliteit berekend op 85,3~95,2 cm 2 /Vs door μn = 1/(RBlad × n × q × t ), waarbij μn, RBlad, n , q , en t zijn de elektronenmobiliteit, de bladweerstand, de elektronenconcentratie, elektronenlading en de dikte van β-Ga2 O3 substraat, vergelijkbaar met de gerapporteerde resultaten [25]. Argon-ionenimplantatie met een energie van 50 keV, de dosis van 2,5 × 10 14 cm −2 , en gloeien bij hoge temperatuur bij 950 °C gedurende 60 min in N2 atmosfeer werden eerst uitgevoerd aan de achterkant, gevolgd door E-beam verdamping van een Ti/Au (20 nm/100 nm) ohmse metalen stapel en snelle thermische uitgloeiing bij 600 ° C gedurende 60 s in N2 omgeving. Vervolgens werd de 2 μm dikke fotoresist gebruikt als masker voor argonimplantatie bij kamertemperatuur met een energie van 50 keV en een dosis van 5 × 10 14 cm −2 (voorbeeld B) en 1 × 10 16 cm −2 (monster C), respectievelijk. Om de implantatieschade te herstellen en de lekstroom onder omgekeerde voorspanning te verminderen, werden de geïmplanteerde monsters onderworpen aan een snelle thermische uitgloeiing bij 400 ° C gedurende 60 s onder N2 omgevingstemperatuur [13, 26]. Ten slotte werden de cirkelvormige Schottky-anode-elektroden met een diameter van 100 m aan de voorkant vervaardigd door standaard fotolithografische patronen, verdamping van Ni / Au (30 nm / 200 nm) stapel en opstijgen. Het referentieapparaat zonder argonimplantatie werd ook vervaardigd (monster A). Afbeelding 2a toont dwarsdoorsnede TEM van gefabriceerd Ga2 O3 Schottky-diode met argon-geïmplanteerde randafsluiting. Een bijna oppervlakte amorf β-Ga2 O3 laag werd gemaakt in het implantatiegebied. De daadwerkelijke foto van de beëindigde β-Ga2 O3 Schottky-diode wordt getoond in figuur 2b. Figuur 2c vertegenwoordigt de meetopstelling van voorwaartse stroom-spanning (I -V ) kenmerken van de β-Ga2 O3 SBD, terwijl de meetspanning tussen 0 en 3 V ligt en de stap 10 mV is. Figuur 2d toont de meetopstelling van sperstroom-spanning (I -V ) kenmerken van β-Ga2 O3 Schottky-gelijkrichters om de doorslagspanning te verkrijgen, terwijl de meetspanning tussen 0 en -500 V ligt en de stap -1 V is.

een XRD schommelende curve en b AFM-beeld van de β-Ga2 O3 driftlaag mechanisch geëxfolieerd van (100) β-Ga2 O3 substraat c gemeten plaatweerstand van 10 mm × 10 mm β-Ga2 O3 substraat
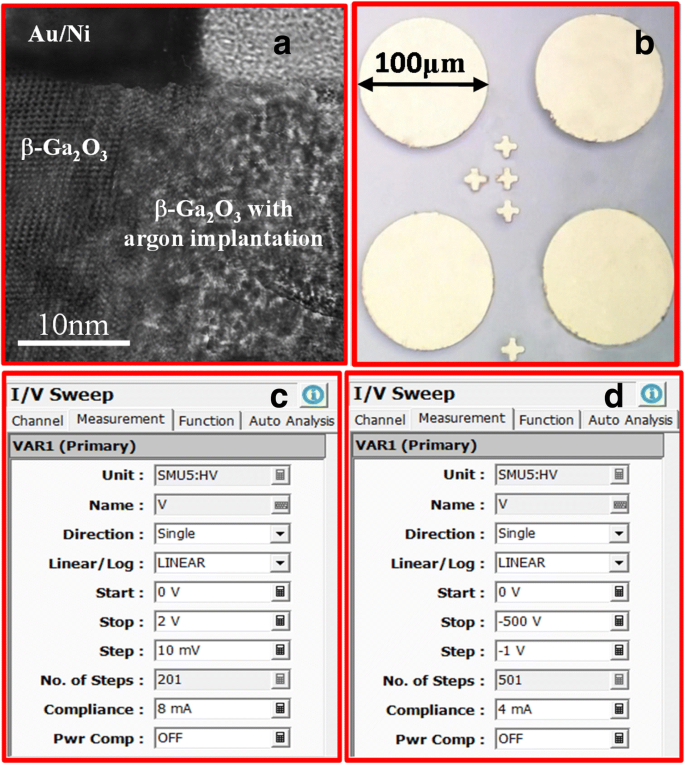
een TEM-afbeelding van monster C en b foto van de afgesloten β-Ga2 O3 Schottky-diode c de meetopstelling van voorwaartse stroom en d omgekeerde stroom-spanning (I-V) kenmerken van de β-Ga2 O3 SBD om de doorslagspanning te verkrijgen
Resultaten en discussie
Afbeelding 3 toont de experimentele 1/C 2 versus V kenmerken van drie SBD-monsters bij kamertemperatuur. De effectieve dragerconcentratie N d -N een van β-Ga2 O3 driftlaag en ingebouwd potentieel (eV bi ) worden geëxtraheerd om (1,3 ± 0,04)× 10 17 . te zijn cm −3 en (1,30 ± 0,08) eV, respectievelijk. Volgens de volgende vergelijkingen is de hoogte van de Schottky-barrière φ b_CV wordt berekend als (1,32 ± 0,08) eV.
$$ \frac{1}{C^2}=\frac{2}{q\varepsilon {A}^2\left({N}_d-{N}_{\mathrm{a}}\right)} \left({V}_{bi}-V\right) $$ (1) $$ e{\varphi}_b={eV}_{bi}+\left({E}_c-{E}_f\ rechts)-e\Delta \varphi $$ (2) $$ {E}_c-{E}_f=kT\ln \left(\frac{N_c}{N_d-{N}_a}\right) $$ ( 3) $$ e\Delta \varphi ={\left\{\frac{e}{4\pi \varepsilon}{\left[\frac{2{eV}_{bi}\left({N}_d- {N}_a\right)}{\varepsilon}\right]}^{1/2}\right\}}^{1/2} $$ (4)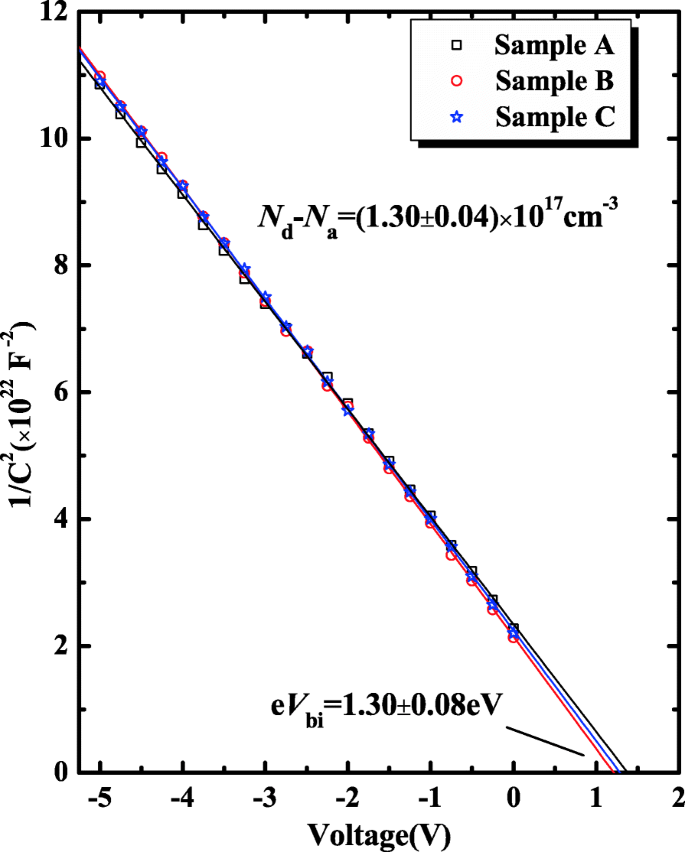
1/C 2 -V percelen van drie β-Ga2 O3 SBD-voorbeelden
waar A , q , en ε zijn Schottky-contactoppervlak, elektronenlading en permittiviteit van β-Ga2 O3 . E c , E f , eΔφ , k , T , en N c zijn respectievelijk het geleidingsbandminimum, Fermi-niveau, potentiële barrièreverlaging veroorzaakt door de beeldkracht, Boltzmann-constante, absolute temperatuur in K en effectieve toestandsdichtheid van de geleidingsband.
Afbeelding 4a geeft de voorwaartse stroomdichtheid-spanning weer (J -V ) kenmerken van de β-Ga2 O3 SBD. Onder de voorwaartse voorspanning heeft de argonimplantatie geen significant effect op de elektrische eigenschappen. De drempelspanning wordt bepaald op 0,91 V, 0,92 V en 0,95 V voor drie monsters, de I aan /Ik uit verhoudingen zijn allemaal groter dan 10 9 bij kamertemperatuur en door het lineaire gebied te passen, de specifieke aan-weerstanden (R aan ) zijn 1,7,2,1 en 3,3 mΩ cm 2 , en doorlaatstroomdichtheden bij 2 V zijn 857, 699 en 621 A/cm 2 voor respectievelijk drie monsters, zoals weergegeven in de inzet van figuur 4a. De stroomdichtheden zijn hoger en de specifieke aan-weerstanden zijn lager dan of vergelijkbaar met de gerapporteerde waarden voor de hogere geleidbaarheid en dragerdichtheid in de driftlaag [12, 13, 26,27,28,29,30].
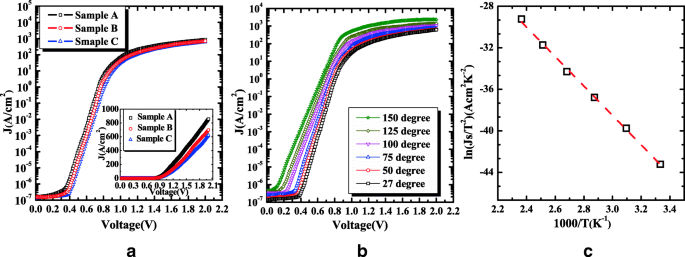
een De voorwaartse J -V kenmerken van de beëindigde en onafgesloten β-Ga2 O3 bij kamertemperatuur en b de temperatuurafhankelijke voorwaartse J -V kenmerken van monster C van 300 tot 423 K. c Richardsons plot van ln(J .) s/T 2 ) vs 1000/T van monster C
Om de effecten van argonimplantatie op de temperatuurafhankelijkheid van de voorwaartse kenmerken te onderzoeken, wordt de voorwaartse J -V metingen van monster C worden uitgevoerd van 300 tot 423 K, zoals weergegeven in Fig. 4b. De ideale factor n en Schottky barrière hoogte φ b_JV zijn vastgesteld op 1,06 en 1,22 eV bij kamertemperatuur, lager dan de φ b_CV van (1,32 ± 0,08) eV, volgens het thermionische emissie (TE)-model [31, 32]. Naarmate de temperatuur stijgt, wordt de n neemt af van 1,06 tot 1,02 en de barrièrehoogte neemt iets af, maar is bijna constant op 1,21 ± 0,01 eV over het temperatuurbereik, wat in strijd is met de barrièrehoogteafname van een ideale Schottky-diode met temperatuurstijging, maar is waargenomen in gefabriceerd β-Ga 2 O3 SBD [26]. Met behulp van de vergelijking ln(J s/T 2 ) = ln(A*)-qϕ b /kT , de hoogte van de barrière ϕ b en de effectieve Richardson-constante A* wordt bepaald op 1,22 eV en 48,5 A/cm 2 K 2 voor monster C van de helling en de y -as snijpunt van het lineaire gebied van de plot, zoals weergegeven in figuur 4c. Bovendien liggen de geëxtraheerde A*-waarden voor tientallen apparaten op de drie voorbeelden tussen 24 en 58 A/cm 2 K 2 , consistent met de resultaten van het vorige experiment en de theoretische waarde, 24-58 A/cm 2 K 2 , met de effectieve elektronenmassa m * = 0,23–0,34 m0 van β-Ga2 O3 [33,34,35,36,37].
Afbeelding 5a toont de omgekeerde J -V kenmerken van de monsters. Na argonimplantatie neemt de doorslagspanning toe van 209 naar 252 en 451 V en het Baliga-verdienste (VBR 2 /Raan ) voor drie monsters zijn ongeveer 25,7, 30,2 en 61,6 MW cm −2 , respectievelijk. Tijdens implantatie kunnen enkele defecten worden geïntroduceerd en leiden tot de significante en ongewenste toename van lekstroom, wat ook werd gerapporteerd in SiC- en GaN Schottky-diode-apparaten [18,19,20]. Hoewel de thermische uitgloeiing werd uitgevoerd na argon-implantatie, zijn er nog steeds iets grotere lekstromen voor monsters B en C. Daarom moeten de onderzoeksdetails van de temperatuur na uitgloeien en de duur van de voorwaartse en achterwaartse elektrische kenmerken in het volgende artikel worden behandeld.

een De omgekeerde J -V kenmerken van de β-Ga2 O3 monsters bij kamertemperatuur. b en c Verdeling van doorslagspanningen van β-Ga2 O3 SBD's met en zonder argonimplantatie
Afbeelding 5b, c geeft de verdeling van doorslagspanningen van β-Ga2 . weer O3 Schottky-gelijkrichters met en zonder argonimplantatie. De ideale vlakke parallelle doorslagspanningen van deze apparaten worden bepaald als 553 ~ 598 V, met behulp van het kritische elektrische veld van 5,1 ~ 5,3 MV/cm [11, 39]. De doorslagspanning zonder argonimplantatie is ongeveer 110 ~ 310 V, wat ongeveer 50% van de ideale waarden is. Echter, met een argon-implantatiedosis van 5 × 10 14 cm −2 , neemt de doorslagspanning toe tot 150~350 V, niet veel groter dan het referentieapparaat, terwijl met de dosis van 1 × 10 16 cm −2 , nadert de doorslagspanning de ideale waarden. In dit werk kan de maximale doorslagspanning van 550 V worden verkregen. Daarnaast werd de elektrische veldverdeling bij de doorslagspanning gesimuleerd. Ter vereenvoudiging werd een enkel acceptorniveau in het midden van de opening toegevoegd met de implantatiediepte van 50 nm bepaald door de TRIM-simulatie en het onvolledige ionisatiemodel werd ook overwogen [38], zoals weergegeven in Fig. 6. Het is duidelijk dat de laag met hoge weerstand effectief gladstrijkt uit elektrisch veld op de junctiehoeken en verbetert de doorslagspanning aanzienlijk in vergelijking met het referentiemonster. De maximale elektrische velden bij doorslagspanning zijn allemaal ongeveer 5,05 MV/cm, vergelijkbaar met de gerapporteerde resultaten [11, 39], terwijl de positie verandert van de anodehoek bij het grensvlak naar de overlappende hoek net onder het implantatiegebied, zoals aangegeven in Afb. 6d, e.
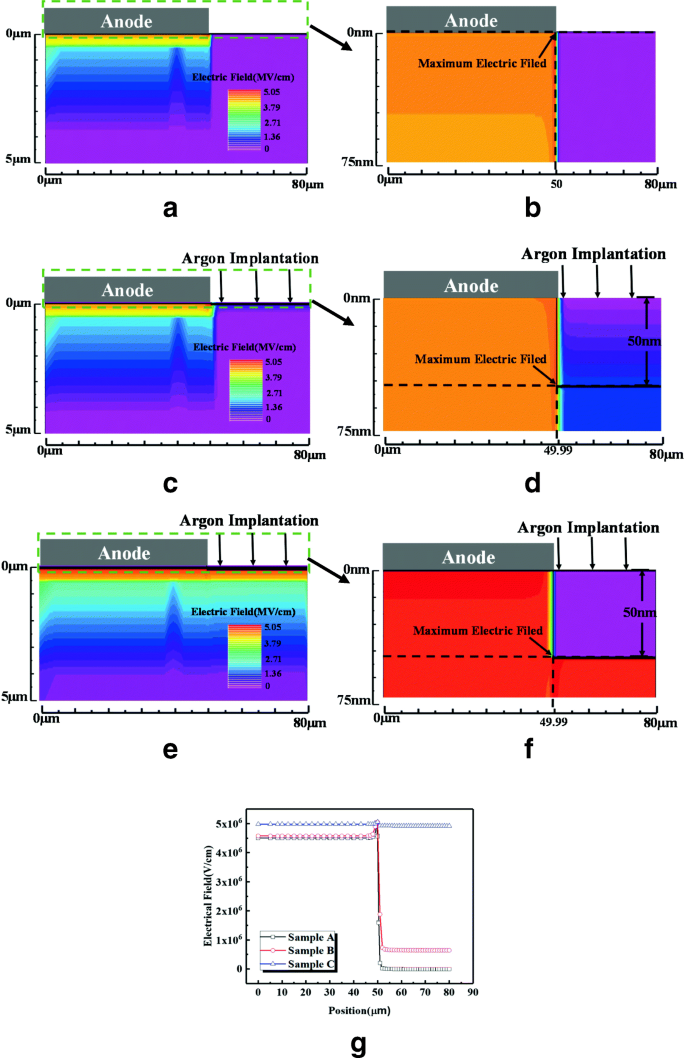
Simulatie van de elektrische veldverdeling bij doorslagspanning van monsters A–C (a , c , e ), de vergrote afbeelding van geselecteerde regio's in een gestippeld vak (b , d , v , g ), het gesimuleerde elektrische veld versus de positie langs de stippellijn in (b , d , v ) voor drie monsters, Au/Ni/β-Ga2 O3 interface voor monster A, 50 nm onder de interface voor respectievelijk monsters B en C. Het maximale veld is 5,05 MV/cm
Conclusies
Verticaal Au/Ni/β-Ga2 O3 Schottky-barrièrediodes met randafsluiting gevormd door argonimplantatie werden vervaardigd op β-Ga2 O3 driftlaag mechanisch geëxfolieerd van hoogwaardige (100)-georiënteerde β-Ga2 O3 bulksubstraat. In vergelijking met het controleapparaat zijn de specifieke aan-weerstanden (R aan ) neemt toe van 1,7 naar 2,1 en 3,3 mΩ cm 2 en de doorslagspanning neemt toe van 209 naar 252 en 451 V voor implantatiedosis van 5 × 10 14 cm −2 en 1 × 10 16 cm −2 , respectievelijk, met een grotere omgekeerde lekstroom. Het maximale elektrische veld bij doorslagspanning is ongeveer 5,05 MV/cm, veel groter dan dat van SiC en GaN.
Afkortingen
- AFM:
-
Atoomkrachtmicroscoop
- EFG:
-
Randgedefinieerde filmgevoede groei
- FWHM:
-
De volledige breedte op halve maximum
- FZ:
-
Drijvende zone
- HRXRD:
-
Röntgendiffractie met hoge resolutie
- JTE:
-
Verlenging knooppuntbeëindiging
- MOSFET:
-
Metaaloxide-halfgeleider veldeffecttransistor
- RMS:
-
Wortelgemiddelde kwadraat
- SBD:
-
Schottky-barrièrediode
- TE:
-
Thermionische emissie
Nanomaterialen
- ST stuurt AI naar edge en node embedded apparaten met STM32 neural-netwerk developer toolbox
- ept:HighSpeed SMT edge-kaartconnector met 0,8 mm pitch
- Toekomstige elektronica:MEMS-microfoon van CUI met verbeterde geluidskwaliteit
- Advantech brengt versneld computergebruik van de cloud naar de edge met NVIDIA
- ADLINK:implementeer AI van edge tot cloud met Edge AI Solutions en het NVIDIA EGX-platform
- ADLINK debuteert snellere, nauwkeurigere logistiek met Edge IoT Smart Pallet Experience
- Cisco verenigt enterprise en industrial edge met nieuwe routers
- Industrie 4.0 upgraden met edge-analyse
- Advancing Edge Computing, IIC sluit zich aan bij OpenFog
- Slimme 5G-patrouillerobots uitgerust met Advantech's edge-computer die worden gebruikt om het coronavirus te bestrijden
- Aan de slag met AI-inferentie aan de rand



