Verbeterde nabij-infraroodabsorber:in twee stappen gefabriceerd gestructureerd zwart silicium en de bijbehorende apparaattoepassing
Abstract
Silicium wordt veel gebruikt in de halfgeleiderindustrie, maar presteert slecht in nabij-infrarood foto-elektronische apparaten vanwege de hoge reflectie en bandafstandlimiet. In deze studie wordt een tweestapsproces, een diepe reactieve ionenetsmethode (DRIE) gecombineerd met plasma-immersie-ionenimplantatie (PIII) gebruikt om microgestructureerd zwart silicium op het oppervlak van C-Si te fabriceren. Deze verbeterde oppervlakken gedoteerd met zwavelelementen zorgen voor een smallere bandafstand en een verbetering van de lichtabsorptie, vooral in het nabij-infraroodbereik (800 tot 2000 nm). Ondertussen neemt de maximale lichtabsorptie aanzienlijk toe tot 83%. Een Si-PIN foto-elektronische detector met microgestructureerd zwart silicium aan de achterkant vertoont opmerkelijke apparaatprestaties, wat leidt tot een responsiviteit van 0,53 A/W bij 1060 nm. Dit nieuwe microgestructureerde zwarte silicium, dat een smalle bandafstand-karakteristiek combineert, zou een potentiële toepassing kunnen hebben in nabij-infrarood foto-elektronische detectie.
Achtergrond
Tot nu toe kunnen veel micro- en nanogestructureerde zwarte siliciummaterialen ook worden vervaardigd met behulp van DRIE-behandeling en ionenimplantatie, met als doel de lichtreflectie te verminderen en de nabij-infraroodabsorptie te verbeteren [1,2,3,4,5]. Het DRIE-proces wordt meestal uitgevoerd in een modus van cyclische ets-passiveringsstappen met een fotoresistmasker dat de siliciummicrofabricage van structuren met een hoge aspectverhouding mogelijk maakt. Over het algemeen maakt deze benadering gebruik van op F gebaseerde plasma's zoals SF6 voor snel isotroop etsen en schakelt vervolgens over naar een passieve cyclus van de zijwand met C4 F8 [6,7,8]. Tijdens de daaropvolgende etscyclus wordt de passiverende film bij voorkeur van de bodem van de groef verwijderd vanwege ionenbombardement, terwijl het etsen van de zijwanden wordt voorkomen [9]. Ten slotte zou het afwisselen van ets- en passiveringscycli de specifieke geometrieën van de geëtste siliciumstructuren kunnen vormen, die voornamelijk afhankelijk zijn van maskergrootte, gasstroom, elektrodevermogen, procestijd, cyclustijden, enzovoort. Om de absorptie van silicium in de nabij-infrarode golflengte te verbeteren, zullen de geëtste siliciumstructuren worden gedoteerd door ionenimplantatie na het DRIE-proces. Onder bepaalde omstandigheden kunnen de zwarte siliciumarrays worden verkregen, en de resulterende zwaveldoteringsmiddelen in het siliciumrooster zullen uiteindelijk een aanzienlijke absorptie van straling onder de bandafstand veroorzaken [10, 11].
Als een van de belangrijkste materialen in de halfgeleiderindustrie wordt zwart silicium veel gebruikt in gevoelige foto-elektronische detectoren, zonnecellen, biochemische sensoren, weergaveapparatuur en optische communicatieobjecten [12,13,14,15,16,17,18, 19,20]. Micro- en nanostructuren van zwart silicium zijn de afgelopen jaren de focus geweest van intensief onderzoek vanwege hun uitgebreide apparaattoepassing. Een Si-PIN foto-elektronische detector met zwart silicium aan de voorkant is onderzocht in onze vroege studie [21]. Deze apparaatstructuur heeft een brede uitputtingslaag, zodat deze de invloed van dragerdiffusiebeweging kan verminderen en het doel kan bereiken om de gevoeligheid en reactiesnelheid van het apparaat te verbeteren. Er wordt ook opgemerkt dat het gebruik van zwart silicium als een lichtgevoelig oppervlak erg moeilijk is voor de gegenereerde dragers die door de P-laag moeten worden verzameld om fotostroom door de elektrode uit te voeren, wat resulteert in een relatief lage respons op zichtbaar licht in vergelijking met een traditionele Si-PIN-detector. Het lijkt dus een vraag dat als een Si-PIN foto-elektronische detector met zwart silicium aan de achterkant twee taken tegelijk zou kunnen uitvoeren, namelijk om de gevoeligheid van het apparaat niet alleen in het nabij-infrarood maar ook in de zichtbare golflengte te verhogen?
In dit artikel rapporteren we de verbetering van de lichtabsorptie en de smallere bandafstand die kenmerkend is voor microgestructureerd zwart silicium vervaardigd door een tweestapsproces:DRIE gecombineerd met PIII. Het effect van verschillende etsprocedures op de lichtabsorptie in het golflengtebereik van 400 tot 2000 nm is bestudeerd, en de detector op basis van dit microgestructureerde zwarte silicium op het achteroppervlak is ook onderzocht met de nadruk op de responsiviteit van het apparaat in de golflengte van 400~1100 nm.
Methoden
Zoals getoond in figuur 1a, werden uniforme en periodieke verdelende cilindrische arrays gekozen om de optische eigenschappen van microgestructureerd silicium te onderzoeken met FDTD-simulatiesoftware. Figuur 1b geeft de relatie weer tussen de absorptie en vier verschillende modelgroottes van het microgestructureerde silicium na geoptimaliseerde simulatie, waarbij vier modellen dezelfde cilinderdiameter hebben (D = 4 μm) maar andere hartafstand (T 1 = 12 μm, T 2 = 10 μm, T 3 = 8 μm, T 4 = 6 μm).
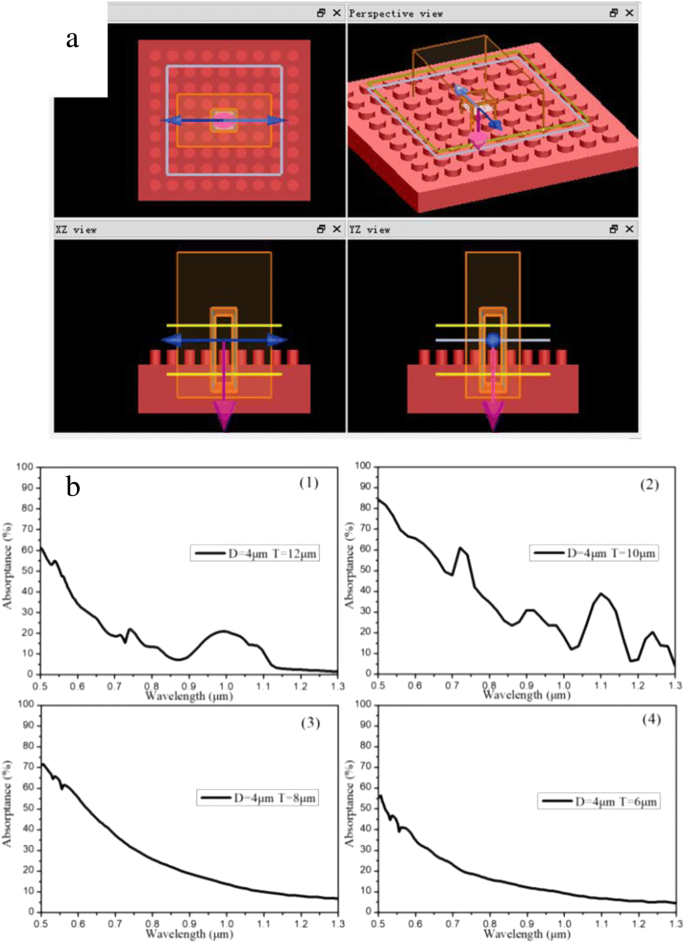
Optisch simulatiemodel (a ) en simulatieresultaten (b ) van microgestructureerd silicium
Zoals getoond in Fig. 2, werden op basis van de bovenstaande geoptimaliseerde simulatieresultaten drie verschillende fotolithografiemaskers ontworpen door de maskergrootte te variëren, genaamd masker I (D = 4 μm, T = 6 μm), masker II (D = 4 μm, T = 8 μm), en masker III (D = 4 μm, T =10 μm), respectievelijk. Vervolgens werd fotoresist NR9-1500PY aangebracht om een cirkelvormig array-masker af te zetten op het polijstoppervlak van siliciumstukken (15 × 15 cm 2 ), die werden gesneden uit n-type siliciumwafels met een dikte van 500 m en een soortelijke weerstand van 2500 tot 3000 Ω· cm. Om het effect van het etsproces op de lichtabsorptie van microgestructureerd silicium te onderzoeken, hebben we de testmonsters die het resultaat waren van masker III naar de procesholte (DRIE, ICP-100D) verplaatst en de cyclustijden gewijzigd, waarbij SF6 werd gebruikt als etsgas en C4 F8 als passiveringsgas, voor 30 keer, 70 keer en 100 keer, anders. Na etsprocessen werden de siliciumstukjes verwijderd van eventuele resterende fotoresist onder de atmosfeer van zuurstof om ervoor te zorgen dat het siliciumoppervlak schoon en glad was. Om de absorptie van microgestructureerd silicium te verbeteren, vooral in de nabij-infraroodband, werden de testmonsters die het resultaat waren van masker III hierna gedoteerd met zwavelelementen via het PIII-proces onder de voorwaarde van 1,0E + 15 cm − 2 implantatiedosis en 800 eV implantatie-energie, respectievelijk.

Het schematische diagram van de maskergrootte
De morfologieën van zwart silicium werden gekarakteriseerd door een veldemissie scanning elektronenmicroscoop (SEM, JSM-7500F). De lichtabsorptie werd verkregen bij kamertemperatuur met behulp van een vezeloptische spectrometer (NIR2500) uitgerust met een integrerende bol (Idea Optics, IS-20-5). De responsiviteit van de detector werd gemeten met behulp van een optische vermogensmeter (OPHIR, Vega), een optische chopper (Scitec Instruments, Model-300CD) en een Keithley2636B-apparaat in de donkere kamer. Om de nauwkeurigheid van de meting te garanderen, hebben we vóór de test een kalibratie uitgevoerd en elk van deze metingen werd uitgevoerd op een paar monsters (meestal 4 tot 6).
Resultaten en discussie
Afbeelding 3 geeft de typische SEM-beelden van uitgelijnde microgestructureerde siliciumarrays die loodrecht op het oppervlak van het substraat staan voor drie verschillende maskergroottes. Het is duidelijk aangetoond dat het bovenaanzicht van het microgestructureerde silicium eigenlijk geen standaardcirkels zijn vanwege het feit dat het DRIE-proces voornamelijk afhangt van de maskergrootte en de kwaliteit van de fotolithografietechniek. Om vervolgens het effect van het etsproces op de lichtabsorptie van microgestructureerd silicium te onderzoeken, veranderen we de cyclustijden als 30, 70 en 100 keer op masker III-testmonsters onder de omstandigheden van etsen met SF6 voor 3 s, en passiveren met C4 F8 gedurende 2 s, elke cyclustijd.
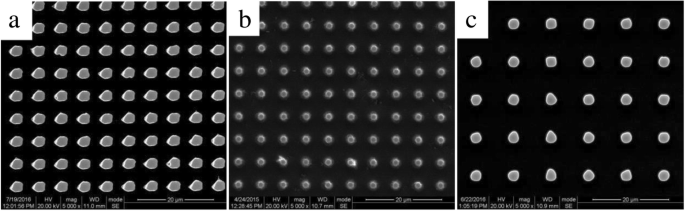
Typische microgestructureerde siliciumarrays gemaakt door DRIE voor verschillende maskerformaten. een Masker I. b Masker II. c Masker III
Afhankelijk van de verschillende etssnelheidsverhoudingen tussen fotoresist en silicium, kan de etsdiepte worden geregeld door procesparameters, zolang de fotoresist maar dik genoeg is als een masker. Uit figuur 4 blijkt dat de hoogte van cilinders toeneemt met het aantal cyclustijden, waarbij de hoogte van de bovenkant tot het substraat respectievelijk ongeveer 1,87 m, 2,35 m en 3,15 μm is. Het is algemeen bekend dat bij het DRIE-proces, hoewel er passiveringsgassen zijn om de zijwand van het etsdoel te beschermen, dit min of meer gepaard gaat met lateraal etsen. Dit is de reden waarom de resulterende morfologieën geen ideale cilindrische arrays zijn. Het is duidelijk dat de morfologieën van deze microgestructureerde siliciumarrays goed kunnen worden gecontroleerd door de lithografieproces- en etscyclustijden te variëren.
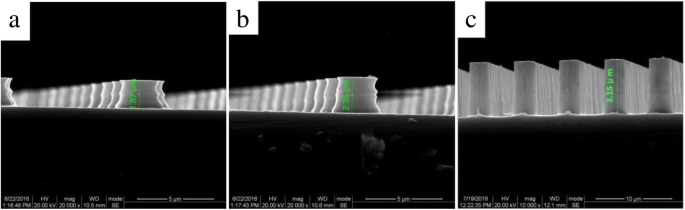
Doorsnede van masker III-monsters vervaardigd voor verschillende cyclustijden. (een ) 30, (b ) 70, en (c ) 100
Figuur 5a geeft de lichtabsorptie weer van microgestructureerde cilindrische arrays bij verschillende cyclustijden zonder PIII-proces. Het is aangetoond dat C-Si met geëtste siliciumarrays, vergeleken met gewoon C-Si, de lichtabsorptie in het golflengtebereik van 400 tot 2000 nm tot op zekere hoogte kan verbeteren. Het monster dat gedurende 100 cyclustijden is geëtst, heeft de hoogste absorptie, tot 70% in het NIR-bereik (800 tot 2000 nm), en de gemiddelde absorptie van dit monster bereikt 55% in het golflengtebereik van 400 tot 2000 nm. Dit komt door de meervoudige reflectie en absorptie van microgestructureerd silicium (zoals in figuur 6). Terwijl invallend licht continu wordt gereflecteerd op het zijoppervlak van de cilinder, neemt de absorptiepadlengte van invallend licht toe, wat resulteert in de absorptieverbetering. Desalniettemin is de absorptiesnelheid nog steeds niet hoog genoeg wanneer de golflengte meer dan 1000 nm is. Om de absorptie van microgestructureerd silicium verder te verbeteren, vooral in de nabij-infrarode band, worden dezelfde monsters daarom gedoteerd met zwavelelementen door middel van het PIII-proces onder de voorwaarde van 1,0E + 15 cm − 2 implantatiedosis en 800 eV implantatie-energie, respectievelijk. Zoals getoond in figuur 5b, is de lichtabsorptie duidelijk verhoogd in het golflengtebereik van 400 tot 2000 nm na ionenimplantatie. Hier is de lichtabsorptie van het geëtste monster gedurende 100 cyclustijden veel hoger dan die van C-Si. De maximale en gemiddelde lichtabsorptie nemen aanzienlijk toe tot respectievelijk 83% en 62%. Bovendien kan men gemakkelijk waarnemen (zoals in figuur 5c) dat de absorptie van 100 cyclusmonsters een significante verandering in de golflengte heeft van 800 tot 2000 nm voor en na doping van zwavelelementen, waarbij de maximale en gemiddelde waarden toenemen met 13% en respectievelijk 7%.
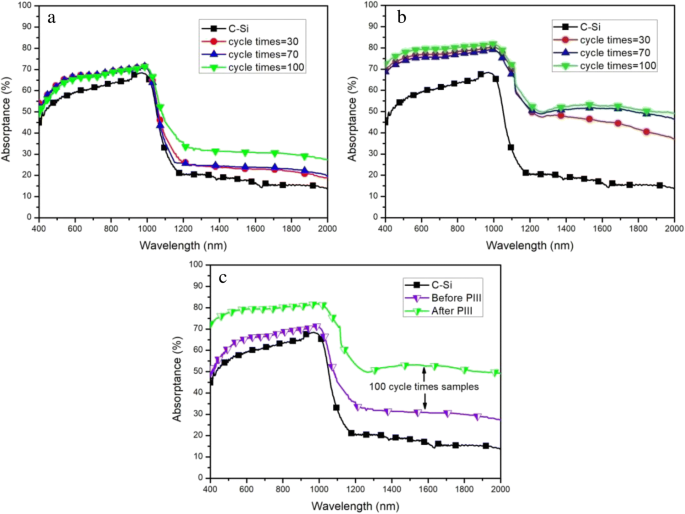
Absorptie van C-Si en zwart silicium vervaardigd door verschillende cyclustijden voor (a ) en na PIII (b ) en vergelijking van 100 cyclusvoorbeelden (c )

Het transmissiepad van invallend licht op het oppervlak van microgestructureerd silicium
Deze hoge absorptie komt voornamelijk van de zwaveldotering onder microgestructureerde cilindrische arrays, waardoor meerdere onzuiverheidsniveaus in de energiebandstructuur van C-Si worden gevormd. Als gevolg hiervan wordt, wanneer deze geïnduceerde meerdere onzuiverheidsniveaus elkaar overlappen, een nieuwe onzuiverheidsband gevormd na verbreding, die uiteindelijk de bandafstand van C-Si vermindert. De bandgap kan worden verkregen uit het absorptiespectrum van het monster door Tauc-mapping. De specifieke genomen stappen zijn als volgt:
(i) het reflectiespectrum wordt geconverteerd naar K-M-functie F (R ∞ ) met behulp van de Kubelka-Munk-theorie:
$$ F\left(R\infty \right)\circa \frac{A^2}{2R} $$ (1)waarin R en A zijn respectievelijk het reflectiespectrum en het absorptiespectrum van het monster.
(ii) De K-M-functie F (R ∞ ) wordt als volgt in de Tauc-formule vervangen:
$$ {\left( hv\alpha \right)}^{1/n}=K\left( hv- Eg\right) $$ (2) $$ hv=\frac{1239.7}{\lambda } $$ (3)waarin de waarde van index n gerelateerd is aan het overgangstype van de steekproef:directe overgang, n = 1/2; indirecte overgang, n = 2. F (R ∞ ) is evenredig met de absorptiecoëfficiënt α, die kan worden vervangen door F (R ∞ ), en n = 2 wordt in de formule (2) vervangen om het volgende te verkrijgen:
$$ {\left( hv F\left(R\infty \right)\right)}^{1/2}=K\left( hv- Eg\right) $$ (4)(iii) De reflectie- en absorptiespectrale gegevens van het monster worden vervangen door Vgl. (1), en vgl. (1) is gesubstitueerd in Vgl. (4), met hv als de abscis (X as) en (hvF(R .) ∞ )) 1/2 als de ordinaat (Y as).
(iv) Het buigpunt (het maximale punt van de eerste afgeleide) wordt verkregen door de eerste afgeleide van de hv te berekenen -(hvF(R .) ∞ )) 1/2 kromme, en de raaklijn van de kromme wordt op dit punt gemaakt. De absciswaarde van het snijpunt van de raaklijn en de X as zijn de band gap van het monster.
Afbeelding 7 toont de uiteindelijke berekende bandafstanden van C-Si en zwart silicium met verschillende cyclustijden. Het kan gemakkelijk worden vastgesteld dat drie lagere bandafstanden van zwart silicium, namelijk 1,045 eV, 1,033 eV en 1,025 eV duidelijk respectievelijk kleiner zijn dan de 1,12 eV bandafstand van C-Si.
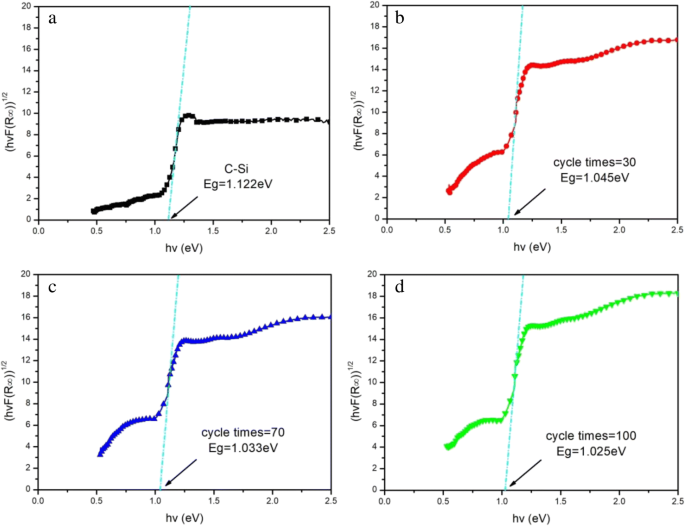
Bandhiaten van C-Si (a ) en zwart silicium gemaakt door verschillende cyclustijden:(b ) 30, (c ) 70, (d ) 100
Gebaseerd op het bovengenoemde zwarte silicium met verbeterde optische eigenschappen, is een Si-PIN-detector gefabriceerd met zwart silicium gevormd op het achteroppervlak. Eerst wordt een zuivere intrinsieke monokristallijne siliciumwafel (n-type) aan beide zijden geoxideerd en vormt SiO2 lagen. Ten tweede wordt de P-laag gefabriceerd door boordiffusie op het lichtgevoelige gebied dat vroeg wordt gevormd door het etsen van de SiO2 laag op het vooroppervlak van de wafer door middel van een fotolithografieproces. Ten derde, een laag Si3 N4 permeatiefilm wordt afgezet op de P-laag en vervolgens wordt het achteroppervlak van de wafel gepolijst en gemalen tot een dikte van ongeveer 200 m. Ten vierde, een P-gedoteerde N + laag wordt afgezet op het geslepen oppervlak en vervolgens wordt het microgestructureerde zwarte silicium gevormd op de bovenkant van N + laag. Ten slotte worden de elektrodevensters geëtst door een fotolithografieproces en worden metalen elektroden aan beide zijden van de wafel afgezet. Afbeelding 8 geeft een echt apparaatbeeld (a), donkerstroom (b), IV-curve onder 1060 nm golflengteverlichting (c) en de responsiviteitsvergelijking van twee verschillende detectoren (d). Hierbij wordt verklaard dat de responsiviteit van apparaat 1 (S1336-44BK, een commerciële Si-PIN-detector) opnieuw is geplot op basis van de openbare website van Hamamatsu Photonics Company [22], en de responsiviteit van apparaat 2 is verkregen op onze nieuwe gefabriceerde Si-PIN-detector met zwart silicium gevormd op het achteroppervlak, waarin het lichtgevoelige oppervlak een cirkel was met een diameter van 2 mm. Het is duidelijk te zien dat apparaat 2 een aanzienlijke toename van de responsiviteit heeft, met name bij nabij-infrarode golflengten, d.w.z. respectievelijk 0,53 A/W bij 1060 nm en 0,31 A/W bij 1100 nm.
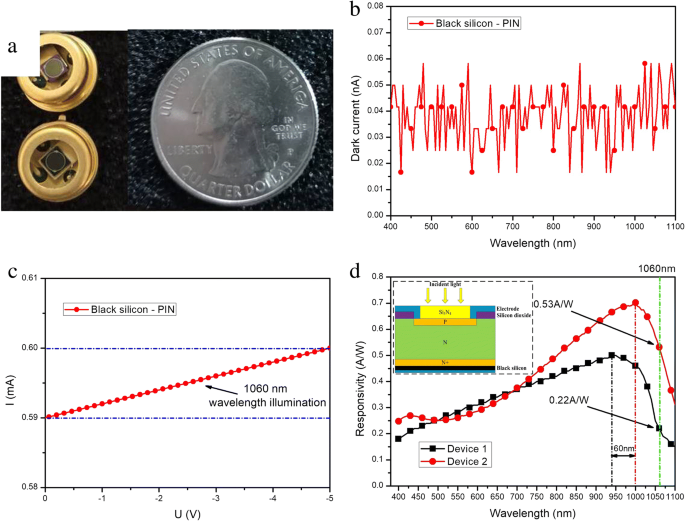
Detectorbeeld (a ), donkere stroom (b ), I–V-curve onder 1060 nm golflengteverlichting (c ), en de reacties van twee verschillende detectoren (d ):apparaat 1 van ref. [22] en apparaat 2 op basis van de resultaten van de huidige paper. De inzet van d toont de apparaatstructuur
Uit figuur 8b blijkt dat hoewel de Si-PIN-detector met zwart silicium gevormd op het achteroppervlak (apparaat 2) een relatief kleine verbetering van de responsiviteit in het zichtbare spectrum vertoont, het responsspectrum ervan een nog hogere responsiviteit in de golflengte geeft. bereik van 680 tot 1100 nm met ongeveer 60 nm roodverschuiving van piekresponsiviteit, vergeleken met de commerciële Si-PIN-detector (apparaat 1). De belangrijkste reden voor een dergelijk onderscheid is dat de apparaatstructuur van deze twee detectoren (apparaten 1 en 2) verschillend is. Wanneer de fotonenergie groter is dan de bandafstand van C-Si, wordt het invallende licht voornamelijk geabsorbeerd door de P-laag en hebben de gegenereerde dragers dus voldoende energie om de N-laag te passeren. De meeste gegenereerde dragers kunnen worden verzameld door N + laag om fotostroom door de elektrode uit te voeren. In deze toestand, of het achteroppervlak van de detector wordt geïntroduceerd met of zonder zwart silicium, zal er een beperkte invloed zijn op de apparaatrespons in de zichtbare golflengte. Anders dan de detector met zwart silicium aan de voorkant [21], vertoont apparaat 2 een betere respons in de zichtbare golflengte. Daarom is er relatief weinig verbetering in de respons op zichtbaar licht volgens de gemeten responsiviteitscurve. Opnieuw in apparaat 2, omdat de zwarte siliciumlaag op het achteroppervlak is geplaatst, zelfs als de fotonenergie minder is dan de bandafstand van C-Si, kan nabij-infraroodlicht de P-laag doordringen en door de N-laag worden geabsorbeerd, en dan kan een groot aantal gegenereerde dragers worden verzameld door de N + laag onder de actie van omgekeerde bias. Als gevolg hiervan zal er een aftelbare fotostroomoutput zijn en vertegenwoordigt het apparaat een substantiële toename van de responsiviteit van de nabij-infrarode golflengte.
Volgens bovenstaande resultaten zou onze huidige studie een haalbare strategie kunnen bieden voor nabij-infrarood foto-elektronisch detectieveld, maar er zijn nog steeds veel aspecten waarmee rekening moet worden gehouden. Er moeten bijvoorbeeld betere fabricageprocessen en ionenimplantatietechnologieën van microgestructureerd zwart silicium worden onderzocht, die de morfologieën en bandhiaten van het gestructureerde silicium nauwkeurig zouden kunnen beheersen. Bovendien moeten enkele andere nieuwe apparaatstructuren van foto-elektronische detectoren op basis van zwart silicium worden ontworpen om betere apparaatprestaties te realiseren.
Conclusies
Samenvattend worden de microgestructureerde zwarte siliciummaterialen vervaardigd door een tweestapsproces:diep reactief ionenetsen gecombineerd met plasma-immersie-ionenimplantatie. De microgestructureerde cilindrische arrays op het oppervlak van siliciumwafels hebben drie verschillende afmetingen:masker I (D = 4 μm, T = 6 μm), masker II (D = 4 μm, T = 8 μm), en masker III (D = 4 μm, T = 10 m), met een hoogte van respectievelijk 1,87 m, 2,35 m en 3,15 m. Duidelijk verbeterde lichtabsorptie van zwart silicium is verkregen in een breed golflengtebereik van 400 tot 2000 nm, en de maximale en gemiddelde lichtabsorptie bereiken respectievelijk 83% en 62%. Deze verbeteringen worden uitgebreid besproken op basis van meervoudige reflectie, grotere absorptiepadlengte en smalle bandafstand. Een nieuwe Si-PIN foto-elektronische detector met zwart silicium gevormd op het achteroppervlak is gefabriceerd, en er is een vergelijking gemaakt van de responsiviteit van het apparaat met een commercieel apparaat genaamd S1336-44BK. Er wordt geconcludeerd dat onze Si-PIN foto-elektronische detector met zwart silicium gevormd op het achteroppervlak een aanzienlijke toename in responsiviteit heeft, met name in de nabij-infrarode golflengten, oplopend tot 0,53 A/W bij 1060 nm en 0,31 A/W bij 1100 nm , respectievelijk.
Nanomaterialen
- Toepassing van molybdeenmetaal en zijn legeringen
- Een vlotte en effectieve onboarding van apparaten via een mobiele applicatie
- IoT-apparaatbeheer en de rol ervan bij het faciliteren van IoT-implementaties op grote schaal
- Coin Paradox Spin-Orbit-interactie verbetert het magneto-optische effect en de toepassing ervan in on-chip geïntegreerde optische isolator
- Elektronische toestanden van nanokristallen gedoteerd met zuurstof en zichtbare emissie op zwart silicium, bereid door ns-Laser
- Ultra-smalle band Perfect Absorber en zijn toepassing als plasmonische sensor in het zichtbare gebied
- Een hervatbare fluorescerende sonde BHN-Fe3O4@SiO2 hybride nanostructuur voor Fe3+ en de toepassing ervan in bioimaging
- Beoordeel toepassing van nanogestructureerd zwart silicium
- Magnetic Gold Nanoparticle-Labeled Heparanase Monoclonal Antibody en de daaropvolgende toepassing voor Tumor Magnetic Resonance Imaging
- Eenvoudige synthese van ultralange en dunne koperen nanodraden en de toepassing ervan op hoogwaardige flexibele transparante geleidende elektroden
- Recyclebare en flexibele zetmeel-ag-netwerken en de toepassing ervan in gewrichtssensoren



