Effect van ultraviolette bestraling op 4H-SiC PiN-diodes Kenmerken
Abstract
In dit artikel wordt het effect van ultraviolette (UV) bestraling op de statische eigenschappen van hoogspannings 4H-SiC PiN onderzocht. Er wordt geen significante verandering waargenomen in de voorwaartse toestand die kenmerkend is voor 4H-SiC PiN-diodes voor en na bestraling met ultraviolet licht. Het is echter gebleken dat de blokkeerspanning aanzienlijk wordt verhoogd met UV-straling, wat het gevolg is van de uitbreiding van de breedte van het uitputtingsgebied met de verzameling van positieve ladingen onder de toename van de negatieve ladingsdichtheid van het oppervlak. De transiënte spectroscopie op diep niveau onthult dat de door UV-straling geïnduceerde defecten op diep niveau een dominante rol spelen ten opzichte van de ingesloten negatieve ladingen, en daarom leiden tot een toename van de blokkeerspanning van 4H-SiC PiN-diodes.
Inleiding
Siliciumcarbide (SiC) zal naar verwachting een veelbelovend kandidaatmateriaal zijn voor de volgende generatie elektronische apparaten met hoog vermogen en hoge temperatuur, vanwege de brede bandgap, hoge kritische elektrische veldsterkte, hoge elektronenverzadigingssnelheid en superieure thermische geleidbaarheid [1 ,2,3,4]. SiC-apparaten worden ontwikkeld ter vervanging van veel van de apparaten die momenteel in silicium worden gebruikt, met name in de vereisten die moeten werken bij hoge spanningen en stroomniveaus en bij temperaturen boven 200 ° C. Vergeleken met unipolaire apparaten, trekken SiC bipolaire apparaten aanzienlijke belangstelling vanwege ultra-hoogspanningstoepassingen vanwege het geleidingsmodulatie-effect in de afgelopen jaren. Als een typisch bipolair apparaat is aangetoond dat de hoogspannings 4H-SiC PiN-diode een potentiële keuze is voor toepassingen met hoogspanningsgelijkrichters, waaronder geavanceerde smart grids, energieopslag en gepulseerd vermogen [5,6,7,8]. Bij het fabricageproces van SiC-vermogensapparaten worden verschillende plasmaprocessen zoals droog etsen en sputterafzetting op grote schaal gebruikt. Er zijn verschillende werken gerapporteerd over procesgeïnduceerde schade in SiC-apparaten om elektrische degradatie teweeg te brengen [9, 10]. Bovendien onthullen eerdere studies dat UV-straling de prestaties van SiC-metaal-oxide-halfgeleider-veldeffecttransistoren (MOSFET's) aanzienlijk vermindert door hoogenergetisch ionenbombardement en plasma-foto-emissie [11, 12]. Onlangs is gemeld dat gepulseerde UV-laserbestraling op 4H-SiC metaaloxide-halfgeleider (MOS) de near-interface oxideval kan induceren en kan leiden tot prestatiedrift en verslechtering van de betrouwbaarheid van het apparaat [13]. Voor zover wij weten, is de UV-straling op SiC PiN-apparaten tot dusver echter niet onderzocht en het is noodzakelijk om de effecten op de kenmerken van het SiC PiN-apparaat te begrijpen.
In deze studie onderzochten we het effect van UV-straling op 4H-SiC PiN-diodes, de voorwaartse en achterwaartse blokkeringskarakteristieken met behulp van UV-straling met een golflengte van 184,9 nm. De invloed van accumulatie van oppervlaktelading op de doorslagspanning van SiC PiN-diodes wordt gepresenteerd met behulp van Technology Computer-Aided Design (TCAD) -simulatie. SiO2 /SiC-toestandsdichtheden voor en na bestraling werden gekarakteriseerd door deep-level transient spectroscopie (DLTS) -systeem op SiC MOS. DLTS wordt veel gebruikt om de dichtheidsverdeling (Dit) van interfacetoestanden en diepe defecten in de MOS-condensator [14, 15] te bestuderen.
Methoden
De schematische structuur van de 4H-SiC PiN-diode die in dit artikel wordt vermeld, wordt getoond in Fig. 1. De 2 μm dikke bufferlaag gedoteerd tot 1 × 10 18 cm −3 en 60 μm dikke n-driftlaag met een dopingconcentratie van 2 × 10 14 cm −3 werden continu gekweekt op 4 ° off-axis zwaar gedoteerde n-type 4H-SiC(0001) substraten. Vervolgens was de bovenste laag p + anode met een dikte van 2 μm en een dopingconcentratie van 2 × 10 19 cm −3 . Na epitaxiale groei werd een cirkelvormige isolatie mesa-structuur met een hoogte van 2, 5 m en een diameter van 300 m gemodelleerd met behulp van inductief gekoppeld plasma dat door de p + anodelaag in de n-driftlaag reageerde. De etsgassen en het maskermateriaal waren SF6 /O2 en respectievelijk afgezet door plasma-versterkte chemische dampafzetting. Na de mesa-isolatie, een dubbel Al-implantaat van 1 × 10 17 cm −3 gebaseerde junctiontermination extension (JTE) werd gevormd om de drukte van elektrische velden nabij de mesarand te verminderen. De implantaten werden geactiveerd door gedurende 30 minuten bij 1650 °C in Ar te gloeien. Een offer SiO2 laag werd gedurende 1 uur bij 1100 ° C gekweekt en ondergedompeld in HF om een vers oppervlak voor thermische oxidatie te verschaffen. Vervolgens thermische oxidatie in droge O2 ambient werd uitgevoerd bij 1100 °C gedurende 3 uur met SiO2 laagdikte van ongeveer 40 nm, gevolgd door gloeien in Ar ambient bij 1100 ° C gedurende 1 uur. Contactmaterialen waren Ni/Ti/Al voor de anode en Ni voor de kathode. Deze metalen gloeiden gedurende 2 minuten bij 800 ° C en 1000 ° C om respectievelijk ohms contact van hoge kwaliteit te verkrijgen. De specifieke contactweerstanden die worden gekenmerkt door de lineaire overdrachtslengtemethode waren 1 × 10 −5 Ω cm 2 en 3,75 × 10 −5 Ω cm 2 voor Ni n type en Ni/Ti/Al p type ohms contact, respectievelijk. Bovenlaagmetaal met dik Al werd op de anode en kathode afgezet. De siliciumdioxidelaag en een dikke polyimidelaag waren aan de voorkant van een patroon voorzien om oppervlaktevonken tijdens hoogspanningsmetingen te voorkomen. Bovendien werden de SiC-MOS-condensatoren gefabriceerd op een hoogwaardig n-type (7 × 10 15 cm −3 ) epitaxielaag op een zwaar gedoteerd 4H-SiC-substraat. Het thermische oxide van 40 nm werd gekweekt op basis van het standaardproces van SiC PiN. De poortelektrode en het ohmse contact aan de achterkant werden gevormd met respectievelijk Al en Ni.

Schematische doorsnede van 4H-SiC PiN-diodes
4H-SiC PiN-diodes en SiC-MOS-condensatoren werden 72 uur zonder voorspanning bestraald met UV-licht met behulp van een kwiklamp met een golflengte van 184,9 nm in lucht. De elektrische kenmerken van 4H-SiC PiN voor en na UV-bestraling werden geëvalueerd door de Wentworth-sonde en het Agilent B1505A halfgeleiderkarakteriseringssysteem. SiC-MOS condensatoren interface toestanden en vaste ladingen werden vervolgens gekarakteriseerd door een PhysTech Fourier Transform DLTS-systeem. De toegepaste omgekeerde bias V R en de vulpulsspanning V P waren respectievelijk 15 V en 2 V. De bemonsteringsperiode t w van de biaspuls van V R naar V P was 1,5 s.
Resultaten en discussie
Het effect van UV-straling op statische kenmerken van SiC PiN wordt getoond in Fig. 2 en 3 waar de kenmerken gemeten voor en na bestraling worden vergeleken voor apparaat 1 (D1) en apparaat 2 (D2). De diameter van ronde SiC PiN-diodes is 3,5 mm en het actieve gebied is ongeveer 10 mm 2 . De voorwaartse spanningsval voor SiC PiN is ongeveer 3,95 V bij een stroomdichtheid van 100 A/cm 2 voor beide twee apparaten vóór UV-bestraling. In figuur 2 is duidelijk te zien dat er geen significante veranderingen zijn in de forward-on-state-karakteristiek voor twee apparaten, die verandert van 3,95 naar 4,0 V na UV-bestraling. De bereikte blokkeerspanningen van apparaat 1 en apparaat 2 vervaardigd op 60 m dikke n-drift epilaag zijn respectievelijk 7 kV en 7,2 kV bij een lekstroom van minder dan 1 A. Opgemerkt moet worden dat de blokkeerefficiëntie van PiN-diodes ongeveer 70% is van de theoretische waarde van 9,7 kV voor een 60 m dikke driftlaag, wat de onnauwkeurigheid van de onzuiverheidsactivering waarschijnlijk leidt tot afwijking van het optimale JTE-implantatievenster. Na UV-bestraling vertoont de blokkeerspanning van apparaat 1 een opmerkelijke toename van 7 naar 9,2 kV met een verbetering van 2,2 kV, die de ideale parallelle-vlakwaarde nadert. Dienovereenkomstig wordt een verbetering van 1,7 kV bereikt voor apparaat 2 na UV-bestraling.

Forward on state-karakteristiek van 4H-SiC PiN-diode voor en na UV-bestraling
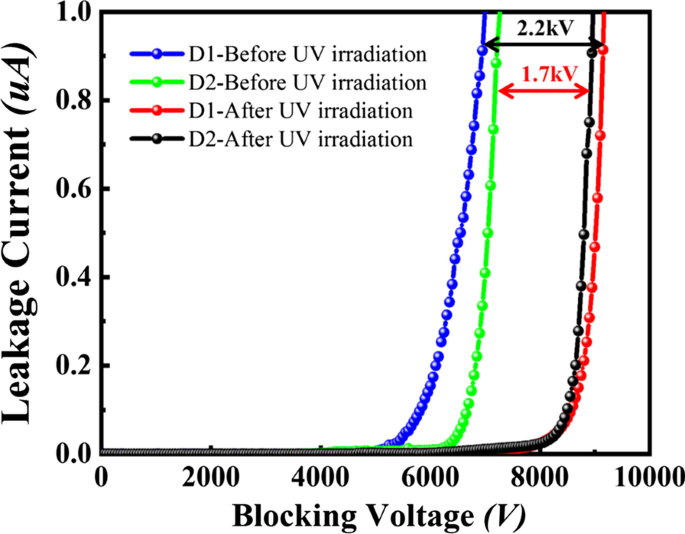
Omgekeerde karakteristiek van 4H-SiC PiN-diode voor en na UV-bestraling
Het is algemeen bekend dat de oppervlaktevallen een significant effect hebben op de distributie van elektrische velden in het eindgebied en vervolgens de omgekeerde blokkeringskarakteristieken in het SiC-vermogensapparaat beïnvloeden. Ikeguchi et al. hebben aangegeven dat hoogenergetische UV-belichting met fotonenergie 5 eV de reeds bestaande gespannen dubbele C-C-bindingen kan transformeren in actieve elektronenvallen, en dus leidt tot de productie van negatief geladen interfacedefecten die worden waargenomen door positieve V FB verschuiving van C/V-curven [11, 12]. Ondertussen kan het gegenereerde elektron door UV-straling worden opgevangen door deep-trap interface-defecten en dus negatief worden geladen met de toename van de vaste ladingsdichtheid. Afbeelding 4 illustreert de afhankelijkheid van gesimuleerde blokkeringskenmerken van de implantaatconcentratie voor dubbele implantaat JTE SiC PiN-diodes met verschillende negatieve oppervlakteladingen. Het is duidelijk te zien dat de oppervlakteladingen in het JTE-gebied een significant effect hebben op de omgekeerde blokkeringsprestaties, vooral wanneer de JTE-implantaatconcentratie afwijkt van het optimale venster. Voor een gegeven dubbele implantaatbeëindigingsstructuur zou, naarmate de negatieve ladingen van het oppervlak toenemen, een breder optimaal venster van doelblokkeringswaarde kunnen worden bereikt. Het is duidelijk dat de JTE-structuur minder gevoelig is voor de interfacelading onder 1 × 10 11 cm −2 en de blokkeerspanning heeft geen duidelijke verandering. Met een dichtheid van oppervlakteladingen hoger dan 5 × 10 11 cm −2 , zou de doorslagspanning dramatisch toenemen. Verrassend genoeg bereikt de doorslagspanning ongeveer de theoretische waarde met een implantaatvenster van 2 × 10 16 cm −3 tot 8 × 10 17 cm −3 bij een dichtheid van oppervlakteladingen van 1 × 10 13 cm −2 .

Gesimuleerde doorslagspanning versus JTE-implantaatconcentratie voor negatieve oppervlaktelading, inclusief geen lading, 1 × 10 11 cm −2 , 5 × 10 11 cm −2 , 1 × 10 12 cm −2 , 5 × 10 12 cm −2 , en 1 × 10 13 cm −2 respectievelijk
Figuur 5 vergelijkt de invloed van de accumulatie van negatieve oppervlaktelading op het elektrisch veldprofiel bij de blokkeringskarakteristiek. De verdeling van het elektrisch veld met de evolutie van het uitputtingsgebied in de 4H-SiC PiN-diodes wordt getoond in figuur 5a. Wanneer de negatieve lading toeneemt tot 5 × 10 12 cm −2 bij de SiO2 /SiC (JTE-structuurgebied) interface van SiC PiN, wordt de positieve lading van N-driftlaag verzameld op het interface-oppervlak, wat leidt tot de significante uitbreiding van het uitputtingsgebied [16]. De figuur 5b toont de snijlijn van het elektrische veld onder de JTE/n-drift-regio-overgang met de negatieve ladingsdichtheid van het oppervlak van 1 × 10 11 en 5 × 10 12 cm −2 . In het geval van een lage oppervlaktelading van 1 × 10 11 cm −2 , treedt ernstige elektrische veldverdringing op in het randbeëindigingsgebied met een maximale waarde van 2,5 MV / cm en de doorslagspanning is ongeveer 8 kV. Naarmate de ladingsdichtheid toeneemt tot 5 × 10 12 cm −2 , het elektrische piekveld daalt tot 2,2 MV / cm en de elektrische veldverdringing bij het randbeëindigingsgebied wordt in vergelijking onderdrukt. Ondertussen is de verdeling van het elektrische veld uniformer en neemt de doorslagspanning duidelijk toe. Daarom kan de negatieve oppervlaktelading de uitputting vergroten en de verdringing van het elektrische veld verminderen, wat resulteert in een verbetering van de doorslagspanning.

Gesimuleerde elektrische veldverdelingen van SiC PiN met een negatieve oppervlakteladingsdichtheid van 1 × 10 11 cm −2 en 5 × 10 12 cm −2 :een elektrische veldverdeling met de evolutie van het uitputtingsgebied b snijlijn van het elektrisch veld onder de JTE/n-drift-regioverbinding. De implantaatconcentratie wordt gebruikt 6 × 10 16 cm −3
Om de fysieke mechanismen voor het genereren van door bestraling veroorzaakte elektronische defecten verder te valideren, is een betere elektrische karakterisering van SiO2 /SiC-interface is vereist om meer details te onderzoeken. DLTS-spectra voor 4H-SiC SiC-MOS-condensatoren werden gekarakteriseerd in uitputting van 15 tot 2 V voor en na UV-bestraling, zoals weergegeven in Fig. 6. Uit de DLTS-spectra werden twee pieken waargenomen in de 4H-SiC MOS-condensatoren, beide eerder en na UV-bestraling, lokaliseren bij respectievelijk 210 K en 490 K. Negatieve DLTS-pieken geven aan dat het P1- en P2-niveau elektronenvallen zijn. Het brede en significante P2-niveau vertoont een significante toename van de piekamplitude, wat betekent dat de concentratie van elektronenvanger wordt verhoogd door UV-straling. Bovendien is gevonden dat het DLTS-signaal proportioneel toeneemt met de vultijd, wat een valvullende kinetiek vertoont die kenmerkend is voor uitgebreide defecten, zoals interface-defecten in plaats van puntdefecten. Het inzetstuk toont de verdelingen van de dichtheid van de interfacetoestand versus de activeringsenergie ET . De dichtheid van de interfacetoestand wordt berekend door \(D_{{{\text{it}}}} =\varepsilon_{{{\text{sic}}}} C_{{{\text{ACC}}}} AN_{{ \text{D}}} \Delta C/\left[ {C_{R}^{3} kT} \right]\) [17]. Uit de figuur blijkt dat het interfacedefect aanleiding geeft tot een energieband in de bandgap van E C − 0,65 eV tot E C − 1,25 eV en zijn dichtheid zijn aanzienlijk toegenomen van 2 × 10 12 cm −2 eV −1 tot 6 × 10 12 cm −2 eV −1 na UV-bestraling. Door de combinatie van transiënte capaciteitsmetingen, transmissie-elektronenmicroscopie met hoge resolutie en dichtheid-functionele theorieberekeningen, Dong et al. suggereerde dat deze interface-defecten voortkwamen uit negatief geladen overtollige gespleten interstitiële koolstof op het grensvlak [18]. De P1-piek bij 210 k komt overeen met een elektronenval bij E C − 0,41 eV. De concentratie ervan vertoont geen essentiële verandering na UV-bestraling, en de P1-val werd voorlopig toegewezen aan puntdefecten in de SiC-epillaag. De atomaire configuratie is echter nog steeds onduidelijk en moet in toekomstig onderzoek worden opgehelderd.
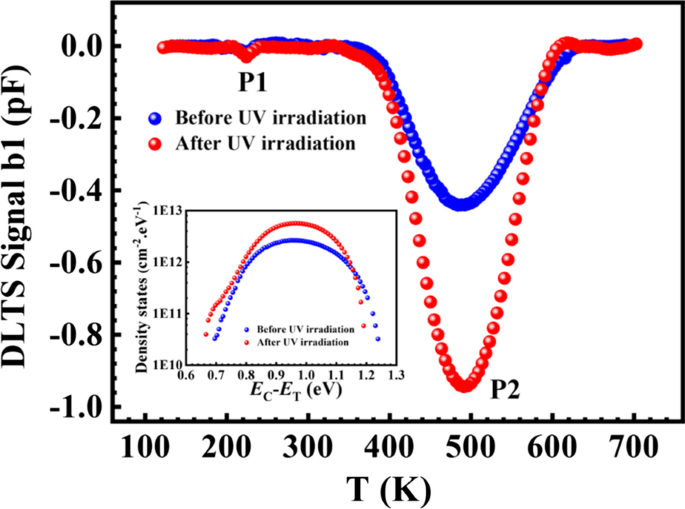
DLTS-spectra voor 4H-SiC PiN-diodes voor en na UV-bestraling. Het inzetstuk toont de D it-distributies voor 4H-SiC PiN-diodes voor en na UV-bestraling
Conclusies
De invloed van UV-straling op de elektrische eigenschappen van 4H-SiC PiN-diodes is onderzocht. Uit de resultaten van elektrische experimenten wordt een onbeduidende verandering van de voorwaartse stroom waargenomen na UV-bestraling. De UV-straling blijkt echter een opmerkelijke toename van de blokkeerspanning. Het is gebleken dat de UV-straling diepe defecten genereert in de interface van PiN-diodes, wat resulteert in een toename van de diepe acceptorniveaus in de bandgap. Deze defecten op diep niveau dienen als het centrum van elektronenvangst en leiden tot de significante toename van negatieve lading in SiO2 /SiC-interface. De positieve ladingen van de N-dirftlaag worden verzameld op het interface-oppervlak en bevorderen de uitbreiding van het uitputtingsgebied verder met een meer uniforme elektrische veldverdeling, wat de toename van de blokkeerspanning teweegbrengt.
Beschikbaarheid van gegevens en materialen
Alle gegevens zijn onbeperkt beschikbaar.
Nanomaterialen
- Diodes
- Diodes voor speciale doeleinden
- Deegrol
- Bowlingspeld
- Kenmerken van glasvezel
- Effect van gouden nanodeeltjesdistributie in TiO2 op de optische en elektrische kenmerken van kleurstofgevoelige zonnecellen
- Effect van polyethyleenglycol op de NiO-fotokathode
- Effect van gloeien op microstructuren en verharding van met helium-waterstof geïmplanteerde sequentieel vanadiumlegeringen
- Effect van wolfraam nanolaagcoating op Si-elektrode in lithium-ionbatterij
- Bijna efficiëntie-Droop-Free AlGaN-gebaseerde ultraviolette lichtemitterende diodes met een speciaal ontworpen superrooster p-Type elektronenblokkerende laag voor hoge Mg-dopingefficiëntie
- Elektronische structuur en IV-kenmerken van InSe Nanoribbons



